Приборы и техника эксперимента, 2023, № 1, стр. 80-86
ПОТЕРИ МОЩНОСТИ ИЗЛУЧЕНИЯ В СВЕТОДИОДАХ
А. В. Градобоев a, *, К. Н. Орлова b, **, Ф. Ф. Жамалдинов a
a Национальный исследовательский Томский политехнический университет
634050 Томск, просп. Ленина, 30, Россия
b Национальный исследовательский ядерный университет “МИФИ”
115409 Москва, Каширское шоссе, 31, Россия
* E-mail: gava@tpu.ru
** E-mail: KNOrlova@mephi.ru
Поступила в редакцию 22.04.2022
После доработки 11.05.2022
Принята к публикации 21.06.2022
- EDN: JPKHRC
- DOI: 10.31857/S0032816222060131
Аннотация
На основании анализа известных литературных данных и структуры конструктивно оформленных светодиодов предложена классификация потерь мощности излучения активного слоя светодиода. При этом выделены активные и пассивные потери мощности светодиода. Показано, что пассивные потери мощности излучения не приводят к изменению квантового выхода активного (рабочего) слоя светодиода и/или прямой ветви вольт-амперной характеристики, но при этом проявляются в виде аномалий на светотехнических характеристиках светодиодов. Предложена методика определения пассивных потерь мощности излучения активного слоя светодиодов. На примере светодиодов инфракрасного диапазона длин волн, изготовленных на основе гетероструктур AlGaAs, показана эффективность контроля пассивных потерь мощности излучения светодиодов при исследовании их эксплуатационных свойств.
1. ВВЕДЕНИЕ
Cветодиоды (СД) активно применяются практически во всех отраслях науки и техники, в том числе для волоконно-оптических линий связи, интегрированных оптоэлектронных устройств, систем оптической связи с открытым каналом, медицинского приборостроения, для осветительной техники различного назначения и т.д. Широкая сфера применения СД с учетом ее интенсивного развития способствовала существенному росту их производства. По условиям эксплуатации СД могут подвергаться действию различных внешних факторов, что требует знаний о закономерностях изменения их параметров при комплексном и комбинированном действии как факторов длительной эксплуатации, так и различных видов ионизирующего излучения.
Для изготовления СД в промышленных и лабораторных условиях используются самые разнообразные полупроводниковые структуры [1–3]. Востребованность СД привела к появлению достаточно большого количества работ по исследованию их надежности и радиационной стойкости [4–6]. При этом практически все авторы отмечают достаточно сложную многокомпонентную структуру СД. Обычно СД содержит корпус, кристалл (чип) из многослойной полупроводниковой структуры, в которой активный (рабочий) слой скрыт промежуточными слоями, в том числе слоями металлизации, а также теплоотвод и оптическую линзу для формирования направленного пучка излучения [7, 8].
При этом часто наблюдается потеря мощности излучения активного слоя на указанных выше элементах конструкции [9, 10], что приводит к заметному отличию внешнего квантового выхода от внутреннего (квантового выхода активного слоя СД) и, как следствие, к снижению КПД СД.
К настоящему времени разработан и опробован комплекс технических решений, позволяющих снизить потери мощности излучения активного слоя СД и, таким образом, повысить его КПД. В частности, следует отметить технические решения, используемые при изготовлении многокомпонентной полупроводниковой структуры СД, а именно: формирование на поверхности структуры прозрачной пленки [11], добавление просветляющего слоя [12], формирование внутренних отражателей [13], использование наклонной боковой стенки кристалла [14] и т.д.
Установлено, что у СД из самых разных материалов (особенно на основе гетероструктур AlGaAs) в процессе эксплуатации и/или радиационного воздействия появляются дефекты темных линий и пятен (ДТЛП) [15–17]. Достаточно часто ДТЛП обнаруживаются и у исходных СД до воздействия внешних факторов. Доказано, что данный вид дефектов связан с дислокациями [18–21]. Появление ДТЛП особенно характерно для СД на основе GaAs, GaP, AlGaAs.
Следует отметить, что все исследования ДТЛП основаны на различных методах микроскопии (оптической, электронной микроскопии, катодолюминесценции и т.д.). При этом весь анализ сосредоточен только на исследовании распределения интенсивности излучения света по площади кристалла СД. Установленная таким образом взаимосвязь между плотностью ДТЛП и плотностью дислокаций носит только качественный характер. Особо отметим отсутствие количественных соотношений, которые бы устанавливали количественную связь между характеристиками ДТЛП (или плотностью дислокаций?) и электрофизическими и светотехническими характеристиками СД.
Таким образом, к настоящему времени отсутствуют методы оценки подобных потерь мощности излучения СД, а эффективность внешнего квантового выхода СД в целом оценивается только путем сопоставления светотехнических и электрофизических характеристик СД различных конструкций, изготовленных из полупроводниковых материалов, которые имеют различное строение и получены разными способами из различных источников.
Отсутствие эффективных методов оценки потерь мощности излучения активного слоя СД не позволяет исследовать развитие потерь в результате действия различных внешних факторов, а также затрудняет исследование влияния структурного состава кристалла, технологии его выращивания и элементов конструктивного оформления на выходную эффективность СД в полном объеме.
Снижение внешнего квантового выхода также может быть следствием потери мощности излучения активного слоя СД в результате изменения оптических свойств линзы при эксплуатации и/или радиационном воздействии (введение центров окраски, дополнительных центров рассеяния излучения и т.д.). Рост последовательного сопротивления омических контактов при воздействии внешних факторов приведет к дополнительному падению рабочего напряжения и, соответственно, к дополнительному снижению КПД.
Исключение представляет работа [21], в которой описана методика оценки снижения мощности излучения СД вследствие подключения объемного канала утечки тока (дислокаций) параллельно p–n-переходу СД. Подобные результаты могут наблюдаться и при формировании каналов утечки тока по боковой поверхности кристалла.
Цель данной работы – разработка методики оценки потерь мощности излучения активного слоя СД, которые могут быть обусловлены рассмотренными выше причинами.
2. КЛАССИФИКАЦИЯ ПОТЕРЬ МОЩНОСТИ ИЗЛУЧЕНИЯ
Прежде чем говорить о методике оценки потерь мощности излучения активного слоя СД, рассмотрим их классификацию. Напомним, что основной электрофизической характеристикой СД является прямая ветвь вольт-амперной характеристики (ВАХ). К основным светотехническим характеристикам СД следует отнести ватт-амперную (ВтАХ) и ватт-вольтную (ВтВХ) характеристики, спектр излучения и диаграмму направленности излучения.
Если внимательно рассмотреть потери мощности излучения, частично изложенные выше, можно предложить их следующую классификацию.
На наш взгляд, можно однозначно выделить пассивные потери мощности, появление которых не приводит к изменению квантового выхода активного (рабочего) слоя СД и/или прямой ветви ВАХ, но при этом должно проявляться в виде аномалий на ВтАХ, ВтВХ, в спектре излучения и диаграмме направленности излучения.
Пассивные потери мощности можно выявлять как до воздействия различных внешних факторов (повышенная температура, внешние электрические поля, ультразвук, ионизирующее излучение и т.д.), так и во время и после воздействий.
К пассивным потерям можно отнести:
1) присутствие и/или формирование центров рассеяния и/или поглощения в элементах конструкции СД (различные промежуточные полупроводниковые слои, оптическая линза);
2) плохую отражательную способность (или ее ухудшение в результате действия внешних факторов) слоев металлизации;
3) деградацию отражателей Брэгга и т.д.;
4) дефекты темных линий и пятен.
Активные потери – это потери мощности излучения активного слоя СД, следствием проявления которых является изменение режима его электропитания. К активным потерям мощности излучения следует отнести потери, которые обусловлены следующими причинами:
1) высоким сопротивлением омических контактов и/или их деградацией при внешних воздействиях;
2) появлением и/или развитием каналов утечки тока на боковой поверхности кристалла СД;
3) появлением и/или развитием объемных каналов утечки тока;
4) сокращением эффективной площади активного слоя и т.д.
Конечно же, представленный выше перечень потерь мощности излучения активного слоя СД не является полным и может быть существенно дополнен при проведении соответствующих исследований. Однако возможность и эффективность проведения таких исследований можно оценить только после разработки методики определения этих потерь.
3. ОБЪЕКТЫ ИССЛЕДОВАНИЙ И ИСПОЛЬЗУЕМОЕ ОБОРУДОВАНИЕ
Объектами исследования выбраны промышленные СД, изготовленные на основе двойных гетероструктур AlGaAs и предназначенные для эксплуатации в инфракрасном диапазоне длин волн.
Кристалл (чип) СД изготавливался по сэндвич-технологии с применением методов:
– осаждения и формирования слоев металлизации для создания омических контактов на многослойной полупроводниковой структуре (пластине);
– фотолитографии и химического травления для формирования кристаллов (чипов);
– скрайбирования для разделения пластин на отдельные чипы.
Выбранные СД имели идентичную конструкцию. Кристалл монтировался на теплоотвод методом прямого или обратного монтажа, присоединялись электрические выводы и формировался корпус из оптического компаунда, который дополнительно имел линзу для создания направленного пучка излучения.
Для измерения основных характеристик СД использовали автоматизированный измерительный комплекс на основе фотометрического шара. Измерительный комплекс позволяет измерять прямое напряжение СД от 0 до 5 В в диапазоне прямых токов 0–500 мА с шагом 1 мА. При этом погрешность задания прямого тока от установленного уровня составляла ±3%. Следует отметить, что мощность излучения индивидуального СД в данной работе характеризовали током фотодиода, используемого в фотометрическом шаре.
Используемый фотометрический комплекс позволяет исключить из рассмотрения изменение диаграммы направленности излучения СД. Это отдельный вопрос и требует отдельного исследования.
Для демонстрации методики определения потерь мощности излучения в данной работе использовались СД после воздействия факторов длительной эксплуатации и после облучения γ-квантами.
Воздействие факторов длительной эксплуатации проводили на специальном сертифицированном стенде. В состав стенда входили тепловые камеры, позволяющие задавать требуемую окружающую температуру, набор индивидуальных блоков питания СД и комплекс контрольно-измерительного оборудования для контроля режимов испытаний и обеспечения их стабильности при испытаниях. Форсирование действия эксплуатационных факторов осуществляли методом ступенчатых испытаний при повышенной температуре. На первой ступени рабочий ток СД соответствовал рекомендуемому режиму его эксплуатации (Iор = 50 мА), окружающая температура изменялась в диапазоне от +65 до +85°С. Верхний предел температуры определялся допустимым режимом форсирования. Затем рабочий ток ступенчато повышали на величину, которую выбирали в диапазоне от 25 до 100 мА. Продолжительность каждого ступенчатого воздействия составляла 24 ч. При этом до и после ступенчатого воздействия контролировали ВАХ и ВтАХ СД. Ступенчатые испытания останавливали при появлении катастрофических отказов и/или заметного изменения электрофизических и светотехнических характеристик СД.
Облучение СД γ-квантами в нормальных климатических условиях проводили на изотопной установке “Исследователь” (изотоп 60Со) в пассивном режиме питания. Степень воздействия характеризовали поглощенной дозой Dγ [Гр(Si)].
4. МЕТОДИКА ОПРЕДЕЛЕНИЯ ПОТЕРЬ МОЩНОСТИ ИЗЛУЧЕНИЯ
Конечно же, трудно предполагать с высокой долей вероятности наличие потерь мощности излучения активного слоя у исходных СД, которые не подвергались воздействию внешних факторов. Однако анализ исходных электрофизических и светотехнических характеристик СД, как это будет показано ниже, позволяет выдвинуть такую гипотезу и проверить ее, используя предлагаемую методику.
4.1. Пассивные потери мощности излучения
Рассмотрим проявление пассивных потерь мощности излучения активного слоя СД. Типичная ВАХ СД инфракрасного диапазона длин волн на основе гетероструктуры AlGaAs показана на рис. 1 в двойных логарифмических координатах. Такое представление ВАХ позволяет выделить область LC низких токов и область HC высоких токов, при этом каждая из выделенных областей характеризуется собственной закономерностью изменения рабочего напряжения в зависимости от рабочего тока.
Рис. 1.
ВАХ СД на основе гетероструктур AlGaAs в двойных логарифмических координатах. LC – область низких токов, HC – область высоких токов.

Рассмотрим ВАХ СД в линейных координатах, которая показана рис. 2. Согласно этому рисунку, ВАХ в области HC достаточно хорошо описывается следующим соотношением:
где Uop, Iop – рабочее напряжение и рабочий ток СД соответственно; U0 = 1.33 В – напряжение отсечки p–n-перехода СД; R = 1.62 Ом – омическое сопротивление активного слоя СД в области HC.Рис. 2.
ВАХ СД на основе гетероструктур AlGaAs в линейных координатах. LC – область низких токов, HC – область высоких токов.

Таким образом, представленные выше результаты позволяют сделать вывод о том, что в области HC ВАХ СД определяется его омическим сопротивлением.
Аналогичным образом рассмотрим ВтАХ СД, которая показана на рис. 3. В данном случае также можно выделить области LC и HC, которые практически совпадают с выделенными ранее областями на ВАХ (см. рис. 1). Согласно представленным на рис. 3 результатам, ВтАХ в области HC может быть описана достаточно простым соотношением:
где Р – мощность излучения СД; А – коэффициент пропорциональности, величина которого характеризует квантовый выход индивидуального СД и чувствительность фотодиода, используемого при измерениях в фотометрическом шаре; γ – показатель степени.Рис. 3.
Типичная ВтАХ СД на основе гетероструктур AlGaAs. LC – область низких токов, HC – область высоких токов.
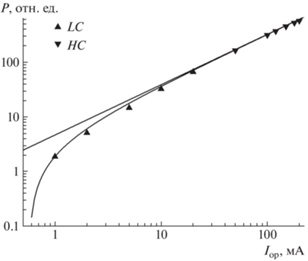
Вернемся к рис. 3. Наблюдаемое отличие между соотношением (2) и результатами измерений в области LC достаточно хорошо описываются введением потерь мощности излучения. Тогда с учетом результатов измерений в области LC получаем следующее соотношение:
где ΔР – пассивные потери мощности излучения активного слоя СД, поскольку их вклад не зависит от рабочего тока СД.Рассмотрим, каким образом выявленные потери изменяются при воздействии факторов длительной эксплуатации. На рис. 4 показано изменение ВтАХ СД при ступенчатых испытаниях.
Рис. 4.
Изменение ВтАХ СД при ступенчатых испытаниях. Точки – результат измерений; линии – расчет по формуле (3).

Ступенчатые испытания проводили при температуре окружающей среды +85°С, начальном токе 50 мА, шаге ступени 50 мА и длительности ступени 24 ч.
Согласно рис. 4, изменение пассивных потерь в результате воздействия факторов длительной эксплуатации приводит к существенному искажению формы ВтАХ по мере роста уровня воздействия. В свою очередь, изменение формы ВтАХ приводит к появлению псевдозависимости скорости снижения мощности излучения от уровня инжекции, а также к псевдозависимости квантовой эффективности от плотности рабочего тока.
Результаты, представленные на рис. 3, позволяют установить закономерность развития потерь в зависимости от номера (или тока) ступени (рис. 5).
Рис. 5.
Зависимость пассивных потерь мощности излучения СД при ступенчатых испытаниях от номера ступени.

Следует отметить, что для данного СД (см. рис. 5) на восьмой ступени испытаний наступил катастрофический отказ.
Рассмотрим изменение пассивных потерь мощности излучения СД при облучении γ-квантами. На рис. 6 показано изменение ВтАХ СД при различных дозах облучения γ-квантами. Полученные закономерности достаточно хорошо описываются соотношением (3).
Рис. 6.
Изменение ВтАХ СД при различных дозах облучения γ-квантами. Точки – результаты измерений; линии – расчет по соотношению (3).

Таким образом, можно сделать вывод о том, что появление пассивных потерь при воздействии ионизирующего излучения приводит к появлению псевдозависимости скорости снижения мощности излучения от уровня инжекции.
Результаты, представленные на рис. 6, позволяют установить зависимость пассивных потерь мощности излучения СД от дозы облучения γ‑квантами (рис. 7).
Согласно рис. 7, облучение γ-квантами приводит к росту пассивных потерь мощности излучения СД на основе гетероструктур AlGaAs. Следует особо отметить, что облучение дозой 1.86 · 108 Гр привело к развитию катастрофического отказа при последующем измерении ВтАХ.
Рассмотрим вопрос о природе пассивных потерь мощности излучения исследованных в данной работе СД. Выборочный анализ кристаллов до изготовления конструктивно оформленных СД показал, что во всех анализируемых кристаллах наблюдаются ДТЛП. Кроме того, у всех исследуемых конструктивно оформленных СД были выявлены пассивные потери мощности излучения. Данные факты позволяют с высокой степенью достоверности утверждать, что описанные выше пассивные потери мощности излучения обусловлены пассивными потерями на ДТЛП. Следует отметить, что в данном случае ДТЛП расположены вне активного слоя, поскольку их вклад не зависит от величины рабочего тока.
4.2. Активные потери мощности излучения
В соответствии с классификацией потерь мощности излучения СД к активным потерям следует отнести потери, которые обусловлены формированием поверхностных и объемных каналов утечки рабочего тока, а также деградацией омического сопротивления СД.
Методика определения активных потерь мощности изучения СД при формировании поверхностных и объемных каналов утечки тока достаточно подробно рассмотрена в [21].
Рассмотрим более подробно деградацию омического сопротивления СД. Омическое сопротивление СД определяется суммой омического сопротивления его активного слоя и сопротивления омических контактов. К настоящему времени нет эффективных способов разделения омического сопротивления контактов и сопротивления активного слоя. В большинстве практических случаев сопротивление омических контактов много меньше сопротивления активного слоя СД, поэтому им можно пренебречь. Суммарное омическое сопротивление СД можно достаточно легко определить по соотношению (1) (см. рис. 1). Таким же способом можно контролировать изменение омического сопротивления СД при различных внешних воздействиях.
С другой стороны, если в процессе исследований контролировать электрофизические характеристики активного слоя (концентрацию носителей заряда, изменение их подвижности), то по нестабильности отдельных характеристик можно сделать вывод о причинах изменения омического сопротивления СД.
Изменение омического сопротивления при воздействии внешних факторов можно определить по соотношению (1).
Далее рассмотрим, каким образом изменятся характеристики СД при изменении омического сопротивления. На ВАХ СД (см. рис. 2) мы однозначно зарегистрируем это изменение. На ВтАХ каких-либо изменений не будет, а на ВтВХ появится сдвиг по оси напряжений на величину дополнительного падения напряжения на омическом сопротивлении. Также проявление деградации омического сопротивления СД будет заметно на зависимости КПД от рабочего тока СД.
В случае, когда ДТЛП расположены в активном слое СД, наблюдаемые потери мощности излучения следует отнести к активным потерям, поскольку их вклад в снижение мощности должен зависеть от рабочего тока. Тогда для определения потерь мощности излучения следует воспользоваться следующим соотношением:
где ΔРactive(Iop) – активные потери мощности излучения.Объединив соотношения (3), (4), получим общую формулу для определения потерь мощности излучения активного слоя в конструктивно оформленном СД:
(5)
$P = A{{I}_{{{\text{ор}}}}} - \Delta P - \Delta {{P}_{{{\text{activе}}}}}({{I}_{{{\text{op}}}}}).$Таким образом, изложенная выше методика позволяет определять пассивные и активные потери мощности излучения как для исходных СД, так и для СД после воздействия различных внешних факторов.
Предложенная методика не позволяет установить причину появления и развития пассивных потерь при воздействии внешних факторов, однако полученные результаты исследований позволяют планировать целевые эксперименты по установлению физической природы потерь мощности.
Практическая реализация указанных выше исследований позволит повысить достоверность оценки эксплуатационных свойств СД (минимальная наработка, безотказность, радиационная стойкость и т.д.).
5. ЗАКЛЮЧЕНИЕ
В заключение сформулируем основные результаты и выводы, полученные в данной работе.
1. На основании анализа известных литературных данных о деградации СД и их конструкции предложена классификация потерь мощности излучения активного слоя СД. При этом выделены активные и пассивные потери мощности. Последние не приводят к изменению квантового выхода активного (рабочего) слоя СД и/или прямой ветви ВАХ, но при этом проявляются в виде аномалий на светотехнических характеристиках СД.
2. Предложена методика определения пассивных и активных потерь мощности излучения активного слоя СД.
3. На примере СД инфракрасного диапазона длин волн, изготовленных на основе гетероструктур AlGaAs, показана эффективность контроля пассивных потерь мощности излучения при исследовании их эксплуатационных свойств.
4. Показано, что появление пассивных потерь мощности излучения СД приводит к появлению мнимой зависимости квантовой эффективности от плотности рабочего тока СД.
5. Показано, что пассивные потери мощности излучения СД на основе гетероструктур AlGaAs могут быть обусловлены дефектами темных линий и пятен.
Список литературы
Bergh A.A., Dean P.J. Light-emitting diodes. Oxford: Clarendon Press, 1976.
Коган Л.М. Полупроводниковые светоизлучающие диоды. М.: Энергоатомиздат, 1983.
Шуберт Ф. Светодиоды. М.: Физматлит, 2008.
Eliashevich I., Dcbray J., Tran C.A., Venugopalan H., Karlicck Jr. F.R. // Proc. ot SPIE Light-Emitting Diodes: Research. Manufacturing, and Applications IV. 2000. V. 3938. https://doi.org/10.1117/12.382815
Stockman S.A., Walter Yao H., Schubert E.F. // Proc. of SPIE Light-Emitting Diodes: Research, Manufacturing, and Applications VIII. 2004. V. 5366. https://doi.org/10.1117/12.528938
Холгер Проcc (Holger Pross) // Современная светотехника. 2010. № 5. С. 47.
Gradoboev A.V., Simonova A.V., Orlova K.N. // Physica Status Solidi (C). 2016. V. 13. № 10–12. P. 895. https://doi.org/10.1002/pssc.201600035
Shailesh K.R., Ciji P.K., Savitha G.K. // International Journal of Semiconductor Science & Technology. 2012. V. 3. № 1. P. 43. https://doi.org/10.1109/ICETEEEM.2012.6494509
Orlova K., Gradoboev A.V., Simonova A. // International Journal of Emerging Technology and Advanced Engineering. 2022. V. 12. P. 100. https://doi.org/10.46338/ijetae0222_12
Gradoboev A.V., Orlova K.N. // IOP Conference Series: Materials Science and Engineering. 2015. V. 81. № 1. P. 012008. https://doi.org/10.1088/1757-899X/81/1/012008
Aliyu Y.H., Morgan D.V., Thomas H., Bland S.W. // Electronics Letters. 1995. V. 31. Issue19. P. 1691. https://doi.org/10.1049/el:19951132
Chin A.K., Zydzik G., Singh S., van Uitert L.G., Minneci G. // Journal of Vacuum Science & Technology B: Microelectronics Processing and Phenomena. 1983. V. 1. Issue 1. P. 72.
Gessmann T., Schubert E.R., Graff J.W., Streubel K., Kamutsch C. // IEEE Electron Device Letters. 2003. V. 24. Issue 11. P. 683. https://doi.org/10.1109/LED.2003.817386
Lee Y.C., Lee C.E., Kuo H.C., Lu T.C., Wang S.C. // IEEE Photonics Technology Letters. 2008. V. 20. Issue 5. P. 369. https://doi.org/10.1109/LPT.2008.2010903
Suzuki T., Matsumoto Y. // Applied Physics Letters. 1975. V. 26. № 8. P. 431. https://doi.org/0.1063/1.88226
Ishida K., Kamejima T., Matsui J. // Applied Physics Letters. 1977. V. 31. № 6. P. 397.
Chin A.K., Zipfel C.L., Chin B.H., DiGiuseppe M.A. // Applied Physics Letters. 1983. V. 42. № 12. P. 1031. https://doi.org/10.1063/1.93831
Chand N., Chu S.N.G. // Applied Physics Letters. 1991. V. 58. № 1. P. 74.
Lester S.D., Ponce R.A., Craford M.G., Steigerwald D.A. // Applied Physics Letters. 1995. V. 66. № 10. P. 1249. https://doi.org/10.1063/1.113252
Hino T., Tomiya S., Miyajima T., Yanashima K., Hashimoto S., Ikeda M. // Applied Physics Letters. 2000. V. 76. № 23. P. 3421. https://doi.org/10.1063/1.126666
Градобоев А.В., Орлова К.Н., Симонова А.В., Сед-нев В.В. // ПТЭ. 2021. № 5. С. 90. https://doi.org/10.31857/S0032816221040157
Дополнительные материалы отсутствуют.
Инструменты
Приборы и техника эксперимента



