ВВЕДЕНИЕ
Сегодня основным объемом выпускаемых электронных устройств являются интегральные схемы (ИС) вычислительных систем на основе комплементарных металл–оксид-полупроводниковых (КМОП) транзисторов на кремнии [1–3]. Для статической кэш-памяти процессоров и схем динамической памяти DRAM применяют наиболее передовые проектные нормы уровня 5–10 нм, а для энергонезависимой памяти в системах на кристалле SoC и флэш-памяти используются менее сложные техпроцессы 10–14 и 22–28 нм, соответственно. Исследование физических основ и технологий формирования интегральных приборов универсальной памяти, объединяющих лучшие характеристики по емкости, быстродействию и энергоэффективности всех типов запоминающих устройств остается актуальной проблемой полупроводниковой микро- и наноэлектроники.
Возможным путем ее решения явилось обнаружение группой из Технического университета Дрездена (ФРГ) в 2011 г. сегнетоэлектрических свойств у суб-20 нм пленок на основе диоксида гафния (HfO2) с примесью Si (HO:Si) в коэрцитивном поле Ec = (1–2) ⋅ 106 В/см [4, 5]. Поскольку беспримесные пленки HfO2 (HO) c 2008 г. активно применяются в качестве подзатворного high-k изолятора во всех современных КМОП ИС с напряжением питания до 1.5 В, нет технических барьеров для внедрения сегнетоэлектрических слоев HfO2 с примесью в КМОП ИС технологию. Чуть позже эта же группа продемонстрировала снижение Ec и увеличение остаточной поляризации Pr до 10–20 мкКл/см2 в твердом растворе диоксида гафния-циркония (Hf0.5Zr0.5O2 или HZO) [6].
Авторами первых работ методами электронной и рентгеновской дифракции было показано, что сегнетоэлектрический гистерезис в HO:Si и HZO слоях обусловлен метастабильной нецентросимметричной орторомбической фазой Pca21. Эта фаза в пленках HO:Si и HZO превращалась в стабильную моноклинную фазу P21/c при длительных стационарных термообработках (FA) выше 600 и 500°С, соответственно [7]. В то же время температурный бюджет изготовления большинства современных КМОП ИС достигает 900–950°С. Решать проблему термостабильности предлагалось двумя способами. Во-первых, использованием редкоземельных примесей (La, Gd, Y и других) или Al для легирования HO вместо кремния [7–9], которые формируют тугоплавкие оксиды за счет большей энергии связи, а во-вторых, – снижением длительности тепловой нагрузки на сегнетоэлектрик при быстрых (десятки секунд) термообработках (RTA) [10].Целью настоящей работы было расширение области термической стабильности сегнетоэлектрической фазы на основе диоксида гафния применением этих двух способов одновременно для сохранения максимальной величины остаточной поляризации после температур отжига T ≤ 900°С. Для этого, вместо введения неупорядоченных включений тугоплавких оксидов, было исследовано влияние регулярных вставок монослоев Al2O3, разбивающих толстые 20 нм пленки на нанометровые ламели НО или НZO. Такие пленки-ламинаты обозначены дальше НАО или HZAO, соответственно. Этим способом предполагалось подавить ускоренный рост стабильной моноклинной фазы при термообработках за счет размерных эффектов в свободных энергиях наноразмерных зародышей всех фаз, формирующихся в процессе плазменно-стимулированного атомно-слоевого осаждения (PEALD) [11], с учетом более высоких температур кристаллизации вставок аморфного Al2O3, по сравнению с HO и HZO.
МЕТОДЫ ИССЛЕДОВАНИЙ И ФОРМИРУЕМЫЕ СТРУКТУРЫ
Поликристаллические пленки HZO (HfO2/ZrO2 1 : 1), HZAO (HZO/Al2O3 10 : 1) и HAO (HfO2/Al2O3 10 : 1) были сформированы методом PEALD в установке FlexAl (Oxford Instruments Plasma Technology, Великобритания) на кремниевых пластинах с естественным окислом и низким удельным сопротивлением (0.3–10 Ом ⋅ см) n- и p-типов при температуре 300°C. Полная толщина пленок 20 нм достигалась попеременным осаждением примерно 200 монослоев различных оксидов, в том числе суперциклами по 10 монослоев с толщиной слоя в суперцикле ~1 нм. Предварительно пластины Si с естественным окислом на поверхности толщиной ~2 нм насыщали азотом в плазме из удаленного ВЧ-источника плазмы в атмосфере N2 при мощности, вкладываемой в разряд, 400 Вт и температуре пластин 500°C в течение 5 мин в той же камере. Для осаждения оксида гафния использовали металлоорганический Hf‑прекурсор TEMAH (ООО ДАЛХИМ, Нижний Новгород), а для оксида алюминия – металлоорганический Al-прекурсор TMA. Плазму O2 применяли на шаге окисления (1–4 с) адсорбированного металлорганического монослоя до предельных оксидов Hf, Zr и Al при давлении в камере 15 мТорр и входной радиочастотной мощности в источнике плазмы 250 Вт. Высокотемпературные RTA термообработки пластин с PEALD пленками проводили при температурах 550–1000°C в атмосфере азота в течение 30 с на установке AS-One (Annealsys, Франция). Образцы кремния с PEALD пленками размером 15 × 15 мм отжигались изохронно на разных образцах (i-RTA) или ступенями на одном и том же образце (s-RTA) в указанном выше интервале температур.
Электрические свойства пленок в структуре металл-сегнетоэлектрик-полупроводник (MFS), нанесенных методом PEALD на кремний с ориентацией (001) n- и p-типа, были исследованы при температурах 25–300°C методами C–V и импульсных PUND (positive-up, negative-down) измерений на установке Keithley SC-4200 (Keithley, США). Верхний металлический контакт к сегнетоэлектрику площадью S = (3–8) ⋅ 10–6 см2 формировался InGa каплей диаметром 70–100 мкм с W иглой в центре, нанесенной на поверхность после RTA термообработок во избежание Redox реакций с электродом. В качестве нижнего контакта также применялась InGa паста. Измерения C–V были выполнены на мезаструктурах MFS на частотах 10 кГц–1 МГц c разверткой по напряжению V = ± 4 В, что соответствовало максимальному электрическому полю E = ±2 МВ/см. Метод PUND заключается в последовательной подаче импульсов напряжения от треугольных до близких к прямоугольным по форме и регистрации вызванных ими импульсов тока, тем самым позволяя отделить отклик тока при переключении поляризации образца от токового сигнала при ее непереключении [12]. Причем, для данного метода характерны нано- и микросекундные длительности сдвоенных положительных и отрицательных импульсов напряжения, что разделяет ответный импульс тока, связанный с переключением поляризации сегнетоэлектрической фазы, от туннелирования и захвата заряда в объеме изолятора и на поверхностных состояниях (IFS) вычитанием каждого второго импульса из первого. Это является прямым подтверждением, сегнетоэлектрических свойств структур. В эксперименте импульсы напряжения подавались на подложку с временными интервалами (таймингом) “длительность–задержка–фронт” от 5–5–1 до 50–50–10 мкс [14].
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Анализ C–V кривых, снятых при разных направлениях развертки напряжения от плюса к минусу (left) и наоборот (right), предложенный в [14], позволяет разделить природу зарядов в диэлектрическом слое: фиксированную Qf, захваченную интерфейсом Qi и мобильную Qm части в общем заряде MFS конденсатора. Емкости Cmin и Cmax были определены на основе высокочастотных C–V характеристик (HF CV). Cmax будет считаться равной диэлектрической емкости, которую можно рассчитать, зная ее параметры, как Cmax = ε0εS/d. Для образца HAO были взяты значения d = 20 нм, ε = 20. Тогда удельная емкость будет равна Ci = 8.85 нФ/м2. Зная параметры подложки, можно рассчитать потенциал φb области обеднения:
Концентрация дырок для образца с подложкой p-типа и удельным сопротивлением 10 Ом ⋅ см приблизительно соответствует значению Na = = 1.5 ⋅ 1015 см–3. Температурная зависимость его собственной концентрации в подложке не учитывалась. Предполагалось, что работы выхода InGa эвтектики и кремния p-типа равны 3.9 и 4.85 эВ, соответственно [15]. Тогда общий сдвиг напряжений плоских зон, исключая встроенный фиксированный заряд, будет равен:
Напряжение плоских зон для прямой (Vfbleft) и обратной (Vfbright) развертки определяется по экспериментальным кривым (рис. 1). Тогда эффективный заряд Qeff в оксиде равен:
Рис. 1.
Измерения гистерезиса C–V кривых на частоте 100 кГц в мезаструктуре MFS с изолятором HAO после RTA (650°C, 30 с) при развертке от –5.0 до +1.0 В и обратно при разных температурах, соответственно.

Рис. 2.
C–V гистерезис на частоте 100 кГц в MFS HZO мезаструктуре после RTA (650°C, 30 с) при развертке от +3.5 до –3.5 В и обратно при разных температурах, соответственно.

Таким образом, можно рассчитать эффективный заряд для прямой (Qeffleft) и обратной (Qeffright) развертки. Если предположить, что заряд в оксиде обусловлен наличием только фиксированных (Qf) и подвижных (Qm) зарядов, а Qeffleft = = Qf – Qm и Qeffright = Qf + Qm, то мы можем найти фиксированный и подвижный заряд:
Если подвижного заряда нет, а есть только поляризационный заряд Pr, то Qm = –Pr и коэрцитивное поле Ec = Qm/(Ci ⋅ d). Температурная зависимость всех зарядов показана на рис. 3. Полученное значение Qm = –Pr = 0.51 мкКл/см2 при комнатной температуре RT близко по величине значению, определенному для поляризации Pr = = 0.54 мкКл/см2 в НАО псевдо-MOSFET структуре ранее [14].
Рис. 3.
Фиксированные Qf и поляризационные Pr = Qm заряды в зависимости от температуры измерений по данным C–V на рис. 1, 2 и [13, 14] для меза структур MFS с изоляторами HZO, HZA и HAO после i- и s-RTA обработок при различных температурах, в то время как развертка начинается с “+V0” или “–V0” 3–5 В, соответственно.
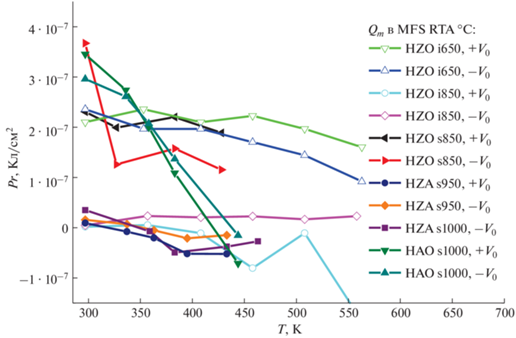
Гистерезис C–V характеристик в MFS HZO меза структурах на кремнии p-типа после s-RTA термообработки при температуре 650°С направлен против часовой стрелки (рис. 1). При такой температуре доля сегнетоэлектрической фазы в HZO пленке должна быть максимальной, а гистерезис должен быть либо по часовой стрелке с поляризацией Pr ≥ 10 мкКл ⋅ см–1, либо с зарядовой плотностью поверхностных состояний Dit ≥ ≥ 6.3 · 1013 см–2 ⋅ эВ–1 [6, 14]. Однако расчет Dit на границе HZO/Si из C–V кривых дает значительно меньшую величину Dit ~ 5 ⋅ 1011 см–2 ⋅ эВ–1. Ступенчатое увеличение теплового бюджета при отжигах s-RTA при температурах 800, 850, 900 и 950°С уменьшает содержание орторомбической фазы и не меняет наблюдаемое направление гистерезиса (рис. 2). Сигнал здесь оказался дифференцирован на паразитной RC-цепи между InGa эвтектикой и вольфрамом с разницей работ выхода электронов ΔWW–InGa = 0.55 эВ.
Противоположный (FE-подобный) сегнетоэлектрический гистерезис емкости (по часовой стрелке) наблюдался на C–V кривых при температурах выше 110°С (рис. 1) и ранее в псевдо-МОП транзисторных измерениях в MFS HAO меза структурах, отожженных вплоть до 950°C, т.е. на ~ 100°C выше, чем для HZAO структур [14]. C–V измерения на меза структурах НАО демонстрировали переход от туннелирования и захвата заряда ловушками на границе с кремнием к гистерезису, подобному сегнетоэлектрическому, при повышении температуры кремниевой подложки до 130–150°C (см. рис. 6 в [14]).
C–V гистерезис для дырок против часовой стрелки не является сегнетоэлектрическим и может происходить не только из-за захвата заряда из полупроводника на состояния вблизи гетерограницы с оксинитридом (IFS), но также из-за туннелирования носителей через SiOхNу в слой HZO, как в энергонезависимой памяти SONOS [16, 17]. Данные по Qm для MFS HZO структуры после RTA при 850°C косвенно подтверждают последний механизм (рис. 3). Действительно, заметная величина Om заряда инжектированных из InGa в HZO электронов при отрицательных смещениях и RT измерениях быстро падает с ростом температуры за счет сдвига уровня Ферми к середине запрещенной зоны. Напротив, при положительных смещениях величина отрицательного подвижного заряда Qm растет с ростом температуры измерений из-за ускорения прыжкового транспорта электронов по ловушкам в HZO. В действительности нужно учитывать, что внешнее поле в сегнетоэлектрике ослаблено поляризационным зарядом Pr и компенсирующим зарядом на межслойных ловушках [18]. Последний заряд обуславливает отрицательный знак поляризации (подвижного заряда Qm) для образцов HZO и HZA при повышенных температурах измерений (рис. 3). То, что HZO структуры обладают сегнетоэлектрическими свойствами после RTA, подтверждают проведенные методом PUND измерения (рис. 4). Величина Pr для MFS HZO меза структур после i-RTA 650°C составляла Pr ~ ~ 1.25 мкКл/см2, что меньше Qm, измеренного по C–V гистерезису несегнетоэлектрического типа на рис. 3.
Рис. 4.
Импульсы PUND напряжения с таймингом 5–5–1 мкс и тока в MFS HZO меза структурах после i-RTA обработок при разных температурах. На вставке: изменение Psw = Pr ⋅ S [мкКл], где S = 3.14 ⋅ 10–4 см2 – площадь электрода, с ростом температуры i-RTA обработок для разных таймингов PUND.

Возможной причиной расхождений является захват заряда из кремния на ловушки, как это показано недавно для диэлектрика Al2O3 [19]. Такой захват заряда в значительной степени компенсирует сегнетоэлектрическую поляризацию и уменьшает окно памяти вплоть до инверсии направления гистерезиса. Туннельная инжекция из кремния на ловушки в HZO на границе с SiOxNy не должна зависеть от температуры, что и наблюдается в эксперименте (рис. 3). Слабая зависимость величины Pr от температуры измерений после i-RTA при 650°С, после которой поляризация Pr максимальна, является косвенным подтверждением этому.
Резко отличное поведение заряда температурной зависимости Qm для HAO меза структур предполагает иной механизм транспорта заряда. Причиной может быть различие в фазовых структурах пленок HZO и HAO. Более высокая термостабильность поляризации Pr у пленок-ламинатов HAO и HZAO, чем у HZO слоев, обусловлена вставками монослоев оксида алюминия и разбиением объемов HfO2 или HfO2/ZrO2 слоев на наноламели [20]. Данные GIXRD подтверждают это предположение [14]. Спектры GIXRD демонстрируют преобладание кубической фазы в ламинированных монослоями Al2O3 пленках HAO и HZAO после RTA обработок. В то же время, наблюдение пика неполярной кубической фазы Fm3m при 30.9° с малоугловым плечом (см. рис. 3 в [14]), соответствующим положению (111) пика полярной орторомбической фазы Pca21 при 30.6°, может свидетельствовать в пользу нового пути фазового перехода в орторомбическую фазу из метастабильной, еще более высокотемпературной кубической. Наблюдавшаяся ранее нелинейная зависимость Ec от температуры измерений (здесь не приведена) свидетельствует и о других существенных вкладах в сегнетоподобный (FE-подобный) гистерезис [14]. Среди них следует рассмотреть поляризацию на границе раздела двух диэлектриков диоксида гафния-циркония HZO и оксинитрида кремния SiOхNy, межзеренную поляризацию из-за поликристаллической природы отожженных при высокой температуре сегнетоэлектрических слоев, а также образование дефектов (кислородных вакансий) у границ сегнетоэлектрика. Но анализ этих явлений выходит за рамки представленных в настоящей работе экспериментов.
ЗАКЛЮЧЕНИЕ
Таким образом, получены стабильные к RTA обработкам вплоть до температур 850 и 950°С MFS структуры с сегнетоэлектрическими (FE) слоями HZA и HAO, соответственно, пригодные для изготовления многофункциональных КМОП ИС: вычислительных систем со встроенной универсальной памятью, нейроморфных систем на кристалле SoC. Промежуточный отжиг FA (450°C, 1 ч) позволяет сохранять зародыши метастабильных FE фаз в ламинированных монослоями Al2O3 пленках HO и HZO, а также в диэлектриках структур КНИ. RTA обработки необходимы для роста зародышей метастабильных фаз и снижения плотности состояний IFS на гетерограницах в MFS структурах с HfO2:ZrO2 1 : 1, HfO :Al2O3 10 : 1 и HfO2:ZrO2:Al2O3 (1 : 1)10 : 1 при T > 650°C. Наибольшая поляризация Pr = 11.2 мкКл/см2 была получена для MFS HAO (HfO2:Al2O3) структур после ступенчатого отжига s-RTA при T = 850°C. Она снижалась более чем на порядок после дальнейшего увеличения температуры RTA T = = 1000°C до Pr = 0.51 мкКл/см2. Несмотря на низкую величину поляризации Pr в последнем случае, метод PUND уверенно разделял вклады поляризации от туннельной инжекции и захвата заряда на ловушках в MFS структурах.
Из температурной зависимости C–V характеристик показано, что на переключение поляризации в MFS структурах на основе слоев диоксидов гафния-циркония большое влияние оказывают, помимо туннельной инжекции из кремния или металла, захват зарядов в диэлектрик SiOxNy на границу с кремнием, а также на границу c сегнетоэлектриком HZO, что компенсирует сегнетоэлектрическую поляризацию и уменьшает окно памяти.
Работа выполнена в рамках тем государственного задания Министерства образования и науки РФ для ИФП СО РАН им. А.В. Ржанова (№ FWGW-2021-0003) и ФТИ РАН им. К.А. Валиева (№ FNN-2022-0019).