Известия РАН. Механика твердого тела, 2023, № 3, стр. 58-72
НОВЫЙ МЕТОД РЕЛАКСАЦИИ УПРУГИХ НАПРЯЖЕНИЙ ПРИ РОСТЕ ГЕТЕРОЭПИТАКСИАЛЬНЫХ ПЛЕНОК
А. А. Корякин a, С. А. Кукушкин b, *, А. В. Осипов a, Ш. Ш. Шарофидинов c, М. П. Щеглов c
a Санкт-Петербургский государственный университет
Санкт-Петербург, Россия
b Институт проблем машиноведения Российской академии наук
Санкт-Петербург, Россия
c Физико-технический институт им. А.Ф. Иоффе Российской академии наук
Санкт-Петербург, Россия
* E-mail: sergey.a.kukushkin@gmail.com
Поступила в редакцию 02.10.2022
После доработки 10.11.2022
Принята к публикации 11.11.2022
- EDN: FTEPIC
- DOI: 10.31857/S0572329922600785
Аннотация
В работе на примере роста нитрида алюминия (AlN) на кремнии (Si) ориентации (110) с буферным слоем карбида кремния (SiC) разработан метод выращивания нового типа подложек, позволяющий получать механически ненапряженные полупроводниковые гетероструктуры. Особенность синтеза данного рода подложек заключается в том, что используемые для роста пленок AlN слои SiC синтезированы методом согласованного замещения атомов. При использовании данного метода роста в подложке Si происходит замещение части атомов Si на атомы углерода. В результате замещения атомов первоначально гладкая поверхность Si(110) превращается в поверхность SiC, покрытую призмоподобными фигурами роста, одна из сторон которых является гранью (111), а другая гранью $(11\bar {1})$. Эти грани являются “подложками” для дальнейшего роста полуполярного AlN. Структура и морфология пленок AlN исследована методами рентгеновской дифракции, электронной микроскопии и методом рамановской спектроскопии. Обнаружено, что слой AlN образован сросшимися гексагональными микрокристаллами, рост которых происходит в двух направлениях, причем для обоих ориентаций кристаллов приближенно выполняется следующее соотношение: AlN$\left( {10\bar {1}3} \right)$ || Si(110). Показано, что полуширина рентгеновской кривой качания (FWHM) для дифракционного пика $\left( {10\bar {1}3} \right)$ от микрокристаллов AlN, усредненная по площади образца, составляет 20 угловых минут. Исследования методами рамановской спектроскопии и рентгеновской дифракции показали практически полное отсутствие механических напряжений в слое AlN. Построена теоретическая модель, объясняющая наличие двух ориентаций пленки AlN на SiC/Si(110), обнаруженных в эксперименте, и предложен метод управления их ориентацией. Показано, что данная морфология пленки AlN позволяет использовать ее в качестве буферного слоя для роста гетероструктур на основе нитрида галлия и нитрида алюминия.
1. Введение. Исследование механизмов роста эпитаксиальных пленок AlN является важной задачей с нескольких точек зрения. Во-первых, нитрид алюминия, обладающий вюрцитной структурой, является прямозонным полупроводником с большой шириной запрещенной зоны (6.2 эВ). Данное свойство AlN определяет перспективность его использования в качестве материала для изготовления оптоэлектронных приборов, работающих в ультрафиолетовом диапазоне. Во-вторых, тонкие слои AlN используются в качестве буферного слоя при росте GaN [1]. Использование AlN в качестве буферного слоя, например при росте слоев GaN на монокристаллах 6H-SiC, позволяет реализовать послойный рост этих пленок с большей вероятностью, чем островковый рост. Галлий в процессе осаждения на Si может химически с ним взаимодействовать. В результате качество слоя значительно снижается. Предварительно осажденные слои AlN на кремнии предотвращают этот процесс. Нитрид галлия лучше растет на подложке, покрытой слоем AlN, поскольку подложка, предварительно покрытая слоем AlN обладает лучшей адгезией для последующего роста GaN. В процессе роста пленок AlN или GaN на Si возникают большие упругие деформации, вызванные различием в параметрах решеток подложек III-нитридов и Si (более 20%), и различием их коэффициентов термических напряжений. Согласно данным, приведенным в [2] при температуре 950°C–1050°C коэффициент термического расширения гексагонального AlN вдоль a-оси 5.41 × 10–6 K–1, а коэффициент термического расширения Si равен 3.9 × 10–6 K–1. В результате при охлаждении пластины Si со слоем AlN от температуры роста до комнатной температуры, в слое AlN образуются трещины, что делает полупроводниковую пленку AlN не пригодной для дальнейшего использования. Поэтому одной из главных проблем над решением которой бьются исследователи, занимающиеся ростом AlN на Si является проблема создания технологии роста AlN, при которой бы полностью отсутствовали упругие деформации в растущем слое пленки. Однако, до сих пор эту задачу не удалось решить. Одним из возможных путей решения данной проблемы является создание промежуточного буферного слоя между Si и пленкой AlN. Как было показано в работах [3, 4] хорошим буферным слоем для роста AlN на Si является слой SiC. Кристаллы SiC обладают параметрами решетки близкими к параметрам решеток таких материалов, как GaN и AlN. Между SiC и Si разница в параметрах решеток достигает 19%, а коэффициент термического расширения кубического SiC равен 4.5 × 10–6 K–1 [2]. Таким образом, не удается полностью сформировать слой AlN на подложке Si даже со слоем SiC.
В последнее время разработаны различные способы, позволяющие нивелировать разницу в параметрах решеток пленки и подложки [5, 6]. Основная идея этих методов – внедрение пор в приповерхностный слой подложки. Действительно, с одной стороны, поры могут играть роль “демпфера” напряжений возникающих, из-за разницы в коэффициентах термических расширений пленки и подложки, поскольку уменьшается площадь контакта пленки с кристаллической поверхностью подложки. С другой стороны, поры являются интенсивным стоком материала пленки, поскольку, согласно термодинамике, энергетически выгодно зарождение новой фазы на разного рода дефектах. Делая ставку на подобные методы роста, исследователи, однако, сталкиваются со следующей проблемой. Для получения совершенных по структуре слоев необходимо с одной стороны, чтобы пленки были ориентированными, а с другой стороны не напряженными. При обычном способе роста очень сложно удовлетворить этим двум условиям. Ориентацию пленки задает кристаллическая структура подложки. Чем больше отличается кристаллическая структура и симметрия пленки от структуры и симметрии подложки, тем более напряженной и более дефектной вырастает пленка. Даже в том случае, если структуры пленки и подложки близки, но поверхность подложки неоднородна и содержит различного рода дефекты, царапины, ямки травления и т.п., качество растущего слоя пленки резко ухудшается. Поэтому внедрение пор в поверхностный слой подложки, несмотря на возможность релаксации механических напряжений, резко снижает ориентационные свойства поверхности подложки. Сложность получения упорядоченного слоя пленки заложена в самой природе фазового превращения первого рода, в результате которого получаются пленки. Процесс фазового превращения – случайный процесс. При гомогенном превращении одной фазы в другую по всему объему старой фазы возникают маленькие зародыши новой фазы. Каждый из них имеет свои размеры. Сливаясь друг с другом, они образуют поликристаллический материал. Именно для уменьшения случайности процесса зарождения при выращивании монокристаллов используют, так называемые затравки – маленькие, специальным образом приготовленные кристаллы, на которые осаждается материал материнской фазы. При росте гомогенных кристаллов, условия осаждения подбирают таким образом, чтобы материнская фаза осаждалась только на затравке, а в окружающем пространстве новая фаза не зарождалась. При гетероэпитаксиальном росте пленок на кристаллических подложках роль затравки играет подложка. Кристаллическая структура подложки отличается от структуры пленки. Площадь поверхности подложки, как правило, большая. Поскольку подложки обладают большой площадью поверхности, то процесс зарождения новой фазы, протекает также случайным образом. При наличии подложки зарождение происходит не во всем объеме старой фазы, а на поверхности подложки. Таким образом, поры, находящиеся на поверхности подложки только увеличивают случайность зарождения и часто ухудшают ориентацию слоев. Таким образом, создание пор в приповерхностных слоях подложки кардинально не решает проблемы получения совершенных по структуре слоев широкозонных полупроводников и, в частности, слоев AlN.
Отметим, что в отличие от искусственно созданных пор, при росте слоя SiC на Si методом разработанным в [3, 4] между слоем SiC и подложкой Si образуются поры сразу в процессе роста пленки SiC и они полностью покрыты слоем SiC, поэтому они не оказывают негативного влияния на структуру SiC. Благодаря наличию пор под слоем SiC, подложка Si со слоем SiC является податливой, эластичной системой, легко подстраивающейся под кристаллические решетки чужеродных материалов. Более того, поскольку слой SiC лежит над поверхностью пор, то часть границы поверхности пленки SiC “не закреплено” механически с подложкой и находится в свободном состоянии. На практике можно вырастить слои SiC, 90% площади которых, будут механически “не закреплены” с подложкой. Это приведет к тому, что в формулах расчета упругих термических деформаций необходимо вместо табличных значений коэффициентов линейного термического расширения ставить их модифицированные значения с учетом площади контакта пленки SiC с подложкой Si. Этот вопрос подробно обсуждался в обзоре [7]. Однако, это не приводит к полной релаксации термических напряжений. Для решения этой проблемы может быть применен следующий подход. Поскольку AlN является гексагональным кристаллом с пространственной группой симметрии P63mc, а пленки SiC, выращенные на Si – кубические (3C–SiC), то рост эпитаксиальных слоев AlN необходимо осуществлять на плоскости SiC(111), иначе будет образовываться поликристаллическая структура. При этом, однако, будут расти полярные пленки AlN, гексагональная c-ось которых будет направлена перпендикулярно плоскости структуры SiC/Si(111), т.е. параллельно плоскости SiC(111) будет формироваться плоскость AlN (0001), и никакой релаксации термических напряжений получить для такой структуры невозможно. Однако, если сформировать кристаллы AlN, c-ось которых наклонена по отношению к плоскости положки SiC/Si(111) таким образом, чтобы практически из одной точки поверхности подложки росла пара кристаллов AlN, имеющая противоположный к друг к другу наклон, то в этом случае упругие напряжения будут в основном концентрироваться в области “соединения” пленки с подложкой, и они должны быть незначительны, поскольку кристаллы AlN направлены под углом к подложке и, лишь, незначительно в некоторых “точках” соприкасаются с подложкой. Если, теперь на поверхности этих наклонных кристаллов вырастить, например, слой GaN, который расположен параллельно подложке SiC/Si, подобно мосту на наклонных сваях, то данная конструкция позволит значительно снизить упругие напряжения в слое GaN. В этом случае слой GaN, может служить хорошей основой для создания различного рода приборных структур на Si.
Синтез кристаллов AlN эпитаксиального качества, c-ось которых наклонена по отношению к нормали к подложке, важен также по следующей причине. Хорошо известно, что большинство исследований эпитаксиального роста пленок III-нитридов посвящено изучению роста полярных слоев [8], т.е. росту таких слоев у которых полярная, гексагональная c-ось направлена перпендикулярно плоскости подложки. В этом случае, как известно, возникает пьезоэлектрический эффект Штарка [9]. Этот эффект приводит к возникновению зарядов на поверхностях AlN и GaN и их спонтанной поляризации, что не позволяет в полной мере реализовать все потенциальные возможности этих материалов. В связи с этим перспективным направлением исследований представляется создание оптоэлектронных приборов на основе полуполярных слоев III-нитридов. Было установлено [9], что интенсивность эффектов поляризации сильно зависит от кристаллографической ориентации пленки и может быть существенно уменьшена путем синтеза неполярных и полуполярных слоев III-нитридов. Работ, посвященных исследованию начальных стадий роста полуполярных слоев AlN немного, поскольку технология синтеза полуполярных слоев AlN трудоемка. Для роста полуполярных слоев необходимо специальным образом подготовить подложку, чтобы на ее поверхности могли расти полуполярные слои AlN эпитаксиального качества. Подробно описание технологии подготовки подложек к росту полуполярных пленок AlN и GaN, можно найти в обзоре [10]. Полуполярные слои AlN были получены с использованием методов МОС-гидридной эпитаксии (MOCVD) [11–13], хлорид-гидридной газофазной эпитаксии (HVPE) [6, 7, 14], молекулярно-пучковой эпитаксии с плазменной активацией азота (PA MBE) [15] и импульсного лазерного напыления [16]. Рост полуполярного AlN был продемонстрирован на подложках Al2O3($10\bar {1}0$) [12, 13, 15, 17], темплейтах SiC/Si(100) [11, 18] и ZnO($1\bar {1}02$) [16]. В работах [7, 14] и обзоре [14] для роста полуполярных слоев AlN и GaN использовалась гибридная подложка, состоящая из эпитаксиального слоя 3C–SiC, синтезированного на вицинальной поверхности Si, отклоненной от сингулярной плоскости Si(100) на 4–7°. Синтез эпитаксиального слоя 3C–SiC осуществлялся методом согласованного замещения атомов. Данный метод осуществляется при помощи химической обработки поверхности Si в атмосфере газа CO. Подробное описание метода можно найти в обзорах [3, 19].
Рассмотрим преимущества использования гибридных подложек SiC/Si, выращенных методом согласованного замещения атомов для роста полуполярных слоев AlN. Обычно, для роста полуполярных слоев на подложках различного типа при помощи специальных методов травления необходимо сформировать клинообразные фасетки определенной ориентации, на которых могли бы зарождаться кристаллы AlN полуполярной ориентации. Выше было отмечено, что подготовка подложки для роста полуполярных слоев III-нитридов является сложной и дорогостоящей операцией, особенно это относится к подготовке подложек из сапфира и монокристаллического SiC. При использовании метода согласованного замещения атомов [10, 19] формирование продольного клинообразного выступа SiC происходит естественным образом. Для формирования поверхности Si со слоем SiC, полученным методом замещения атомов не используются маскирующие поверхность подложки и химические травящие вещества. В процессе синтеза SiC вицинальные ступени на плоскости Si (100) превращаются в массив параллельных ступеней SiC, представляющих собой треугольные призмы (боковые грани пирамидок), ограненные плоскостями (111) [10]. Поскольку симметрия подобных призм характерна как для кубических кристаллов, так и гексагональных кристаллов, то на их поверхностях могут расти кристаллы как с кубической симметрией, так и с гексагональной. И зависеть это будет не от ориентации подложки, что весьма важно, а только от условий роста. Это открывает совершенно новые перспективы для выращивания гексагональных полуполярных кристаллов.
Согласно теоретическим выводам, описанным в работах [10, 20] поверхность Si(110) трансформируется в поверхность SiC, покрытую призмоподобными фигурами роста, одна из сторон которых является гранью (111), а другая гранью ($11\bar {1}$). Эти фигуры роста сливаются друг с другом, образуют подобие протяженных “горных хребтов”. Остальные плоскости семейства плоскостей (111) перпендикулярны плоскостям (110). Плоскость, расположенная между “горными хребтами”, является гранью (110). Поскольку призмоподобные фигуры покрыты гранью (111) и гранью ($11\bar {1}$), то зарождение AlN должно происходить на обеих этих гранях. В результате на поверхности подложки SiC/Si(110) будут расти развернутые относительно друг друга кристаллы AlN. Зарождение AlN на части призматической поверхности SiC(110) будет происходить с меньшей вероятностью и, только при больших значениях пересыщенный. В данной работе, будут экспериментально обоснованы сформулированные выше предположения о механизме роста слоя AlN на гибридных подложках SiC/Si(110), а также будет проведен количественный анализ начальных стадий зарождения AlN на поверхности подложки SiC/Si(110) при росте полуполярных слоев AlN методом HVPE и сделаны выводы по управлению их ростом. Подобное рассмотрение позволит решить две упомянутые выше проблемы, а именно: создать новый тип подложки для роста ненапряженных слоев обычной (полярной) ориентации и создать слой AlN полуполярной ориентации для дальнейшего его использования в приборных структурах.
2. Методика эксперимента. Буферный слой был сформирован методом согласованного замещения атомов [10, 19] в атмосфере CO и SiH4 на подложках Si(110) p-типа c удельным сопротивлением 50 Ом ∙ см. В процессе синтеза SiC происходит химическая реакция между Si и CO
Синтез SiC проводился при температуре 1250°C в течение 15 минут. Расход газов CO и SiH4 составил 12 × 10–3 л/мин и 0.25 × 10–3 л/мин, соответственно, при давлении CO 2 торр. Перед синтезом кремниевые подложки очищались от оксидов и проходили пассивацию атомами водорода по методике, развитой в работе [21]. После формирования слоя SiC на поверхности подложек Si(110) осуществлялся рост слоя AlN методом HVPE. Формирование AlN при HVPE происходит в результате химической реакции (2.2), протекающей в зоне роста [10]
Рост осуществлялся при температуре 1080°C. Время роста составило 5 минут при потоке NH3 1 л/мин, потоке HCl – 0.3 л/мин, который проходил над лодочкой с жидким алюминием и потоке газа-носителя Ar 4 л/мин. Перед ростом слоя AlN подложка SiC/Si(110) выдерживалась в потоке HCl в течение 3 минут при потоке 0.1 л/мин для очистки от загрязнений.
3. Результаты. На рис. 1 представлены типичные РЭМ (растровая электронная микроскопия) изображения поверхности и торцевого скола подложки SiC/Si(110). Видно, что поверхность SiC состоит из протяженных призмоподобных “холмиков” со средним латеральным размером 100 нм и высотой 20 нм. Под слоем SiC толщиной ∼70 нм в результате топохимической реакции сформированы поры. Внутренняя поверхность пор покрыта слоем SiC. На рис. 2 приведена электронограмма, полученная от поверхностного слоя пленки SiC электронографом ЭМР-100 с энергией электронов 50 кэВ. При такой энергии электронов глубина их проникновения в образец не превышает ~100 нм, поэтому данная картина дифракции соответствует только верхнему слою эпитаксиального SiC. Картины, соответствующие поликристаллической или аморфной структуре, полностью отсутствуют. Таким образом, в результате замещения атомов на поверхности Si формируется монокристаллическая пленка карбида кремния политипа 3С-SiC.
Слой AlN исследовался методами электронной микроскопии и рентгеновской дифрактометрии (XRD). На основе данных исследований можно сделать следующие выводы о структуре слоя AlN. РЭМ-изображения пленки AlN на SiC/Si(110) (рис. 3) показывают, что слой AlN представляет собой сросшиеся гексагональные кристаллы высотой ~12 мкм.
Данные рентгеноструктурного анализа, проведенного в режиме θ–2θ, показали наличие двух симметрично расположенных пиков, соответствующих плоскостям AlN{$10\bar {1}3\} $. Обнаружено, что выстраивание гексагональных кристаллов AlN на подложке SiC/Si(110) происходит за счет поворота c-оси на ~30° относительно нормали к подложке. При этом количество гексагональных кристаллов, развернутых в одну сторону в два раза больше, чем в другую (по интенсивностям пиков отражения). Для отражающих плоскостей AlN{$10\bar {1}3\} $ разнонаправленных гексагональных кристаллов отмечена разориентация относительно друг друга на 7° в направлении поворота кристаллов AlN и не более 0.5° в перпендикулярном направлении. Полуширина рентгеновских кривых качания (FWHM) для рефлекса AlN($10\bar {1}3$), усредненная по площади образца, составляет 20 и 30 угловых минут для гексагональных кристаллов повернутых в разные стороны. Рентгеновский рефлекс AlN($10\bar {1}3$) от структуры AlN/SiC/Si(110) также анализировался методом трехкристальной рентгеновской дифрактометрии (рис. 4, a). Из картины контуров равной интенсивности по характеру асимметрии можно заключить, что в слое AlN присутствуют остаточные напряжения. Величина остаточных деформаций в слое AlN определялась на основе измерения положения рентгеновских пиков AlN(0002) (θ = 18°00'52'') и AlN($10\bar {1}3$) (θ = 33°01'45'') от одного из семейств разнонаправленных кристаллов (рис. 4, b). Были найдены следующие значения параметров кристаллической решетки AlN: c = 0.49815 нм и a = 0.31078 нм. Это означает, что решетка AlN сжата вдоль направления c-оси и a-оси, причем деформация составляет ‒1 × 10–4 и –1.3 × 10–3 соответственно. Параметры кристаллической решетки недеформированного кристалла AlN были определены на основе справочных данных [22].
Рис. 4.
(а) Карта распределения контуров равной интенсивности для симметричного рефлекса AlN($10\bar {1}3$). Полуширина кривой качания для данного рефлекса равна 21 угловой секунде. 2θ и ω в угловых секундах. (b) Относительная интенсивность рентгеновских пиков AlN(0002) и AlN($10\bar {1}3$), полученных для одного из двух семейств разнонаправленных гексагональных кристаллов AlN в режиме сканирования θ–2θ. Интенсивность в относительных единицах, 2θ в угловых секундах. Схематический рисунок на вставке показывает ориентацию осей гексагональных кристаллов: n1n2∼60°.
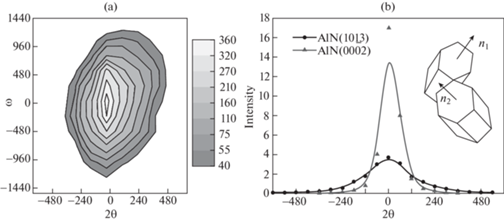
На рис. 5 представлены результаты исследования структуры AlN/SiC/Si(110) методом рамановского рассеяния. Исследования были выполнены с использованием микрорамановского микроскопа Witec Alpha 300R с латеральным разрешением при сканировании ∼0.5 мкм. Было обнаружено, что пик E1(TO) четко отделен от основного пика E2(high), что свидетельствует о высоком кристаллическом совершенстве отдельных кристаллитов, составляющих пленку.
Рис. 5.
Типичный спектр рамановского рассеяния для структуры AlN/SiC/Si(110). Интенсивность в относительных единицах, Raman shift, выражен в волновых числах с размерностью в см–1.

Таким образом, проведенные нами эксперименты указывают на то, что, как и предполагалось, поверхность SiC/Si(110) состоит из призмоподобных “холмиков” ограненных гранями (111) и ($11\bar {1}$). Наименьшее рассогласование решеток между AlN и SiC, которое, как хорошо известно, приблизительно составляет 1% выполняется для граней AlN(0001) и грани 3C-SiC{111}. Естественно, поэтому предположить, что зарождение и рост островков AlN будет, в основном, происходить на гранях SiC(111) и SiC($11\bar {1}$). Именно в этом случае, рассогласование решеток между кристаллами будет минимальным. Отметим, что если зародыш AlN образуется вблизи линии пересечения грани (111) или ($11\bar {1}$) с другой низкоиндексной гранью, например (110), то первый монослой островка формируется также когерентно с данной гранью. Таким образом, на поверхности подложки можно выделить следующие возможные места зарождения островка AlN: на грани (111), на грани ($11\bar {1}$), а также в углу, образованном гранью (111) или ($11\bar {1}$) и другими низкоиндексными гранями.
Рассмотрим зарождение островка AlN в форме призмы с боковыми гранями {$1\bar {1}00$} на гранях SiC(111) и SiC($11\bar {1}$). Данная форма кристаллов III-нитридов является равновесной [23], причем наличие контакта с поверхностью SiC приводит к изменению высоты кристалла равновесной формы [24]. Атомарная модель островков с двумя возможными вариантами сопряжения решеток AlN и SiC, соответствующими минимальной энергии границы раздела кристаллов с идеальной структурой, приведена на рис. 6. Как было показано в [25], наличие примесных атомов замещения в решетке AlN или в решетке SiC на границе раздела может дополнительно уменьшить ее энергию (например, замещение части атомов Si атомами Al или части атомов C на атомы N). На рис. 6 также изображены идеальные поверхности AlN(0001) и AlN($000\bar {1}$) для двух островков, ограниченные атомами Al и N соответственно. Таким образом, кристаллографическая ориентация островков относительно подложки задается следующими соотношениями: AlN[0001]||SiC[111] и AlN[$\bar {1}210$]||SiC[$\bar {1}10$]. Теоретически рассчитанный угол между плоскостями кристаллов AlN(0001) и AlN($000\bar {1}$) и плоскостью SiC(110) равен 35.3°. Угол между плоскостью AlN{$10\bar {1}3\} $ гексагональных кристаллов и плоскостью AlN(0001)/($000\bar {1}$) составляет 31.6°. В результате находим, что плоскости AlN{$10\bar {1}3\} $ отклоняются от плоскости SiC(110) на 3.7°. Это согласуется с экспериментальными данными по измерению угла между плоскостями AlN{$10\bar {1}3\} $ кристаллов, растущих в двух направлениях (7°).
Рис. 6.
Модель зарождения AlN на SiC. Показаны два зародыша AlN, растущие в направлении [0001] и [$000\bar {1}$], также отмечены соответствующие им кристаллографические направления (вверху слева и справа).

Как известно [26], интенсивность нуклеации зародышей определяется Больцмановским распределением $I\sim {\text{exp}}( - {{\Delta }}G{\text{*/}}(kT))$, где ΔG* – энергия Гиббса образования зародыша новой фазы критического размера. Таким образом, для прогнозирования вероятности зарождения зародыша той или иной формы на гранях SiC(111) и SiC($11\bar {1}$), прежде всего, необходимо определить энергию Гиббса образования зародыша AlN. Энергия Гиббса образования трехмерного островка AlN определяется по формуле:
(3.1)
${{\Delta }}G(m,n) = - 3{{m}^{2}}n{{\Delta \mu }} + {{3}^{{3/2}}}{\text{/}}2{{m}^{2}}{{a}^{2}}{{\Delta \gamma }} + 3mnac{{{{\gamma }}}_{s}}$(3.2)
${{\Delta }}G{\text{*}} = \frac{{{{3}^{{3/2}}}{{a}^{4}}{{c}^{2}}{{\gamma }}_{s}^{2}{{\Delta \gamma }}}}{{2{{\Delta }}{{{{\mu }}}^{2}}}}$Из формулы (3.2) следует, что режим роста пленки зависит от значения разницы поверхностных энергий ${{\Delta \gamma }}$, в которую входят только энергии ${{{{\gamma }}}_{{{\text{AlN}}}}}$, ${{{{\gamma }}}_{i}}$ и ${{{{\gamma }}}_{{{\text{SiC}}}}}$ (энергия боковых граней островка ${{{{\gamma }}}_{s}}$ не входит) [24]. Если ${{\Delta \gamma }}$ > 0 трехмерный рост пленки энергетически выгоден, если ${{\Delta \gamma }}$ < 0, то формируется двумерный слой, т.к. пленка будет смачивать подложку. Приведем также выражения для энергии Гиббса и барьера нуклеации при двумерном зарождении островка AlN:
(3.3)
${{\Delta }}G(m) = - 3{{m}^{2}}{{\Delta \mu }} + {{3}^{{3/2}}}{\text{/}}2{{m}^{2}}{{a}^{2}}{{\Delta \gamma }} + 3mac{{{{\gamma }}}_{s}}$(3.4)
${{\Delta }}G{\text{*}} = \frac{{3{\text{/}}4~{{a}^{2}}{{c}^{2}}{{\gamma }}_{s}^{2}}}{{{{\Delta \mu }} - {{3}^{{1/2}}}{{a}^{2}}{{\Delta \gamma /}}2}}$В формулах (3.3) и (3.4) было использовано приближенное значение межфазной энергии на единицу длины периметра
островка, равное ${{{{\gamma }}}_{s}}$c/2. Приравнивая формулы (3.2) и (3.4) для барьеров нуклеации при трехмерном и двумерном зарождении находим, что барьеры
нуклеации равны, если ${{\Delta \mu }}$ = 31/2a2 при условии, что ${{\Delta \gamma }}$ > 0 [24].
при условии, что ${{\Delta \gamma }}$ > 0 [24].
Пренебрегая разностью в скоростях роста зародышей, отношение вероятностей зарождения трехмерных зародышей AlN на гранях (111) и ($11\bar {1}$) равно:
(3.5)
$\frac{{{{P}_{{(111)}}}}}{{{{P}_{{(11\bar {1})}}}}} \approx \frac{{\exp ( - {{\Delta }}G_{{(111)}}^{*}{\text{/}}\left( {{{k}_{B}}T} \right)~)}}{{\exp ( - {{\Delta }}G_{{(11\bar {1})}}^{*}{\text{/}}\left( {{{k}_{B}}T} \right)~)}} = \exp \left( { - \frac{{{{3}^{{3/2}}}{{a}^{4}}{{c}^{2}}{{\gamma }}_{s}^{2}({{\Delta }}{{{{\gamma }}}_{{(111)}}} - {{\Delta }}{{{{\gamma }}}_{{(11\bar {1})}}})}}{{2{{\Delta }}{{{{\mu }}}^{2}}{{k}_{B}}T}}} \right)$Определение поверхностных энергий границ раздела AlN/SiC является сложной задачей. Как правило, расчеты этих значений осуществляются с использованием методами теории функционала плотности (DFT). Следует, однако, учитывать, что эти значения являются приближенными. В работах [25, 27] методом DFT были рассчитаны значения поверхностных энергий полярных граней AlN(0001) и AlN($000\bar {1}$), а также энергия границы раздела AlN/SiC(111) и AlN/SiC($\bar {1}\bar {1}\bar {1}$) (эквивалентной AlN/SiC($11\bar {1}$)). Эти значения были получены как функции разности ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}}$ (в эВ), где μAl – химический потенциал алюминия μAl на поверхности AlN, а ${{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}}$ – химический потенциал чистого Al в объемном кристалле. Причем значения разности ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}}$ принадлежат интервалу от EAlN до 0, где EAlN = –2.8 эВ – энтальпия формирования AlN (на пару атомов). Таким образом в [25, 27], вычисляется разность между химическим потенциалом атомов верхнего слоя алюминия на поверхности AlN и чистым кристаллическим алюминием, т.е. за начало отсчета принимается химический потенциал чистого алюминия. Поверхностные энергии идеальных поверхностей SiC(111) (ограниченной атомами Si) и SiC($\bar {1}\bar {1}\bar {1}$) (ограниченной атомами C) были вычислены методом DFT в работе [28]: 2.856 Дж/м2 и 3.065 Дж/м2 для нерелаксированных поверхностей и 1.830 Дж/м2 и 2.720 Дж/м2 для релаксированных поверхностей. Значения поверхностных энергий SiC(111) и SiC($\bar {1}\bar {1}\bar {1}$) вычислены при условии избытка атомов Si и C на поверхностях. На основании этих данных нами были рассчитаны значения величин Δγ, которые определяют механизм зарождения островков AlN на SiC. Эти данные приведены на рис. 7, как функции разности величин химических потенциалов ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}}$.
Рис. 7.
Зависимости разности поверхностных энергий ${{\Delta \gamma }}$ от химического потенциала алюминия при росте AlN на SiC(111) и SiC($11\bar {1}$). Показан результат расчета ${{\Delta \gamma }}$ с использованием значений поверхностных энергий SiC(111) и SiC($\bar {1}\bar {1}\bar {1}$), соответствующих релаксированным поверхностям (сплошные линии) и нерелаксированным поверхностям (пунктирные линии). Также показаны зависимости поверхностных энергий AlN и энергий границы раздела AlN/SiC (для идеальной границы раздела и при замещении в ячейке 2 × 2 границы раздела одного атома Si на атом Al (AlSi(2 × 2)) [25, 27]. Графики зависимости энергии границы раздела AlN/SiC($11\bar {1}$)(SiAl(2 × 2)) и энергии границы раздела AlN/SiC(111) (AlSi(2 × 2)) неразличимы в выбранном масштабе. Значения поверхностных энергий в эВ/Å2 (ось слева) и в Дж/м2 (ось справа), разность химических потенциалов в эВ.
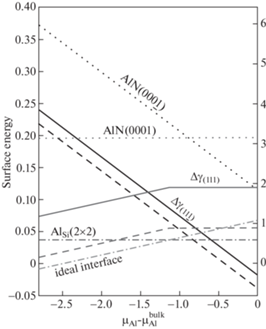
График на рис. 7 позволяет определить условия, при которых островки AlN будут зарождаться на гранях
SiC (111) и ($11\bar {1}$) либо с одинаковой скоростью, либо их скорости нуклеации будут иметь различные значения.
Например условие ${{\Delta }}{{{{\gamma }}}_{{\left( {111} \right)}}}$ =  будет выполнено, если ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}} < $ –1.4 эВ (или ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}} < $ –1 эВ для нерелаксированной поверхности SiC). Таким образом, скорости зарождения
трехмерных островков AlN на гранях SiC(111) и SiC($11\bar {1}$) будут равны друг другу, если в процессе роста AlN значения химического потенциала
${{{{\mu }}}_{{Al}}}$ на поверхности AlN сравнимо с химическим потенциалом μN на поверхности AlN, выполняется условие ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}} \approx {{{{\mu }}}_{{\text{N}}}} - {{\mu }}_{{\text{N}}}^{{{\text{bulk}}}}$. Из графиков рис. 7 также следует, что если на поверхности SiC/Si (110) в процессе роста AlN создать
избыток Al, то значение величины ${{\Delta }}{{{{\gamma }}}_{{\left( {11\bar {1}} \right)}}}$ может стать отрицательным т.е. ${{\Delta }}{{{{\gamma }}}_{{\left( {11\bar {1}} \right)}}}$ < 0. При таком значении величины ${{\Delta }}{{{{\gamma }}}_{{\left( {11\bar {1}} \right)}}}$, как следует из уравнений (3.2) и (3.4) энергетически выгодным становится двумерный
рост слоя AlN.
будет выполнено, если ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}} < $ –1.4 эВ (или ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}} < $ –1 эВ для нерелаксированной поверхности SiC). Таким образом, скорости зарождения
трехмерных островков AlN на гранях SiC(111) и SiC($11\bar {1}$) будут равны друг другу, если в процессе роста AlN значения химического потенциала
${{{{\mu }}}_{{Al}}}$ на поверхности AlN сравнимо с химическим потенциалом μN на поверхности AlN, выполняется условие ${{{{\mu }}}_{{{\text{Al}}}}} - {{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}} \approx {{{{\mu }}}_{{\text{N}}}} - {{\mu }}_{{\text{N}}}^{{{\text{bulk}}}}$. Из графиков рис. 7 также следует, что если на поверхности SiC/Si (110) в процессе роста AlN создать
избыток Al, то значение величины ${{\Delta }}{{{{\gamma }}}_{{\left( {11\bar {1}} \right)}}}$ может стать отрицательным т.е. ${{\Delta }}{{{{\gamma }}}_{{\left( {11\bar {1}} \right)}}}$ < 0. При таком значении величины ${{\Delta }}{{{{\gamma }}}_{{\left( {11\bar {1}} \right)}}}$, как следует из уравнений (3.2) и (3.4) энергетически выгодным становится двумерный
рост слоя AlN.
4. Обсуждение. Важно отметить, что данный анализ проведен без учета влияния примесных адсорбированных частиц на поверхностях SiC и AlN. Если, например, рост AlN осуществляется в атмосфере H2, являющимся газом-носителем вместо Ar, то в этом случае на поверхности может быть создан избыток H. Наличие избытка водорода меняет значение поверхностных энергий граней SiC(111) и SiC($11\bar {1}$), так что их разница становится малой [29]. При наличии адсорбированного водорода поверхностная энергия граней AlN также меняется и, согласно расчетам [27], поверхностная энергия AlN($000\bar {1}$) становится меньше поверхностной энергии грани AlN(0001) во всем интервале значений химического потенциала алюминия (азота). Следовательно, в данном случае скорость роста AlN на поверхности SiC($11\bar {1}$) будет выше, чем на поверхности SiC(111). Из проведенного выше анализа (без учета реконструкций поверхностей с H) следует, что в наблюдаемом экспериментально росте AlN на SiC/Si(110) на поверхности SiC(111) и SiC($11\bar {1}$) приближенно выполняется условие μAl – ${{\mu }}_{{{\text{Al}}}}^{{{\text{bulk}}}} \approx {{{{\mu }}}_{{\text{N}}}} - {{\mu }}_{{\text{N}}}^{{{\text{bulk}}}}$, так как количества гексагональных кристаллов, повернутых в одну и в другую стороны, отличаются только в два раза (т.е. являются сравнимыми величинами). Нужно отметить, что на данное отношение также влияет площадь поверхности граней SiC(111) и SiC($11\bar {1}$) перед ростом пленки AlN. Без учета реконструкции поверхности находим, что из-за большей энергии граней SiC($11\bar {1}$) [28, 29] их площадь должна быть меньше. Однако, с учетом реконструкции поверхности с H, расчеты показывают [29], что поверхностные энергии данных граней имеют близкие значения и, следовательно, их площади также должны быть близкими по величине. Таким образом, замена газа-носителя Ar на H2 может привести к изменениям в механизме роста полуполярных слоев AlN на гибридной подложке SiC/Si(110) и, в частности, к изменению химической реакции образования AlN [10]. Более того, в присутствии примесных атомов на поверхностях SiC и AlN, может стать энергетически выгодным зарождение кристаллов AlN одной полярности. Таким образом, построенная модель показывает, что изменение отношения потоков компонентов V/III в газовой фазе приводит к изменению данного отношения на поверхности SiC. Путем изменения отношения V/III на подложке можно изменять относительное число гексагональных кристаллов, растущих в различных направлениях.
5. Заключение. В работе исследована структура и морфологическое строение поверхности эпитаксиального слоя SiC, выращенного методом согласованного замещения атомов на поверхности подложки Si(110). Показано, что гибридные подложки SiC/Si(110) могут служить темплейтом для роста методом HVPE механически ненапряженных слоев AlN ориентации ($10\bar {1}3$). На основе исследования структуры и морфологии слоя AlN, выращенного методом HVPE, предложена кристаллографическая модель, объясняющая наличие двух ориентаций пленки AlN на SiC/Si(110), обнаруженных в эксперименте. Показано, что путем изменения отношения V/III в газовой фазе можно изменять отношение числа кристаллов, растущих в двух данных направлениях. В рамках этой модели объяснено экспериментально установленное соотношение между ориентациями кристаллических решеток AlN и SiC. Полученные структуры AlN/SiC/Si(110) могут использоваться как материал для микроэлектроники, в частности, как темплейты для дальнейшего роста таких соединений как AlGaN и GaN.
Финансирование работы. А.А. Корякин и А.В. Осипов выполняли свою часть работы при поддержке гранта СПбГУ № 75746688 (теоретическое исследование, исследования методами растровой электронной микроскопии). С.А. Кукушкин выполнял свою часть работы при поддержке Министерства науки и высшего образования Российской Федерации в рамках государственного задания по контракту № FFNF-2021-0001 (рост наноструктур, исследования методами рентгеновской дифракции и рамановской спектроскопии). Исследования проводились с использованием оборудования УНУ “Физика, химия и механика кристаллов тонких пленок” ИПМаш РАН, Санкт-Петербург.
Список литературы
Kukushkin S.A., Osipov A.V., Bessolov V.N., Medvedev B.K., Nevolin V.K., Tcarik K.A. Substrates for epitaxy of gallium nitride: new materials and techniques // Rev. Adv. Mater. Sci. 2008. V. 17. P. 1–32.
Barghout K., Chaudhuri J. Calculation of residual thermal stress in GaN epitaxial layers grown on technologically important substrates // J. Mater. Sci. 2004. V. 39. P. 5817–5823. https://doi.org/10.1023/B:JMSC.0000040094.33095.6f
Kukushkin S.A., Osipov A.V. Theory and practice of SiC growth on Si and its applications to wide-gap semiconductor films // J. Phys. D: Appl. Phys. 2014. V. 47. P. 313001. https://doi.org/10.1088/0022-3727/47/31/313001
Кукушкин С.А., Осипов А.В., Феоктистов Н.А. Синтез эпитаксиальных пленок карбида кремния методом замещения атомов в кристаллической решетке кремния // ФТТ. 2014. Т. 56. С. 1457–1498. https://doi.org/10.1134/S1063783414080137
Zytkiewicz Z. Laterally overgrown structures as substrates for lattice mismatched epitaxy // Thin Solid Films. 2002. V. 412. P. 64–75. https://doi.org/10.1016/S0040-6090(02)00315-2
Bessolov V.N., Karpov D.V., Konenkova E.V., Lipovskii A.A., Osipov A.V., Redkov A.V., Soshnikov I.P., Kukushkin S.A. Pendeo-epitaxy of stress-free AlN layer on a profiled SiC/Si substrate // Thin Solid Films. 2016. V. 606. P. 74–79. https://doi.org/10.1016/j.tsf.2016.03.034
Кукушкин С.А. Эпитаксиальный карбид кремния на кремнии. Метод согласованного замещения атомов (Обзор) // Журнал общей химии. 2022. Т. 92. https://doi.org/10.31857/S0044460X22040023
Masui H., Nakamura S., DenBaars S.P., Mishra U.K. Nonpolar and Semipolar III-Nitride Light-Emitting Diodes: Achievements and Challenges // IEEE Trans. Electron. Devices. 2010. V. 57. P. 88–100. https://doi.org/10.1109/TED.2009.2033773
Takeuchi T., Amano H., Akasaki I. Theoretical Study of Orientation Dependence of Piezoelectric Effects in Wurtzite Strained GaInN/GaN Heterostructures and Quantum Wells // Jpn. J. Appl. Phys. 2000. V. 39. P. 413–416. https://doi.org/10.1143/JJAP.39.413
Bessolov V.N., Konenkova E.V., Kukushkin S.A., Osipov A.V., Rodin S.N. Semipolar gallium nitride on silicon: technology and properties // Rev. Adv. Mater. Sci. 2014. V. 38. P. 75–93.
Abe Y., Komiyama J., Isshiki T., Suzuki S., Yoshida A., Ohishi H., Nakanishi H. Semipolar Nitrides Grown on Si(001) Offcut Substrates with 3C-SiC Buffer Layers // Mater. Sci. Forum. 2008. V. 600–603. P. 1281–1284. https://doi.org/10.4028/www.scientific.net/MSF.600-603.1281
Jo M., Hirayama H. Effects of Ga Supply on the Growth of (11-22) AlN on m-Plane (10-10) Sapphire Substrates // PSS (b). 2018. V. 255. P. 1700418. https://doi.org/10.1002/pssb.201700418
Shen X.-Q., Kojima K., Okumura H. Single-phase high-quality semipolar (10–13) AlN epilayers on m-plane (10–10) sapphire substrates // Appl. Phys. Express. 2020. V. 13. P. 035502. https://doi.org/10.35848/1882-0786/ab7486
Bessolov V., Kalmykov A., Konenkova E., Kukushkin S., Myasoedov A., Poletaev N., Rodin S. Semipolar AlN and GaN on Si(100): HVPE technology and layer properties // J. Cryst. Growth. 2017. V. 457. P. 202–206. https://doi.org/10.1016/j.jcrysgro.2016.05.025
Lahourcade L., Bellet-Amalric E., Monroy E., Abouzaid M., Ruterana P. Plasma-assisted molecular-beam epitaxy of AlN(112-2) on m sapphire // Appl. Phys. Lett. 2007. V. 90. P. 131909. https://doi.org/10.1063/1.2716375
Ueno K., Kobayashi A., Ohta J., Fujioka H., Amanai H., Nagao S., Horie H. Room temperature growth of semipolar AlN (1–102) films on ZnO (1–102) substrates by pulsed laser deposition // PSS (RRL) 2009. V. 3. P. 58–60. https://doi.org/10.1002/pssr.200802263
Li X., Zhao J., Liu T., Lu Y., Zhang J. Growth of Semi-Polar (101¯3) AlN Film on M-Plane Sapphire with High-Temperature Nitridation by HVPE // Materials. 2021. V. 14. P. 1722. https://doi.org/10.3390/ma14071722
Bessolov V., Kalmykov A., Konenkov S., Konenkova E., Kukushkin S., Myasoedov A., Osipov A., Panteleev V. Semipolar AlN on Si(100): Technology and properties // Microelectron. Eng. 2017. V. 178. P. 34–37. https://doi.org/10.1016/j.mee.2017.04.047
Kukushkin S.A., Osipov A.V. Nanoscale Single-Crystal Silicon Carbide on Silicon and Unique Properties of This Material // Inorganic Materials. 2021. V. 57. P. 1319–1339. https://doi.org/10.1134/S0020168521130021
Kukushkin S.A., Osipov A.V., Soshnikov I.P. Growth of epitaxial SiC layer on Si (100) surface of n- and p- type of conductivity by the atoms substitution method // Rev. Adv. Mater. Sci. 2017. V. 52. P. 29–42.
Kalinkin I.P., Kukushkin S.A., Osipov A.V. Effect of Chemical Treatment of a Silicon Surface on the Quality and Structure of Silicon-Carbide Epitaxial Films Synthesized by Atom Substitution // Semiconductors. 2018. V. 52. P. 802–808. https://doi.org/10.1134/S1063782618060118
Goldberg Y. Properties of Advanced Semiconductor Materials: GaN, AIN, InN, BN, SiC, SiGe / Y. Goldberg, Eds. M.E. Levinshtein, S.L. Rumyantsev, M.S. Shur. New York: John Wiley & Sons, 2001. 216 P.
Jindal V., Shahedipour-Sandvik F. Theoretical prediction of GaN nanostructure equilibrium and nonequilibrium shapes // J. Appl. Phys. 2009. V. 106. P. 083115. https://doi.org/10.1063/1.3253575
Markov I.V. Crystal Growth for Beginners. Singapore: Scientific, 2003. 546 p.
Akiyama T., Nakane H., Nakamura K., Ito T. Effective approach for accurately calculating individual energy of polar heterojunction interfaces // Phys. Rev. B. 2016. V. 94. P. 115302. https://doi.org/10.1103/PhysRevB.94.115302
Kukushkin S. New phase formation on solid surfaces and thin film condensation // Prog. Surf. Sci. 1996. V. 51. P. 1–107. https://doi.org/10.1016/0079-6816(96)82931-5
Akiyama T., Nakane H., Uchino M., Nakamura K., Ito T. Structures and Polarity of III-Nitrides: Phase Diagram Calculations Using Absolute Surface and Interface Energies // PSS (b). 2018. V. 255. P. 1700329. https://doi.org/10.1002/pssb.201700329
Abavare E.K.K., Iwata J.-I., Yaya A., Oshiyama A. Surface energy of Si(110)- and 3C-SiC(111)-terminated surfaces // PSS (b). 2014. V. 251. P. 1408–1415. https://doi.org/10.1002/pssb.201350335
Sambonsuge S., Nikitina L.N., Hervieu Y.Y., Suemitsu M., Filimonov S.N. Silicon Carbide on Silicon (110): Surface Structure and Mechanisms of Epitaxial Growth // Russ. Phys. J. 2014. V. 56. P. 1439–1444. https://doi.org/10.1007/s11182-014-0197-7
Дополнительные материалы отсутствуют.
Инструменты
Известия РАН. Механика твердого тела