Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2023, № 5, стр. 103-112
Оптимизация геометрии конструкции высокочастотных двигателей и ионных источников
В. К. Абгарян a, *, А. В. Мельников a, А. Ю. Купреева a, О. Д. Пейсахович a
a Научно-исследовательский институт прикладной механики и электродинамики
Московского авиационного института (национального исследовательского университета)
125080 Москва, Россия
* E-mail: vka.mai@mail.ru
Поступила в редакцию 20.05.2022
После доработки 21.06.2022
Принята к публикации 21.06.2022
- EDN: KUZDAY
- DOI: 10.31857/S1028096023050023
Аннотация
В статье изложены результаты расчетов оптимальной геометрии конструкции одного из типов источников квазинейтральной плазмы. Рассмотрена схема ионного источника с индуктивным разрядом плазмы, образуемым и поддерживаемым с помощью высокочастотного электромагнитного поля с частотой порядка 1 МГц. С помощью численного моделирования проведена совместная оптимизация профилей поверхностей основных узлов конструкции, а именно разрядной камеры и электродов ионно-оптической системы. Расчеты выполняли с помощью разработанной ранее инженерной модели индуктивного разряда в плазме. Критериями оптимизации являлись тяга и величина извлекаемого из источника ионного тока, определяемые из расчетных распределений электронной плотности и температуры электронов в объеме разрядной камеры. Оптимизационные расчеты проведены для ионного источника диаметром 16 см с разрядными камерами, поверхность которых имеет форму сегментов сферы. Результаты расчетов тяги представлены в сравнении с величинами, рассчитанными для базовой конфигурацией схемы ионного источника с полусферической разрядной камерой и плоской ионно-оптической системой. Получено существенное увеличение величины извлекаемого ионного тока и тяги в найденной оптимальной конфигурации ионного источника.
ВВЕДЕНИЕ
Ионные источники достаточно давно применяют в ионно-плазменных технологиях, в основном, в микроэлектронике при ионно-плазменной обработке различных поверхностей, например, с целью формирования нужного рельефа поверхностей или направленной модификации физических свойств приповерхностных слоев технологических материалов [1].
В космической технике ионные источники используют для получения тяги, образующейся при ускорении плазменного потока до скоростей в несколько десятков км/с. Плазменные двигатели такого типа, называемые также ионными двигателями, являются двигателями малой тяги. В соответствии со своими техническими характеристиками они могут быть применены для решения ряда транспортных задач в космических технологиях в качестве основных узлов двигательных установок космических аппаратов. В настоящее время ионные двигатели используют для решения задач коррекции и поддержания орбиты космических аппаратов в околоземном пространстве. Однако практически все ведущие космические державы рассматривают применение ионных двигателей на борту космических аппаратов, разрабатываемых для эксплуатации в дальнем космосе.
В списке завершенных к настоящему времени – успешные миссии Hayabusa-1 и Hayabusa-2 [2], выполненные Японским космическим агентством JAXA, в которых в качестве маршевых были использованы ионные двигатели µ10. Также отметим миссию агентства NASA Deep Space 1, целью которой был полет к астероиду Веста, в которой в качестве маршевой установки использовали ионный двигатель NSTAR [3].
Существуют три конкурирующих между собой технологии ионных двигателей и источников ионов, различающиеся по способу получения и поддержания плазменного разряда в разрядной камере: ионные двигатели Кауфмана, основанные на разряде постоянного тока [4–7]; высокочастотные (ВЧ) источники ионов и двигатели с индуктивным радиочастотным разрядом (диапазон частот возбуждающего электромагнитного поля 0.5–2.0 МГц) [8]; сверхвысокочастотные ионные двигатели с разрядом плазмы с частотой электромагнитного поля более 2 ГГц [9, 10].
Среди перечисленных наибольшее распространение получила технология ионных двигателей постоянного тока, которую широко используют в NASA, например, в космических ионных двигателях XIPS и NEXT. В Европе активно применяют двигатели как постоянного тока, так и ВЧ. Автором схемы последних является доктор Хорст Леб, Германия [11], такие ВЧ ионные двигатели называют “RIT” (Radio-Frequancy Ion Thruster). Сверхвысокочастотные ионные двигатели успешно используют в космическом агентстве Японии (JAXA).
КОНСТРУКЦИЯ И ПРИНЦИП ДЕЙСТВИЯ ИСТОЧНИКОВ ИОНОВ С ВЫСОКОЧАСТОТНЫМ НАГРЕВОМ ПЛАЗМЫ
Различные схемы ионных источников имеют много общего как в конструкции составляющих ее элементов, так и в физике протекающих процессов. Во всех схемах ионных источников в разрядной камере образуется разряд низкотемпературной плазмы с температурой электронов Te порядка 2–5 эВ. Извлечение положительных ионов из плазменного разряда и их дальнейшее ускорение осуществляется с помощью ионно-оптической системы, состоящей из двух или более электродов, между которыми приложено ускоряющее электростатическое напряжение. Электроды ионно-оптической системы представляют собой тонкие сетки с большим количеством (до нескольких тысяч) соосных отверстий, через которые извлекаются из разряда положительные ионы рабочего газа и ускоряются в промежутке между электродами ионно-оптической системы до энергий в несколько кэВ. Выходящий из ионного источника поток плазмы используют по назначению – для обработки поверхностей в наземных технологиях или получения тяги в космической технике.
В предлагаемой работе рассмотрена схема ионного источника с высокочастотным разрядом плазмы [12]. В состав конструкции ВЧ ионного источника входят следующие основные элементы (рис. 1): керамическая газоразрядная камера 1; ВЧ индуктор 2, выполненный в виде медной спирали; питающий его ВЧ генератор 3; ионно-оптическая система 4, состоящая из эмиссионного и ускоряющего электродов, расположенных на расстоянии порядка 1 мм; газоввод 5 и катод-нейтрализатор 6.
Рис. 1.
Основные элементы конструкции в схеме высокочастотного источника ионов с полусферической разрядной камерой и плоскими электродами: керамическая газоразрядная камера (1); ВЧ индуктор (2); ВЧ генератор (3); ионно-оптическая система (4); газоввод (5); катод-нейтрализатор (6).
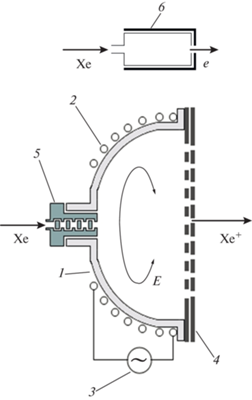
В ВЧ источнике ионов используют индуктивный разряд плазмы, для образования которого в индуктор подают ток с частотой до нескольких МГц, генерирующий в разрядной камере переменное электромагнитное поле, которое поддерживает плазменный разряд. Образующиеся в разряде положительные ионы рабочего газа извлекаются из плазмы в разрядной камере так же, как и в других схемах сеточных ионных источников, через отверстия в электродах ионно-оптической системы. После добавления электронов из катода-нейтрализатора формируется выходящий поток квазинейтральной плазмы, в котором ионы рабочего газа имеют энергии до нескольких кэВ. Подробное описание физических процессов, протекающих в ионных источниках, изложено, например, в [13].
ОСНОВНЫЕ ФИЗИЧЕСКИЕ ХАРАКТЕРИСТИКИ ПЛАЗМЫ В РАЗРЯДЕ
В данной работе рассматривается применение ксеноновой плазмы, поскольку ксенон в настоящее время используют в качестве рабочего газа в подавляющем большинстве известных ионных двигателей. В последнее время значительные усилия направлены для поиска альтернативного, более дешевого рабочего тела при сохранении требуемых эксплуатационных характеристик [14–16].
Ионизация атомов ксенона осуществляется электронным ударом. Также между компонентами плазмы – электронами, ионами и нейтральными атомами – в разряде происходят различные виды упругих и неупругих столкновений с характерными значениями сечений столкновений порядка 10–19 м–2. Более высокое значение, порядка 10–18 м–2, имеет сечение резонансной перезарядки ионов на нейтральных атомах [17]. Процесс перезарядки состоит в переходе электрона с нейтрального атома на ион, в результате чего ион нейтрализуется. Перезарядка происходит без изменения скоростей сталкивающихся частиц.
Длины свободного пробега $\lambda $ между столкновениями различных типов можно оценить по известному соотношению:
(1)
$\lambda = {1 \mathord{\left/ {\vphantom {1 {n\sigma {\text{,}}}}} \right. \kern-0em} {n\sigma {\text{,}}}}$Концентрация заряженных частиц ${{n}_{e}}$ в разрядной камере ионных источников такого типа – ионов и электронов – составляет порядка ~1016–1017 м–3. Концентрация нейтральных атомов рабочего газа составляет 1018–1019 м–3. То есть степень ионизации плазмы достаточно низкая и находится на уровне 1–2%.
Длины пробега между столкновениями для всех видов взаимодействий между частицами, кроме кулоновских, имеют значения $\lambda $ > 0.5 м. В настоящей работе рассмотрен ионный источник с разрядной камерой диаметром L = 16 см, т.е. длины свободного пробега значительно превосходят размеры камеры. Таким образом, для всех видов столкновений между компонентами плазмы, кроме кулоновских, число Кнудсена ${\text{Kn}} = {\lambda \mathord{\left/ {\vphantom {\lambda L}} \right. \kern-0em} L} > 1.$ Это означает, что в камере реализуется свободномолекулярный режим течения плазмы.
Температура электронов ${{T}_{e}}$ в плазме разряда, как указано выше, составляет 2–5 эВ, в то время как нейтральные атомы рабочего газа находятся в равновесии со стенками разрядной камеры, и поэтому имеют температуру, равную температуре стенок камеры и составляющую около 300–400°С, что соответствует энергии около 0.05 эВ. Таким образом, температура электронов значительно превышает температуру нейтральных атомов рабочего газа и, следовательно, в разрядной камере отсутствует термодинамическое равновесие, поскольку различные компоненты плазмы имеют разную среднеквадратическую температуру.
Суммируя вышеизложенное, можно заключить, что в ВЧ ионном источнике реализуется индуктивный разряд квазинейтральной разреженной низкотемпературной, существенно неравновесной плазмы с малой степенью ионизации.
ПОТЕРИ МОЩНОСТИ В ВЫСОКОЧАСТОТНЫХ ИОННЫХ ИСТОЧНИКАХ
Переменный ток в цепи индуктора формирует ВЧ электромагнитное поле в разрядной камере. При характерных для данного типа источников ионов значениях амплитуды индукции переменного магнитного поля в несколько мТл и амплитуды напряженности вихревого электрического поля в несколько В/см происходит ускорение только электронов плазмы, которые поглощают вкладываемую ВЧ мощность и ионизуют атомы рабочего газа путем электронного удара. Образующиеся в результате такого рода ударов ионы практически не воспринимают ВЧ электрическое и магнитное поля. Ионы медленно (относительно электронов) дрейфуют в самоорганизующемся в плазме разряда самосогласованном стационарном электростатическом поле купольного типа, с потенциалом, спадающим от центра плазмы к ее границам, где на поверхностях, граничащих с разрядом, происходит сток компонентов плазмы – ионов и электронов.
Ионы, движущиеся в сторону выходного сечения двигателя, где расположена ионно-оптическая система, формируют выходящий ионный поток. Другая часть ионов дрейфует в электростатическом поле в направлении стенок разрядной камеры. Ионы ускоряются до энергий около $6{{T}_{e}}$ (для ксенона) в пристеночном слое плазмы и выпадают на поверхность разрядной камеры, что приводит к безвозвратным потерям входной ВЧ мощности источника. Данный вид потерь энергии на стенках разрядной камеры является наибольшим во всех типах ионных источников.
Эффективность ускорения ионов выходного пучка до энергий в несколько кэВ непосредственно в ионно-оптической системе близка к 100%, несмотря на то, что именно на ускорение ионов тратится большая часть всей подводимой к источнику ионов электрической мощности. Принято считать, что ускорение ионов протекает без заметных потерь. Доля ВЧ мощности, подаваемой в индуктор, в общем балансе потребляемой электрической мощности составляет 10–25% при различных режимах работы и размерах ионных источников. Соответственно, улучшение технических характеристик ВЧ ионных источников связано с сокращением нежелательных потерь вкладываемой в разряд ВЧ мощности.
Отметим, что полезная часть входной ВЧ мощности тратится только на ионизацию той части атомов рабочего газа, которые проходят через отверстия в ионно-оптической системе, и предварительное ускорение таких ионов до указанных выше энергий (около $6{{T}_{e}}$), что составляет около 20–30 эВ. Доля полезной части ВЧ мощности принципиально невелика для схемы ВЧ ионных источников и составляет около 15% для лучших образцовы источников ионов данной схемы. Остальная часть ВЧ мощности уходит в конечном итоге на нагрев узлов конструкции, и небольшая часть мощности выносится из источника ионов в виде излучения.
ТОК И ТЯГА ИОННЫХ ДВИГАТЕЛЕЙ И ИСТОЧНИКОВ ИОНОВ
Величина ионного тока ${{I}_{0}},$ выходящего из ионного источника, можно определить интегрированием по выходной поверхности ${{S}_{{{\text{ИОС}}}}}$ плотности тока Бома ${{j}_{{\text{B}}}}$ [13] с учетом коэффициента пропускания ионно-оптической системы $\sigma $, определяемого прозрачностью ионно-оптической системы и кривизной плазменного мениска собирающей поверхности $\gamma $ [18], а именно:
(2)
${{I}_{0}} = \sigma \gamma \iint\limits_{{{S}_{{{\text{ИОС}}}}}} {\left| {{{{\mathbf{j}}}_{{\text{B}}}}} \right|ds},$При расчете ${{{\mathbf{j}}}_{{\text{B}}}}$ использованы значения ${{n}_{e}}$ и ${{T}_{e}}$ в плазме вблизи поверхности эмиссионного электрода ионно-оптической системы до начала пристеночного дебаевского слоя.
Тяга ионного двигателя T с учетом расходимости ионного пучка в общем виде можно выразить следующим образом:
где $\dot {m}$ – массовый расход выходящего потока, ${{V}_{i}}$ – скорость истечения ионов, $\overline {{\text{cos}}{\kern 1pt} \theta } $ – усредненный по выходной поверхности ионно-оптической системы косинус угла между направлением движения ионов в точке выхода иона из источника и осью ионного источника.Соотношение расхода $\dot {m}$ и тока I0 следующее:
(5)
$\dot {m} = {{{{\mu }_{{{\text{Xe}}}}}{{I}_{0}}} \mathord{\left/ {\vphantom {{{{\mu }_{{{\text{Xe}}}}}{{I}_{0}}} {e{{N}_{{\text{A}}}},}}} \right. \kern-0em} {e{{N}_{{\text{A}}}},}}$С учетом (5), соотношение (4) можно привести к виду:
(6)
$T = {{{{V}_{i}}\sigma \gamma {{\mu }_{{{\text{Xe}}}}}} \mathord{\left/ {\vphantom {{{{V}_{i}}\sigma \gamma {{\mu }_{{{\text{Xe}}}}}} {e{{N}_{{\text{A}}}}}}} \right. \kern-0em} {e{{N}_{{\text{A}}}}}}\iint\limits_{{{S}_{{{\text{ИОС}}}}}} {\left( {{{{\mathbf{j}}}_{{\text{B}}}},{{{\mathbf{n}}}_{z}}} \right)d\sigma },$В (2) и (6) использовано допущение, что из отверстий в электродах ионно-оптической системы произвольной формы – плоской, выпуклой или вогнутой – вытекает ионный поток по нормали к поверхности с плотностью тока ${{{\mathbf{j}}}_{{\text{B}}}}.$ Также принято, что скорости истечения ионов ${{V}_{i}}$ одинаковы по всей выходной поверхности, поскольку, за исключением предварительного ускорения ионов в пристеночном слое до указанных выше энергий $6{{T}_{e}},$ они практически целиком определяются ускоряющей разностью потенциалов, приложенной между электродами ионно-оптической системы.
Таким образом, тяга двигателя T и ионный ток ${{I}_{0}}$ можно рассчитать из соотношений (2) и (6) соответственно с использованием также (3), если известны распределения электронной плотности ne и электронной температуры ${{T}_{e}}$ в объеме разрядной камеры, точнее их значений вблизи эмиссионного электрода ионно-оптической системы.
ЦЕНА ИОНА И ДРУГИЕ ХАРАКТЕРИСТИКИ ИОННЫХ ИСТОЧНИКОВ
Одной из важнейших технических характеристик ионных источников, наряду с величиной ионного тока I0, извлекаемого из источника, является цена ионного тока:
где $P$ – мощность, затрачиваемая на образование и поддержание плазменного разряда. Здесь не рассмотрена часть мощности, затрачиваемая на предварительное ускорение ионов в ионно-оптической системе до энергий в несколько кэВ по указанной выше причине высокой эффективности использования этой части мощности.В наиболее распространенных источниках ионов на постоянном токе (схема Кауфмана) мощность P расходуется в основном на образование и ввод в разряд потока электронов с энергиями около 20 эВ с помощью катода, что превышает энергию ионизации атомов рабочего газа (в данном случае, ксенона) с энергией ионизации ${{E}_{{{\text{Xe}}}}}$ = = 12.13 эВ. Для ВЧ источников ионов входной мощностью считают подаваемую в индуктор ВЧ мощность, идущую на нагрев плазмы. Наименьшие значения ${{С}_{I}}$ для ионных двигателей на постоянном токе достигают уровня 250 Вт/A, в то время как для ВЧ ионных источников значения ${{С}_{I}}$ составляют выше 400 Вт/A.
Другой важной характеристикой источников ионов являются коэффициент использования рабочего тела, по которому можно определить массовую эффективность использования рабочего газа. Этот коэффициент достигает значений 0.5–0.6 в современных ионных источниках. Этот параметр является фактически отношением числа ионов, выходящих из источника в составе пучка в единицу времени, к числу атомов рабочего газа, вводимых в разрядную камеру через газоввод в тот же промежуток времени.
В случае ионных двигателей важной характеристикой в некоторых задачах является расходимость ионного пучка, в то время как для технологических источников ионов такого требования к ионному пучку, как правило, не предъявляют, и на первый план выходят значение ионного тока и ширина ионного пучка.
Существуют и другие способы оценки эффективности ионных источников, например, по массовым и энергетическим КПД. Перечисленные технические характеристики ионных источников в основном определяют соотношением полезной и теряемой частей входной мощности, которое в значительной мере зависит от соотношения площадей разрядной камеры и выходного сечения двигателя. Это достаточно очевидно, если учесть, что наибольшие потери вкладываемой в разряд ВЧ мощности происходят на поверхностях, граничащих с разрядом за счет выпадения на них ионов и электронов с их последующей нейтрализацией. Эти потери мощности пропорциональны площади ограничивающих разряд поверхностей, наибольшей из которых является поверхность разрядной камеры. В то время как величина извлекаемого из источника ионного тока ${{I}_{0}}$ пропорциональна площади выходного сечения с учетом коэффициента прозрачности электродов ионно-оптической системы. В случае анализа тяги T также надо принимать во внимание расходимость ионного пучка.
ОПТИМИЗАЦИЯ ГЕОМЕТРИИ РАЗРЯДНОЙ КАМЕРЫ И ЭЛЕКТРОДОВ ИОННО-ОПТИЧЕСКОЙ СИСТЕМЫ
На практике применяли разрядные камеры различной формы – от цилиндрической, как в первых моделях ВЧ ионных источников, до полусферической, конической и других форм. На стенках разрядной камеры происходит наибольшая часть потерь мощности разряда за счет выпадения на ее внутреннюю поверхность компонент плазмы – ионов, электронов и фотонов. Поэтому естественное стремление разработчиков ионных источников состоит в попытках уменьшить площадь поверхности разрядной камеры с целью улучшения технических характеристик.
Геометрия электродов ионно-оптической системы во всех схемах была выбрана плоской или близкой к ней, что позволяло обеспечить малую расходимость ионного пучка не более 4°–5°, что могло быть использовано в ряде задач. Например, в так называемой технологии Ion Beam Shepherd требуется максимально узкий ионный пучок для удаления космического мусора с геостационарной орбиты, где располагаются телекоммуникационные и другие спутники, на безопасные орбиты с помощью ионного пучка. При использовании этой технологии сервисный космический аппарат сближается с образцом космического мусора (отработавшие срок активного существования и не функционирующие космические аппараты) на расстояние порядка 20 м и за несколько суток плазменной струей своего ионного источника уводит объект с занимаемой орбиты на орбиту “захоронения” выше геостационарной, либо на более низкую орбиту, обеспечивающую последующее сгорание объекта в атмосфере Земли. Соответственно, необходимо использовать источник с узким пучком ионов, чтобы максимальная часть пучка попадала на поверхность удаляемого объекта, особенно с учетом указанного расстояния, на котором может безопасно размещаться сервисный космический аппарат в момент увода. Данная технология рассматривается как одна из применимых во всех космических державах [19].
В технологических ионных источниках требование к узости пучка ионов, как правило, не выдвигают, поскольку облучаемый образец можно расположить сколь угодно близко к ионному источнику.
При плоской геометрии электродов ионно-оптической системы поток атомов нейтрального газа, не ионизовавшихся в разряде и покидающих разрядную камеру через отверстия в ионно-оптической системе, очевидно, минимальный. Поэтому считается, что выбор плоских электродов позволяет поддерживать на должном уровне такие технические характеристики двигателя, как коэффициент использования рабочего тела и тяга T двигателя, определяемая также и расходимостью ионного пучка, согласно выражению (6).
В ионных источниках и двигателях с диаметром разрядной камеры более 15 см, как правило, применяют электроды с ненулевой кривизной, причем как выпуклые, так и вогнутые. Но их применение обусловлено скорее стремлением избежать отрицательных последствий от неизбежной в ионных двигателях термомеханической деформации электродов, нагреваемых до температур 300–500°С. Кривизна электродов определяет, по крайней мере, направление термической деформации, от разрядной камеры или внутрь нее, в зависимости от исходной конфигурации, а плоские тонкие поверхности электродов в этом случае являются неустойчивыми.
Выбор же той или иной геометрии разрядной камеры и электродов ионно-оптической системы, судя по публикациям, производили только из технологических соображений, что было связано с высокой стоимостью изготовления керамической разрядной камеры и тонких перфорированных электродов.
С физической точки зрения, выбор профиля поверхности разрядной камеры можно сделать с учетом целесообразности уменьшения площади, а, следовательно, и кривизны поверхности камеры для сокращения потерь ВЧ мощности на ее стенках. Ранее [20] было отмечено, что переход от изначальной цилиндрической формы разрядной камеры к полусферической (рис. 1), привел к уменьшению цены ионного тока ${{С}_{I}}$ примерно на 25%. Принято, что целесообразно использовать выпуклые электроды ионно-оптической системы с поверхностью с небольшой кривизной с сохранением допустимой расходимости ионного пучка.
Наличие упрощенной инженерной модели расчета параметров плазмы в ВЧ ионных двигателях позволяет рассчитывать распределения в разрядной камере основных параметров плазмы (ne и Te), а также практически все перечисленные выше характеристики источника ионов. Это позволяет в свою очередь поставить задачу об определении оптимальной формы плазменного разряда, ограниченного в пространстве поверхностями разрядной камеры и эмиссионным электродом ионно-оптической системы. Критерием оптимизации может быть тяга T для ионных двигателей или величина ионного тока ${{I}_{0}}$ для технологических ионных источников, рассчитываемые из распределений ne и Te. Такая оптимизационная задача была решена в рамках настоящей работы.
ОСНОВНЫЕ ПОЛОЖЕНИЯ РАСЧЕТНОЙ МОДЕЛИ
Распределения ${{n}_{e}}$ и ${{T}_{e}}$ в объеме разрядной камеры рассчитывали с помощью инженерной численной модели расчета параметров плазмы в индуктивном разряде. При построении вычислительной модели были сделаны допущения, позволяющие в короткие сроки проводить оценочные расчеты без привлечения существенных вычислительных мощностей, таких как рабочие станции. Подробное описание модели выходит за рамки настоящей статьи, ниже приведены только основные аспекты. Более полное описание модели и результатов расчетов с ее использованием приведено в [21, 22].
Основные принятые в использованной модели допущения следующие. При описании заряженных частиц плазмы разряда считали, что функция распределения электронов по энергиям является максвелловской с температурой электронов ${{T}_{e}},$ одинаковой в объеме разряда. Во всем объеме разряда соблюдается условие квазинейтральности $({{n}_{e}} = {{n}_{i}}),$ где ${{n}_{i}}~$ – объемная плотность ионов. В расчетах не учтены пристеночные процессы, такие как пристеночное падение потенциала, нарушение зарядового равновесия в дебаевском приповерхностном слое и прочее. В расчетах не учтены перезарядки ионов на нейтральных атомах и ион-электронные рекомбинации в объеме разряда. Нейтральные частицы имеют одинаковую температуру во всем объеме разрядной камеры, которая постоянна и равна температуре стенки разрядной камеры. Для описания поведения заряженных частиц плазмы использованы приближенные к магнитной гидродинамике соотношения. В расчетах использована упрощенная геометрия основных элементов ВЧ ионного двигателя (разрядной камеры, индуктора, газораспределителя и электродов ионно-оптической системы), без учета характеристик материалов, из которых они были изготовлены. Ионы и электроны, выпадающие на стенки разрядной камеры, рекомбинируют на стенках и возвращаются в объем плазмы в виде нейтральных атомов. В модели не учтено распространение электромагнитных волн в плазме. Положительные ионы, выходящие из источника ионов, двигаются по нормали к поверхности электродов ионно-оптической системы, т.е. процесс прохождения ионов через ячейки ионно-оптической системы детально не рассматривается.
В модели численным способом решается система уравнений из 24 уравнений, часть из которых относится к определению напряженностей электромагнитного поля, создаваемого ВЧ индуктором. Другие уравнения, в том числе и балансовые соотношения относительно параметров плазмы, являются известными выражениями, такими как уравнение неразрывности, диффузии ионов и другие.
РАСЧЕТНЫЕ СХЕМЫ МОДЕЛЕЙ ИСТОЧНИКОВ ИОНОВ
Расчеты тяги двигателя и ионного тока выполняли для моделей ВЧ источников ионов с выходным диаметром ионного пучка ${{R}_{0}}$ = 16 см. Ионный двигатель такого размера можно отнести к двигателям средней мощности, составляющей несколько кВт. Его можно применять не только для поддержания орбит геостационарных спутников, но и для выполнения миссий в дальнем космосе. Уже существуют ионные двигатели с такой схемой и такого класса мощности, разработанные в Германии [23], это двигатели семейства RIT. Двигатель RIT-22 [24] имеет разрядную камеру с формой в виде усеченного конуса диаметром 22 см. Особо отметим относительно новый и продвигаемый на рынок компанией Airbus DS GmbH ВЧ ионный двигатель RIT-2-X [25], размеры и форма которого не опубликованы. Однако по имеющимся в литературе фотографиям можно оценить его диаметр в диапазоне 25–28 см и предположить форму разрядной камеры, как выполненную в виде сегмента сферической поверхности с отношением высоты к радиусу разрядной камеры на уровне 0.5 (для полусферической разрядной камеры это отношение, очевидно, равно 1). В обоих указанных двигателях типа RIT использована ионно-оптическая система с небольшим прогибом наружу от разрядной камеры.
Выбор размера исследуемого ионного источника продиктован в числе других и тем обстоятельством, что в случае успеха в достижении тех же значений основных технических характеристик на двигателе меньших размеров (диаметром 16 см), такой бы двигатель имел бы неоспоримое преимущество в конкурентной борьбе.
На данном этапе исследований рассматривали поверхности разрядной камеры и электродов ионно-оптической системы из класса сферических поверхностей. Базовой являлась распространенная схема (рис. 1) с плоскими электродами и полусферической разрядной камерой. Вырезы в схемах в верхней части разрядной камеры во всех схемах обусловлены наличием газоввода.
В качестве варьируемых геометрических параметров выбрали высоту профиля разрядной камеры ${{H}_{{{\text{РК}}}}}$ и прогиб электродов ионно-оптической системы ${{H}_{{\text{Э}}}}$ (рис. 2). Удобнее пользоваться относительными высотой камеры и прогибом электродов:
(8)
${{h}_{{{\text{РК}}}}} = {{{{H}_{{{\text{РК}}}}}} \mathord{\left/ {\vphantom {{{{H}_{{{\text{РК}}}}}} {{{R}_{0}},}}} \right. \kern-0em} {{{R}_{0}},}}\,\,\,\,{{h}_{{\text{Э}}}} = {{{{H}_{{\text{Э}}}}} \mathord{\left/ {\vphantom {{{{H}_{{\text{Э}}}}} {{{R}_{0}}.}}} \right. \kern-0em} {{{R}_{0}}.}}$РЕЗУЛЬТАТЫ РАСЧЕТОВ. ОБСУЖДЕНИЕ
Целью расчетов являлось определение оптимальных значений параметров ${{h}_{{{\text{РК}}}}}$ и ${{h}_{{\text{Э}}}}$ схемы, при использовании которых значения тяги T и ионного тока I0 были бы наибольшими по отношению к тем же величинам, рассчитываемым для базовой схемы с полусферической камерой и плоскими электродами.
Для каждой схемы, т.е. для различных пар значений ${{h}_{{{\text{РК}}}}}$ и ${{h}_{{\text{Э}}}},$ с помощью модели плазменного разряда рассчитывали распределения в объеме камеры электронной плотности ${{n}_{e}}\left( r \right)$ и численное значение электронной температуры Tе. Далее с помощью выражений (2), (3) и (6) вычисляли значения ионного тока ${{I}_{0}}$ тяги T.
В численных расчетах для различных схем ВЧ источников ионов с диаметром выходного сечения 16 см использовали одинаковые значения вкладываемой ВЧ мощности ${{P}_{{{\text{ВЧ}}}}}$ = 270 Вт, расхода рабочего газа $\dot {m}$ = 1 мг/с, числа витков ВЧ индуктора N = 8 и их расположение относительно разрядной камеры.
В результате проведенной серии численных расчетов определены две схемы источника ионов с максимальными значениями ионного тока и тяги. Для схемы с максимальным значением ионного тока значения относительных высоты разрядной камеры и прогиба электродов составили:
Максимальное значение тяги соответствовало схеме с параметрами: Максимальное превышение ионного тока ${{I}_{0}}$ составило около 14% по сравнению с базовой схемой. Максимальное увеличение тяги T составило около 12%. На рис. 3 изображены распределение электронной плотности ${{n}_{e}}$ в разрядной камере базовой схемы и схемы с наибольшим значением ионного тока. На рис. 4 изображено распределение электронной плотности ${{n}_{e}}$ в разрядной камере схемы с наибольшим значением тяги.Рис. 3.
Распределения электронной плотности ne в разрядной камере базовой схемы (а) и оптимальной схемы с наибольшим ионным током (б). Диаметр камеры 16 см.

Рис. 4.
Распределения электронной плотности в разрядной камере оптимальной схемы с наибольшим значением тяги. Диаметр камеры 16 см.

Во всех схемах, для которых проводили расчеты, максимум концентрации плазмы наблюдали в верхней части камеры вблизи выреза для газоввода, через который осуществляется ввод рабочего газа в разрядную камеру. В этой области разрядной камеры концентрация нейтральных атомов является наибольшей и поэтому частота ионизации в данной области также максимальна.
Как видно из рис. 3б и рис. 4 значения ${{n}_{e}}$ в разрядной камере оказались значительно выше для обеих оптимальных схем по сравнению с базовой схемой. Соответственно, и значения ${{n}_{e}}$ вблизи выходной поверхности ионного источника, определяющие значения ионного тока и тяги источника, также оказались более высокими.
Наилучшие результаты по ионному току и тяге получены на схемах с выпуклыми электродами. Схемы с вогнутыми электродами показали меньшие значения.
На рис. 5 показана зависимость ионного тока и тяги в области их максимальных значений от прогиба электродов ${{H}_{{\text{Э}}}}.$ Для наглядности результатов расчетов приведены значения ионного тока ${{I}_{0}}$ и тяги T и по отношению к их значениям $I_{0}^{{{\text{opt}}}}$ и ${{T}^{{{\text{opt}}}}}$, соответственно, рассчитанным для схемы, где достигнуты максимальные значения тяги, изображенной на рис. 4. По оси ОХ отложено отклонение прогиба электродов от значения прогиба, соответствующего схеме с максимальной тягой T, т.е.
Приведенному в (9) оптимальному значению ${{h}_{{\text{Э}}}}$ соответствует, очевидно, прогиб электронов ионно-оптической системы: Отметим, что зависимость ионного тока и тяги от прогиба электродов ${{H}_{{\text{Э}}}}$ достаточно слабая, поскольку достаточно заметное изменение ${{H}_{{\text{Э}}}}$ в приведенном на рис. 5 диапазоне прогиба электродов от 5.6 до 15.6 мм приводит к изменениям как ионного тока, так и тяги в пределах лишь 1.2%, что малозначительно. Практически весь прирост и по ионному току и по тяге на упомянутых уровнях 14 и 12%, соответственно, достигнут за счет перехода формы разрядной камеры от полусферической к поверхности со значительно меньшей кривизной. Выявленное в расчетах обстоятельство позволяет в дальнейших расчетах, например, для источников ионов других размеров и мощности выбрать удобную стратегию оптимизационных расчетов с точки зрения его объема. Сначала выбирают схему с прогибом электродов на уровне значений ${{h}_{{\text{Э}}}},$ приведенных в (9)–(10). Далее следует серия оптимизационных расчетов для поиска максимума по относительной высоте разрядной камеры ${{h}_{{{\text{РК}}}}}.$ После фиксации найденного наилучшего значения ${{h}_{{{\text{РК}}}}}$ можно провести уточнение прогиба электродов ${{h}_{{\text{Э}}}}.$ Таким образом, двумерную оптимизацию геометрических параметров источника ионов можно заменить на две последовательные одномерные процедуры. Такая стратегия значительно сокращает требуемые вычислительные мощности и время расчетов.На рис. 5 отметим различие положения максимумов относительных значений ионного тока и тяги $\frac{T}{{{{T}^{{{\text{opt}}}}}}}$ и $\frac{{{{I}_{0}}}}{{I_{0}^{{{\text{opt}}}}}},$ которое объясняется увеличением расходимости ионного пучка заметных значениях прогибов электродов ${{h}_{{\text{Э}}}}.$
С ростом ${{h}_{{\text{Э}}}}$ увеличивается площадь электродов, через отверстия в которых непрерывно вытекают атомы рабочего газа, не ионизовавшиеся в разряде. Соответственно, можно было ожидать ухудшение массовой эффективности по сравнению со схемой с плоскими электродами. Однако в данной серии расчетов наоборот выявлено улучшение массовой эффективности на 14%, т.е. на примерно те же значения, что и в случае с ионным током ${{I}_{0}}$ и тягой T.
Цена ионного тока ${{С}_{I}}$ сократилась на 14% в оптимальной схеме с максимальным значением ионного тока по сравнению базовой схемой. Электронная температура повысилась с 5 до 7 эВ, что способствует повышению электронной плотности ${{n}_{e}}$ в плазме разряда.
Все это свидетельствует о лучшей организации плазменного разряда в обеих оптимальных схемах по сравнению с базовой, что подтверждается более высокими значениями электронных плотностей ${{n}_{e}}\left( r \right)$ во всем объеме разрядной камеры.
При дальнейших исследованиях будет расширен класс рассматриваемых поверхностей разрядной камеры и ионно-оптической системы за счет более сложных форм, например, эллипсоидальных. Наглядно видно на распределениях рассчитанных электронных плотностей ${{n}_{e}},$ изображенных на рис. 3б и 4, что плазма не заполняет углы камеры. Поэтому в будущих работах следует учесть это и сгладить углы по окружности сопряжения поверхностей разрядной камеры и электродов ионно-оптической системы.
ЗАКЛЮЧЕНИЕ
С помощью инженерной модели выполнена серия оптимизационных расчетов тяги и ионного тока схем ВЧ ионного источника с диаметром 16 см с различными профилями поверхностей разрядной камеры и электродов ионно-оптической системы. Рассмотрены поверхности разрядной камеры и электродов ионно-оптической системы из класса сегментов сферических поверхностей. Варьировали кривизну поверхности разрядной камеры и величину прогиба электродов ионных источников. Определена область значений данных параметров, при которых расчетные значения ионного тока и тяги, превышают такие же значения, рассчитанные для базовой схемы с полусферической разрядной камерой и плоскими электродами ионно-оптической системы. Максимальное выявленное увеличение указанных характеристик ионного источника составило 12–14% при применении заметно выпуклых электродов ионно-оптической системы. При использовании оптимизированной схемы массовая эффективность источника ионов, несмотря на увеличение площади выходной поверхности, не уменьшилась, а наоборот увеличилась, что можно объяснить лучшей организацией плазменного разряда. Расчетами выявлено существенное увеличение электронной плотности в разряде в найденной оптимальных схемах конструкции ионного источника. Перечисленное позволяет утверждать, что конструкции семейства ВЧ ионных источников с разрядной камерой малой кривизны и заметно выпуклыми электродами ионно-оптической системы могут быть рассмотрены для практического применения в наземных технологиях и космической технике.
Список литературы
Kanarov V., Hayes A.V., Yevtukhov R., Vidinsky B., Navy A. // Rev. Sci. Instrum. 1998. № 69. P. 874. https://www.doi.org/10.1063/1.1148742
Jet Propulsion Laboratory NASA. 2003. https://www.jpl.nasa.gov/missions/hayabusa Cited 10 April 2022
Jet Propulsion Laboratory NASA. 1998. https://www.jpl.nasa.gov/missions/deep-space-1-ds1 Cited 10 April 2022
Van Noord J. // In 43rd AIAA/ASME/SAE/ASEE Joint Propulsion Conference & Exhibit. 2007. P. 5218. https://www.doi.org/10.2514/6.2007-5218
Van Noord J., Herman D. // In 44th AIAA/ ASME/SAE/ASEE Joint Propulsion Conference & Exhibit. 2008. P. 4526. https://www.doi.org/10.2514/6.2008-4526
Васин А.И., Коротеев А.С., Ловцов А.С., Муравлев В.А., Шагайда А.А., Шутов В.Н. // Труды МАИ. 2012. Т. 60. С. 8.
Herman D.A. // 57th Joint Army-Navy-NASA-Air Force (JANNAF) Propulsion Meeting. 2010. No. E-17447.
Антропов Н.Н., Ахметжанов Р.В., Балашов В.В., Богатый А.В., Дьяконов Г.А., Могулкин А.И., Обухов В.А., Плохих А.П., Попов Г.А. // Тезисы 14-й Международной конференции “Авиация и космонавтика-2015”. 2015. С. 141.
Tsukizaki R., Ise T., Koizumi H., Togo H., Nishiyama K., Kuninaka H. // J. Propulsion and Power. 2014. V. 30. № 5. P. 1383. https://www.doi.org/10.2514/1.B35118
Foster J., Haag T., Kamhawi H., Patterson M., Malone S., Elliot F. // In 40th AIAA/ASME/SAE/ASEE Joint Propulsion Conference and Exhibit. 2004. P. 3812. https://www.doi.org/10.2514/6.2004-3812
Loeb H. // Astronautica Acta. 1962. V. 8. № 1. P. 49.
Abgaryan V.K., Nadiradze A.B., Semenov A.A., Troshin A.E. // J. Surf. Invest.: X-Ray, Synchrotron Neutron Tech. V. 13. 2019. № 6. P. 1054. https://www.doi.org/10.1134/S102745101906003X
Goebel D.M., Katz I. // Fundamentals of Electric Propulsion: Ion and Hall. N.Y.: John Wiley & Sons, 2008. P. 100.
Абгарян В.К., Леб Х.В., Обухов В.А., Шкарбан И.И. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2012. № 8. С. 70.
Канев С.В., Кожевников В.В., Хартов С.А. // Известия РАН. Энергетика. 2017. Т. 3. С. 21.
Cifali G., Misuri T., Rossetti P., Andrenucci M., Valentian D., Feili D., Lotz B. // 32nd International Electric Propulsion Conference. 2011. № 11. P 15.
Девдариани А.З., Артамонова А.О., Беляев А.К. // Письма в ЖТФ. 2020. Т. 46. Вып. 4. С. 45. https://www.doi.org/10.21883/PJTF.2020.04.49051.17990
Абгарян В.К., Ахметжанов Р.В., Леб Х.В., Обухов В.А., Черкасова М.В. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2013. №11. С. 82.
Balashov V., Cherkasova M., Kruglov K., Kudriavtsev A., Masherov P., Mogulkin A., Obukhov V., Riaby V., Svotina V. // Rev. Sci. Instrum. 2017. V. 88. № 8. P. 083304. https://www.doi.org/10.1063/1.4998247
Holste K., Dietz P., Scharmann S., Keil K., Henning T., Zschätzsch D., Reitemeyer M., Nauschütt B., Kiefer F., Kunze F., Zorn J., Heiliger C., Joshi N., Probst U., Thüringer R., Volkmar C., Packan D., Peterschmitt S., Brinkmann K.-T., Zaunick H.-G., Thoma M.H., Kretschmer M., Leiter H.J., Schippers S., Hannemann K., Klar P.J. // Rev. Sci. Instrum. 2020. V. 91. P. 061101. https://www.doi.org/10.1063/5.0010134
Мельников А.В., Хартов С.А. // Известия РАН. Энергетика. 2018. Т. 3. С. 4.
Kanev S., Melnikov A., Nazarenko I., Khartov S. // IOP Conference Series: Mater. Sci. Engineer. 2020. P. 012010. https://www.doi.org/10.1088/1757-899X/868/1/012010
Porst, J.P., Kuhmann J., Kukies R., Leiter H. // In Proceedings of the 34th International Electric Propulsion Conference. 2015.
Leiter H.J., Kukies R., Porst J.P., Kuhmann J., Berger M, Rath M., // In 50th AIAA/ASME/SAE/ASEE Joint Propulsion Conference. 2014. P. 3421. https://www.doi.org/10.2514/6.2014-3421
Porst J.P., Altmann C., Arnold C., Kuhmann J., Syring C., Leiter H.J., Berger M., Scholze F., Eichhorn C., Bundesmann C. // 35th International Electric Propulsion Conference. 2017.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования




