Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2023, № 5, стр. 80-94
Современная растровая электронная микроскопия. 1. Вторичная электронная эмиссия
Ю. А. Новиков *
Институт общей физики им. А.М. Прохорова РАН
119991 Москва, Россия
* E-mail: nya@kapella.gpi.ru
Поступила в редакцию 22.09.2022
После доработки 17.11.2022
Принята к публикации 17.11.2022
- EDN: AMQMFC
- DOI: 10.31857/S102809602305014X
Аннотация
Развитие современных технологий, в том числе нанотехнологии, основано на применении методов диагностики объектов, используемых в технологиях процессах. Для этой цели наиболее перспективными являются методы, реализованные в растровом электронном микроскопе. При этом одним из основных методов является измерение линейных размеров рельефных структур микронного и нанометрового диапазонов, используемых в микро- и наноэлектронике. В основе работы растрового электронного микроскопа лежит вторичная электронная эмиссия твердого тела. Однако практически все известные закономерности вторичной электронной эмиссии были получены на поверхностях, рельефом которых пренебрегалось. Приведен обзор теоретических и экспериментальных материалов исследования вторичной электронной эмиссии твердого тела на безрельефных поверхностях. Практически все известные закономерности проверены в экспериментах и получили свое физическое объяснение. Однако применение вторичной электронной эмиссии в растровой электронной микроскопии, используемой в микро- и наноэлектронике и нанотехнологиях, требует знания закономерностей, которые проявляются именно на рельефных поверхностях. Демонстрируется, какие закономерности можно применять в растровом электронном микроскопе для измерения линейных размеров рельефных структур. Делается вывод о необходимости изучения влияния рельефа поверхности твердого тела на вторичную электронную эмиссию.
ВВЕДЕНИЕ
Растровая электронная микроскопия получила широкое распространение в науке, технике и технологии, включая нанотехнологии [1–6]. Это обусловлено тем, что современная промышленность выпускает растровые электронные микроскопы (РЭМ) высокого качества. Кроме того, с использованием РЭМ можно реализовать большое количество разных методов исследования – как качественных, так и количественных [1–6]. Управление РЭМ от компьютера и цифровизация получаемой информации (особенно перевод изображений в цифровую форму) позволило осуществить автоматизацию обработки и анализа получаемой на РЭМ информации, что упростило и ускорило работу на РЭМ.
Однако все методы, реализованные на РЭМ, находятся на разных стадиях развития. Одни доведены до практически полной автоматизации измерений (например, рентгеновский анализ химического состава вещества [1–5]). Другие до недавнего времени являлись только наблюдательными или, в крайнем случае, полуколичественными (например, измерение линейных размеров рельефа структур). В связи с быстрым прогрессом в области микроэлектроники, а потом и наноэлектроники [7] потребовались методы измерения линейных размеров рельефа структур в микрометровом и нанометровом диапазонах [7–13]. В результате выполненных исследований метод измерения линейных размеров на РЭМ резко повысил свое качество. Он перешел из полуколичественного метода в высокоточный количественный метод измерения на РЭМ линейных размеров рельефных структур с размерами, лежащими в микрометровом и нанометровом диапазонах [14, 15]. Метод был доведен до практически полной автоматизации и встраивания в технологическую линию производства микросхем [16–19].
Для превращения РЭМ из наблюдательного прибора в области измерения линейных размеров рельефа структур в измерительный прибор необходимо было выполнить ряд работ.
1) Нужны удобные для работы на РЭМ тест-объекты, обладающие рельефом и размерами, пригодными для калибровки РЭМ.
2) РЭМ может работать в двух режимах – высоковольтном режиме при энергии электронов зонда E > 2 кэВ и низковольтном режиме при E ≤ ≤ 2 кэВ. Необходимо выбрать режим работы РЭМ, в котором будут проводить калибровку РЭМ и измерение размеров рельефа структур.
3) Для высоковольтного режима нужно выбрать способ регистрации вторичных электронов – вторичных медленных электронов или обратно рассеянных электронов.
4) Необходимо разработать методы калибровки РЭМ с помощью имеющихся тест-объектов. Под калибровкой будем подразумевать не только определение увеличения РЭМ (как это было ранее), но и измерение всех параметров РЭМ, влияющих на результаты измерений линейных размеров в выбранных режимах работы РЭМ и всеми способами регистрации вторичных электронов.
5) Нужно разработать методы измерения линейных размеров рельефных структур (включая измерения в технологическом процессе производства микросхем).
6) Необходимо исследовать механизмы генерации вторичных электронов первичными электронами, взаимодействующими с рельефными поверхностями. Дело в том, что все закономерности вторичной электронной эмиссии исследовали на поверхностях, рельефом которых пренебрегали. В то же время с помощью РЭМ исследуют именно рельефные поверхности. Переносить закономерности, полученные на “безрельефных” поверхностях, на рельефные поверхности не вполне корректно.
7) Нужно найти математические выражения, связывающие параметры РЭМ и параметры изображений, получаемых на РЭМ, с параметрами рельефных структур, что даст возможность осуществлять измерение линейных размеров рельефа структур.
8) Надо создать модели формирования изображений в РЭМ, работающих во всех режимах, что позволит научно обосновать математические выражения, связывающие параметры РЭМ и параметры изображений с параметрами рельефных структур, и позволит верифицировать созданные методы измерения размеров рельефных структур.
9) Необходимо обеспечить прослеживаемость созданных методов измерений линейных размеров рельефных структур от первичного эталона длины – метра, до измеряемого размера, что обеспечит единство измерений в микрометровом и нанометровом диапазонах линейных размеров рельефа структур.
В настоящее время все необходимые тест-объекты и методы калибровки РЭМ и измерений на РЭМ разработаны. Исследования вторичной электронной эмиссии (ВЭЭ) рельефных поверхностей проведены. Получены математические выражения, связывающие параметры РЭМ и параметры изображений с параметрами рельефных структур. Созданы модели формирования изображений в РЭМ, работающих во всех режимах работы. Но, в силу обстоятельств быстрого развития данного направления науки, техники и технологий, результаты исследований опубликованы в большем количестве журналов и трудах международных конференций, доступ к которым ограничен в силу разных причин. В связи с этим необходим обзор современного состояния растровой электронной микроскопии, используемой в качестве метода измерения линейных размеров рельефа структур, широко применяемого в производстве микро- и наноэлектроники. Однако большой объем материалов не позволяет описать все это в одном обзоре. Поэтому было принято решение написать серию обзоров, связанных общим названием и представляющих современное состояние растровой электронной микроскопии в области измерения линейных размеров рельефных структур в микрометровом и нанометровом диапазонах.
Настоящая статья представляет собой первый обзор из серии, посвященный закономерностям вторичной электронной эмиссии – твердо установленным законам и механизмам взаимодействия электронов с твердым телом, на которых основана растровая электронная микроскопия. Эти закономерности позволяют решить ряд проблем растровой электронной микроскопии даже без подробного изучения формирования изображений рельефных структур в РЭМ, работающем в некоторых режимах регистрации вторичных электронов.
ЗАКОНОМЕРНОСТИ ВТОРИЧНОЙ ЭЛЕКТРОННОЙ ЭМИССИИ
В основе работы РЭМ лежит ВЭЭ [20]. Она представляет собой явление испускания электронов поверхностью твердого тела, возникающее при воздействии на твердое тело первичных (падающих) электронов. ВЭЭ можно наблюдать у любых веществ [21, 22]. ВЭЭ имеет место, как на поверхности, обращенной к падающим электронам (ВЭЭ на отражение) [2, 3, 21–25], так и на противоположной поверхности твердого тела после прохождения электронами сквозь вещество [22, 25, 26]. Последнее реализуют обычно при облучении электронами тонких пленок (ВЭЭ “на прострел”) [26–30].
Коэффициент вторичной электронной эмиссии
Одним из основных параметров, характеризующих ВЭЭ, является коэффициент вторичной эмиссии:
(1)
$\phi = {{{{I}_{{\text{S}}}}} \mathord{\left/ {\vphantom {{{{I}_{{\text{S}}}}} {{{I}_{{\text{P}}}}.}}} \right. \kern-0em} {{{I}_{{\text{P}}}}.}}$Зависимость ϕ(E) имеет более сложную форму, чем представленная на рис. 1. При возникновении ВЭЭ в некоторых веществах можно наблюдать “тонкую структуру” ϕ(E) [31, 45, 46] – набор локальных минимумов и максимумов. У других веществ ВЭЭ имеет место при энергии первичных электронов меньше работы выхода электрона из вещества [47–52]. ВЭЭ имеет место даже тогда, когда энергии первичных электронов явно недостаточно для генерации вторичных электронов [45]. В ряде случаев первичный электрон играет роль спускового механизма эмиссии электронов, а энергия, за счет которой эта эмиссия идет, берется из других источников [53]. Такую эмиссию называют экзоэмиссией.
ВЭЭ сильно зависит от состояния поверхности, испускающей электроны. Так в работе [52] отмечено, что необезгаженные материалы эмиттируют значительно больше вторичных электронов, чем прошедшие термообработку. В работах [54, 55] высказано предположение о влиянии поверхностных электронных состояний на ВЭЭ. Так как количество и тип поверхностных электронных состояний зависит от истории создания образца [56], то это может приводить к неоднозначным результатам экспериментов. В связи с этим на практике при исследовании ВЭЭ принимают специальные меры для ослабления влияния поверхности (в частности отжиг образца или напыление пленок в высоком вакууме) [21]. Отметим, что экзоэмиссия [53] существенно определяется состоянием поверхности твердого тела.
Спектр вторичных электронов
Одной из основных закономерностей ВЭЭ является спектр вторичных электронов, испущенных в направлении, противоположном распространению пучка первичных электронов [1, 20]. На рис. 2 схематично изображено распределение ВЭ n по энергии ВЭ ES при энергии первичных электронов E. Спектр представляет собой довольно сложную картину, которая определяется механизмами генерации ВЭ. В РЭМ в высоковольтном режиме осуществляется регистрации так называемых “вторичных медленных электронов” и “обратно рассеянных электронов”. Это разделение основано на использовании разных типов детекторов вторичных электронов и тем, что спектре вторичных электронов можно выделить три резко различающиеся области [1, 20].
Рис. 2.
Схематичное изображение спектра электронов n(ES), испущенных в направлении, обратном по отношению к движению первичных электронов, при энергии первичных электронов E (отмечено стрелкой).

В область 1 дают вклад электроны, которые в результате взаимодействия с веществом, потеряли очень малую часть своей энергии. Обычно это однократно упруго рассеянные обратно (первоначальному движению) первичные электроны.
Во область 2 дают вклад электроны с энергией меньшей (часто гораздо меньшей) энергии первичного электрона. Это первичные и вторичные электроны, испытавшие многократное упругое и неупругое рассеяние, а также электроны из некоторых других процессов рождения электронов, которые будут рассмотрены ниже.
В область 3 входят только те ВЭ, энергия которых меньше 50 эВ [1–3, 21]. Эта граница введена эмпирически. Она определяется тем, что в ее области заканчивается склон максимума низкоэнергетичных электронов (ES < 50 эВ), испущенных практически из всех твердых тел. Эксперименты по измерению спектров ВЭ при разных энергиях первичных электронов E показали, что для большинства веществ положение максимума в спектре лежит в диапазоне 1–4 эВ [21]. Кроме того, при E ≥ 0.5 кэВ положение максимумов спектра и их полуширины практически не зависят от энергии первичных электронов [57].
Необходимо отметить, что реальные спектры имеют более сложную структуру [1]. Некоторые особенности спектра n(ES) будут описаны ниже. Однако эти особенности не оказывают существенного влияния на применение РЭМ в научных, технических и технологических работах.
МЕХАНИЗМЫ ГЕНЕРАЦИИ ВТОРИЧНЫХ ЭЛЕКТРОНОВ
В настоящее время известно достаточно много физических эффектов, приводящих к эмиссии электронов из твердого тела в вакуум под воздействием налетающего электрона. К ним можно отнести упругое рассеяние электронов (например, [58–60]), испускание электронов атомом облучаемого вещества за счет ионизационных потерь [58–60] или эффекта Оже [4, 61], а также двух- или многоступенчатые процессы (например, идущие через образование квантов электромагнитного излучения с последующей генерацией этими квантами вторичных электронов [59]). Большой вклад во ВЭЭ дает эффект эмиссии электронов из поверхностных электронных состояний налетающим электроном при его движении из вакуума в твердое тело [62, 63], при движении налетающих электронов через поверхность из твердого тела в вакуум такой эмиссии не происходит.
Рассмотрим некоторые эффекты и закономерности, которые можно использовать при анализе формирования изображений рельефных структур в РЭМ.
Упругое рассеяние электронов
Упругое рассеяние электронов является одним из главных механизмов генерации электронов, покидающих твердое тело. При этом различают 4 вида таких механизмов [59]: однократное упругое рассеяние электронов; кратное упругое рассеяние электронов; многократное упругое рассеяние электронов; диффузия электронов. Рассмотрим более подробно эти механизмы.
Однократное упругое рассеяние электронов. Наиболее простым механизмом генерации ВЭ является однократное упругое рассеяние. Оно заключается в однократном взаимодействии налетающего электрона с атомным ядром рассеивающего вещества, после чего рассеянный первичный электрон покидает вещество и выходит в вакуум. Дифференциальное сечение такого процесса определяется формулой Резерфорда (поэтому эти электроны часто называют резерфордовскими). Для рассеяния электронов в веществе с учетом эффекта экранирования электрического поля атомного ядра дифференциальное сечение такого рассеяния, полученное в первом борновском приближении, имеет вид [60]:
(2)
${{d\sigma } \mathord{\left/ {\vphantom {{d\sigma } {d\Omega }}} \right. \kern-0em} {d\Omega }} = {{[Z(Z + 1){{e}^{4}}]} \mathord{\left/ {\vphantom {{[Z(Z + 1){{e}^{4}}]} {[16{{E}^{2}}({\text{si}}{{{\text{n}}}^{2}}({\theta \mathord{\left/ {\vphantom {\theta 2}} \right. \kern-0em} 2}) + {{\beta }^{2}})}}} \right. \kern-0em} {[16{{E}^{2}}({\text{si}}{{{\text{n}}}^{2}}({\theta \mathord{\left/ {\vphantom {\theta 2}} \right. \kern-0em} 2}) + {{\beta }^{2}})}}],$(3)
$\beta = {{5.43{{Z}^{{{2 \mathord{\left/ {\vphantom {2 3}} \right. \kern-0em} 3}}}}} \mathord{\left/ {\vphantom {{5.43{{Z}^{{{2 \mathord{\left/ {\vphantom {2 3}} \right. \kern-0em} 3}}}}} {E.}}} \right. \kern-0em} {E.}}$На рис. 3 приведена зависимость плотности вероятности вылета электрона под углом θ относительно первоначального движения при его рассеянии на атомах кремния для трех энергий первичных электронов E = 1, 5 и 30 кэВ (кривые 1, 2 и 3 соответственно):
(4)
$P(\theta ) = {{({{d\sigma } \mathord{\left/ {\vphantom {{d\sigma } {d\Omega }}} \right. \kern-0em} {d\Omega }})} \mathord{\left/ {\vphantom {{({{d\sigma } \mathord{\left/ {\vphantom {{d\sigma } {d\Omega }}} \right. \kern-0em} {d\Omega }})} \sigma }} \right. \kern-0em} \sigma }.$(5)
$\sigma = \int {({{d\sigma } \mathord{\left/ {\vphantom {{d\sigma } {d\Omega }}} \right. \kern-0em} {d\Omega }})d\Omega } = {{[\pi {{e}^{4}}Z(Z + 1)]} \mathord{\left/ {\vphantom {{[\pi {{e}^{4}}Z(Z + 1)]} {[4{{E}^{2}}\beta (\beta + 1)]}}} \right. \kern-0em} {[4{{E}^{2}}\beta (\beta + 1)]}},$Рис. 3.
Зависимость плотности вероятности вылета электронов из кремния под углом θ относительно их первоначального движения при E = 1 (1), 5 (2) и 30 кэВ (3).
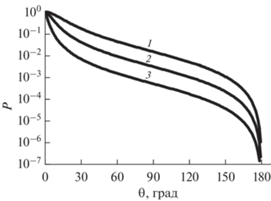
Хотя за счет однократного обратного упругого рассеяния электроны могут выйти из твердого тела и дать вклад во вторичную электронную эмиссию, однако вероятность такого процесса достаточно мала (рис. 3).
Большой вклад в ВЭЭ однократное упругое рассеяние может дать в экспериментах “на прострел”, когда ВЭ вылетают в направлении движения первичного пучка. Стоит отметить, что для этого вещество должно представлять собой тонкую пленку толщиной много меньше длины свободного пробега λ первичного электрона в веществе мишени, которую можно определить выражением для вещества сложного состава:
(6)
$\lambda = {{({{N}_{{\text{A}}}}\rho \sum {{{{{C}_{i}}{{\sigma }_{i}}} \mathord{\left/ {\vphantom {{{{C}_{i}}{{\sigma }_{i}}} {{{A}_{i}}}}} \right. \kern-0em} {{{A}_{i}}}}} )}^{{ - 1}}},$Рис. 4.
Зависимость длины свободного пробега от энергии электронов в кремнии (1), хроме (2) и золоте (3).
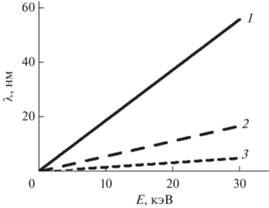
Таким образом, однократное упругое рассеяние электронов в толстых образцах (ВЭЭ “на прострел”) и под большими углами (ВЭЭ на отражение), для любых толщин дает малый вклад во вторичную электронную эмиссию.
Вклад однократного упругого обратного рассеяния электронов осуществляется в область спектра ВЭ 1 (рис. 2), и имеет вид узкого максимума шириной порядка Eme/MN, где E – энергия налетающего электрона, me – масса электрона, а MN – масса атомного ядра. Для кремния и энергии первичных электронов меньше 100 кэВ эта ширина имеет значение меньше 1 эВ. Ширина канала многоканальной системы регистрации электронов много больше ширины максимума резерфордовских электронов, а вероятность рассеяния электронов в обратную полусферу очень мала (рис. 3). Поэтому на экспериментально измеренных спектрах область спектра ВЭ 1 обычно не видна.
Кратное упругое рассеяние электронов. Кратное упругое рассеяние электронов занимает промежуточную область между однократным и многократным рассеянием [59]. Его нижняя граница представляет собой двукратное взаимодействие налетающего электрона с атомами вещества. Верхняя граница явно неопределена. Обычно за верхнюю границу кратного рассеяния принимают значение среднего числа упругих столкновений, равное 20 [59].
Условием возникновения вторичной электронной эмиссии за счет кратного рассеяния электронов является вылета электрона из вещества после нескольких актов однократного рассеяния (от 2 до 20). Теория кратного рассеяния электронов до настоящего времени не разработана, хотя существуют некоторые предложения для учета этого вида рассеяния [25]. Наиболее просто кратное рассеяние электронов можно учесть с помощью моделирования взаимодействия электронов с веществом по методу Монте-Карло.
Электрон, претерпевший кратное рассеяние, дает вклад в область спектра вторичных электронов 2 (рис. 2). Это обусловлено тем, что кратное упругое рассеяние электронов сопровождается потерями энергии за счет различных неупругих процессов.
Многократное упругое рассеяние электронов. Многократное упругое рассеяние электронов отличается от кратного практически только тем, что количество актов рассеяния настолько большое, что удается получить формулы, позволяющие проводить достаточно точные расчеты этого вида рассеяния [58, 59]. В работе [59] приведен краткий обзор теоретических и экспериментальных результатов исследования многократного упругого рассеяния электронов. В качестве теории многократного рассеяния (среднее число соударений n > 20) использована теория Мольера [59], справедливая для не очень больших средних углов многократного рассеяния электронов $\bar {\theta }$ < 20°.
Согласно Мольеру [59] число соударений n можно определить из выражения
(7)
$\begin{gathered} {\text{lg}}{\kern 1pt} n = 8.215 + {\text{lg}}\left( {{{s{{\gamma }^{2}}} \mathord{\left/ {\vphantom {{s{{\gamma }^{2}}} {\left[ {A{{Z}^{{{2 \mathord{\left/ {\vphantom {2 3}} \right. \kern-0em} 3}}}}(1.13 + 376{{\gamma }^{2}})} \right]}}} \right. \kern-0em} {\left[ {A{{Z}^{{{2 \mathord{\left/ {\vphantom {2 3}} \right. \kern-0em} 3}}}}(1.13 + 376{{\gamma }^{2}})} \right]}}} \right), \\ \gamma = {{\alpha Z} \mathord{\left/ {\vphantom {{\alpha Z} \beta }} \right. \kern-0em} \beta },\,\,\,\,\beta = {{v} \mathord{\left/ {\vphantom {{v} {c,}}} \right. \kern-0em} {c,}} \\ \end{gathered} $(8)
$\begin{gathered} {{P}_{{\text{M}}}}(\theta )2\pi d\theta = \\ = (2{\text{exp}}( - {{\vartheta }^{2}}) + {{{{F}_{1}}(\vartheta )} \mathord{\left/ {\vphantom {{{{F}_{1}}(\vartheta )} B}} \right. \kern-0em} B} + {{{{F}_{2}}(\vartheta )} \mathord{\left/ {\vphantom {{{{F}_{2}}(\vartheta )} {{{B}^{2}}}}} \right. \kern-0em} {{{B}^{2}}}} + \ldots )\vartheta d\vartheta , \\ \vartheta = {\theta \mathord{\left/ {\vphantom {\theta {[\chi {{B}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}]}}} \right. \kern-0em} {[\chi {{B}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}]}}, \\ \chi ({\text{град}}) = {{[44.8Z{{{\left( {{s \mathord{\left/ {\vphantom {s A}} \right. \kern-0em} A}} \right)}}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}]} \mathord{\left/ {\vphantom {{[44.8Z{{{\left( {{s \mathord{\left/ {\vphantom {s A}} \right. \kern-0em} A}} \right)}}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}]} {\left[ {{{(E + {{m}_{{\text{e}}}}{{c}^{2}})} \mathord{\left/ {\vphantom {{(E + {{m}_{{\text{e}}}}{{c}^{2}})} {({{m}_{{\text{e}}}}{{c}^{2}})}}} \right. \kern-0em} {({{m}_{{\text{e}}}}{{c}^{2}})}}} \right.}}} \right. \kern-0em} {\left[ {{{(E + {{m}_{{\text{e}}}}{{c}^{2}})} \mathord{\left/ {\vphantom {{(E + {{m}_{{\text{e}}}}{{c}^{2}})} {({{m}_{{\text{e}}}}{{c}^{2}})}}} \right. \kern-0em} {({{m}_{{\text{e}}}}{{c}^{2}})}}} \right.}} - \\ \left. { - \,\,{{({{m}_{{\text{e}}}}{{c}^{2}})} \mathord{\left/ {\vphantom {{({{m}_{{\text{e}}}}{{c}^{2}})} {(E + {{m}_{{\text{e}}}}{{c}^{2}})}}} \right. \kern-0em} {(E + {{m}_{{\text{e}}}}{{c}^{2}})}}} \right]. \\ \end{gathered} $(9)
$\bar {\theta } = {{\pi \chi {{B}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}} \mathord{\left/ {\vphantom {{\pi \chi {{B}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}} 2}} \right. \kern-0em} 2}\left( {1 + {{0.982} \mathord{\left/ {\vphantom {{0.982} B}} \right. \kern-0em} B} + {{0.117} \mathord{\left/ {\vphantom {{0.117} {{{B}^{2}}}}} \right. \kern-0em} {{{B}^{2}}}} + \ldots } \right).$Таблица 1.
Табулированные значения параметра B в зависимости от числа рассеяний n
| lg n | 1 | 2 | 3 | 4 | 5 | 6 | 7 | 8 | 9 |
|---|---|---|---|---|---|---|---|---|---|
| B | 3.36 | 6.29 | 8.93 | 11.49 | 13.99 | 16.46 | 18.90 | 21.32 | 23.71 |
Таблица 2.
Табулированные значения функций F1(ϑ) и F2(ϑ)
| ϑ | F1(ϑ) | F2(ϑ) |
|---|---|---|
| 0.0 | 0.8456 | 2.49 |
| 0.2 | 0.700 | 2.07 |
| 0.4 | 0.343 | 1.05 |
| 0.6 | –0.073 | –0.003 |
| 0.8 | –0.306 | –0.606 |
| 1.0 | –0.528 | –0.636 |
| 1.2 | –0.477 | –0.305 |
| 1.4 | –0.318 | 0.052 |
| 1.6 | –0.147 | 0.243 |
| 1.8 | 0.000 | 0.238 |
| 2.0 | 0.080 | 0.131 |
| 2.2 | 0.106 | 0.020 |
| 2.4 | 0.101 | –0.046 |
| 2.6 | 0.082 | –0.064 |
| 2.8 | 0.062 | –0.055 |
| 3.0 | 0.045 | –0.036 |
| 3.2 | 0.033 | –0.019 |
| 3.5 | 0.0206 | 0.0052 |
| 4 | 0.0105 | 0.0011 |
| 5 | 3.82 × 10–3 | 0.836 × 10–3 |
| 6 | 1.74 × 10–3 | 0.345 × 10–3 |
| 7 | 0.91 × 10–3 | 0.157 × 10–3 |
Сравнение результатов теории Мольера и эксперимента, приведенное в работе [59], показало их хорошее совпадение в той области, где применение теории Мольера обосновано. Кроме того, из выражения (8) следует, что при не очень больших углах θ (<20°) достаточно хорошо работает приближение квадратично-экспоненциальной зависимости плотности вероятности рассеяния электрона на угол θ.
Аналогичная квадратично-экспоненциальная зависимость была получена и в работе [64], где приведено выражение для пространственного распределения плотности вероятности многократного рассеяния электронов в однокомпонентном веществе, полученное с использованием уравнения Больцмана,
(10)
$P(r,z) = {{[3\Lambda {\text{exp}}{{([ - 3\Lambda {{r}^{2}}]} \mathord{\left/ {\vphantom {{([ - 3\Lambda {{r}^{2}}]} {[4{{z}^{3}}]}}} \right. \kern-0em} {[4{{z}^{3}}]}})} \mathord{\left/ {\vphantom {{[3\Lambda {\text{exp}}{{([ - 3\Lambda {{r}^{2}}]} \mathord{\left/ {\vphantom {{([ - 3\Lambda {{r}^{2}}]} {[4{{z}^{3}}]}}} \right. \kern-0em} {[4{{z}^{3}}]}})} {[4\pi {{z}^{3}}].}}} \right. \kern-0em} {[4\pi {{z}^{3}}].}}$(11)
$\begin{gathered} \Lambda ({\text{нм}}) = \\ = {{[5.12 \times {{{10}}^{{ - 4}}}{{E}^{2}}A]} \mathord{\left/ {\vphantom {{[5.12 \times {{{10}}^{{ - 4}}}{{E}^{2}}A]} {\left[ {\rho {{Z}^{2}}{\text{ln(}}{{0.725{{E}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}} \mathord{\left/ {\vphantom {{0.725{{E}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}} {{{Z}^{{{1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}}}}} \right. \kern-0em} {{{Z}^{{{1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}}}}{\text{)}}} \right],}}} \right. \kern-0em} {\left[ {\rho {{Z}^{2}}{\text{ln(}}{{0.725{{E}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}} \mathord{\left/ {\vphantom {{0.725{{E}^{{{1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}}}}} {{{Z}^{{{1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}}}}} \right. \kern-0em} {{{Z}^{{{1 \mathord{\left/ {\vphantom {1 3}} \right. \kern-0em} 3}}}}}}{\text{)}}} \right],}} \\ \end{gathered} $Отметим, что в разных работах величину Λ называют по-разному. Например, в [60] она называется длина потерь импульса, в [58] – средняя длина свободного пробега.
В соответствии с выражением (10) пучок электронов радиуса r0, имеющий первоначальное квадратично-экспоненциальное распределение электронов по радиусу, после прохождения пленки толщиной d будет иметь также квадратично-экспоненциальное распределение с радиусом пучка, определяемым выражением [64]
(12)
$r_{{\text{d}}}^{2} = r_{0}^{2} + {{4{{d}^{3}}} \mathord{\left/ {\vphantom {{4{{d}^{3}}} {[3\Lambda ].}}} \right. \kern-0em} {[3\Lambda ].}}$Метод Монте-Карло также позволяет достаточно просто учесть многократное рассеяние электронов в веществах сложного состава и формы. Однако в связи с тем, что обычно одновременно с упругим рассеянием происходят неупругие потери энергии электроном, то отдельно упругое многократное рассеяние в методе Монте-Карло не используется.
Вклад в спектр вторичных электронов многократно рассеянные электроны дают в область 2 (рис. 2). Это связано с тем, что многократное рассеяние электронов сопровождается неупругими потерями, приводящими к значительному изменению энергии первичного электрона.
Диффузия электронов. При больших средних углах рассеяния $\bar {\theta }$ > 60° (cos $\bar {\theta }$ < 0.5) [59, 65] наступает диффузионная стадия рассеяния электронов. Соответствующая теория была разработана Бете [65]. Согласно Бете, угловое распределение электронов в области диффузии можно представить в виде
(13)
${{{{P}_{{\text{D}}}}(\theta )} \mathord{\left/ {\vphantom {{{{P}_{{\text{D}}}}(\theta )} {{{P}_{{\text{D}}}}(\theta = 0)}}} \right. \kern-0em} {{{P}_{{\text{D}}}}(\theta = 0)}} = (0.717 + {\text{cos}}{\kern 1pt} \theta ){\kern 1pt} {\text{cos}}{\kern 1pt} \theta .$При рассмотрении диффузионной стадии рассеяния электронов необходимо помнить, что диффузия наступает при практически полной потере электроном его первоначальной энергии путем неупругих столкновений электронов с атомами рассеивающего вещества. Поэтому вклад диффузионных электронов в спектр вторичных электронов (рис. 2) осуществляется в область спектра 3.
Энергетические потери электронов
При прохождении через вещество электрон теряет свою энергию. Различают два вида таких потерь. Один из них связан с упругим рассеянием электронов на атомах вещества. Этот вид энергетических потерь очень мал из-за большой разности масс электрона и атомного ядра. Другой вид потерь энергии связан с неупругим взаимодействием налетающего электрона с рассеивающими атомами, которое приводит к возбуждению атомов или их ионизации по разным механизмам, возникновению тормозного излучения электронов и характеристического излучения возбужденных атомов облучаемого вещества.
Однако возможны еще два эффекта генерации вторичных электронов. Это двухступенчатые процессы. На первом этапе образуется квант электромагнитного излучения, а на втором этапе фотон генерирует вторичный электрон за счет фото- или комптон-эффекта. Теории этих вторичных эффектов хорошо разработаны, что позволяет проводить расчеты двухступенчатых процессов с достаточно высокой точностью. Вклад этих эффектов в спектр вторичных электронов (рис. 2) осуществляется в область спектра 2.
Ионизационные потери электронов. Основной вклад в энергетические потери электронов при энергии первичных электронов меньше 100 кэВ дают ионизационные потери [59, 60]. Для вещества сложного состава эти потери описываются в первом борновском приближении формулой Бете, которую запишем в виде [60]
(14)
${{dE} \mathord{\left/ {\vphantom {{dE} {dX}}} \right. \kern-0em} {dX}} = {{2\pi {{e}^{4}}\rho {{N}_{{\text{A}}}}} \mathord{\left/ {\vphantom {{2\pi {{e}^{4}}\rho {{N}_{{\text{A}}}}} {E\sum {{{C}_{i}}{{Z}_{i}}} }}} \right. \kern-0em} {E\sum {{{C}_{i}}{{Z}_{i}}} }}{{{\text{ln}}\left( {{{1.166E} \mathord{\left/ {\vphantom {{1.166E} {{{J}_{i}}}}} \right. \kern-0em} {{{J}_{i}}}}} \right)} \mathord{\left/ {\vphantom {{{\text{ln}}\left( {{{1.166E} \mathord{\left/ {\vphantom {{1.166E} {{{J}_{i}}}}} \right. \kern-0em} {{{J}_{i}}}}} \right)} {{{A}_{i}},}}} \right. \kern-0em} {{{A}_{i}},}}$Необходимо отметить, что обычно в формуле Бете используют знак минус (“–”) для указания того, что формула описывает именно потери энергии электроном. Однако, такое представление приводит к ряду трудностей при иллюстрации данной зависимости, появлению особенностей в написании формул, использующих для расчетов ионизационные потери электронов, а также к появлению двусмысленностей при описании потерь энергии. Поэтому предлагается устранить все эти трудности и противоречия и использовать для описания энергетических потерь формулу Бете в виде (14) (без знака минус).
На рис. 5 приведена зависимость dE/dX (по формуле (14)) от энергии E налетающего электрона (рис. 5а при E < 3 кэВ; рис. 5б при 1 кэВ < E < < 30 кэВ) для трех веществ: кремния, хрома и золота (кривые 1, 2 и 3 соответственно). При E больше 10 кэВ энергетические потери для кремния лежат в диапазоне 1.6–4.0 эВ/нм (именно потери энергии, а не приобретение энергии). Используя эти данные, получим, что на длине свободного пробега электрона в кремнии его средние ионизационные потери равны 74–85 эВ. Это составляет около 50% от среднего ионизационного потенциала кремния.
Рис. 5.
Зависимость ионизационных потерь электронов от их энергии E для кремния (1), хрома (2) и золота (3) в областях энергий E < 3 кэВ (а) и E < 30 кэВ (б).
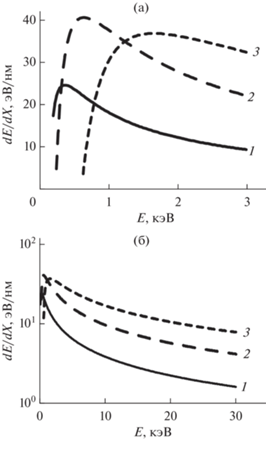
Таким образом, при E больше 10 кэВ в среднем на каждые два акта упругого рассеяния первичного электрона в кремнии в результате ионизации генерируется один электрон, который дает вклад в области 2 и 3 спектра вторичных электронов (рис. 2).
Пробеги электронов в веществе. Пробег электрона в веществе практически полностью определяется его ионизационными потерями. Однако в силу сложного характера движения электрона не существует однозначного определения величины пробега. В работе [66] получена эмпирическая функция распределения электронов в мишени по глубине z:
(16)
${{n}_{{\text{e}}}}\left( z \right) = m{{z}^{{m{\kern 1pt} - {\kern 1pt} 1}}}{\text{exp}}{{( - {{{\left[ {{z \mathord{\left/ {\vphantom {z {{{z}_{0}}}}} \right. \kern-0em} {{{z}_{0}}}}} \right]}}^{m}})} \mathord{\left/ {\vphantom {{( - {{{\left[ {{z \mathord{\left/ {\vphantom {z {{{z}_{0}}}}} \right. \kern-0em} {{{z}_{0}}}}} \right]}}^{m}})} {z_{0}^{m},}}} \right. \kern-0em} {z_{0}^{m},}}$(17)
${{z}_{0}} = {{{{R}_{z}}} \mathord{\left/ {\vphantom {{{{R}_{z}}} {\Gamma \left( {{1 \mathord{\left/ {\vphantom {1 {m + 1}}} \right. \kern-0em} {m + 1}}} \right).}}} \right. \kern-0em} {\Gamma \left( {{1 \mathord{\left/ {\vphantom {1 {m + 1}}} \right. \kern-0em} {m + 1}}} \right).}}$(18)
${{R}_{z}} = {{40{{E}^{{1.6}}}} \mathord{\left/ {\vphantom {{40{{E}^{{1.6}}}} {\rho .}}} \right. \kern-0em} {\rho .}}$Величина Rz, определяемая формулой (18), получила название глубины остановки электронов. Она не совпадает с максимумом распределения, который достигается на глубине:
(19)
${{z}_{m}} = {{z}_{0}}({{[m - {{1]} \mathord{\left/ {\vphantom {{1]} m}} \right. \kern-0em} m})}^{{{1 \mathord{\left/ {\vphantom {1 m}} \right. \kern-0em} m}}}}.$На рис. 6 приведены примеры распределения электронов по глубине в кремнии, хроме и золоте при E = 20 кэВ (рис. 6а, кривые 1, 2 и 3 соответственно) и в кремнии при E = 10, 20 и 30 кэВ (рис. 6б, кривые 1, 2 и 3 соответственно). Во всех случаях число электронов, достигающих глубин в несколько мкм, очень мало. Это означает, что при толщинах пленок больше этих значений вклад во вторичную электронную эмиссию возможен только на отражение.
Рис. 6.
Распределение замедлившихся электронов по глубине для кремния, хрома и золота (кривые 1, 2 и 3 соответственно) при E = 20 кэВ (а) и для кремния (б) при энергиях E = 10 (1); 20 (2) и 30 кэВ (3).
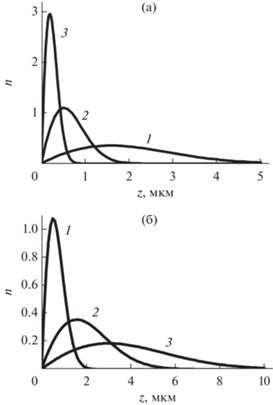
Одновременный учет упругого рассеяния электронов и их неупругих потерь в веществе достаточно сложен. Существует ряд работ, в которых делают попытки аналитического решения этой задачи для целей электронной литографии. Обзор таких работ можно найти в [60]. Однако эту задачу решить достаточно просто в случае использования моделирования процесса взаимодействия электронов с твердым телом по методу Монте-Карло (например, [60, 67]). Как показывает моделирование, траектории движения электронов в твердом теле имеют сложную форму. В связи с этим существует несколько определений пробега электрона в веществе.
Пробегом Бете называют величину
(20)
${{R}_{{\text{B}}}} = \int\limits_0^E {{{dE} \mathord{\left/ {\vphantom {{dE} {\left[ {{{dE} \mathord{\left/ {\vphantom {{dE} {dX}}} \right. \kern-0em} {dX}}} \right],}}} \right. \kern-0em} {\left[ {{{dE} \mathord{\left/ {\vphantom {{dE} {dX}}} \right. \kern-0em} {dX}}} \right],}}} $(21)
${{R}_{{\text{G}}}} = {{40{{E}^{{1.75}}}} \mathord{\left/ {\vphantom {{40{{E}^{{1.75}}}} \rho }} \right. \kern-0em} \rho }$(22)
$R = {{100{{E}^{{1.43}}}} \mathord{\left/ {\vphantom {{100{{E}^{{1.43}}}} \rho }} \right. \kern-0em} \rho }.$Кроме этих величин введены определение глубины полной диффузии [68]:
(23)
${{R}_{{\text{D}}}} = {{40{{R}_{{\text{B}}}}} \mathord{\left/ {\vphantom {{40{{R}_{{\text{B}}}}} {[7Z],}}} \right. \kern-0em} {[7Z],}}$Рис. 7.
Распределение замедлившихся в кремнии электронов с энергиями 10 кэВ (а) и 30 кэВ (б). Вертикальными линиями показаны величины различных пробегов электронов при этих энергиях.

На рис. 8 приведены зависимости пробега электронов в кремнии от начальной энергии электронов. Штриховая линия на рис. 8а указывают границу 1 мкм. Эта граница разделяет шкалу энергий первичных электронов на две части – ниже 7–10 кэВ и выше 10 кэВ. В нижней области энергий рельеф поверхности с высотой менее 1 мкм очень сильно влияет на движение электронов в твердом теле. В области энергий падающего электрона более 10 кэВ влияние такого рельефа на движение электронов внутри твердого тела, но не в приповерхностной зоне, мало. Штриховая линия на рис. 8б обозначает границу 4.7 нм. Это толщина слоя кремния, из которого выходят медленные ВЭ (более подробно об этом будет сказано ниже).
Рис. 8.
Зависимости пробега электронов в кремнии от начальной энергии электронов. Штриховыми линиями показаны значения 1 мкм (а) и 4.7 нм (б).
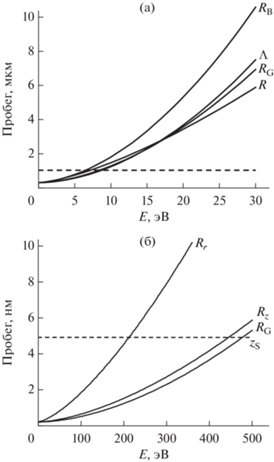
Обратное рассеяние электронов играет важную роль в прикладном применении ВЭЭ, особенно в электронной литографии и растровой электронной микроскопии. Однако рассмотрение этого вопроса представляет собой довольно сложную задачу, что связано с требованием одновременного учета однократного, кратного и многократного упругих рассеяний электронов вместе с процессами, ответственными за потери энергии электронами. Кроме того, необходимо учитывать еще и диффузию электронов в твердом теле. Однако все существующие в настоящее время теоретические модели дают разумные результаты только в ограниченных областях изменения своих параметров. Причем эти области не пересекаются, что требует введения дополнительных неясных с физической точки зрения параметров, “сшивающих” результаты разных моделей.
Наиболее просто решить задачу обратного рассеяния электронов можно с помощью моделирования по методу Монте-Карло [60, 67]. Этот метод [69], по существу, представляет собой численный эксперимент, отличающийся от реального эксперимента только тем, что в него заложен модельный, а не реально существующий механизм взаимодействия электрона с веществом. В случае, если обнаружится расхождение расчетов и эксперимента, то в методе Монте-Карло очень просто ввести модификацию взаимодействия, не меняя саму схему расчета. Поэтому метод Монте-Карло получил достаточно широкое применение при решении задач электронной литографии [60, 67] и растровой электронной микроскопии.
Одним из важных параметров обратного рассеяния является коэффициент отражения (обратного рассеяния) электронов γB. В работе [70] он был рассчитан с помощью моделирования по методу Монте-Карло. На рис. 9 приведены зависимости этого коэффициента от атомного номера (рис. 9а) и энергии налетающего электрона (рис. 9б). В диапазоне энергий 10–30 кэВ γB не зависит от энергии электрона и определяется только видом рассеивающего вещества, достигая значений 0.1–0.5 (рис. 9а) для разных веществ. Вклад обратно рассеянных электронов в спектр вторичных (рис. 2) осуществляется в основном в область спектра 2.
Рис. 9.
Зависимости коэффициента обратного рассеяния от атомного номера (а) и энергии налетающего электрона при Z = 6 (1); 14 (2); 22 (3); 29 (4); 47 (5); 92 (6) (б).

Кроме эффекта ионизации атома, связанного с неупругими потерями энергии электроном, существуют реакции более сложной эмиссии электрона из атома. К ним относятся эффект Оже [61] и так называемая (e,2e)-реакция [71] – прямое выбивание атомарного электрона налетающим электроном. В результате обеих этих реакций атом испускает электроны с фиксированной энергией, определяемой не только строением конкретного атома, но и строением конкретной молекулы, в которую этот атом входит. Вклад таких электронов идет в область спектра 2 (рис. 2).
Потери энергии электроном за счет тормозного излучения. Изменение направления движения или уменьшение скорости заряженной частицы сопровождается испусканием электромагнитного излучения, названного тормозным. Теория этого процесса в первом борновском приближении была создана Гайтлером [72]. При энергиях электронов меньше 100 кэВ тормозное излучение называется рентгеновским. В настоящее время теория процесса тормозного излучения разработана достаточно хорошо [72, 73], что позволяет проводить расчеты эффектов, связанных с тормозным излучением, с любой точностью.
Роль ВЭ в эффекте тормозного излучения играет первичный электрон, испустивший тормозной фотон. Такие электроны дают вклад в область 2 спектра ВЭ (рис. 2).
Потери энергии электроном за счет образования характеристического излучения атомов. Кроме тормозного (с непрерывным спектром) излучения в рентгеновском диапазоне при взаимодействии электрона с веществом образуется характеристическое (с дискретным спектром) рентгеновское излучение. Этот эффект используют в растровой электронной микроскопии для локального анализа состава вещества [1–5]. Роль ВЭ в эффекте испускания характеристического излучения играют первичный электрон, потерявший часть энергии, и электрон, испущенный атомом, который получил эту энергию. Вторичные электроны, образованные с помощью такого механизма, дают вклад в область 2 спектра ВЭ (рис. 2).
ВТОРИЧНЫЕ ЭЛЕКТРОНЫ В РАСТРОВОЙ ЭЛЕКТРОННОЙ МИКРОСКОПИИ
Исследование конкретных механизмов генерации ВЭ обычно производят с помощью конкретных методов и приборов, отличных друг от друга. Однако есть и общие методы, которые не различают отдельные механизмы. К таким методам относится регистрация ВЭ в растровом электроном микроскопе. Дело в том, что детекторы РЭМ не измеряют энергию регистрируемых электронов, которая определяет конкретный механизм генерации вторичных электронов. Но конструкции детекторов [2, 5] позволяют определять в какую область спектра вторичных электронов входят регистрируемые конкретным детектором электроны.
Были разработаны приставки к растровым электронным микроскопам [74], которые измеряют спектры вторичных электронов. Однако широкого распространения такие приставки не получили.
Обратно рассеянные и вторичные медленные электроны
Обратно рассеянными электронами называют все электроны, дающие вклад в области 1 и 2 спектра ВЭ [1, 20] (рис. 2), независимо от их природы, в то время как медленные ВЭ дают вклад только в третью область [1, 20]. Такое разделение имеет и другие обоснования. Например, обратно рассеянные и вторичные медленные электроны вылетают в вакуум с разных глубин. Так обратно рассеянные электроны могут вылетать с глубины до нескольких мкм (рис. 6). В то время как вторичные медленные электроны не могут проходить большие расстояния в веществе. Обычно глубину выхода вторичных медленных электронов принимают равной 1–10 нм [21]. В работе [21] приведено выражение для вычисления этой глубины:
(24)
${{z}_{{\text{S}}}} = {{1.9A{{Z}^{{ - 0.6}}}} \mathord{\left/ {\vphantom {{1.9A{{Z}^{{ - 0.6}}}} \rho }} \right. \kern-0em} \rho },$На рис. 8б эта граница нанесена на графике зависимости от энергии пробега электронов в кремнии. Хорошо видно, что при энергиях ниже 200–400 эВ пробег всех электронов лежит в пределах глубины выхода вторичных медленных электронов. Поэтому контраст изображения, получаемый за счет ионизации атомов вещества исследуемого образца, при этих энергиях первичных электронов должен отсутствовать, так как вся энергия, потерянная первичными электронами, которая определяет количество вторичных медленных электронов, остается в пределах этого слоя. Однако эксперименты в РЭМ с первичными электронами, имеющими энергию 200 эВ, показали, что контраст присутствует [75].
На рис. 10 приведено изображение в РЭМ выступа в кремнии с трапециевидным профилем и большими углами наклона боковых стенок (относительно нормали к поверхности образца), полученное при энергии электронов зонда 200 эВ. Хорошо видно, что контраст изображения рельефа присутствует. Это обусловлено тем, что кроме ионизационных электронов вклад в контраст осуществляют и электроны, полученные за счет “стряхивания” электронов из поверхностных электронных состояний [20, 62, 63], так как порог этого эффекта составляет ~0.3 эВ.
Рис. 10.
Изображение в РЭМ при энергии электронов зонда 200 эВ выступа с трапециевидным профилем и большими углами наклона боковых стенок.
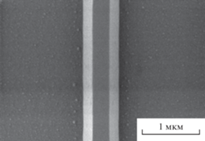
Одним из основных свойств ВЭЭ является ее зависимость от угла падения первичных электронов на поверхность твердого тела φ и от угла вылета ВЭ из вещества θ.
Оба эти типа рассмотрены в научной литературе отдельно для обратно рассеянных электронов и вторичных медленных электронов. Например, в работах [58, 76] приведены зависимости коэффициента отражения электронов γB(φ) для кремния, меди и золота (рис. 11, кривые 1, 2 и 3 соответственно). Для зависимость коэффициента генерации вторичных медленных электронов γL(φ) можно представить в виде [77]:
(25)
${{\gamma }_{L}} = {{{{\gamma }_{L}}(\varphi = 0)} \mathord{\left/ {\vphantom {{{{\gamma }_{L}}(\varphi = 0)} {{\text{cos}}{\kern 1pt} \varphi {\kern 1pt} .}}} \right. \kern-0em} {{\text{cos}}{\kern 1pt} \varphi {\kern 1pt} .}}$Рис. 11.
Зависимости коэффициента обратного рассеяния от угла падения φ первичных электронов для кремния (1), меди (2) и золота (3).
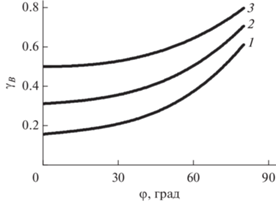
Угловое распределение обратно рассеянных электронов γB(θ) можно аппроксимировать синусоидальной зависимостью [57] при нормальном падении первичных электронов. Для вторичных медленных электронов зависимость γL(θ) ближе всего к косинусоидальной [77, 78]. Экспериментальные исследования угловых зависимостей были выполнены в работах [79, 80].
Деление ВЭ на обратно рассеянные и медленные, кроме всего прочего, позволяет легко экспериментально разделить их вклады в ВЭЭ. Так вторичные медленные электроны можно отсечь введением вещества-поглотителя, которое полностью устраняет эти электроны, или с помощью задерживающего потенциала величиной до 50 В. Вторичные медленные электроны можно сфокусировать на детекторе путем подачи на детектор или образец потенциала величиной до нескольких сотен В. Следует отметить, что этот потенциал практически не искажает движение обратно рассеянных электронов, что не меняет вероятность их регистрации. То есть удается разделить вклады в регистрируемый сигнал от обратно рассеянных и вторичных медленных электронов.
Измерение спектра вторичных электронов
Схематичный спектр обратно рассеянных ВЭ приведена на рис. 2. Существует ряд работ, в которых был измерен реальный спектр ВЭ. Так в работе [74] была описана установка (приставка для РЭМ) для измерения спектра ВЭ. Однако такие приставки серийно не выпускают. Поэтому их применение имеет достаточно малую область использования в растровой электронной микроскопии.
ЭФФЕКТ МЁЛЛЕРА
При взаимодействии первичных электронов с веществом обычно учитывают упругое рассеяние и неупругие потери энергии. Упругое рассеяние описывается как рассеяние электрона на атомном ядре (выражения (2)–(6)). А неупругие потери энергии – как ионизацию атомов вещества (выражение (14)). Однако, есть один механизм, который объединяет оба процесса – упругое рассеяние и потери энергии первичным электроном. Это эффект Мёллера (C. Møller) [81]. Он заключается в упругом рассеянии электрона на свободном электроне.
Дело в том, что во многих веществах кроме атомарных электронов есть электроны, которые считают свободными (обобществленными). К таким веществам относятся металлы и электронные полупроводники. Если в электронных полупроводниках свободных электронов очень мало (на 5–7 порядков меньше количества атомов в веществе: 1015–1017 электронов в кубическом сантиметре против 1022 атомов, в которых от 3 до 90 атомарных электронов), то в металлах свободных электронов очень много. На каждый атом приходится от 1 до 4 свободных электронов (зависит от вида металла). Кроме того, после каждого рассеяния Мёллера один движущийся электрон заменяется на два движущихся электрона, которые участвуют в следующих рассеяниях Мёллера. Это приводит к геометрическому возрастанию количества ВЭ, которые дают вклад в области 2 и 3 спектра ВЭ (рис. 2). Поэтому эффект Мёллера необходимо учитывать при формировании изображения в растровой электронной микроскопии.
В нерелятивистском пределе, который реализуется в РЭМ, в первом борновском приближении дифференциальное сечение меллеровского рассеяния имеет вид:
(26)
$\begin{gathered} {{d{{\sigma }_{{\text{M}}}}} \mathord{\left/ {\vphantom {{d{{\sigma }_{{\text{M}}}}} {d\Omega }}} \right. \kern-0em} {d\Omega }} = {{{{e}^{4}}} \mathord{\left/ {\vphantom {{{{e}^{4}}} {{{{[16\pi {{m}_{{\text{e}}}}{{{v}}^{2}}]}}^{2}}({1 \mathord{\left/ {\vphantom {1 {{\text{si}}{{{\text{n}}}^{4}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2}}}} \right. \kern-0em} {{\text{si}}{{{\text{n}}}^{4}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2}}})}}} \right. \kern-0em} {{{{[16\pi {{m}_{{\text{e}}}}{{{v}}^{2}}]}}^{2}}({1 \mathord{\left/ {\vphantom {1 {{\text{si}}{{{\text{n}}}^{4}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2}}}} \right. \kern-0em} {{\text{si}}{{{\text{n}}}^{4}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2}}})}} + \\ + \,\,{1 \mathord{\left/ {\vphantom {1 {{\text{co}}{{{\text{s}}}^{4}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2})}}} \right. \kern-0em} {{\text{co}}{{{\text{s}}}^{4}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2})}} - {1 \mathord{\left/ {\vphantom {1 {[{\text{si}}{{{\text{n}}}^{2}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2}){\kern 1pt} {\text{co}}{{{\text{s}}}^{2}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2})]),}}} \right. \kern-0em} {[{\text{si}}{{{\text{n}}}^{2}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2}){\kern 1pt} {\text{co}}{{{\text{s}}}^{2}}({\vartheta \mathord{\left/ {\vphantom {\vartheta 2}} \right. \kern-0em} 2})]),}} \\ \end{gathered} $Необходимо отметить, что сечение Резерфорда (формула (2)), которая является аналогом формулы Мёллера (выражение (26)), но без учета обменного взаимодействия, приведена для лабораторной системы координат, а сечение Мёллера (формула (26)) написано для системы центра масс. Поэтому углы рассеяния первичных электронов в формулах (2) и (26) разные – в разных системах координат.
ИСПОЛЬЗОВАНИЕ ЗАКОНОМЕРНОСТЕЙ ВТОРИЧНОЙ ЭЛЕКТРОННОЙ ЭМИССИИ
Представленные выше закономерности можно использовать для решения ряда проблем применения вторичной электронной эмиссии. Рассмотрим некоторые результаты такого применения.
Коэффициент вторичной электронной эмиссии
Зависимость коэффициента вторичной электронной эмиссии от энергии первичных электронов используют достаточно широко. Это фотоэлектронные умножители [82], микроканальные пластины [76] и электронные лампы [82, 83].
Упругое рассеяние и энергетические потери
Упругое рассеяние и потери энергии первичным электроном используют в основном для моделирования взаимодействия электронов с твердым телом методом Монте-Карло [1, 60, 84].
Пробеги электронов
Пробег электронов в твердом теле может быть использован для оценки эффектов ослабления электронных пучков при их прохождении через твердое тело и оценки влияния параметров рельефа (шаг, высота) на такое ослабление.
Эффект Мёллера
Эффект Мёллера в основном используют как простой пример применения квантовой электродинамики. В РЭМ эффект Меллера никогда не учитывали. Это связано с тем, что с точки зрения математики полное сечение резерфордовского рассеяния с учетом эффекта экранирования является конечным (формула (5)), а мёллеровского рассеяния – бесконечным. С точки зрения физики неучет эффекта Мёллера в растровой электронной микроскопии объясняется двумя причинами.
Во-первых, масса электрона в веществе (эффективная масса) не совпадает с массой покоя свободного электрона [85], которую используют при выводе формулы (26). Во-вторых, энергия свободного электрона в веществе не равна нулю в лабораторной системе координат, как это требуется для эффекта Мёллера. Энергия свободного электрона в металлах отрицательная [82] (работа выхода электрона положительная). Кроме того, за счет того, что электроны – это фермионы, то энергия электрона в лабораторной системе координат для каждого “свободного” электрона своя. Однако, в научной литературе учет таких поправок к эффекту Мёллера отсутствует. Это не позволяет использовать эффект Мёллера в растровой электронной микроскопии.
ВЫВОДЫ
Подводя итоги, можно сказать, что ВЭЭ изучена достаточно хорошо. Практически все ее закономерности проверены в экспериментах и получили свое физическое объяснение. Для большей их части созданы модели, позволяющие проводить расчеты с достаточно высокой точностью. Все это дает возможность использовать ВЭЭ в различных прикладных исследованиях, например, в растровой электронной микроскопии для изучения состава [1–5] или дефектности вещества [86–88], поверхностного потенциала [89–91], некоторых свойств рельефных поверхностей [1–5] и создания электронных устройств [82, 83]. Однако практически все исследования ВЭЭ проводили на “безрельефных” поверхностях. В то же время применение ВЭЭ в растровой электронной микроскопии, используемой в микро- и наноэлектронике и нанотехнологиях, требует знания закономерностей, которые проявляются именно на рельефных поверхностях. Поэтому требуется изучение влияния рельефа поверхности твердого тела на ВЭЭ.
Список литературы
Reimer L. Scanning Electron Microscopy: Physics of Image Formation and Microanalysis. Springer Berlin, Heidelberg, 1998. https://doi.org/10.1007/978-3-540-38967-5
Практическая растровая электронная микроскопия / Ред. Гоулдстейн Дж., Яковиц Х. Пер. с англ. М.: Мир, 1978. 656 с.
Гоулдстейн Дж., Ньюбери Д., Эчлин П., Джой Д., Фиори Ч., Лифшин Э. Растровая электронная микроскопия и рентгеновский микроанализ / Пер. с англ. М.: Мир, 1984. 303 с.
Микроанализ и растровая электронная микроскопия / Ред. Морис Ф. и др. Пер. с фр. М.: Металлургия, 1985. 392 с.
Криштал М.М., Ясников И.С., Полунин В.И., Филатов А.М., Ульяненков А.Г. Сканирующая электронная микроскопия и рентгеноспектральный микроанализ в примерах практического применения. М.: Техносфера, 2009. 208 с.
Растровая электронная микроскопия для нанотехнологий. Методы и применение. / Ред. Жу У., Уанг Ж.Л. Пер. с англ. М.: БИНОМ. Лаборатория знаний, 2013. 582 с.
International Technology Roadmap for Semiconductors. 2013 Edition. Metrology. 2013. 42 p.
Hatsuzawa T., Toyoda K., Tanimura Y. // Rev. Sci. Instrum. 1990. V. 61. № 3. P. 975.
Marchman H.M., Griffith J.E., Guo J.Z.Y., Frackoviak J., Celler G.K. // J. Vacuum Sci. Technol. 1994. V. B12. № 6. P. 3585.
Новиков Ю.А., Раков А.В. // Измерительная техника. 1999. № 1. С. 14.
Postek M.T., Vladar A.E. Critical dimension metrology and the scanning electron microscope / Handbook of Silicon Semiconductor Metrology. Ed. Diebold A.C. Marcel Dekker Inc. New York – Basel, 2001. P. 295.
Postek M.T. // Proc. SPIE. 2002. V. 4608. P. 84.
Постек М. // Вестник технического регулирования. 2007. № 7. С. 8.
Гавриленко В., Новиков Ю., Раков А., Тодуа П. // Наноиндустрия. 2009. № 4. С. 36.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7405. P. 740504. https://doi.org/10.1117/12.826164
Тодуа П.А., Быков В.А., Волк Ч.П., Горнев Е.С., Желкобаев Ж., Зыкин Л.М., Ишанов А.Б., Календин В.В., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Прохоров А.М., Раков А.В., Саунин С.А., Черняков В.Н. // Микросистемная техника. 2004. № 3. С. 25.
Gavrilenko V.P., Kalnov V.A., Novikov Yu.A., Orlikovsky A.A., Rakov A.V., Todua P.A., Valiev K.A., Zhikharev E.N. // Proc. SPIE. 2009. V. 7272. P. 727227. https://doi.org/10.1117/12.814062
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A., Volk Ch.P. // Proc. SPIE. 2009. V. 7272. P. 72720Z. https://doi.org/10.1117/12.813514
Новиков Ю.А. // Микроэлектроника. 2017. Т. 46. № 1. С. 61. https://doi.org/10.7868/S0544126917010070
Новиков Ю.А., Раков А.В. // Труды ИОФАН. 1998. Т. 55. С. 3.
Бронштейн И.М., Фрайман Б.С. Вторичная электронная эмиссия. М.: Наука, 1969. 407 с.
Шульман А.З., Фридрихов С.А. Вторично-эмиссионные методы исследования твердого тела. М.: Наука, 1977. 551 с.
Модинос А. Авто-, термо и вторично-электронная эмиссионная спектроскопия. М.: Наука, 1990. 320 с.
Герус В.Л. Физические основы электронно-лучевых приборов. М.: Наука, 1993. 352 с.
Корнюшкин Ю.Д. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 1992. № 9. С. 27.
Каничева И.Р., Павлова А.А. // Физика твердого тела. 1966. Т. 8. № 5. С. 1641.
Лорикян М.П., Ковалов З.Д., Трофимчук Н.Н. // Радиотехника и электроника. 1969. Т. 14. № 5. С. 935.
Бушкевич В.Г., Бутслов М.М. // Радиотехника и электроника. 1958. Т. 3. № 3. С. 355.
Каничева И.Р., Бурцев В.А. // Физика твердого тела. 1959. Т. 1. № 8. С. 1250.
Вятский А.Я., Трунев В.В. // Радиотехника и электроника. 1967. Т. 12. № 9. С. 1636.
Гомоюнова М.В., Алиев Б.З. // Физика твердого тела. 1969. Т. 11. № 12. С. 3619.
Шульман А.Р., Кораблев В.В., Морозов Ю.А. // Физика твердого тела. 1970. Т. 12. № 2. С. 666.
Шульман А.Р., Кораблев В.В., Морозов Ю.А. // Физика твердого тела. 1970. Т. 12. № 3. С. 758.
Морозов Ю.А., Осарков Е.Б. // Физика твердого тела. 1971. Т. 13. № 7. С. 2051.
Бронштейн И.М., Броздниченко А.Н. // Радиотехника и электроника. 1969. Т. 14. № 2. С. 1528.
Афонина А.Ф., Воробьева О.Б., Климин А.И., Стучинский Г.Б. // Радиотехника и электроника. 1969. Т. 14. № 12. С. 2237.
Бронштейн И.М., Проценко А.И. // Радиотехника и электроника. 1970. Т. 15. № 9. С. 805.
Бронштейн И.М., Броздниченко А.Н. // Радиотехника и электроника. 1970. Т. 15. № 8. С. 1721.
Рашковский С.Ф. // Радиотехника и электроника. 1958. Т. 3. № 3. С. 371.
Бронштейн И.М., Сегаль Р.Б. // Физика твердого тела. 1959. Т. 1. № 8. С. 1247.
Рогаля Л.М. // Радиотехника и электроника. 1967. Т. 12. № 9. С. 1680.
Бронштейн И.М., Сегаль Р.Б. // Радиотехника и электроника. 1960. Т. 5. № 10. С. 1741.
Лепешинская В.Н., Борисов В.Л., Перчанак Т.М. // Радиотехника и электроника. 1960. Т. 5. № 10. С. 1636.
Шульман А.Р., Закирова И.Р., Морозов Ю.А., Фридрихов С.А. // Радиотехника и электроника. 1958. Т. 3. № 3. С. 329.
Фридрихов С.А., Шульман А.Р. // Физика твердого тела. 1959. Т. 1. № 8. С. 1259.
Фридрихов С.А., Шульман А.Р. // Физика твердого тела. 1959. Т. 1. № 8. С. 1268.
Зорин И.Е., Коган В.М., Абрамова Н.Н. // Радиотехника и электроника. 1981. Т. 26. № 4. С. 889.
Harrower G.A. // Physical Review. 1956. V. 104. № 1. P. 52.
Бронштейн И.М., Рощин В.В. // Журн. технической физики. 1958. Т. 28. № 10. С. 2200.
Бронштейн И.М., Рощин В.В. // Журн. технической физики. 1958. Т. 28. № 11. С. 2476.
Шульман А.Р., Ганичев Д.А. // Физика твердого тела. 1962. Т. 4. № 3. С. 745.
Шульман А.Р., Ганичев Д.А. // Физика твердого тела. 1960. Т. 2. № 3. С. 530.
Крылова И.В. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 1988. № 1. С. 5.
Фридрихов С.А. // Физика твердого тела. 1960. Т. 2. № 1. С. 171.
Фридрихов С.А., Горячева С.Н. // Известия АН СССР. Сер. физ. 1958. Т. 22. № 5. С. 486.
Вавилов В.С., Киселев В.Ф., Мукашев Б.Н. Дефекты в кремнии и на его поверхности. М.: Наука, 1990. 216 с.
Ковалев В.П. Вторичные электроны. М.: Энергоиздат, 1987. 177 с.
Броудай И., Мерей Дж. Физические основы микротехнологии. Пер. с англ. М.: Мир, 1985. 496 с.
Бета- и гамма-спектроскопия / Ред. Зигбан К. Пер. с англ. М.: Государственное издательство физико-математической литературы, 1959.
Валиев К.А. Физика субмикронной литографии. М.: Наука, 1990. 528 с.
Методы анализа поверхностей. / Ред. Зандерна А. Пер. с англ. М.: Мир, 1979. 582 с.
Новиков Ю.А., Прохоров А.М., Раков А.В. // Поверхность. Физика, химия, механика. 1993. № 3. С. 22.
Новиков Ю.А., Раков А.В. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 1999. № 8. С. 24.
Nosker R.W. // J. Appl. Phys. 1969. V. 40. P. 1872.
Bethe H.A., Rose M.E., Smith H.I. // Proc. Am. Philosophical Soc. 1938. V. 78. P. 573.
Махов А.Ф. // Физика твердого тела. 1960. Т. 2. № 9. С. 2172.
Валиев К.А., Кириллов А.Н., Ковтун Б.Н., Махвиладзе Т.М., Мкртчян М.М. // Труды ИОФАН. 1987. Т. 8. С. 5.
Reimer L. // Scanning Electron Microscopy. 1979. № 2. P. 111.
Ермаков С.М., Михайлов Г.А. Курс статистического моделирования. М.: Наука, 1976. 319 с.
Newbury D.E., Yakowitz H. // Proc. Workshop Held at the NBS. Gaithersburg: NBS. 1976. P. 15.
Хейфец А.С. // Журнал экспериментальной и теоретической физики. 1985. Т. 89. № 2. Вып. 8. С. 459.
Гайтлер В. Квантовая теория излучения. Пер. с англ. М.: Иностранная литература, 1956.
Шпольский Э.В. Атомная физика. Т. 1. М.: Наука, 1974. 575 с.
Аристов В.В., Дремова Н.Н., Рау Э.И. // Журн. технической физики. 1996. Т. 66. № 10. С. 78.
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 5. С. 373. https://doi.org/10.7868/S0544126914050068
Postek M.T., Keery W.J., Frederick N.V. // Rev. Sci. Instrum. 1990. V. 61. № 6. P. 1648.
Kanter H. // Annals of Physics. 1957. V. 20. P. 144.
Hachenberg O., Brauer W. // Adv. Electronics Electron Phys. 1959. V. 11. P. 413.
Борисов В.Л., Перчанок Т.М., Лепешинская В.Н. // Радиотехника и электроника. 1960. Т. 5. № 10. С. 1643.
Сотников В.М. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 1988. № 1. С. 59.
Берестецкий B.Б., Лифшиц Е.М., Питаевский Л.П. Квантовая электродинамика. 4-е изд. М.: Физматлит, 2002. 720 с.
Жигарев А.А., Шамаева Г.Т. Электронно-лучевые и фотоэлектронные приборы. М.: Высшая школа, 1982. 463 с.
Батушев В.А. Электронные приборы. М.: Высшая школа, 1969. 608 с.
Новиков Ю.А. // Поверхность. Физика, химия, механика. 1995. № 10. С. 58.
Епифанов Г.И. Физические основы микроэлектроники. М.: Советское радио, 1971. 376 с.
Van der Ziel A. // Phys. Rev. 1953. V. 92. № 1. P. 35.
Томашпольский Ю.Я., Севостьянов М.А., Садовская Н.В., Колганова Н.В. // Журн. технической физики. 1990. Т. 60. № 6. С. 103.
Коханчик Л.С. // Заводская лаборатория. 1994. № 7. С. 21.
Спивак Г.В., Рау Э.И., Карелин Н.М., Назаров М.В. // Микроэлектроника. 1978. Т. 7. № 3. С. 212.
Дюков В.Г. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 1982. № 11. С. 1.
Дюков В.Г., Непийко С.А., Седов Н.Н. Электронная микроскопия локальных потенциалов. Киев: Наукова думка, 1991. 200 с.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования