Физика металлов и металловедение, 2019, T. 120, № 5, стр. 492-497
Двусторонний рост Cu9Ga4-фазы в ходе реакций на границе между медной основой и Sn–Ag–Cu–Ga-припоями
Вэньдзин Ван a, Гуй Мин Чень a, Цзиньшуй Чень b, Льюкуй Гон b, Хан Ван a, *
a Инженерно-технический научно-исследовательский институт, Цзянсийский университет науки
и технологии
341000 пров. Цзянси, Ганьчжоу, Китай
b Факультет материаловедения и машиностроения, Цзянсийский университет науки и технологии
341000 пров. Цзянси, Ганьчжоу, Китай
* E-mail: wanghang84@hotmail.com
Поступила в редакцию 10.02.2017
После доработки 14.02.2018
Принята к публикации 03.04.2018
Аннотация
Исследованы химические реакции на границе между медной основой и припоями состава Sn–3.0Ag–0.5Cu–1.0Ga/1.5Ga (вес. %). Пары припой–основа были подвергнуты отжигу при 180°C, продолжительностью 6, 12, 18 и 24 дня. Было обнаружено формирование слоев различных интерметаллических соединений, таких как Cu6Sn5 и Cu9Ga4. После отжига между этими слоями наблюдалось также присутствие олова (Sn). В объеме нанесенного на Cu–основу припоя отмечено попеременное чередование фаз Cu6Sn5 и Cu9Ga4. Для фазы Cu9Ga4 был характерен рост как со стороны припоя, так и со стороны интерметаллических прослоек. Установлено, что рост Cu9Ga4 фазы контролировался диффузией галлия (Ga) и присутствием Cu6Sn5-фазы.
1. ВВЕДЕНИЕ
Сплавы на основе системы Sn–Ag–Cu до сих пор рассматриваются как потенциальные кандидаты, призванные заменить традиционные Sn–Pb-припои [1, 2]. В целях улучшения качества, предписываемого технологией монтажа на поверхности платы, возникает необходимость дополнительного легирования припоев Sn–Ag–Cu-системы добавками, такими как – к примеру – Fe [3], Zn [4], Al [5], Co [6] и т.д. Добавка галлия к составу Sn–Ag–Cu припоев впервые была изучена авторами работы [7] (Chen с соавторами), в которой удалось добиться существенно более низкой (в сравнении с традиционной) точки плавления припоев. При этом можно было говорить и об улучшении их механических свойств [8–11].
Реакции на границе между припоем Sn–Ag–Cu–Ga и основой были изучены нами при пониженных температурах в предыдущих исследованиях [11, 12]. При этом, однако, паяные соединения в процессе их эксплуатации могут быть подвержены в некотором смысле экстремальному воздействию. Именно поэтому в данной работе реакция на границе между припоем и основой была изучена при больших температурах. При этом, мы обнаружили и впоследствии проанализировали ряд не наблюдавшихся ранее явлений.
2. МЕТОДИКА ЭКСПЕРИМЕНТА
В качестве исходных материалов для приготовления припоев, были использован Sn–3.0Ag–0.5Cu (вес. %) сплав (поставки Корпорации Sumitomo) и чистый Ga (99.9%). Галлий был добавлен в количестве 0, 1.0 и 1.5 вес. %. Пайка осуществлялась с использованием в качестве основы медных пластин 2 мм толщиной, предварительно прошедших шлифовку и полировку. В качестве флюса был выбран раствор 45% ZnCl2 + 5% NH4Cl + 50% H2O. Пайка осуществлялась при 260°C, в течение 5 мин, в атмосфере азота. Полученные образцы далее охлаждались на воздухе, а следы паяльного флюса удалялись с применением раствора 2.0% HCl, 2.0% NaOH и горячей воды.
Термообработка (ТО) осуществлялась для трех наборов диффузионных пар припой–основа. Температура и продолжительность ТО составили 180°C и 6, 12, 18 и 24 дня, соответственно. После ТО изучали поперечное сечение каждого из образцов. Морфологию микроструктуры наблюдали в сканирующий электронный микроскоп (РЭМ). Состав интерметаллических соединений (ИМС) был установлен в результате проведения энергодисперсионного (ЭДС) анализа.
3. РЕЗУЛЬТАТЫ
Изображения микроструктуры поперечных сечений области контакта Cu-основы и оплавленного припоя Sn–Ag–Cu, снятые в обратно рассеянных электронах (ОРЭ), представлены на рис. 1. Помимо Cu6Sn5 слоя, со стороны припоя оказался сформированным другой более темный (на изображении) слой, а именно – слой Cu9Ga4-фазы.
Рис. 1.
Поперечные сечения области контакта Cu-основы и Sn–Ag–Cu оплавленного припоя: 1.0 вес. % Ga (a); 1.5 вес. % Ga (б). Изображение в ОРЭ.
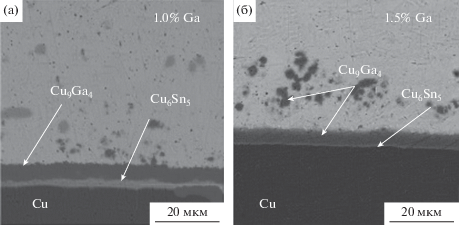
На рис. 2 представлены изображения в ОРЭ структуры поперечных сечений образцов с 1.5 вес. % Ga, отожженных при 180°C в течение 6, 12, 18 и 24 дней. Для образца, прошедшего отжиг в течение 6 дней (рис. 2a), можно отчетливо видеть два непрерывных слоя ИМС: серого цвета – фазы Cu6Sn5 и более темного цвета – фазы Cu9Ga4. Между фазой Cu6Sn5 и основой Cu наблюдаются области с зубчатыми краями, представляющими собой Cu3Sn-фазу. Светлые, пятнистые области, являющиеся Sn фазой, располагаются вблизи границы припой/основа между слоями Cu9Ga4 и Cu6Sn5-фазы. Также видно формирование несколько более темных, испещренных пятнами областей, являющихся Cu9Ga4-фазой в теле матрицы припоя. Как видно из рис. 2б, три слоя ИМС (Cu9Ga4, Cu6Sn5, Cu3Sn) по-прежнему стабильны после 12 дней отжига. Но, фаза Sn отсутствует между слоями Cu9Ga4 и Cu6Sn5, и отмечается наличие фазы Cu6Sn5, формирующейся на границе раздела слоя фазы Cu9Ga4 и припоя Sn–3.0Ag–0.5Cu–1.5Ga. На рис. 2в представлено изображение в ОРЭ структуры образца, отожженного в течение 18 дней; в нем еще наблюдаются слои Cu3Sn, Cu9Ga4 и Cu6Sn5-фаз вместе с некоторым количеством объемной фазы Cu6Sn5. После отжига продолжительностью в 24 дня, как видно из рис. 2г, вдоль границы раздела идет чередование подросших слоев Cu6Sn5 и Cu9Ga4, без каких-либо изменений выделения Cu3Sn-фазы. Картирование распределения атомов элементов Cu, Sn, Ga, и Ag по объему образца представлено на рис. 3. В зоне припоя, почти все атомы Cu и Ga связаны в фазу Cu9Ga4, тогда как атомы Sn находятся в матрице припоя, а также в фазе Cu6Sn5 и Ag3Sn.
Рис. 2.
Поперечные сечения областей контакта Cu-основы и Sn–3.0Ag–0.5Cu–1.5Ga-припоя в образцах, отожженных при 180°C в течение: 6 (a), 12 (б), 18 (в) и 24 (г) дней. Изображение в ОРЭ.
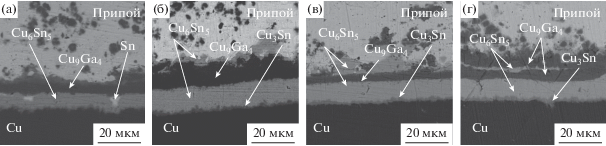
Рис. 3.
ЭДС картирование распределения элементов: Cu (a), Sn (б); Ga (в) и Ag (г) в области контакта основы Cu и припоя Sn–3.0Ag–0.5Cu–1.5Ga в образце, отожженном при 180°C в течение 12 дней.

На рис. 4 представлены изображения в ОРЭ поперечных сечений образцов с 1.0 вес. % Ga, отожженных при 180°C. Межфазные слои, начиная от Cu-основы в сторону Sn-припоя, представляют собой слои Cu3Sn, Cu6Sn5, Cu9Ga4 и Cu6Sn5 фаз (см. рис. 4 а–г для ТО продолжительностью 6, 12, 18 и 24 дня соответственно). Следует отметить, что непрерывность слоя Cu9Ga4 нарушается после 24 дней отжига, и этот слой неким образом перемешивается с фазой Cu6Sn5.
4. ОБСУЖДЕНИЕ
За формирование фазы Cu9Ga4 ответственна реакция между растворенными в припое атомами Ga и Cu; иными словами, Cu + Ga → Cu2Ga (Cu9Ga4) [8]. Это подтверждается результатами картирования распределения элементов, приведенными на рис. 3, согласно которым почти все атомы Cu в Sn припое были привлечены на формирование Cu9Ga4 фазы.
Сравнивая микроструктуру оплавленных областей образцов с 1.0 и 1.5 вес. % Ga, что представлена на рис. 1a и 1б соответственно, следует подчеркнуть два момента: (i) слой фазы Cu6Sn5, изображенный на рис. 1a, толще в сравнении с приведенным на рис. 1б; и (ii) слои фазы Cu9Ga4 имели одинаковую толщину. Для объяснения процессов затвердевания в образцах с 1.0 и 1.5 вес. % Ga воспользуемся схематической иллюстрацией, приведенной на рис. 5a и б соответственно. Сначала фаза Cu6Sn5 формировалась в образцах обоих составов вдоль границы раздела Cu-основа/припой. Этот слой фазы Cu6Sn5 начинал реагировать с атомами Ga в некоторой пространственной точке. Образец с 1.5 вес. % Ga обеспечил большее количество атомов Ga, вступивших в указанную реакцию, так что плотный слой фазы Cu9Ga4 смог образоваться за более короткое время на фоне заторможенного роста фазы Cu6Sn5. В свою очередь, в образце с 1.0 вес. % галлия фаза Cu6Sn5 продолжала расти, поскольку сформировался меньший объем фазы Cu9Ga4, величина которого пропорциональна возникающему диффузионному барьеру. Формирование фазы Cu9Ga4 обеспечило больший приток атомов Ga к границе раздела припой/основа. В конечном итоге, почти вся фаза Cu6Sn5 была израсходована в образце с 1.5 вес. % Ga, и остаточная фаза Ga послужила материалом для формирования глобулярной фазы Cu9Ga4 в объеме матрицы припоя, прилежащем к границе раздела. При этом, в образце с 1.0 вес. % Ga помимо прослойки Cu9Ga4 фазы аналогичной толщины сохранился и слой фазы Cu6Sn5 толщиной ~2.5 мкм, одновременно сформировалась фаза Cu9Ga4 менее сферически симметричной морфологии.
Рис. 5.
Схематическая иллюстрация формирования микроструктуры оплавленного слоя для образцов с 1.0 (а) и 1.5 (б) вес. % Ga.

На изображении микроструктуры образца припой Sn–3.0Ag–0.5Cu–1.5Ga – Cu-основа (рис. 2a), прошедшего отжиг при 180°C продолжительностью 6 дней, видны две светлые области, отвечающие фазе Sn. Присутствие фазы Sn в пределах слоя фазы Cu6Sn5 может быть объяснено результатом реакции Cu6Sn5 + Ga → Cu9Ga4 + Sn. Но эта фаза Sn не могла увеличиваться в объеме по мере увеличения продолжительности отжига, поскольку она была подвержена превращению в фазу Cu6Sn5 в результате интенсивного притока атомов Cu со стороны Cu-основы. Глобулярная фаза Cu6Sn5 формируется на границе раздела между слоем фазы Cu9Ga4 и припоем, поскольку область, вплотную прилегающая к указанной границе раздела, показанная на Рис. 2в, не в состоянии обеспечить количества атомов галлия, достаточного для формирования фазы Ga. И, таким образом, атомы Cu реагируют с Sn с образованием фазы Cu6Sn5. При большем количестве атомов Ga, диффундирующих из матрицы припоя к указанной границе раздела, становится возможным формирование фазы Cu9Ga4, и на это одновременно расходуется объем фазы Cu6Sn5 (см. рис. 2г).
Схематическая иллюстрация действия механизма формирования различных слоев ИМС представлена на рис. 6 для припоя Sn–3.0Ag–0.5Cu–1.5Ga в образцах, прошедших отжиг при 180°C. Перед началом пайки припой помещался на верхнюю поверхность Cu-основы (рис. 6a), и, после начала пайки, два слоя ИМС (Cu6Sn5 и Cu9Ga4) сформировались вдоль границы раздела в соответствии со схемой рис. 6б, что соответствует морфологии слоев, приведенной на рис. 1б. Фаза Cu6Sn5 продолжала свой рост в Cu-основу, тогда как часть ее расходовалась в результате реакции с Ga на формирование фаз Cu9Ga4 и Sn, как схематически показано на рис.6в, который соответствует рис. 2a. Вновь образованная фаза Sn вступала в реакцию с Cu, что приводило к увеличению количества фазы Cu6Sn5. В то же время, некоторое количество фазы Cu3Sn начинало формироваться между Cu6Sn5 и Cu-основой, что приводило к торможению дальнейшего образования фазы Cu6Sn5, как схематически описывается на рис. 6г, который отвечает случаю, представленному на Рис. 2б. Так как имеющееся количество Ga неспособно поддержать протекание реакции Cu6Sn5 + Ga → Cu9Ga4 + Sn, то слой фазы Gu9Ga4 и слой фазы Cu6Sn5 оказываются в одно и то же время и стабильными, и равновесными. Но атомы Cu продолжают диффундировать из Cu-основы в припой, и формируется некоторое количество глобулярной Cu6Sn5 фазы, что отражено на схеме рис. 6д, соответствующей рис. 2в. После дальнейшего отжига, требовалось уже большее время для атомов Ga, локализованных в объеме матрицы припоя, чтобы продиффундировать к границе раздела и вступить в реакцию с фазой Cu6Sn5. Это приводило к формированию второго слоя фазы Cu9Ga4; и вытесненные атомы Sn вступали в реакцию с атомами Cu с образованием другого тонкого слоя фазы Cu6Sn5, локализованного между двумя слоями фазы Cu9Ga4, чему отвечает схема, приведенная на рис. 6е, описывающая случай, приведенный на рис. 2г.
Рис. 6.
Схематическая иллюстрация эволюции микроструктуры в зоне контакта Cu основы с припоем Sn–3.0Ag–0.5Cu–1.5Ga в образцах, отожженных при 180°C: Перед началом пайки припой помещается на верхнюю поверхность Cu-основы (а); случай, отвечающий морфологии, представленной на рис. 1б (б); случай, отвечающий рис. 2a (в); случай, отвечающий рис. 2б (г); случай, отвечающий рис. 2в (д); случай, отвечающий рис. 2г (е).
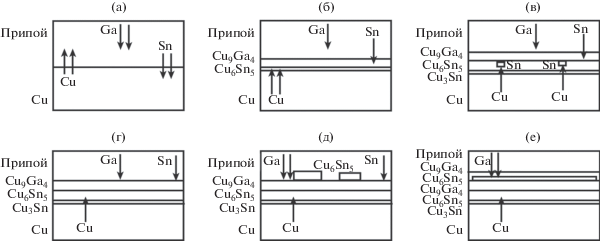
5. ВЫВОДЫ
Исследованы реакции на границе между Cu-основой и припоями Sn–Ag–Cu–Ga. Предложено и верифицировано два различных механизма роста фазы Cu9Ga4: Cu + Ga → Cu9Ga4 – со стороны припоя и Cu6Sn5 + Ga → Cu9Ga4 + Sn – со стороны фазы Cu6Sn5. Рост объема фазы Cu9Ga4 зависит как от наличия фазы Cu6Sn5, так и от диффузии Ga из матрицы припоя к границе раздела основа/припой. Сделан однозначный вывод, что присутствие фазы Cu9Ga4 препятствует развитию диффузионных процессов.
Работа профинансирована Цзянсийским университетом науки и технологии (проект № 3304000029, jxxjbs15001, xjptzd05). Авторы также хотели бы поблагодарить м-ра Ваньги Ху за оказанную помощь в работе.
Список литературы
Maleki M., Cugnoni J., Botsis J. Microstructure-based modeling of the ageing effect on the deformation behavior of the eutectic micro-constituent in SnAgCu lead-free solder // Acta Mater. 2013. V. 61. P. 103–114.
Anderson I.E. Development of Sn–Ag–Cu and Sn–Ag–Cu–X alloys for Pb-free electronic solder applications // J. Mater. Sci.: Mater. Electron. 2007. V. 18. P. 55–76.
Kantarcioglu A., Kalay Y.E. Effects of Al and Fe additions on microstructure and mechanical properties of SnAgCu eutectic lead-free solders // Mater. Sci. Eng. A 2014. V. 593. P. 79–84.
Wang F.J., Yu Z.S., Qi K. Intermetallic compound formation at Sn–3.0Ag–0.5Cu–1.0Zn lead-free solder alloy/Cu interface during as-soldered and as-aged conditions // J. Alloy. Compd. 2007. V. 438. P. 110–115.
Gain A.K., Zhang L.C. Interfacial microstructure, wettability and material properties of nickel (Ni) nanoparticle doped tin–bismuth–silver (Sn–Bi–Ag) solder on copper (Cu) substrate // J. Mater. Sci.: Mater. Electro. 2016. V. 27. P. 1–13.
Ma Z.L., Belyakov S.A., Gourlay C.M. Effects of cobalt on the nucleation and grain refinement of Sn–3Ag–0.5Cu solders // J. Alloy. Compd. 2016. V. 682. P. 326–337.
Chen G.H., Ma J.S., Geng Z.T. Fabrication and Properties of Lead-Free Sn–Ag–Cu–Ga Solder Alloy // Mater. Sci. Forum. 2005. V. 1747. P. 475–479.
Zhang Q.K., Long W.M., Yu W.M., Yu X.Q., Pei Y.Y., Qiao P.X. Effects of Ga addition on microstructure and properties of Sn–Ag–Cu/Cu solder joints // J. Alloy. Compds. 2015. V. 622. P. 973–978.
Luo D., Xue S.B., Li Z.Q. Effects of Ga addition on microstructure and properties of Sn–0.5Ag–0.7Cu solder // J. Mater. Sci.: Mater. Electron. 2014. V. 25. P. 3566–3571.
Nan X.J., Xue S.B., Zhai P.Z., Luo D.X. Effect of Pr addition on properties of Sn–0.5Ag–0.7Cu–0.5Ga lead-free solder // J. Electro. Mater. 2016. V. 45. P. 1–6.
Chen H.M., Guo C.J., Huang J.P., Wang H. Influence of gallium addition in Sn–Ag–Cu lead-fee solder // J. Mater. Sci: Mater. Electro. 2015. V. 26. P. 5459–5464.
Chen H.M., Shang G.F., Hu W.Y., Wang H. Growth kinetics of intermetallic compounds during interfacial reactions between SnAgCuGa lead-free solder and Cu substrate // Powder Metall. Met. Ceram. 2017. V. 55 (1–2), in press.
Дополнительные материалы отсутствуют.
Инструменты
Физика металлов и металловедение