Физика плазмы, 2019, T. 45, № 10, стр. 937-951
Исследование ионного пучка в плазменном фокусе на 1.5 кДж
F. Diab *
Plasma and Nuclear Fusion Dep., Nuclear Research Center, Atomic Energy Authority
Egypt
* E-mail: fatheyd@yahoo.co.uk
Поступила в редакцию 23.01.2018
После доработки 21.01.2019
Принята к публикации 20.02.2019
Аннотация
Исследована эмиссия пучка быстрых ионов из плазменного фокуса малой энергии (типа Мейзера на 1.5 кДж), работающего на аргоне при давлении от 2 × 10–2 Торр до 1 Торр. Установка питалась от конденсаторов емкостью 30.84 мкФ, заряженных до 10 кВ, дающих максимальный ток разряда до 120 кА, со временем нарастания 3 мкс. Цилиндр Фарадея (ЦФ) использовался для определения характеристик пучков заряженных частиц по времени пролета. Для детектирования ионов ЦФ помещался на расстоянии 20 см от вершины анода под углом 0° относительно оси анода. ЦФ, работающий с потенциалом смещения, использовался для измерения характеристик импульсного ионного пучка. Энергия и скорость ионов определялись методом времени пролета (TOF) с учетом расстояния от центрального электрода до плоскости детектирования. Морфология поверхности необлученных и облученных образцов ZnO Co0.04 исследовалась методом сканирующей электронной микроскопии (SEM). На необработанном образце видна относительно гладкая поверхность, в то время как SEM-микрофотографии облученных образцов показывают многочисленные маленькие пустоты на поверхности образцов ZnO Co0.04 в результате эмиссии ионного пучка из PF. Анализ рентгеновской флуоресценции (XRF) показал, что после воздействия ионного пучка на поверхности образца появились новые элементы. Проведена регистрация этих элементов и их концентрации. Измерена шероховатость поверхности исходного образца ZnO Co0.04 и облученного пучком ионов Ar в различных плазменных разрядах. Микротвердость поверхности определялась методом Викерса. Наблюдалось значительное увеличение твердости, зависящее от ионной дозы под углом 0° и уменьшающееся при увеличении приложенной нагрузки.
1. ВВЕДЕНИЕ
Установки “плазменный фокус” (PF) имеют две конфигурации: типа Мейзера [1] и типа Филиппова [2]. Геометрически эти установки являются линейными пинчами. Это обеспечивает быстрое сжатие плазменной оболочки за счет собственных магнитных сил. В PF создается импульсный разряд, в котором самогенерируемое магнитное поле создает короткоживущий (0.01–0.1 мкс) плазменный пинч с высокой температурой ~(1–2) кэВ и, высокой плотностью (1025–1026) м–3 [3]. Кроме того, PF интенсивно излучает в микроволновом [4], мягком [5] и жестком [6] рентгеновском диапазоне, а также электронные пучки [7], ионные пучки [8] и нейтроны [9].
В данной работе использовался PF типа Мейзера, который широко изучен из-за низкой стоимости, простоты конструкции, разнообразия излучения и малых размеров по сравнению с другими типами источников излучения [10]. Установка имеет центральный сплошной медный анод и катод, состоящий из восьми медных стержней, расположенных по окружности, концентрической с анодом. Как из эксперимента, так и из теории хорошо известно, что первичные быстрые ионы из установки PF испускаются преимущественно в осевом направлении. Исследование эмиссии ионов из PF важно по нескольким причинам, в том числе для понимания механизма их применения в различных областях. Пучок быстрых ионов, генерируемый PF, широко применяется для плазменной обработки, включая ионную имплантацию, модификацию поверхности, термическую обработку поверхности, ионное покрытие, изготовление приборов, нанесение тонких пленок и т.д.
Для исследования поведения ПФ типа Мейзера, Ли разработал код с излучательной моделью, ответвленная версия которой названа RADPF V5.15 de.c. Этот код показывает, что установка плазменного фокуса описывается моделями магнитного поршня и размытой плазменной области (слага). Этот код позволяет найти предпочтительную реальную установку “плазменный фокус” путем ввода определенных переменных и параметров. Код показывает, что динамика ПФ делится на две основные фазы: осевую и радиальную. Осевой фазовый механизм запускается, когда токовая оболочка ускоряется силой Лоренца Jr × B. Радиальная фаза начинается в конце осевой фазы, когда токовая оболочка движется радиально внутрь. Эта фаза содержит подробные профили формирования фокуса. Таким образом, когда оболочка достигает конца электродов, осевое движение переходит в радиальное движение, в то время как токовый слой распространяется радиально. В этот момент плазма образует высокотемпературный шнур высокой плотности, который затем сжимается внутрь [11].
Более подробно, физические процессы, которые учитываются в коде Ли для описания параметров плазмы, образующейся при магнитном сжатии плазменного фокуса в аргоне, могут быть описаны динамикой токовой оболочки (CS) в плазменном фокусе, содержащей пробой, осевую, радиальную, отраженную и излучательную фазу. Осевая фаза начинается с пробоя газа, и модель магнитного поршня используется для описания движения CS. Сила, направленная вдоль оси z, ускоряет и толкает CS в осевом направлении. Следовательно, плазма движется к торцу анода, чтобы аккумулировать долю fm (фактор сгребания массы газа вдоль оси). Радиальная фаза начинается с фазы внутренней ударной волны, где динамика CS описывается моделью слага. Плазменный слаг образуется и сжимается в радиальном направлении магнитным поршнем. Ударная волна движется внутрь перед слагом, поэтому она достигает оси раньше слага. Кинетическая энергия плазменного слага передается во внутреннюю энергию плазмы, поэтому температура и плотность плазмы в центре увеличиваются. Фаза отраженной волны начинается, когда фронт волны достигает оси, он отражается, пока CS все еще движется к оси. Когда фаза отраженной ударной волны заканчивается, начинается медленная фаза сжатия, которая также называется излучательной фазой [12].
Для детектирования ионов использовалось много методов, таких как: метод ядерной активации, магнитный анализатор, цилиндр Фарадея (ЦФ) и т.д. Среди этих методов ЦФ является наилучшим методом определения энергии ионного пучка при различных угловых позициях и рабочих давлениях аргона в камере PF.
Основная цель настоящей статьи – это исследование интенсивности, энергии ионных пучков и использование этих ионов во время образования плазменного фокуса. Методом времени пролета установлено, что максимальные энергии ионных пучков для различных давлений составляют 4.5, 8, 10.58, 15.68, 20.5 и 26.26 кэВ соответственно при разрядном напряжении 5, 6, 7, 8, 9 и 10 кВ. Эта особенность открывает возможность для ряда важных применений, особенно в области обработки тонких пленок и материалов. Кроме того, для обработки различных материалов в установках с плотным плазменным фокусом используются быстрые ионы аргона. Знание поведения этих ионов важно не только для понимания механизма производства быстрых ионов, но и для их применения в различных областях.
Образец ZnO, легированный Co, является перспективным материалом из-за его высокой растворимости и превосходного ферромагнетизма при комнатной температуре. В настоящей работе изучается влияние разрядов с плазменным фокусом на структурные и морфологические свойства тонких пленок из ZnO Co0.04. Целью работы является изучение применения ионного пучка, испускаемого PF, для исследования рабочих условий осаждения тонких пленок и поверхностной обработки сплава ZnO Co0.04, поскольку PF обладает привлекательными свойствами для осаждения, например, при осаждении со вспомогательными быстрыми ионами, позволяющем повысить энергию осаждаемых частиц и скорость осаждения. Кроме того, адгезия осажденной пленки к поверхности подложки обычно является хорошей. Также, осаждение с использованием PF может создать более плотный слой покрытия за меньшее время осаждения. Во время осаждения пленки не требуется дополнительного нагрева подложки, поскольку подложки нагреваются во время обработки ионным пучком.
2. УСЛОВИЯ ЭКСПЕРИМЕНТА И ДИАГНОСТИКИ
Схема установки PF типа Мейзера и электродной системы показана на рис. 1. Эксперименты проводились на установке PF типа Мейзера, которая была разработана и изготовлена в Отделе плазмы и ядерного синтеза Центра ядерных исследований Египетского управления по атомной энергии (NRC, EAEA). Система запитана от конденсаторной батареи, состоящей из четырех конденсаторов общей емкостью 30.84 мкФ, заряженных до 10 кВ, соединенных параллельно и дающих максимальный ток разряда до 120 кА. Чтобы начать разряд через электроды, вблизи искрового промежутка был расположен высоковольтный разрядник, который работал как включатель для передачи электрической энергии из конденсаторной батареи на электроды. Очистка искрового промежутка проводится через каждые 8 разрядов. Разрядная камера, изготовленная из нержавеющей стали, имеет длину 40 см и диаметр 38 см. Она состоит из внутреннего электрода в виде медного цилиндра диаметром 40 мм и длиной 130 мм. Внешний электрод состоит из восьми медных стержней, имеющих длину 140 мм и диаметр 10 мм. Они расположены по кругу диаметром 140 мм концентрически с анодом, и образуют “беличье колесо” с внутренним диаметром 3.5 см, показанное на рис. 1. Система электродов помещена в вакуумной камере с несколькими диагностическими патрубками.
Рис. 1.
Схема установки “Плазменный фокус” (PFD) и цилиндра Фарадея (ЦФ): (a) – Схема PFD и ее электрической цепи; (б) – ЦФ с цепью смещения.
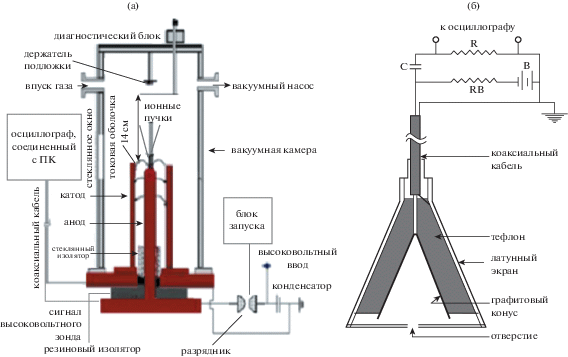
Анод изолирован от катода у задней стенки трубкой из пирекса длиной 50 мм, толщиной 2.5 мм и диаметром 44 мм. На внутренний электрод подается положительный потенциал от источника питания через переключатель под давлением, а внешний электрод заземлен. Изолятор из пирекса установлен в резиновом держателе, который действует как вакуумное и высоковольтное уплотнение. Он должен быть правильно установлен, чтобы избежать его разрушения от вибрации. Вакуумная система состоит из роторного насоса, который откачивает камеру до уровня ниже 10‒2 Торр перед напуском аргона.
Экспериментальная установка PF и детектор ЦФ с цепью смещения представлены на рис. 1a и рис. 1б. Временная зависимость тока в разрядной цепи PF и напряжения на камере PF во время формирования плазменного фокуса соответственно контролируются поясом Роговского и омическим делителем напряжения. Сигналы с делителя напряжения и пояса Роговского регистрировались на цифровом осциллографе (Tektronix 2014, 100 МГц). Ионные пучки генерировались во время разрядов с плазменным фокусом, возникающих в электрической цепи, показанной на рис. 1а. Спектр ионов пучка определяется с помощью детектора ЦФ. Для исследования эмиссии ионов из PF используется метод времени пролета (TOF). Кроме того, детектор ЦФ в качестве коллектора заряда представляет собой простую, легко реализуемую и недорогую диагностику, которая обычно состоит из небольшого входного отверстия и глубокого коллектора, на который подается желаемый потенциал смещения. Если детектор ЦФ используется в качестве ионного коллектора, на него надо подавать отрицательный потенциал смещения для удаления любых электронов, сопровождающих входящий ионный пучок. Отрицательный потенциал также удаляет вторичные электроны с поверхности коллектора, которые генерируются на поверхности коллектора под действием падающего ионного пучка. Таким образом, подходящий потенциал смещения на коллекторе ЦФ необходим для правильной интерпретации сигнала коллектора. Детектор ЦФ был соединен с осциллографом 50‑омным коаксиальным кабелем, так что практически нет рассогласования импеданса между ионным коллектором и кабелем. Электрическая изоляция между электродами детектора ЦФ была достигнута путем вставки внутреннего электрода внутрь тефлонового конуса, показанного на рис. 1б. Диаметр входного отверстия детектора ЦФ обычно составлял 200 мкм. Когда входящий ионный пучок попадает на поверхность графитового коллектора с отрицательным смещением относительно входного отверстия, в цепи генерируется ток, и на резисторе (R) создается соответствующее напряжение (VR). Это напряжение VR пропорционально потоку входящих ионов и может быть записано на осциллографе. Отверстие определяет количество ионов, достигающих поверхности коллектора, и, следовательно, контролирует величину ионного импульса.
3. РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
В настоящей работе проведено численное моделирование формирования плазменного фокуса. Результаты расчетов сравниваются с подробными измерениями параметров PF при различных условиях эксперимента. Для этого эксперимента код с моделью Ли был адаптирован как ответвленная версия RADPF V5.15 de.c для газа, представляющего для нас особый интерес, а именно для аргона.
Экспериментальные исследования формирования плазменного фокуса проводились при разных давлениях аргона и при разных разрядных напряжениях. Типичные сигналы пояса Роговского и высоковольтного зонда, зарегистрированные в экспериментах, показаны на рис. 2. Типичные сигналы напряжения и тока разряда при напряжении батареи 10 кВ и давлении аргона 4 × 10–1 Торр, показывающего оптимальные условия работы для Ar, показаны на рис. 2. Когда образуется плазменный фокус, форма импульса тока отклоняется от затухающей синусоиды из-за электродинамических эффектов движения плазмы. Провал на осциллограмме тока указывает на то, что начинается фаза пинча, а пик напряжения отображает максимальное сжатие при формировании плазменного пинча. Рисунок 2 показывает, что наилучшее действие достигается, когда максимальное сжатие пинча приблизительно совпадает с пиком тока разряда.
Рис. 2.
Временная эволюция напряжения в типичном разряде с плазменным фокусом (верхняя кривая) и тока (нижняя кривая) при зарядном напряжении 10 кВ и давлении аргона 4 × 10–1 Торр.

Оценка всех данных, используемых в экспериментах на этой установке, представлена в табл. 1, где Vch – рабочее зарядное напряжение (кВ); Eion – энергия ионного пучка (кэВ); Idis – ток разряда (кА); Vdis – напряжение разряда (кВ); E – энергия, запасенная в конденсаторной батарее (Дж), и P – электрическая мощность, (МВт). Согласно экспериментальным результатам, скорость ионного пучка составляла от 15 до 33 см/мкс, а энергия ионного пучка – от 4.5 до 26.620 кэВ.
Таблица 1.
Основные рабочие параметры установки плазменный фокус типа Мейзера
| Vch (кВ) | Eion (кэВ) | Idis (кА) | Vdis (кВ) | E (Дж) | P (МВт) |
|---|---|---|---|---|---|
| 5 | 4.5 | 57 | 1 | 385.5 | 57 |
| 6 | 8 | 62 | 1.5 | 555 | 93 |
| 7 | 10.58 | 78 | 1.65 | 756 | 129 |
| 8 | 15.68 | 86 | 1.75 | 987 | 150.5 |
| 9 | 20.5 | 105 | 2 | 1249 | 210 |
| 10 | 26.62 | 120 | 2.2 | 1542 | 264 |
Схема установки PF имеет постоянное сопротивление и индуктивность. Общее сопротивление можно оценить по соотношению затухания тока (In = I0sin(ωt)exp(–r0t/2L0)), где In, I0 и ω – соответственно экспериментальный ток разряда, амплитуда тока цепи разряда и частота колебания тока. В максимуме тока sin(ωt) = 1, поэтому полное сопротивление системы составляет 9 мОм. Индуктивность контура можно оценить с помощью уравнения резонансного контура (L0 = = τ2/4π2C0), где τ – период сигнала тока, поэтому общая индуктивность системы составляет 157 нГн. Перед началом численного моделирования, выбиралась осциллограмма тока разряда эксперимента, взятая с пояса Роговского. Выбранный измеренный сигнал соответствует разряду при 0.4 Торр. Соответствующие рабочие параметры приведены в табл. 2. Код с моделью Ли (RADPF V5.15 de.c) настроен для описания любого плазменного фокуса, если подставить в него соответствующие параметры камеры b, a и z0, параметры батареи L0, C0 и активное сопротивление r0, рабочие параметры V0 и P0, а также заполняющий газ. Все эти параметры сведены в табл. 2.
Таблица 2.
Основные проектные параметры модели Ли и рабочие условия эксперимента
| L0 (нГн) | C0 (мкФ) | b (см) | a (см) | r0 (мОм) | Z0 (см) | V0 (кВ) | P0 (Торр) | fm | fc | fmr | fcr |
|---|---|---|---|---|---|---|---|---|---|---|---|
| 157 | 30.84 | 6.375 | 2 | 9 | 11.7 | 10 | 0.16 | 0.072 | 0.77 | 0.1 | 0.7 |
| 0.4 | 0.068 | 0.77 | 0.1 | 0.7 | |||||||
| 0.6 | 0.064 | 0.77 | 0.1 | 0.7 |
где: L0 – статическая индуктивность; C0 – емкость; b – радиус катода; a – радиус анода; Z0 – длина анода; r0 – активное сопротивление; V0 – напряжение заряда батареи; P0 – давление рабочего газа; и параметры модели: fm, fc, и fmr, fcr – массовые и токовые факторы, соответственно, для осевой и радиальной фазы.
В табл. 2 приведены основные расчетные параметры кода с моделью Ли и рабочие условия эксперимента, где L0 – статическая индуктивность, C0 – емкость, b – радиус катода, a – радиус анода, z0 – длина анода, r0 – активное сопротивление, V0 – зарядное напряжение, P0 – рабочее давление. Параметры модели fm, fmr и fc, fcr – это массовые и токовые факторы, соответственно, для осевой и радиальной фазы. В модели mw – молекулярный вес атома, A – атомный номер, At-1 и mol-2 относятся к типу газа: атомный (1) или молекулярный (2). Для аргона; mw = 40, A = 18 и At = 1. В этой таблице, когда давление равно 0.4 Торр (оптимальное рабочее состояние), масс-фактор fm = 0.068, но при снижении давления до 0.16 торр, масс-фактор fm увеличился до 0.072, в то время как при давлении 0.6 Торр, масс-фактор fm снизился до 0.064. Все эти результаты получены при постоянном токовом факторе 0.77.
Экспериментальное измерение тока разряда является очень важной диагностикой, которое может использоваться в качестве индикатора общих характеристик плазменного фокуса. Следовательно, подбор экспериментальной формы тока разряда с помощью численного подхода, использующего версию кода RADPF V5.15 de.c модели Ли, может дать много ценных данных о плазменном пинче. Когда подгонка завершена, мы получаем четыре параметра модели для конкретных установок PF.
Код настроен для работы с использованием экспериментальных параметров и подобранных параметров модели. Затем проводятся численные эксперименты при различных начальных давлениях аргона. В работе описаны измерения формы импульса тока в зависимости от давления Ar, позволяющие найти параметры модели осевой фазы fm, fc в зависимости от давления наполняющего газа. После работы кода проводится сравнение вычисленной формы импульса тока с соответствующей измеренной формой импульса. Оказалось, что изменение fm и fc в пределах каждого давления было достаточно небольшим (±5%), так что их изменения в зависимости от давления стали заметными, хотя и небольшими. Результаты для Ar дают значение fm = 0.068 ± 0.004.
Более подробно, вычисленная форма импульса полного тока подгоняется к измеренной форме импульса путем изменения параметров модели fm, fc, fmr и fcr по одному, пока вычисленная форма импульса не совпадет с измеренной формой импульса, что показано на рис. 3. Параметры модели fm, fc, fmr и fcr являются массовыми и токовыми факторами на осевой и радиальной фазе, полученные из подгонки вычисленных кривых тока к измеренным. Сначала осевые модельные факторы fm и fc варьируются до тех пор, пока вычисленный наклон нарастающей кривой полного тока и округление пикового тока, а также сам пиковый ток не будут в разумном (как правило, в хорошем) соответствии с измеренной формой импульса полного тока. Затем происходит подгонка модельных факторов для радиальной фазы fmr и fcr, пока вычисленный наклон и глубина провала не совпадут с измеренными. Эта серия численных экспериментов проводится при Vch = 10 кВ, P = = 0.4 Торр аргона, индуктивности L0 = 157 нГн и активном сопротивлении r0 = 9 мОм. Отношение c = b/a сохраняется на уровне 3.188. В этом случае получаются следующие подобранные параметры модели: fm = 0.068, fc = 0.77, fmr = 0.1 и fcr = 0.7. Эти значения параметров модели затем используются для расчета всех разрядов при различных давлениях. Исходя из вышеизложенного, вычисленная форма импульса тока подгоняется к измеренной форме импульса тока, хорошо воспроизводя провал на рассчитанном токе, показанный на рис. 3.
Рис. 3.
Сравнение рассчитанной временной эволюции тока (пунктирная линия) с измеренной (сплошная линия) для плазменного фокуса, заполненного аргоном при различном давлении и при зарядном напряжении 10 кВ (a) давление аргона 0.16 Торр; (б) давление аргона 0.4 Торр; (в) давление аргона 0.6 Торр.

Изменения амплитуды тока, Ipeak, тока пинча, Ipinch и скорости токовой оболочки в зависимости от давления аргона, полученные из расчетов разрядов PF по коду с моделью Ли, представлены на рис. 4.
Рис. 4.
Зависимости значений максимального тока, Ipeak и тока пинча, Ipinch (а) и максимальной осевой скорости токовой оболочки, ${{v}_{{a\;peak}}}$, максимальной скорости ударной волны ${{v}_{{s\;peak}}}$ и максимальной радиальной скорости поршня ${{v}_{{p\;peak}}}$, (б) от давления аргона, полученные из расчетов разрядов PF по коду с моделью Ли.
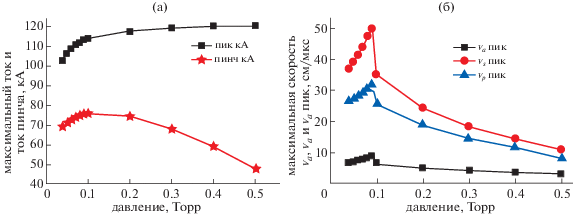
На рис. 4а показано отличие Ipeak от Ipinch в зависимости от давления, полученное при моделирований по коду с моделью Ли. Зависимость тока в начале фазы пинча Ipinch от давления сильно отличается от зависимости Ipeak, так как Ipeak представляет максимум сигнала тока при определенном давлении на рис. 3, в то время как Ipinch представляет соответствующее пиковое значение тока, который протекает через пинч в начале фазы медленного сжатия. Как видно из рис. 4а, при увеличении давления амплитуда полного тока разряда Ipeak слегка увеличивается, пока не достигнет максимального значения 120 кА при 0.5 Торр. Причина этого увеличения объясняется уменьшением динамического сопротивления, или уменьшением скорости изменения индуктивности плазмы из-за уменьшения скорости поршня при увеличении давления [13].
С другой стороны, ток пинча Ipinch, который протекает через сжатый плазменный шнур, увеличивается с ростом давления из-за времени пинчевания, происходящего до момента достижения максимума тока. В конце концов, Ipinch достигнет максимального значения 75.73 кА при 0.1 Торр. Затем, при давлении выше 0.1 Торр, величина I-pinch начинает уменьшаться из-за смещения момента образования пинча относительно максимума тока, когда токовый слой движется все быстрее и быстрее [14]. Основным фактором снижения Ipinch при увеличении Ipeak, является сдвиг времени схлопывания от поздней части разряда к более ранней части. Радиальная фаза при низком давлении возникает рано, и она рано заставляет ток снижаться, что уменьшает оба тока.
На рис. 4б показано изменение максимальной продольной скорости ${{v}_{{a\;peak}}}$ на стадии убегания оболочки (обычно это продольная скорость при выходе на торец), изменение максимальной скорости радиальной ударной волны ${{v}_{{s\;peak}}}$, и изменение максимальной радиальной скорости поршня, ${{v}_{{p\;peak}}}$, как функции давления аргона. Все скорости одинаково уменьшаются по мере роста давления. Однако на рисунке видны более низкие значения скорости плазмы в осевой фазе и более высокие в фазе радиального поршня (тока оболочки). Снижение скоростей приводит к падению температуры плазмы ниже температуры, необходимой для получения мягкого рентгеновского излучения [14].
Детектор ЦФ с отрицательным напряжением смещения используется для измерения тока ионных пучков в произвольных единицах (интенсивности) и помещается на осевом расстоянии 20 см от торца коаксиального электрода. Выходной сигнал детектора ЦФ, показанный на рис. 5, записывается во время разрядов PF при 8 кВ и при давлении аргона 2 × 10–2 Торр. Временные зависимости сигналов тока ионного пучка и высокого напряжения, регистрируемых в разрядах ПФ на газообразном аргоне с помощью детектора ЦФ и высоковольтного зонда при давлениях аргона 2 × 10–2 торр и 4 × 10–2 Торр, показаны на рис. 5. Из временной эволюции при всех давлениях заполняющего газа, показанной на рис. 5a и 5б, видно, что первый пик сигнала датчика напряжения (от 0 до 1 мкс) соответствует пробою поверхности поперек изолирующей втулки, а относительно длинная плоская часть (от 1 до 6 мкс) и последующий второй пик соответствуют фазе осевого ускорения, а третий пик (от 6 до 7 мкс) соответствует фазе радиального коллапса плазменного фокуса.
Рис. 5.
Временная зависимость сигналов тока ионного пучка и высокого напряжения, регистрируемых при разрядах PF в аргоне с помощью детектора ЦФ и высоковольтного зонда: (a) – давление аргона 2 × 10–2 Торр; (б) – давление аргона 4 × 10–2 Торр.

Зависимость интенсивности ионного пучка, создаваемого в ПФ при зарядном напряжении 10 кВ, от давления газа Ar показана на рис. 6. Как видно из рисунка, интенсивность ионного пучка вначале увеличивается с ростом давления газа, пока не достигнет максимума, равного 20 (отн. ед.) при давлении 4 × 10–1 Торр. Затем интенсивность слегка уменьшается с ростом давления, пока оно не достигнет 1.2 Торр, а затем интенсивность, падающая при более высоких давлениях, выглядит как прямая линия. Для зарегистрированной интенсивности ионного пучка наилучшие рабочие условия были получены при давлении 4 × 10–1 Торр.
Рис. 6.
Зависимость интенсивности ионного пучка, создаваемого разрядом PF при зарядном напряжении 10 кВ, от давления Ar.

Энергия ионного пучка E оценивается по уравнению:
где $v$ – скорость ионного пучка, полученная методом времени пролета, а M – атомная масса. Скорость ионного пучка $v$ оценивается из измерений времени прилета (t), которое необходимо для того, чтобы ионные пучки прошли из области ПФ в детектор ЦФ, сдвинутый на 20 см.Зависимость энергии ионного пучка E от давления аргона в качестве рабочего газа на выходе установки плазменного фокуса для различных значений приложенного напряжения представлена на рис. 7. На рис. 7 показан рост энергии ионного пучка с увеличением давления газа при приложенном напряжении 5 кВ и запасенной энергией 385.5 Дж. Энергия ионного пучка увеличилась с 3.5 кэВ при 0.1 Торр до максимального значения 4.5 кэВ при 0.4 Торр, затем она уменьшилась до минимального значения 2.7 кэВ при 1 Торр. При приложенном напряжении 6 кВ и энергии 555 Дж, энергия ионного пучка увеличилась с 5 кэВ при 0.1 Торр до максимального значения 8 кэВ при 0.4 Торр, а затем снизилась до минимального значения 3.6 кэВ при 1 Торр. При приложенном напряжении 7 кВ и энергии 756 Дж, энергия ионного пучка увеличилась с 6.4 кэВ при 0.1 Торр до максимального значения 10.58 кэВ при 0.5 Торр, затем она уменьшилась до минимального значения 5.2 кэВ при 1 Торр. При приложенном напряжении 8 кВ и 987 Дж запасенной энергии, энергия ионного пучка увеличилась с 7.3 кэВ при 0.1 Торр до максимального значения 15.68 кэВ при 0.5 Торр, затем она уменьшилась до минимального значения 9.5 кэВ при 1 Торр. При приложенном напряжении 9 кВ и энергии 1249 Дж, энергия ионного пучка увеличилась с 10.6 кэВ при 0.1 Торр до максимального значения 20.5 кэВ при 0.6 Торр, затем она уменьшилась до минимального значения 12 кэВ при 1 Торр. При приложенном напряжении 10 кВ и энергии 1542 Дж энергия ионного пучка увеличилась с 17.3 кэВ при 0.1 Торр до максимального значения 26.26 кэВ при 0.6 Торр, а затем уменьшилась до минимального значения 15.7 кэВ при 1 Торр. Из вышеприведенных результатов можно заметить, что при зарядном напряжении 5 кВ энергия ионных пучков постепенно увеличивается с давлением аргона, а максимальное значение энергии ионного пучка 26.26 кэВ достигается при приложенном напряжении 10 кВ и давлении 0.6 Торр.
Рис. 7.
Зависимость энергии ионного пучка Eion (кэВ) от давления рабочего газа аргона (торр) на выходе установки плазменного фокуса для различных значений приложенного напряжения.

Наблюдаемое изменение энергии пучка с давлением можно объяснить следующим образом. При более высоких напряжениях ионизируется больше газа. Таким образом, генерируется больше ионов с более высокими энергиями, которые ускоряются к катоду. При пониженном давлении ионы сильнее ускоряются полем. При более высоком давлении ионы чаще сталкиваются, и по мере увеличения давления мы выходим из оптимального режима. Рисунок 7 показывает, что с ростом давления интенсивность увеличивается до максимального значения, а затем уменьшается. Для подъема энергии пучка, оптимальное давление сильно коррелирует с приложенным напряжением. Таким образом, очевидно, что приложенное напряжение и рабочее давление являются эффективными параметрами.
4. ВОЗМОЖНОЕ ПРИМЕНЕНИЕ ИОННОГО ПУЧКА, ЭМИТТИРОВАННОГО ИЗ ПЛАЗМЕННОГО ФОКУСА
При обработке различных материалов на установке с плотным плазменным фокусом используются быстрые ионы аргона. Пучок ионов аргона, извлеченный из источника PF, использовался для облучения оксида цинка, легированного кобальтом (ZnO Co0.04). В этих процессах гомогенный раствор готовили растворением ацетата цинка Zn (CH3COO)2 ⋅ 2H2O) (0.1 М) и Co(NO3)2 в 100 мл дистиллированной воды. Раствор перемешивали в течение 15 минут. Осадок сушили при 100°С в течение 2 часов, чтобы получить высушенный полуфабрикат. Полуфабрикат прокаливали при 400°С (согласно термогравиметрическому анализу, ТГА) в течение 4 часов, чтобы получить наночастицы ZnO Co0.04.
Ионный пучок, эмиттированный из PF, изучался многими исследователями в области плазменной обработки материалов, таких как ионная имплантация, модификация поверхности, термическая обработка поверхности, фазовые изменения тонких пленок и осаждение тонких пленок [15]. Активные частицы, в том числе ионы и радикалы, способствовали росту пленок, состоящих из наночастиц, свойства которых сильно отличаются от свойств материала подложки [14]. Исследована морфология поверхности композитных пленок ZnO Co0.04 при разном количестве импульсов PF (5, 10, 15, 20 и 30) при угловом положении 0°. Чтобы исследовать влияние ионов на образец, методом SEM сравнивалась морфология поверхности первичного и облученного образца ZnO Co0.04. Наблюдается четкое различие внешнего вида поверхности. Поверхность первичного образца гладкая и имеет отражающий светло-серый цвет, тогда как поверхность обработанных образцов темно-серая или черная. Рисунки 8 и 9 наглядно иллюстрируют изменения морфологии поверхности первичного и облученного образца с увеличением дозы ионного пучка из плазменного фокуса.
Рис. 8.
Фотографии, сделанные сканирующим электронным микроскопом, SEM, (а) и после цифровой обработки изображений, DIP; (б) поверхности исходного образца ZnO Co0.04 до экспонирования на ионном пучке из плазменного фокуса.
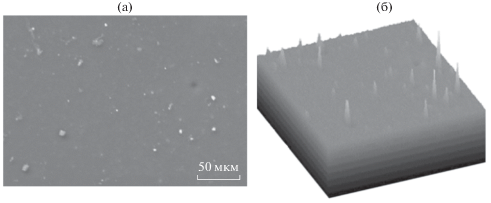
Рис. 9.
SEM (левая колонка) и DIP (правая колонка) фотографии поверхности образца ZnO Co0.04, экспонированного в 5, 10, 15, 20 и 30 импульсах плазменного фокуса.
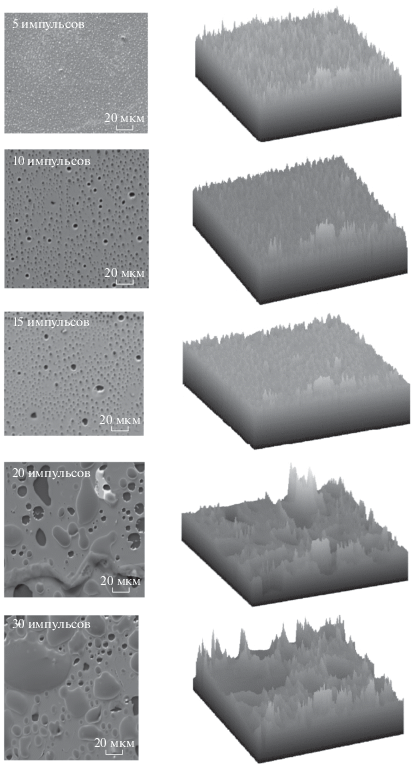
Электронный микроскоп (SEM) модели JEOL JSM-5600LV использовался для наблюдения и анализа морфологии поверхности образцов до и после плазменной обработки. Топография чистой поверхности выглядит более однородной. И наоборот, на поверхности, подвергавшейся воздействию плазмы, виден аблированный и расплавленный материал, повторно перенапыленный после переноса плазмой. Образцы размещались на расстоянии 20 см от торца анода, и это расстояние можно легко изменить. На образец, помещенный на большое расстояние в несколько см от анода, попадают пучки быстрых ионов, быстрые осевые ударные волны и плазменные струи, а также воздействует медленная струя меди, распыляемой из анода под действием ионного пучка. Исследовано влияние увеличения числа импульсов PF на морфологию поверхности образца ZnO Co0.04. Некоторые активные частицы могут взаимодействовать с поверхностью ZnO Co0.04, разрушая химические связи на поверхности образца. На рис. 8 показаны SEM и DIP-фотографии (DIP – это цифровая обработка изображений, использующая двумерные компьютерные алгоритмы) первичного образца ZnO Co0.04 перед воздействием плазмы. Из рис. 8 видно, что исходный образец имеет очень гладкую поверхность.
На рис. 9 показаны SEM-фотографии микроструктуры поверхности образца ZnO Co0.04, облученного в различном числе (5, 10, 15, 20 и 30) импульсов плазменного фокуса, когда образцы размещались вдоль оси анода. На микрофотографии образца, облученного в 5 импульсах PF, SEM-микроструктура показывает образование прикрепленных частиц, равномерно распределенных по всей поверхности. Края и границы зерен не очень четкие и не имеют определенной формы. Микрофотография пленки, напыленной после 10 импульсов PF, показывает микроструктуру типа сетки. Микрофотография образца после 15 импульсов показывает, как не очень четкие, так и четкие границы зерен. На поверхности также видны небольшие поры, демонстрирующие эффект плавления поверхности. Эффект плавления увеличился в образце после 20 импульсов PF, где большая часть зерен превратилась в агломерированные структуры и сформировала однородную морфологию с некоторыми трещинами и порами на поверхности. Появление нерегулярных пор может быть связано с облучением быстрыми ионами в последовательных импульсах PF. На поверхности, обработанной в 20 импульсах PF, наблюдаются зерна почти одинакового размера с равномерным распределением. Агломерация зерен на поверхностной морфологии с некоторыми трещинами также наблюдается после 30 импульсах PF, причем границы и края четкие, но не очень острые. Морфология поверхности образца, экспонированного в 30 импульсах PF, показывает присутствие агломерированных структур. Однако по поверхности неравномерно распределены различные зерна неправильной формы малых и больших размеров. Более того, большинство зерен имеют острые и ясные границы. Более высокая доза ионов может привести к повышению температуры в объеме подложки, что приводит к плавлению и агломерации в синтезированных пленках. Из SEM-анализа делается вывод, что форма, размер и распределение частиц, и компактность пленки зависят от увеличения числа импульсов PF, потому что общая энергия, подводимая к поверхности подложки, увеличивается с ростом числа импульсов. Общая подводимая энергия повышает нестационарную температуру поверхности подложки, что, в свою очередь, изменяет внешний вид микроструктуры, размер, форму и распределение частиц.
5. АНАЛИЗ РЕНТГЕНОВСКОЙ ФЛУОРЕСЦЕНЦИИ
Рентгеновская флуоресценция (XRF) – очень простой аналитический метод, позволяющий исследовать, какие элементы присутствуют, и их концентрации в исследуемом образце. Рентгенограммы образца ZnO Co0.04 до и после ионного облучения различным числом импульсов (5, 10, 15, 20 и 30) при размещении образца были вдоль оси анода (угловое положение 0°) на расстоянии 14 см от анода показаны на рис. 10 и 11.
Рис. 10.
Типичный спектр энергетического распределения рентгеновской флуоресценции, XRF, образца ZnO Co0.04 до экспонирования на ионном пучке плазменного фокуса.

Рис. 11.
Типичный спектр энергетического распределения XRF образца ZnO Co0.04 после экспонирования на ионном пучке плазменного фокуса.

Рентгенограммы (XRF) исходного образца ZnO Co0.04 перед воздействием плазмы представлены на рис. 10, где получены следующие концентрации основных элементов: Na (15.11%), Mg (4.21%), Al (0.23%), Si (66.98%), P (3.14%), S (0.09%), K (0.37%), Ca (9.67%), Ti (0.057%), Fe (0.14%), Sr (0.01%), Zr (0.01%), Rh (0%), а других элементов не обнаружено. XRF-анализ образца ZnO Co0.04 перед воздействием плазмы показывает, что основным элементом является Si с концентрацией 66.98%. Результаты XRF образца ZnO Co0.04 после воздействия ионного пучка из плазменного фокуса представлены на рис. 11, где получены следующие концентрации основных элементов: Na (11.19%), Mg (2.96%), Al (0.99%), Si (58.97%), P (0.55%), S (1.23%), K (0.78%), Ca (19.71%), Ti (0.18%), Mn (0.05%), Fe (0.49%), Co (0.17%), Zn (2.30%), Мо (0.39%), Rh (0%), а другие элементы не обнаружены. XRF-анализ образца ZnO Co0.04 показывает, что после воздействия плазмы, основным элементом является Si с концентрацией 58.97%.
Результаты XRF-анализа показали, какие новые элементы осаждаются на поверхности после воздействия плазмы с энергией 1.5 кДж, и каковы их концентрации. Основное назначение этих покрытий – придать материалам дополнительную устойчивость к износу, коррозии и окислению, а также найти им применение в электротехнике и электронике [16]. XRF может анализировать образцы и определять дополнительные концентрации и характеристики образца. Это неразрушающий, быстрый, чувствительный и многоэлементный анализ. Электроны из внешних оболочек заполняют вакансии внутренней оболочки, и испускают рентгеновские фотоны [17]. Измеряя интенсивность излучаемых энергий, можно количественно определить, сколько данного элемента присутствует в образце [17]. Интенсивности связаны с концентрацией каждого элемента в образце и вероятностями возбуждения. Программное обеспечение для анализа определяет, какие пики присутствуют, определяет интенсивность каждого пика и вычисляет концентрацию каждого элемента в образце [18].
6. АНАЛИЗ ПОВЕРХНОСТНОЙ ШЕРОХОВАТОСТИ ОБРАЗЦА ZNO Co0.04
Шероховатость поверхности как первичного образца ZnOCo0.04, так и облученного ионным пучком Ar при различной энергии ионного пучка после 15 и 30 импульсов PF в осевом положении, измеряется с помощью системы MITUTOYO SURFTEST 301. Поверхностные испытания показали, что шероховатость поверхности исходного образца составляет ≈0.06 мкм; и она увеличивается до 0.14 мкм для образца ZnO Co0.04, облученного в 15 импульсах PF, и до 0.40 мкм для ZnO Co0.04, облученного в 30 импульсах PF. После облучения поверхность кажется более шероховатой; это увеличивает смачиваемость облученного образца ZnO Co0.04 [19]. Это явление связано с увеличением площади поверхности из-за шероховатости, вызванной облучением пучком ионов Ar. Фактически, увеличение шероховатости поверхности происходит из-за увеличения общей энергии, приходящей на поверхность подложки, которая связана с общим числом ионов, которое увеличивается с увеличением импульсов PF. Хорошо известно, что шероховатость поверхности для облученного образца ZnOCo0.04 непосредственно влияет на силу адгезии [19].
7. ИЗМЕРЕНИЯ МИКРОТВЕРДОСТИ
Твердость по Виккерсу (Hv) определялась методом вдавливания, выполняемым с помощью микротвердомера в диапазоне нагрузок от 50 до 500 г при постоянном времени нагрузки 10 с. Твердость поверхности образца ZnO Co0.04, экспонированного и не экспонированного ионами из плазменного фокуса, измерялась с помощью микротвердомера Виккерса, оснащенного алмазным 136°-индентором.
На рис. 12 представлены значения микротвердости в образце, обработанном 5, 10, 15, 20 и 30 импульсами в осевом положении, как функция приложенных нагрузок 50, 100, 150, 200, 250, 300, 350, 400 и 500 Г. Было взято среднее значение твердости из пяти измерений на поверхности образца. Значение твердости по Виккерсу (VHN) рассчитывается по отношению приложенной нагрузки к области вдавливания, определяемой по диагоналям пирамиды:
Рис. 12.
Зависимость поверхностной твердости по Викерсу (кГ/мм2) от приложенной нагрузки (Г) для исходных и облученных образцов ZnO Co0.04 после нескольких импульсов плазменного фокуса (5, 10, 20 и 30) при угловом положении 0°.
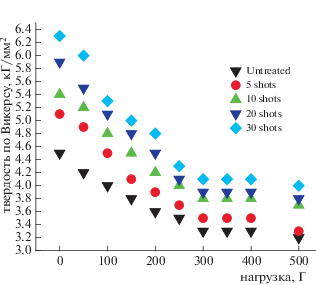
Микротвердость поверхности (кГ/мм2) в зависимости от различных приложенных нагрузок (Грамм), измеренных как для необработанных образцов ZnO Co0.04, так и для образцов ZnO Co0.04, многократно облученных на плазменном фокусе (5, 10, 15, 20 и 30 импульсов), показана на рис. 12. Для оценки средних значений микротвердости поверхности при каждой нагрузке проведено пять измерений в разных точках поверхности. Ясно, что микротвердость увеличивается с увеличением количества импульсов PF и уменьшается с увеличением приложенной нагрузки. Однако увеличение микротвердости указывает на образование компактных и плотных пленок.
Рисунок 12 показывает, что средняя твердость образца, подвергшегося ионному облучению на плазменных импульсах, увеличивалась при увеличении количества импульсов PF. Видна корреляция поверхностной твердости тонких пленок ZnO Co0.04 с количеством импульсов PF, так как при увеличении количества импульсов PF растет количество осаждаемого материала. Это увеличение твердости объясняется увеличением ионной дозы, приводящей к образованию более толстого слоя на поверхности подложки. Ионная доза вызывает повышение объемной температуры подложки, что может улучшить кристалличность, снизить уровень напряжений и снизить твердость. В то же время причиной увеличения твердости является более толстый слой композита, который увеличивается с увеличением дозы ионов.
Профиль микротвердости, представленный на рис. 12, можно разделить на три части. Первая часть (нагрузка от 0 до 100 Г) характеризуется сильным снижением значений микротвердости. Вторая часть (от 100 до 300 Г приложенной нагрузки) – крутое падение значений микротвердости нанокомпозитных пленок. Третья часть (приложенная нагрузка 300–500 Г) указывает на медленное снижение значений микротвердости композитных пленок. Резкое снижение значений микротвердости в приповерхностной области может быть связано с быстрым градиентом концентрации элементов по сравнению со второй частью. Такое поведение можно интерпретировать как эффект образования сильных дефектов и микротрещин в имплантированной области с увеличением дозы имплантации [20].
8. ВЫВОДЫ
Измерения интенсивности и энергии излучения ионных пучков из рассматриваемой установки плазменного фокуса регистрируются с помощью детектора ЦФ и метода TOF. Для регистрации ионов ЦФ помещается на расстоянии 20 см от конца анода вдоль оси анода. Экспериментальные результаты показывают, что максимальное значение интенсивности ионных пучков получается при разрядном напряжении 10 кВ и давлении газа Ar 0.4 Торр. Методом сканирующей электронной микроскопии (SEM) исследована морфология поверхности первичных и облученных образцов ZnO Co0.04. Необработанный образец имел относительно гладкую поверхность, в то время как SEM-микрофотографии облученных образцов показывают многочисленные небольшие пустоты на поверхности образцов ZnO Co0.04, вызванные облучением капиллярным плазменным разрядом. Анализ рентгеновской флуоресценции (XRF) показал, что после воздействия ионного пучка из плазменного фокуса на поверхности образца появились некоторые новые элементы, концентрации которых зарегистрированы. Измерены значения шероховатости поверхности для первичного образца ZnO Co0.04 и облученного ионным пучком Ar при различном числе плазменных импульсов. Показано, что шероховатость поверхности образца ZnO Co0.04 увеличивается с увеличением импульсов ионного пучка. Измеритель микротвердости по Виккерсу используется для измерения твердости поверхности. Наблюдалось значительное увеличение твердости в зависимости от ионной дозы и ее уменьшение при увеличении приложенной нагрузки при угловом положении 0°.
Список литературы
Mather J.W. // Phys. Fluids. 1965. V. 8. P. 366–377.
Filippov N.V., Filippova T.I., Vinogradov V.P. // Nucl. Fusion. 1962. V. 2. P. 577–587.
Hussnain A., Rawat R.S., Seng T.K., Ahmad R., Hussain T., Lee P., C. Zhong, Lu S., Zheng Z. // J. Fusion Energy. 2015. V. 34. P. 435–442.
Gerdin G., Tanis M.J., Venneri F. // Plasma Phys. Control. Fusion. 1986. V. 28. P. 527.
Skladnik-Sadowska E., Zaloga D., Sadowski M.J., Kwiatkowski R., Malinowski K., Miklaszewski R., Paduch M., Surala W., Zielinska E., Tomaszewski K. // Plasma Phys. Control. Fusion. 2016. V. 58. P. 095003.
RaspaV., Sigaut L., Llovera R., Cobelli P., Knoblauch P., Vieytes R., Clausse A., Moreno C. // Brazilian J. Phys. 2004. V. 34. P. 1696.
Khan M.Z., Ling Y.S., San W.C. // Frontiers in Physics. AIP Conf. Proc. Kuala Lumpur, Malaysia. 2014. V. 1588. P. 185.
Akel M., Salo S.A., Saw S.H., Lee S. // Vacuum. 2014. V. 110. P. 54–57.
Bogolubov Ye.P., Koltunov M.V., Lemeshko B.D., Mike-rov V.I., Samosyuk V.N., Sidorov P.P., Yurkov D.I. // N-ucl. Instruments and Methods in Physics Research. 2009. V. 605. P. 62–64.
Ng C.M., Moo S.P., Wong C.S. // IEEE Trans. Plasma Sci. 1998. V. 26. P. 1146–1153.
Gautam P., Khanal R., Saw S.H., Lee S. J. // Fusion Energy. 2015. V. 34. P. 686–693.
Wong D., Lee P., Zhang T., Patran A., Tan T.L., Ra-wat R.S., Lee S. // Plasma Sources Sci. Technology. 2007. V. 16. P. 116–123.
Jassim K.M., Firas, Hady M. // Diyala Journal for Pure Sciences. 2013. V. 9. P. 1–10.
Al-Hawat S., Akel M., Lee S. J. // Fusion Energy. 2011. V. 30. P. 494–502.
Shaaban E.R., El-Kashef G.M., Diab F., Ali A.S. // Int. J. Thin. Film. Sci. Tec. 2016. V. 5. P. 67–74.
Chandler H. editor, Hardness Testing, 2nd Edition. ASM International, Ohio, USA, 1999.
Sueda S. Katsuki, Akiyama H. // Appl. Phys. Lett. 1996. V. 68. P. 1766–1768.
Rott M. // IEEE Trans. on Magnetics. 1993. V. 29. P. 597–602.
Fakes D.W., Newton J.M., Watts J.F., Edgell M.J. // Surf. Inter. Anal. 1987. V. 10. P. 416.
Murtaza G., Hussain S.S., Rehman N.U., Naseer S., Shafiq M., Zakaullah M. // Surface & Coatings Technology. 2011. V. 205. P. 3012–3019.
Дополнительные материалы отсутствуют.


