Физика плазмы, 2020, T. 46, № 3, стр. 281-288
Исследование степени неоднородности характеристик индуктивно-связанной плазмы в магнитном поле
Hee-Woon Cheong a, Woohyun Lee b, Ji-Won Kim b, Sujin Cha c, Kyoungji Kim d, Hwally Lee e, *, Е.М. Анохина
a Grad. School of Management of Technology, Hoseo University
Asan, Korea
b Samsung Electronics Co. Ltd.
Hwaseong, Korea
c Dept. of Applied Statistics, Hoseo University
Asan, Korea
d Dept. of Electrical and Computer Engineering, Seoul Natl. University
Seoul, Korea
e Hyundai Motor Company
Hwaseong, Korea
* E-mail: hwally@nate.com
Поступила в редакцию 05.04.2019
После доработки 21.06.2019
Принята к публикации 21.06.2019
Аннотация
Исследована степень неоднородности параметров плазмы в установке травления с индуктивно-связанной плазмой в магнитном поле (M-ICP). Показано, что результаты травления оксида кремния и фоторезиста коррелируют с неоднородностями плазменных параметров. Степени неоднородности плотности электронов и скорости травления в конфигурации M-ICP-V (9.28% и 2.4%, соответственно) оказались ниже, чем в конфигурации M-ICP-A (14.6% и 21.4%, соответственно) или в конфигурации ICP (13.03% and 5.2%, соответственно). Измерен угол профиля травления оксида кремния в конфигурациях ICP, M-ICP-A и M-ICP-V. В конфигурациях M-ICP-V и ICP он приблизительно был равен 85°.
1. ВВЕДЕНИЕ
Увеличение размера пластин интегральных микросхем и уменьшение масштаба их дизайна приводит к повышению требований к устройствам сухого травления. В связи с этим стали активно исследоваться различные направления плазменного травления: травление с помощью индуктивно связанной плазмы (ИСП) [1, 2], травление с помощью ион-циклотронного резонанса (ИЦР) [3–5] и другие методы [6]. В частности, устройство травления с индуктивно-связанной плазмой в магнитном поле (M-ICP) производит плазму высокой плотности и демонстрирует высокую скорость травления материалов при наличии слабого магнитного поля в традиционном устройстве травления с индуктивно-связанной плазмой (ICP) [7].
В данной работе показано, что результаты травления диоксида кремния коррелируют со степенью неоднородности таких плазменных параметров как объемная плотность электронов, плотность ионов и плотность потока ионов на подложку. В работе рассматривались различные конфигурации травления с индуктивно связанной плазмой (ICP, M-ICP-A и M-ICP-V) [8]. Стоит отметить, что для конфигурации M-ICP-A плотность магнитного потока на подложке уменьшается как в радиальном, так и в осевом направлениях от центра подложки, а в конфигурации M-ICP-V плотность магнитного потока на подложке, наоборот, с расстоянием увеличивается. Также в данной работе показано, что селективность травления по отношению к фоторезисту в различных конфигурациях ICP коррелирует с величиной плотности радикалов в установке травления. В дополнение были измерены углы профилей травления диоксида кремния в различных конфигурациях ICP.
2. ЭКСПЕРИМЕНТАЛЬНАЯ УСТАНОВКА
На рис. 1а представлена схема установки травления с индуктивно-связанной плазмой в магнитном поле (M-ICP), которая использовалась в данной работе. Более детальное описание установки, включая описание конфигурации катушек, приведено в [9]. Плотность магнитного потока в центре подложки для конфигураций M‑ICP-A и M-ICP-V была фиксированной и составляла 17 Гс. В таблице 1 приведены величины токов в катушках в конфигурациях M-ICP-A и M-ICP-V. На рис. 1б приведены радиальное и осевое распределения магнитного поля, которые были получены с помощью программного обеспечения FEMM. Подробное рассмотрение пространственного распределения магнитного поля в конфигурациях ICP, M-ICP-A и M-ICP-V было проведено в [8].
Рис. 1.
Схема установки травления M-ICP с семью магнитными катушками и пространственное распределение магнитного поля в установке травления в конфигурациях M-ICP-A и M-ICP-V. а) – схема установки травления M-ICP с семью магнитными катушками: катушки 1, 2, 3, 6 и 7 – 1400 витков, катушки 4 и 5 – 1000 витков; б) – пространственное распределение магнитного поля в установке травления в конфигурациях M-ICP-A и M-ICP-V, полученное в [8] (отредактировано из рис. 2а в [8]).
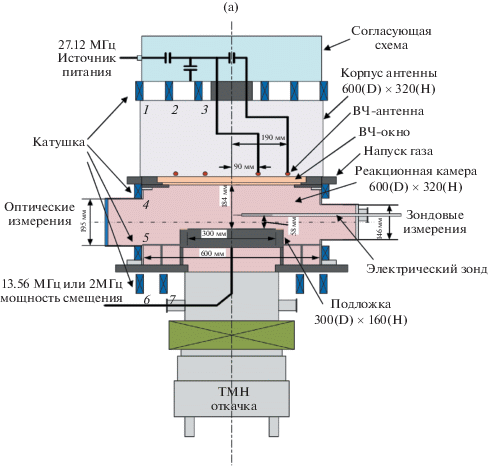
Рис. 1.
Окончание
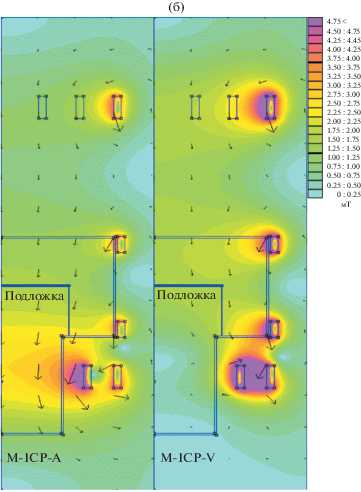
Таблица 1.
Токи в катушках 1–7, изображенных на рис. 1а
| Кат-ка 1 | Кат-ка 2 | Кат-ка 3 | Кат-ка 4 | Кат-ка 5 | Кат-ка 6 | Кат-ка 7 | |
|---|---|---|---|---|---|---|---|
| M-ICP-A | 340 мА | 340 мА | 340 мА | 340 мА | 340 мА | 340 мА | 340 мА |
| M-ICP-V | 560 мА | 560 мА | 330 мА | 560 мА | 560 мА | –750 мА | 560 мА |
Радиальное распределение плотности электронов внутри установки травления было измерено методом двойного электрического зонда [10]. Измерения проводились на высоте 10 мм от подложки. Расстояние от центра подложки изменялось от 0 до 160 мм с шагом 10 мм. Степень неоднородности параметров плазмы оценивалась с помощью следующего выражения:
(1)
${\text{Неоднородность}}\;(\% ) = \frac{{({\text{максимальное}}\;{\text{значение}}{\kern 1pt} - {\kern 1pt} {\text{минимальное}}\;{\text{значение}}){\text{/}}2}}{{{\text{среднее}}\;{\text{значение}}}}.$Дополнительно с помощью оптической эмиссионной актинометрии были измерены плотности радикалов в технологической камере установки травления [11]. В качестве газа-актинометра для измерения интенсивности линий F (703.7 нм) и CF2 (251.9 нм) использовался Ar (750.4 нм), а результирующая плотность F и CF2 рассчитывалась следующим образом [12]:
(2)
${{n}_{{\text{F}}}} = {{K}_{{\text{F}}}}{{n}_{{{\text{Ar}}}}} \times \frac{{{{I}_{{\text{F}}}}}}{{{{I}_{{{\text{Ar}}}}}}},\quad {{n}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}}}} = {{K}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}}}}{{n}_{{{\text{Ar}}}}} \times \frac{{{{I}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}}}}}}{{{{I}_{{{\text{Ar}}}}}}},$С помощью анализатора энергии ионов [14], размещенного на подложке, определялись функция распределения ионов по энергиям, плотность потока ионов и плотность ионов, бомбардирующих подложку. Данные величины были получены с использованием методики, примененной для ВЧ-разряда низкого давления и описанной в [15, 16].
3. РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
На рис. 2а и 2б приведены плотность электронов, измеренная методом двойного электрического зонда, и плотность ионов, измеренная с помощью анализатора энергии ионов, как функции расстояния от центра подложки в конфигурациях ICP, M-ICP-A и M-ICP-V. В данном эксперименте в качестве газа-носителя использовался аргон, расход и давление которого составляли 48 ст. см3/мин и 0.67 Па. Мощность источника и мощность смещения составляли 1000 Вт и 0 Вт, соответственно. Как было показано в [7], плотность электронов в конфигурации M-ICP-A и M‑ICP-V была выше, чем в конфигурации ICP. Также стоит отметить, что плотность электронов в конфигурации M-ICP-A была ниже, чем в конфигурации M-ICP-V. Данное обстоятельство означает, что плотность электронов в плазме зависит от распределения магнитного поля, так как при уменьшении плотности магнитного потока в радиальном направлении (конфигурация M-ICP-A) возникает желобковая неустойчивость плазмы, что приводит к уменьшению плотности электронов [8]. По этой же причине наибольшая неоднородность плотности электронов (14.64%) наблюдалась в конфигурации M-ICP-A, в то время как в конфигурации M-ICP-V она была наименьшей (9.28%). Плотность ионов при трех различных конфигурациях вела себя аналогично плотности электронов за исключением того, что в конфигурациях M-ICP-A и M-ICP-V значения ионной плотности в центре подложки совпадали. Таким образом можно сделать вывод, что объемная плотность электронов в плазме не является единственным параметром плазмы, определяющим плотность ионов на подложке.
Рис. 2.
Плотности электронов и ионов как функции расстояния от центра подложки в конфигурациях ICP, M-ICP-A и M-ICP-V для условий: мощность источника – 1000 Вт, мощность смещения – 0 Вт, расход Ar – 48 ст. см3/мин, давление – 0.67 Па. а) – плотность электронов в зависимости от расстояния до центра подложки, измеренная методом двойного электрического зонда; б) – плотность ионов в зависимости от расстояния до центра подложки, измеренная с помощью анализатора энергии ионов.
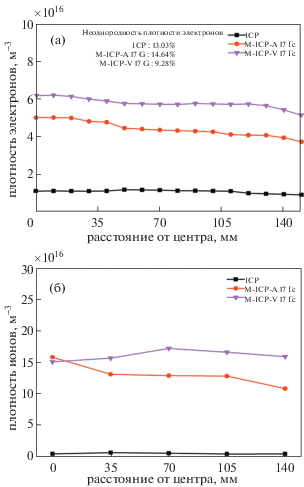
На рис. 3 приведено изображение линейчатых образцов оксида, которые использовались для экспериментов по травлению [8].
На рисунках 4а, 4б и 4в представлены плотность ионов (м–3), степень ее неоднородности (%) и плотность потока ионов (м–2 с–1) в зависимости от расстояния до центра подложки и конфигурации магнитного поля. Все вышеперечисленные параметры определялись по результатам травления образцов. В данном эксперименте использовалась газовая смесь CF4-Ar с парциальными расходами газов 18 и 30 ст. см3/мин, соответственно, и общим давлением 0.67 Па. Мощность источника и мощность смещения составляли 1000 Вт и 200 Вт, соответственно. Неоднородность травления оксида в образцах соответствовала неоднородности плотности электронов в плазме для конфигураций ICP, M-ICP-A и M-ICP-V, приведенной на рис. 2а. Данное обстоятельство означает, что скорость травления оксида сильно зависит от плотности электронов в плазме. Поведение плотности потока ионов, приведенное на рис. 4в, соответствовало поведению плотности ионов, показанному на рис 2б. Скорость травления оксида в конфигурациях M-ICP-A и M-ICP-V была выше, чем в конфигурации ICP, из-за того, что плотность электронов в плазме для этих конфигураций превышала плотность электронов в конфигурации ICP. С другой стороны, скорость травления в конфигурации M-ICP-A в центральной области подложки была выше, чем в конфигурации M-ICP-V, несмотря на более низкую плотность электронов. Стоит отметить, что скорость травления в конфигурациях M-ICP-A и M-ICP-V превышала скорость травления в конфигурации ICP примерно в 1.5 раза при том, что плотность электронов была выше более чем в 5 раз. Следовательно можно сделать вывод, что плотность электронов не является единственным параметром, который определяет скорость травления оксида.
Рис. 4.
Зависимости плотности ионов (м–3), неоднородности скорости травления (%) и плотности потока ионов (м–2 с–1) от расстояния до центра подложки и конфигурации магнитного поля, рассчитанные по результатам травления образца. а) – зависимость плотности ионов (м–3) от расстояния до центра подложки; б) – зависимость неоднородности скорости травления (%) от конфигурации магнитного поля; в) – зависимость плотности потока ионов (м–2 с–1) от расстояния до центра подложки.
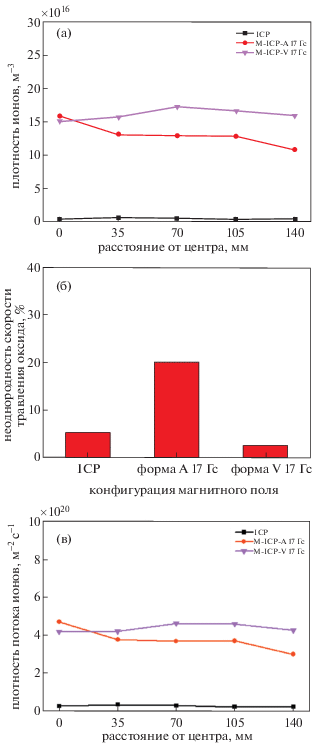
На рис. 5а для конфигураций M-ICP-A и M‑ICP-V приведено распределение ионов по энергиям в центре подложки и на расстоянии 105 мм от центра. В данном эксперименте в качестве газа-носителя использовался аргон, расход и давление которого составляли 48 ст. см3/мин и 0.67 Па. Мощность источника и мощность смещения составляли 1000 Вт и 0 Вт, соответственно. Максимальные значения энергии ионов и плотности потока ионов (см. рис. 4в) в конфигурации M-ICP-A были выше, чем в конфигурации M‑ICP-V в центре подложки, в то же время на расстоянии 105 мм от центра обе эти величины в конфигурации M-ICP-A оказались меньше, чем в конфигурации M-ICP-V. Другими словами, желобковая неустойчивость плазмы может приводить в условиях конфигурации M-ICP-A к возникновению радиальных неоднородностей плотности потока ионов и распределения ионов по энергиям, что может являться причиной существенного отличия скорости травления оксида на краях подложки от скорости травления в центре. По той же причине в центре подложки скорость травления, плотность потока ионов и величина ионной плотности в конфигурации M-ICP-A были выше, чем в M-ICP-V, несмотря на то, что в конфигурации M-ICP-V плотность электронов была больше.
Рис. 5.
Распределение ионов по энергиям (м4 с) и средняя энергия ионов в конфигурациях ICP, M‑ICP-A и M-ICP-V для условий: мощность источника – 1000 Вт, мощность смещения – 0 Вт, расход Ar – 48 ст. см3/мин, давление – 0.67 Па. а) – распределение ионов по энергиям в центре подложки и на расстоянии 105 мм от центра; б) – распределение ионов по энергиям в центре подложки; в) – средняя энергия ионов (eV) в зависимости от расстояния до центра подложки.

На рис. 5б и 5в приведены распределение ионов по энергиям в центре подложки и усредненная энергия ионов в зависимости от радиального расстояния. Обе величины – максимальная и средняя энергии ионов – в конфигурации ICP более чем в 3 раза превышали аналогичные величины для конфигураций M-ICP-A и M-ICP-V, несмотря на то, что плотность электронов и плотность потока ионов в конфигурации ICP была в 5–6 раз меньше. Данное обстоятельство может привести к увеличению скорости травления при наличии магнитного поля. Из-за магнитного поля эффективная область заземления в конфигурации M-ICP была меньше, чем в ICP, что приводило к уменьшению емкости заряженного слоя и увеличению падения напряжения. Что касается механизма, который приводит к различиям в распределениях ионов по энергиям для конфигураций ICP и M-ICP, то его еще предстоит выяснить.
На рис. 6а и 6б приведены селективность травления по отношению к фоторезисту и отношение плотностей радикалов CF2 и F в зависимости от радиального расстояния. Поведение кривой селективности совпадает с поведением зависимости отношения плотностей радикалов CF2 и F в конфигурациях M-ICP-A и M-ICP-V и не совпадает в конфигурации ICP. Обычно вероятность прилипания CF2 возрастает с ростом количества бомбардирующих образец ионов, что означает возможность использовать CF2 как прекурсор пассивации поверхности при бомбардировке ионами [17]. Таким образом, высокая энергия ионов в конфигурации ICP одновременно усиливает и бомбардировку поверхности ионами, и ее пассивацию, что может приводить к ускорению травления и увеличению его селективности.
Рис. 6.
Селективность травления по отношению к фоторезисту и отношение плотностей CF2 и F в зависимости от расстояния до центра подложки в конфигурациях ICP, M-ICP-A и M-ICP-V для условий: мощность источника – 1000 Вт, мощность смещения – 200 Вт, расход CF4 – 18 ст. см3/мин, расход Ar – 30 ст. см3/мин, общее давление – 0.67 Па. а) ‒ селективность травления оксида по отношению к фоторезисту в зависимости от расстояния до центра подложки; б) – правая ось ординат: селективность травления по отношению к фоторезисту; левая ось ординат: отношение плотностей CF2 и F.
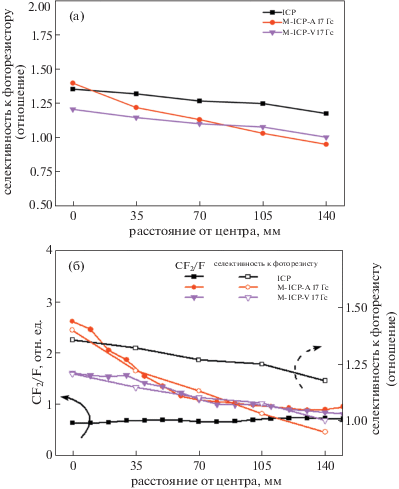
Измерение угла профиля травления проводилось в соответствии с рис. 7а. Результаты измерения приведены на рис. 7б. Величина угла профиля травления определялась следующим образом:
(3)
$\begin{gathered} {\text{Угол}}\;{\text{профиля}} = \\ \, = {{\tan }^{{ - 1}}}\frac{{{\text{глубина}}\;{\text{травления}}}}{{({\text{Верхн}}{\text{.}}\;{\text{КР}}{\kern 1pt} - {\kern 1pt} {\text{Нижн}}{\text{.}}\;{\text{КР}}){\text{/}}2}} \\ \end{gathered} $Рис. 7.
Область измерения и величина измеренного угла профиля травления в конфигурациях ICP, M‑ICP-A и M-ICP-V для условий: мощность источника – 1000 Вт, мощность смещения – 200 Вт, расход CF4 – 18 ст. см3/мин, расход Ar – 30 ст. см3/мин, общее давление – 0.67 Па. а) – область измерения профиля угла травления в образце (Верхн. КР: критический размер верхнего слоя, Нижн. КР: критический размер нижнего слоя); б) – измеренный угол профиля травления в зависимости от расстояния до центра подложки.
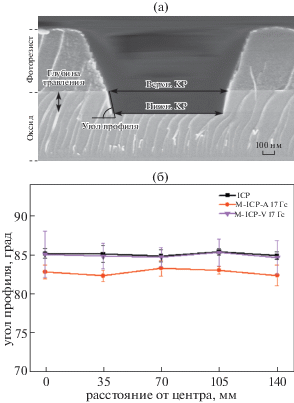
Судя по всему физическое травление в наших условиях превалировало над химическим, так как измеренный угол профиля составлял 85°, что достаточно близко к 90°.
4. ВЫВОДЫ
В работе была исследована степень неоднородности характеристик индуктивно-связанной плазмы и индуктивно-связанной плазмы в магнитном поле с различными распределениями магнитного поля. Степень неоднородности плотности электронов и скорости травления оксида могут быть уменьшены путем наложения магнитного поля при условии отсутствия желобковой неустойчивости плазмы. Скорость травления оксида и фоторезиста может быть определена не только по величине плотности электронов, но и по плотности потока ионов, а также по распределению ионов по энергиям. Скорость травления в центре подложки в конфигурации M-ICP-A оказалась выше, чем в конфигурации M-ICP-V, несмотря на более низкую плотность электронов из-за различия распределений ионов по энергиям (или плотности потока ионов) в центральной области и на расстоянии 105 мм от центра в конфигурации M-ICP-A. Высокая энергия ионов в конфигурации ICP позволяет использовать радикал CF2 как прекурсор при пассивации поверхности, что приводит к увеличению селективности по отношению к фоторезисту.
Список литературы
Imai S. // Journal of Vacuum Science and Technology B. 2008. V. 26 (6). P. 2008.
Westerheim A.C., Labun A.H., Dubash J.H., Arnold J.C., Sawin H.H. // Journal of Vacuum Science and Technology A. 1995. V. 13 (3). P. 853.
Doh H.H., Yeon C.K., Whang K.W. // Journal of Vacuum Science and Technology A. 1997. V. 15 (3). P. 664.
Nojiri K., Iguchi E. // Journal of Vacuum Science and Technology B. 1995. V. 13 (4). P. 1451.
Maruyama T., Narukage T., Onuki R., Fujiwara N. // Journal of Vacuum Science and Technology B. 2010. V. 28 (4). P. 854.
Hosomi S., Omori N. // Journal of Vacuum Science and Technology A. 1997. V. 15 (3). P. 585.
Lee H.J., Kim J.H., Whang K.W., Joo J.H. // Journal of Vacuum Science and Technology A. 1996. V. 14 (3). P. 1007.
Lee W.H., Cheong H.W., Kim J.W., Whang K.W. // Plasma Sources Science and Technology. 2015. V. 24 (6). P. 065012.
Cheong H.W. // Journal of Magnetics. 2016. V. 21 (2). P. 222.
Sung Y., Lim H.B., Houk R.S. // Journal of Analytical Atomic Spectrometry. 2002. V. 17 (6). P. 565.
Coburn J.W., Chen M. // Journal of Applied Physics. 1980. V. 51 (6). P. 3134.
Ding J., Jenq J.S., Kim G.H., Maynard H.L., Hamers J.S., Hershkowitz N., Taylor J.W. // Journal of Vacuum Science and Technology A. 1993. V. 11 (4). P. 1283.
Kokkoris G., Goodyear A., Cooke M., Gogolides E. // Journal of Physics. D: Applied Physics. 2008. V. 41 (19). P. 195211.
Lee W.H., Kim H., Kim J.W., Cheong H.W., Koo I.G., Lee S., Seong H., Whang K.W. in Proceedings of the 66th Annual Gaseous Electronics Conference, New Jersey. 2013. V. 58.
Bohm C., Perrin J. // Review of Scientific Instruments. 1993. V. 64 (1). P. 31.
Kudyan H.M. // Review of Scientific Instruments. 1978. V. 49 (1). P. 8.
Zhang D., Kushner M.J. // Journal of Vacuum Science and Technology A. 2000. V. 18 (6). P. 2661.
Дополнительные материалы отсутствуют.
Инструменты
Физика плазмы