Физика плазмы, 2022, T. 48, № 5, стр. 468-480
Изучение параметров плазмы и скорости нанесения тонких титановых пленок при распылении частиц в магнетронном разряде постоянного тока
G. K. Sabavath a, *, R. Swaroop b, J. Singh c, A. B. Panda d, S. Haldar e, N. Rao f, S. K. Mahapatra b
a Department of Physics, CMR Engineering College, Kandlakoya, Medchal, Hyderabad
Telangana, India
b Department of Physical Sciences, Central University of Punjab
Bathinda, India
c Department of Physics, Akal University, Talwandi Sabo, Bathinda
Punjab, India
d Birupa College, Indupur, Kendrapara
Odisha, India
e Hearne Institute for Theoretical Physics, Department of Physics and Astronomy, Louisiana State University, Baton Rouge
Louisiana, United State of America
f Department of Physics, St. Martins Engineering College, Secundrabad
Telangana, India
* E-mail: nayakgopikishan@gmail.com
Поступила в редакцию 06.10.2021
После доработки 21.01.2022
Принята к публикации 25.01.2022
- EDN: JRLLEG
- DOI: 10.31857/S0367292122200124
Аннотация
Пространственные распределения плазменных параметров, таких как температура электронов (Te) и их плотность (ne), а также скорости нанесения тонких титановых пленок изучались количественно на установке, где распыление частиц было организовано с помощью магнетронного разряда постоянного тока. Значения Te и ne определялись на основе измерений электронного потока и энергетического распределения электронов системой зондов Ленгмюра. Распределение концентрации электронов также вычислялось методом частиц в ячейках при моделировании столкновений методом Монте-Карло (PIC-MCC). Согласно наблюдениям величины Te и ne уменьшались по мере удаления от центра катода по радиусу и вдоль оси системы. Скорость нанесения тонких титановых пленок вела себя с удалением от катода аналогичным образом. На основе полученных экспериментальных и расчетных данных был выполнен анализ влияния конфигурации магнитного поля и изменения параметров плазмы на скорость нанесения пленок.
1. ВВЕДЕНИЕ
Распыления частиц в магнетронном разряде постоянного тока широко используется для нанесения тонких пленок. Этот метод привлекает значительное внимание исследователей из-за высокой скорости осаждения пленок [1]. Увеличение скорости осаждения происходит благодаря совместному действию аксиального магнитного поля и радиального электрического поля. В цилиндрическом магнетронном разряде заряженные частицы движутся под влиянием скрещенных электрического и магнитного полей. Энергичные электроны захватываются во внешнем магнитном поле, что приводит к существенному увеличению эффективности ионизации. Вследствие этого достигается высокая скорость нанесения тонких пленок при малом давлении газа [2]. Поведение частиц в плазме магнетронного разряда постоянного тока определяется именно магнетроном. В 1930–1940 гг. магнетроны цилиндрической формы стали использоваться для нанесения пленок при распылении частиц [3, 4]. Без применения магнетрона возможности метода оказались ограничены из-за малой степени ионизации, низкой скорости нанесения напыления и неустойчивости плазмы [5]. Поэтому понимание закономерностей поведения частиц в магнетроне важно для технологий нанесения тонких пленок [6–10]. Температура и концентрация электронов, а также скорость нанесения покрытий, могут меняться в пространстве, как вдоль оси разряда, так и в поперечном направлении. В результате такая неоднородность в магнетроне влияет на качество образуемых тонких пленок. Поэтому в последнее время внимание исследователей, интересующихся свойствами образующихся пленок, привлекает вопрос о распределении в пространстве параметров плазмы с учетом сложного распределения магнитного поля в плазменном столбе [11–17].
Знание пространственного распределения плазменных параметров позволяет оптимизировать плазмохимические реакции и процесс зарождения и роста тонких пленок. Для измерения характеристик плазмы используются различные методы. К ним относятся оптическая эмиссионная спектроскопия (OES), метод зондов Ленгмюра (LP), когерентное антистоксово комбинационное рассеяние (CARS), лазерно-индуцированная флуоресценция (LIF) и так далее [18–20]. В частности, метод LP позволяет измерять параметры плазмы в плазме низкого давления типа той, что используется в распылительных системах на основе магнетронного разряда постоянного токах [21–23].
В настоящее время ведутся измерения параметров плазмы с целью оптимизации процесса получения тонких пленок с заданными свойствами [24–26]. Однако взаимосвязь между параметрами магнетронного разряда постоянного тока, параметрами разрядной плазмы и скоростью нанесения пленок почти не исследовалась [27–32]. В [27] измерялись аксиальные распределения электронной температуры (Te) и концентрации (ne), которые менялись, соответственно, в диапазонах 1.5–2 эВ и 2.5 × 1011–4.5 × 1011 см−3 для систем с физическим осаждением паров (PVD) при магнетронном распылении. Но расчетные и экспериментальные результаты анализировались отдельно и не сопоставлялись друг с другом.
Исходя из сказанного, целью данной работы было определение радиальных и аксиальных распределений таких параметров плазмы, как Te and ne. Они находились методом зондов Ленгмюра, которые позволяли непосредственно измерять поток электронов на зонд (EF) и функцию распределения электронов по энергиям (EEDF). Конфигурация магнетрона и распределение магнитного поля в нем моделировались численно и сравнивались с реальным магнитным полем в установке. Пространственное распределение концентрации электронов вычислялось для реального распределения магнитного поля в магнетроне с помощью численного кода на основе метода частиц в ячейках с моделированием столкновений методом Монте Карло (PIC-MCC). Скорость осаждения (Dr) тонких титановых пленок при постоянном подводимом напряжении и заданном давлении газа определялась в тех же точках пространства, где проводились и зондовые измерения. Результаты определения скорости осаждения сопоставлялись и анализировались вместе с результатами расчетов и измерений параметров плазмы.
2. ТЕОРИЯ И ЧИСЛЕННАЯ МОДЕЛЬ
2.1. Функция распределения электронов по энергиям (EEDF)
Концентрация электронов (ne) и электронная температура (Te) вычислялись на основе функции распределения электронов по энергиям, которая определялась по вольтамперной (I–V) характеристике зонда Ленгмюра согласно соотношению [33, 34]
(1)
$f\left( \varepsilon \right) = \frac{4}{{A{{e}^{2}}}}\sqrt {\frac{m}{{2e}}} x\frac{{{{d}^{2}}{{I}_{e}}}}{{d{{V}_{p}}^{2}}},$(2)
${{n}_{e}} = \int\limits_0^{{{\varepsilon }_{{max}}}} {f\left( \varepsilon \right)d\varepsilon } ,$(3)
${{T}_{{eff}}} = \frac{2}{{3{{n}_{e}}}}\int\limits_0^{{{\varepsilon }_{{max}}}} {\varepsilon f\left( \varepsilon \right)d\varepsilon } ,$2.2. Метод электронного потока (EF)
Концентрация электронов и электронная температура также определялись по кривым I–V методом электронного потока. В этом случае температура электронов находилась из наклона кривых I–V с помощью соотношения
где I – ток на зонд, а V – его напряжение. Концентрация электронов оценивалась согласно бомовской теории приповерхностного слоя [36, 37] где Ies – электронный ток насыщения в зависимости I–V. Эти подходы являются классическими в отношении определения параметров плазмы на основе зондовых измерений. Причем метод электронного потока и метод функции распределения электронов по энергиям, как объяснялось ранее, отличаются друг от друга [38, 39].2.3. Детали численного моделирования
Распределение магнитного поля в магнетроне моделировалось с помощью пакета программ COMSOL Multiphysics. Магнетрон диаметром 6 см состоял из 13 магнитов D63, имеющих одну и ту же высоту h и радиус r. Один из магнитов (южный полюс) находился в центре системы и был окружен двенадцатью другими магнитами (северные полюса), как показано на рис. 1а. Конструкция реального магнетрона (см. рис. 1) отображалась в среде COMSOL с помощью решения уравнений ${{x}^{2}} + {{y}^{2}} = {{r}^{2}}$и $y = x\tan \theta $, где x, y – координаты каждого магнита, r – радиус магнетрона, а tan$\theta $ – угловой коэффициент. Концентрация плазмы в магнетроне постоянного тока вычислялась с помощью метода частиц в ячейках (PIC). Ионизация и другие столкновения моделировались в рамках метода Монте Карло (MCC). Профиль концентрации электронов определялся вдоль оси z при рассмотрении стабильной плазмы в магнитном поле магнетрона. Тепловые скорости вдоль осей x и y находились согласно максвелловскому распределению по скоростям. Подробная информация по алгоритмам метода PIC–MCC приведена в приложении.
3. ДЕТАЛИ ЭКСПЕРИМЕНТА
Схема системы распыления вещества в магнетронном разряде постоянного тока приведена на рис. 2. Она представляет собой цилиндрическую камеру из нержавеющей стали диаметром 27 см и длиной 23 см. Установка включает в себя оборудование для подвода постоянного напряжения (а), средства измерения, позволяющие снимать вольтамперную характеристику (б), разъемы компании Wilson (в), верхний фланец (г), цилиндрическую камеру из нержавеющей стали (д), пушку для магнетронного распыления (е), мишень (ж), систему зондов Ленгмюра (з), вакуумный насос (и), держатель подложки (к) и нижний фланец (л). На верхнем фланце устанавливаются магнетронная система распыления и зондовая система, а к нижнему фланцу крепится держатель подложки. Схема всей системы приведена в прежних публикациях [40, 41].
Рис. 2.
Схема системы распыления на основе магнетронного разряда постоянного тока: (a)–(л) разные части системы с пояснениями в тексте.
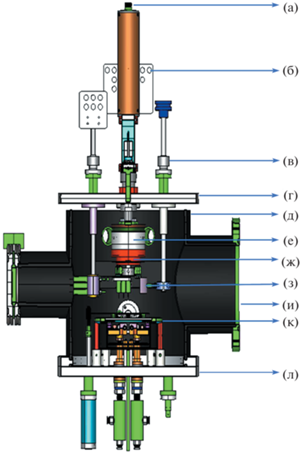
Многозондовая система (MLP) использовалась для измерения вольтамперных характеристик. Радиус Дебая был равен 1 × 10–4 м. Толщина приповерхностного слоя плазмы примерно равна удвоенному радиусу Дебая и составляла 0.2 мм, в то время как диаметр зонда Ленгмюра был равен 0.5 мм. Поскольку этот диаметр гораздо больше толщины слоя, то расстояние между зондами выбиралось равным 0.5 см, что позволяло снимать зондовые вольтамперные характеристики. При этом выполнялось условие того, что радиус зонда (0.25 мм) был много больше радиуса Дебая (λD = = 0.1 мм). Система зондов состояла из 4 цилиндрических зондов Ленгмюра, которые были изолированы друг от друга, располагались на кварцевой пластине и обозначались буквами A, B, C и D. Зонд A соответствовал центру катода, в то время как зонды B, C и D соответствовали радиальному сдвигу относительно центра на 0.5, 1 и 1.5 см. Все зонды были подключены к измерительной системе (Keithley 2410, 1100 В). Система зондов могла двигаться вверх и вниз без нарушения вакуума посредством разъемов компании Wilson. Пять различных позиций (с 1-й по 5-ю) соответствовали удалению от катода на 2.5, 3, 3.5, 4 и 4.5 см, соответственно. В каждый момент измерений система зондов располагалась на заданном расстоянии по оси и позволяла проводить исследования в четырех разных точках по радиусу плазменного столба. Вольтамперные характеристики снимались одновременно для каждого зонда. Измерения повторялись для пяти разных расстояний от катода, что в итоге давало информацию о вольтамперных характеристиках для 20 разных точек в пространстве. Значения ne и Te в этих точках получались из обработки измеренных характеристик.
Камера откачивалась центробежным и диффузионным насосами до давления 5 × 10−6 мбар. Рабочее давление составляло 6 × 10−3 мбар и контролировалось во время эксперимента. Рабочим газом был аргон, которым наполнялась камера со скоростью 20 см3/мин при стандартных условиях. Для распыления использовалась титановая мишень диаметром 5.08 см и толщиной 3 мм, которая для этого помещалась в магнетронную систему. Силиконовые подложки размером 5 × 5 мм2 и толщиной 0.5 мм перед нанесением пленок очищались с помощью разбавленной фтороводородной кислоты, после чего на протяжении 15 минут производилась их обработка ультразвуком. Далее подложки высушивались при комнатной температуре. Эти подложки могли устанавливаться в тех же четырех различных положениях по радиусу и пяти различных положениях по оси, что и зонды, с помощью которых снимались вольтамперные характеристики. Зондовая система сдвигалась, а на ее место помещались подложки во время напыления титановых пленок. В этом режиме подводимая мощность составляла 16 Вт (320 В × × 0.05 A). Для оценки скорости нанесения пленок (Dr) измерялся вес подложки до и после осаждения пленки. Измерения производились с помощью аналитических приборов фирмы Mettler-Toledo (производство Германии). Скорость Dr определялась как отношение разницы весов подложки после и до осаждения к времени осаждения. Толщина осажденной пленки анализировалась с помощью прибора для измерения профиля поверхности.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
На рис. 3 представлены распределение силовых линий магнитного поля в магнетроне (а) и радиальные распределения этого поля для трех различных расстояний в направлении по оси от магнетрона: (б) 0 см, (в) 1 см и (г) 2 см. Из рисунка следует, что с удалением от катода вдоль оси магнитное поле уменьшается.
Рис. 3.
Силовые линии магнитного поля (a) и радиальные профили магнитного поля при удалении от магнетрона на 0 см (б), 1 см (в) и 2 см (г).

При удалении от оси в радиальном направлении магнитное поле сначала растет, а потом падает. Этот вывод подтверждается природой магнитного поля, представленного на рис. 4, где приведены его измерения с помощью флюксометра. На рис. 4а представлены радиальные профили поля для пяти различных расстояний от магнетрона. Видно, что с удалением от него максимальные значения магнитного поля снижаются. Согласно рис. 4а радиальные распределения магнитного поля симметричны относительно центра катода. На рис. 4б приведено вычисленное распределение магнитного поля магнетрона. Наблюдается согласие между расчетными данными и результатами измерений магнитного поля.
Рис. 4.
Измеренные с помощью флюксометра радиальные профили магнитного поля для пяти разных положений по оси (a), распределение магнитного поля магнетрона, вычисленное с помощью пакета CST (б), распределение концентрации электронов в плазме магнетронного разряда постоянного тока, вычисленное методом PIC-MCC (на вкладке фото реальной плазмы) (в).

Измеренные распределения этого поля использовались для расчета распределений концентрации электронов в плазме. На рис. 4в представлен вычисленный методом PIC-MCC профиль концентрации электронов, который сравнивается с фотографией плазмы (см. вставку к рис. 4в). Концентрация электронов, как ожидается, уменьшается с удалением по радиусу от центра катода и вдоль оси от его поверхности. Для наглядности распределение концентрации электронов представлено в виде цветных профилей [42, 43]. Профили не являются гладкими из-за ограничений системы обработки данных на масштабах радиуса Дебая. Полученные расчетные данные согласуются с измерениями концентрации электронов, результаты которых приведены на рис. 5. Здесь представлены данные, полученные как методом EF, так и методом EEDF.
Рис. 5.
Распределение концентрации электронов по оси для четырех (A, Б, В и Г) разных положений по радиусу (a) и по радиусу для пяти (1, 2, 3, 4 и 5) разных положений по оси (б); 2D-распределение концентрации электронов, вычисленное методом EF (в) и методом EEDF (г).

Из рис. 5 следует, что ne снижается по мере удаления от центра катода, как вдоль оси, так и в радиальном направлении. В центральной области магнитное поле слабее по сравнению с внешней областью. Из-за этого электроны оказываются запертыми, и плазма фокусируется в центре. Поэтому выполняется сравнение концентрации электронов на оси и на расстояниях по радиусу вплоть до 1.5 см. Аналогичным образом, магнитное поле является большим около поверхности катода и слабеет при удалении от нее. Это вызывает изменение концентрации электронов с увеличением расстояния вдоль оси системы. Поэтому значения концентрации электронов около центра катода больше, чем на расстоянии 4.5 см от него в направлении оси. Распределение концентрации электронов в магнетронном разряде вычислялось на основе распределения магнитного поля и ранее [44]. Эти данные согласуются с результатами настоящей работы.
На рис. 6а и 6б приведены результаты измерения температуры электронов методами EF и EEDF. Здесь Te также снижается с удалением от центра катода по радиусу и по оси. Около катода при ионизационных столкновениях электронов с атомами рождаются новые электроны. Они приобретают высокую кинетическую энергию, поскольку в областях с сильным магнитным полем у катода температура Te высокая. При удалении от катода по оси кинетическая энергия электронов снижается, возможно – из-за столкновений с распыляемыми атомами. Поэтому температура Te снижается по мере удаления от поверхности катода. Около катода также возможна значительная потеря ионов и эмиссия вторичных электронов. Эти вторичные электроны ускоряются в электрическом поле слоя, но оказываются запертыми внешним магнитным полем. Локализация вторичных электронов может приводить к увеличению эффективности ионизации, что приводит к высоким значениям концентрации и температуры электронов перед катодной областью [45, 46]. Из анализа величин ne и Te, измеренных методами EF и EEDF, следует, что метод EF лучше подходит для случаев с немаксвелловским распределением электронов по энергиям, в то время как метод EEDF оправдан для случая, когда распределение максвелловское. Интересно наблюдать отличия в результатах измерения электронной температуры (ΔTe) и электронной концентрации (Δne), полученных методами EEDF и EF. На рис. 7 приведены эти отличия, которые определялись по формулам (6) и (7)
Рис. 6.
Распределение температуры электронов по оси для четырех (A, Б, В и Г) разных положений по радиусу (a) и по радиусу для пяти (1, 2, 3, 4 и 5) разных положений по оси (б); 2D-распределение температуры электронов, вычисленное методом EF (в) и методом EEDF (г).

Из рис. 7а следует, что максимальное отклонение по плотности электронов достигает (0.35–0.74) × × 1015 м–3 и наблюдается в областях, закрашенных на рисунке желтым, темно-красным и красным цветами (обозначены на рисунке штриховой линией). На рис. 5в область с максимальной концентрацией электронов отмечена аналогичными цветами (и линией с двумя стрелками) в левой нижней области рисунка. На рис. 7а в данной области различие между концентрациями, измеренными разными методами, существенно меньше – 0.08 × 1015 м–3 (область отмечена линией с двумя стрелками). Отсюда следует, что в области с высокой концентрацией электронов различия между результатами измерений разными методами невелико.
Аналогичным образом, область с меньшей температурой электронов характеризуется наибольшим отклонением в ее измерениях разными методами на рис. 6в. Это также видно на рис. 7б при удалении от центра катода более чем на 0.4 см по радиусу и более чем на 3.5 см по оси. Таким образом, из рис. 7 следует, что в областях с пониженными значениями концентрации и температуры электронов наблюдаются наибольшие различия между их измерениями разными методами. Поэтому магнитное поле приводит к эффективной локализации плазмы вблизи катода, где получается напыление тонких пленок с большими размерами зерен. Скорость напыления Dr измерялась в тех же точках пространства, что и значения Te и ne. Для определения этой скорости использовалось уравнение
где w1 и w2 – вес силиконовой подложки до и после напыления, а t1 и t2 – время начала и окончания напыления, соответственно.Рисунок 8 показывает, что значения Dr меняются в пространстве по аналогии со значениями ne и Te: скорость роста наибольшая около поверхности катода и уменьшается с удалением по радиусу и по оси. Об изменении скорости Dr с изменением магнитного поля также сообщалось ранее [47–49]; эти данные находятся в согласии с полученными в настоящей работе. На рис. 9 приведена измеренная толщина осаждаемых тонких пленок в зависимости от смещения вдоль оси и по радиусу системы. Эти распределения подобны распределениям параметров плазмы и скорости напыления Dr. В основе процесса распыления лежит реакция ${\text{Ar}} + M \to {{M}^{ + }} + {\text{Ar}} + e$. В непосредственной близости к поверхности (на расстояниях порядка 0.5 см от нее) наблюдаются более высокие температуры электронов. В результате ускорение заряженных частиц приводит к нанесению тонких пленок с более крупными зернами. Повышенная концентрация электронов около поверхности способствует более высокой концентрации ионов и нейтральных атомов титана, которые способствуют более быстрому росту тонких пленок [50].
ВЫВОДЫ
Пространственное распределение параметров плазмы и скорости осаждения пленок в описываемой магнетронной системе определяются пространственным распределением магнитного поля. Значения температуры и концентрации электронов уменьшаются с удалением от катода вдоль радиуса и по оси системы. Аналогичные закономерности наблюдаются и для распределения в пространстве скорости осаждения пленок. Магнитное поле реальной системы измеряется с помощью флюксметра и моделируется с помощью пакета программ COMSOL-Multiphysics. Изменение в пространстве параметров плазмы влияет на пространственное распределение скорости нанесения пленок.
Список литературы
Hull W. J. Am. Inst. Elect. Eng. 1921. V. 40. P. 715.
Greene J.E. Vac J. Sci. Technol. A. 2017. V. 35. P. 05C204.
Penning F.M. Physica. 1936. V. 3. P. 873.
Penning F.M., Moubis J.H.A. Proc. K. Ned. Akad. Wet. 1940. V. 43. P. 41.
Musil J. Surf. Coat. Tech. 1998. V. 100. P. 280.
Choi S.K., Lee J.I. J. Vac. Sci. Technol. A. 2001. V. 19. P. 2043.
Kwon U.H., Choi S.H., Park Y.H., Lee W.J. Thin Solid Films. 2005. V. 475. P. 2043.
Ivanov I., Kazansky P., Hultman L., Petrov I., Sundgren J.E. J. Vac. Sci. Technol. A. 1994. V. 12. P. 314.
Petrov I., Orlinov V., Ivanov I., Kourtev J. Contrib. Plasm. Phys. 1988. V. 28. P. 157.
Ayesh A.I., Qamhieh N., Ghamlouche H., Thaker S., El-Shaer M. J. Appl. Phys. 2010. V. 107. P. 034317.
Raggl S., Postler J., Winkler J., Strauss G., Feist C., Plankensteiner A., Eidenberger-Schober M., Scheier P. J. Vac. Sci. Technol. A. 2017. V. 35. P. 061308.
Poluektov N.P., Tsar’gorodsev Y.P., Usatov I.I., Evstig-neev A.G., Kamyschov I.A. J. Mod. Phys. 2012. V. 31. P. 494.
Borah S.M., Pal A.R., Bailung H., Chutia J. Chinese Phys. B. 2011. V. 20. P. 014701.
Holík M., Bilyk O., Marek A., Kudrna P., Behnke J.F., Tichý M. Contrib. Plasm. Phys. 2004. V. 44. P. 613.
Tang D.L., Fu R.K., Tian X.B., Peng P., Chu P.K. Nucl. Instrum. Meth. B. 2003. V. 206. P. 808.
Lagarde T., Arnal Y., Lacoste A., Pelletier J. Plasma Sources. Sci. Technol. 2001. V. 10. P. 181.
Wu S.Z. J. Appl. Phys. 2005. V. 98. P. 083301.
Nisha M., Saji K.J., Ajimsha R.S., Joshy N.V., Jaya-raj M.K. J. Appl. Phys. 2006. V. 99. P. 033304.
Aanesland A., Bredin J., Chabert P., Godyak V. Appl. Phys. Lett. 2012. V. 100. P. 044102.
Abu-Hashem A., Hassouba M.A., Masoud M.M. J. Mod. Phys. 2012. V. 3. P. 48.
Nakamura T., Okimura K. Vacuum. 2004. V. 74. P. 391.
Posadowski W.M. Thin Solid Films. 2001. V. 392. P. 201.
Seo D.C., Chung T.H., Yoon H.J., Kim G.H. J. Appl. Phys. 2001. V. 89. P. 4218.
Borah S.M. J. Mater. 2013. V. 9. P. 2013.
Kakati H., Pal A.R., Bailung H., Chutia J. J. Phys. D: Appl. Phys. 2007. V. 40. P. 6865.
Seo S.H., In J.H., Chang H.Y. J. Appl. Phys. 2004. V. 96. P. 57.
Bretagne J., Laporte C.B., Gousset G., Leroy O., Minea T.M., Pagnon D., de Poucques L., Touzeau M. Plasma Sources Sci. Technol. 2003. V. 12. P. 33.
Sheridan T.E., Goeckner M.J., Goree J. J. Vac. Sci. Technol. A. 1991. V. 9. P. 688.
Sherdian T.E., Goree J. J. Vac. Sci. Technol. A. 1989. V. 7. P. 1014.
Sherdian T.E., Goeckner M.J., Goree J. J. Vac. Sci. Technol. A. 1998. V. 16. P. 02173.
Goeckner M.J., Goree J.A., Sheridan T.E. IEEE T. Plasma. Sci. 1991. V. 19. P. 301.
Negrea C., Manea V., Covlea V., Jipa A. Plasma Phys. Reports. 2011 V. 37. P. 5.
Ivanov I., Statev S., Orlinov V., Shkevov R. Vacuum. 1992. V. 43. P. 837.
Gudmundsson J.T., Alami J., Helmersson U. Appl. Phys. Lett. 2001. V. 78. P. 3427.
Singh S.B., Chand N., Patil D.S. Vacuum. 2009. V. 83. P. 372.
Merlino R.L. Am. J. Phys. 2007. V. 12. P. 1078.
Amemiya H. J. Phys. D: Appl. Phys. 1990. V. 23. P. 999.
Barjatya A. Doctor of Philosophy, thesis (2007), http://digitalcommons.usu.edu/etd/274.
Godyak V.A., Piejak R.B., Alexandrovich B.M. J. Appl. Phys. 1993. V. 73. P. 3657.
Gopikishan S., Kumar P., Iyengar A.S., Banerjee I., Mahapatra S.K. Results Phys. 2019. V. 12. P. 1814.
Sabavath G.K. Plasma Phys. Reports. 2020. V. 46. P. 6.
Birdsall C.K. IEEE Transactions Plasma. Sci. 1991. V. 19. P. 65.
Serikov V.V., Kawamoto S., Nanbu K. IEEE Transactions Plasma. Sci. V. 27. P. 1389.
Ekpe S.D., Jimenez F.J., Field D.J., Davis M.J., Dew S.K. J. Vac. Sci. Technol. A. 1999. V. 27. P. 1275 (2009).
Mišina M., Setsuhara Y., Miyake S. J. Vac. Sci. Technol. A. 1997. V. 15. P. 1922.
Borah S.M., Bailung H., Pal A.R., Chutia J. J. Phys. D: Appl. Phys. 2008. V. 41. P. 195205.
Papa F., Gerdes H., Bandorf R., Ehiasarian A.P., Kolev I., Braeuer G., Tietema R., Krug T. Thin Solid Films. 2011. V. 520. P. 1559.
Dickson M., Hopwood J. J. Vac. Sci. Technol. A. 1997. V. 15. P. 2307.
Hellgren N., Macák K., Broitman E., Johansson M.P., Hultman L., Sundgren J.E. J. Appl. Phys. 2000. V. 88. P. 524.
Gudmundsson J.T. Plasma Sources Sci. Technol. 2020. V. 29. P. 113001.
Shon C.H., Lee J.K. Applied Surface Science. 2002. V. 269. P. 192258.
Longo S. Plasma Sources Science and Technology. 2000. V. 9.
Langdon A.B. J. Comput. Phys. 1970. V. 6. P. 247.
Langdon A.B., Birdsall C.K. Phys. Fluids. 1970. V. 13. P. 2115.
Computer modeling of low-temperature plasmas, Gas Discharges – Fundamentals & Applications / Ed. J. de Amorim Filho, F. Iza, S.H. Lee, and J.K. Lee (2007), p. 1–30.
Mandilas C., Daskalos E., Karagiannakis G., Konstandopoulos A.G. Materials Science and Engineering B. 2013. V. 178. P. 22.
Ahadi A., Sun Q. Acta Materialia. 2014. V. 76. P. 186.
Serov A.O., Mankelevich Yu.A., Pal A.F., Ryabinkin A.N. J. Phys.: Confer. Series. 2015. V. 653. P. 012127.
Rudolf T.H. NASA casi/ntrs archives 19910023412.
Kabla M., Seiner H., Musilova M., Shilo D. Acta Materialia. 2014. V. 70. P. 79.
Sigurjonsson P., Gudmundsson J.T. J. Phys.: Confer. Series. 2009. V. 100. P. 234.
Geiser J., Blankenburg S. Commun. Comput. Phys. 2012. V. 11. P. 1618.
Khomkin A.L., Shumikhin A.S. European Phys. J. D. 2009. V. 54. P. 493.
Smirnov B.M. Fundamentals of Ionized Gases (Wiley VCH, 2001).
Hensel F. J. Phys.: Condens. 1990. V. 2. P. SA33.
Upton T.H. Phys. Rev. Lett. 1986. V. 56. P. 2168.
Franz G. Low Pressure Plasmas and Microstructuring Technology (Springer, 2009).
Дополнительные материалы отсутствуют.
Инструменты
Физика плазмы






