Известия РАН. Серия физическая, 2022, T. 86, № 1, стр. 78-83
Влияние поверхностных слоев и сеток контактов кремниевого солнечного элемента на распределение фото-ЭДС по площади p–n перехода при локальном освещении
О. Г. Кошелев 1, *, Т. Н. Кост 1, А. Б. Чеботарева 1
1 Федеральное государственное бюджетное образовательное учреждение высшего образования
“Московский государственный университет имени М.В. Ломоносова”
Москва, Россия
* E-mail: Scon282@phys.msu.ru
Поступила в редакцию 24.08.2021
После доработки 06.09.2021
Принята к публикации 22.09.2021
- EDN: BOPBAI
- DOI: 10.31857/S0367676522010185
Аннотация
Исследованы искажения контраста фоточувствительности по площади солнечного элемента, связанные с токами вдоль n+ и p+ слоев, а также покрывающих их сеток контактов. Измерения проведены при частичном освещении солнечных элементов, у которых n+ и p+ слои были полностью или частично покрыты контактными сетками. Проведены также расчеты распределения фото-ЭДС по площади солнечного элемента непосредственно на p–n переходе.
ВВЕДЕНИЕ
В настоящее время наиболее распространенными являются солнечные элементы (СЭ) на основе кремния. Их КПД определяется в первую очередь величиной фоточувствительности, зависящей от величины времени релаксации фотопроводимости (τэф). Значения τэф зависят от величины времени жизни неравновесных носителей заряда (ННЗ) в объеме базовой области и скорости их поверхностной рекомбинации на тыльной стороне базы. Для получения максимального КПД фоточувствительность и, соответственно, τэф должны быть максимальными и практически одинаковыми по всей площади готовых СЭ [1]. Возникновение областей с низкой фоточувствительностью возможно не только при выращивании слитков кремния, но и в процессе последующих этапов изготовления СЭ, в частности, при нанесении p+ и n+ слоев. Для определения распределения значений τэф по площади исходных слитков и пластин кремния (сокращенно карты τэф) широко применяются методы, основанные на измерении нестационарной фотопроводимости по пропусканию или отражению СВЧ волн. При этом для возбуждения ННЗ используется сканирование поверхности импульсами луча лазера с энергией кванта hν больше ширины запрещенной зоны (Eg) кремния [2]. В этом случае время релаксации концентрации ННЗ в освещаемой области базы определяется их рекомбинацией и диффузией в неосвещаемую область. На последующих этапах изготовления СЭ используются и другие методы, например, QSSPC (Quasi-steady-state photoconductance) [3] и PLIR (Photo Luminescence Intensity Ratio) [4, 5] методы. Первый метод состоит в измерениях на радиочастотах нестационарной фотопроводимости, создаваемой импульсом белого света, медленно (по сравнению с временем жизни ННЗ) меняющегося по амплитуде. Второй метод основан на измерении фотолюминесценции вследствие излучательной рекомбинации ННЗ, возникающих под действием луча лазера также при hν > Eg. При наличии p+ и n+ слоев снижение значений τэф происходит и вследствие экстракции ННЗ из освещаемой области через p–n переход и их последующей инжекции в неосвещаемую область [6].
При наличии контактов измерения карты τэф проводятся по току короткого замыкания (метод LBIC – light beam induced current) [7] или напряжения холостого хода (метод LBIV – light beam induced voltage) [8], возникающих при сканировании поверхности p–n перехода лучом ИК лазера с энергией hν > Eg. Совместное использование этих методов представляет интерес, поскольку КПД СЭ зависит как от фототока, так и от фото-ЭДС. Наличие сетки контактов приводит к дополнительному сглаживанию рельефа фото-ЭДС. Попытка обнаружить контраст фотопроводимости CЭ из кремния была предпринята в [9]. Зондирование производилось с помощью СВЧ микроскопа ближнего поля на частоте 4.1 ГГц с разрешающей способностью около 10 мкм. Хотя контраст СВЧ проводимости в отсутствие света четко регистрировался, контраст СВЧ фотопроводимости практически не наблюдался. Влияние снижения фото-ЭДС из-за экстракции ННЗ из базовой области исследовалось в [10]. Путем расчетов было показано, например, что при времени жизни ННЗ τr =1000 мкс снижение напряжения на p–n переходе на 50 мВ (т.е. на 10%) может привести к уменьшению τэф в 9 раз.
Цель настоящей работы – исследовать распределение фото-ЭДС по площади локально освещаемой n+–p(n)–p+ однородной или неоднородной структуры как с контактами, так и без них.
УСЛОВИЯ ИЗМЕРЕНИЙ
Измерения проводились на двух СЭ, фоточувствительных с обеих сторон. Они были изготовлены из одной пластины с диффузионной структурой (p+nn+) Cz–Si, на основе монокристаллического кремния n-типа, выращенного по методу Чохральского (Cz–Si), толщиной 420 мкм c удельным сопротивлением 4.9 Ом ⋅ см. СЭ имели площадь 24 × 24 мм2. На p+ эмиттер глубиной ~0.5 мкм наносился просветляющий слой прозрачного проводящего оксида ITO (Indium Tin Oxide), а на n+-слой глубиной ~3 мкм наносился просветляющий слой прозрачного проводящего оксида IFO Indium Fluorine Oxide). Толщины слоев ITO и IFO составляли ∼0.08 мкм, а слоевые сопротивления (R◻) слоев ITO, p+, n+ и IFO были равны 52.3, 63.6, 130 и 38.5 Ом/◻ соответственно (по определению, слоевое сопротивление R◻ [Ом] = ρ/ω, где ρ – удельное сопротивление слоя, ω – его толщина. R◻ есть продольное сопротивление слоя квадратной формы произвольного размера. Видимо, поэтому оно часто и называется квадратным сопротивлением, при этом к его обозначению буквой R добавляется индекс в виде квадрата). Поверх этих слоев у стандартных СЭ по всей поверхности наносилась проволочная контактная сетка, изготовленная из медной проволоки диаметром 60 мкм, покрытой низкотемпературным припоем (Sn–In), с расстоянием между проволоками, равным 1.5 мм. Проволочные контакты прикреплялись низкотемпературным методом ламинирования одновременно к поверхности оксидов и к двум электрическим шинам, расположенным перпендикулярно с другой стороны. Применение таких контактов вместо широко применяемой серебряной пасты позволило снизить стоимость производства СЭ, а за счет уменьшения затенения p–n перехода повысить их КПД (технология изготовления таких СЭ описана в [11]).
В настоящей работе исследования проводились на стандартном СЭ с рассмотренными выше параметрами и на нестандартном, отличавшимся только тем, что контакты на нем были созданы в виде трех проволочек на лицевой (p+) и тыльной (n+) сторонах с одного края СЭ. Оба СЭ освещались лампой накаливания.
ОСНОВНЫЕ СООТНОШЕНИЯ
Влияние p+ и n+ слоев на снижение контраста фото-ЭДС определяется их слоевыми сопротивлениями R◻. Каждую пару слоев ITO–p+ и n+–IFO можно рассматривать как два сопротивления, соединенных параллельно. В этом случае суммарное слоевое сопротивление определяется из соотношения
(1)
${{R}_{\square }} = {{({1 \mathord{\left/ {\vphantom {1 {{{R}_{{ITO}}}}}} \right. \kern-0em} {{{R}_{{ITO}}}}} + {1 \mathord{\left/ {\vphantom {1 {{{R}_{{p + }}}}}} \right. \kern-0em} {{{R}_{{p + }}}}})}^{{--1}}} + {{({1 \mathord{\left/ {\vphantom {1 {{{R}_{{IFO}}}}}} \right. \kern-0em} {{{R}_{{IFO}}}}} + {1 \mathord{\left/ {\vphantom {1 {{{R}_{{n + }}}}}} \right. \kern-0em} {{{R}_{{n + }}}}})}^{{--1}}}.$Согласно (1), у исследованных СЭ R◻ = 58.5 Ом.
При наличии сетки контактов поверхностное сопротивление СЭ становится существенно меньше. В частности, если СЭ представляет собой прямоугольный параллелепипед длиной l, у которого по краям p–n перехода на расстоянии d нанесены контакты, то его сопротивление R равно [12]
(2)
$R\left[ {{\text{Ом}}} \right] = {{\rho d} \mathord{\left/ {\vphantom {{\rho d} {(12\omega l)}}} \right. \kern-0em} {(12\omega l)}},$(3)
$R = {{{{R}_{{\text{к}}}}} \mathord{\left/ {\vphantom {{{{R}_{{\text{к}}}}} {\Delta S}}} \right. \kern-0em} {\Delta S}},$Для обоих СЭ расчеты зависимостей тока (J) от напряжения (V) проводились на основании уравнения [12, 13]
(4)
${J \mathord{\left/ {\vphantom {J S}} \right. \kern-0em} S} = {{j}_{s}}\left[ {\exp \left( {{{qV} \mathord{\left/ {\vphantom {{qV} {AkT}}} \right. \kern-0em} {AkT}}} \right) - 1} \right] - {{j}_{{sc}}}.$Здесь S – площадь p–n перехода, js и jsc – плотности токов насыщения и короткого замыкания. k – постоянная Больцмана, T – температура, q – заряд электрона, A – фактор идеальности – численный множитель, обычно принимающий значения 1–3. В настоящей работе при расчетах использовалось значение А = 1.36, полученное на основании измерений напряжения холостого хода (Voc) и тока короткого замыкания от интенсивности света. Ток насыщения вычислялся из соотношения, следующего из формулы (4),
(5)
${{j}_{s}} = {{j}_{{sc}}}\left[ {\exp \left( {{{q{{V}_{{OC}}}} \mathord{\left/ {\vphantom {{q{{V}_{{OC}}}} {AkT}}} \right. \kern-0em} {AkT}}} \right) - 1} \right].$Количественное рассмотрение шунтирующего влияния p+ и n+ слоев с просветляющими покрытиями проводилось на нестандартном СЭ. Для этого он рассматривался как набор фотодиодов с номерами n = 1, 2, 3, …, N. Эти фотодиоды имели формы одинаковых тонких прямоугольных параллелепипедов, большие плоскости которых были перпендикулярны p–n переходу и параллельны проволочкам контактов. Расчеты проводились для случая, когда освещаемая на одном краю p–n полоса полностью перекрывала грани фотодиодов, на которых находился p–n переход. Отсчет номеров n начинался с этих фотодиодов, а заканчивался на фотодиоде, который находился между проволоками на p+ и n+ слоях ближайшего контакта вблизи другого края p–n перехода. Эквивалентная схема такой структуры представляет собой ряд из N параллельных одинакового размера фотодиодов, соединенных резисторами с сопротивлениями R(n) = Rк/(NSо), где Sо – площадь p–n перехода, не покрытая контактами. В этом случае напряжения V(n) на каждом из фотодиодов и токи ∆J(n) через них связаны соотношением
(6)
$V\left( {n + 1} \right) = V\left( n \right) + R\left( n \right)\left[ {{{J}_{R}}\left( {n - 1} \right) + \Delta J\left( n \right)} \right],$Количественное рассмотрение шунтирующего влияния сетки контактов проводилось на стандартном СЭ, у которого поверхности обоих сильно легированных слоев были целиком покрыты сетками металлических контактов. В этом случае расчеты существенно отличались. Эквивалентная схема такого частично освещаемого СЭ представлялась, как два параллельных фотодиода. Из них освещаемый фотодиод площадью SL нагружен на сопротивление RL. а неосвещаемый площадью SD – на сопротивление RD, где RL = Rк/SL, RD = Rк/SD. При этом в режиме холостого хода напряжение на контактах VК равно
где VL и VD – напряжения на освещаемом и неосвещаемом фотодиодах, а JL и JD – токи через них, протекающие в противоположных направлениях. При этом значения VL подбирались такими, чтобы выполнялось равенство (7).РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Исследования влияния p+ и n+ слоев на сглаживание контраста фотоЭДС проводилось на нестандартном СЭ, у которого проволочные контакты были только вдоль одного края p–n перехода, а освещение производилось в узкой полосе с противоположного края. На рис. 1. приведены вычисленные при таких условиях зависимости фото ЭДС (V) по длине (Х) этого СЭ в области от края освещаемой полосы при Х = 0 мм до ближайших контактов при Х = 21 мм. Кривая 1 вычислена при таких же условиях, как при измерениях на этом СЭ (Voc = 402 мВ, Jsc = 14.3 мА, A = 1.7, R◻ = = 58.5 Ом/◻). Линия 2 при Х = 2–24 мм соответствует фотоЭДС, непосредственно измеренной на контактах этого СЭ. Как видно, измеренное напряжение отличается вычисленного вблизи Х = = 21 мм значения всего на 6%. Это небольшое расхождение связано, видимо, с тем, что при расчетах не учитывался ток через p–n переход в области контактов. Для сравнения на рисунке приведены также результаты других расчетов. Кривая 5 вычислена для предельного случая, когда шунтирующее действие высоко проводящих поверхностных слоев отсутствует (R◻ = ∞), а расплывание ННЗ из освещаемой области происходит только благодаря их диффузии (Эти расчеты проводились при длине диффузии ННЗ, равной 0.7 мм, характерной для базовых областей современных СЭ из монокристаллического кремния). Из сравнения кривых 1 и 5 видно, что поверхностные слои существенно сглаживают перепад напряжений между освещаемой и неосвещаемой областями. Контраст фото-ЭДС между этими областями снижается от 400 мВ у кривой 5 до 48 мВ у кривой 1. При этом значения фото-ЭДС в освещаемой области для этих кривых различаются на 40 мВ. Как отмечалось выше, такое изменение может привести к снижению времени релаксации ННЗ после импульсного освещения в несколько раз [10]. Кривая 3 в отличие от кривой 1 вычислена при R◻ = 100 Ом/◻, для нее контраст фото-ЭДС значительно больше – примерно 170 мВ. Кривая 4 соответствует освещению дефектного участка, у которого Voc = 350 мВ, Jsc = 10 мА. В этом случае, наоборот, контраст фото-ЭДС почти в 2 раза меньше, чем для кривой 1. Таким образом контраст фото-ЭДС между освещаемым и неосвещаемым участками p+–n–n+ структуры существенно зависит как от значения R◻, так и от наличия дефектных участков.
Рис. 1.
Вычисленные зависимости фото-ЭДС (V) для нестандартного солнечного элемента от расстояния (Х) до края освещаемой полосы при Х = 0 мм. Смысл кривых 1–5 пояснен в тексте.
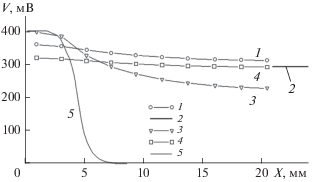
Сетки контактов еще более сглаживают рельеф контраста фото-ЭДС рассматриваемых СЭ. В настоящей работе их влияние исследовалось на другом СЭ, у которого лицевая и тыльная стороны были полностью покрыты сетками контактов. Результаты этих измерений и расчетов приведены на рис. 2. Здесь штриховой линией 1 (с точками) показана измеренная зависимость фото-ЭДС (Voc) от величины освещаемой площади (S) этого СЭ. В случае освещения всей площади этого СЭ Voc = 600 мВ, Jsc = 210 мА (плотность тока 34.4 мА/см2). Сплошной линией 2 показана расчетная зависимость, вычисленная при тех же значениях Voc и Jsc по формулам (5)–(7). Расхождение измеренной и расчетной кривых не превышает 2%. При этом напряжение непосредственно на p–n переходе было больше, чем на контактах. Их различие не превышало 5%. Для сравнения на этом рисунке кривой 3 показана также аналогичная зависимость, но для неоднородного СЭ, у которого дефектной области соответствует Voc = 500 мВ, а плотность тока 26 мА/см2. Расчет производился для случая освещения такой дефектной области. При этом предполагалось также, что размер дефектной области совпадает с размером освещаемой области. Как и следовало ожидать, значения Voc были меньше, чем для однородного СЭ при всех размерах освещаемой дефектной области. Разность между кривыми 2 и 3 характеризует контраст фото-ЭДС при сканировании неоднородных СЭ с такими параметрами.
Рис. 2.
Измеренная (1) и расчетные (2, 3) зависимости фото-ЭДС (Voc) однородного (1, 2) и неоднородного (3) солнечного элемента от площади (S) освещаемой области.

На рис. 3 показаны вычисленные зависимости напряжений V на стандартном СЭ от его поверхностного сопротивления Rк при освещении дефектного участка (кривые 2, 4) или бездефектного участка (кривые 1, 3). Кривые 1, 2 соответствуют фото-ЭДС Vk на контактах, которые не трудно померить. Тогда как сплошные кривые 3, 4 соответствуют напряжениям VL непосредственно на p–n переходе освещаемой области СЭ, которые и определяют контраст τэф. Зависимости напряжений на p–n переходах неосвещаемой области СЭ не приводятся, т.к. они отличались от напряжений на контактах менее, чем на 1%. Для неосвещаемой области расчеты проводились при Voc = = 550 В, Jsc = 40 мА/см2, А = 1. Для освещаемой области, если она является бездефектной, использовались эти же значения параметров, а если она является дефектной, расчеты проводились при Voc = 450 мВ, Jsc = 10 мА/см2, А = 1. Во всех случаях полагалось, что площадь освещаемой области равна 0.01 от общей площади. Разность напряжений для кривых 1 и 2 соответствует измеряемому на контактах контрасту фотоЭДС при освещении дефектного или бездефектного участков. Тогда как разность напряжений между кривыми 3 и 4 есть контраст фото-ЭДС непосредственно на p–n переходах при освещении тех же участков неоднородного СЭ. Как видно, при Rк < < 0.1 Ом ⋅ см2 эти разности практически одинаковы и составляют 37 мВ (вместо 100 мВ при отсутствии шунтирования). С ростом Rк при Rк > > 0.1 Ом ⋅ см2 контраст фото-ЭДС на p–n переходе заметно возрастает, тогда как на контактах он, наоборот, несколько снижается. При уменьшении площади дефекта это снижение становится еще сильнее.
ЗАКЛЮЧЕНИЕ
Проведены исследования искажений контраста фоточувствительности по площади СЭ, связанных с шунтирующим влиянием n+ и p+ слоев и покрывающих их сеток контактов. Предложена методика расчета таких искажений. Исследования проводились на СЭ, у которых n+ и p+ слои были полностью или частично покрыты сеткой контактов. Результаты измерений фото-ЭДС на контактах отличались от расчетных не более, чем на 6%. Получено, что контраст фото-ЭДС между освещаемыми участками с различной фоточувствительностью, измеряемый на контактах, может быть в несколько раз меньше, чем непосредственно на p–n переходе вследствие токов вдоль n+ и p+ слоев, а также по сеткам контактов. Расчеты показали также, что контраст фото-ЭДС между освещаемой и неосвещаемой областями неоднородного солнечного элемента становится меньше, чем для однородного.
Авторы признательны Г.Г. Унтиле, благодаря которому была поставлена настоящая работа.
Список литературы
Wezep D.A., Velden M.H.L., Bosra D.M. et al. // Proc. 26th EU PVSEC (Munich, 2016). P. 1423.
Palais O., Gervais J., Clere L. et al. // Mater. Sci. Engin. 2000. V. 71. P. 47.
Sinton R.A. // Proc. 25th IEEE Photovoltaic. Spec. Conf. (Washington, 1996) P. 457.
Chung D., Mitchell B., Juhl M.K. et al. // IEEE J. Photovolt. 2018. V. 8. No. 4. P. 943.
Wurfel P., Trupke T., Puzzel T. et al. // J. Appl. Phys. 2007. V.101. No. 12. Art. No. 123110.
Кошелев О.Г. // Изв. РАН. Сер. физ. 2020. Т. 84. № 1. С. 52; Koshelev O.G. // Bull. Russ. Acad. Sci. Phys. 2020. V. 84. No. 1. P. 44.
https://www.czl.ru/applications/light-beam-induced-current-lbic/.
Benda V. // Proc. 20th EU PVSEC. (Barcelona, 2005). P. 670.
Hovsepyan A., Babajanyan A., Sargsyan T. et al. // J. Appl. Phys. 2009. V. 106. Art. No. 114901.
Koshelev O.G., Untila G.G. // Phys. Wave Phenom. 2016. V. 24. No. 3. P. 214.
Untila G.G., Kost T.N., Chebotareva A.B. et al. // Prog. Photovolt. 2015. V. 23. P. 600.
Васильев А.М., Ландсман А.П. Полупроводниковые фотопреобразователи. М.: Сов. радио, 1971.
Зи С. Физика полупроводниковых приборов. М.: Мир, 1984. 455 с.
Дополнительные материалы отсутствуют.
Инструменты
Известия РАН. Серия физическая