Известия РАН. Серия физическая, 2022, T. 86, № 7, стр. 981-984
Деформация полуполярного и полярного нитрида галлия, синтезированного на подложке кремния
В. Н. Бессолов 1, М. Е. Компан 1, Е. В. Коненкова 1, *, С. Н. Родин 1
1 Федеральное государственное бюджетное учреждение науки
“Физико-технический институт имени А.Ф. Иоффе Российской академии наук”
Санкт-Петербург, Россия
* E-mail: lena@triat.ioffe.ru
Поступила в редакцию 14.02.2022
После доработки 28.02.2022
Принята к публикации 23.03.2022
- EDN: RAORGJ
- DOI: 10.31857/S0367676522070109
Аннотация
Представлены результаты исследования деформации полуполярного GaN(11–22) выращенного на наноструктурируемой подложке Si(113) и полярного GaN(0001) – на плоской подложке Si(111). Показано, что эпитаксия полуполярной структуры по сравнению с полярной приводит к снижению деформации слоя, и обусловлена меньшим различием коэффициентов термического расширения подложки и нитрида галлия в полуполярном направлении кристалла, чем в полярном.
В последнее время значительные усилия направляются на создание и исследование структур на основе AlN и GaN, которые перспективны для создания новых каналов связи с высокой скоростью передачи данных для интернет-коммуникаций [1].
В последние годы каналы связи в видимом свете, которые используют диапазон 400–790 ТГц, рассматриваются как перспективные устройства для уменьшения перегрузки полосы пропускания в каналах связи [2]. Оптоэлектронные приборы с использованием полярной плоскости GaN обладают сильным внутренним поляризационным полем, что приводит к пространственному разделению электронов и дырок в квантовых ямах и уменьшению их излучательной рекомбинации и не обладают достаточным быстродействием для каналов связи в видимом свете. Одним из возможных путей повышения быстродействия и эффективности люминесценции квантово-размерных структур является выращивание III-нитридных излучателей вдоль полуполярных ориентаций. Из всех полуполярных ориентаций (11-22) GaN, возможно, является лучшим выбором для получения. светодиодов с более длинной длиной волны для высокоскоростных применений [1].
Полуполярные (11–22) GaN слои, выращенные на сапфире m-плоскости, позволили получить высокоэффективные светодиоды InGaN/GaN пригодные для применения их в каналах связи в видимом свете [3]. В настоящее время предпринимаются попытки синтезировать полуполярные нитриды галлия и алюминия [4, 5], в которых предлагается для синтеза использовать наклонную грань Si(111).
Полуполярный GaN(11–22) на кремнии удалось получать за счет роста на структурированных кремниевых Si(113) подложках с полосатыми канавками [6].
В работе [7] синтезирован GaN(11–22) на микроструктурированных подложках Si(113) с рисунком периодических квадратных окон, который показал низкую плотность дефектов и хорошие оптические свойства. Недавно наша группа получила полуполярные GaN(10–11) и AlN(10–12) на наноструктурированных V-образных Si(100) подложках, которые показали неплохие рентгеноструктурные характеристики [8, 9], однако полуполярные GaN(11–22) слои являются наиболее привлекательными для светодиодов [10].
Данная работа посвящена изучению деформации слоев полуполярного GaN(11–22) при эпитаксии на подложке Si(113), на поверхности которой сформирована наноструктура с размером элементов <100 нм (темплейт NP-Si(113)). Для выполнения поставленной цели формировался темплейт с периодом 75 нм, высотой наклонных узких прямоугольных нанохребтов 75 нм с нанополосками аморфного нитрида кремния SiN на вершинах (рис. 1).
В ходе технологического эксперимента в одинаковых температурно-временных режимах выращивались два образца – полуполярные слои GaN(11–22) на NP-Si(113) и, для сравнения, полярный GaN(0001) на плоской подложке Si(111). Слои AlN и GaN были выращены методом MOCVD на модифицированной установке EpiQuip с горизонтальным реактором и индукционно нагреваемым графитовым подложкодержателем. Водород использовался в качестве несущего газа, а аммиак, триметилгаллий и триметилалюминий – в качестве прекурсоров. Структуры состояли из слоя AlN толщиной 20–30 нм и нелегированного слоя GaN толщиной ~1 мкм. Структурные характеристики слоев GaN определялись методами рентгеновской дифрактометрии, растровой электронной микроскопии, комбинационного рассеяния света (КРС). КРС изучалось с помощью рамановского спектрометра MRS 320 Источником света являлся гелий-неоновый лазер с длиной волны излучения 632.8 нм. Исследования проводились при комнатной температуре аналогично [11].
Рентгенодифракционный анализ слоев показал, что слои имеют полуширину кривой рентгеновской дифракции ωƟ ~ 30 угл. мин для GaN(11–22) и ωƟ ~ 22 угл. мин для GaN(0002).
Исследование гетероструктур GaN(11–22)/ NP-Si(113) и GaN(0001)/Si(111) с помощью КРС позволило выявить различие в деформации структур при эпитаксии на плоской подложке Si(111) и на темплейте NP-Si(113). Спектры КРС, измеренные в области фононной моды E2(high), для слоев GaN, выращенных на NP-Si(113) и Si(111), в целом соответствовали тому, что можно было ожидать и содержали линии, принадлежащие кремниевой подложке, линии E2(high), обусловленные нитридом галлия. Положение линии E2(high) зависело от структуры и составляло 563.3 cм–1 для GaN(0001)/Si(111) и 565.2 cм–1 для GaN(11–22 )/ NP-Si(113) (рис. 2).
Рис. 2.
Спектр комбинационного рассеяния света структур GaN(11–22)/Si(113), обозначен 1, и GaN(0001)/Si(111), обозначен 2.

Различие в положении линий E2(high) для этих структур можно объяснить следующим образом. Из данных по КРС хорошо видно, что положение пика линии E2(high) для слоев GaN сдвинуто в низкочастотную сторону по отношению к его положению в недеформированном слое (при оценке принималось, что для ненапряженной структуры положение E2(high) = 568 cм–1), что свидетельствует о наличии деформации растяжения GaN в плоскости, параллельной плоскости подложки. Для слоев GaN(0001) и GaN(11–22) по выражению Δω = Кσ, где К = 4.2 cм–1 · ГПа–1, оценивалась величина продольных упругих напряжений – σ. Оказалось, что величины σ существенно различаются: σ(0001) −1.12 ГПа и σ(11-22) –0.67 ГПа, соответственно, для GaN(0001)/Si(111) и GaN(11–22 )/ NP-Si(113) структур.
Полученные величины упругих напряжений включают в себя остаточные упругие напряжения σΔa, которые возникают при температуре эпитаксии GaN = 1030°С, и напряжения σΔα, которые возникают при охлаждении структур GaN(0001)/Si(111) и GaN(11–22)/NP-Si(113). Поскольку зарождение и рост слоя GaN происходит на плоскости Si(111) или на гранях Si(111) мы полагаем, что остаточные упругие напряжения при температуре эпитаксии σΔα будут одинаковы для обоих типов структур, а напряжения, которые возникают при охлаждении могут различаться из-за различия коэффициентов термического расширения плоскостей сопряжения: GaN(0001)/Si(111) и GaN(11–22)/ NP-Si(100).
Действительно, величины упругих напряжений структур GaN(0001)/Si(111) и GaN(11–22)/ NP-Si(113), которые возникают при охлаждении, зависят от различия коэффициентов термического расширения GaN и Si Δα = αGaN-αSi для плоскостей сопряжения. Как известно, коэффициенты термического расширения Si kSi = 3.6 · 10–6 К–1 [12], а в GaN из-за анизотропии кристаллов коэффициенты различаются: в направлении осей, $\left\langle {\text{a}} \right\rangle $ – kGaN(a) – 5.6 · 10–6 К–1 [13] и $\left\langle {\text{c}} \right\rangle $ – kGaN(c) = 3.17 · ⋅ 10–6 К–1 [14]. Тогда, согласно [15], напряжение, возникающее в гетероструктуре из-за разницы коэффициентов термического растяжения, можно оценить из выражения
(1)
${{{{\sigma }}}_{{\Delta \propto }}} \approx \frac{E}{{1 - {{\nu }}}} \times \Delta \propto \Delta T,$Поскольку в настоящее время известны коэффициенты термического расширения только в направлении $\left\langle {\text{a}} \right\rangle $ и $\left\langle {\text{c}} \right\rangle $, то при охлаждения полуполярного GaN(11–22) слоя на кремниевой подложке предлагается ввести эффективный коэффициент термического расширения полуполярного слоя в направлении $\left\langle {{\text{11--22}}} \right\rangle $ – $k_{{{\text{GaN}}\left( {{\text{11--22}}} \right)}}^{ * },$ который должен быть в интервале kGaN(c) < < $k_{{{\text{GaN}}\left( {{\text{11--22}}} \right)}}^{ * }$ < kGaN(a) (рис. 3б). Очевидно, что если положить $k_{{{\text{GaN}}\left( {{\text{11--22}}} \right)}}^{ * }$ = 4.47 · 10-6 К–1, то тогда величина σΔα(11–22) = –0.34 ГПа и совпадает с экспериментально полученной величиной напряжения для полуполярного слоя.
Рис. 3.
Схематическое изображение соотношений коэффициентов термического расширения слоев GaN(0001) (а) и GaN(11–22) (б) на подложках кремния.
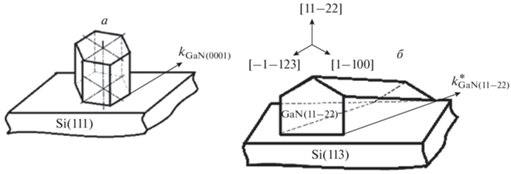
Итак, применение наноразмерной структурированной подложки Si(113) при формировании слоя полуполярного GaN(11–22) на темплейте предпочтительней, чем полярного GaN(0001) на подложке Si(111) из-за меньшей деформации в процессе охлаждения структуры от температуры роста до комнатной.
Авторы благодарят В.К. Смирнова за предоставление темплейтов. Исследования выполнены при частичной финансовой поддержке Российского фонда фундаментальных исследований (проект № 20-08-00096).
Список литературы
Haggar J.I.H., Cai Y., Ghataora S.S. et al. // ACS Appl. Electron. Mater. 2020. V. 2. No. 8. P. 2363.
Bao Q., Zhu T., Zhou N. et al. // J. Cryst. Growth. 2015. V. 419. P. 52.
Quan Z., Dinh D.V., Presa S. et al. // IEEE Photonics J. 2016. V. 8. No. 5. P. 1.
Honda Y., Kameshiro N., Yamaguchi M., Sawaki N. // J. Cryst. Growth. 2002. V. 242. No. 1–2. P. 82.
Bessolov V., Zubkova A., Konenkova E. et al. // Phys. Stat. Sol. B. 2019. V. 256. No. 2. Art. No. 1800268.
Tanikawa T., Hikosaka T., Honda Y. et al. // Phys. Stat. Sol. C. 2008. V. 5. No. 9. P. 2966.
Yu X., Hou Y., Shen S. et al. // Phys. Stat. Sol. C. 2016. V. 13. No. 5–6. P. 190.
Бессолов В.Н., Компан М.Е., Коненкова Е.В. и др. // Письма в ЖТФ. 2019. Т. 45. № 11. С. 3; Bessolov V.N., Kompan M.E., Konenkova E.V. et al. // Tech. Phys. Lett. 2019. V. 45. No. 6. P. 529.
Бессолов В.Н., Компан М.Е., Коненкова Е.В., Пантелеев В.Н. // Письма в ЖТФ. 2020. Т. 46. № 2. С. 12; Bessolov V.N., Kompan M.E., Konenkova E.V., Panteleev V.N. // Tech. Phys. Lett. 2020. V. 46. No. 1. P. 59.
Shen S., Zhao X., Yu X. et al. // Phys. Stat. Sol. A. 2020. V. 217. No. 7. Art. No. 1900654.
Аксянов И.Г., Компан М.Е., Кулькова И.В. // ФТТ. 2010. Т. 52 № 9. С. 1724; Aksyanov I.G., Kompan M.E., Kul`kova I.V. // Phys. Solid State. 2010. V. 52. No. 9. P. 1850.
Katona T.M., Speck J.S., Denbaars S.P. // Phys. Stat. Sol. A. 2002. V. 194. No. 2. P. 550.
Qian W., Skowronski M., Rohrer G.S. // MRS Online Proc. Library. 1996. V. 423. P. 475.
Maruska H.P., Tietjen J.J. // Appl. Phys. Lett. 1969. V. 15. No. 10. P. 327.
Dai Y., Li S., Gao H. et al. // J. Mater. Sci. Mater. Electron. 2016. V. 27. No. 2. P. 2004.
Дополнительные материалы отсутствуют.
Инструменты
Известия РАН. Серия физическая