Кристаллография, 2019, T. 64, № 4, стр. 624-631
Ионно-лучевое осаждение нанокристаллов и нанопленок InGaAs на подложках арсенида галлия
М. Л. Лунина 1, *, Л. С. Лунин 1, 3, И. А. Сысоев 2, Д. А. Гусев 2, А. Е. Казакова 3
1 Федеральный исследовательский центр Южный научный центр РАН
Ростов-на-Дону, Россия
2 Северо-Кавказский федеральный университет
Ставрополь, Россия
3 Южно-Российский государственный политехнический университет (НПИ) им. М.И. Платова
Новочеркасск, Россия
* E-mail: lunin_ls@mail.ru
Поступила в редакцию 12.09.2017
После доработки 29.03.2018
Принята к публикации 10.05.2018
Аннотация
Экспериментально показана возможность выращивания массивов нанокристаллов InxGa1 – xAs на GaAs-подложках методом ионно-лучевого осаждения. Исследовано влияние энергии ионов, плотности тока, а также времени осаждения распыляемых материалов на высоту, латеральный размер и плотность массивов наноразмерных кристаллов InxGa1 – xAs. Исследованы возможности контролируемым образом изменять параметры осаждения нанокристаллов InxGa1 – xAs(GaAs). Определены технологические параметры выращивания нанопленок InGaAs на GaAs. Исследованы состав, кристаллическое совершенство и фотолюминесценция выращенных нанокристаллов и пленок InxGa1 – xAs на GaAs.
ВВЕДЕНИЕ
Достижения в области полупроводниковой оптоэлектроники стимулировали исследования фотоактивных материалов и структур, а также разработку методов их получения [1–4]. В настоящее время наибольший интерес для оптоэлектроники представляют фотоактивные материалы на основе полупроводниковых соединений и твердых растворов AIIIBV [5–9]. Это обусловлено фотоэлектрическими, оптическими, электрофизическими параметрами и характеристиками материалов. К примеру, на основе гетероструктур InxGa1 – xAs/GaAs могут быть изготовлены полупроводниковые лазеры, фотодатчики и светодиоды, работающие в ближнем ИК-диапазоне видимого спектра и позволяющие успешно решать достаточно широкий круг технических задач [10–15].
Твердые растворы AIIIBV и нанопленки на их основе являются основными материалами нового этапа развития оптоэлектроники [16–23]. Для получения твердых растворов AIIIBV и нанопленок на их основе широко применяются методы молекулярно-лучевой, газофазной и жидкофазной эпитаксии. Несмотря на стремительный и долгий путь своего развития, неоспоримые достоинства, данные технологические методы становятся все сложнее. Внимание многих исследовательских лабораторий приковано к поиску новых, более простых технологических решений.
Одним из таких решений может быть метод ионно-лучевого осаждения (ИЛО). Он является относительно простым и дешевым технологическим решением, позволяющим получать полупроводниковые эпитаксиальные пленки и наноструктуры [24–27].
Суть метода ИЛО заключается в направленном распылении мишени, изготовленной из осаждаемого материала ускоренными частицами. Распыленные частицы мишени образуют поток осаждаемого материала. Более подробно аспекты технологии ИЛО рассмотрены в [22–27]. Несмотря на широкое применение в микроэлектронной промышленности методов ионного распыления, исследование процесса кристаллизации нанокристаллов и нанопленок AIIIBV данным методом изучено слабо. Закономерности и особенности влияния технологических параметров ИЛО на низкоразмерные кристаллы и нанопленки практически не изучены. Исследование возможности управления формой, размерами и плотностью нанокристаллов применительно к данному методу могло бы дать дополнительную гибкость при его использовании. В связи с этим исследование процесса кристаллизации нанокристаллов и нано-пленок на основе многокомпонентных твердых растворов методом ИЛО представляется весьма актуальным.
В данной работе экспериментально исследуется влияние энергии ионов, плотности ионного тока, а также времени кристаллизации распыляемых материалов при ИЛО на высоту, латеральный размер и плотность массивов низкоразмерных кристаллов и нанопленок InxGa1 –xAs на подложках GaAs и их свойства.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Исследуемые нанокристаллы и нанопленки выращены методом ИЛО на подложках арсенида галлия АГЧО (100) с концентрацией носителей заряда n-типа порядка 2 × 1017 см–3 диаметром 35 мм. Выращивание нанокристаллов InxGa1 – xAs на подложках GaAs проводили на экспериментальной установке ИЛО, выполненной на базе стандартной ростовой камеры с двухуровневой вакуумной системой, источником ионов КЛАН-53 М, блоком электропитания СЕФ-53 М, системой газоподачи и автоматической заслонки.
Получение нанокристаллов и нанопленок InxGa1 – xAs на подложках GaAs имело следующую последовательность. Исходные компоненты взвешивали на высокоточных аналитических весах в соответствующих долях, общая масса шихты составляла 10 г. Полученную смесь компонентов измельчали до порошкообразного состояния однородной фракции (размер зерен ~ 0.2–0.3 мм), тщательно перемешивали и спрессовывали. Готовую мишень помещали в ячейку кассеты-источника, ориентированную под углом 45° по отношению к подложке. Устройство ростовой камеры и технологической оснастки установки ИЛО рассмотрено в [25, 26].
Подложки после стандартной предварительной очистки помещали в кассету для выращиваемых соединений, затем в ростовой камере установки ИЛО создавался вакуум (остаточное давление 6 × 10–4 Па). Для более тонкой очистки поверхности подложки проводили дополнительную обработку непосредственно в технологической камере с помощью ионного пучка аргона при рабочем давлении 8 × 10–4 Па. Далее с помощью резистивного нагревателя проводили нагрев подложки до температуры в диапазоне от 500 до 600°С и осуществляли процесс синтеза нанокристаллов и нанопленок.
Также требовалась обработка мишени ионами в камере, параметры которой были следующими: время очистки tоч = 15–30 мин, энергия ионов – 500–800 эВ, ток ионного пучка – 15–20 мА. По окончании ионной очистки распыляемая мишень совмещалась с подложкой и проводился процесс кристаллизации нанокристаллов и нанопленок InxGa1 – xAs на GaAs.
В серии экспериментов по исследованию влияния скорости кристаллизации на параметры массивов нанокристаллов InxGa1 – xAs значение энергии ионного пучка устанавливали в диапазоне 700–1200 эВ, что соответствовало диапазону величины тока ионного пучка 18–30 мА, так как в ионном источнике КЛАН-53 М эти параметры взаимосвязаны.
При исследовании характера влияния времени кристаллизации на формирование нанокристаллов и нанопленок длительность технологического процесса выращивания составляла 1, 2, 4, 6 и 8 мин. Температура осаждаемой подложки, энергия ионов и ток ионного пучка в серии экспериментов имели одинаковое значение и составляли 550°С, 1000 эВ, 25 мА соответственно.
Исследование поверхности образцов после кристаллизации нанокристаллов твердого раствора InxGa1 – xAs на GaAs проводили на атомно-силовом микроскопе NM-MDT Ntegra и сканирующем электронном микроскопе (СЭМ) Quanta 200.
Оценка кристаллического совершенства нанокристаллов и пленок осуществлялась методом рентгеновской дифракции на дифрактометре ТРС-1 в двухкристальной геометрии с использованием линий излучения меди CuKα1,2.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Установлено, что при сохранении постоянной температуры роста 550°С, времени выращивания 3 мин в диапазоне значений энергии ионов 700–800 эВ и ионного тока до 18–20 мА на поверхности подложки GaAs кристаллизуются нанокристаллы твердого раствора InGaAs с характерными латеральными размерами 30–50 нм. Их высота составляет 10–14 нм, поверхностная плотность – 7 × 109 мм–2. При увеличении энергии ионов до значений 800–900 эВ и соответственно ионного тока 20–23 мА размеры нанокристаллов увеличиваются незначительно и составляют 50–60 нм, высота 14–16 нм. На поверхности подложки наблюдается некоторое уменьшение плотности нанокристаллов. В данном случае она составляет 5 × 109 мм–2.
В диапазоне значений энергии 900–1000 эВ (23–25 мА) наблюдается несколько иная картина. Размеры нанокристаллов увеличиваются, а их плотность уменьшается. При этом уменьшается разброс по размерам и высоте, наблюдается более равномерное распределение нанокристаллов по поверхности. Размеры их составляют 60–65 нм, высота около 30 нм, поверхностная плотность 5 × × 109 мм–2. Нанокристаллы имеют форму, близкую к сферической.
На рис. 1 представлены результаты атомно-силовой микроскопии (АСМ) исследований образца, полученного при температуре подложки 550°С, времени кристаллизации 3 мин, энергии 1000 эВ и значении тока пучка 25 мА.
Рис. 1.
3D АСМ-изображение нанокристаллов InxGa1 – xAs(GaAs), полученных методом ИЛО (а); зависимость количества островков (N) от их размера (h) (б).

Исследования по выращиванию нанокристаллов InxGa1 – xAs при увеличении энергии ионов в диапазоне 1100–1200 эВ, тока ионного пучка 28–30 мА показали, что распределение нанокристаллов по размерам становится больше в диапазоне от 25 до 80 нм. При этом уменьшаются их плотность, разброс по высоте и расположение нанокристаллов становится менее однородным. Ширина оснований нанокристаллов и островков имеет диапазон 40–80 нм.
При уменьшении скорости роста нанокристаллы, получаемые методом ИЛО, характеризуются меньшим разбросом по размерам, высоте и более равномерным расположением на поверхности. По-видимому, данный факт связан с тем, что энергия распыленных частиц при ИЛО заметно превосходит тепловую энергию и они более подвижны. Уменьшение скорости кристаллизации при ИЛО приводит к увеличению роли диффузионных процессов на поверхности осаждаемого слоя, что ведет к улучшению структурных свойств формируемых нанокристаллов. Следовательно, в случае уменьшения скорости роста методом ИЛО возможно получать нанокристаллы с требуемыми параметрами. Однако скорость их роста при этом существенно снижается.
Характер влияния величины энергии ионов на размеры нанокристаллов представлен на рис. 2.
В проведенной серии исследований установлено, что оптимальное значение энергии ионов для кристаллизации InxGa1 – xAs на GaAs лежит в пределах 700–1000 эВ, значение тока пучка – 20–25 мА. При указанных значениях скорость роста составляет примерно 0.5–1 мкм/ч.
Выращивание нанокристаллов InxGa1 – xAs на GaAs можно проводить при меньших энергиях и значениях тока пучка для получения более упорядоченных массивов нанокристаллов, но скорость роста при этом существенно снижается. Увеличение энергии ионов нежелательно, так как увеличивается вероятность распыления мишени преимущественно в виде кластеров, что негативно отражается на параметрах выращиваемых наноразмерных кристаллов.
Исследовано влияние времени кристаллизации в условиях ИЛО на параметры массивов нанокристаллов InxGa1 – xAs. Первоначально время кристаллизации в серии исследований составляло 1 и 2 мин, затем было увеличено до 4, 6 и 8 мин. Энергия ионов в пучке, ток ионного пучка и температура в серии экспериментов также имели одинаковое значение: 1000 эВ, 25 мА, 550°С соответственно.
По результатам исследования образцов, выращенных при длительности роста в 1 мин, сделан вывод о полном отсутствии нанокристаллов на поверхности подложки. Следовательно, толщина образовавшегося смачивающего слоя недостаточна для достижения упругой релаксации поверхностных состояний. При большей длительности ростового процесса, равной 2 мин, на поверхности наблюдаются незначительные образования нанокристаллов с характерными размерами 7–14 нм, расположение которых является крайне неоднородным. Величина упругих напряжений в системе растет по мере увеличения толщины смачивающего слоя.
На рис. 3а приведено изображение системы нанокристаллов, сформировавшихся на поверхности подложки при увеличении времени роста до 4 мин. При указанной длительности ростового процесса характерные размеры нанокристаллов составляют 18–25 нм, средняя высота – около 5–7 нм. Общая поверхностная плотность нанокристаллов составляет 8 × 109 мм–2.
Результаты исследований при увеличении времени выращивания до 6 мин представлены на рис. 3б. При данной продолжительности ростового процесса на поверхности подложки наблюдается некоторое уменьшение числа нанокристаллов и их плотности в массиве.
Согласно приведенным результатам в данном случае увеличивается количество нанокристаллов, имеющих более крупные размеры. Видно, что чем больше время процесса, тем менее выраженным является островковый рост. Размеры нанокристаллов увеличиваются, а их количество уменьшается. Большая часть крупных нанокристаллов образовалась, вероятно, за счет коалесценции. В пространстве между сформировавшимися крупными нанокристаллами наблюдаются мелкие нанокристаллы более поздних поколений. Размеры нанокристаллов составляют примерно 26–60 нм. Общая поверхностная плотность нанокристаллов составляет 5 × 1010 мм–2.
При увеличении времени процесса роста до 8 мин на поверхности подложки GaAs образуется практически сплошная нанопленка твердого раствора GaxInAs1 – x с шероховатостью не более 6 нм (рис. 4).
На рис. 5 показан характер влияния времени кристаллизации на размеры нанокристаллов InxGa1 – xAs на GaAs в условиях ИЛО.
В итоге можно утверждать, что для выращивания массивов наноразмерных кристаллов InxGa1 – xAs на GaAs методом ИЛО при указанных выше параметрах технологического процесса продолжительность должна составлять не более 6 мин, а для получения нанопленок InGaAs на GaAs время процесса должно составлять более 8 мин.
Характерные спектры фотолюминесценции нанопленок InxGa1 – xAs представлены на рис. 6. Хорошо видно, что с изменением состава нанослоев изменится и положение пика фотолюминесценции. Так, при увеличении индия в составе пик смещается в сторону меньших энергий. А для третьего состава фотолюминесценция разбивается на два пика. Пик с меньшей энергией соответствует нанопленкам InxGa1 – xAs (h$v$ = 1.336 эВ), а с большей подложечному материалу – арсениду галлия h$v$ = 1.435 эВ.
Рис. 6.
Спектры фотолюминесценции наноструктур InxGa1 – xAs(GaAs). Состав и размеры нанокристаллов соответственно: 1 – In0.021Ga0.979As h =125 нм; 2 – In0.047Ga 0.953As h = 83 нм; 3 – In0.097Ga0.903As h = = 60 нм.

Отметим, что при исследовании влияния энергии ионов и продолжительности ростового процесса на размеры и количество нанокристаллов состав необходимо поддерживать постоянным. Эксперименты показали, что состав получаемых пленочных твердых растворов InxGa1 – xAs(GaAs) всегда соответствовал составу распыляемой мишени при различных условиях ее распыления (энергия ионов, ионный ток, температура подложки). Определение состава нанокристаллов прямыми методами с помощью воздействия сфокусированных электронных пучков с целью получения характеристического рентгеновского излучения не представляется возможным, так как размер пучка в десятки раз больше исследуемого объекта нанокристаллов. Поэтому используются косвенные методы, например фотолюминесценция.
Исследования элементного химического состава полученных нанопленок показали, что все три компонента In, Ga, As входят в их состав: In0.021Ga0.979As; In0.047Ga0.953As; In0.0907Ga0.903As (рис. 7).
Рис. 7.
Результаты рентгеновского энергодисперсионного микроанализа нанокристаллов InGaAs(GaAs), выращенных при энергии, токе ионов, температуре подложки, состав соответственно: 1000 эВ, 25 мА, 550°С, In0.021Ga0.979As (а, б); 1000 эВ, 25 мА, 550°С, In0.047Ga0.953As (в, г); 1000 эВ, 25 мА, 550°С, In0.0907Ga0.903As (д, е); а, в, д – графическое изображение элементного состава полученного соединения; б, г, е – соответствие атомных и весовых долей полученного состава.

Изучение структурного качества исследуемых нанокристаллов и нанопленок проводили методом регистрации рентгеновской дифракции. Видно, что на кривых дифракционного отражения (КДО) присутствуют пики, отвечающие плоскостям, ограничивающим нанокристаллы (рис. 8). Ограниченный набор таких пиков говорит о том, что существует преимущественное направление плоскостей огранки нанокристаллов.
Рис. 8.
Дифракционные кривые изопериодных нанокристаллов InxGa1 – xAs(GaAs) при x < 0.2 (а) и неизопериодных нанокристаллов InxGa1 – xAs (GaAs) при x > 0.2 (б).

Полуширина КДО (BH/2) подложки всегда меньше, чем сплошной нанопленки (рис. 9), причем с увеличением полуширины КДО эпитаксиального слоя росла аналогичная величина для подложки. Это связано с тем, что ухудшение структуры слоя приводит к появлению в нем дополнительных напряжений, воздействующих на подложку. При малой толщине полученных эпитаксиальных слоев InGaAs возрастание полуширины их КДО не приводило к увеличению полуширины КДО подложки. Уменьшение полуширины переходного слоя (неоднородного по составу) на границе раздела или его отсутствие приводят к улучшению кристаллического совершенства нанопленки в целом. Вследствие низкой плотности ростовых дефектов сохраняется однородность эпитаксиальных пленок InGaAs, о чем свидетельствует присутствие четко наблюдаемых толщинных осцилляций на КДО, обусловленных интерференцией излучения, дифрагируемого эпитаксиальной пленкой с планарным верхним и нижним ограничением (между прямой волной и двукратно отраженной).
Рис. 9.
КДО от подложки GaAs (1), изопериодной эпитаксиальной пленки In0.1Ga0.9As (2), неизопериодной эпитаксиальной пленки In0.3Ga0.7As (3).
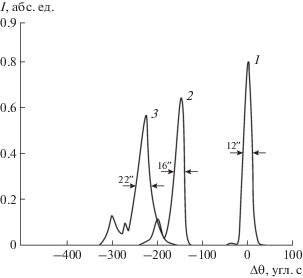
Отметим, что интерференционная картина диафрагируемого рентгеновского излучения в силу реализуемых в условиях дифракции четких фазовых соотношений оказывается наиболее чувствительной к минимальным нарушениям кристаллического совершенства, возникающим на начальной стадии релаксации упругих напряжений. Увеличение значения рассогласования параметров решетки слоя InGaAs и подложки GaAs ведет к уменьшению амплитуды, увеличению BH/2 и количества толщинных осцилляций, что в свою очередь указывает на ухудшение планарности эпитаксиальных слоев и гладкости границ (рис. 8, 9).
Кристаллическое совершенство нанопленок InGaAs/GaAs также оценивалось по электронограммам, снятым на отражение, путем анализа наличия кикучи-линий. Для изопериодных структур InGaAs/GaAs с несоответствием решеток Δa/a × 10–3 кристаллическая структура (по данным электронограмм) поверхностного слоя высокосовершенна, кристаллические плоскости строго параллельны, о чем свидетельствует наличие на электронограммах сетки штрихов и кикучи-полос. При увеличении несоответствия до 2.5 × 10–3 структура верхнего слоя мозаична, а более глубоких слоев (свыше 10 нм) совершенна. При еще большем увеличении несоответствия (до 0.25%) структура остается мозаичной на всю глубину эпитаксиального слоя, что свидетельствует о наличии негомогенности состава.
Анализ электронограмм показал, что для всех составов InxGa1 – xAs, изопериодных с GaAs, выросшие слои были монокристаллическими. Элекронограммы содержат сетку штрихов от плоскости (110), ось зоны [110] и кикучи-полосы. Наличие вытянутых к центру рефлексов (штрихов) свидетельствовал о высокой степени совершенства исследуемого слоя (монокристалличности). Присутствие кикучи-линий указывает на удовлетворительное кристаллическое совершенство более глубоких слоев.
ЗАКЛЮЧЕНИЕ
В результате экспериментальных исследований выявлено влияние технологических условий: энергии ионов, ионного тока и продолжительности ростового процесса – на параметры осаждения нанокристаллов InxGa1 – xAs на GaAs (плотность, латеральный размер, высоту). Значения энергии ионов 1000 эВ, тока пучка 25 мА и времени 8 мин являются оптимальными параметрами для выращивания однородных нанопленок InxGa1 – xAs на GaAs. Выращивание нанокристаллов InGaAs можно проводить при меньших энергиях и значениях тока пучка для получения более упорядоченных массивов островков, но скорость роста при этом существенно снижается. Увеличение энергии ионов нежелательно, поскольку распыляться компоненты мишени будут преимущественно в виде кластеров, что негативно отражается на параметрах выращиваемых наноразмерных кристаллов и нанопленок. Для получения требуемого массива наноразмерных островков InGaAs с минимальными размерами методом ИЛО продолжительность технологического процесса кристаллизации должна составлять 4–6 мин.
Проведенные рентгеноструктурные и микроскопические исследования подтверждают, что нанокристаллы и нанопленки InxGa1 – xAs, изопериодные с GaAs, полученные методом ИЛО, обладают достаточно высоким структурным совершенством.
Работа выполнена в рамках госзадания (грант № 16.4757.2017/8.9), при финансовой поддержке Российского фонда фундаментальных исследований (грант № 17-08-01206 А).
Список литературы
Seredina P.V., Glotova A.V., Lenshina A.S. et al. // Semiconductors. 2014. V. 48. № 1. P. 21.
Song H.Z., Hadi M., Zheng Y. et al. // Nanoscale. Res. Lett. 2017. V. 12. P. 128.
Gulebaglan S.E., Dogan E.K., Aycibin M. et al. // Cent. Eur. J. Phys. 2013. V. 11. № 12. P. 1680.
Gladysheva A.G., Novikova I.I., Karachinskya L.Ya. et al. // Semiconductors. 2016. V. 50. № 9. P. 1186.
Vinokurov D.A., Kapitonov V.A., Lyutetskiy A.V. et al. // Semiconductors. 2012. V. 46. № 10. P. 1321.
Shamakhov V.V., Nikolaev D.N., Lyutetskiy A.V. et al. // Semiconductors. 2014. V. 48. № 3. P. 373.
Schättiger F., Bauer D., Demsar J. et al. // Appl. Phys. B. 2012. P. 605.
Rumyantsev V.D., Davidyuk N.Y., Chekalin A.V. et al. // IEEE J. Photovoltaics. 2015. V. № 5. 6. P. 1715.
Luque A., Panchak A., Ramiro I. et al. // IEEE J. Photovoltaics. 2015. V. 5. № 4. P. 1074.
Mintairov M.A., Kalyuzhnyy N.A., Evstropov V.V. et al. // IEEE J. Photovoltaics. 2015. V. 5. № 4. P. 1229.
Levin R.V., Marichev A.E., Shvarts M.Z. et al. // Semiconductors. 2015. V. 49. № 5. P. 700.
Алфимова Д.Л., Лунин Л.С., Лунина М.Л. и др. // Физика и техника полупроводников. 2016. Т. 58. Вып. 9. С. 1695.
Khvostikov V., Kalyuzhnyy N., Mintairov S. et al. // AIP Conference Proceedings. 2014. P. 21.
Kalyuzhnyy N.A., Evstropov V.V., Lantratov V.M. et al. // Int. J. Photoenergy. 2014. V. 2014. Article number 836284.
Кузнецов В.В., Лунин Л.С., Ратушный В.И. “Гетероструктуры на основе четверных и пятерных твердых растворов соединений АIIIBV”, Ростов-на-Дону: СКНЦВШ, 2003. 375 с.
Алферов Ж.И. // Физика и техника полупроводников. 1998. Т. 32. № 1. С. 3.
Долгинов Л.М., Елисеев П.Г., Исмаилов И. // Итоги науки и техники. Сер. Радиотехника. М.: ВИНИТИ, 1980. Т. 21. С. 3.
Хвостиков В.П., Лунин Л.С., Кузнецов В.В. и др. // Письма в ЖТФ. 2003. Т. 29. Вып. 20. С. 33.
Rogalski A. // Opt.-Electron. Rev. 2008. V. 16. № 4. P. 458.
Wang C.A., Choi H.K., Ransom S.L. // Appl. Phys. Lett. 1999. V. 75. № 9. P. 1305.
Карандашев С.А., Матвеев Б.А., Ременный М.А. и др. // Физика и техника полупроводников. 2007. Т. 41. Вып. 11. С. 1385.
Чеботарев С.Н., Лунина М.Л., Алфимова Д.Л. // “Наноструктуры AIVBIV и AIIIBV для устройств оптоэлектроники”, Ростов-на-Дону: ЮНЦ РАН, 2014. 275 с.
Чеботарев С.Н., Калинчук В.В., Лунин Л.С. Полупроводниковые наногетероструктуры с промежуточной подзоной. М.: Физматлит, 2016. 192 с.
Lunin L.S., Chebotarev S.N., Pashchenko A.S., Bolobanova L.N. // Inorg. Mater. 2012. V. 48. № 5. P. 439.
Lunin L.S., Sysoev I.A., Alfimova D.L. et al. // J. Surface Investigation. X-ray, Synchrotron and Neutron Techniques. 2011. V. 5. №. 3. P. 559.
Лунин Л.С., Сысоев И.А. // Изв. вузов. Северо-Кавказский регион. Техн. науки. 2003. Спец. вып. С. 53.
Chebotarev S.N., Pashenko A.S., Lunin L.S., Irkha V.A. // Nanotechnologies in Russia. 2016. V. 11. № 7–8. P. 435.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография