Кристаллография, 2019, T. 64, № 5, стр. 776-780
Сопоставление данных просвечивающей электронной микроскопии и рентгеновской рефлектометрии при исследовании строения нанокомпозитных кремний-углеродных пленок
В. Е. Асадчиков 1, 2, Ю. О. Волков 1, И. Г. Дьячкова 1, О. М. Жигалина 1, 3, В. М. Каневский 1, А. Э. Муслимов 1, А. Д. Нуждин 1, С. М. Пименов 4, Б. С. Рощин 1, *, А. А. Русаков 1, Д. Н. Хмеленин 1, С. Ю. Шахбазов 5, М. Л. Шупегин 6
1 Институт кристаллографии им. А.В. Шубникова ФНИЦ “Кристаллография и фотоника” РАН
Москва, Россия
2 Московский государственный университет им. М.В. Ломоносова
Москва, Россия
3 Московский государственный технический университет им. Н.Э. Баумана
Москва, Россия
4 Институт общей физики им. А.М. Прохорова РАН
Москва, Россия
5 Научно-исследовательский институт перспективных материалов и технологий
Москва, Россия
6 Национальный исследовательский университет “Московский энергетический институт”
Москва, Россия
* E-mail: ross@crys.ras.ru
Поступила в редакцию 06.02.2019
После доработки 06.02.2019
Принята к публикации 12.03.2019
Аннотация
Алмазоподобные кремний-углеродные пленки, легированные ванадием, исследованы методами рентгеновской рефлектометрии и просвечивающей электронной микроскопии. Сопоставление полученных данных позволило установить, что слоистая структура пленок сохраняется на площади порядка 100 мм2 при общей толщине пленок 3–4 мкм и толщинах слоев 10–40 нм. Исследование поверхности пленок проведено методом полуконтактной зондовой микроскопии. Показано, что среднеквадратичная высота шероховатости снижается на порядок (от 2.0 до 0.2 нм) при увеличении содержания ванадия в пленке от 12 до 17 ат. %.
ВВЕДЕНИЕ
Пленки нанокомпозитов на основе кремний-углеродной матрицы из плазмополимеризованного полиметилфенилсилоксана (ПФМС) и нанофазы на основе карбидов металлов привлекают в последние годы все большее внимание как в России, так и за рубежом [1, 2] Устоявшееся название DLN (diamond-like nanocomposite) [3] связано с высокой концентрацией sp3-связей между атомами углерода в их структуре. Причиной повышенного интереса к этим материалам является их высокая устойчивость к агрессивным средам. Следует отметить уникальный набор их физических свойств в совокупности с возможностью управлять ими в чрезвычайно широких пределах путем вариации параметров процесса осаждения. Среди этих свойств наиболее практически полезными являются высокая адгезия пленок к различным типам подложек, высокая твердость (15–28 ГПа) [4], низкие величины коэффициента трения (∼0.1) [5, 6] и шероховатости (≤1 нм) [7]. Возможность заданно получать значение удельного сопротивления в интервале 1013–10–4 Ом см [3] также является ценной особенностью технологии получения.
Все это делает пленки DLN перспективными для использования в разных сферах науки и техники, таких как трибология (как в земных условиях, так и в космосе), ИК-оптика, радиотехника, микро- и наноэлектроника, медицина и других. Большинство свойств пленок DLN являются структурно чувствительными и имеют выраженные зависимости перколяционного типа [8] от концентрации нанофазы. На конкретный вид зависимостей влияют структура, морфология и характер распределения нанофазы в объеме матрицы. Практическое использование DLN-пленок требует широких и подробных исследований зависимости их свойств от последних трех параметров. При этом основной проблемой является строгая дифференциация существующих методов исследования по таким параметрам, как объем и морфология исследуемого объекта. Так, рентгеновская рефлектометрия позволяет получать данные о слоях пленки с характерной толщиной не более 100 нм и площадью порядка единиц квадратных сантиметров. Для электронной микроскопии толщина объекта может быть того же порядка, но площадь составляет лишь единицы квадратных микрон. Сканирующая зондовая микроскопия имеет промежуточные возможности, но является чисто поверхностным методом. Сопоставление полученных тремя методами результатов может, с накоплением их объема, привести к синергии и значительно усовершенствовать знания об изучаемых пленках, что является актуальной задачей.
МЕТОД ПОЛУЧЕНИЯ ПЛЕНОК DLN, ЛЕГИРОВАННЫХ ВАНАДИЕМ
Пленки DLN, легированные ванадием, получали осаждением в вакуумной камере, содержащей два разнородных источника подачи прекурсоров: плазмотрон уникальной конструкции и стандартный магнетрон [2]. Камера представляла собой цилиндр (∅ = 70 см, L = 50 cм) с горизонтальной осью вращения, закрытый с торцов плоскими крышками в форме круга. Источники были расположены на горизонтальном диаметре одной из крышек по разные стороны от ее центра на одинаковом расстоянии (15 см). Держатель подложек находился на противоположной крышке и имел круглую форму (∅10–60 см) с осью вращения, совпадающей с осью камеры. Скорость вращения держателя подложек составляла 0–10 об./мин. Необходимый уровень вакуума обеспечивали форвакуумный и диффузионный насосы. Пленки для исследования выращивали в процессе одновременного осаждения кремний-углеродной матрицы из плазмы паров ПФМС и магнетронного распыления ванадиевой мишени в атмосфере аргона при его парциальном давлении 8 × 10–4 мм рт. ст. Исходным веществом для получения матрицы являлся ПФМС 2.5Л – жидкое кремний-углеродное соединение (CH3)3SiO(CH3C6H5SiO)3Si(CH3)3 с температурой кипения в диапазоне 130–140°С. В плазме под действием ускоренного потока электронов от вольфрамового катода плазмотрона происходит как диссоциация молекул ПФМС по слабым связям с освобождением ионов водорода и радикалов СНх-углерода, так и ассоциация радикалов углерода с образованием алмазоподобных sp3-связей углерода и ассоциация ионов водорода со свободными связями кремния [9]. В качестве рабочей жидкости диффузионного насоса используется также ПФМС. Эта особенность – совпадение состава паров диффузионного насоса с составом паров плазмообразующего вещества – позволяет не использовать азотные ловушки. Второй особенностью технологии является способ введения плазмообразующего вещества в камеру. ПФМС подавали в реактор через стандартный игольчатый натекатель под действием разности давления между камерой и окружающей средой. В плазмотроне жидкость попадает в его фронтальную часть, выполненную из пористой корундовой керамики, расположенную в камере вблизи вольфрамового катода. Температура катода превышает 2000°С, а его потенциал смещен на 100–200 В ниже потенциала земли. Благодаря воздействию теплового излучения катода керамика разогревается до температуры выше 300°С, ПФМС переходит в парообразное состояние и по порам керамики, в виде направленного потока, попадает в камеру. Интенсивная термоэлектронная эмиссия катода превращает пар в плазму. На держатель подложек подавали высокочастотный потенциал с частотой, равной 1.7 МГц, и амплитудой в диапазоне от 100 до 400 В.
Для оценки времени, необходимого для формирования пленок нужной толщины, использовали градуировочные графики, полученные в пробных процессах. В работе исследовали два образца пленок – с содержанием ванадия 12 и 17 ат. %.
МЕТОДЫ И РЕЗУЛЬТАТЫ ИССЛЕДОВАНИЯ
Электронная микроскопия. Структурные исследования выполнены методами просвечивающей электронной микроскопии (ПЭМ) с помощью микроскопа FEI Tecnai Osiris с ускоряющим напряжением 200 кВ. На рис. 1 представлены ПЭМ-изображения поперечных сечений DLN-пленок. На поверхность пленок в процессе приготовления образцов нанесен защитный слой Pt толщиной около 1 мкм. Толщина пленок по данным ПЭМ составляет 3.8 мкм (12 ат. % V) и 3.75 мкм (17 ат. % V). Как видно из рисунков, пленки имеют слоистую структуру без видимых дефектов или несплошностей. Слоистая структура обусловлена химической неоднородностью пленок, в результате которой выделяются нанокристаллы карбида вольфрама VC [10].
Рис. 1.
ПЭМ-изображения приповерхностной структуры пленок DLN с содержанием ванадия 12 (а) и 17 ат. % (б). Вертикальными линиями показаны области определения профилей яркости (длина линии 80 нм).
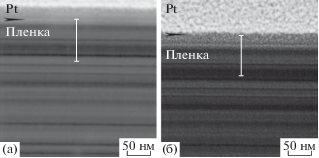
Рентгеновская рефлектометрия. Рентгеновский дифрактометр с подвижной системой трубка–детектор [11] позволяет измерять интенсивность как отраженного, так и рассеянного поверхностью образца рентгеновского излучения. Рентгенооптический тракт дифрактометра включает в себя трехщелевой коллиматор, кристалл-монохроматор однократного отражения Si (111) и вакуумные пути для уменьшения поглощения излучения в воздухе. Образец устанавливали на юстировочном столике так, что его поверхность параллельна направлению распространения (оси) падающего пучка. При дальнейших измерениях образец остается неподвижным, а источник и детектор совершают вращение вокруг образца на заданные углы. Решение обратной задачи рентгеновской рефлектометрии позволяет восстановить из угловой зависимости коэффициента отражения рентгеновских лучей (рис. 2) распределение действительной части диэлектрической проницаемости (пропорциональное объемной электронной концентрации в материале) в направлении, перпендикулярном поверхности. С этой целью был применен модельно-независимый подход, не требующий никакой априорной информации о внутренней структуре исследуемого объекта [12].
Рис. 2.
Угловые зависимости коэффициентов отражения, полученные в эксперименте (точки) и с помощью моделирования (линии) для пленок DLN с содержанием ванадия 12 (1) и 17 ат. % (2).

Для сопоставления результатов, полученных при решении обратной задачи рентгеновской рефлектометрии, по полученным в электронном микроскопе изображениям был вычислен профиль яркости вдоль соответствующего заданного направления и в сопоставимом масштабе (вертикальные линии на рис. 1). При расчете данные о яркости были усреднены в латеральной плоскости по области шириной 20 нм. Сравнение полученных результатов для образцов с содержанием ванадия 12 и 17 ат. % представлено на рис. 3.
Рис. 3.
Профили электронной концентрации по данным рефлектометрии (1) и профили яркости по данным ПЭМ, усредненные в латеральной плоскости в интервале 20 нм (2), полученные для пленок DLN с содержанием ванадия 12 (а) и 17 ат. % (б).
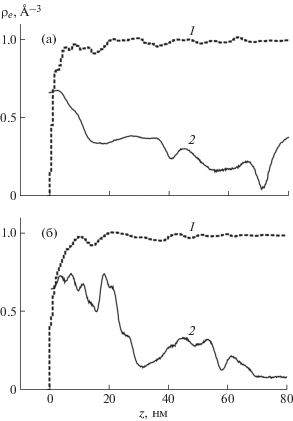
Поскольку при рентгеновских исследованиях получаемая информация усреднена по области, соответствующей площади засветки поверхности рентгеновским пучком (≈ 50 мм2) и существенно превосходящей размеры области измерения ПЭМ, совпадение ряда основных пиков по положению свидетельствует о том, что слоистая структура пленки в определенной степени сохраняется и в макромасштабе. Различие в остальных особенностях кривых обусловлено, вероятно, некоторой неравномерностью толщин слоев в пленке, связанной с изменением расстояния до источников распыления материалов пленки на различных участках вдоль поверхности, а также неоднозначностью в задании положения “внешней поверхности” структуры на ПЭМ-изображениях, обусловленной нанесением на нее защитного слоя Pt.
Для оценки статистической неравномерности параметров слоев в направлении, перпендикулярном поверхности, для полученных распределений электронной концентрации и яркости с помощью косинус-преобразования Фурье вычислена функция частотного спектра (рис. 4):
где ν – пространственная частота, z – координата в направлении, перпендикулярном поверхности, С(z) – автокорреляционная функция.Рис. 4.
Частотные спектры профилей яркости, полученных по данным ПЭМ (1, 2), и профилей электронной концентрации по данным рентгеновской рефлектометрии (3, 4).
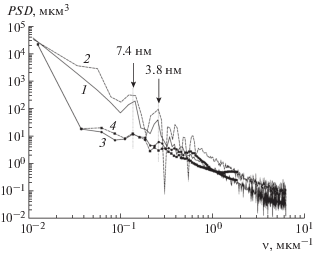
Такое спектральное представление статистических пространственных характеристик физических объектов ранее применялось для описания параметров шероховатости сверхгладких поверхностей. В ряде работ показана целесообразность его использования при сопоставлении данных, полученных с помощью методик, основанных на различных физических принципах [13, 14].
Отметим, что в отличие от расчетов спектральной плотности мощности высот шероховатости, где все типы экспериментальных данных в конечном итоге связаны с рельефом поверхности, в данном случае яркость изображения и действительная часть диэлектрической проницаемости имеют лишь качественное соответствие, что исключает прямое сопоставление полученных кривых по амплитуде. На частотных характеристиках, где пространственная частота является величиной, обратной периоду вдоль координаты, по которой проводится расчет, можно наблюдать некоторые закономерности, выражающиеся в совпадении пиков, соответствующих периодам 3.8 и 7.4 нм. Этими величинами можно охарактеризовать усредненные значения толщин слоев в структурах пленок, а их совпадение свидетельствует о частичном, но значительном сохранении периодичности пространственных характеристик структуры в макромасштабе.
Атомно-силовая микроскопия. Измерения проводили на сканирующем зондовом микроскопе NTEGRA Prima (NT-MDT) в полуконтактном режиме. Для каждого образца сканирование осуществляли в двух точках: точка 1 – в центре пластины, точка 2 – на расстоянии 3 мм от края пластины. Обработку топографических данных осуществляли с использованием программного обеспечения Nova, поставляющегося в комплекте с микроскопом. Полученные изображения представлены на рис. 5.
Образец с содержанием ванадия 12 ат. % характеризуется высоким значением среднеквадратичной высоты шероховатости поверхности, составляющей порядка 1.7–2.3 нм. На поверхности присутствуют кратеры с латеральными размерами до 100 нм и глубиной до 10 нм, имеющие высокую плотность распределения вдоль поверхности.
Измерения образца с содержанием ванадия 17 ат. % свидетельствуют о низкой шероховатости, среднеквадратичная величина которой составляет 0.2–0.3 нм и характеризуется высокой однородностью параметров вдоль поверхности. Различия в шероховатости, измеренные в точках 1 и 2, составляли не более 3–5%, поэтому приводятся данные, снятые в одной точке. Для обоих образцов наблюдается хаотичное распределение выступов и впадин. Наличия статического заряда для этих образцов не выявлено.
ВЫВОДЫ
С использованием комплексного подхода, сочетающего прямой метод определения структуры пленок в нанометровом диапазоне (просвечивающая электронная микроскопия) и неразрушающий метод, дающий усредненную информацию о толщинах покрытий в широкой в латеральном направлении области (рентгеновская рефлектометрия), установлено, что характерная для легированных ванадием нанокомпозитных кремний-углеродных пленок слоисто-полосчатая структура сохраняется в среднем вдоль всей поверхности образца. Предложен статистический подход к описанию параметров пространственной структуры многослойных пленок и количественной характеризации степени разупорядочения толщин составляющих их слоев. Вывод о том, что слоистая структура пленок в целом сохраняется на значительных площадях и глубинах, является важным, поскольку свидетельствует о воспроизводимости технологии, что является основой для ее практического применения. Установлено существенное снижение среднеквадратичной высоты шероховатости поверхности пленки DLN при увеличении содержания ванадия от 12 до 17 ат. %. Это обстоятельство, на первый взгляд, представляется парадоксальным, поскольку можно было ожидать увеличения поверхностной шероховатости с ростом концентрации легирующей примеси (ванадия). Однако результаты, полученные на образцах того же состава и исследованные по той же методике на другом атомно-силовом микроскопе, были аналогичными. Причина такого явления заслуживает дальнейшего изучения.
Работы по синтезу алмазоподобных нанокомпозитных пленок и их легированию ванадием проведены при поддержке Российского научного фонда (проект № 15-12-00039). Работы по структурному исследованию пленок выполнены в рамках государственного задания Министерства науки и высшего образования РФ (проект № 16.9350.2017/8.9). Методика сопоставления данных рентгеновской рефлектометрии и электронной микроскопии разработана при поддержке Министерства науки и высшего образования в рамках выполнения работ по Государственному заданию ФНИЦ “Кристаллография и фотоника” РАН.
Список литературы
Meškinis Š., Tamulevičienė A. // Mater. Sci. (medžiagotyra). 2011. V. 17. № 4. P. 358.
Шупегин М.Л. // Заводская лаборатория. Диагностика материалов. 2013. Т. 79. № 2. С. 28.
Dorfman V.F. // Thin Solid Films. 1992. V. 212. P. 267.
Zavedeev E.V., Zilova O.S., Barinov A.D. et al. // Diamond Relat. Mater. 2017. V. 74. P. 45.
Scharf T.W., Ohlhausen J.A., Tallant D.R. et al. // J. Appl. Phys. 2007. V. 101. P. 063521.
Pimenov S.M., Zavedeev E.V., Arutyunyan N.R. et al. // J. Appl. Phys. 2017. V. 122. P. 145301.
Zavedeev E.V., Jaeggi B., Zuercher J. et al. // Wear. 2018. V. 416–417. P. 1.
Dorfman V.F. // Thin Solid Films. 1998. V. 330. P. 76.
Белогорохов А.И., Додонов А.Н., Малинкович М.Д. и др. // Материалы электронной техники. 2007. № 1. С. 69.
Жигалина О.М., Хмеленин Д.Н., Пименов С.М. и др. // Кристаллография. 2018. Т. 63. № 5. С. 778.
Асадчиков В.Е., Бабак В.Г., Бузмаков А.В. и др. // Приборы и техника эксперимента. 2005. № 3. С. 99.
Kozhevnikov I.V. // Nucl. Instrum. Methods Phys. Res. A. 2003. V. 508. P. 519.
Занавескин М.Л., Занавескина И.С., Рощин Б.С. и др. // Вестн. МГУ. Сер. 3. Физика. Астрономия. 2006. № 3. С. 80.
Асадчиков В.Е., Кожевников И.В., Рощин Б.С. и др. // Мир измерений. 2012. № 7. С. 22.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография