Кристаллография, 2019, T. 64, № 5, стр. 790-795
Эпитаксиальный рост “неполярных” пленок ZnO на подложках сапфира с террасно-ступенчатым нанорельефом
А. Э. Муслимов 1, *, А. М. Исмаилов 2, В. А. Бабаев 2, В. М. Каневский 1
1 Институт кристаллографии им. А.В. Шубникова ФНИЦ “Кристаллография и фотоника” РАН
Москва, Россия
2 Дагестанский государственный университет
Махачкала, Россия
* E-mail: amuslimov@mail.ru
Поступила в редакцию 10.03.2019
После доработки 01.04.2019
Принята к публикации 01.04.2019
Аннотация
Исследованы процессы получения методом магнетронного распыления “неполярных” пленок (11$\bar {2}$0) ZnO толщиной до 7.25 мкм на (1$\bar {1}$02) сапфировых (Al2O3) подложках с террасно-ступенчатой наноструктурой поверхности со скоростью роста до 4.5 нм/с. На начальных стадиях роста обнаружено влияние ступеней, приводившее к формированию изолированных наноструктур ZnO, декорирующих ступени. На всех последующих стадиях роста наблюдалась сплошная эпитаксиальная пленка (11$\bar {2}$0) ZnO с продольной осью [0001] кристаллитов, лежащей вдоль ребра ступени на поверхности сапфира. Величина межплоскостного расстояния пленок ZnO в направлении [11$\bar {2}$0], полученная по данным рентгеновской дифракции, зависела от толщины и скорости осаждения и приближалась к значению рентгенографических стандартов для ZnO при увеличении толщины до 7.25 мкм и снижении скорости роста до 2.1–2.3 нм/с.
ВВЕДЕНИЕ
Полифункциональные кристаллы со структурой вюрцита (ZnO, AlN, GaN и др.) находят широкое применение при создании технических устройств пьезоэлектроники, акустоэлектроники и оптоэлектроники [1, 2]. Традиционно применяли “полярные” пленки с выраженной текстурой в направлении оси [0001], поскольку они легко формируются на неориентирующих подложках (стекло, ситалл) благодаря наибольшей ретикулярной плотности атомов в плоскости (0001) [3, 4]. Однако при широком внедрении оптоэлектронных устройств на основе кристаллов с вюрцитной структурой обнаружилась их основная проблема: внутренние электрические поля, как спонтанные, так и наведенные за счет пьезоэлектричества в механически напряженных пленках при гетероэпитаксиальном наращивании, препятствуют рекомбинации зарядов, образованию фотонов и приводят к снижению эффективности устройств [5]. Известно [6], что поляризация в направлении, перпендикулярном поверхности слоя в вюрцитной структуре, уменьшается в случае “полуполярных” (11$\bar {2}$2) и равна нулю в случае “неполярных” (11$\bar {2}$0) пленок. Ориентационная зависимость поляризации в вюрцитных пленках имеет широкие перспективы применения в стрейнтронике [7], новом направлении в физике конденсированного состояния вещества, использующем методы деформационной инженерии и физические эффекты, наведенные механическими деформациями в твердых телах. При эпитаксии пьезоэлектрических пленок “неполярной” ориентации “полярная” ось будет лежать в плоскости подложки, что позволит управлять магнитными свойствами нанесенной на подложку и механически связанной с ней магнитострикционной пленки. В отличие от “полярных” для выращивания пленок “неполярных” или “полуполярных” ориентаций используются ориентирующие подложки [8] и эпитаксиальные технологии нанесения.
В настоящей работе исследованы процессы получения пьезоэлектрических пленок (11$\bar {2}$0) ZnO на (1$\bar {1}$02) сапфировых подложках методом магнетронного распыления. При выборе метода нанесения исходили из условия получения высокоориентированных пленок (11$\bar {2}$0) ZnO толщиной до 5–6 мкм с высокой скоростью роста. Если высокая скорость роста определяется требованием технологичности, то микронные толщины, как показано в [9], позволяют достичь высоких электромеханических коэффициентов связи (до 6%). Помимо этого, “толстые” пленки ZnO могут обладать сцинтилляторными свойствами и использоваться для регистрации гамма- и рентгеновских квантов [10]. Структурные данные изучаемых кристаллов приведены в табл. 1.
Использование (1$\bar {1}$02) сапфировых подложек для эпитаксии (11$\bar {2}$0) ZnO обусловлено сходством в расположении узлов обеих решеток на плоскостях (11$\bar {2}$0) ZnO и (1$\bar {1}$02) Al2O3 – это прямоугольники (почти квадраты) со сторонами ∼0.5 нм [11]. Помимо этого, в работе использованы подложки сапфира с предварительной обработкой поверхности по методике, описанной в [13, 14], для формирования упорядоченной террасно-ступенчатой наноструктуры (ТСН). В [15–17] исследовано влияние упорядоченной ТСН на процессы гетерогенного зародышеобразования и подтверждено, что ступени являются областями стока диффундирующих вдоль поверхности адатомов и предпочтительны в качестве центров гетерогенного зародышеобразования.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
В качестве подложек использовали сапфировые пластины диаметром 50.8 мм и толщиной 0.43 мм, разориентированные относительно R-плоскости вокруг оси [1$\bar {1}$0$\bar {1}$] и обработанные химико-механическим способом. В соответствии с [13, 14] угол разориентации определяет период атомно-гладкой ТСН на R-плоскости сапфира. При угле разориентации от плоскости R(1$\bar {1}$02) ∼ ∼ 0.02° на поверхности подложки сапфира после полировки и отжига при температуре выше 1000°С формируются ТСН вдоль [1$\bar {1}$0$\bar {1}$] с шириной террас ∼1.1 мкм и высотой ступеней ∼1.2–1.4 нм (рис. 1а).
Рис. 1.
АСМ-изображение поверхности подложки R(1$\bar {1}$02) сапфира с ТСН (а); АСМ-изображение пленки ZnO (I) (б).
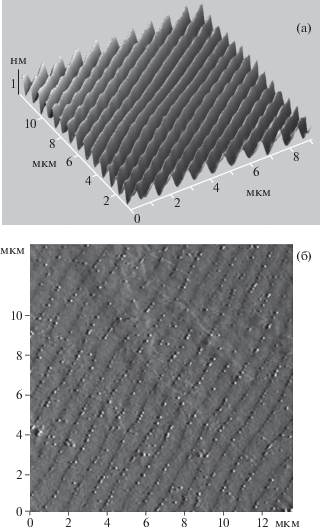
Микроскопические исследования, в том числе измерения толщин пленок, проводили на атомно-силовом микроскопе (АСМ) Ntegra Aura (НТ-МДТ) в режимах топографии и спектроскопии. На поверхность подложек наносили пленки ZnO на автоматизированном магнетронном комплексе ВАТТ АМК-МИ (ООО “Ферри Ватт”, Казань) в условиях “сухого” вакуума (спиральный форвакуумный насос Anest Iwata ISP-500С, Япония; криогенный высоковакуумный насос Cryogenics CryoTorr 8, США). Перед каждым распылением вакуумную камеру откачивали до остаточного давления ∼9 × 10–5 Па. Давление рабочего газа (кислород) регулировали с помощью РРГ-10 (ООО “Элточприбор”, Россия) и измеряли широкодиапазонным вакуумметром TELEVAC СС-10 (США). Использовали классический вариант планарного сбалансированного магнетрона, мишень – керамический диск ZnO диаметром 50 мм и толщиной 5 мм. Мишень устанавливали на охлаждаемое основание магнетрона без прижима. Расстояние мишень–подложка (от центра мишени до центра подложки) составляло 3.5 см. Пленки ZnO осаждали на подложки через маску поликора с квадратным отверстием 5 × 5 мм2. Условия напыления образцов приведены в табл. 2. Нагрев подложки осуществляли резистивным нагревателем (нихром), температуру которого регистрировали термопарным методом (хромель–алюмель).
Таблица 2.
Технологические режимы нанесения пленок ZnO при температуре подложки T = 650°C и давлении кислорода в камере p = 9.6 × 10–3
| Тип образца | Скорость нанесения, нм/с | Толщина, мкм |
|---|---|---|
| I | 2.1–2.3 | 0.09 |
| II | 2.1–2.3 | 0.33 |
| III | 2.1–2.3 | 0.67 |
| IV | 2.1–2.3 | 7.25 |
| V | 4–4.5 | 1.21 |
Структуру и ориентацию пленок исследовали методом дифракции быстрых электронов (ДБЭ) и рентгеновской дифракции (РД). Исследования методом ДБЭ проводили в геометрии на отражение (электронограф ЭМР 100, U = 75 кВ). Рентгеновские исследования выполняли на дифрактометре Empyrean Series 2 (PANalytical, Нидерланды) с использованием CuKα-излучения (1.5405 Å), углы сканирования 10°–80°, β-фильтр. Схема съемки по Брэггу–Брентано, геометрия 2θ. Идентификацию фаз проводили сравнением экспериментально полученных межплоскостных расстояний с данными картотеки JCPDS.
РЕЗУЛЬТАТЫ ЭКСПЕРИМЕНТОВ И ИХ ОБСУЖДЕНИЕ
С помощью исследований начальных стадий роста пленок ZnO (I) на плоскости R(1$\bar {1}$02) Al2O3 c ТСН обнаружили наличие морфологически неоднородной пленки (рис. 1б). На поверхности наблюдались изолированные структуры ZnO размером ∼100 нм, декорирующие ступени на поверхности подложки, и сплошная пленка, состоящая из более мелких кристаллитов ZnO размером ∼30–50 нм. Значительные размеры структур ZnО на ступенях по сравнению с кристаллитами, образующими сплошную пленку ZnO на атомно-гладких террасах между ступенями, свидетельствуют о преимущественном стоке диффундирующих по поверхности горячей подложки адатомов в области ступеней. Высокая плотность адатомов в области ступени способствует зародышеобразованию. Ранее предложенное [15, 18] объяснение стока адатомов к ступеням вследствие их электрической активности, по всей видимости, применимо и здесь. В процессе увеличения объема кристаллизующегося материала в области ступени формируются первичные островки, которые в дальнейшем разрастаются. Очевидно, что скорости разрастания первичных островков на ступенях и на атомно-гладких террасах значительно различаются (рис. 1б).
Данные ДБЭ и РД (рис. 2) свидетельствуют о поликристаллической структуре пленки I. На кривой РД можно выделить широкий участок в области 2θ ∼ 56.5°, соответствующий кристаллитам ориентации (11$\bar {2}$0) ZnO в вюрцитной структуре ZnO (JCPDS № 98-002-6170 [19]). Размытость пика можно объяснить одновременным присутствием наноразмерных кристаллитов (11$\bar {2}$0) ZnO с близкими параметрами ячейки, что типично для начальных стадий роста. Данные РД коррелируют с результатами, полученными методом ДБЭ (рис. 2, вставка), свидетельствующими о низком совершенстве осадка ZnO.
Рис. 2.
Картины РД и ДБЭ (вставка) пленки ZnO (I). Дифракционные пики подложки сапфира отмечены звездочками.

С увеличением толщины слоя ZnO (рис. 3) наблюдаются кардинальные ориентационные изменения. При толщине порядка 300 нм в пленке начинают преобладать кристаллиты ZnO, ориентированные плоскостью (11$\bar {2}$0) параллельно R(1$\bar {1}$02)-плоскости сапфира (рис. 4). По данным ДБЭ кристаллиты ориентированы азимутально в соответствии со следующими эпитаксиальными соотношениями: [$\bar {1}$100] ZnO//[11$\bar {2}$0] Al2O3, [0001] ZnO // [$\bar {1}$101] Al2O3. Рефлексы на картине ДБЭ (рис. 3) вытянуты, что говорит о формировании протяженных двумерных структур на поверхности подложки. Отличительной особенностью морфологии поверхности полученных пленок (11$\bar {2}$0) ZnO (рис. 3) является продольная структура кристаллитов, разрастающихся вдоль ребра ступени, совпадающей с [$\bar {1}$101] сапфира. С увеличением толщины пленки ZnO при одной и той же скорости нанесения увеличивается размер кристаллитов; для пленки IV продольный размер достигает 10–15 мкм по данным АСМ.
Рис. 3.
АСМ-изображения пленок (11$\bar {2}$0) ZnO типов II (а), III (б), IV (в), V (г) и соответствующие им картины ДБЭ (вставки).
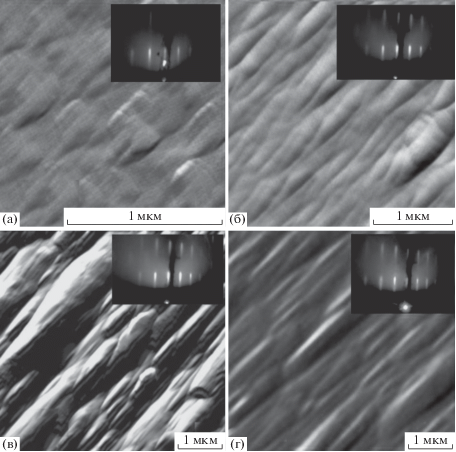
Рис. 4.
Общая картина РД для всех образцов ZnO (а). На вставке: увеличенное изображение пика 2θ ∼ 56.5° на картине РД. Схематическое изображение направлений в системе “эпитаксиальная пленка (11$\bar {2}$0) ZnO//(1$\bar {1}$02) сапфир” (б).

Межплоскостные расстояния a для пленок (11$\bar {2}$0) ZnO (II–V), рассчитанные из данных РД (рис. 4а), равны 0.328 нм (II), 0.329 нм (III), 0.325 нм (IV), 0.335 нм (V). Аналогичные осцилляции параметра a в зависимости от толщины пленки ранее отмечены в [20] и связаны с напряжениями в пленках. Наиболее близкое к величине а ∼ 0.32498 нм (JCPDS № 98-002-6170 [19]) значение параметра а получено для толстых пленок IV (толщина 7.25 мкм). По-видимому, с увеличением толщины происходит релаксация напряжений, присутствующих в пленках. Ширина кривой дифракционного отражения на полувысоте (полуширина) для пленки толщиной 7.25 мкм порядка 1° (рис. 5).
Помимо этого, наблюдается существенная зависимость углового положения пика (11$\bar {2}$0) ZnO от скорости осаждения (рис. 4а). Расчет по данным РД показывает, что при увеличении скорости роста в 2 раза параметр а увеличивался на ∼3%. Авторы [21] наблюдали подобное увеличение параметров с и а решетки ZnO при увеличении концентрации вакансий кислорода. Известно, что скорость роста может влиять на стехиометрию получаемых пленок. Проводимость в кристаллах и пленках ZnO напрямую связана с нарушением их стехиометрического состава. Традиционно для получения высокоомных образцов ZnO применяется постростовой отжиг в атмосфере кислорода. Проведены исследования вольт-амперных характеристик (рис. 5, врезки) образцов IV и V, которые продемонстрировали значительное различие в проводимости. По-видимому, увеличение скорости роста приводит к нарушению стехиометрии в сторону избытка металла, увеличению концентрации вакансий кислорода в пленке ZnO и снижению кристаллического качества (рис. 5, кривая V).
Рис. 5.
Экспериментальные кривые качания образцов IV, V пленок ZnO в области пика (11$\bar {2}$0). На вставках: соответствующие вольт-амперные характеристики образцов.
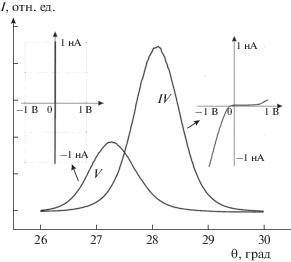
Нестехиометрия в оксидных системах типа M1 + xO (М – металл) с недостатком кислорода вследствие его выделения обычно определяется образованием межузельного металла по типу “неразупорядоченный кристалл” ↔ 1/2O2 + $M_{i}^{{ \bullet \bullet }}$ + + 2e'. $M_{i}^{{ \bullet \bullet }}$ – двукратно заряженный атом металла в междоузлии, e′ – свободные электроны. Этим объясняется высокая проводимость пленок ZnO. В свою очередь высокая концентрация межузельного цинка приводит к увеличению параметров решетки в растущих c высокой скоростью пленках ZnO.
ЗАКЛЮЧЕНИЕ
С использованием микроскопических и спектроскопических методик исследованы процессы получения “неполярных” пленок (11$\bar {2}$0) ZnO на (1$\bar {1}$02) сапфировых подложках. Для получения пленок ZnO использован метод магнетронного напыления, который отличается высокой производительностью и возможностью масштабирования на подложки больших размеров. Для обнаружения возможного влияния микроморфологии поверхности подложек на процессы роста тонких пленок использована методика предростового наноструктурирования поверхности. На начальных стадиях роста обнаружено влияние ступеней, приводившее к формированию изолированных наноструктур ZnO размером ∼100 нм, декорирующих ступени. При этом на атомно-гладких террасах ступеней наблюдались более мелкие кристаллиты размером ∼30–50 нм с преимущественной ориентацией (11$\bar {2}$0) параллельно (1$\bar {1}$02) сапфира. В целом пленка на этой стадии была поликристаллической. На всех последующих стадиях роста наблюдалась сплошная эпитаксиальная пленка (11$\bar {2}$0) ZnO. Величина межплоскостного расстояния пленок ZnO в направлении [11$\bar {2}$0], полученная по данным рентгеновской дифракции, зависела от толщины и скорости осаждения и приближалась к значению рентгенографического стандарта для ZnO при увеличении толщины до 7.25 мкм и снижении скорости роста до 2.1–2.3 нм/с. В пленках (11$\bar {2}$0) ZnО, полученных при скорости роста 4–4.5 нм/с, наблюдалось значительное увеличение межплоскостного расстояния в направлении [11$\bar {2}$0]. Такие пленки обладали высокой проводимостью. По-видимому, эти эффекты связаны с нарушением стехиометрии и высокой концентрацией межузельных атомов цинка. Отличительной особенностью морфологии поверхности полученных пленок (11$\bar {2}$0) ZnO является продольная структура кристаллитов, разрастающихся вдоль ребра ступени, совпадающей с [$\bar {1}$101] сапфира. С увеличением толщины пленки ZnO при сохранении скорости осаждения увеличивается продольный размер кристаллитов, для пленки IV он достигает 10–15 мкм по данным АСМ.
Работа выполнена при поддержке Министерства науки и высшего образования РФ в рамках выполнения работ по Государственному заданию ФНИЦ “Кристаллография и фотоника” РАН в части “получения пленок” и Российского фонда фундаментальных исследований (грант № 18-29-12099 мк) в части “диагностики эпитаксиальных пленок” с использованием оборудования ЦКП ИК РАН “Структурная диагностика материалов”.
Список литературы
Cui J., Sun A., Reshichkov M. et al. // MRS Internet J. Nitride Semicond. Res. 2000. V. 5. P. 7.
Hsua Y.P., Changa S.J., Sua Y.K. et al. // J. Cryst. Growth. 2004. V. 261. P. 466.
Akiyama M. // Thin Solid Films. 1999. V. 350. № 1. P. 85.
Муслимов А.Э., Буташин А.В., Каневский В.М. и др. // Кристаллография. 2017. Т. 62. № 3. С. 464.
Bernardini F., Fiorentini V. // Phys. Rev. B. 1998. V. 57. P. 9427.
Den Baars S., Nakamura Sh., Speck J. // Compd. Semicond. 2007. V. 13. № 6. P. 37.
Si C., Sun Z., Liu F. // Nanoscale. 2016. V. 8. P. 3207.
Liu T., Xujun S., Zhang J. et al. // Sci. Rep. 2016. V. 6. P. 26040.
Gorla C.R., Emanetoglu N.W., Liang S. et al. // J. Appl. Phys. 1999. V. 85. № 5. P. 2595.
Demidenko V.A., Gorokhova E.I., Khokyuk I.V. et al. // Radiat. Meas. 2007. V. 42. P. 549.
Meyer B., Dominik M. // Phys. Rev. B. 2003. V. 67. P. 035403.
Tian J.S., Peng C.Y., Wang W.L. et al. // Phys Status Solidi. 2013. V. 7. P. 293.
Буташин А.В., Власов В.П., Каневский В.М. и др. // Кристаллография. 2012. Т. 57. № 6. С. 927.
Муслимов А.Э., Буташин А.В., Каневский В.М. и др. // Кристаллография. 2018. Т. 63. № 2. С. 254.
Власов В.П., Каневский В.М., Буташин А.В., Муслимов А.Э. // Поверхность. Рентген., синхротр. и нейтр. исслед. 2018. № 10. С. 92.
Власов В.П., Буташин А.В., Каневский В.М. и др. // Кристаллография. 2014. Т. 59. № 3. С. 467.
Муслимов А.Э., Буташин А.В., Власов В.П., Каневский В.М. // Кристаллография. 2016. Т. 61. № 6. С. 982.
Власов В.П., Каневский В.М., Муслимов А.Э. // Письма в ЖТФ. 2019. Т. 45. Вып. 5. С. 30.
Cheng X.L., Zhao H., Huo L.H. et al. // Sens. Actuators B Chem. 2004. V. 102. P. 248.
Shaban M., Zayed M., Hamdy H. // RSC Adv. 2017. V. 7. P. 617.
Uekawa N., Mochizuki N., Kajiwara J. et al. // Phys. Chem. Chem. Phys. 2003. № 5. P. 929.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография


