Кристаллография, 2020, T. 65, № 1, стр. 137-146
Энергетическое состояние эпитаксиальных слоев в многослойной гетероструктуре, выращенной на подложке (001) GaAs
А. Н. Алёшин 1, *, А. С. Бугаев 1, О. А. Рубан 1, В. В. Сарайкин 1, Н. Ю. Табачкова 2, И. В. Щетинин 2
1 Институт сверхвысокочастотной полупроводниковой электроники им. В.Г. Мокерова РАН
Москва, Россия
2 Национальный исследовательский технологический университет “МИСиС”
Москва, Россия
* E-mail: a.n.aleshin@mail.ru
Поступила в редакцию 19.11.2018
После доработки 19.11.2018
Принята к публикации 29.11.2018
Аннотация
На основе структурных исследований, выполненных методом построения карт обратного пространства, а также экспериментальных результатов, полученных методами вторичной ионной масс-спектрометрии и просвечивающей электронной микроскопии, показано, что в многослойной эпитаксиальной гетероструктуре, содержащей метаморфный ступенчатый буфер, наряду с латеральными сжимающими напряжениями возникают вертикальные сжимающие напряжения, причиной возникновения которых являются межфазные границы, препятствующие полному снятию напряжений в процессе структурной релаксации. Выполненный в рамках линейной теории упругости анализ показал, что упруго-напряженное состояние слоев гетероструктуры является аналогом состояния, возникающего в процессе двухстадийного деформационного процесса: всестороннего и двухосного сжатия. Показано, что в этом случае значение свободной энергии системы, находящейся в метастабильном состоянии, минимально.
ВВЕДЕНИЕ
Одним из основных конструкционных элементов гетероструктуры с квантовой ямой, выращенной на подложках (001) GaAs, является метаморфный буфер (ММБ) [1–4], функциональное назначение которого состоит в демпфировании упругих напряжений, возникающих вследствие рассогласования кристаллических решеток подложки (материального носителя гетероструктуры) и активных приборных слоев, например, в высокочастотном транзисторе (НЕМТ). Метаморфный буфер представляет собой область, в которой с помощью легирования основного материала соответствующей примесью (для легирования таких веществ, как GaAs и AlAs, используют In) достигается пространственное изменение периода решетки, вследствие которого создается виртуальная подложка для активных слоев. Закон изменения концентрации In по толщине ММБ может быть различным: линейным, параболическим, квадратно-корневым и др. [5, 6]. К конструкции ММБ – толщине и числу ступеней, содержанию легирующего элемента в ступенях, закону изменения In в пространстве, градиенту концентрации (в случае однослойного буфера) – предъявляется ряд требований, основным из которых является способность буфера к формированию вблизи поверхности бездислокационной области (в ступенчатом ММБ – бездислокационного слоя), которая является платформой для активных слоев HEMT. Наличие бездислокационной области предотвращает проникновение прорастающих дислокаций в активные слои HEMT. Образование бездислокационной области происходит в процессе структурной релаксации системы, основными механизмами которой являются мультипликация дислокаций несоответствия и их скольжение по плотноупакованным плоскостям. В [7] на примере однослойного ММБ с линейным законом изменения концентрации легирующего элемента по толщине буфера было показано, что при образовании бездислокационного слоя в такой системе достигается локальный минимум свободной энергии. Распространение модельного подхода [7] на ступенчатые ММБ дано в [8–10]. В основу этих работ положена закономерность, выявленная для релаксационного процесса в однослойных гетероструктурах композиции InxGa1 – xAs, выращенных на подложке (001) GaAs [11, 12]. В этих работах показано, что область легкого скольжения дислокаций вдоль плоскостей семейства {111} ограничивается толщинами 100–800 нм. При этом между остаточной упругой деформацией и толщиной пленки наблюдается обратно пропорциональная зависимость. При толщинах пленки, превышающих 800 нм, структурная релаксация замедляется, что вызвано деформационным упрочнением, которое в общем случае обусловлено взаимодействием движущихся дислокаций между собой [13, 14]. В многослойных тонкопленочных системах существенное влияние на эффект деформационного упрочнения оказывают межфазные границы. Их роль двояка: с одной стороны, в области межфазных границ происходит мультипликация дислокаций несоответствия, а с другой – межфазные границы являются препятствием для скользящих дислокаций в нижележащем слое [15]. Наличием межфазных границ можно объяснить установленный экспериментальным путем факт [16], что в многослойных системах наблюдается снижение критической толщины эпитаксиального слоя, при которой начинает развиваться эффект деформационного упрочнения, по сравнению с толщиной слоя в однослойной гетероструктуре.
Поскольку многослойная гетероструктура находится в существенно неравновесном состоянии, ее важной характеристикой является величина свободной энергии. Однако вклад от деформационного упрочнения в общий баланс свободной энергии многослойной тонкопленочной системы неизвестен. Целью данной работы явилось изучение влияния деформационного упрочнения на энергетическое состояние эпитаксиальных слоев в многослойной гетероструктуре, содержащей ступенчатый ММБ. Исходные экспериментальные данные о кристаллографических параметрах слоев многослойной гетероструктуры были получены в результате построения карт обратного пространства. Этот метод является единственным, позволяющим учитывать пространственную разориентацию эпитаксиальных слоев, присущую гетероэпитаксиальным структурам [17]. Поправка на эффект пространственной разориентации вносит существенные изменения в координаты дополнительных интерференционных максимумов при определении их положения в обратном пространстве [18]. Далее при описании гетероструктуры HEMT, содержащей MMБ, используется аббревиатура MHEMT (метаморфный HEMT).
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Выращивание гетероструктуры
Гетероструктура MHEMT с активными слоями InAlAs/InGaAs/InAlAs и содержащая пятиступенчатый ММБ была выращена на стандартной полуизолирующей подложке GaAsc ориентацией (001) методом молекулярно-лучевой эпитаксии на установке RIBER 32P. Мольное содержание In, XIn в активных слоях MHEMT было равно 0.39. Толщина первых четырех ступеней ММБ равнялась 0.1 мкм, содержание XIn в них составляло 0.15, 0.23, 0.29 и 0.35 соответственно. Пятая ступень имела толщину 0.2 мкм и XIn = 0.39. Такое же мольное содержание In и такую же толщину имел нижний барьерный слой – следующий конструкционный элемент MHEMT. Рост ММБ происходил при постоянной температуре подложки (Тподл = 380°C). Нижний барьерный слой MHEMT был сформирован при Тподл = 480°C. Скорость роста эпитаксиальных слоев равнялась 0.5 мкм ч–1. Перед ростом нижнего барьерного слоя для повышения Тподл процесс эпитаксии был остановлен на пять минут. В процессе роста состав элементов конструкции MHEMT контролировался температурой молекулярных источников In, Al, Ga, As и Si (последний из элементов использовался для ${\delta }$-легирования) на основе предварительной калибровки температурной зависимости молекулярных потоков. Перед выращиванием ММБ на подложке была сформирована сверхрешетка, на которой выращен слой из чистого GaAs толщиной 100 нм. Схематическое представление выращенной конструкции MHEMT показано на рис. 1.
Рис. 1.
Схематическое представление MHEMT с квантовой ямой AlInAs/AlGaAs/AlInAs, содержащей пятиступенчатый ММБ. Конструкционные элементы гетероструктуры: 1–5 – ступени ММБ с увеличивающимся содержанием In, 6 – нижний барьерный слой, 7 – квантовая яма, 8 – спейсер, 9 – δ-слой, 10 – верхний барьерный слой, 11 – кэп-слой.

Аттестация MHEMT
Аттестацию гетероструктуры выращенного MHEMT проводили методами вторичной ионной масс-спектрометрии (ВИМС) и просвечивающей электронной микроскопии (ПЭМ). Использовали масс-спектрометр IMS-4f фирмы Cameca. При профилировании в качестве первичного ионного пучка использовали ионы Cs+ с энергией 5.5 кэВ. В качестве вторичных ионов регистрировали ионы GaCs$_{2}^{ + }$, InCs$_{2}^{ + }$ и AlCs$_{2}^{ + }$. За величину XIn принимали отношение тока ионов InCs$_{2}^{ + }$ к сумме токов ионов GaCs$_{2}^{ + }$, InCs$_{2}^{ + }$ и AlCs$_{2}^{ + }$. Учет выхода ионов GaCs$_{2}^{ + }$ позволил максимально снизить влияние матричного эффекта при проведении анализа состава эпитаксиальных слоев MHEMT методом ВИМС, особенно в области межфазной границы подложка–первая ступень ММБ. Структурная аттестация MHEMT выполнена на микроскопе JeolJEM 2010 при ускоряющем напряжении 200 кВ.
Рентгеновскую съемку проводили в излучении CuKα(1) в трехосевой геометрии при двух азимутальных углах 0° и 90° на прецизионном дифрактометре SmartLab 9kW в пошаговом режиме. В качестве кристалла-анализатора использовали монокристалл Ge с ориентацией (022). Съемку вели в двух рефлексах 004 и 224 (в положении скользящего отражения) в режиме ω–2θ-сканирования, которое заключается в съемке образца по методу Брэгга–Брентано при различных исходных угловых отклонениях подложки от угла Брэгга. Режим ω–2θ-сканирования позволяет построить карты обратного пространства, представляющие собой набор линий равной интенсивности дифрагированного рентгеновского излучения, включая области пучностей (неосновных рентгеновских максимумов), с указанием их расположения вдоль осей обратного пространства: [001] (ось Z) и [110] (ось Y). За начало координат обратного пространства был принят основной рентгеновский максимум, соответствующий подложке. Координаты неосновных рентгеновских максимумов, т.е. значения векторов отклонения ${{q}_{y}}$ и ${{q}_{z}}$ от основного рентгеновского максимума, определяли путем нахождения точки с максимальным значением интенсивности дифрагированного рентгеновского излучения с помощью специальной опции компьютерной программы Origin 15.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ
Общий вид гетероструктуры (светлопольное ПЭМ-изображение ее поперечного сечения), а также пространственное распределение мольной доли In, XIn, в эпитаксиальных слоях MHEMT показаны на рис. 2. Видно, что в нижних четырех ступенях ММБ наблюдаются скопления дислокаций, в то время как пятая ступень и прилегающий к ней нижний барьерный слой от дислокаций свободны. В структурном отношении финальные эпитаксиальные слои (слои 5 и 6) являются единым конструкционным элементом, который ввиду отсутствия в них прорастающих дислокаций можно рассматривать как бездислокационную область. Далее совокупность ступени 5 ММБ и нижнего барьерного слоя рассматривается как объединенный слой 5 толщиной 0.4 мкм. Из данных ВИМС следует, что величина XIn в эпитаксиальных слоях MHEMT совпадает с задаваемыми в процессе роста концентрациями In, а глубина залегания In в пространстве соответствует задаваемым толщинам эпитаксиальных слоев.
Рис. 2.
Светлопольное ПЭМ-изображение поперечного сечения исследуемой гетероструктуры MHEMT (а) и пространственное распределение мольного содержания In в эпитаксиальных слоях, полученное методом ВИМС (б). Цифрами обозначены порядковые номера эпитаксиальных слоев.
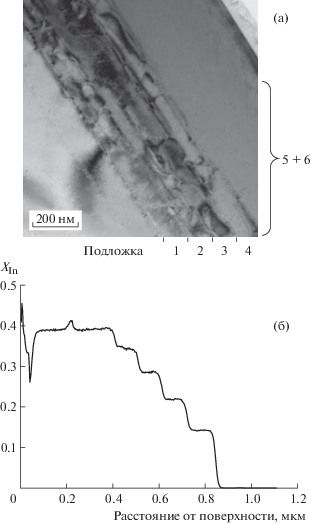
Карты обратного пространства (отражения 004 и 224) для изученной гетероструктуры MHEMT при двух азимутальных углах 0° и 90° показаны на рис. 3. На них видны пять неосновных рентгеновских максимумов, которые в соответствии с ростом величины $\left| {{{q}_{{\text{z}}}}} \right|$ можно приписать слоям 1, 2, 3, 4 и 5 (6). Наличие одного (пятого по счету) сильного рефлекса свидетельствует о том, что слои 5 и 6 являются в структурном отношении одинаковыми, что согласуется с результатами исследования ПЭМ.
Рис. 3.
Карты обратного пространства, полученные на основе отражений 004 и 224, для двух азимутальных углов: 0° (a) и 90° (б). Цифрами обозначены порядковые номера эпитаксиальных слоев, ответственных за появление данного рентгеновского максимума.

Карты обратного пространства позволяют определить так называемые “полные” (относительно
подложки GaAs) деформации ${{{\varepsilon }}_{ \bot }}$ и ${{{\varepsilon }}_{{{\text{||}}}}}$ каждого из эпитаксиальных слоев: ${{{\varepsilon }}_{ \bot }}$ вдоль кристаллографической оси [001] (${{{\varepsilon }}_{ \bot }} = {{\left[ {{{\left( {{{a}_{ \bot }} - {{a}_{s}}} \right)} \mathord{\left/ {\vphantom {{\left( {{{a}_{ \bot }} - {{a}_{s}}} \right)} {{{a}_{s}}}}} \right. \kern-0em} {{{a}_{s}}}}} \right]}_{{\left\langle {100} \right\rangle }}}$) и ${{{\varepsilon }}_{{{\text{||}}}}}$ вдоль кристаллографических осей [110] и [1$\bar {1}$0] (${{\varepsilon }_{{||}}} = {{[({{a}_{{||}}} - {{a}_{s}}){\text{/}}{{a}_{s}}]}_{{\left\langle {110} \right\rangle }}}$), где ${{a}_{ \bot }}$ и ${{a}_{{||}}}$ – вертикальный и латеральный периоды решетки слоя в соответствующих кристаллографических
направлениях, ${{a}_{s}}$ – период решетки подложки. Необходимость определения двух значений ${{{\varepsilon }}_{{\left[ {{\text{110}}} \right]}}}$ и  обусловлена существованием в химических соединениях GaAs, InAs и AlAs двух типов
дислокаций, так называемых α- и β-дислокаций [19], которые ответственны за релаксационные процессы в двух взаимно перпендикулярных
направлениях [110] и [1$\bar {1}$0]. Эти направления в указанных веществах неэквивалентны, так как вектор Бюргерса
в них связан с подрешетками, образованными различными сортами атомов. Процедура определения
величин ${{\varepsilon }_{ \bot }}$ и ${{\varepsilon }_{{||}}}$ на основе соответствующих карт обратного пространства описана в [20]. Для определения компонент тензора упругой деформации ${{e}_{{ii}}}$ и ${{e}_{{ij}}}$ необходимо перейти от ${{{\varepsilon }}_{{\left[ {110} \right]}}}$ и ${{{\varepsilon }}_{{\left[ {1\bar {1}0} \right]}}}$ к ${{{\varepsilon }}_{{11}}}$ и ${{{\varepsilon }}_{{22}}}$ – диагональным компонентам тензора полных упругих деформаций, записанным в главных
кристаллографических осях. Такой переход достигается вращением системы декартовых
координат вокруг оси [001] на угол 45°. Соответствующие компоненты ${{{\varepsilon }}_{{11}}}$ и ${{{\varepsilon }}_{{22}}}$, а также недиагональный компонент ${{{\varepsilon }}_{{12}}}$ будут равны
обусловлена существованием в химических соединениях GaAs, InAs и AlAs двух типов
дислокаций, так называемых α- и β-дислокаций [19], которые ответственны за релаксационные процессы в двух взаимно перпендикулярных
направлениях [110] и [1$\bar {1}$0]. Эти направления в указанных веществах неэквивалентны, так как вектор Бюргерса
в них связан с подрешетками, образованными различными сортами атомов. Процедура определения
величин ${{\varepsilon }_{ \bot }}$ и ${{\varepsilon }_{{||}}}$ на основе соответствующих карт обратного пространства описана в [20]. Для определения компонент тензора упругой деформации ${{e}_{{ii}}}$ и ${{e}_{{ij}}}$ необходимо перейти от ${{{\varepsilon }}_{{\left[ {110} \right]}}}$ и ${{{\varepsilon }}_{{\left[ {1\bar {1}0} \right]}}}$ к ${{{\varepsilon }}_{{11}}}$ и ${{{\varepsilon }}_{{22}}}$ – диагональным компонентам тензора полных упругих деформаций, записанным в главных
кристаллографических осях. Такой переход достигается вращением системы декартовых
координат вокруг оси [001] на угол 45°. Соответствующие компоненты ${{{\varepsilon }}_{{11}}}$ и ${{{\varepsilon }}_{{22}}}$, а также недиагональный компонент ${{{\varepsilon }}_{{12}}}$ будут равны
(1)
${{{\varepsilon }}_{{11}}} = {{{\varepsilon }}_{{22}}} = \frac{{{{{\varepsilon }}_{{[110]}}} + {{{\varepsilon }}_{{[1\bar {1}0]}}}}}{2},$(2)
${{{\varepsilon }}_{{12}}} = \frac{{{{{\varepsilon }}_{{[1\bar {1}0]}}} - {{{\varepsilon }}_{{[110]}}}}}{2}.$Упругие деформации ${{e}_{{ij}}}$ (отнесенные к равновесному состоянию вещества) в обобщенном виде, включающем в себя случай $i = j$, определяются выражением
(3)
${{e}_{{ij}}} = \frac{{{{{\varepsilon }}_{{ij}}} - {{{\delta }}_{{ij}}}{\varepsilon }_{0}^{V}}}{{1 + {\varepsilon }_{0}^{V}}},$(4)
${{{\sigma }}_{{33}}} = \frac{{({{S}_{{11}}} + {{S}_{{12}}}){{e}_{{33}}} - 2{{S}_{{12}}}{{e}_{{11}}}}}{{({{S}_{{11}}} + {{S}_{{12}}}){{S}_{{11}}} - 2S_{{12}}^{2}}},$(5)
${{{\sigma }}_{{11}}} = \frac{{{{e}_{{11}}} - {{S}_{{12}}}{{{\sigma }}_{{33}}}}}{{{{S}_{{11}}} + {{S}_{{12}}}}},$ , иллюстрирует рис. 4. Видно, что эти зависимости “коррелируют” между собой в соответствии с принципом
зеркальной симметрии. Уменьшение фактора зацепления при переходе от четвертого слоя
к пятому бездислокационному слою свидетельствует о резком увеличении межслоевого упругого
взаимодействия [7], что обеспечивает условие перехода от релаксированной области к бездислокационной.
Уменьшению величины ${{f}_{i}}$ для пятого слоя (более чем на порядок по сравнению со значениями ${{f}_{i}}$ для других слоев) сопутствует изменение характера структурных фрагментов в области
сочленения этих двух слоев (рис. 5). Наряду с фрагментами, на которых имеется четкое изображение границы раздела между
четвертым и пятым слоями (рис. 5а), наблюдаются структурные фрагменты, на которых граница раздела отсутствует (рис. 5б). Такой тип сочленения двух фаз с одинаковыми кристаллическими решетками, но не
совпадающими периодами решеток, наблюдается при псевдоморфном гетероэпитаксиальном
росте, и ему соответствует высокий уровень латеральных напряжений. Пространственное
распределение $\left| {{{{\sigma }}_{{11}}}} \right|({\varepsilon }_{0}^{V})$ подобно распределению $\left| {{{e}_{{11}}}} \right|({\varepsilon }_{0}^{V})$ “коррелирует” с пространственным распределением ${{f}_{i}}({\varepsilon }_{0}^{V})$ на основе принципа зеркальной симметрии. Отметим, что для зависимостей $\left| {{{{\sigma }}_{{33}}}} \right|({\varepsilon }_{0}^{V})$ и $\left| {{{e}_{{33}}}} \right|({\varepsilon }_{0}^{V})$ подобной зеркальной симметрии с фактором межслоевого структурного “зацепления” не
наблюдается.
, иллюстрирует рис. 4. Видно, что эти зависимости “коррелируют” между собой в соответствии с принципом
зеркальной симметрии. Уменьшение фактора зацепления при переходе от четвертого слоя
к пятому бездислокационному слою свидетельствует о резком увеличении межслоевого упругого
взаимодействия [7], что обеспечивает условие перехода от релаксированной области к бездислокационной.
Уменьшению величины ${{f}_{i}}$ для пятого слоя (более чем на порядок по сравнению со значениями ${{f}_{i}}$ для других слоев) сопутствует изменение характера структурных фрагментов в области
сочленения этих двух слоев (рис. 5). Наряду с фрагментами, на которых имеется четкое изображение границы раздела между
четвертым и пятым слоями (рис. 5а), наблюдаются структурные фрагменты, на которых граница раздела отсутствует (рис. 5б). Такой тип сочленения двух фаз с одинаковыми кристаллическими решетками, но не
совпадающими периодами решеток, наблюдается при псевдоморфном гетероэпитаксиальном
росте, и ему соответствует высокий уровень латеральных напряжений. Пространственное
распределение $\left| {{{{\sigma }}_{{11}}}} \right|({\varepsilon }_{0}^{V})$ подобно распределению $\left| {{{e}_{{11}}}} \right|({\varepsilon }_{0}^{V})$ “коррелирует” с пространственным распределением ${{f}_{i}}({\varepsilon }_{0}^{V})$ на основе принципа зеркальной симметрии. Отметим, что для зависимостей $\left| {{{{\sigma }}_{{33}}}} \right|({\varepsilon }_{0}^{V})$ и $\left| {{{e}_{{33}}}} \right|({\varepsilon }_{0}^{V})$ подобной зеркальной симметрии с фактором межслоевого структурного “зацепления” не
наблюдается.
Таблица 1.
Результаты рентгеноструктурного анализа и параметры упруго-напряженного состояния эпитаксиальных слоев MHEMT, рассчитанные на основании закона Гука
| Параметры | Слой 1 | Слой 2 | Слой 3 | Слой 4 | Слой 5 |
|---|---|---|---|---|---|
| ${{X}_{{{\text{In}}}}}$ | 0.15 | 0.23 | 0.29 | 0.35 | 0.39 |
| ${\varepsilon }_{0}^{V}$, $ \times {{10}^{{ - 3}}}$ | 12.10 | 17.71 | 21.92 | 26.12 | 28.92 |
| ${{{\varepsilon }}_{{[110]}}}$, $ \times {{10}^{{ - 3}}}$ | 8.52 | 13.01 | 17.06 | 21.78 | 22.19 |
| ${{{\varepsilon }}_{{[1\bar {1}0]}}}$, $ \times {{10}^{{ - 3}}}$ | 8.07 | 12.63 | 16.65 | 21.43 | 21.79 |
| ${{{\varepsilon }}_{{11}}}$, $ \times {{10}^{{ - 3}}}$ | 8.30 | 12.82 | 16.86 | 21.61 | 21.99 |
| ${{{\varepsilon }}_{ \bot }}({{0}^{{\text{o}}}})$, $ \times {{10}^{{ - 3}}}$ | 10.77 | 15.90 | 20.11 | 23.85 | 29.89 |
| ${{{\varepsilon }}_{ \bot }}({{90}^{{\text{o}}}})$, $ \times {{10}^{{ - 3}}}$ | 10.77 | 16.00 | 20.09 | 23.93 | 29.79 |
| ${{{\varepsilon }}_{{33}}}$, $ \times {{10}^{{ - 3}}}$ | 10.77 | 15.95 | 20.10 | 23.89 | 29.84 |
| ${{{\varepsilon }}_{{12}}}$, $ \times {{10}^{{ - 4}}}$ | –2.25 | –1.90 | –2.05 | –1.75 | –2.0 |
| ${{e}_{{11}}}$, $ \times {{10}^{{ - 3}}}$ | –3.76 | –4.80 | –4.95 | –4.40 | –6.74 |
| ${{e}_{{33}}}$, $ \times {{10}^{{ - 3}}}$ | –1.32 | –1.73 | –1.78 | –2.17 | 0.89 |
| ${{e}_{{12}}}$, $ \times {{10}^{{ - 4}}}$ | –2.22 | –1.87 | –2.01 | –1.71 | –1.94 |
| ${{{\sigma }}_{{11}}}$, МПа | –712.9 | –891.5 | –902.7 | –819.7 | –1019.4 |
| ${{{\sigma }}_{{33}}}$, МПа | –566.7 | –714.9 | –725.2 | –698.5 | –612.2 |
| ${{f}_{i}}$, $ \times {{10}^{{ - 3}}}$ | 8.065 | 4.525 | 3.973 | 4.699 | 0.357 |
Рис. 4.
Сопоставление пространственных распределений модуля остаточных латеральных упругих деформаций $\left| {{{e}_{{11}}}} \right|$ и фактора межслоевого структурного “зацепления” ${{f}_{i}}$, построенных в виде зависимости от параметра рассогласования ${\varepsilon }_{0}^{V}$, рассчитанного на основании закона Вегарда.

СТРУКТУРНОЕ СОСТОЯНИЕ ЭПИТАКСИАЛЬНЫХ СЛОЕВ MHEMT В УСЛОВИЯХ ДЕФОРМАЦИОННОГО УПРОЧНЕНИЯ
При анализе упруго-напряженного состояния эпитаксиальных слоев в многослойных MHEMT большую роль играет параметр рассогласования ${\varepsilon }_{0}^{{sl}}$, рассчитываемый на основании теории упругости при описании упруго-напряженного состояния одиночного эпитаксиального слоя со свободной поверхностью [24]. Выражение для расчета величины ${\varepsilon }_{0}^{{sl}}$ имеет вид
(7)
${\varepsilon }_{0}^{{sl}} = {\varepsilon }_{{33}}^{{sl}} - \frac{{2{{С}_{{12}}}}}{{{{С}_{{11}}} + 2{{С}_{{12}}}}}({\varepsilon }_{{33}}^{{sl}} - {\varepsilon }_{{11}}^{{sl}}),$Дадим формальное описание упруго-напряженного состояния эпитаксиальных слоев MHEMT в условиях деформационного упрочнения. В кристаллах кубической сингонии процесс всестороннего сжатия вдоль главных кристаллографических осей (случай, соответствующий исследуемой гетероструктуре MHEMT) является аналогом процесса сжатия изотропных материалов в условиях гидростатического давления. При этом относительное изменение элементарного объема ${{\Delta V} \mathord{\left/ {\vphantom {{\Delta V} V}} \right. \kern-0em} V}$ описывается выражением
где ${\beta }$ – объемный модуль упругости (для рассматриваемого случая β = (С11 + 2С12)/3), ${{{\sigma }}_{{bc}}}$ – сжимающие напряжения вдоль главных кристаллографических осей. Поскольку в кристаллах кубической сингонии при продольных деформациях вдоль осей 〈100〉 коэффициент Пуассона не зависит от латеральных кристаллографических направлений [25], выражение (8) может быть использовано для расчета параметра рассогласования эпитаксиального слоя ${\varepsilon }_{0}^{{bc}}$, вызванного всесторонним сжатием исходного кристалла, находящегося первоначально в равновесном состоянии. Соответствующее выражение имеет вид(9)
${\varepsilon }_{0}^{{bc}} = (1 + {\varepsilon }_{0}^{V}){{\left( {1 - \left| {\frac{{{{{\sigma }}_{{bc}}}}}{{\beta }}} \right|} \right)}^{{1/3}}} - 1.$Для двухстадийного деформационного процесса упругую деформацию $e_{{ii}}^{{\bmod }}$ можно представить как сумму деформации всестороннего сжатия $e_{0}^{{bc}}$ и латеральной (или вертикальной) деформации ${{u}_{{ii}}}$, возникающей при двухосном сжатии:
причем обе эти величины, $e_{0}^{{bc}}$ и ${{u}_{{ii}}}$, связаны с параметром рассогласования ${\varepsilon }_{a}^{{sl}}$. Связь между деформациями $e_{0}^{{bc}}$, ${{u}_{{ii}}}$ и величиной ${\varepsilon }_{a}^{{sl}}$ устанавливают соотношения(11)
$e_{0}^{{bc}} = \frac{{{\varepsilon }_{a}^{{sl}} - {\varepsilon }_{0}^{V}}}{{1 + {\varepsilon }_{0}^{V}}},$(12)
${{u}_{{ii}}} = \frac{{{{{\varepsilon }}_{{ii}}} - {\varepsilon }_{a}^{{sl}}}}{{1 + {\varepsilon }_{a}^{{sl}}}}.$(14)
${{{\tau }}_{{11}}} = \frac{{({{С}_{{11}}} + 2{{С}_{{12}}})}}{{{{С}_{{11}}}}}({{С}_{{11}}} - {{С}_{{22}}})\frac{{{{{\varepsilon }}_{{11}}} - {\varepsilon }_{a}^{{sl}}}}{{1 + {\varepsilon }_{a}^{{sl}}}}.$(15)
$\begin{gathered} \Delta {{F}_{{v}}} = \frac{1}{2}{{C}_{{11}}}({{e}_{{11}}}^{2} + e_{{22}}^{2} + e_{{33}}^{2}) + \\ + \;{{C}_{{12}}}({{e}_{{11}}}{{e}_{{22}}} + {{e}_{{11}}}{{e}_{{33}}} + {{e}_{{22}}}{{e}_{{33}}}) + \\ + \,2{{С}_{{44}}}(e_{{12}}^{2} + e_{{13}}^{2} + e_{{23}}^{2}). \\ \end{gathered} $Таблица 2.
Параметры упруго-напряженного состояния MHEMT, реализующегося в результате двухстадийного деформационного процесса
| Параметры | Слой 1 | Слой 2 | Слой 3 | Слой 4 | Слой 5 |
|---|---|---|---|---|---|
| ${\varepsilon }_{a}^{{sl}}$, $ \times {{10}^{{ - 3}}}$ | 9.56 | 14.41 | 18.49 | 22.76 | 25.93 |
| ${{u}_{{11}}}$, $ \times {{10}^{{ - 3}}}$ | –1.25 | –1.56 | –1.61 | –1.12 | –3.84 |
| $e_{0}^{{bc}}$, $ \times {{10}^{{ - 3}}}$ | –2.52 | –3.26 | –3.35 | –3.28 | –2.91 |
| $e_{{11}}^{{\bmod }}$, $ \times {{10}^{{ - 3}}}$ | –3.77 | –4.82 | –4.96 | –4.4 | –6.75 |
| ${{{\tau }}_{{{\text{11}}}}}$, МПа | –145.7 | –177.1 | –178.1 | –121.5 | –408.5 |
| ${\sigma }_{{11}}^{{\bmod }}$, МПа | –712.4 | –892 | –903.3 | –820 | –1020.7 |
| $\Delta F_{{v}}^{{bc}}$, Дж/см3 | 2.14 | 3.48 | 3.64 | 3.44 | 2.67 |
| $\Delta F_{{v}}^{{ba}}$, Дж/см3 | 0.18 | 0.28 | 0.29 | 0.14 | 1.57 |
| $\Delta F_{{v}}^{\Sigma }$, Дж/см3 | 2.32 | 3.76 | 3.93 | 3.58 | 4.24 |
| $\Delta {{F}_{{v}}}$, Дж/см3 | 3.06 | 4.90 | 5.12 | 4.37 | 6.60 |
Отметим, что для всех эпитаксиальных слоев MHEMT выполняется неравенство $\Delta F_{{v}}^{\Sigma } < \Delta {{F}_{{v}}}$. Таким образом, “упорядоченный” деформационный процесс, сводящийся к двум последовательным элементарным схемам деформации, характеризуется меньшей работой деформации (и соответственно меньшей свободной энергией системы) по сравнению с “хаотически” организованным деформационным процессом, что обеспечивает энергетический выигрыш образующегося при этом метастабильного состояния. Структурное состояние элементарного объема эпитаксиальных слоев в многослойной гетероструктуре MHEMT можно описать как состояние всесторонне сжатой квазиячейки, обладающей свойством одиночного слоя со свободной поверхностью. При этом энергетические затраты, связанные с эффектом деформационного упрочнения, являются затратами на проведение процесса всестороннего сжатия.
ЗАКЛЮЧЕНИЕ
В многослойной тонкопленочной системе, представляющей собой гетероструктуру с пятиступенчатым метаморфным буфером с толщинами слоев 100–200 нм, наряду с латеральными сжимающими упругими деформациями, появление которых типично при метаморфном эпитаксиальном росте, наблюдаются вертикальные сжимающие упругие деформации, связанные с эффектом деформационного упрочнения. Выполнено моделирование упруго-напряженного состояния слоев гетероструктуры, возникающего в процессе эпитаксиального роста, основанное на представлении о протекании в системе двухстадийного деформационного процесса: всестороннего (первая стадия) и двухосного (вторая стадия) сжатия. Показано, что протекание двухстадийного деформационного процесса при эпитаксиальном росте слоев обеспечивает минимальное энергетическое состояние многослойной тонкопленочной системы по сравнению с “хаотическим” нерегулируемым процессом структурной релаксации. Установлено, что эффект деформационного упрочнения изменяет структурное состояние эпитаксиальных слоев, в результате чего кристаллическая решетка каждого эпитаксиального слоя находится в состоянии всестороннего сжатия, образуя при этом квазиячейку, обладающую свойством слоя со свободной поверхностью. На основании проведенных исследований можно сделать вывод, что при эпитаксиальном росте в результате структурной релаксации происходит самоорганизация многослойной тонкопленочной системы через «механизм» двухстадийного деформационного процесса.
Авторы выражают благодарность профессору Б.С. Бокштейну за полезное обсуждение полученных результатов.
Список литературы
Imaizumi M., Hirotani M., Soga T. Proceedings of 2015 IEEE 42nd Photovoltaic Specialist Conference, New Orleans, LA, 2015. 5 p.
Kumar R., Bag A., Mukhopadhyay P. et al. // Appl. Surf. Sci. 2015. V. 357. P. 922.
Kujofsa T., Ayers J.E. // Int. J. High Speed Electronics Systems. 2015. V. 24. P. 152009.
Галиев Г.Б., Климов E.А., Имамов Р.М. и др. // Поверхность. Рентген., синхротр. и нейтр. исслед. 2016. № 5. С. 32.
Romanato F., Napolitani E., Carnera A. et al. // J. Appl. Phys. 1999. V. 86. P. 4748.
Capotondi F., Biasiol G., Ercolani D. et al. // Thin Solid Films. 2005. V. 484. P. 400.
Tersoff J. // Appl. Phys. Lett. 1993. V. 62. P. 693.
Dunstan D.J., Kidd P., Fewster P.E. et al. // Appl. Phys. Lett. 1994. V. 65. P. 839.
Dunstan D.J. // Philos. Mag. A. 1996. V. 73. P. 1323.
Beanland R., Dunstan D.J., Goodhew P.J. // Adv. Phys. 1996. V. 45. P. 87.
Dunstan D.J., Young S., Dixon R.H. // J. Appl. Phys. 1991. V. 70. P. 3038.
Dunstan D.J., Kidd P., Howard L.K., Dixon R.H. // Appl. Phys. Lett. 1991. V. 59. P. 3390.
Dodson B.W. // J. Appl. Phys. 1988. V. 53. P. 37.
Gonzalez D., Araujo D., Aragon G., Garcia R. // Appl. Phys. Lett. 1997. V. 71. P. 2475.
Freund L.B., Ramirez J.C., Bower A.F. // Mat. Res. Soc. Symp. Proc. 1990. V. 160. P. 47.
Gonzalez D., Araujo D., Aragon G., Garcia R. // Appl. Phys. Lett. 1997. V. 71. P. 3099.
Ayers J.E., Ghandhi S.K., Schowalter L.J. // J. Cryst. Growth. 1991. V. 113. P. 430.
Алёшин А.Н., Бугаев А.С., Ермакова М.А., Рубан О.А. // Физика и техника полупроводников. 2015. Т. 49. С. 1065.
Feuillet G., Cherns D. // Mater. Sci. Forum. 1986. V. 10–12. P. 803.
Алёшин А.Н., Бугаев А.С., Ермакова М.А., Рубан О.А. // Кристаллография. 2016. Т. 61. № 2. С. 300.
Tu K.N., Mayer J.W., Feldman L.S. Electronic thin film science. For electrical engineers and materials scientists. New York: Macmillan Publishing Company, 1992. 428 p.
Стрельченко С.С., В.В. Лебедев В.В. Соединения A3B5. Справочник. М.: Металлургия, 1984. 144 с.
Ayers J.E. Heteroepitaxy of semiconductors. Theory, growth, and characterization. Roca Raton: Taylor and Francis Group, 2007. 439 p.
Khapachev Yu.P., Dyshekov A.A., Kiselev D.S. // Phys. Status Solidi. B. 1984. V. 126. P. 37.
Ballato A. // IEEE Transactions on Ultrasonics, Ferroelectrics, and Frequency Control. 1996. V. 43. № 1. P. 56.
Ландау Л.Д., Лифшиц Е.М. Теоретическая физика. Т. VII. Теория упругости. М.: Физматлит, 2003. 264 с.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография



