Кристаллография, 2020, T. 65, № 3, стр. 489-494
Влияние условий зарождения на структуру слоев оксида цинка
А. Х. Абдуев 1, А. К. Ахмедов 1, А. Ш. Асваров 1, 2, *, А. Э. Муслимов 2, В. М. Каневский 2
1 Институт физики им. Х.И. Амирханова Дагестанского федерального исследовательского центра РАН
Махачкала, Россия
2 Институт кристаллографии им. А.В. Шубникова ФНИЦ “Кристаллография и фотоника” РАН
Москва, Россия
* E-mail: abil-as@list.ru
Поступила в редакцию 23.10.2019
После доработки 13.11.2019
Принята к публикации 18.11.2019
Аннотация
Изучены температурные условия зарождения слоев ZnO на термически окисленных с поверхности кремниевых подложках при магнетронном распылении металлокерамической мишени ZnO–Zn (30 мол. %) в атмосфере Ar и осаждении методом химического газового транспорта в потоке водорода при взаимодействии паров Zn и H2O. Показано, что превышение температуры 450°С на поверхности роста приводит к существенному ускорению процесса десорбции цинка и подавлению процесса формирования слоев. Выявлено, что необходимым условием формирования слоев ZnO при высоких температурах является проведение двухступенчатого осаждения с низкотемпературным формированием подслоя.
ВВЕДЕНИЕ
Широкий спектр функциональных свойств и высокая совместимость с традиционными полупроводниковыми материалами делают тонкие пленки оксида цинка весьма перспективным материалом для различных приложений микро- и оптоэлектроники [1–8].
Среди многочисленных методов формирования поликристаллических пленок ZnO наиболее широкое применение нашли различные модификации магнетронного распыления [9, 10] и химического осаждения (газотранспортный синтез, атомно-слоевое осаждение, спрей-пиролиз) [11–13]. При очевидных преимуществах метода магнетронного распыления (высокая степень контроля процесса и простота масштабирования метода от лабораторных условий до промышленного применения) основным его недостатком является характерная бомбардировка растущей поверхности пленки ZnO заряженными частицами. Индуцируемые бомбардировкой дефекты приводят к неоднородности физических свойств по поверхности пленки и общему снижению структурного совершенства пленки [14, 15]. В свою очередь, методы химического осаждения в условиях, близких к равновесным, с относительно высокой скоростью позволяют получать совершенные пленки ZnO c приемлемыми для оптоэлектронных применений свойствами [16, 17].
Анализ результатов многочисленных исследований процессов формирования слоев ZnO на различных подложках показывает решающее влияние начальной стадии зарождения на структуру и свойства слоев [8, 13, 18–20]. В [8] показано, что при магнетронном синтезе слоев ZnO : Ga увеличение содержания галлия в составе потока реагентов на начальной стадии осаждения способствует ускорению процессов формирования и коалесценции зародышей и, как следствие, росту кристаллического совершенства слоев, формируемых на подслоях с увеличенным содержанием примесной компоненты. В [21] показано, что увеличение содержания атомарного цинка в составе потока реагентов в определенном диапазоне температур подложек (200–500°С) приводит к увеличению длины миграции осаждаемых атомов на поверхности роста и подавлению процесса формирования столбчатых структур. Наблюдаемый эффект аналогичен механизму увеличения поверхностной подвижности адатомов при молекулярно-лучевой эпитаксии нитридов алюминия и галлия в режиме “избыток металла” [22, 23].
В [20, 24] продемонстрировано, что для синтеза эпитаксиальных пленок ZnO высокого структурного и оптического качества методами химического осаждения необходимо повышать температуру синтеза. Ранее авторами было показано, что высокотемпературное формирование эпитаксиальных слоев ZnO в обратимой реакции ZnO + + H2 ↔ Zn + H2O может протекать лишь при условии предварительного осаждения подслоя при температурах ниже 400°С [25]. В свою очередь, было продемонстрировано, что использование предварительно нанесенных буферных подслоев ZnO на подложках Si улучшает кристаллическое и оптическое качество основного слоя ZnO [26], наблюдаются снижение макронапряжений [17] и рост адгезии [27].
В настоящей работе предпринята попытка определения общих закономерностей зарождения и роста слоев ZnO на окисленном кремнии при магнетронном и газотранспортном осаждении в присутствии паров цинка.
МАТЕРИАЛЫ И МЕТОДЫ
Все слои оксида цинка, рассматриваемые в работе, синтезированы на подложках из термически окисленного с поверхности кремния КЭФ размером 25 × 10 × 0.5 мм3. Часть слоев получена в установке “МАГНЕТРОН” (г. Воткинск, Россия) методом магнетронного распыления на постоянном токе металлокерамической мишени ZnO–Zn (содержание металлической фазы 30 мол. %) при следующих режимах: давление рабочего газа (Ar) 0.1 Пa, ток разряда 600 мА, расстояние мишень–подложка 10 см. Температура подложки варьировалась от 150 до 800°С. Суммарное время напыления составляло 60 мин.
Другая часть слоев получена методом химического газового транспорта в проточном реакторе пониженного давления (ПРПД) с использованием реакции ZnO + H2 ↔ Zn + H2O [27, 28].
Газофазное осаждение слоев ZnO на чистые подложки и подложки с подслоем ZnO, предварительно нанесенным методом магнетронного распыления, осуществлялось в едином цикле при следующих условиях: температура в зоне испарения 740°С, в зоне осаждения – 670°С, давление газа-носителя (H2) 2000 Па при расходе 5 см3/мин.
Морфологию поверхности и сколов тонкопленочных образцов исследовали с помощью сканирующего электронного микроскопа (SEM Leo-1450, Карл Цейсс, Германия). Фазовый состав и структурные свойства выращенных пленок исследовали с использованием порошкового рентгеновского дифрактометра PANalytical Empyrean Series 2 с длиной волны излучения (CuKα) λ = = 0.15418 нм в диапазоне углов 2θ от 25° до 75° с шагом 0.02°. Параметр кристаллической решетки с рассчитывали из положения рефлекса 004 ZnO, а область когерентного рассеяния (ОКР) оценивали по данным рефлекса 002 ZnO.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Ранее было показано, что в случае распыления металлокерамической мишени при температуре подложки выше 100°C избыточный цинк, присутствующий в составе потока реагентов к подложке, не встраивается в растущую пленку. В результате формируется прозрачная в видимом диапазоне пленка без самостоятельной фазы металлического цинка [29].
Данные рентгеновской дифракции (XRD) слоев ZnO, синтезированных методом магнетронного распыления металлокерамической мишени при температурах подложки до 450°С, показывают наличие явно выраженной текстуры (рис. 1). На XRD-спектрах слоев, синтезированных при 150 и 450°С, помимо рефлекса 111 монокристаллической подложки кремния присутствуют только два рефлекса – 002 и 004 ZnO в области углов 2θ = 34° и 72° соответственно. Также видно, что попытка синтеза пленки при 800°С (спектр 3 на рис. 1) на подложке Si не привела к осаждению слоя.
Рис. 1.
Дифрактограммы тонкопленочных образцов, осажденных методом магнетронного распыления при температурах 150 (1), 450 (2), 800°С (3), а также образца, полученного при 800°С на подслое, предварительно нанесенном при температуре 150°С (4). На вставках 1'–4' приведены соответствующие СЭМ-микрофотографии поверхностей тонкопленочных образцов.
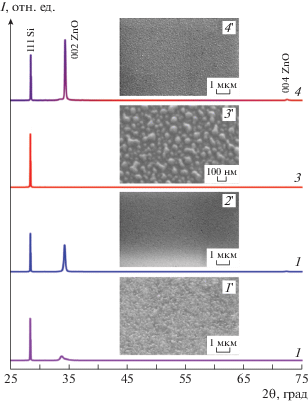
На вставках рис. 1 приведены данные сканирующей электронной микроскопии (СЭМ). Слои, синтезированные при 150°С, имеют достаточно развитую поверхность, что свидетельствует о росте пленки по баллистическому механизму осаждения из-за ограниченной подвижности адатомов [30]. Увеличение температуры до 450°С приводит к росту миграционной способности частиц на поверхности и соответствующей этому гладкой поверхности сформированной пленки. Дальнейшее увеличение температуры до 800°С приводит к тому, что скорость роста слоев снижается практически до нуля из-за увеличения вероятности десорбции частиц с поверхности подложки; на ее поверхности обнаруживаются лишь многочисленные островковые зародыши с латеральным размером до 100 нм без признаков кристаллической огранки.
С целью получения пленки при 800°С использованы подложки Si с предварительно нанесенным при 150°С подслоем ZnO толщиной примерно 200 нм. Как видно из рис. 1 (спектр 4), наличие такого подслоя способствует дальнейшему формированию пленки при высокой температуре синтеза (800°C). В соответствующем обзорном спектре присутствуют узкие и интенсивные рефлексы, соответствующие отражению от семейства плоскостей (00l) ZnO. По данным СЭМ (вставка 4' рис. 1) синтез пленки ZnO при 800°С с использованием подслоя обеспечивает формирование слоев с относительно гладкой поверхностью.
Анализ формы и положения профилей рефлексов 002 ZnO показывает, что увеличение температуры синтеза слоев от 150 до 450°С сопровождается ростом интенсивности рефлекса 002 ZnO и его смещением в область больших 2θ (рис. 2а), что обусловлено снижением содержания междоузельного цинка в кристаллитах ZnO, уменьшением макронапряжений в пленках и ростом их структурного совершенства [17, 31]. Этому способствует увеличение подвижности осаждаемых атомов цинка на поверхности роста. Отметим составной характер рефлекса 002 ZnO в слоях, нанесенных при 800°С на подложку с подслоем. Он образован суперпозицией низкотемпературного нестехиометричного подслоя и слоя, синтезированного при высокой температуре. В таблице обобщены результаты обработки данных XRD для всех синтезированных образцов. С ростом температуры синтеза наблюдаются уменьшение параметра c кристаллической решетки ZnO, приближающегося к табличному значению (PDF № 00-036-1451), и увеличение ОКР D002. Наибольшим кристаллическим совершенством обладает пленка, синтезированная при максимальной температуре с использованием предварительно нанесенного подслоя. На рис. 2б–2г приведены микрофотографии сколов пленок, синтезированных при 150, 450°С на подложке Si и при 800°С на подложке с подслоем. Все пленки ZnO, включая образец, осажденный на подслое, имеют столбчатую структуру. Меньшая толщина пленки, осажденной при 800°С на подслой, свидетельствует о низкой скорости роста и приближении процесса роста к равновесным условиям.
Рис. 2.
Профили рефлексов 002 ZnO образцов, синтезированных при температурах 150°С (1), 450°С (2), и образца, полученного при 800°С на подслое (3) (а). На вставке показана увеличенная область рефлексов вблизи фонового уровня. СЭМ-микрофотографии поперечных сколов тонкопленочных образцов, синтезированных при температурах 150°С (б), 450°С (в), и образца, полученного при 800°С на подслое (г).
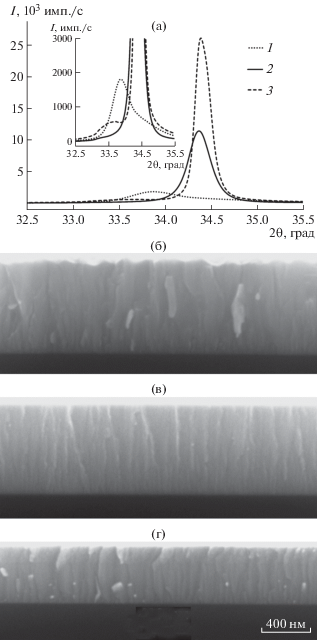
Исследование процесса синтеза пленок ZnO из потока паров цинка и окислителя на подложках кремния в условиях, приближенных к равновесным, с использованием газотранспортной реакции ZnO + H2 ↔ Zn + H2O также показало, что при высоких температурах синтеза в зоне осаждения ПРПД формирования сплошного слоя ZnO на чистой подложке кремния не наблюдается. Согласно данным оптической микроскопии (рис. 3а) на подложке при температуре в зоне роста 670°С происходит формирование островковых зародышей ZnO в локальных областях (на дефектах, посторонних включениях) и их разрастание без коалесценции. В аналогичных условиях на подложке Si с предварительно сформированным магнетронным распылением подслоем ZnO (температура подложки 300°С, толщина 300 нм) наблюдается формирование сплошного слоя толщиной около 1 мкм (рис. 3б, 3в). На поперечном сколе синтезированной структуры наблюдается четкая граница между подслоем ZnO, нанесенным магнетронным распылением, и основной пленкой ZnO, выращенной химическим осаждением в условиях, приближенных к равновесным. Отметим существенную разницу в поперечном размере столбов для магнетронной пленки, выращенной в условиях, далеких от равновесных, и пленки, синтезированной в ПРПД.
Рис. 3.
Оптическая микрофотография образца, полученного химическим осаждением в ПРПД без предварительно сформированного подслоя (а); СЭМ-микрофотографии поверхности (б) и поперечного скола (в) тонкопленочного образца, полученного в ПРПД на подложке с подслоем ZnO, предварительно сформированным магнетронным распылением.
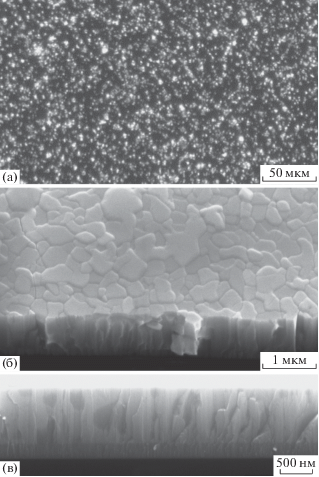
На рис. 4 приведены дифрактограммы магнетронного подслоя ZnO и сформированной двухслойной структуры ZnO. Видно, что основной слой в двухслойной структуре, полученный химическим осаждением, также является текстурированным с ориентацией оси с перпендикулярно поверхности роста. Заметное смещение рефлекса 002 ZnO в область больших углов 2θ по сравнению с положением в подслое обусловлено высокотемпературной десорбцией избыточного цинка и формированием стехиометричных слоев. Оценка размеров ОКР показала, что при химическом осаждении размер кристаллитов достигает больших значений (табл. 1), что находится в согласии с данными СЭМ.
Рис. 4.
Обзорные дифрактограммы исходного подслоя ZnO (1) и пленки ZnO, выращенной на данном подслое в ПРПД (2). На вставке – профили рефлекса 002 ZnO.

Таблица 1.
Результаты обработки данных XRD
| Образец | 2θ002, град | Параметр кристаллической решетки с, нм | FWHM002, град | D002, град |
|---|---|---|---|---|
| Магнетрон, Т = 150°С | 33.85 | 0.5282 ± 0.0005 | 0.589 | 15 |
| Магнетрон, Т = 300°С | 34.28 | 0.5227 ± 0.0001 | 0.288 | 30 |
| Магнетрон, Т = 450°С | 34.35 | 0.5225 ± 0.0001 | 0.262 | 33 |
| Магнетрон, подслой Т0 = 150°С, Т = 800°С | 34.38 | 0.5219 ± 0.0001 | 0.140 | 69 |
| ПРПД, подслой Т0 = 300°С, Т = 670°С | 34.52 | 0.5192 ± 0.0001 | 0.125 | 109 |
ЗАКЛЮЧЕНИЕ
Выполненные исследования позволяют сделать выводы об общих закономерностях зарождения слоев ZnO при магнетронном распылении металлокерамических мишеней в инертной атмосфере и в процессе газотранспортного осаждения в потоке водорода:
– синтез слоев ZnO при магнетронном распылении и химическом осаждении при высоких температурах подложки (>500°C) приводит лишь к формированию отдельных центров кристаллизации на поверхности подложки окисленного кремния из-за интенсивной термодесорбции адатомов с поверхности роста;
– создание при температурах до 450°С центров кристаллизации позволяет осуществить последующий рост слоев при температурах вплоть до 800°С;
– создание буферного подслоя с преимущественной базисной ориентацией приводит в последующем высокотемпературном синтезе к формированию пленок с идентичной ориентацией;
– высокотемпературный синтез слоев ZnO на буферных подслоях ZnO обеспечивает формирование слоев в условиях, близких к равновесным, с высоким структурным совершенством.
Работа выполнена в рамках Государственных заданий Института физики Дагестанского федерального исследовательского центра РАН и ФНИЦ “Кристаллография и фотоника” РАН и при частичной финансовой поддержке Российского фонда фундаментальных исследований (проекты № 19-07-00537, 20-02-00373) с использованием оборудования АЦКП ДФИЦ РАН и ЦКП ФНИЦ “Кристаллография и фотоника” РАН при поддержке Минобрнауки России (проект RFMEFI62119X0035).
Список литературы
Voiculescu I., Li F., Kowach G. et al. // Micromachines. 2019. V. 10. № 10. Article 661. https://doi.org/10.3390/mi10100661
Laurenti M., Castellino M., Perrone D. et al. // Sci. Rep. 2017. V. 7. Article 41957. https://doi.org/10.1038/srep41957
Hu M., Duan F.L. // Solid-State Electron. 2018. V. 150. P. 28. https://doi.org/10.1016/j.sse.2018.08.005
Rahman F. // Opt. Eng. 2019. V. 58. № 1. Article 010901. https://doi.org/10.1117/1.OE.58.1.010901
Adachi Y., Saito N., Sakaguchi I., Suzuki T.T. // Thin Solid Films. 2019. V. 685. P. 238. https://doi.org/10.1016/j.tsf.2019.06.023
Асваров А.Ш., Абдуев А.Х., Ахмедов А.К. и др. // Кристаллография. 2018. Т. 63. № 6. С. 952. https://doi.org/10.1134/s0023476118060036
Lee B.R., Goo J.S., Kim Y.W. et al. // J. Power Sources. 2019. V. 417. P. 61. https://doi.org/10.1016/j.jpowsour.2019.02.015
Abduev A., Akmedov A., Asvarov A., Chiolerio A. // Plasma Processes Polym. 2015. V. 12. № 8. P. 725. https://doi.org/10.1002/ppap.201400230
Liang H. // Solid State Phenom. 2018. V. 278. P. 48. https://doi.org/10.4028/www.scientific.net/SSP.278.48
Sittinger V., Ruske F., Werner W. et al. // Thin Solid Films. 2006. V. 496. № 1. P. 16. https://doi.org/10.1016/j.tsf.2005.08.177
Hamelmann F.U. // J. Phys.: Conf. Ser. 2016. V. 764. Article 012001. https://doi.org/10.1088/1742-6596/764/1/012001
Pilz J., Perrotta A., Christian P. et al. // J. Vac. Sci. Technol. A. 2018. V. 36. № 1. P. 01A109. https://doi.org/10.1116/1.5003334
Zhang J., Cui X., Shi Zh. et al. // Superlattices Microstruct. 2014. V. 71. P. 23. https://doi.org/10.1016/j.spmi.2014.03.030
Vijayalakshmi K., Karthick K., Dhivya P., Sridharan M. // Ceram. Int. 2013. V. 39. P. 5681. https://doi.org/10.1016/j.ceramint.2012.12.085
Ellmer K., Welzel T. // J. Mater. Res. 2012. V. 27. № 5. P. 765. https://doi.org/10.1557/jmr.2011.428
Alivov Ya.I., Van Nostrand J.E., Look D.C. et al. // Appl. Phys. Lett. 2003. V. 83. № 14. P. 2943. https://doi.org/10.1063/1.1615308
Khranovskyy V., Minikayev R., Trushkin S. et al. // J. Cryst. Growth. 2007. V. 308. P. 93. https://doi.org/10.1016/j.jcrysgro.2007.06.034
Inamdar A.I., Mujawar S.H., Sadale S.B. et al. // Sol. Energy Mater. Sol. Cells. 2007. V. 91. № 10. P. 864. https://doi.org/10.1016/j.solmat.2007.01.018
Vasco E., Zaldo C., Vazquez L. // J. Phys.: Condens. Matter. 2001. V. 13. P. L663. https://doi.org/10.1088/0953-8984/13/28/102
Baji Z., Labadi Z., Horvath Z.E. et al. // Cryst. Growth Des. 2012. V. 12. P. 5615. dx.doi.org/.https://doi.org/10.1021/cg301129v
Abduev A., Akhmedov A., Asvarov A. // J. Phys.: Conf. Ser. 2011. V. 291. P. 012039. https://doi.org/10.1088/1742-6596/291/1/012039
Koblmueller G., Averbeck R., Geelhaar L. et al. // J. Appl. Phys. 2003. V. 93. P. 9591. https://doi.org/10.1063/1.1575929
Tsumuki Sh., Akiyama T., Pradipto A.-M. et al. // Jpn. J. Appl. Phys. 2019. V. 58. P. SC1009. https://doi.org/10.7567/1347-4065/ab06b1
Zhang B.P., Wakatsuki K., Binh N.T. et al. // Thin Solid Films. 2004. V. 449. P. 12. https://doi.org/10.1016/S0040-6090(03)01466-4
Абдуев А.Х., Атаев Б.М., Багомадова А.М., Красулин Г.А. // Изв. АН СССР. Неорган. материалы. 1987. № 11. С. 1928.
Jeong S.-H., Kim I.-S., Kim J.-K., Lee B.-T. // J. Cryst. Growth. 2004. V. 264. P. 327. https://doi.org/10.1016/j.jcrysgro.2004.01.006
Shimizu M., Shiosaki T., Kawabata A. // J. Cryst. Growth. 1982. V. 57. № 1. P. 94. https://doi.org/10.1016/0022-0248(82)90253-6
Abduev A., Akhmedov A., Asvarov A., Omaev A. // J. Phys.: Conf. Ser. 2012. V. 345. № 1. P. 012046. https://doi.org/10.1088/1742-6596/345/1/012046
Абдуев А.Х., Ахмедов А.К., Асваров А.Ш. // Письма в ЖТФ. 2014. Т. 40. № 14. С. 71.
Ramanlal P., Sander L.M. // Phys. Rev. Lett. 1985. V. 54. № 6. P. 1828.
Li L.N., Zhao Y., Chen X.L. et al. // Phys. Procedia. 2012. V. 32. P. 687. https://doi.org/10.1016/j.phpro.2012.03.619
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография


