Кристаллография, 2020, T. 65, № 3, стр. 495-501
Структурные характеристики эпитаксиальных сверхрешеток {InGaAs/InAlAs}, выращенных в низкотемпературном режиме на подложках InP (100) и (111)А
Г. Б. Галиев 1, А. Л. Васильев 2, 3, И. С. Васильевский 4, А. Н. Виниченко 4, Е. А. Климов 1, А. Н. Клочков 1, И. Н. Трунькин 2, С. С. Пушкарев 1, *
1 Институт сверхвысокочастотной полупроводниковой электроники им. В.Г. Мокерова РАН
Москва, Россия
2 Национальный исследовательский центр “Курчатовский институт”
Москва, Россия
3 Институт кристаллографии им. А.В. Шубникова ФНИЦ “Кристаллография и фотоника” РАН
Москва, Россия
4 Национальный исследовательский ядерный университет “МИФИ”
Москва, Россия
* E-mail: s_s_e_r_p@mail.ru
Поступила в редакцию 10.10.2019
После доработки 18.10.2019
Принята к публикации 22.10.2019
Аннотация
Исследованы структурные характеристики сверхрешеток {InGaAs/InAlAs}, выращенных методом молекулярно-лучевой эпитаксии при температуре 200°С на подложках InP с кристаллографическими ориентациями поверхности (100) и (111)А. Сверхрешетки состоят из 100 периодов чередующихся слоев In0.53Ga0.47As и In0.52Al0.48As с номинальными толщинами 12 и 8 нм соответственно. Структурное совершенство образцов исследовано методами просвечивающей электронной микроскопии. Показано, что сверхрешетка на подложке InP (100) является монокристаллической с высокой концентрацией дефектов упаковки и двойников, а также малоугловых доменов. Сверхрешетка на подложке InP (111)A является поликристаллической, тем не менее сформированные слои прослеживаются практически по всей толщине сверхрешетки. Волнообразная кривизна слоев, сформированных на подложке InP (111)A, существенно больше, чем на InP (100): диапазоны углов отклонения слоев от горизонтальной плоскости роста доходят до ±30° и ±18° соответственно.
ВВЕДЕНИЕ
Полупроводниковые структуры на основе соединений А3В5, выращенные методом молекулярно-лучевой эпитаксии (МЛЭ) в низкотемпературном режиме (low-temperature growth, LTG), широко используются как материал для изготовления фотопроводящих антенн (ФПА) – генераторов и детекторов электромагнитного излучения терагерцевого диапазона частот [1]. Характерными параметрами материалов для ФПА являются: большое удельное сопротивление (106–107 Ом·см), большая напряженность поля пробоя (∼500 кВ/см), ультракороткое время жизни фотовозбужденных носителей (10–70 пс для ФПА-эмиттера и 0.5 пс для ФПА-детектора) [2]. Одним из первых материалов, который начали использовать при изготовлении ФПА, является LTG–GaAs и гетероструктуры на его основе [1, 2]. Другой разновидностью материалов для ФПА являются эпитаксиальные пленки LTG–InxGa1 – xAs с х < 0.3, выращенные на подложках GaAs [3–5], и пленки LTG–In0.53Ga0.47As на подложках InP [6–9].
Дальнейшие шаги по улучшению характеристик ФПА были связаны с использованием сверхрешеток {InGaAs/InAlAs}, согласованных по параметру решетки с подложками InP. В ряде работ подробно исследованы такие сверхрешетки с различными толщинами слоев, числом периодов и уровнем легирования бериллием, причем наиболее часто используемыми и соответственно лучше исследованными являются сверхрешетки {In0.53Ga0.47As (12 нм)/In0.52Al0.48As (8, 9 нм)} с числом периодов 60–100 [10–15].
В указанных выше работах использовали подложки А3В5 с ориентацией (100), поскольку на них относительно легко удавалось вырастить большое количество всевозможных структур. Но в последние годы появилась возможность выращивания высококачественных эпитаксиальных пленок соединений А3В5 на подложках с ориентациями (111) и (110) [16]. Структуры, выращенные на таких подложках, обладают встроенным вертикальным или латеральным пьезоэлектрическим полем [17, 18]. Это обстоятельство влияет не только на механизмы и особенности эпитаксиального роста, но и на фундаментальные свойства полученных материалов [16, 19–21].
В литературе практически отсутствуют сведения по использованию для создания ФПА подложек А3В 5 с ориентациями, отличными от (100). В предыдущих работах авторов [22–24] показана эффективность структур на подложках GaAs (111)A и InP (411)A для изготовления ФПА по сравнению со структурами на подложках GaAs (100) и InP (100).
Целью настоящей работы является исследование структурных характеристик сверхрешеток {In0.53Ga0.47As/In0.52Al0.48As}, выращенных методом МЛЭ на подложках InP с ориентациями (100) и (111)А в низкотемпературном режиме.
ОБРАЗЦЫ И МЕТОДИКА ЭКСПЕРИМЕНТА
Исследуемые образцы 439 и 440 представляли собой сверхрешетки, выращенные на полуизолирующих подложках InP с кристаллографическими ориентациями поверхности (100) и (111)А. Сверхрешетка состояла из 100 периодов чередующихся нелегированных слоев LTG–In0.53Ga0.47As и LTG–In0.52Al0.48As с номинальными толщинами 12 и 8 нм соответственно. Суммарная толщина гетероструктуры составляла 2 мкм. Образцы выращены на установке МЛЭ Riber Compact 21T 3-5 (Франция). Температура роста образцов составляла 200°С, а парциальные давления потоков элементов V и III групп составляли PAs4 = 1.23 × 10–5, PAl = 1.2 × 10–7, PGa = 3.0 × 10–7, PIn = 5.2 × 10–7 торр. Выращенные образцы подвергали постростовому отжигу при температуре 590°С в течение 30 мин.
Подготовку поперечных срезов образцов для исследований методами просвечивающей электронной микроскопии (ПЭМ) выполняли согласно стандартной методике, описанной в [25]. После механического утонения до толщины 20–40 мкм образцы утоняли ионами Ar+ в установке Gatan 691 (GATAN, США) при ускоряющем напряжении 5 кэВ до образования отверстия. Окончательную полировку выполняли ионами Ar+ с понижением энергии до 0.1 кэВ. Приготовленные поперечные срезы образцов исследовали в просвечивающем растровом электронном микроскопе Titan 80-300 TEM/STEM (FEI, США) с корректором сферической аберрации зонда в режимах светлого и темного поля. Ускоряющее напряжение составляло 300 кВ. При анализе образцов использовали следующие режимы: ПЭМ, просвечивающей растровой электронной микроскопии (ПРЭМ), а также режим дифракции электронов. Последний режим позволял более точно оценить степень монокристалличности пленки.
Подвижность μ и двумерную концентрацию nS носителей заряда измеряли с помощью эффекта Холла методом Ван дер Пау.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Измерение эффекта Холла показало, что, несмотря на отсутствие преднамеренного легирования, выращенные сверхрешетки обладают n-типом проводимости, а подвижность электронов в них низкая. Измеренные при комнатной температуре электрофизические характеристики образцов после отжига были следующие: для образца 439 μ = 120 см2/(В с), nS = 5.1 × 1012 см–2; для образца 440 μ = 30 см2/(В с), nS = 1.2 × 1012 см–2. Полученные данные свидетельствуют о сильном рассеянии электронов проводимости, причем в образце на подложке InP (111)А это рассеяние значительно сильнее, чем в образце на стандартной подложке InP (100).
Рассмотрим образец 439, выращенный на подложке InP (100). На рис. 1 представлены светлопольное ПРЭМ-изображение всей пленки и светлопольное ПЭМ-изображение участка образца, полученное с высоким разрешением. Изображения и двумерные спектры Фурье этих изображений (в статье не приведены) указывают на то, что образец 439 является монокристаллическим, однако содержит дефекты упаковки и двойники в высокой концентрации. Дефекты упаковки на рис. 1б выглядят как одиночные узкие полосы, а двойники – как широкие полосы или каскад полос. Дефекты упаковки (в основном наблюдаются дефекты упаковки вычитания) располагаются параллельно кристаллическим плоскостям {111}. Размеры двойников варьируются в пределах 5–50 нм. Слои сверхрешетки при использовании режима ПЭМ высокого разрешения не проявляются. Существенной разницы в размерах и концентрации протяженных дефектов до и после отжига образца 439 не обнаружено.
Рис. 1.
Светлопольное ПРЭМ-изображение образца 439 после отжига (а); ПЭМ-изображение участка образца 439 после отжига, стрелками отмечены дефекты упаковки (SF) и двойники (T), [100] – направление роста от подложки к поверхности (б).
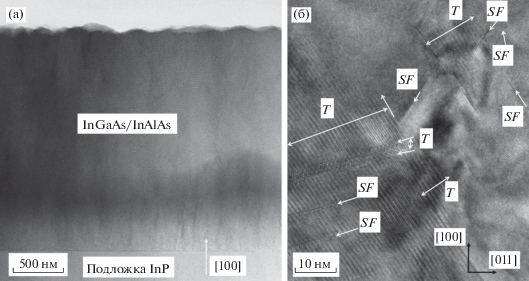
Электронограммы, полученные от разных участков образца 439 и представленные на рис. 2а, 2б, также свидетельствуют о том, что образец является высокодефектным монокристаллом. Дополнительные рефлексы, отмеченные горизонтальными стрелками, указывают на присутствие двойников. Расщепление рефлексов в позициях 0$\overline {kl} $, отмеченное вертикальными стрелками, свидетельствует о формировании малоугловых доменов с углом разориентации до 1.5°.
Рис. 2.
Электронограммы: а – от образца 439 на высоте ~ 50 нм над подложкой; б – от образца 439 в средней области на высоте ∼1 мкм над подложкой; в – от образца 440 в средней области на высоте ∼1 мкм над подложкой. Горизонтальными стрелками отмечены рефлексы, вызванные дефектами двойникования; вертикальными стрелками отмечены расщепленные из-за разориентации рефлексы.

В образце 439 до отжига домены имели средний латеральный размер ∼280 нм. Исследования показали, что приблизительно половина доменов начинает формироваться на границе с подложкой и достигает поверхности пленки, имея 2 мкм в высоту. Остальные домены также начинают формироваться на границе с подложкой, но ограничены расстоянием 500–1300 нм от подложки. Соответственно, такое же число доменов образуется на этой толщине пленки и достигает поверхности пленки, имея высоту 800–1600 нм. После отжига в этом же образце домены имеют средний латеральный размер ∼260 нм, часть доменов прорастает от подложки до поверхности пленки, часть – до расстояния 800–1300 нм от подложки, после чего образуются новые домены, которые достигают поверхности пленки, имея такую же высоту 800–1300 нм. До и после отжига над подложкой наблюдаются небольшие домены высотой 100–300 нм и с латеральными размерами 40–80 нм. Таким образом, разница в морфологических особенностях микроструктуры неотожженного и отожженного образца 439 с учетом погрешности измерений незначительна. Из рис. 1а отчетливо видно, что доменные границы расположены вертикально. С учетом симметрии второго порядка можно сделать вывод, что и в направлении [01$\bar {1}$] эти границы вертикальны, что позволяет исключить наклонный рост доменов.
Темнопольное высокоугловое ПРЭМ-изображение прилегающей к подложке области образца 439 после отжига, характеризующееся существенным Z-контрастом, представлено на рис. 3а, а соответствующий интегральный профиль интенсивности сигнала ПРЭМ вдоль направления роста – на рис. 3б. На рис. 3а проявляются несколько слоев сверхрешетки вблизи поверхности подложки. Гетерограницы между слоями непланарны, что особенно заметно при сравнении с плоской границей раздела подложка/гетероструктура, толщина слоев неоднородна. Размер переходных областей между слоями согласно анализу ПРЭМ-изображения составляет ∼2.8 нм. Тем не менее пространственное распределение интенсивности на ПРЭМ-изображениях показывает хорошее совпадение значений толщин слоев LTG–InGaAs и LTG–InAlAs с технологически заданными.
Рис. 3.
Темнопольное высокоугловое ПРЭМ-изображение прилегающей к подложке области образца 439 после отжига; стрелками показана граница раздела подложка/пленка (а); соответствующий интегральный профиль интенсивности сигнала ПРЭМ вдоль направления роста (б).
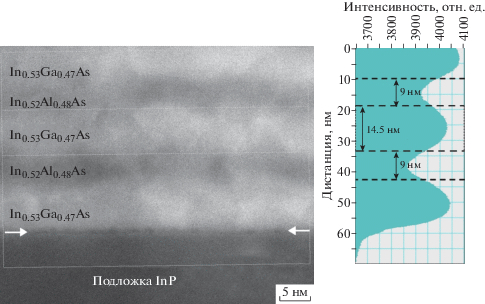
Начиная с расстояния ∼200 нм от подложки слои сверхрешетки (соответственно и гетерограницы между слоями) становятся волнообразно изогнутыми. На рис. 4 представлены светлопольное и темнопольное ПРЭМ-изображения приповерхностной области образца 439, полученные от наиболее тонкого участка приповерхностной области со стравленными нижними слоями и подложкой. Как видно из рис. 4а и 4б, внутри доменов, расположенных вблизи поверхности пленки, наблюдаются резкие гетерограницы между слоями. В области дефектов гетерограницы размываются, и изображение слоев теряет четкость. Также можно наблюдать наложение слоев, принадлежащих разным периодам. Максимальный угол отклонения гетерограниц слоев от горизонтальной плоскости роста, оцененный по ПРЭМ-изображениям, достигает ±18°.
Рис. 4.
Область образца 439 вблизи поверхности (отмечена стрелками): а – светлопольное ПРЭМ-изображение; б – темнопольное высокоугловое ПРЭМ-изображение.

ПРЭМ-изображения позволили оценить шероховатость поверхности образца 439, которая оказалась близкой к 60–70 нм.
Рассмотрим образец 440, выращенный на подложке InP (111)A. Исследования показали, что сформированная пленка представляет собой поликристалл (рис. 5), о чем однозначно свидетельствует электронограмма, представленная на рис. 2в. С самого начала эпитаксиального роста в пленке образуются разноориентированные зерна и двойники. Светлопольное ПРЭМ-изображение (рис. 6а) показывает начальную стадию эпитаксиального роста пленки на подложке InP (111)A. Из рис. 6а видно, что часть пленки ориентирована одинаково с подложкой, но на части границы с подложкой начинается формирование двойников, что связано с компенсацией несоответствия параметров кристаллических решеток подложки и растущей пленки. Зерна с ориентацией, отличной от ориентации подложки и прилегающих к подложке участков пленки, появляются на расстоянии 5 нм от подложки. На рис. 6а в области, отмеченной пунктиром, наблюдается муар, вызванный наложением матрицы зерна и двойников. На начальной стадии роста в области пленки толщиной до 250 нм формируются небольшие зерна с латеральными размерами 30–80 нм. Выше формируются более крупные зерна со средним латеральным размером ∼160 нм. Бóльшая часть зерен растет до середины толщины пленки и достигает 800–1100 нм в направлении роста, после чего начинается рост новых зерен. Только небольшая часть зерен продолжается от подложки до самой поверхности пленки, имея размер 2 мкм в высоту. Также в объеме пленки могут встречаться зерна с вертикальным размером до 300 нм и латеральным размером ∼160 нм. Угол разориентации зерен достигает 20°.
Рис. 5.
Светлопольное ПРЭМ-изображение образца 440; на поверхности наблюдаются остатки эпоксидного клея (Epoxy). На вставке представлено темнопольное высокоугловое ПРЭМ-изображение области образца 440 вблизи поверхности.
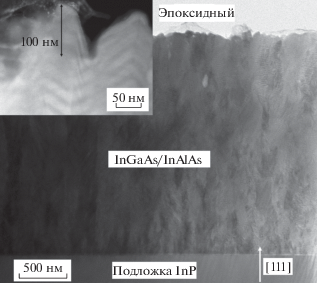
Рис. 6.
Образец 440: а – светлопольное ПРЭМ-изображение, пунктиром выделена область с зерном, M1 – матрица с ориентацией подложки, М2 – матрица зерна, T – двойники; б – темнопольное высокоугловое ПРЭМ-изображение.
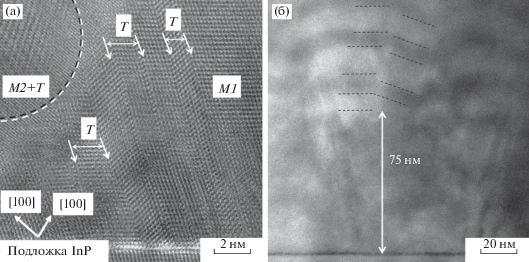
Слои сверхрешетки проявляются на темнопольных высокоугловых ПРЭМ-изображениях, начиная с расстояния 75 нм от подложки (рис. 6б). Толщина слоев LTG–InAlAs и LTG–InGaAs, оцененная по таким изображениям, составляет 7.5–9 и 10–15 нм соответственно, а толщина переходной области – 1.5–2 нм. В некоторых областях образца 440 изгибающиеся слои смещаются на расстояние ~10 нм, что сравнимо с периодом сверхрешетки.
Шероховатость поверхности образца 440, оцененная по различным ПЭМ- и ПРЭМ-изображениям, оказалась близкой к 80–90 нм. Темнопольное высокоугловое ПРЭМ-изображение образца 440 вблизи поверхности, представленное на вставке к рис. 5, показывает, что в приповерхностной области зерна достигают размера ∼100 нм. Несмотря на большие неровности и разориентацию, в приповерхностных зернах проявляются слои сверхрешетки, как и у образца 439, однако они волнообразно изгибаются существенно сильнее, чем в образце 439. Контраст слоев сверхрешетки в отдельных зернах заметно различается. Максимальный угол отклонения гетерограниц слоев от горизонтальной плоскости роста достигает ±30°.
ЗАКЛЮЧЕНИЕ
Методом молекулярно-лучевой эпитаксии в низкотемпературном режиме выращены сверхрешетки {In0.53Ga0.47As/In0.52Al0.48As} × 100 на подложках InP (100) и (111)A. Микроструктура сверхрешеток исследована методами просвечивающей электронной микроскопии, просвечивающей растровой электронной микроскопии и электронной дифракции. Установлено, что при выбранных технологических условиях низкотемпературного МЛЭ-роста сверхрешетки, выращенные на подложках InP (100), являются монокристаллическими, хотя и обладают высокой концентрацией дефектов упаковки и двойников, а также доменов, разориентированных на малые углы до 1.5°. Использование подложки InP (111)А приводит к формированию поликристаллической пленки практически с самого начала роста. Зерна в пленке разориентированы друг относительно друга на угол до 20°. Несмотря на это, в поликристаллической пленке, начиная с расстояния 75 нм от подложки, формируются отчетливые слои сверхрешетки {LTG–InAlAs/LTG–InGaAs}. В разных областях поликристаллической пленки эти слои различаются наклоном и толщиной. Обнаружено, что ориентация подложки оказывает сильное влияние на волнистость гетерограниц между слоями: при росте сверхрешетки на подложке InP (111)A слои оказываются волнообразно изогнутыми существенно больше, чем при росте на InP (100). В верхней, наиболее деформированной части сверхрешетки гетерограницы между слоями могут отклоняться от горизонтальной плоскости роста на углы до 30° и 18° соответственно.
Несмотря на ярко выраженную шероховатость поверхности сверхрешеток {LTG–InAlAs/LTG–InGaAs} на подложках InP (100) и (111)А, полученные гетероструктуры пригодны для изготовления фотопроводящих антенн, так как характерные размеры шероховатости поверхности существенно меньше стандартной толщины металлизации антенны (около 1 мкм), ширины металлических полосков (более 10 мкм) и фотопроводящих зазоров (5–10 мкм). Использование сверхрешеток {LTG–InAlAs/LTG–InGaAs}, выращенных на подложках InP (111)A, для ФПА может быть более предпочтительным из-за их большего сопротивления и, следовательно, меньшего темнового тока, протекающего через ФПА.
Работа выполнена при финансовой поддержке Российского фонда фундаментальных исследований (грант № 18-32-20207 мол-а-вед).
Список литературы
Krotkus A. // J. Phys. D: Appl. Phys. 2010. V. 43. P. 273001.
Coutaz J.-L., Roux J.-F., Gaarder A. et al. // XI International Semiconducting and Insulating Materials Conference, 3–7 July 2000, Australian National University, Canberra. P. 89.
Baker C., Gregory I.S., Tribe W.R. et al. // Appl. Phys. Lett. 2003. V. 83. № 20. P. 4113.
Baker C., Gregory I.S., Tribe W.R. et al. // Appl. Phys. Lett. 2004. V. 85. № 21. P. 4965.
Baker C., Gregory I.S., Evans, M.J. et al. // Opt. Express. 2005. V. 13. № 23. P. 9639.
Kostakis I., Missous M. // AIP Adv. 2013. V. 3. P. 092131.
Künzel H., Böttcher J., Gibis R., Urmann G. // Appl. Phys. Lett. 1992. V. 61. № 11. P. 1347.
Künzel H., Böttcher J., Gibis R. et al. // J. Cryst. Growth. 1993. V. 127. P. 519.
Globish B., Dietz R.J.B., Stanze D. et al. // Appl. Phys. Lett. 2014. V. 104. P. 172103.
Kostakis I., Saeedkia D., Missous M. // J. Appl. Phys. 2012. V. 111. P. 103105.
Pocas L.C., Lopes E.M., Duarte J.L. et al. // J. Appl. Phys. 2005. V. 97. P. 103518.
Dietz R.J.B., Globish B., Gerhars M. et al. // Appl. Phys. Lett. 2013. V. 103. P. 061103.
Roehle H., Dietz R.J.B., Hensel H.J. et al. // Opt. Express. 2010. V. 18. № 3. P. 2296.
Dietz R.J.B. Dissertation “Photoconductive THz Emitters and Detectors on the Basis of InGaAs/InP for Terahertz Time Domain Spectroscopy”. Marburg; Lahn: Phillips Universität, 2015. 81 p.
Dietz R.J.B., Brahm A., Velauthapillai A. et al. // J. Infrared Millim. Terahertz Waves. 2014. V. 36. № 1. P. 1.
Yerino C.D., Liang B., Huffakeret D.L. et al. // J. Vac. Sci. Technol. B. 2017. V. 35. № 1. P. 010801.
Chin A., Martin P., Ho P. et al. // Appl. Phys. Lett. 1991. V. 59. № 15. P. 1899.
Vaccaro P.O., Tominaga K., Hosoda M. et al. // Jpn. J. Appl. Phys. 1995. V. 34. Part 1. № 2B. P. 1362.
Belk J.G., Sudijono J.L., Yamaguchi H. et al. // J. Vac. Sci. Technol. A. 1997. V. 15. № 3. P. 915.
Gonzales-Borrero P.P., Lubyshev D.I., Marega E. et al. // J. Cryst. Growth. 1996. V. 169. № 3. P. 424.
Yeo W., Dimitrov R., Schaff W.J. et al. // Appl. Phys. Lett. 2000. V. 77. № 17. P. 2764.
Галиев Г.Б., Пушкарев С.С., Буряков А.М. и др. // Физика и техника полупроводников. 2017. Т. 51. Вып. 4. С. 529.
Kuznetsov K.A., Galiev G.B., Kitaeva G.Kh. et al. // Laser Phys. Lett. 2018. V. 15. № 7. P. 076201.
Галиев Г.Б., Грехов М.М., Китаева Г.Х. и др. // Физика и техника полупроводников. 2017. Т. 51. Вып. 3. С. 322.
Галиев Г.Б., Трунькин И.Н., Васильев А.Л. и др. // Кристаллография. 2019. Т. 64. № 2. С. 184.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография


