Кристаллография, 2020, T. 65, № 6, стр. 857-861
Структурные особенности, связанные с двойникованием в процессе роста монокристаллов арсенида галлия методом Чохральского
А. А. Югов 1, Б. В. Пугачев 1, Т. Г. Югова 1, *, С. Н. Князев 1
1 АО “Гиредмет”
Москва, Россия
* E-mail: P_Yugov@mail.ru
Поступила в редакцию 27.11.2019
После доработки 03.03.2020
Принята к публикации 03.03.2020
Аннотация
Рассмотрены структурные особенности, связанные с двойникованием в кристаллах арсенида галлия, легированных оловом и теллуром, в процессе роста кристаллов методом Чохральского с жидкостной герметизацией расплава борным ангидридом. Показано, что двойники роста и краевые грани возникают на периферии кристаллов в области переохлажденного расплава. В области двойника концентрация легирующей примеси всегда выше, чем в области без двойника. Наблюдается изменение направления прорастания дислокаций в кристалле в процессе двойникования.
ВВЕДЕНИЕ
При выращивании кристаллов арсенида галлия методом Чохральского из-под слоя борного ангидрида в ряде случаев в кристаллах наблюдаются двойники. Источниками образования двойников роста в монокристаллах являются большие термические и механические напряжения на фронте кристаллизации. В 80–90-е годы прошлого столетия появилось большое количество работ [1–6], посвященных определению параметров, приводящих к образованию двойников при росте кристаллов полупроводников методом Чохральского. К таким параметрам относятся температурный градиент [1], флуктуация температур на фронте кристаллизации [2], форма фронта кристаллизации [3], стехиометрия расплава [4], концентрация и природа легирующей примеси [5], различные примесные включения [6].
В ростовых двойниках плоскость двойникования совпадает с плоскостью плотной упаковки атомов из семейства плоскостей {111} и является когерентной границей, т.е. ростовой, а двойник относится к двойникам первого рода. Когерентные границы обладают наименьшей энергией, поэтому в кристаллах с решеткой алмаза и сфалерита двойникование происходит преимущественно по плоскостям {111} [7].
Двойникование при росте кристалла связано с механизмом роста кристалла. Вероятность двойникования пропорциональна отношению скорости роста к величине температурного градиента на фронте кристаллизации [8].
Двойникование при выращивании существенно зависит от формы фронта кристаллизации. Считается, что образование двойников роста происходит при переохлаждении расплава [9, 10].
Попадание инородных частиц на поверхность роста или боковую поверхность растущего кристалла вблизи фронта кристаллизации может также способствовать двойникованию [6]. При выращивании кристаллов соединений двойникование может усиливаться при отклонении состава расплава от стехиометрического [4]. Отчасти это может быть вызвано концентрационным переохлаждением расплава. Поверхностно-активные примеси (например, теллур в арсениде галлия), снижающие энергию дефекта упаковки, также способствуют образованию двойников роста. В кристаллах, выращиваемых в одном из направлений семейства 〈100〉, двойникование обычно происходит под углом ∼35° к оси роста. Заключение о том, что в монокристаллах арсенида галлия образуются ростовые двойники, сделано в [11] на основании отсутствия остаточных напряжений на двойниковых границах при исследовании методом фотоупругости.
Несмотря на обширную информацию по двойникованию в кристаллах полупроводников, мало изучено влияние двойникования на коэффициент распределения легирующей примеси в частях кристалла с различной ориентацией, а также на направление прорастания дислокаций в различных частях кристалла с двойником. Изучению этих проблем посвящена данная работа.
МЕТОДИКИ
Изучено влияние двойников на структурные свойства монокристаллов арсенида галлия (GaAs), выращенных в направлении [100] и легированных оловом и теллуром. Из кристаллов с двойниками вырезали пластины вдоль плоскости (0$\bar {1}$1) так, чтобы место зарождения двойника находилось на краю этой пластины. Эта плоскость параллельна направлению выращивания и перпендикулярна границам двойников. Исследованы образцы, вырезанные из конусообразной и цилиндрической частей кристалла с двойником.
Поверхность пластин готовили путем шлифовки, полировки и химического травления. В работе использовали как метод избирательного травления в расплаве щелочи КОН, выявляющего дислокационные ямки травления на плоскости (100), так и метод проекционного травления [12] в травителе Абрахамса–Бьюочи (АВ) [13]. Проекционное травление осуществляли в АВ-травителе при вращении в “пьяной бочке” в течение 30 мин. Этот травитель выявляет на продольном срезе кристалла проекции дислокаций на плоскость травления [14]. Кроме этого, травитель выявляет полосы роста (примесная неоднородность), форма которых определяется формой фронта кристаллизации (граница раздела кристалла и расплава, из которого этот кристалл вытягивают).
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Типичный пример двойника, возникшего при увеличении диаметра кристалла арсенида галлия при разращивании, показан на рис. 1. Плоскость двойникования (111) расположена под углом примерно 35° к направлению выращивания [100] и перпендикулярна плоскости среза (1$\bar {1}$0).
Авторы [14], изучая возникновение двойников при росте кристаллов арсенида галлия методом Чохральского, пришли к выводу, что в процессе роста сначала происходит расплавление периферии кристалла, потом очень быстрый рост этой области, и, наконец, формируется двойниковая линия. Область быстрого роста определяется по отсутствию в ней полос роста. Скорость роста в этой области примерно в 25 раз выше, чем в других местах, что определяется по разделению полос роста. Расплавы и области быстрого роста, предшествующие образованию двойников в кристаллах GaAs, получаемых методом Чохральского с жидкостной герметизацией расплава, свидетельствуют о резких изменениях температуры и напряжений. Для того чтобы обеспечить напряжения в точке двойникования расплава, температурное возмущение в этой точке должно быть достаточно большим. Расплавы появляются из-за тепловых колебаний атомов, вызванных турбулентной конвекцией [15].
Проведенные исследования подтвердили эти предположения. На рис. 2 показан участок кристалла GaAs с двойником после проекционного травления в АВ-травителе. Над двойником наблюдается область без полос роста, что говорит о том, что в этой области ранее произошло расплавление периферии кристалла, а потом быстрая кристаллизация. Кроме этого, виден сильный загиб полос роста в области кристалла над двойником, что свидетельствует о сильном переохлаждении расплава в области над двойником. Однако на другой стороне образца толщиной 5 мм в области над двойником изгиб полос роста не наблюдался. Следовательно, в процессе роста произошло только локальное переохлаждение расплава шириной менее 5 мм. Локальное переохлаждение расплава было выявлено и в [4]. Выходящие на поверхность раздела фаз (кристалл–расплав) двойники обеспечивают быстрый рост и уменьшают переохлаждение [2].
В [10] методом математического моделирования показано, что при выращивании кристалла кремния методом Чохральского увеличение скорости роста до определенного значения вызывает появление под растущим кристаллом области переохлажденного расплава, что приводит к возникновению двойника в кристалле.
В кристаллах GaAs, так же как и в кристаллах InP [15], на периферии обнаружены области, в которых наблюдается множество коротких прямых борозд, лежащих в плоскости (111). Эти борозды назвали краевыми гранями. Типичный пример области с краевыми гранями показан на рис. 3. Полосы роста указывают на форму фронта кристаллизации, но из-за присутствия краевых граней очень трудно определить точную форму фронта кристаллизации у периферии кристалла. Сопоставляя полосы роста в области вне граней с бороздками, получаем, что края граней врезались в расплав. Причина, по которой краевые грани имеют форму острия, может быть объяснена скоростью роста. Известно, что рост на плоскости (111), где появляются краевые фасетки, идет медленно в направлении [111] и очень быстро в направлении [211]. Направление [111] перпендикулярно плоскости краевой фасетки, а направление [211] параллельно ей. Эта разница в темпе роста объясняет форму граней с острыми краями. Наблюдение краевых граней показало, что глубина проникновения граней меняется по мере роста кристалла. Это изменение, вероятно, связано с колебаниями в переохлаждении и разницей в степени переохлаждения на границе раздела твердое/жидкое [16], поскольку увеличение переохлаждения усиливает разницу в скорости роста в каждом направлении.
Рис. 3.
Картина проекционного травления образцов с краевыми гранями, образовавшимися в области кристалла без двойника (а) и в области кристалла, где ранее прошло двойникование по плоскости (111) (б).

Краевые грани наблюдались в области кристалла, где раньше прошло двойникование по плоскости (111) (рис. 3б). Следовательно, на образование краевых граней не влияет ориентация прилегающей к ним области кристалла.
Следует отметить, что в обоих случаях при проекционном травлении выявляется изгиб полос роста вблизи области окончания краевых граней из-за переохлаждения расплава при стыковке области с краевыми гранями и основным объемом кристалла.
По мере травления образца граница области краевых граней сдвигается ближе к поверхности кристалла (рис. 3б). Это означает, что область с краевыми гранями имеет произвольную форму и меняется по толщине, иногда исчезая совсем.
Установлено, что четкость выявления полос роста улучшается с увеличением концентрации примеси. Это хорошо видно при наблюдении картин травления областей кристалла по обе стороны двойниковой границы в кристаллах арсенида галлия, легированных оловом (рис. 4а) и теллуром (рис. 4б).
Рис. 4.
Картины проекционного травления областей кристаллов с двойниковой границей (Дв). Кристалл, легированный оловом (n ∼ 3 × 1016 см–3) (а) и легированный теллуром (n ∼ 5 × 1017 см–3) (б). “Мелкоточечный фон” в области двойника в кристалле GaAs, легированном теллуром (в).
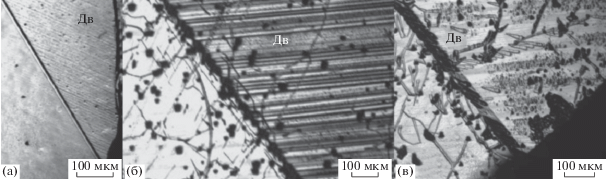
В области двойника полосы роста выявлены более четко (рис. 4). С увеличением концентрации легирующей примеси четкость выявления полос роста улучшается (рис. 4а, 4б). Более четкое выявление полос роста в области двойника свидетельствует о том, что концентрация примеси в этой области выше, чем в области без двойников. Следовательно, коэффициент распределения примеси больше в области двойника. По-видимому, это связано с изменением ориентации растущей поверхности кристалла после двойникования. Плоскостью растущей поверхности двойника при выращивании в направлении [100] является плоскость (221) [17]. Эта плоскость в отличие от плоскостей (111) и (100) в арсениде галлия не является плотноупакованной. В связи с этим легирующая примесь легче встраивается в решетку, тем самым увеличивая коэффициент распределения примеси. Это позволяет заключить, что имеется зависимость коэффициента распределения примеси (олова и теллура) от ориентации различных плоскостей в кристалле. Кроме того, при сильном легировании теллуром в области двойника выявляется “мелкоточечный фон” (недислокационные ямки травления) (рис. 4в), который связан с образованием микродефектов при сильном легировании кристалла.
Обнаружено влияние ориентации растущей поверхности на распространение дислокаций вдоль направления роста. На рис. 5 показан участок кристалла с двойниковой ламелью, с двух сторон окруженной несдвойникованным кристаллом.
Рис. 5.
Распространение линий дислокаций вдоль направления роста в различных областях кристалла, легированных теллуром, с двойниковой ламелью.
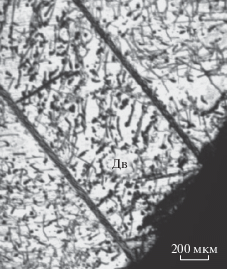
Выявленные линии на рис. 5 показывают проекцию линии дислокаций на плоскость травления, которая находилась в области кристалла, стравленной с поверхности образца. То есть направление дислокации вдоль оси кристалла в области двойниковой ламели отличается от распространения дислокаций в основном объеме кристалла.
Подавляющее большинство дислокаций в монокристаллах GaAs являются 60°-ными, которые распространяются скольжением в плоскости [111]. Тогда проекции дислокации на картинах проекционного травления в области кристалла ориентации [100] должны распространяться под углом ∼35° к оси кристалла по двум плоскостям семейства {111}, проходящим под углом 70° друг к другу. Одна из этих плоскостей проходит параллельно границе двойникования. Действительно, на рис. 5 наблюдаются дислокации, проекции которых идут параллельно границе двойникования. В области двойниковой ламели плоскости {111} идут под другим углом к границе двойникования. Следовательно, и следы дислокаций идут по другим направлениям, чем в области кристалла ориентации [100].
Как при избирательном травлении плоскости (100), так и при проекционном травлении выявлены дислокации, находящиеся на двойниковой границе (рис. 6). Поэтому двойниковые границы в монокристаллах GaAs, выращенных методом Чохральского, не являются когерентными.
Рис. 6.
Дислокации, выявленные на двойниковой границе при избирательном (а) и проекционном травлении (б) в кристалле, легированном теллуром.
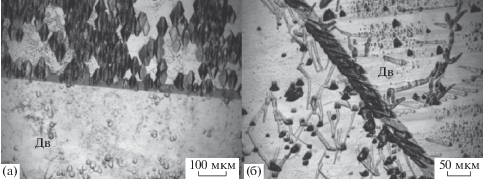
Границы двойников могут служить барьером для скользяших дислокаций и приводить к образованию плоских скоплений дислокаций [7] (рис. 6). Следовательно, двойниковая граница препятствует распространению дислокаций из основной области кристалла в область двойника.
ЗАКЛЮЧЕНИЕ
Обнаружены двойники и краевые грани в кристаллах арсенида галлия, выращенных методом Чохральского из-под слоя борного ангидрида. Показано, что образованию двойников и краевых граней в кристаллах GaAs способствует локальное переохлаждение расплава в области под растущим кристаллом, возникающее на границе раздела твердое/жидкость. Кроме этого, двойникование кристалла влияет как на концентрацию примеси в областях кристалла различной ориентации, так и на направление распространения дислокаций вдоль оси кристалла.
Авторы выражают благодарность $\boxed{{\text{В}}{\text{.}}\,{\text{Ф}}{\text{.}}\,{\text{Павлову}}}$ и В.Н. Чернову за помощь в работе.
Список литературы
Chen T.P., Guo Y.D., Huang T.S., Chen L.J. // J. Crystal Growth. 1990. V. 103. P. 343.
Koh H.J., Choi M.H., Park I.S., Fukuda T. // Crys. Res. Technol. 1995. V. 30. P. 397.
Rudolph P., Matsumoto F., Fukuda T. // J. Crystal Growth. 1996. V. 150. P. 43.
Steinemann A., Zimmerli U. // Solid State Electron. 1963. V. 6. P. 597.
Hashio K., Sawada S. // J. Crystal Growth. 1997. V. 173. P. 33.
Горелик С.С., Дашевский М.Я. Материаловедение полупроводников и диэлектриков. М.: Металлургия, 1988. 495 с.
Мильвидский М.Г., Освенский В.Б. Структурные дефекты в монокристаллах полупроводников. М.: Металлургия, 1984. 240 с.
Родес Р.Г. Несовершенства и активные центры в полупроводниках. М.: Металлург, 1968. 101 с.
Iseler G.W. // J. Crystal Growth. 1981. V. 54. P. 16.
Kalaev V., Sattler A., Kadinski L. // J. Crystal Growth. 2015. V. 413. P. 12.
Herle D.T. // J. Crystal Growth. 1995. V. 147. P. 239.
Селиваниов В.А., Мисик А.М., Преснов В.А. Арсенид галлия. Томск: Изд-во ТГУ, 1968. 427 с.
Stirland D.J., Orgen R. // Phys. Status. Solidi. A. 1973. V. 17. P. K1.
Abrachams M.S., Buiocchi C.J. // J. Appl. Phys. 1965. V. 36. P. 2855.
Tower J.P., Tobin R., Pearah P.J. et al. // J. Crystal Growth. 1991. V. 114. P. 665.
Shibata M., Sasaka Y., Inada T., Kuma S. // J. Crystal Growth. 1990. V. 102. P. 557.
Шашков А.Я. Производство полупроводниковых материалов. М.: Металлург, 1989. 267 с.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография




