Кристаллография, 2021, T. 66, № 3, стр. 473-477
Контролируемое образование β-Si3N4 в потоке аммиака на подложках кремния, покрытых слоем нативного оксида
И. О. Майборода 1, *, Е. М. Колобкова 1, Ю. В. Грищенко 1, И. А. Черных 1, М. Л. Занавескин 1, Н. К. Чумаков 1
1 Национальный исследовательский центр “Курчатовский институт”
Москва, Россия
* E-mail: mrlbr@mail.ru
Поступила в редакцию 07.07.2020
После доработки 13.07.2020
Принята к публикации 14.07.2020
Аннотация
Изучено формирование β-Si3N4 для последующего роста гетероструктур AlGaN и GaN на подложках кремния. Установлено, что при нагревании в потоке аммиака слой естественного оксида защищает поверхность кремния от формирования аморфной формы нитрида кремния. Продемонстрировано контролируемое формирование β-Si3N4 при парциальных давлениях аммиака до 3 × 10–5 Торр. Это позволяет проводить эпитаксию нитридных пленок без очистки ростовой камеры от аммиака, которая обычно необходима для снятия естественного оксида кремния путем отжига в высоком вакууме.
ВВЕДЕНИЕ
Транзисторы с высокой подвижностью электронов на основе нитрида галлия обеспечивают сочетание высоких рабочих частот и высокой удельной мощности, что делает их крайне востребованными в сверхвысокочастотной (СВЧ) и силовой электронике. Для производства нитридных гетероструктур используются материалы подложек, близкие к нитридам по параметрам решетки [1]. Особенно привлекателен в качестве материала подложки для нитридных гетероструктур монокристаллический кремний [2]: он дешевле и легче поддается механической обработке, чем карбид кремния, а его теплопроводность выше, чем у сапфира [3]. Использование кремниевых подложек позволяет адаптировать нитридные технологии для существующих кремниевых производств, что открывает перспективы массового выпуска дешевых СВЧ- и силовых устройств [4, 5].
Исследования показывают, что для успешного роста нитридных гетероструктур на подложке кремния в установках аммиачной молекулярно-лучевой эпитаксии (МЛЭ) требуется процесс нитридизации поверхности кремния с образованием Si3N4 [6, 7]. Поверхность кремния обычно покрыта слоем естественного оксида, который удаляют отжигом в вакууме [8–11], так как он препятствует росту нитридных гетероструктур [12, 13]. Показателем очистки поверхности от оксида является возникновение поверхностных реконструкций 7 × 7. Данный тип реконструкций наблюдается в интервале температур 400–850°С и свыше 1100°С [14–16]. При температурах от комнатной до 400°С и в диапазоне 850–1100°С на картине дифракции быстрых отраженных электронов (RHEED) наблюдается реконструкция 1 × 1 [17, 18].
После удаления оксида на очищенный кремний подается аммиак и формируется кристаллический β-Si3N4. При этом с помощью RHEED регистрируется изменение меток реконструкций с 7 × 7 на 8 × 8 [19, 8 ]. Аморфный нитрид кремния можно определить по диффузному характеру картины RHEED [17].
Сложность состоит в том, что для успешного удаления оксида и проведения последующей нитридизации отжиг кремния должен проходить при отсутствии активного азота (аммиак в аммиачной МЛЭ или моноатомный азот в плазменной МЛЭ). На практике выполнить это условие оказывается сложно. Ростовые камеры установок МЛЭ оснащены криогенными панелями, которые улавливают аммиак, не позволяя его молекулам многократно отражаться от стенок камеры. Аммиак накапливается на криогенных панелях и неизбежно попадает на подложку в процессе ее отжига. Результатом такого воздействия становится образование аморфного нитрида кремния, на котором рост качественных нитридных гетероструктур, по-видимому, невозможен. На практике после каждого эпитаксиального процесса приходится проводить длительную очистку криопанелей от аммиака, сопровождающуюся удалением из них криоагента (обычно жидкого азота) [20, 21].
Данная работа направлена на поиск возможности проведения нитридизации кремниевых подложек при наличии аммиака в ростовой камере. Установлено, что за счет быстрого нагрева подложки кремния можно добиться удаления естественного оксида кремния и формирования кристаллической фазы нитрида кремния без предварительного отжига в высоком вакууме. На нитридизованных подобным образом подложках были получены и исследованы нитридные гетероструктуры с двумерным электронным газом. Таким образом, предложенный способ нитридизации кремниевых подложек выполняет свою функцию и позволяет получить эпитаксиальные структуры нитридных полупроводников.
ДЕТАЛИ ЭКСПЕРИМЕНТА
Рост гетероструктур проводили в установке аммиачной МЛЭ SemiTEQ STE3N. Для роста нитридных гетероструктур использовали кремниевые (111) подложки диаметром 2 дюйма.
Перед загрузкой в эпитаксиальную установку пластины окунали в разбавленный раствор плавиковой кислоты (HF : H2O = 1 : 10) комнатной температуры, промывали в дистиллированной деионизованной воде и сушили под потоком азота. Нитридизацию проводили по следующей схеме: подложку нагревали в фиксированном потоке аммиака путем линейного увеличения подаваемой на нагреватель мощности; по окончании нагрева поток аммиака перекрывали, а подложку выдерживали в течение 30 с. Затем следовало резкое охлаждение подложки до 600°С путем сброса мощности на нагревателе.
В описанной процедуре варьировали время нагрева (8, 16 и 32 мин), максимальную мощность нагревателя (ниже 1100°С и в диапазоне 1100–1250°С) и поток аммиака ((1–4) × 10–5 Торр). Эксперименты по нитридизации проводили как в дегазированной, так и в загрязненной аммиаком камере.
Измерения поступающего на подложку аммиака проводили с помощью ионизационного датчика модели PVC X производства EpiMax. Наблюдение за поверхностными реконструкциями в процессе нитридизации и последующего эпитаксиального роста проводили с помощью RHEED при ускоряющем напряжении 20 кэВ.
Рост гетероструктуры на нитридизованной подложке состоял из нескольких этапов. Первые этапы – напыление металлического алюминия, синтез зародышевого слоя AlN (10 нм), рост буферного слоя, состоящего из AlGaN, осажденного в условиях десорбции галлия [22], и градиентных слоев (слои с переменным содержанием галлия и алюминия [23]). После градиентных слоев формировались три вставки AlN/AlGaN для накопления сжимающих напряжений, а затем 300 нм канального слоя GaN. Барьерный слой, обеспечивающий формирование двумерного электронного газа, состоял из спейсер-слоя AlN толщиной 1 нм и слоя AlGaN толщиной 25 нм c мольной концентрацией алюминия 25%. Схема структуры представлена на рис. 1. Исследование морфологии поверхности проводили методом атомно-силовой микроскопии (АСМ).
Невжигаемые омические контакты формировали путем рецесса гетероструктуры и последующей селективной эпитаксии слоя GaN, сильно легированного кремнием, в установке МЛЭ. Межприборную изоляцию транзистора формировали травлением в плазме Cl2/BCl3. Далее выполняли металлизацию невжигаемых контактов Cr (40 нм)/Au (300 нм).
Измерения статических параметров проводили на зондовой станции с помощью двухканального источника-измерителя Keithley 2636B при комнатной температуре. Электрофизические измерения характеристик двумерного электронного газа в гетеростуктуре проведены четырехзондовым методом Ван дер Пау.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Проведено измерение потоков аммиака, который поступает на нагреваемую подложку со стенок криопанелей, не прошедших дегазацию. Полученный график представлен на рис. 2. Также предпринято несколько попыток провести нитридизацию путем нагрева подложки в загрязненной аммиаком камере. Успешной оказалась попытка, в которой температура нагревателя была поднята до 1200°С (46% от максимальной мощности нагревателя) в течение 8 мин. Величина потока аммиака, поступающего на подложку, достигала при этом 1.5 × 10–5 Торр. В результате подобной нитридизации удалось наблюдать реконструкции 8 × 8, подтверждающие формирование кристаллической фазы нитрида кремния (рис. 3). Данные значения температуры, времени нагрева и потока аммиака в дальнейшем использовали как референсные. Последующие эксперименты проводили в камере, предварительно очищенной от аммиака. Аммиак подавался на подложку штатным путем из инжектора.
Рис. 2.
Поток аммиака в процессе нагрева подложки. Начальная и конечная температуры отмечены на графике.

Рис. 3.
Изменение картины RHEED поверхности кремния в течение процесса нагрева: а – наблюдение реконструкций 1 × 1 при комнатной температуре; б – реконструкции 8 × 8.
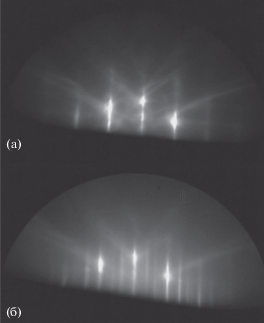
Для оценки влияния времени нагрева подложку кремния нагревали в потоке аммиака 1.5 × 10–5 Торр до 1200°С в течение 16 и 32 мин (в 2 и 4 раза медленнее, чем в референсном эксперименте). В обоих случаях сформировался аморфный нитрид кремния, что подтверждается диффузной дифракционной картиной (рис. 4).
Дли установления максимальной величины потока аммиака, при котором возможна успешная нитридизация подложки, его величина варьировалась в диапазоне (1–4) × 10–5 Торр. В итоге удалось установить, что нитридизация с формированием кристаллической фазы нитрида кремния успешно проходит в диапазоне (1–3) × × 10–5 Торр. При потоке 4 × 10–5 Торр образуется аморфный нитрид кремния.
Проводилось также варьирование максимальной температуры нагрева в процессе нитридизации. Поток аммиака и время нагрева составляли 1.5 × 10–5 Торр и 8 мин соответственно. Было выявлено, что при температуре ниже 1100°С поверхность кремния не нитридизуется в степени, достаточной для проведения эпитаксиального процесса роста нитридных пленок. На подложках, которые нитридизовались при меньшей температуре, рост слоев AlN и AlGaN приводил к возникновению точек на дифракционной картине, т.е. полученные пленки обладали развитой морфологией поверхности (рис. 5). Максимальная опробованная температура нитридизации составляла 1250°С.
Рис. 5.
Картина RHEED гетероструктуры: а – гетероструктура хорошего качества; б – гетеростуктура с развитым рельефом поверхности.
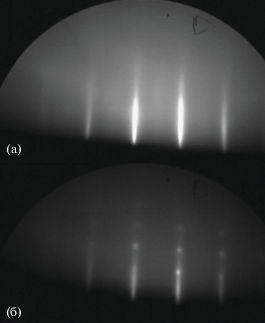
При постоянном потоке аммиака 1.5 × 10–5 Торр проведен нагрев подложки кремния, предварительно очищенной от естественного оксида с помощью стандартной процедуры отжига в высоком вакууме. Нагрев до 1200°С длился 8 мин. В результате на поверхности кремния сформировался аморфный нитрид кремния. Таким образом, слой естественного оксида защищает подложку от образования аморфной формы нитрида кремния при нагреве в потоке аммиака.
На нитридизованных при оптимальных условиях подложках кремния (нагрев до 1100–1250°С в течение 8 мин при потоке аммиака (1–3) × × 10‒5 Торр) выращены гетероструктуры с двумерным электронным газом. Изображение поверхности гетерострукуры, полученное с помощью АСМ, представлено на рис. 6. Среднеквадратичное значение шероховатости, полученное на площади 10 × 10 мкм, составляет в среднем 2.3 нм. На изображениях наблюдаются специфические пирамиды с террасно-ступенчатыми склонами. Подобные пирамиды часто формируются в пленках, выращенных методом аммиачной МЛЭ, вокруг проникающих винтовых дислокаций. Каждая вершина пирамиды представляет собой выход винтовой дислокации на поверхность [24]. Подобный рельеф образуется при росте GaN в условиях, обеспечивающих нитриду галлия наибольшую изолирующую способность [25], и является типичным для аммиачной МЛЭ [6, 10, 26].
Результаты измерения электрофизических характеристик двумерного газа одной из гетероструктур продемонстрированы в табл. 1.
Таблица 1.
Электрические характеристики двумерного электронного газа
| Слоевое сопротив-ление, Rs, Ом/$\square $ |
Концен-трация
электронов ne, 1/см2 |
Подвижность электронов µe, см2/(В сек) |
Ток насы-щения, Isat, A/мм |
|---|---|---|---|
| 309 | 1.27 × 1013 | 1575 | 0.9–0.95 |
Таким образом, предложенная методика нитридизации обеспечивает возможность роста нитридных гетероструктур надлежащего качества с точки зрения электрофизических параметров и шероховатости поверхности.
ЗАКЛЮЧЕНИЕ
Показано, что для формирования кристаллической фазы нитрида кремния на подложке кремния, изначально покрытой слоем естественного оксида, не требуется проведение отжига в высоком вакууме в отсутствие активного азота. Кристаллический Si3N4 может быть сформирован путем нагрева подложки до температуры 1100–1250°С в течение ~ 8 мин при потоке аммиака, поступающего на подложку, в интервале (1–3) × 10–5 Торр. Таким образом, если состояние ростовой камеры в процессе нагрева подложки обеспечивает давление аммиака в области подложки не более 3 × 10–5 Торр, камера не требует очистки от аммиака, что обеспечивает большую производительность установки МЛЭ и снижает расход криогенного агента.
Работа выполнена при финансовой поддержке Национального исследовательского центра “Курчатовский институт” (приказ № 1359 от 25.06.2019).
Список литературы
Ambacher O. // J. Phys. D: Appl. Phys. 1998. V. 31. № 20. P. 2653. https://doi.org/10.1088/0022-3727/31/20/001
Neumann H. Properties of Group III Nitrides / Ed. Edgar J.H. London, United Kingdom: the Institution of Electrical Engineers, INSPEC, 1994. 310 p. https://doi.org/10.1002/crat.2170300704
Kaun S.W., Wong M.H., Mishra U.K., Speck J.S. // Semicond. Sci. Technol. 2013. V. 28. P. 074001. https://doi.org/10.1088/0268-1242/28/7/074001
Medjdoub F., Zegaoui M., Grimbert B. et al. // Appl. Phys. Express. 2011. V. 4. № 12. P. 124101. https://doi.org/10.1143/APEX.4.124101
Sun H., Alt A.R., Benedickter H. et al. // Appl. Phys. Express. 2010. V. 3. № 9. P. 094101. https://doi.org/10.1143/APEX.3.094101
Le Louarn A., Vézian S., Semond F., Massies J. // J. Cryst. Growth. 2009. V. 311. № 12. P. 3278. https://doi.org/10.1016/j.jcrygro.2009.04.001
Nakada Y., Aksenov I., Okumura H. // Appl. Phys. Lett. 1998. V. 73. № 6. P. 827. https://doi.org/10.1063/1.122014
Vézian S., Le Louarn A., Massies J. // J. Cryst. Growth. 2007. V. 303. № 2. P. 419. https://doi.org/10.1016/j.jcrysgro.2007.01.007
Flammini R., Allegrini P., Wiame F. et al. // Phys. Rev. B. 2015. V. 91. P. 075303. https://doi.org/10.1103/PhysRevB.91.075303
Semond F., Cordier Y., Grandjean N. et al. // Phys. Status Solidi. 2001. V. 188. № 2. P. 501. https://doi.org/10.1002/1521-396X(200112)188:23.0.CO;2-6
Tamariz S., Martin D., Grandjean N. // J. Cryst. Growth. 2017. V. 476. P. 58. https://doi.org/10.1016/j.jcrysgro.2017.08.006
Kawaguchi Y., Honda Y., Matsushima H. et al. // Jpn. J. Appl. Phys. 1998. V. 37. № 8B. P. L966. https://doi.org/10.1143/JJAP.37.L966
Yang M., Ahn H.S. // J. Korean Phys. Soc. 2009. V. 54. № 6. P. 2363. https://doi.org/10.3938/jkps.54.2363
Takayanagi K., Tanishiro Y., Takahashi S., Takahashi M. // Surf. Sci. 1985. V. 164. № 2. P. 367. https://doi.org/10.1016/0039-6028(85)90753-8
Yamabe N., YamamotoY., Ohachi T. // Phys. Status Solidi. 2011. V. 8. № 5. P. 1552. https://doi.org/10.1002/pssc.201000900
Gangopadhyay S., Schmidt T., Falta J. // Phys. Status Solidi. B. 2006. V. 243. № 7. P. 1416. https://doi.org/10.1002/pssb.200565439
Yu I.-S., Chang Ch.-P., Yang Ch.-P. et al. // Nanoscale Res. Lett. 2014. V. 9. № 682. P. 1. https://doi.org/10.1186/1556-276X-9-682
Kanamori J., Sakamoto Y. // Surf. Sci. 1991. V. 242. № 1–3. P. 119. https://doi.org/10.1016/0039-6028(91)90252-N
Kim J.W., Yeom H.W. // Phys. Rev. 2003. V. 67. № 3. P. 35304. https://doi.org/10.1103/PhysRevB.67.035304
Cordier Y., Semond F., Massies J. et al. // J. Cryst. Growth. 2007. V. 301. P. 434. https://doi.org/10.1016/j.jcrysgro.2006.11.286
Fireman M.N., Speck J.S. Molecular Beam Epitaxy: Materials and Applications for Electronics and Optoelectronics / Eds. Asahi H., Horikoshi Y. N.Y.: John Wiley & Sons Ltd, 2019. P. 73. https://doi.org/10.1002/9781119354987.ch5
Mayboroda I.O., Knizhnik A.A, Grishchenko Yu.V. et al. // J. Appl. Phys. 2017. V. 122. № 10. P. 105305. https://doi.org/10.1063/1.5002070
Lev L.L., Maiboroda I.O., Husanu M.-A. et al. // Nat. Commun. 2018. V. 9. № 1. P. 2653. /https://doi.org/10.1038/s41467-018-04354-x
Vezian S., Natali F., Semond F., Massies J. // Phys. Rev. B. 2004. V. 69. P. 125329. https://doi.org/10.1103/.69.125329
Corrion A.L., Poblenz C., Wu F., Speck J.S. // J. Appl. Phys. 2008. V. 103. P. 093529. https://doi.org/10.1063/1.2919163
Han S.-W., Noh Y., Jo M.-G. et al. // IEEE Electron Device Lett. 2016. V. 37. № 12. P. 1613. https://doi.org/10.1109/led.2016.2621184
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография