Микроэлектроника, 2019, T. 48, № 6, стр. 474-480
Метод определения наиболее чувствительной области кристалла оптрона при дозовом воздействии с помощью рентгеновского источника
М. Е. Черняк 1, *, Е. В. Раннева 2, А. В. Уланова 1, 2, **, А. Ю. Никифоров 1, А. И. Верижников 3, А. М. Цырлов 3, В. С. Федосов 3, А. Н. Щепанов 4, В. Д. Калашников 1, Д. О. Титовец 1
1 Национальный исследовательский ядерный университет МИФИ
115409 г. Москва, Каширское ш., 31, Россия
2 АО “ЭНПО Специализированные электронные системы”
115409 г. Москва, Каширское ш., 31, Росссия
3 АО “Протон”
302040 г. Орел, ул. Лескова, Россия
4 ФГУП “МНИИРИП”
141008 МО, г. Мытищи, ул. Колпакова, д. 2А, Россия
* E-mail: mecher@spels.ru
** E-mail: avulan@spels.ru
Поступила в редакцию 24.12.2018
После доработки 15.03.2019
Принята к публикации 15.03.2019
Аннотация
Работа посвящена анализу влияния гамма-излучения на поведение оптронов. С помощью серии экспериментов с маскированием различных частей кристалла от имитирующего рентгеновского воздействия определена наиболее чувствительная область кристалла, проведена доработка конструкции оптрона. Стойкость изделия после доработки повышена более чем в 3 раза.
ВВЕДЕНИЕ
Устройства оптической развязки электрических цепей широко используются при изготовлении электронной аппаратуры, в том числе космического назначения, что накладывает требования по радиационной стойкости данного класса микросхем. Для подтверждения возможности использования микросхемы необходимо проведение радиационных испытаний.
Оптроны, входящие в состав приборов космических аппаратов могут подвергаться воздействию ионизирующего излучения, что приводит к основным эффектам – дозовым, смещения и одиночным [1, 2]. В ходе исследования радиационной стойкости цифровых оптронов был обнаружен низкий уровень стойкости к ионизирующему воздействию, нетипичный для данного класса приборов. В связи с этим предметом данной статьи являются дозовые эффекты.
Некоторые вопросы дозовой стойкости различных элементов оптронов рассмотрены в [3–9]. В данной работе объектом исследований являлся цифровой оптрон с входным светодиодом производства АО “Протон”. Данный класс приборов позволяет организовать электрическую защиту в системах, работающих на частотах порядка 1.0 МГц. В состав оптрона входят светодиод, преобразующий электрический сигнал в световой, оптическая среда, по которой оптический сигнал передается на фотодиод. В результате передачи генерируется фототок, который поступает в базу выходного транзистора, осуществляя его переключение.
Данный класс оптронов обладает достаточно большой дозовой стойкостью (порядка сотен крад [Si]) [10], однако исследованный образец показал меньшие уровни стойкости. Для выявления наиболее радиационно-критичного режима и наиболее радиационно-чувствительного элемента была проведена серия экспериментов с моделированием последствий воздействия протонов и электронов космического пространства гамма и рентгеновским излучением [11, 12].
ОПИСАНИЕ ЭКСПЕРИМЕНТА
Схема включения исследуемых оптронов приведена на рис. 1.
Рис. 1.
Схема включения оптронов при исследованиях на дозовую стойкость: 1 – исследуемый оптрон; 2 – АПК для контроля работоспособности оптронов под управлением Lab View фирмы National Instruments; 3 – компьютер; А1, А2 – амперметры (в составе АПК); V1, V2, V3 – измерители напряжения (в составе АПК).
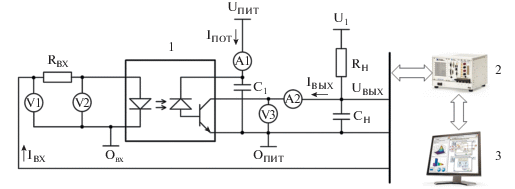
Контроль работоспособности оптронов и измерение электрических параметров осуществлялись с использованием специализированного аппаратно-программного комплекса фирмы National Instruments. АПК позволял контролировать входное напряжение, выходные напряжения низкого уровня, выходной ток высокого уровня, ток потребления, а также динамические параметры (времена включения/выключения). Оборудование позволяло контролировать параметры четырех каналов оптронов одновременно [13]. Облучение проводилось на ускорителе электронов У-31/33, работающем режиме генерации тормозного гамма-излучения и рентгеновском источнике РИК−0401 (НОЦ “Стойкость”). В ходе эксперимента были проведены облучения при нормальных климатических условиях, а также при крайних значениях рабочих температур.
РЕЗУЛЬТАТЫ ИССЛЕДОВАНИЙ И ИХ АНАЛИЗ
После облучения исследуемых оптронов гамма-квантами наблюдалась дозовая деградация выходного тока высокого уровня, а также тока потребления. Током потребления (IПОТ) считалась величина тока, проходящего при напряжении 18В через фотодиод, при отсутствии светового сигнала. Выходным током высокого уровня (IВЫХ) считался ток утечки, проходящий через коллектор выходного транзистора. Результаты исследования деградации выходного тока высокого уровня и тока потребления приведены на рис. 2.
Рис. 2.
Деградация выходного тока высокого уровня и тока потребления оптрона при дозовом воздействии.
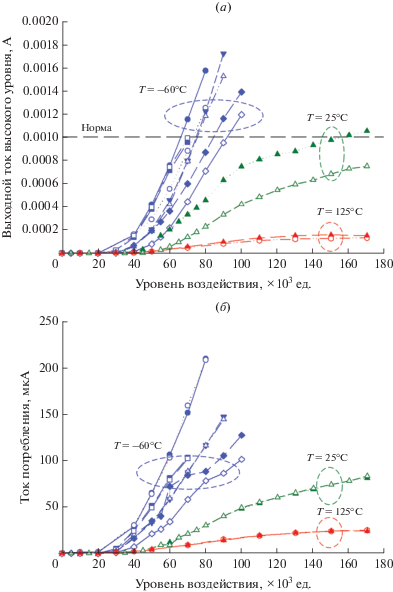
Анализ результатов показывает, что наиболее критична пониженная температура. Также в результате анализа рис. 2 видно, что параллельно увеличению тока потребления с определенным коэффициентом увеличивается и выходной ток высокого уровня. Можно предположить, что при воздействии гамма-квантами образуется паразитный канал тока утечки в базу транзистора. Данный эффект часто наблюдается в других классах приборов [14, 15 ] . Однако анализ разреза кристалла не показал наличие потенциальных мест образования каналов утечки.
C целью определения механизма дозовой деградации была проведена серия дополнительных облучений на рентгеновском источнике специально подготовленных образцов оптронов (без светодиода и оптической среды) в нормальных климатических условиях. Воздействию подвергался как весь выходной каскад, так и определенные участки кристалла (не исследуемые области маскировались пластинами свинца толщиной 1 мм согласно рис. 3) – область фотодиода, область транзистора, область трассировки. Результаты эксперимента приведены на рис. 4. Здесь и далее на оси абсцисс на графиках приведены секунды облучения образца на рентгеновском источнике РИК−0401.
Рис. 4.
Результаты облучения (первый этап) на рентгеновском источнике образцов исследуемых оптронов. Закрашенные маркеры – ток потребления, не закрашенные – выходной ток высокого уровня.
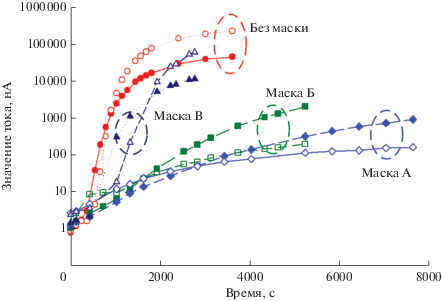
Из графиков видно, что наиболее чувствительная к воздействию область расположена в области трассировки. В результате детального рассмотрения топологии наиболее чувствительного участка, выяснилось, что в кристалле предусмотрены два перехода (эмиттерные перемычки) для более удобной трассировки. В ходе второго этапа облучений были использованы новые маски, приведенные на рис. 6.
Поведение образца под Маской Г (см. рис. 5) сходно с деградацией в отсутствие маскирования – в первую очередь увеличивается выходной ток высокого уровня, ток потребления растет меньше. Маска Д дает аналогичный результат, но деградация оптрона происходит медленнее. Облучение образца под Маской Е дает диаметрально противоположный результат.
Рис. 6.
Результаты локального облучения (второй этап) на рентгеновском источнике образцов исследуемых оптронов. Закрашенные маркеры – ток потребления, не закрашенные – выходной ток высокого уровня.
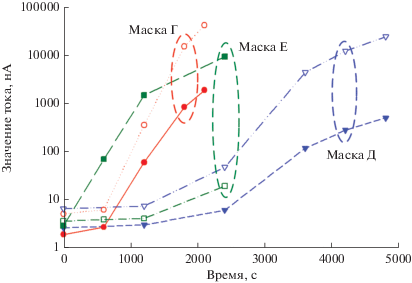
В целях анализа полученного результата рассмотрим сечения двух упоминаемых выше переходов (рис. 7).
В обоих сечениях наблюдается n-p-n-структура с пассивирующим окислом. В результате воздействия в пассивирующем окисле накапливается радиационно-индуцированный заряд, приводящий к инверсии типа проводимости p-области и образованию канала протекания тока утечки. В случае перехода от общего вывода (сечение А-А) это приводит только к увеличению тока через амперметр А1, в случае перехода от анода фотодиода к базе транзистора наблюдается рост базового тока, приводящий к увеличению тока коллектор-эмиттер.
Результаты дозовых исследований доработанных оптронов при нормальных климатических условиях в наиболее критичном электрическом режиме (UПИТ = UВЫХ = 18 В) при гамма-воздействии приведены на рис. 8.
ЗАКЛЮЧЕНИЕ
В результате экспериментальных исследований дозовой стойкости цифрового оптрона определен наиболее критичный температурный режим при воздействии (отрицательная температура минус 60°С) и локализованы наиболее радиационно-чувствительные области кристалла (блок трассировки). С помощью локальных облучений поверхности оптронарентгеновским источником выявлено место возникновения каналов утечки. В результате проведенной доработки дозовая стойкость оптрона была повышена более чем в три раза. Рекомендовано избегать при трассировке использования p-карманов при разнесении участков линий с низким и высоким потенциалом из-за потенциального возникновения каналов утечки или паразитных токов.
Список литературы
Reed R. Guideline for Ground Radiation Testing and Using Optocouplers in the Space Radiation Environment // http://radhome.gsfc.nasa.gov/radhome/papers, 2002.
Pershenkov V.S., Sogoyan A.V., Telets V.A. Conversion model of radiation-induced interface-trap buildup and the some examples of its application // IOP Conference Series: Materials Science and Engineering, V. 151. № 1. 17 Nov. 2016, article number 012001.
Sogoyan A.V., Chumakov A.I., Smolin A.A., Ulanova A.V., Boruzdina A.B. A simple analytical model of single-event upsets in bulk CMOS // Nuclear Instruments and Methods in Physics Research, Section B: Beam Interactions with Materials and Atoms. 2017. V. 400. 1 June 2017. P. 31–36.
Akhmetov A.O., Bobrovskiy D.V., Tararaksin A.S., Petrov A.G., Kessarinskiy L.N., Boychenko D.V., Chumakov A.I., Rousset A., Chatry C. IC SEE comparative studies at UCL and JINR heavy ion accelerators // in 2016 IEEE Radiation Effects Data Workshop, REDW 2016, Portland; United States, 3 April 2017, article number 7891720.
Shvetsov-Shilovskiy I.I., Boruzdina A.B., Ulanova A.V., Orlov A.A., Amburkin K.M., Nikiforov A.Y. Measurement system for test memory cells based on keysight B1500A semiconductor device analyzer running LabVIEW software // in Proc. 2017 International Siberian Conference on Control and Communications, SIBCON 2017, S. Seifullin Kazakh Agrotechnical University, Astana; Kazakhstan; June 29–30, 2017, article number 7998542.
Amburkin K., Chukov G., Elesin V., Nazarova G., Usachev N. Measurement issues of radio frequency integrated circuits with digital control at radiation testing // MATEC Web of Conferences. 2016. V. 79. article number 01041.
Kalashnikov O.A., Nikiforov A.Y. TID behavior of complex multifunctional VLSI devices // Proceedings of the International Conference on Microelectronics, ICM. 2014. P. 455–458.
YUW J. Bias Dependence of Total Dose Effect of Partially Depleted SOI MOSFET // High Energy Physics and Nuclear Physics. V.31. № 9. Sep. 2007. P. 819–822.
Kessarinskiy L.N., Boychenko D.V., Petrov A.G., Nekrasov P.V., Sogoyan A.V., Anashin V.S., Chubunov P.A. Compendium of TID comparative results under X-Ray, Gamma and LINAC irradiation // in 2014 IEEE Radiation Effects Data Workshop, REDW 2014, Paris, France; Jul. 14–18. 2014. P. 236–238. article number 7004562.
Artamonov A.S., Sangalov A.A., Nikiforov A.Y., Telets V.A., Boychenko D.V. The new gamma irradiation facility at the National Research Nuclear University MEPhI // in 2014 IEEE Radiation Effects Data Workshop, REDW 2014, Paris, France; Jul. 14–18. 2014. P. 258–261. article number 7004600.
Petrova E.V., Komarova N.A., Cherniak M.E., Ulanova A.V., Nikiforov A.Y. Hardware/software solution for optocouplers with output MOSFET transistors based on National Instruments PXI-platform // in Proc. 2016 International Siberian Conference on Control and Communications, SIBCON 2016 National Research University “Higher School of Economics"Moscow; Russian Federation; May 12–14, 2016. article number 7491764.
Davydov G.G., Kolosova A.S., Boychenko D.V., Pechenkin A.A. The critical elements of the modern transceiver ICs upon space radiation exposure // in Proc. 14 th European Conf. on Radiation and its Effects on Components and Systems, RADECS-2015, Moscow; Russian Federation; Sept. 14–18, 2015. article number 7365673.
Kessarinskiy L.N., Davydov G.G., Boychenko D.V., Artamonov A.S., Nikiforov A.Y., Yashanin I.B. X-ray grading procedure for conventional 65-nm CMOS technology // in Proc. 2017 International Siberian Conference on Control and Communications, SIBCON 2017, S. Seifullin Kazakh Agrotechnical University, Astana; Kazakhstan; June 29–30, 2017. article number 7998515.
Boychenko D.V., Kalashnikov O.A., Karakozov A.B., Nikiforov A.Y. Rational methodological approach to evaluation of dose resistance of CMOS microcircuits with respect to low intensity effects // Russian Microelectronics. 2015.V. 44. № 1. P. 1–7.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника