Микроэлектроника, 2021, T. 50, № 5, стр. 333-338
Исследование плазмостойкости электронного резиста HSQ высокого разрешения для прототипирования приборов наноэлектроники
А. В. Мяконьких a, **, А. В. Шишлянников b, А. А. Татаринцев a, *, В. О. Кузьменко a, К. В. Руденко a, Е. С. Горнев b
a Физико-технологический институт им. К.А. Валиева Российской АН
Нахимовский проспект, 36, корп. 1
117218 Москва, Россия
b АО “НИИМЭ”
124460 12/1, Москва, Зеленоград, 1-ый Западный проезд, Россия
** E-mail: miakonkikh@ftian.ru
* E-mail: tatarintsev@ftian.ru
Поступила в редакцию 29.04.2021
После доработки 29.04.2021
Принята к публикации 29.04.2021
Аннотация
Проведено исследование селективности плазмохимического травления функциональных материалов, входящих в приборные структуры наноэлектроники, по отношению к маске негативного электронного резиста на основе водород-силсесквиоксана (HSQ). Формирование наноструктур c суб-50 нм критическими размерами под маской HSQ изучено для ряда материалов: монокристаллического кремния, слоев металлического Ta, диэлектрических слоев SiO2, Al2O3, HfO2, Si3N4, а также пористого low-k диэлектрика на основе органосиликатного стекла (OSG) на кремниевых положках. Установлено, что резистные маски HSQ могут применяться для изготовления прототипов микро- и наноэлектроннных приборов с топологическими размерами до 10 нанометров при использовании широкого спектра материалов, в том числе для создания структур, имеющих относительно высокие аспектные отношения при абсолютной толщине слоев функциональных материалов в десятки нанометров.
ВВЕДЕНИЕ
Кремний-неорганический негативный электронный резист на основе водород-силсесквиоксана (HSQ) является одним из распространенных электронных резистов, отличающимся сверхвысоким разрешением до нескольких единиц нанометров, при этом маски из него обладают достаточно хорошей стойкостью в химически активной плазме. Ранее было продемонстрировано [1], что селективность (S) данного резиста в процессах анизотропного плазмохимического травления, по отношению к нижележащему слою, зависит от дозы облучения, однако уже при дозах ~1000 мкКл/см2 значение селективности (S = Rlayer/RHSQ) выходит на постоянное значение. Плазмостойкость резиста HSQ в некоторых случаях сопоставима с жесткими масками, что позволяет формировать наноструктуры плазмохимическими методами непосредственно после электронно-лучевой литографии [2–6]. Также известны успешные применения резиста HSQ в литографической технологии наноимпринта [7] и при создании гибридных оптоэлектронных устройств [8].
Однако, в общем случае, плазмостойкость резиста и, соответственно, селективность процесса плазмохимического травления не является постоянной, а зависит и от свойств резиста, и от химии плазмы, а также режимов плазмохимического травления структур. Поэтому цель настоящего исследования – комплексное изучение возможностей HSQ-резиста при переносе топологического рисунка в слои функциональных материалов, с учетом ограниченной толщины маски, что свойственно электронно-чувствительным резистам. Использовались рецепты анизотропного плазмохимического травления наноструктур под маской HSQ, типичные для создания прототипов наноразмерных транзисторов интегральных схем.
ЭКСПЕРИМЕНТ
1. Электронно-лучевая литография
В качестве образцов использовались пластины монокристаллического кремния КДБ-10 (100), а также пластины с нанесенными различными функциональными слоями: оксидом кремния (SiO2) толщиной 100 нм, нитридом кремния (Si3N4) – 130 нм, оксидом гафния (HfO2) – 32.4 нм, оксидом алюминия (Al2O3) – 110 нм, танталом (Ta) – 113.5 нм, пористым low-k диэлектриком на основе органосиликатного стекла (ОSG) – 200 нм. Пленка SiO2 наносилась методом плазмостимулированного осаждения (PECVD-процесс) из смеси SiH4/O2. Слои HfO2 и Al2O3 осаждались при помощи плазмостимулированного атомно-слоевого осаждения (PEALD) из прекурсоров TEMAH и ТМА соответственно. Тантал наносился на кремний магнетронным распылением мишени (PVD). Слой пористого OSG-диэлектрика на кремниевой подложке получен методом центрифугования (Spin-On).
Поверхности образцов перед нанесением слоя резиста предварительно очищались органическими растворителями с последующей дегидратацией в среде сухого азота при температуре 150°С в течение 1 ч. Для исследований был использован HSQ резист XR-1541 Dow Corning 6% концентрации, который наносился на поверхность образца на центрифуге SAWATEC при 2000 об/мин, что позволяло получить толщину резиста до 190 ± 4 нм. Сушка резиста проводилась при температуре 150°С в течение 4 мин в среде азота. Экспонирование резиста HSQ осуществлялось на электронно-лучевом литографе Raith-150 при максимальной энергии первичного пучка 30 кэВ.
Топология рисунка в резисте представляла собой серию линий длиной 1 мм [1]. Доза облучения варьировалась в диапазоне от 500 до 2000 мкКл/см2 с шагом 125 мкКл/см2. После экспонирования образцы проявлялись в 25% водном растворе гидроксида тетраметиламмония (TMAH) в течении 60 с, далее промывались в течение 60 с в деионизированной воде и сушились в потоке сухого азота.
Ранее [1] было продемонстрировано улучшение стойкости резистной маски при температурной обработке перед процессом плазмохимического травления. В процессе такой обработки сшиваются дополнительные связи, и образуется близкая к SiOx структура. В дополнительных исследованиях [1] было установлено минимально необходимое время отжига резистной маски перед плазмохимическим травлением структур. Основываясь на этих данных, в настоящей работе образцы резистной маски подвергались термическому отжигу на воздухе в течение 30 мин при температуре 400°С.
2. Плазмохимическое травление
Анизотропное плазмохимическое травление структур проводилось в кластерной установке Dual PlasmaLab 100 (Oxford Instruments Plasma Technology, UK), использующей плазму ICP источника диаметром 380 мм, возбуждаемую на частоте 2 МГц, в которую вкладывалась мощность до 3 кВт. Регулируемое электрическое смещение на образце создается ВЧ генератором с частотой 13.56 МГц, что позволяет получить эквивалентное постоянное смещение DC в диапазоне 20–500 В. Базовый вакуум в камере составлял 10–6 Торр. Использовались плазмообразующие газы с чистотой не хуже 99.999%. Образцы структур с литографической маской HSQ размещались на кремниевой пластине-носителе диаметром 100 мм, при этом обеспечивался тепловой контакт образца как с носителем, так и носителя со столом в камере. Стол реактора термостабилизировался при температуре 20°С. Время процессов травления варьировалось в диапазоне 20–120 с.
В зависимости от химического состава вещества функционального слоя, подвергающегося травлению, выбирались индивидуальные параметры процесса травления (химический состав газовой смеси, мощность разряда, давление, напряжение смещения, температура подложки). Цель оптимизации плазмохимического процесса – получение наибольшей селективности S по отношению к маске при сохранении степени анизотропии, обеспечивающей вертикальный профиль стенки структуры травления. Учитывалась также и химическая природа проявленного резиста HSQ после отжига, близкая по структуре и составу к аморфному оксиду кремния.
2.1. Травление слоя SiO2
Для травления оксида кремния применялась плазма смеси С4F8/Ar (10/90), возбуждаемая при мощности разряда Wpl = 1500 Вт, в диапазоне давлений p = 10–20 мТорр. Анизотропия травления обеспечивалась напряжением смещения в диапазоне VDC = 67–123 В. Сходная химическая природа резиста HSQ и оксида кремния не позволяет рассчитывать на получение селективности процесса, значительно отличающейся от 1.
2.2. Травление слоя low-k диэлектрика OSG
Для травления пористого диэлектрика с низкой диэлектрической проницаемостью применялась плазма CF4, возбуждаемая при Wpl = 1700 Вт, в диапазоне p = 10–20 мТорр. Напряжение смещения составило VDC = 84–190 В. Ожидалось, что пористость диэлектрика (~30%) и его химический состав (органосиликатное стекло, содержащее углерод) должны привести к селективности травления превышающей единицу по отношению к резисту HSQ.
2.3. Структурирование кремния
Для структурирования кремния использовался процесс анизотропного плазмохимического травления в плазме смеси газов SF6/C4F8, где хорошо регулируется наклон стенок в структурах травления и вертикальность профиля [1]. Это достигается настройкой соотношения потоков газов. Увеличение содержания C4F8 ведет к усиленному образованию полимерных пленок, что ведет к увеличению угла наклона стенок за счет избыточной пассивации стенок структуры травления. Увеличение содержания SF6 ведет к смещению равновесия в сторону химических процессов травления, что ведет к уменьшению угла наклона стенки. Из-за различий в динамике формирования и разрушения полимерного слоя на кремнии и резистной маске HSQ, отношение скоростей травления маски (RHSQ) и кремния (RSi) растет с ростом полимерсодержащих компонентов плазмы [10], а, следовательно, ожидается падение селективности процесса относительно HSQ резиста.
Наиболее сильная пассивация полимерами стенок требуется для получения Fin-структур наноразмерного диапазона критических размеров [11], а при оптимизации процессов травления, ориентированных на получение высокоаспектных структур, возможно увеличение соотношения SF6/C4F8. В экспериментах по структурированию кремния применялись следующие параметры процесса: p = 10 мТорр, Wpl = 1200 Вт, общий поток газа – 70 ст. см3/мин. Содержание SF6 (${{C}_{{{\text{S}}{{{\text{F}}}_{{\text{6}}}}}}}$) в смеси SF6/C4F8 варьировалось от 28 до 43%. Процесс ${{C}_{{{\text{S}}{{{\text{F}}}_{{\text{6}}}}}}}$ = 28% был оптимизирован для формирования высокоаспектных fin-структур, а процесс ${{C}_{{{\text{S}}{{{\text{F}}}_{{\text{6}}}}}}}$ = 43% – для получения максимальной селективности при сохранении анизотропного профиля.
2.4. Плазмохимическое травление слоя Si3N4
Травление нитрида кремния проводилось в плазме газовой смеси CF4/O2 (40/10) при Wpl = 2500 Вт. Предварительное исследование отношения скоростей травления нитрида кремния и оксида кремния показало, что наиболее сильно селективность к HSQ-резисту зависит от давления. Были исследованы процессы травления Si3N4 под маской HSQ в диапазоне давлений 20–50 мТорр при напряжении смещения ~100 В.
2.5. Плазмохимическое травление слоев Ta
Для травления тантала удобно использовать фторсодержащую плазму, поскольку при этом образуются летучие фториды тантала. В данной работе исследовалось травление в плазме смеси C4F8/O2, в которой содержание O2 варьировалось от 10 до 30% при p = 10–20 мТорр в камере реактора и Wpl = 1700 Вт. Напряжение смещения VDC = 66–126 В.
2.6. Плазмохимическое травление HfO2 и Al2O3
Для травления Al2O3 и HfO2 применялась хлорсодержащая плазма, так как хлориды гафния и алюминия являются летучими соединениями. Использована плазма BCl3 с добавками азота и кислорода, позволяющая получить большую селективность по сравнению с плазмой на основе Cl2. Механизм увеличения селективности состоит в том, что при повышении концентрации кислорода и азота в плазме растет скорость образования BClx-полимерных пленок, пассивирующих поверхность. Баланс между процессами пассивации и травления, индивидуальный для каждого материала, определяет скорость его травления плазмой, которая также существенно растет с напряжением ВЧ-смещения и падает при увеличении доли пассивирующих добавок в плазму BCl3 [12].
В экспериментах образцы слоев оксида гафния и оксида алюминия подвергались анизотропному травлению в плазме на основе BCl3 в режимах: Wpl = 400–1250 Вт, Vbias = 70–160 В, содержание кислорода ${{C}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ = 0–10% или азота ${{C}_{{{{{\text{N}}}_{{\text{2}}}}}}}$ = 0, 7, 14, 21%.
3. Методы измерений
Для измерения толщин нанесённых диэлектрических пленок использовался спектральный эллипсометр Woollam M-2000X (250–1000 нм). Диэлектрические константы определялись в модели Коши одновременно с толщиной пленок, что допустимо при толщине пленок более 50 нм и не приводит к значимой погрешности.
Измерения толщин неструктурированных металлических слоев, измерения геометрических параметров образцов после травления под маской, а также толщина резиста HSQ до и после процессов травления наноструктур выполнялись на сканирующем электронном микроскопе Carl Zeiss Ultra 55.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Селективность исследованных процессов травления оксида кремния через маску HSQ не отличалась от единицы на статистически значимом уровне. Это подтверждает предположение о близкой к оксиду кремния химической природе резиста HSQ.
По результатам травления пористого low-k диэлектрика OSG установлено, что с ростом напряжения смещения в исследованном диапазоне скорость травления и диэлектрика, и резиста возрастает (рис. 1а), при этом при относительно низких давлениях в камере (10 мТорр) селективность значимо не зависит от напряжения смещения, а при повышенных значениях давления (20 мТорр) селективность снижается с ростом напряжения смещения (рис. 1б), что может быть объяснено ростом проникновения химически активных частиц плазмы в поры low-k диэлектрика с увеличением давления.
Рис. 1.
Зависимость скорости травления (а) и селективности травления (б) по отношению к HSQ-маске пористого low-k диэлектрика от напряжения смещения VDC.

Зависимость скоростей травления кремния и HSQ резиста от состава плазмы показана на рис. 2. С ростом относительного содержания SF6 в смеси SF6/C4F8 скорость травления кремния растет, а резиста – падает, что обеспечивает рост селективности до 20 и более. Отметим, что умеренное значение селективности S ~ 4 при использовании смеси SF6/C4F8 = 5/9, оптимальной для прецизионного формирования суб-20 нм структур, достаточно для формирования высокоаспектных структур типа Fin с высотой до 100 нм и более, что удовлетворяет требованиям формирования современных транзисторов FinFET и может служить базовым процессом для последующего изготовления стековых GAA-FET на кремниевых нанопроводах.
На рис. 3 показана зависимость скорости анизотропного травления резистной маски и нитрида кремния и селективности этого процесса от давления при фиксированных остальных параметрах процесса. Видно, что с ростом давления происходит снижение скорости травления обоих материалов, что сильнее проявляется для резиста. В диапазоне давлений 30–50 мТорр селективность травления Si3N4/HSQ составляет S = 2–2.5. Это является близким к значениям, представленным в литературе данным по паре материалов Si3N4/SiO2 [13].
Рис. 3.
Зависимость скорости травления резистной маски HSQ и нитрида кремния (Si3N4) и селективности процесса травления от давления p.

При травлении структур металлического тантала с использованием плазмы C4F8/O2 оптимальная селективность на исследованном пространстве параметров достигалась при соотношении C4F8/O2 = 40/10 и Vbias = 110 В. Полученное значение селективности S = 0.9 хорошо коррелирует с известными ранее результатами травления тантала через маску HSQ во фторсодержащей плазме другого состава [14].
Для оксида алюминия добавка стимулирующих пассивацию поверхности газов (N2, O2) не привела к получению более высокой селективности. Максимальная селективность S = 0.45 для режима анизотропного травления была достигнута при использовании чистого BCl3 при Vbias = 160 В.
При исследовании травления оксида гафния, установлено, что добавка кислорода в плазму BCl3 не позволяет получить селективность более 0.5. Однако увеличение доли азота в смеси BCl3/N2 приводит к росту селективности процесса к резисту HSQ, который можно объяснить более сильной пассивацией материала маски, чем поверхности оксида гафния (рис. 4). При увеличении доли азота в смеси до ~20% травление оксида гафния прекращается (отрицательная скорость травления на графике объясняется тем, что при эллипсометрическом измерении детектируется осаждение полимерной пленки на поверхности оксида гафния). При доле азота в плазмообразующей смеси, равной 14%, оптимальная селективность S ~ 3 к резисту HSQ.
Рис. 4.
Зависимость скорости травления резистной маски и оксида гафния (HfO2) и селективности процесса при выбранных параметрах от доли азота N2 в составе плазмы BCl3/N2.
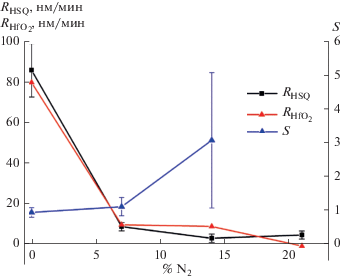
Итоговые результаты по достигнутой селективности к резисту HSQ в процессах структурирования исследованных материалов представлены в табл. 1
Таблица 1.
Значения селективностей при травлении различных функциональных по отношению к негативному электронному резисту HSQ
| Функциональный слой | S, селективность |
|---|---|
| Al2O3 | 0.45 ± 0.04 |
| HfO2 | 3.06 ± 2.21 |
| Ta | 0.90 ± 0.04 |
| low-k | 2.81 ± 0.23 |
| SiO2 | 1.22 ± 0.25 |
| Si3N4 | 2.72 ± 0.59 |
| Si | 19.2 ± 3.8 |
| Si, оптимизированный под травление fin-структур | 3.8 ± 0.3 |
ЗАКЛЮЧЕНИЕ
Проведено исследование селективности плазмохимического травления различных функциональных материалов по отношению к негативному электронному резисту на основе водород-силсесквиоксана HSQ. Исследования формирования наноструктур были проведены на ряде материалов: монокристаллический кремний, слои металлического Ta и слои диэлектриков SiO2, Al2O3, HfO2, Si3N4, а также пористого low-k диэлектрика на основе органосиликатного стекла, нанесенных на кремниевые положки. Показано, что резист HSQ может применяться для создания прототипов приборов наноэлектроники с критическими размерами до 10 нанометров, и аспектными отношениями до 1 : 10 при структурировании широкого спектра материалов.
Исследование выполнено в рамках Государственного задания ФТИАН им. К.А. Валиева РАН по Программе № 0066-2019-0004, при частичной финансовой поддержке РФФИ в рамках проекта 19-37-90083.
Список литературы
Мяконьких А.В., Орликовский Н.А., Рогожин А.Е., Татаринцев А.А., Руденко К.В. Влияние дозы экспонирования на стойкость негативного электронного резиста HSQ в процессах плазмохимического и химического травления // Микроэлектроника. 2018. Т. 47. № 3. С. 179–186. [Miakonkikh A.V., Orlikovskiy N.A., Rogozhin A.E., Tatarintsev A.A., Rudenko K.V. Dependence of the Resistance of the Negative e-Beam Resist HSQ Versus the Dose In the RIE and Wet Etching Processes // Russian Microelectronics. 2018. V. 47(3). P. 157–164.]
Larrieu G., Dubois E. Reactive ion etching of a 20 nanometers tungsten gate using a SF6/N2 chemistry and hydrogen silsesquioxane hard mask resist // J. Vacuum Science & Technology B. 2005. V. 23. 2046.
Kazazis D., Tseng L.T., Ekinci Y. Achromatic Talbot lithography with nano-ring masks for high-throughput periodic patterning // Microelectronic Engineering. 2020. V. 225. 111273.
Hill P., Gua E., Dawsona M.D., Straina M.J. Thin film diamond membranes bonded on-demand with SOI ring resonators // Diamond and Related Materials. 2018. V. 88. P. 215–221.
Kleinlein J., Borzenko T., Münzhuber F., Brehm J., Kiessling T., Molenkamp L.W. NV-center diamond cantilevers: Extending the range of available fabrication methods // Microelectronic Engineering. 2016. V. 159. P. 70–74.
Peng Sun, Chengchun Tang, Xiaoxiang Xia, Zehan Yao, Baogang Quana, Guang Yuan, Changzhi Gu, Junjie Li. Controlled fabrication of periodically high-aspect ratio CVD-diamond nanopillar arrays by pure oxygen etching process // Microelectronic Engineering. 2016. V. 155. P. 61–66.
Lauvernier D., Garidel S., Legrand C., Vilcot J.P. Realization of sub-micron patterns on GaAs using a HSQ etching mask // Microelectron. Eng. 2005. V. 77. № 3–4. P. 210–216.
Lina L., Oua Y., Jokubaviciusb V., Syvajarvib M., Liangc M., Liuc Z., Yic X., Schuhd P., Wellmannd P., Herstrome B., Jensene F., Oua H. An adhesive bonding approach by hydrogen silsesquioxane for silicon carbidebased LED applications // Materials Science in Semiconductor Processing. 2019. V. 91. P. 9–12.
Trellenkamp St., Moers J., van der Hart A., Kordos P., Lüth H. Patterning of 25-nm-wide silicon webs with an aspect ratio of 13 // Microelectronic Engineering. 2003. V. 67–68. P. 376–380.
Efremov A.M., Murin D.B., Kwon K.H. On the Effect of the Ratio of Concentrations of Fluorocarbon Components in a CF4 + C4F8 + Ar Mixture on the Parameters of Plasma and SiO2/Si Etching Selectivity // Russ. Microelectronics. 2018. V. 47. P. 239–246.
Miakonkikh A.V., Tatarintsev A.A., Rogozhin A.E., Rudenko K.V. Technology for fabrication of sub-20 nm silicon planar nanowires array // Proceedings of SPIE. 2016. V. 10224. 1022419.
Myakonkikh A.V., Kuvaev K.Y., Tatarintsev A.A., Orlikovskii N.A. et al. Investigation of the Process of Plasma Through Etching of HkMG Stack of Nanotransistor with a 32-nm Critical Dimension // Russ. Microelectronics. 2018. V. 47(5). P. 323–331.
Lee H.K., Chung K.S., Yu J.S. Selective Etching of Thick Si3N4, SiO2 and Si by Using CF4/O2 and C2F6 Gases with or without O2 or Ar Addition // J. Korean Physical Society. 2009. V. 54. P. 1816–1823.
Welch C.C., Olynick D.L., Liu Z., Holmberg A., Peroz C., Robinson A.P.G., Henry M.D., Scherer A., Mollenhauer T., Genova V., Ng D.K.T. Formation of nanoscale structures by inductively coupled plasma etching // Proceedings of SPIE. 2013. V. 8700. 870002.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника



