Неорганические материалы, 2019, T. 55, № 10, стр. 1040-1045
Получение легированных мышьяком эпитаксиальных слоев Hg1 – xCdxTe с x ~ 0.4 MOCVD-методом
В. С. Евстигнеев 1, *, А. В. Чилясов 1, А. Н. Моисеев 1, М. В. Костюнин 1
1 Институт химии высокочистых веществ им. Г.Г. Девятых Российской академии наук
603951 Нижний Новгород, ул. Тропинина, 49, Россия
* E-mail: evstigneev@ihps.nnov.ru
Поступила в редакцию 18.02.2019
После доработки 04.04.2019
Принята к публикации 16.04.2019
Аннотация
Исследованы закономерности вхождения мышьяка из трис-диметиламиноарсина в эпитаксиальные слои Hg1– xCdxTe (x ~ 0.4), выращенные методом MOCVD-IMP на подложках GaAs (310), (100) и (111)B. Рост CdTe проводили из паров диметилкадмия и диэтилтеллура, а HgTe – из диизопропилтеллура и ртути. Вхождение As в слои зависит от кристаллографической ориентации роста и увеличивается в ряду (111)B–(100)–(310). Установлено, что добавление трис-диметиламиноарсина на стадии роста подслоя CdTe в избытке диэтилтеллура не оказывает заметного влияния на макросостав HgCdTe. Легирование приводит к получению слоев HgCdTe p-типа. Доля электрически активного As в слоях зависит от его концентрации и увеличивается с 15 до 85% в ряду ориентаций (111)B–(100)–(310). Дополнительные двухступенчатые отжиги приводят к практически 100%-ной активации As в HgCdTe.
ВВЕДЕНИЕ
Твердые растворы теллурида кадмия-ртути (Hg1– хCdхTe, КРТ) широко используются в технологии инфракрасных детекторов. Наибольшее применение находит HgCdTe с x ~ 0.2 и 0.3 (для диапазонов 8–12 и 3–5 мкм соответственно). В последнее время растет интерес к использованию материала с x > 0.38 в ближнем и коротковолновом ИК-диапазоне (0.8–2.5 мкм) для астрофизических исследований [1].
Фотоприемные устройства на основе КРТ в основном изготавливаются на базовых слоях p‑типа. Получение КРТ p-типа возможно за счет собственных дефектов (вакансии ртути VHg) либо за счет легирования элементами I (Cu, Au) или V (P, As, Sb) групп. Однако VHg и их комплексы с другими точечными дефектами (например, TeHg) являются центрами рекомбинации Шокли–Рида–Холла и снижают время жизни носителей заряда [2]. Поэтому примесное легирование, прежде всего элементами V группы, предпочтительнее, поскольку они не являются центрами рекомбинации и позволяют получать структуры с резким профилем распределения примеси. Однако для элементов V группы характерно амфотерное поведение, поэтому контроль акцепторного легирования представляет значительную проблему в различных методах выращивания КРТ. Наиболее применяемой акцепторной примесью является мышьяк.
Химическое осаждение из газовой фазы (MOCVD) предлагает широкий выбор прекурсоров для легирования КРТ мышьяком. Это арсин и его органические производные (триметиларсин, трет-бутиларсин и др.) [3, 4]. Использование этих прекурсоров позволяет получать от 50 до 100% электрически активного As после дополнительных отжигов HgCdTe в парах ртути. Однако время жизни носителей заряда при этом сопоставимо с вакансионно-легированным КРТ, что может быть обусловлено наличием комплексов As–H и As–C [5]. Перспективным прекурсором As считается трис-диметиламиноарсин (ТДМАА, As[(CH3)2N]3). Применение ТДМАА позволяет уменьшить концентрацию встраиваемых в матрицу HgCdTe комплексов As–H и As–C, при этом время жизни неосновных носителей заряда ограничивается фундаментальными процессами рекомбинации [6].
Большинство исследований по легированию слоев HgCdTe мышьяком и анализу их свойств выполнено на узкозонных составах с x < 0.3. Нераскрытым является также механизм изменения макросостава слоев HgCdTe в процессе легирования мышьяком.
Целью данной работы являлось исследование особенностей процесса легирования слоев Hg1 –xCdxTe с x > 0.38 мышьяком в MOCVD-процессе с использованием ТДМАА и его влияния на электрофизические свойства слоев.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Эпитаксиальные слои Hg1– хCdхTe выращивали путем осаждения тонких чередующихся слоев CdTe и HgTe (с их последующей взаимодиффузией, т.н. IMP-метод) в вертикальном кварцевом реакторе с нагретыми стенками при давлении 20 кПа и температуре подложки 350–360°C. Более подробно методики выращивания и исследования свойств слоев HgCdTe описаны в [2]. Легирование As осуществляли с использованием ТДМАА на стадии роста подслоя CdTe. Соотношение диэтилтеллур (ДЭТ)/диметилкадмий (ДМК) на входе в реактор изменяли от 1 до 4.4. Осаждение слоев проводили на подложки полуизолирующего GaAs (100)4° → 〈110〉, (111)В ± 0.5°, (310) ± 0.5°. Первоначально на подложки осаждали буферный слой CdTe толщиной 2–3 мкм, а затем слой HgCdTe. На заключительной стадии выращивания на поверхность КРТ наносили пассивирующий слой CdTe толщиной 200–500 нм. Профили состава и концентрации As по толщине исследовали методом вторичной ионной масс-спектрометрии (ВИМС) на приборе TOF.SIMS-5 (предел обнаружения по As ~6 × 1016 см–3).
Электрофизические параметры слоев определяли при помощи измерений эффекта Холла методом Ван дер Пау в изменяющемся магнитном поле (0–1 Тл) при температуре 77 K. Двухступенчатые отжиги (360°C, 2 ч + 220°C, 24 ч) для активации As проводили в насыщенных парах ртути в вакуумированных кварцевых ампулах.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Особенность метода MOCVD-IMP для получения слоев HgCdTe на GaAs – раздельное осаждение тонких чередующихся слоев CdTe и HgTe, при этом заметное вхождение As наблюдается лишь при росте подслоя CdTe [4].
Первые опыты по легированию HgCdTe проводили при добавлении ТДМАА во время роста подслоя CdTe при мольном отношении ДЭТ/ДМК = 1. Это соотношение было выбрано исходя из литературных данных [4, 7], где отмечается, что рост в небольшом избытке ДМК обеспечивает лучшую активацию As как акцептора. При добавлении ТДМАА (5 × 10–7 моль/мин) в газовую фазу во время роста Hg1 –xCdxTe наблюдалось изменение x с 0.4 до 0.8 (рис. 1) при неизменном отношении времен осаждения подслоев CdTe и HgTe. Подобный эффект отмечался в работе [7] при легировании HgCdTe в MOCVD-IMP-методе с использованием ТДМАА и AsH3. Было отмечено, что добавление прекурсора As в газовую фазу приводит к увеличению скорости роста подслоя CdTe. Увеличение скорости роста авторы связывали с возможным образованием аддукта между ДМК и ТДМАА или AsH3, который имеет меньшую термическую устойчивость и, соответственно, большую скорость распада, чем отдельные соединения.
Рис. 1.
Распределение концентрации As (1) и состава (x) (2) по толщине Hg1 –xCdxTe (310) (поток ТДМАА – 5 × 10–7 моль/мин, ДЭТ/ДМК = 1 во время роста подслоя CdTe).
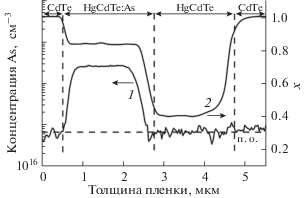
В работе [8] показано, что добавление ТДМАА в концентрации (5–10) × 10–7 моль/мин при легировании As слоев CdTe в условиях, близких к условиям осаждения слоев HgCdTe в настоящей работе, приводит к увеличению скорости роста CdTe лишь на 15–25%. Поэтому объяснить резкое изменение состава слоев Hg1 –xCdxTe (с x = 0.4 до x = 0.8) только увеличением скорости роста CdTe нельзя. Можно предположить, что изменение макросостава слоев Hg1 –xCdxTe может также происходить за счет уменьшения скорости роста HgTe.
На основе экспериментов по выращиванию соединений AIIIBV было показано, что алкилы элементов III группы образуют донорно-акцепторные комплексы (аддукты) с ТДМАА и его аналогами [9]. Способность к образованию довольно устойчивых аддуктов соединений элементов III и V групп используется для очистки алкильных соединений Ga и In [10]. Прямые экспериментальные доказательства образования аддукта между ДМК и ТДМАА в литературе отсутствуют. Однако комплексы ДМК и схожего с ним по химической природе диметилцинка (ДМЦ) с органическими основаниями (например, дипиридилом и его производными) описаны и используются для их очистки [11]. Одним из основных продуктов термического распада ТДМАА в H2 является сильное азотсодержащее основание – диметиламин (ДМА, (CH3)2NH) [12]. В литературе отсутствуют сведения об образовании аддукта между ДМК и ДМА. Однако экспериментально установлено, что ДМЦ может образовывать малолетучее соединение с ДМА – бис-диметиламиноцинк (Zn[N(CH3)2]2) с температурой разложения 270–290°C [13]. Таким образом, уменьшение скорости осаждения на стадии роста HgTe (потоки ДМК и ТДМАА в реактор не идут) может быть связано с десорбцией со стенок реактора аддуктов между ДМК и ТДМАА (или продуктами его разложения) и конкурирующей адсорбцией этих аддуктов и атомов ртути на поверхности растущего слоя.
На рис. 2 представлен концентрационный профиль As и х по толщине трехслойной структуры со ступенчатым профилем легирования, выращенной при соотношении ДЭТ/ДМК = 4.4 во время роста подслоя CdTe. Соотношение времен осаждения подслоев CdTe и HgTe было рассчитано для х = 0.4 и на протяжении роста HgCdTe оставалось постоянным. Как видно из рис. 2, x однородно распределен по толщине, а концентрационный профиль As имеет резкие переходы между легированной и нелегированными областями. Избыток ДЭТ в газовой фазе во время роста подслоя CdTe позволяет проводить легирование Hg1 –xCdxTe без изменения x по толщине слоев. Описание эффекта влияния добавления прекурсоров As на макросостав при росте слоев КРТ в избытке ДЭТ в литературе отсутствует.
Рис. 2.
Распределение концентрации As (1) и состава (x) (2) по толщине слоев Hg1 –xCdxTe (310) (поток ТДМАА – 5 × 10–7 моль/мин, ДЭТ/ДМК = 4.4 во время роста подслоя CdTe).

На рис. 3 приведены результаты эксперимента по легированию HgCdTe при соотношении ДЭТ/ДМК = 4.4 и потоке ТДМАА 5 × × 10‒7 моль/мин одновременно на трех кристаллографических ориентациях роста. Концентрация As сильно зависит от кристаллографической ориентации растущего слоя и увеличивается в ряду (111)B < (100) < (310). Эта зависимость коррелирует с данными ориентационной зависимости вхождения As в CdTe, полученной ранее [8]. Во всех трех случаях не наблюдается заметного отклонения состава от запланированного значения (х ~ 0.4). Можно предположить, что увеличение отношения ДЭТ/ДМК > 1 в газовой фазе уменьшает вероятность побочных реакций между ДМК и ТДМАА (или продуктами его разложения) за счет более вероятного взаимодействия ДМК и ДЭТ. Это приводит к снижению концентрации азотсодержащих аддуктов и, как следствие, уменьшению влияния ТДМАА на состав КРТ.
Рис. 3.
Профили распределения концентрации As (1) и состава (x) (2) по толщине слоев Hg1 –xCdxTe кристаллографической ориентации (310) (а), (100) (б), (111)B (в), выращенных в одном процессе (поток ТДМАА – 5 × 10–7 моль/мин, ДЭТ/ДМК = 4.4 во время роста подслоя CdTe).
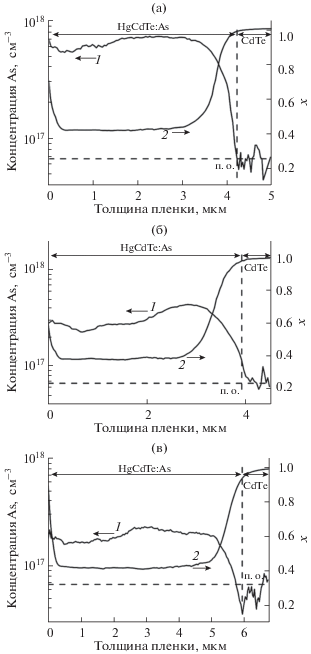
Зависимость концентрации носителей заряда в нелегированных слоях HgCdTe (310), (100) и (111)B от соотношения ДЭТ/ДМК во время роста подслоя CdTe представлена на рис. 4. Нелегированные слои Hg1 –xCdxTe (x = 0.38–0.40) ориентации (310), полученные в описанных условиях, имеют p-тип проводимости, которая определяется вакансиями ртути VHg. Слои Hg1 –xCdxTe (x = 0.38–0.40) ориентаций (100) и (111)B имеют смешанный тип проводимости с преобладанием электронной составляющей, которая обусловлена фоновыми донорными примесями и возможным наличием антиструктурного теллура (TeHg). Уменьшение концентрации носителей заряда при увеличении соотношения ДЭТ/ДМК, вероятно, обусловлено увеличением концентрации глубоких центров, связанных с TeHg, проявляющих донорные свойства [2].
Рис. 4.
Зависимости концентрации носителей заряда (77 K, 1 Тл) в слоях Hg1 –xCdxTe (310) (1), (100) (2) и (111)B (3) c x = 0.38–0.4 от соотношения ДЭТ/ДМК во время роста подслоя CdTe.
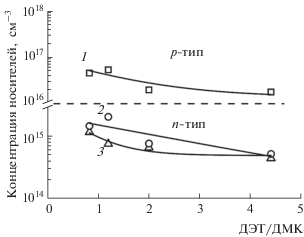
При легировании As наблюдается конверсия типа проводимости n → p в слоях HgCdTe (100) и (111)B и рост концентрации дырок на ориентации (310). В табл. 1 представлены электрофизические параметры слоев Hg1 –xCdxTe:As различных кристаллографических ориентаций. Непосредственно после роста лишь часть As находится в электрически активном состоянии. Наибольшая активация As наблюдается в HgCdTe (310) и может достигать ~80% в зависимости от концентрации As. Образцы 3, 4 и 5 были выращены в одном процессе. В случае образцов 3 и 4 (ориентация (310) и (100) соответственно) степень электрической активации As одинакова, а у образца 5 (ориентация (111)B) она значительно меньше. По-видимому, встраивание As на ориентации (111)B сопряжено с более высокой степенью его компенсации дефектами кристаллической решетки (например, микродвойниками, характерными для ориентации (111)В [14]).
Таблица 1.
Электрофизические параметры слоев HgCdTe:As различной кристаллографической ориентации (ДЭТ/ДМК = 4.4 во время осаждения подслоя CdTe, поток ТДМАА – 5 × 10–7 моль/мин)
| Образец | Ориентация | x | As, см–3 (ВИМС) | Электрофизические параметры (77 K, 1 Тл) |
Активация As,% | |
|---|---|---|---|---|---|---|
| p, см–3 | μ, см2/(В с) | |||||
| 1 | (310) | 0.360 | 2.5 × 1017 | 1.8 × 1017 | 214 | 72 |
| 2 | (310) | 0.390 | 2.0 × 1017 | 1.7 × 1017 | 206 | 85 |
| 3 | (310) | 0.430 | 6.4 × 1017 | 2.3 × 1017 | 120 | 36 |
| 4 | (100) | 0.392 | 3.5 × 1017 | 1.3 × 1017 | 140 | 37 |
| 5 | (111)B | 0.420 | 2.0 × 1017 | 3.4 × 1016 | 120 | 15–20 |
| 6 | (111)B | 0.393 | 2.0 × 1017 | 3.8 × 1016 | 180 | |
Для увеличения доли электрически активного As образцы 1, 4 и 5 были подвергнуты активационному отжигу в парах Hg, который состоял из высокотемпературной (360°C, 2 ч) и низкотемпературной (220°C, 24 ч) стадий. На рис. 5 представлена зависимость концентрации дырок от концентрации As в слоях КРТ до и после двухступенчатых отжигов. Как видно из рис. 5, после отжига концентрация носителей заряда значительно выросла и приблизилась к концентрации As, определяемой методом ВИМС (100%-ная активация примеси).
ЗАКЛЮЧЕНИЕ
Исследованы закономерности вхождения As из ТДМАА в условиях MOCVD-IMP-осаждения слоев HgCdTe из паров ДМК, ДЭТ, диизопропилтеллура и Hg.
Добавление ТДМАА в газовую фазу во время роста подслоя CdTe приводит к изменению макросостава слоев Hg1 –xCdxTe, что может быть обусловлено адсорбцией и распадом на ростовой поверхности менее термически стойких аддуктов между ДМК и ТДМАА (и/или продуктами его распада). Установлено, что добавление ТДМАА в газовую фазу во время роста подслоя CdTe в избытке ДЭТ (ДЭТ/ДМК = 4.4) не оказывает заметного влияния на состав слоев Hg1 –xCdxTe.
Вхождение As в слои HgCdTe зависит от кристаллографической ориентации растущего слоя и увеличивается в ряду (111)B–(100)–(310).
Нелегированные слои HgCdTe (310), полученные в исследованных условиях, имеют p-тип проводимости, а слои ориентаций (100) и (111)B – смешанный тип проводимости с преобладанием электронной. Показано, что легирование As приводит к получению слоев HgCdTe p-типа проводимости, при этом доля электрически активного As меньше 100% и увеличивается в ряду кристаллографических ориентаций (111)B–(100)–(310). Дополнительные двухступенчатые отжиги (360°C, 2 ч + 220°C, 24 ч) приводят к практически 100%-ной активации As в слоях HgCdTe.
Список литературы
Hipwood L.G., Shorrocks N., Maxey C.D., Atkinson D., Bezawada N. SWIR and NIR MCT Arrays Grown by MOVPE for Astronomy Applications // Infrared Technology and Applications XXXVIII. Baltimore: International Society for Optics and Photonics, 2012. V. 8353. P. 83532M.
Евстигнеев В.С., Варавин В.С., Чилясов А.В., Ремесник В.Г., Mоисеев А.Н., Степанов Б.С. Электрофизические свойства нелегированных и легированных мышьяком эпитаксиальных слоев Hg1 –xCdxTe p-типа проводимости с x ~ 0.4, выращенных методом MOCVD // ФТП. 2018. Т. 52. № 6. С. 554–559.
Maxey C.D., Gale I.G., Clegg J.B., Whiffin P.A.C. Doping Studies in MOVPE-Grown CdxHg1 –xTe // Semicond. Sci. Technol. 1993. V. 8. P. S183–S196.
Capper P., Maxey C.D., Whiffin P.A.C., Easton B.C. Incorporation and Activation of Group V Elements in MOVPE-Grown CdxHg1 –xTe // J. Cryst. Growth. 1989. V. 97. № 3–4. P. 833–844.
Clerjaud B., Cote D., Svob L., Marfaing Y., Druilhe R. Hydrogen-Acceptor Pairing in CdTe Epitaxial Layers Grown by OMVPE // Solid. State Commun. 1993. V. 85. № 2. P. 167–170.
Madejczyk P., Piotrowski A., Kłos K., Gawron W., Rutkowski J., Rogalski A. Control of Acceptor Doping in MOCVD HgCdTe Epilayers // Opto-Electron. Rev. 2010. V. 18. № 3. P. 271–276.
Piotrowski A., Kłos K. Metal-Organic Chemical Vapor Deposition of Hg1−xCdxTe Fully Doped Heterostructures without Post-Growth Anneal for Uncooled MWIR and LWIR Detectors // J. Electron. Mater. 2007. V. 36. № 8. P. 1052–1058.
Чилясов А.В., Моисеев А.Н., Евстигнеев В.С., Степанов Б.С., Дроздов М.Н. Получение эпитаксиальных слоев легированного мышьяком теллурида кадмия MOCVD-методом // Неорган. материалы. 2016. Т. 52. № 12. С. 1284–1289.
Salim S. In-situ Fourier Transform Infrared Spectroscopy of Chemistry and Growth in Chemical Vapor Deposition: Doctoral Dissertation. Massachusetts Institute of Technology. 1995.
Jones A.C., Holliday A.K., Cole-Hamilton D.J., Ahmad M.M., Gerrard N.D. Routes to Ultra-Pure Alkyls of Indium and Gallium and their Adducts with Ethers, Phosphines and Amines // J. Cryst. Growth. 1984. V. 68. P. 1–9.
Shenai-Khatkhate D.V., Obrell E.D., Mullin J.B., Cupertino D.C., Cole-Hamilton D.J. Preparation and Purification of Metal Alkyls for Use in MOCVD Growth of II/VI Compound Semiconductors // J. Cryst. Growth. 1986. V. 77. P. 27–31.
Salim S., Lim C.K., Jensen K.F. Gas-Phase Decomposition Reactions of Tris(dimethylamino)phosphine, -Arsine, and-Stibine Reagents // Chem. Mater. 1995. V. 7. № 3. P. 507–516.
Ridley D. Synthetic and Spectroscopic Studies on Some Inorganic and Organometallic Compounds. Doctoral Dissertation. Durham University. 1965.
Capper P., Garland J. Mercury Cadmium Telluride: Growth, Properties and Applications. United Kingdom: John Wiley & Sons Ltd., 2011. P. 564.
Дополнительные материалы отсутствуют.
Инструменты
Неорганические материалы



