Неорганические материалы, 2020, T. 56, № 4, стр. 393-401
Электрические свойства тонких пленок In2O3/С
И. В. Бабкина 1, М. Н. Волочаев 2, О. В. Жилова 1, Ю. Е. Калинин 1, В. А. Макагонов 1, *, С. Ю. Панков 1, А. В. Ситников 1
1 Воронежский государственный технический университет
394026 Воронеж, Московский пр., 14, Россия
2 Институт физики им. Л.В. Киренского ФИЦ КНЦ СО Российской академии наук
660036 Красноярск, Академгородок, 50, стр. 38, Россия
* E-mail: vlad_makagonov@mail.ru
Поступила в редакцию 21.03.2019
После доработки 12.09.2019
Принята к публикации 02.10.2019
Аннотация
Исследованы структура и электрические свойства тонких пленок на основе полупроводника In2O3 и углерода, полученных послойным осаждением с применением метода ионно-лучевого распыления. Структура изученных материалов, сформированная в процессе послойного осаждения островковых слоев, представляет собой нанокристаллические гранулы In2O3, хаотически распределенные в аморфном углероде. Электрофизические свойства тонких пленок In2O3/С зависят от толщины. Для тонких пленок In2O3/С толщиной h < 70 нм с увеличением температуры в диапазоне 80–300 K наблюдается последовательная смена доминирующего механизма электропереноса: прыжковый механизм с переменной длиной прыжка по локализованным состояниям в узкой полосе энергий вблизи уровня Ферми (от 80 до 120 K), по ближайшим соседям (от 120 до 250 K), по локализованным состояниям в хвосте зоны проводимости (от 250 до 300 K). При h > 70 нм обнаружен переход от проводимости, связанной с сильной локализацией носителей заряда, к проводимости, обусловленной наличием перколляционных кластеров, образованных нанокристаллами In2O3, что проявляется в виде линейной температурной зависимости проводимости с отрицательным температурным коэффициентом сопротивления.
ВВЕДЕНИЕ
Тонкие пленки оксида индия In2O3 являются полупроводниками n-типа с шириной запрещенной зоны 3.55–3.75 эВ, обладают высокой оптической прозрачностью, высокой электропроводностью и превосходной люминесценцией, что позволяет применять их в изделиях прозрачной электроники [1], светодиодах [2], солнечных элементах [3], газовых сенсорах [4, 5] и других устройствах электронной техники.
В последние годы тонкие пленки оксидных полупроводников, в частности оксида индия, предложено использовать в качестве каналов тонкопленочных транзисторов (TFT) [6–8]. Однако нестабильность и недолговечность рабочих характеристик полупроводников и твердых растворов на их основе в однослойных каналах TFT, возникающая под влиянием различных условий (температуры, напряжения смещения, освещенности), требует поиска новых методов стабилизации их параметров. Причиной нестабильности многих электрических параметров являются кислородные вакансии [9]. В то же время известно, что перенос заряда в прозрачных оксидных полупроводниках обеспечивается дефектами, связанными с кислородом, и, следовательно, плотность вакансий кислорода определяет электрические свойства оксидных полупроводников. Таким образом, возникает ситуация, когда приходится выбирать между стабильностью работы и ухудшением рабочих характеристик. Кроме того, применяемые в настоящее время материалы каналов TFT не отвечают предъявляемым к ним требованиям, связанным со скоростью работы, временем переключения и подвижностью носителей заряда.
Выходом из сложившейся ситуации является изготовление двухфазных нанокомпозитов или многослойных канальных структур с высокой подвижностью носителей заряда и высокой стабильностью рабочих характеристик. Среди двухфазных систем были изучены ZnO–SnO2, ZnO–In2O3 и др. [10–13]. При этом по электрическим и оптическим свойствам двухфазные оксидные полупроводники значительно уступают чистому оксиду индия, а их стабильность оказывается выше.
Для стабилизации нанокристаллической структуры оксида индия широкое распространение получил способ легирования оксида индия различными примесями [14, 15]. Одной из наиболее интересных легирующих примесей в In2O3 является углерод. Отметим также, что высокая цена индия, необходимого для производства, наиболее популярного тонкопленочного оксида, тоже стимулирует исследования и разработки, направленные на поиск его замены.
Цель настоящей работы – экспериментальное исследование структуры гетерогенных тонких пленок системы In2O3/С и ее влияния на электрические свойства.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Тонкие пленки (In2O3/С)74 были получены послойным осаждением In2O3 и C с применением метода ионно-лучевого распыления в атмосфере аргона с чистотой 99.998% при давлении 7 × 10–2 Па по методике [16]. Мишени из керамического In2O3 и графита С были закреплены на водоохлаждаемых медных основаниях размером 280 × 80 мм и размещены в разных положениях в вакуумной камере. Для того чтобы осуществить послойное осаждение, подложка перемещалась из одного положения распыления в другое путем вращения подложкодержателя вокруг оси напылительной камеры со скоростью 0.13 об./мин. Осаждение велось на подложки из монокристаллического кремния с кристаллографической ориентацией (100) для исследования структуры и ситалла СТ-50 для исследования электрофизических свойств. В процессе напыления поддерживалась комнатная температура подложек. Для получения различных толщин слоев In2O3 и С в ходе единого процесса напыления между мишенями и держателем подложки были установлены V-образные экраны. В одном цикле напыления в качестве подложек использовали 4 ситалловых пластины с размерами 60 × 48 × 0,6 мм, которые располагались в виде полоски размером 240 × 80 мм на расстоянии ~70 мм. Длинные оси подложки и мишени совпадали. Применение V-образных экранов и соосное размещение мишени и подложки позволили в едином цикле нанесения формировать пленки с различной толщиной бислоев по длине подложки.
Оценка толщины слоев осуществлялась путем предварительного напыления отдельных пленок In2O3 и C с подобранными ранее параметрами процесса. Перед началом напыления выставлялись подобранные ранее параметры процесса напыления многослойной структуры и осуществлялся процесс распыления с выбранной мишени. После продолжительного, обычно несколько часов, процесса нанесения пленки на вращающиеся с заданной скоростью подложки проводилось измерение толщины с различных участков полученных пленок с помощью интерферометра МИИ-4. Точки измерения толщины фиксировались относительно расположения подложки и мишени. Измеренные толщины пленки аппроксимировались в зависимости от расстояния до края подложки. По известным времени распыления и времени одного оборота подложкодержателя рассчитывалась толщина слоя пленки, полученная за одно прохождение подложкой зоны нанесения материала. Аналогичным образом определялась толщина одного слоя второй фазы многослойной структуры. Количество циклов осаждения определяло количество бислоев In2O3/C. В нашем случае было проведено 74 цикла осаждения, что позволило получить 75 тонких пленок толщиной от 28 до 138 нм, что соответствовало значениям эквивалентной толщины бислоя In2O3/C, изменяющейся от 0.38 до 1.9 нм. Следует отметить, что полученное таким образом значение толщины монослоя является эквивалентным и не учитывает возможность островкового роста, т.е. это толщина тонкой пленки, нанесенной за один оборот подложкодержателя при условии, что эта пленка является сплошной.
Структура и фазовый состав полученных образцов исследовались методами рентгеновской дифракции на приборе Bruker D2 Phaser (${{\lambda }_{{{\text{Cu}}{{K}_{{\alpha 1}}}}}}$ = = 1.54 Å) с применением программного обеспечения DIFFRAC.EVA 3.0 и базы данных ICDD PDF Release 2012. Снимки просвечивающей электронной микроскопии (ПЭМ) поперечного сечения образцов и электронограммы были получены на микроскопе Hitachi HT7700 при ускоряющем напряжении 100 кВ (W-источник) в Институте физики им. Л.В. Киренского ФИЦ КНЦ СО РАН. Образцы были подготовлены при помощи системы фокусируемого ионного пучка (однолучевой FIB, Hitachi FB2100) при ускоряющем напряжении 40 кВ. Толщина подготовленных таким способом образцов составила ~40–50 нм. Для защиты от травления пучком ионов Ga+ поверхность тонких пленок (In2O3/С)74 покрывалась слоем напыленного термическим способом аморфного Ge.
Удельное электрическое сопротивление и термо-ЭДС измеряли по методике [17].
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Структура полученных образцов. Анализ картин рентгеновской дифракции от тонких пленок In2O3 и C, полученных при напылении на вращающуюся подложку (рис. 1), показал, что пленки In2O3 имеют поликристаллическую, а углеродные – аморфную структуру [18, 19 ] . Результаты рентгенофазового анализа пленок (In2O3/С)74 показали, что во всех исследованных образцах присутствует значительное количество рентгеноаморфной фазы. Кристаллическая составляющая в виде дифракционных максимумов наиболее ярко проявляется в пленках толщиной более 80 нм (рис. 2a) и относится к фазе In2O3 с кубической кристаллической решеткой (пр. гр. Ia3). Расчеты среднего размера областей когерентного рассеяния (ОКР), проведенные по формуле Шеррера
где λ – длина волны рентгеновского излучения (1.54 Å для СuKα1-излучения), b – ширина рефлекса на полувысоте, θ – брэгговский угол, позволили получить значения 19 и 12 нм для образцов с толщинами 90 и 121 нм [18 ] . Полученные значения размеров кристаллитов In2O3 значительно превышают соответствующие этим же образцам рассчитанные значения эквивалентной толщины бислоя. Таким образом, протяженные слои In2O3 и С для указанных эквивалентных толщин бислоя не были сформированы и структуру тонких пленок (In2O3/С)74 можно характеризовать как композит, состоящий из двух фаз: кристаллов In2O3 нанометрового размера и областей аморфного углерода. Анализ картин дифракции рентгеновских лучей в области малых углов подтвердил, что для всех исследованных в работе тонких пленок (In2O3/С)74 слоистая структура не наблюдалась, на что указывает отсутствие дифракционных максимумов (рис. 2б).Чтобы убедиться в отсутствии многослойности в полученной системе, были проведены исследования поперечного сечения образцов методом ПЭМ, результаты которых подтвердили ранее сделанный вывод о нанокристаллической структуре тонких пленок (рис. 3а), а также справедливость оценки толщины пленок на основании измерений, предварительно сделанных с помощью интерферометра МИИ-4. Методом дифракции электронов также были выявлены фазы кристаллического In2O3 и аморфного углерода, на что указывает наличие широкого гало (рис. 3б).
Рис. 3.
ПЭМ-снимок поперечного сечения тонких пленок (а) и электронограмма (In2O3/С)74 (б) (h = 132 нм).

Поскольку исследуемые тонкие пленки (In2O3/ С)74 являются композитами, их электрофизические свойства должны зависеть главным образом не от эквивалентной толщины бислоя, а от общей толщины пленки.
Электрические свойства пленок (In2O3/С)74 в области низких температур. Для анализа влияния углерода на электрические свойства исследуемых пленок (In2O3/С)74 были проведены измерения удельного электрического сопротивления и термо-ЭДС (рис. 4) при комнатной температуре. Добавление углерода приводит к увеличению удельного электрического сопротивления пленок (In2O3/С)74 почти на порядок по сравнению с чистым In2O3 для всех толщин. Вместе с тем удельное электрическое сопротивление пленок (In2O3/С)74 остается ниже, чем в пленках чистого углерода и с ростом толщины уменьшается с 2.5 Ом см при толщине 30 нм до 4 × 10–3 Ом см при толщине 135 нм (рис. 4а). C ростом толщины пленок (In2O3/С)74 также уменьшается величина термо-ЭДС: с 75 мкВ/К при толщине 30 нм до 28 мкВ/К при толщине 130 нм (рис. 4б). Знак термо-ЭДС отрицательный, что свидетельствует об электронном типе проводимости.
Рис. 4.
Зависимости удельного электрического сопротивления (а) и термо-ЭДС (б) от толщины тонких пленок C (1), In2O3 (2) и (In2O3/C)74 (3), измеренные при комнатной температуре.
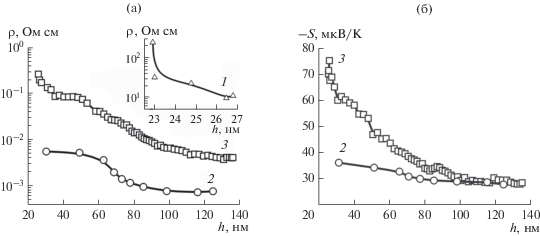
Анализ полученных результатов показал, что пленка (In2O3/C)74 сформирована островковыми слоями нанокристаллического In2O3 и аморфного углерода для всех исследованных толщин, что эквивалентно образованию двухфазной системы (рис. 3). В этом случае при h < 70 нм островки отдельных фаз хаотически распределены в объеме тонкой пленки (In2O3/C)74 и электрическая проводимость будет определяться отношением содержания наиболее проводящей фазы In2O3 (кривая 2 на рис. 4а) к наименее проводящей фазе углерода (кривая 1 на рис. 4а). С ростом толщины пленки, при h > 70 нм, размеры островков в прослойках In2O3 и углерода увеличиваются, кристаллики In2O3 соприкасаются, образуя квазидвумерный перколяционный кластер, что приводит к уменьшению удельного электрического сопротивления пленки (кривая 3 на рис. 4а). Другими словами, при h < 70 нм в данной двухфазной системе при наличии островков углерода реализуются условия сильной локализации на межфазных границах полупроводниковой многослойной структуры при наличии хаотического потенциала, обусловленного случайно распределенными сосредоточенными зарядами в области пространственного заряда [20]. При h > 70 нм электрическая проводимость будет определяться проводимостью перколяционных кластеров, образованных кристаллитами In2O3. Поэтому анализ механизмов проводимости проведем отдельно для тонких пленок с h < 70 нм и пленок с h > 70 нм.
Для установления доминирующих механизмов электропереноса в полученных образцах были исследованы температурные зависимости удельного электросопротивления ρ(T) в интервале от 80 до 300 K (рис. 5). Для пленок (In2O3/C)74 толщиной h = 43 нм и h = 65 нм полученные экспериментальные зависимости ρ(T) были перестроены в координатах lnρ ∼ f(1/Tn) (где n – 1/4, 1/2, 1). Установлено, что в температурном интервале от 80 до 120 K зависимости ρ(T) описываются прямой линией в координатах lnρ ~ f(1/T1/4) (рис. 6а), что указывает на прыжковый механизм проводимости носителей заряда с переменной длиной прыжка по локализованным состояниям, лежащим в узкой полосе энергий вблизи уровня Ферми [21]. Тогда, согласно [21], выражение для электрической проводимости имеет следующий вид:
(2)
$\sigma = {{e}^{{\text{2}}}}{{{\text{R}}}^{{\text{2}}}}{{\nu }_{{ph}}}g{\text{exp}}{{\left( { - \frac{B}{T}} \right)}^{{{1 \mathord{\left/ {\vphantom {1 4}} \right. \kern-0em} 4}}}},$(4)
$R = {{\left[ {\frac{3}{{2\pi ag\left( {{{E}_{F}}} \right)kT}}} \right]}^{{{1 \mathord{\left/ {\vphantom {1 4}} \right. \kern-0em} 4}}}},$Рис. 5.
Температурные зависимости электрического сопротивления для тонких пленок (In2O3/C)74 различной толщины: 1 – 43 нм, 2 – 65 нм, 3 – 97 нм, 4 – 119 нм, 5 – 135 нм.
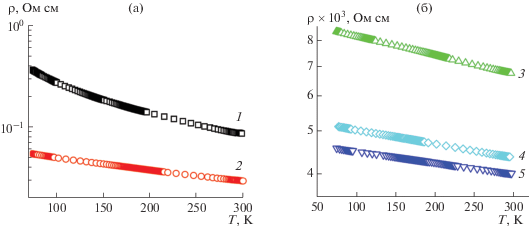
Рис. 6.
Зависимости lnρ ∼f(1/T1/4) (а) и lnρ ∼f(103/T) (б) для тонких пленок (In2O3/C)74 различной толщины: 1 – 43 нм, 2 – 65 нм.

Из рис. 6а были определены значения величины B в уравнении (2). Предполагая, что процесс переноса заряда лимитируется прыжками между оборванными связями индия, для оценки плотности локализованных состояний принимаем радиус локализации равным среднему размеру кристаллитов In2O3 – ≈12 нм. Значения плотности состояний на уровне Ферми g(EF), полученные из выражений (2)–(4), для пленок (In2O3/C)74 толщиной 43 и 65 нм приведены в табл. 1. Видно, что с увеличением толщины пленок (In2O3/C)74 значения g(EF) стремятся к характерным для пленок In2O3 – 1020–1021 эВ–1 см–3 [22].
Таблица 1.
Параметры тонких пленок (In2O3/С)74, рассчитанные на основе моделей прыжковой проводимости электронов с переменной длиной прыжка по локализованным состояниям, лежащим в узкой полосе энергий вблизи уровня Ферми (T = 80–120 К), по ближайшим соседям (T = 120–250 К) и по локализованным состояниям в хвосте зоны проводимости (T = = 250–300 К)
| h, нм | g(EF), эВ–1 см–3 | WNNH, эВ | R0, нм | Ea, эВ |
|---|---|---|---|---|
| 43 | 5.75 × 1018 | 0.013 | 14.7 | 0.058 |
| 65 | 8.63 × 1020 | 0.015 | 3.8 | 0.029 |
Температурные зависимости электрического сопротивления в интервале от 120 до 250 K описываются моделью прыжковой проводимости по ближайшим соседям [21], согласно которой должно выполняться равенство
Здесь WNNH – энергия активации прыжка по ближайшим соседям
где R0 – среднее расстояние между ближайшими соседями.Используя формулы (5) и (6) и учитывая полученное ранее значение g(EF), из низкотемпературного участка рис. 6б оценили WNNH и R0. Результаты таких оценок для тонких пленок (In2O3/C)74 приведены в табл. 1.
В интервале температур 250–300 K зависимости удельного электрического сопротивления также имеют линейные участки в координатах lnρ ~f(103/T) (рис. 6б). Тогда, согласно [21], справедливо уравнение
где Ea – энергия активации электрической проводимости. Используя уравнение (7), рассчитали энергию активации проводимости (табл. 1).Экспериментальные зависимости удельного электрического сопротивления от температуры для пленок (In2O3/C)74 толщиной h > 70 нм, когда формируются перколяционные кластеры In2O3, удовлетворительно спрямляются в координатах ρ ~ f(T) (рис. 5б). В этом случае температурная зависимость электрического сопротивления аналогична ρ(T) для аморфных металлических сплавов металл–металлоид [23], когда вклад фононного рассеяния носителей в зависимость ρ ~ f(T) мал. С другой стороны, отрицательный температурный коэффициент удельного электрического сопротивления может быть связан с переходом от сильной локализации в случае пленки из островковых слоев при h < 70 нм к слабой локализации носителей заряда при h > 70 нм, когда уменьшение удельного электрического сопротивления связывают с квантовой интерференцией волновых функций невзаимодействующих электронов и возрастанием роли межэлектронного взаимодействия [24].
Отметим, что линейная зависимость электрического сопротивления от температуры имеет большое практическое значение при разработке датчиков температуры и наблюдается в тонких пленках из углеродных нанотрубок [25].
Влияние термообработки на структуру пленок (In2O3/C)74. Для исследования влияния термической обработки на стабильность структуры тонких пленок (In2O3/C)74 был проведен ступенчатый отжиг в вакууме (p < 70 Па) при температурах tт от 250 до 600°C с шагом 50°C в течение 30 мин. Аналогичной термообработке подвергались также тонкие пленки In2O3 без углерода. После термической обработки размер кристаллитов In2O3 как для тонких пленок In2O3 без углерода, так и для (In2O3/C)74 увеличивается, что следует из увеличения интенсивности и уменьшения уширения дифракционных максимумов фазы In2O3, а также уменьшения интенсивности гало от рентгеноаморфной составляющей (рис. 7); при этом увеличение температуры отжига сопровождается ростом среднего размера кристаллитов In2O3 (рис. 8). Несколько неожиданным результатом является то, что размеры кристаллитов в более тонких пленках имеют больший размер, чем в более толстых (кривые 2 и 3 на рис. 8), что может быть связано с увеличением толщины углеродной прослойки в более толстых пленках.
Рис. 7.
Картины дифракции рентгеновских лучей от тонких пленок (In2O3/С)74 толщиной 50 нм в исходном состоянии и после термической обработки при различных температурах в течение 30 мин.

Рис. 8.
Зависимости среднего размера кристаллитов In2O3 от температуры термообработки для тонких пленок In2O3 (1) и (In2O3/С)74 с h = 51 нм (2) и h = 121 нм (3).

Также из рис. 8 можно сделать вывод, что влияние температуры на рост кристаллитов In2O3 в пленках (In2O3/С)74 в процессе рекристаллизации значительно меньше, чем в пленках In2O3. Особенно сильно этот эффект проявляется при tт > 450°C, когда начинается процесс наиболее интенсивного роста среднего размера кристаллитов в пленках чистого In2O3 (кривая 1 на рис. 8) [26].
Таким образом, термическая обработка тонких пленок (In2O3/С)74 в вакууме при температурах не более 600°C показала, что влияние температуры на процесс рекристаллизации в них значительно менее выражено, чем в пленках чистого In2O3.
ЗАКЛЮЧЕНИЕ
В результате послойного осаждения In2O3 и C с применением ионно-лучевого распыления формируется пленка композита, состоящего из двух фаз: наноразмерных кристаллов In2O3 и аморфного углерода. Установлено, что для тонких пленок (In2O3/С)74 с толщиной h < 70 нм в интервале температур 80–300 K наблюдается последовательная смена доминирующего механизма электропереноса от прыжков с переменной длиной моттовского типа к прыжкам по ближайшим соседям, а затем прыжкам с переменной длиной по локализованным состояниям в хвосте зоны проводимости при температурах, близких к комнатной. Для пленок (In2O3/С)74 с толщиной h > 70 нм в интервале температур от 80 до 300 K наблюдается линейное изменение электрического сопротивления с отрицательным температурным коэффициентом, что связывается с наличием перколляционных кластеров, образованных нанокристаллами In2O3.
Термическая обработка тонких пленок (In2O3/ С)74 в вакууме при температурах не более 600°C приводит к рекристаллизации и увеличению размера кристаллитов In2O3, однако влияние температуры на процесс рекристаллизации значительно менее выражено, чем в пленках чистого In2O3.
Список литературы
Rakesh A., Sharma N., Maheshwar Sh., Sharon M. Transparent Conducting Oxide Films for Various Applications: a Review // Rev. Adv. Mater. Sci. 2018. V. 53. № 1. P. 79–89. https://doi.org/10.1515/rams-2018-0006
Morales-Masis M., De Wolf S., Woods-Robinson R., Ager J. W., Ballif C. Transparent Electrodes for Efficient Optoelectronics // Adv. Electron. Mater. 2017. V. 3. № 5. P. 1600529. https://doi.org/10.1002/aelm.201600529
Ramanujam J., Verma A., Gonzalez-Diaz B, Guerrero-Lemus R. Inorganic Photovoltaics - Planar and Nanostructured Devices // Prog. Mater. Sci. 2016. V. 82. P. 294–404. https://doi.org/10.1016/j.pmatsci.2016.03.005
Korotcenkov G., Brinzari V., Cho B.K. In2O3 – and SnO2-Based Thin Film Ozone Sensors: Fundamentals // J. Sensors. 2016. P. 3816094. https://doi.org/10.1155/2016/3816094
Derek M.R., Sheikh A.A., Patricia M.A. Nanoscale Metal Oxide-Based Heterojunctions for Gas Sensing: A Review // Sens. Actuators. B. Chem. 2014. V. 204. P. 250–272. https://doi.org/10.1016/j.snb.2014.07.074
Sanctis S., Krausmann J., Guhl C. Stacked Indium Oxide/Zinc Oxide Heterostructures as Semiconductors in Thin Film Transistor Devices: A Case Study Using Atomiclayer Deposition // J. Mater. Chem. 2018. V. 6. P. 464–472. https://doi.org/10.1039/C7TC03724D
Park J.W., So H.S., Lee H.M., Kim H.J., Kim H.K., Lee H. Transition from a Nanocrystalline Phase to an Amorphous Phase in In–Si–O Thin Films: The Correlation between the Microstructure and the Optical Properties // J. Appl. Phys. 2015. V. 117. P. 155305. https://doi.org/10.1063/1.4918658
Mitoma N., Aikawa S., Gao X., Kizu T., Shimizu M., Lin M.F., Nabatame T., Tsukagoshi T. Stable Amorphous In2O3-Based Thin-Film Transistors by Incorporating SiO2 to Suppress Oxygen Vacancies // Appl. Phys. Lett. 2014. V. 104. P. 102103. https://doi.org/10.1063/1.4868303
Del Valle J., Ramírez J.G., Rozenberg M.J., Schuller I.K. Challenges in Materials and Devices for Resistive-Switching-Based Neuromorphic Computing // J. Appl. Phys. 2018. V. 124. P. 211101. https://doi.org/10.1063/1.5047800
Zhilova O.V., Pankov S., Sitnikov A.V., Kalinin Yu.E., Kashirin M.A., Makagonov V.A. Optical and Electrical Properties of Thin-Film Hetero-Structures of the In2O3–ZnO System // Mater. Res. Express. 2019. V. 6. P. 086330. https://doi.org/10.1088/2053-1591/ab2721
Lee S.J., Hwang C.S., Pi J.E., Yang J.H., Byun C.W., Chu H.Y., Cho K.I., Cho S.H. High-Performance Amorphous Multilayered ZnO–SnO2 Heterostructure Thin-Film Transistors: Fabrication and Characteristics // ETRI J. 2015. V. 37. P. 1135‑1142. https://doi.org/10.4218/etrij.15.0114.0743
Zhilova O.V., Pankov S.Yu., Sitnikov A.V., Kalinin Yu.E., Volochaev M.N., Makagonov V.A. Structure and Electrophysical Properties of Thin‑Film SnO2–In2O3 Heterostructures // J. Mater. Sci. – Mater. Electron. 2019. V. 30. P.1185911867. https://doi.org/10.1007/s10854-019-01503-w
Cui G., Han D., Dong J., Cong Y., Zhang X., Li H., Yu W., Zhang S, Zhang X., Wang Y. Effects of Channel Structure Consisting of ZnO/Al2O3 Multilayers on Thin-Film Transistors Fabricated by Atomic Layer Deposition // Jpn. J. Appl. Phys. 2017. V. 56. P. 04CG03. https://doi.org/10.7567/JJAP.56.04CG03
Калинин Ю.Е., Жилова О.В., Бабкина И.В., Ситников А.В., Макагонов В.А., Ремизова О.И. Влияние термообработки на электрические свойства тонких пленок In2O3, легированных иттрием // Неорган. материалы. 2018. Т. 54. №. 9. С. 936–942. https://doi.org/10.1134/S0020168518090030
Suchea M., Katsarakis N., Christoulakis S., Nikolopoulou S., Kiriakidis G. Low Temperature Indium Oxide Gas Sensors // Sens. Actuators, B. 2006. V. 118. P. 135–141. https://doi.org/10.1016/j.snb.2006.04.020
Rylkov V.V., Nikolaev S.N., Chernoglazov K.Yu., Demin V.A., Sitnikov A.V., Presnyakov M.Yu., Vasiliev A.L., Perov N.S., Vedeneev A.S., Kalinin Yu.E., Tugushev V.V., Granovsky A.B. Tunneling Anomalous Hall Effect in Nanogranular CoFe-B-Al-O Films near the Metal-Insulator Transition // Phys. Rev. B: Condens. Matter. 2017. V. 95. P. 144202 (1–12). https://doi.org/10.1103/PhysRevB.95.144202
Калинин Ю.Е., Каширин М.А., Макагонов В.А., Панков С.Ю., Ситников А.В. Электрические свойства тонких пленок аморфного углерода, полученных методом ионно-лучевого напыления // ЖТФ. 2017. Т. 87. № 11. С. 1722–1728. https://doi.org/10.21883/JTF.2017.11.45137.2248
Zhilova O.V., Pankov S.Yu., Sitnikov A.V., Kalinin Yu.E., Babkinа I.V. The Structure and the Gas Sensetive Properties of the Thin Films of Zinc Oxide // AIP Conf. Proc. 2017. V. 1886. Р. 020054. https://doi.org/10.1063/1.5002951
Zhilova O.V., Pankov S.Y., Sitnikov A.V., Kalinin Y.E., Babkina I.V. The Structure and Electrical Properties of In2O3–C Heterogeneous System // AIP Conf. Proc. 2018. V. 2015. P. 020123. https://doi.org/10.1063/1.5055196
Бондаренко В.Б., Филимонов А.В. Критерий сильной локализации на поверхности полупроводника в приближении Томаса−Ферми // ФТП. 2017. Т. 51. №. 10. С. 1372–1375. https://doi.org/10.21883/FTP.2017.10.45015.8507
Мотт Н., Дэвис Э. Электронные процессы в некристаллических веществах: в 2 т. М.: Мир, 1982. Т. 1. 658 с.
Lin J.J., Li Z.Q. Electronic Conduction Properties of Indium Tin Oxide: Single-Particle and Many-Body Transport // J. Phys.: Condens. Matter. 2014. V. 26. № 34. P. 343201. https://doi.org/10.1088/0953-8984/26/34/343201
Судзуки К., Фудзимори Х., Хасимото К. Аморфные металлы. М.: Металлургия, 1987. 328 с.
Полянская Т.А., Шмарцев Ю.В. Квантовые поправки к проводимости в полупроводниках с двумерным и трехмерным электронным газом // ФТП. 1989. Т. 23. № 1. С. 3–32.
Bartolomeo D., Sarno M., Giubileo F., Altavilla C., Iemmo L., Piano S., Bobba F., Longobardi M., Scarfato A., Sannino D., Cucolo A.M., Ciambelli P. Multiwalled Carbon Nanotube Films as Small-Sized Temperature Sensors // J. Appl. Phys. 2009. V. 105. P. 064518. https://doi.org/10.1063/1.3093680
Жилова О.В., Макагонов В.А., Панков С.Ю. Структура тонких пленок широкозонных полупроводников In2O3, ZnO, модифицированных углеродом // Вест. ВГТУ. 2018. Т. 14. № 4. С. 168–173.
Дополнительные материалы отсутствуют.
Инструменты
Неорганические материалы




