Неорганические материалы, 2020, T. 56, № 9, стр. 979-985
О структурном совершенстве слитков карбида кремния большого диаметра
Ю. О. Быков 1, *, А. О. Лебедев 1, 2, М. П. Щеглов 2
1 Санкт-Петербургский государственный электротехнический университет “ЛЭТИ” им. В.И. Ульянова (Ленина)
197376 Санкт-Петербург, ул. проф. Попова, 5, Россия
2 Физико-технический институт им. А.Ф. Иоффе Российской академии наук
194021 Санкт-Петербург, Политехническая ул., 26, Россия
* E-mail: siclab-tairov@yandex.ru
Поступила в редакцию 02.03.2020
После доработки 02.04.2020
Принята к публикации 10.04.2020
Аннотация
Модифицированным методом Лели (методом ЛЭТИ) на затравках диаметром 100 мм выращены слитки карбида кремния политипа 4H высокого структурного совершенства. На основе собственных экспериментальных данных и теоретического анализа систематизированы главные факторы, приводящие к деградации кристаллической структуры выращенных слитков в процессе роста. Показано, что появление на ранних стадиях роста паразитных политипных включений приводит к возникновению в слитке антифазных границ и блочной субструктуры.
ВВЕДЕНИЕ
Карбид кремния используется для создания приборов силовой, высокочастотной и высокотемпературной электроники [1]. Монокристаллические слитки карбида кремния обычно выращивают методом сублимации на собственных затравках (модифицированный метод Лели, или метод ЛЭТИ) в вакууме или инертном газе (обычно в аргоне) при температуре порядка 2000°С и выше [2]. Важной особенностью карбида кремния является его способность кристаллизоваться в большом количестве родственных структур, так называемых политипов [3]. В настоящее время таких политипов известно более 200, тем не менее, для роста промышленных слитков большого диаметра применяют только два – 4H и 6H.
Для выращивания слитков политипов 4H и 6H используют затравки кристаллографических ориентаций (000$\bar {1}$)C и (0001)Si соответственно. Вследствие близости параметров политипов в слитках часто появляются паразитные политипные включения, приводящие к деградации выращенных монокристаллов [4]. Так, для слитков политипа 4H характерно появление включений 6H-, 15R- и 3С-политипов (последний – при сравнительно невысоких температурах, <1900°С). Кроме политипных включений, слитки SiC как правило характеризуются развитой дислокационной структурой, включающей базисные и прорастающие дислокации, в том числе с полым ядром (т.н. микропоры) [1].
Контроль за дефектной структурой слитков, особенно при выращивании на затравках большой площади, является важнейшей технологической задачей.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Объемные монокристаллы SiC политипа 4H выращивали, используя модифицированный метод Лели (метод ЛЭТИ), в реакторе с резистивным нагревом тигля, при рабочей температуре 2100–2150°С и скоростях роста 0.3–0.5 мм/ч. Тигель был выполнен из плотного конструкционного графита (марки МПГ-7) и имел диаметр 200 мм. Слитки имели диаметр 100–110 мм. В процессе роста выполняли легирование слитков азотом (концентрация 1018–5 × 1018 см–3, оценка по данным оптического поглощения [5]). Суммарное время роста составляло 55–60 ч.
Исходные затравки имели диаметр 100–105 мм, толщину 0.6 мм и ориентацию (000$\bar {1}$)С с отклонением в 4° в направлении [2$\bar {1}$$\bar {1}$0] (off-cut (0001)-затравки). Для выращивания слитков затравки предварительно подвергали полирующему травлению в жидкостном щелочном травителе (NaOH : KOH = = 1 : 1 (моли), t = 420–440°С, продолжительность травления 20–40 мин). Обратную сторону затравки, не предназначенную для роста слитка, – (0001)Si пассивировали нанесением углеродсодержащего состава для исключения прорастающих дефектов и обеспечения однородного теплового контакта с элементами графитовой арматуры [6]. Затравки содержали протяженные дефекты в соответствии со спецификацией: микропоры <5 см–2, плотность дислокаций <5 × 103 см–2. Затравки фиксировали на держателе без использования клея, контакт затравки с поверхностью держателя обеспечивался механическим поджатием.
В качестве источника карбида кремния использовали высокочистый порошок SiC производства фирмы Taiheiyo Cement Corp. (Япония).
Полученные слитки подвергали отжигу при температуре 1100–1300°С в вакууме для снижения уровня упругих напряжений и предупреждения разрушения слитков при дальнейшей механической обработке. Слитки калибровали под диаметр 100 мм и распиливали на пластины. Пластины подвергали двустороннему шлифованию с применением алмазных паст с постепенным уменьшением размера зерна. Поверхности (000$\bar {1}$)С пластин, предназначенных для использования в качестве затравок при выращивании слитков, подвергали финишному полированию на алмазных пастах с размером зерна 0.25 мкм.
Для выявления дефектной структуры пластин их подвергали селективному травлению в щелочном травителе (KOH, t = 450°С, 10 мин). Дефектную структуру анализировали с использованием оптической микроскопии (средние плотности дефектов на поле визирования единичной площади).
Для выявления и идентификации политипных включений использовали различную флуоресценцию политипов 4H, 6H и 15R под действием УФ-облучения (длина волны излучения λ = 365 нм).
Структурное совершенство пластин 4Н-SiC оценивали как по полуширинам кривых дифракционного отражения рентгеновского излучения, так и на основе построения карт контуров равной интенсивности в обратном пространстве. Измерения проводили на базе трехкристального рентгеновского дифрактометра, в качестве монохроматора и анализатора использовали кристаллы Ge (001) (рефлекс 004 для CuKα1-излучения). Выбранная геометрия дифракции для всех используемых рефлексов позволяет получить высокое разрешение при измерениях за счет минимальной угловой дисперсии.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Полученные слитки имеют толщины от 16 до 25 мм и слабовыпуклый фронт роста (рис. 1). На поверхности в целом отсутствуют структурные особенности, за исключением мест выходов отдельных дислокаций и ростовой фасетки, соответствующей грани (000$\bar {1}$)С. Рельеф поверхности (0001)Si пластин SiC после селективного травления представлен на рис. 2. Кроме растрава однородного рельефа, характерного для шлифования мелким алмазным порошком, наблюдаются базисные и прорастающие дислокации различных видов (в соответствии с классическими представлениями, форма ямки травления соотносится с направлением линии дислокации, а размер ямки травления коррелирует с величиной вектора Бюргерса). Суммарная плотность дислокаций составляет 102–5 × 103 см–2, причем количество прорастающих дислокаций достигает 80% от общего числа дислокаций.
Рис. 1.
Общий вид слитков (буквой Ф обозначена ростовая фасетка, соответствующая истинной плоскости): а – вид сверху, б – вид сбоку.

Рис. 2.
Микрофотография поверхности типовой пластины (0001)Si (селективное травление в расплаве щелочи): П – прорастающие, Б – базисные дислокации.

По собственным экспериментальным данным выполняли систематизацию факторов, приводящих к ухудшению структурного совершенства выращенных слитков. Как известно, деградация структуры слитка карбида кремния при увеличении размеров затравочных кристаллов может быть связана с большим числом эффектов [7], таких как испарение затравки, недостаточно однородный тепловой контакт затравки с держателем, инжекция микрочастиц графита и прорастание поликристаллических включений в монокристаллический слиток, включения паразитных политипов и т.д.
Испарение затравки. Испарение участков обратной стороны затравочного монокристалла, прилегающего к держателю, приводит к нарушению целостности затравки и деградации растущего слитка. Это явление, характерное для ранних стадий монокристаллического роста слитков SiC, наблюдается при отсутствии пассивации обратной стороны затравки, а объясняется неточной фиксацией затравки на графитовом держателе и наличием массопереноса в микрозазорах между держателем и затравкой в условиях существования температурных градиентов [6]. В то же время, пассивирующее покрытие должно не только препятствовать испарению затравки, но и обеспечивать однородный тепловой контакт держатель–затравка по всей площади роста кристалла во избежание появления локальных вогнутых участков, которые в свою очередь приводят к появлению малоугловых границ и политипных включений [7].
Инжекция макрочастиц графита. Инжекция макрочастиц графита в растущий слиток наблюдается как из обуглероженного источника карбида кремния, так и со стенок графитового тигля. Микрочастицы графита приводят к возникновению микропор или кустов дислокаций. Сценарии процесса заброса частиц графита посредством термофоретической силы и силы Стокса, а также возможности для минимизации эффекта рассмотрены нами ранее [8].
Наиболее интенсивный перенос графита из источника наблюдается при высоких степенях износа источника (рис. 3), т.е. при появлении на поверхности источника большой массы мелкодисперсного несвязанного графита (при изменении массы источника на величину более 40% от первоначальной). Внедрение частиц графита приводит к появлению на поверхности каверн различного диаметра, а также к возникновению дефектов при зарастании каверн (кустов дислокаций и микропор). Инжекция микрочастиц графита со стенок графитового тигля в растущий кристалл также возможна при коррозионном износе стенок вследствие взаимодействия с элементами газовой фазы внутри тигля (Si, Si2C, SiC2). Для предотвращения инжекции наиболее важными факторами являются: использование для создания арматуры наиболее плотных марок графита (с плотностью 1.85 г/см3 и более), пассивация элементов графитовой арматуры [9] и снижение температурных градиентов в ростовом тигле.
Рис. 3.
Инжекция микрочастиц графита на поверхность слитка: а – общий вид поверхности (включения показаны стрелками), б – микрофотография группы каверн (К).
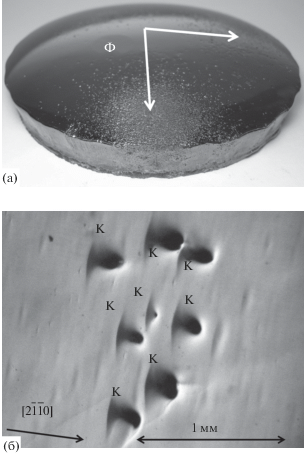
Политипные включения в слитках карбида кремния. Включения имеют политип 6H (реже – 15R или даже 3С) и возникают, по нашим наблюдениям, при взаимодействии края кристалла с поликристаллическим окружением на ранних стадиях роста слитка, обычно вблизи фасетки (рис. 4а). Область вблизи фасетки наиболее благоприятна для инжекции поликристалла в монокристаллический слиток вследствие послойного роста на off-cut-затравке (рис. 4б). Далее, политипное включение [$\bar {2}$110] “движется” в направлении азимута и исчезает на противоположном краю слитка. После исчезновения политипного включения на поверхности слитка формируются протяженные дефекты, напоминающие трещины и ориентированные вдоль азимута (азимут отклонения грани затравки от истинной ориентации (0001)). В объеме слитка такому морфологическому дефекту всегда соответствует двумерный кристаллографический дефект в виде разрыва на участке плоскости (01$\bar {1}$0). Экспериментально установлено, что появление таких дефектов всегда связано с политипными включениями в процессе роста слитка. В случае 15R-включений морфологические дефекты наблюдаются всегда, 6H-включения иногда могут не сопровождаться появлением таких дефектов.
Рис. 4.
Деградация слитка вследствие появления политипного включения: а – общий вид слитка (ЗВ – место зарождения включения в слитке, Ф – ростовая фасетка (000$\bar {1}$)С, МД – морфологический дефект), б – схематичный вид сбоку на растущий слиток (ФО – графитовый формообразователь, SiC – слиток карбида кремния), в – схематичный вид поверхности слитка сверху (ФР – фронты роста антифазных доменов 4H-SiC на поверхности слитка).
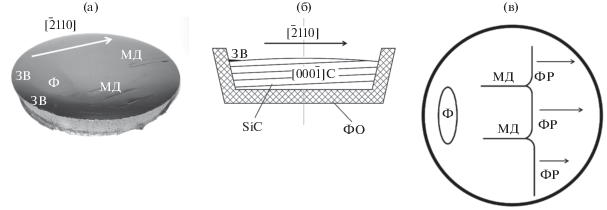
Известно, что появление и последующее исчезновение паразитного политипного включения в условиях полицентричной нуклеации приводит к образованию нескольких антифазных доменов политипа 4H [10] вследствие различной точечной или пространственной симметрии политипов основного кристалла (4H) и включений (6H, 15R или 3С). Эти антифазные домены имеют такую же политипную последовательность укладки слоев, как и исходный домен, но смещенную в пространстве относительно исходного домена в направлении [0001] или в плоскости (0001) на вектор, меньший решеточного. Образующийся закономерный сросток может быть охарактеризован некоторой пространственной группой симметрии, являющейся расширением групп симметрии обоих кристаллов (политипа 4H и включения).
Легко показать [10], что после прохождения политипа 6H в структуре политипа 4H должны возникать 4 неэквивалентных антифазных домена. При их срастании образуются 2 типа доменных границ, а вероятность бездефектного срастания доменов составляет 25% (при равновероятном появлении всех 4 доменов). В случае появления включения политипа 15R или 3С число антифазных доменов в структуре 4H – 12, количество типов двойных границ – 5, а вероятность бездефектного срастания двух доменов составляет всего 8.3% [10].
В случае использования off-cut-подложки при послойном росте возникающие антифазные границы должны формироваться преимущественно в направлении азимута отклонения плоскости затравки от истинной, т.е. [2$\bar {1}\bar {1}$0], при срастании фронтов роста антифазных доменов (схематично представлено на рис. 4в), что и наблюдается экспериментально. Для включений политипа 6H вероятность бездефектного срастания доменов высока (25%), что приводит в ряде случаев к появлению на практике политипных сростков (4H + 6H) без видимых морфологических дефектов.
Для определения динамики структурных превращений в процессе роста слитка было проведено сравнительное исследование типовых пластин карбида кремния, вырезанных из слитка без политипных включений и из слитка после “прохождения” политипного включения 6H (образец 1 и образец 2 соответственно). Морфология картин селективного травления образца 1 характеризуется однородным распределением дислокаций, причем их плотность примерно соответствует затравочному кристаллу (не более 5 × 103 см–2) (рис. 2). Плотность микропор не превышает 2 см–2. В образце 2 прохождение политипного включения приводит к увеличению суммарной плотности дислокаций на 1.5–2 порядка, в первую очередь за счет увеличения базисных дислокаций. Базисные дислокации полигонизуются, формируя многочисленные субзеренные границы, ориентированные вдоль азимута [01$\bar {1}$0] (рис. 5). На более поздних стадиях роста слитка часть базисных дислокаций трансформируется в прорастающие.
Рис. 5.
Микрофотография поверхности пластины (0001)Si после прохождения политипного включения (селективное травление в расплаве щелочи), штриховыми линиями обозначены направления малоугловых границ.

Параметры решетки обоих образцов, определенные в нескольких точках с использованием рентгеновских рефлексов 0008 и 01$\bar {1}$7, даже с учетом разброса соответствуют политипу 4H. Параметр a практически одинаков для двух образцов, но характеризуется большим разбросом от точки к точке (от 3.0798 до 3.0807 Å). Параметр с образца 2 значительно больше (с = 10.1156 ± 0.0002 Å), чем у образца 1 (с = 10.0847 ± 0.0002 Å).
Типовые двухкристальные кривые качания рефлексов 0008 и 01$\bar {1}$7 (CuKα1-излучение) для образцов 1 и 2 представлены на рис. 6. Полуширины пиков симметричного рефлекса 0008, зафиксированные на различных участках образцов, составляли 15"–20" и 20"–25" соответственно (рис. 6а), что отвечает достаточно высокому уровню упорядочения обеих структур вдоль оси с. Для асимметричного рефлекса 01$\bar {1}$7 типовые полуширины для образца 1 составляли 20"–25", для образца 2 они были существенно больше (40"–50"), причем кривые качания в ряде случаев приобретали явную асимметрию (рис. 6б), вероятно, вследствие существования блочной структуры.
Рис. 6.
Кривые качания для образцов 1 и 2 (пояснения в тексте): а – рефлекс 0008, б – 01$\bar {1}$7.

Наиболее полное представление о структурных искажениях решетки было получено на основе карт контуров равной интенсивности дифрагированного рентгеновского излучения вблизи узла обратной решетки (рис. 7). Точка начала координат соответствует главному пиковому максимуму. Отклонение вдоль оси qx связано с изменением интенсивности рассеяния вследствие поворота образца (ω-сканирование образца) и определяется искажениями ориентационного характера. Отклонение вдоль оси qz происходит при отклонении анализатора-детектора (θ/2θ-сканирование) и вызывается в первую очередь искажениями дилатационного характера.
Рис. 7.
Карта контуров равной интенсивности для узла обратной решетки: а – образец 1, б – образец 2.
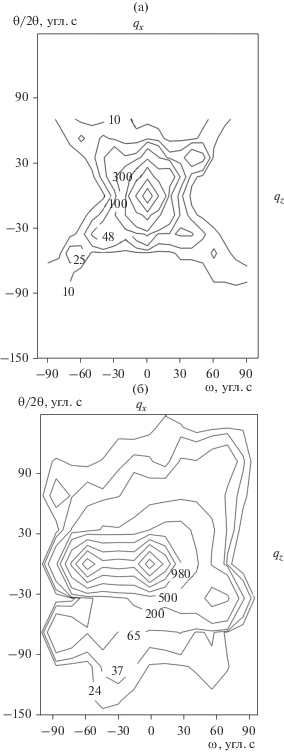
Как видно из рис. 7а, образцы без политипных включений (образец 1) характеризуются незначительным вкладом мозаичности (малое размытие узла по оси абсцисс). В то же время в образце присутствуют микродеформации, приводящие к размытию узла по оси ординат (по параметру решетки). Вклад мозаичности для образца 1 для узлов 01$\bar {1}$7 и 0008 (контуры для рефлекса 0008 на рис. 7а не представлены) не превышает значения 8"–10", что характеризует достаточно высокое качество кристаллической структуры. Более высокие значения полуширин кривых качания (от 15" до 25") определяются только вкладом флуктуаций по параметру решетки.
Для образцов, в которых на ранних этапах роста присутствовали политипные включения (образец 2), подтверждается существование блочной субструктуры (на рис. 7б два максимума при одном и том же значении двойного брэгговского угла 2θ). Типовые значения углов мозаичности составляли 1'–2'.
ЗАКЛЮЧЕНИЕ
Слитки карбида кремния политипа 4H были выращены с использованием модифицированного метода Лели на затравках диаметром 100 мм. Основными факторами, приводящими к деградации структурного совершенства слитка на затравках большой площади, являются: испарение обратной стороны затравочного монокристалла, неоднородный тепловой контакт затравки с держателем, инжекция микрочастиц графита с обуглероженного источника в растущий слиток и возникновение в основном политипе 4H паразитных политипных включений (6H и 15R). Паразитные включения 6H и 15R в слитках приводят к появлению антифазных границ и развитию двумерных кристаллографических дефектов. Соответствующие морфологические дефекты ориентированы в направлении азимута [2$\bar {1}$$\bar {1}$0] (азимут отклонения плоскости затравки от истинной плоскости (0001)).
Появление и последующее исчезновение политипных включений не влияет на плотность микропор, но приводит к увеличению плотности базисных дислокаций на 1–2 порядка. В кристаллах формируется сложная блочная субструктура с типовыми углами мозаичности 1'–2'.
Список литературы
Tairov Yu., Lebedev A., Avrov D. The Main Defects of Silicon Carbide Ingots and Epitaxial Layers. Saarbrücken: Lambert Academic Publishing, 2016. 76 p.
Powell A., Jenny J., Muller S., Hobgood H.McD., Tsvetkov V., Lenoard R., Carter C., Jr. Growth of SiC Substrates // Int. J. High Speed Electron. Systems. 2006. V. 16. № 3. P. 751–777.
Верма А., Кришна П. Полиморфизм и политипизм в кристаллах. М.: Мир, 1969. 278 с.
Авров Д.Д., Лебедев А.О., Таиров Ю.М. Политипные включения и политипная стабильность кристаллов карбида кремния // ФТП. 2016. Т. 50. Вып. 4. С. 501–508.
Firsov D.D., Komkov O.S., Fadeev A.Yu., Lebedev A.O. Evaluation of Nitrogen Incorporation into Bulk 4H-SiC Grown on Seeds of Different Orientation from Optical Absorption Spectra // J. Phys.: Conf. Ser. 2016. V. 741. 012043. 5 p.
Авров Д.Д., Лебедев А.О., Таиров Ю.М. Способ получения монокристаллического SiC: Патент РФ на изобретение № 2557597, приоритет от 22 января 2014 г.
Авров Д.Д., Булатов А.В., Дорожкин С.И., Лебедев А.О., Таиров Ю.М., Фадеев А.Ю. О механизмах образования дефектов в слитках карбида кремния политипа 4H // ФТП. 2011. Т. 45. Вып. 3. С. 289–294.
Avrov D.D., Bulatov A.V., Dorozhkin S.I., Lebedev A.O., Tairov Yu.M. Defect Formation in Silicon Carbide Large-Scale Ingots Grown by Sublimation Technique // J. Cryst. Growth. 2005. V. 275. Iss. 1–2. P. e485–e489.
Авров Д.Д., Быков Ю.О., Комлев А.Е., Лебедев А.О., Таиров Ю.М. Способ подготовки тигля для выращивания монокристаллов карбида кремния // Евразийский патент № 033855, приоритет от 03.05.2018 г.
Авров Д.Д., Дорожкин С.И., Лебедев А.О., Таиров Ю.М. Образование доменов при синтаксическом срастании политипов карбида кремния // ФТП. 2007. Т. 41. Вып. 12. С. 1409–1413.
Дополнительные материалы отсутствуют.
Инструменты
Неорганические материалы


