Неорганические материалы, 2021, T. 57, № 11, стр. 1185-1189
Индуцированные электрическим полем примесныe явления в монокристаллах р-GaSe
А. Ш. Абдинов 1, Р. Ф. Бабаева 2, *
1 Бакинский государственный университет
AZ 1148 Баку, ул. З. Халилова, 23, Азербайджан
2 Азербайджанский государственный экономический университет (UNEC)
AZ 1001 Баку, ул. Истиглалийят, 6, Азербайджан
* E-mail: babayeva.rena@unec.edu.az
Поступила в редакцию 14.12.2020
После доработки 27.07.2021
Принята к публикации 27.07.2021
Аннотация
При электрических напряжениях, создающих инжекцию в чистых (нелегированных специально), а также легированных редкоземельными элементами (гадолинием и эрбием) с NРЗЭ ≤ 10–1 ат. % монокристаллах моноселенида галлия (p-GaSe) р-типа, обнаружены и исследованы индуцированная электрическим полем примесная фотопроводимость и cпонтонные пульсации темнового тока. Показано, что оба этих явления непосредственно обусловлены перезарядкой существующих в запрещенной зоне p-GaSe уровней прилипания инжектированными носителями заряда, не зависят от химической природы введенной примеси и определяются лишь ее количеством, а в более высокоомных чистых и легированных образцах (NРЗЭ ≤ 10–2 ат. %) на них сильно влияют также случайные макроскопические дефекты.
ВВЕДЕНИЕ
Монокристаллы р-типа моноселенида галлия (p-GaSe) благодаря своим уникальным физическим свойствам, нелинейным характеристикам, сильной анизотропии, высокой способности к легированию и другим специфическим особенностям [1, 2] привлекают внимание как перспективные материалы для создания различного типа оптоэлектронных устройств в области всего видимого и значительной части ближнего ИК-диапазонов оптического спектра, а также в микроэлектронных и эпитаксиальных технологиях. В последние десятилетия возрос интерес к исследованиям физических свойств этого полупроводника также в связи с возможностями изготовления на его основе различного типа нано- и планарных структур [3–5]. Известно, что исследование индуцированных различными внешними воздействиями неравновесных электронных процессов способствует изучению особенностей электронных свойств в рассмотренном полупроводнике [6, 7].
Цель данной работы – исследование индуцированных электрическим полем фотопроводимости в области примесного поглощения (ИПФ) и спонтанных пульсаций темнового тока (ИПТ) в нелегированных специально (чистых) и легированных редкоземельными элементами (гадолинием и эрбием) монокристаллах p-GaSe при различных внешних условиях.
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Как и в предыдущих работах, посвященных экспериментальным исследованиям кинетических коэффициентов [8], влияния легирования Gd и Er и электрического поля на собственную фотопроводимость [9] и электролюминесценцию [10] в монокристаллах p-GaSe, в данной работе исследуемые образцы были изготовлены расщепления из выращенных методом Бриджмена чистых и легированных редкоземельными элементами (РЗЭ) с содержанием 10–5–10–1 ат. % монокристаллических слитков p-GaSe, полученных с использованием галлия металлического марки 5N или 6N, селена гранулированного марки ОСЧ 22-4, гадолиния металлического марки ГдМ-1, эрбия металлического марки ЭрМ-1.
Величина темнового удельного сопротивления (ρт) различных образцов при комнатной температуре (ρ300) была одинаковой и составляла ~6 × 103–104 Ом см, а начиная с Т ≈ 240 К с понижением температуры постепенно увеличивалась и при 77 К для различных образцов менялась в пределах ρ77 ≈ 1 × 104–8 × 107 Ом см. Величина ρт кристаллов p-GaSe〈РЗЭ〉 при Т < 240 К, помимо температуры, оказалась зависимой также от содержания введенной примеси и с ростом NРЗЭ при 77 К немонотонно менялась в пределах ~104–7 × 107 Ом см, достигая максимального значения при при NРЗЭ ≈ 10–4–5 × 10–4 ат. % [8].
Измерения проводились в диапазонах температуры Т ≈ 77–300 К, напряженности электрического поля Е ≈ 10–2.5 × 103 В/см, длины волны λ ≈ 0.30–4.00 мкм и интенсивности света I ≈ 5 × × 100–5 × 102 Лк.
Образцы с индиевыми и серебряными токовыми контактами имели форму плоскопараллельной пластины с толщиной 0.200–0.300 мм и поперечными размерами (5.0–6.0) × (5.0–6.0) мм в направлениях перпендикулярно и вдоль естественных слоев кристалла соответственно. При всех измерениях ток через образец и падающий на него световой поток были направлены перпендикулярно естественным слоям кристалла.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Установлено, что в области Т ≤ 240 К в зависимости от ρ77 и NРЗЭ при электрических напряжениях (U), больших напряжения перехода статической ВАХ от линейного участка к первому квадратичному (U1–2) [11], на спектральной зависимости фотопроводимости помимо собственной фотопроводимости (рис. 1, кривые 1–4) появляется и ИПФ (рис. 1, кривые 5–8), а на темновой ВАХ (рис. 2а) начиная с величины U, заметно превышающей напряжение полного заполнения ловушек (ПЗЛ) (UПЗЛ) [11] – ИПТ (рис. 2б) со своеобразной кинетикой (рис. 2в).
Рис. 1.
Спектральное распределение собственной (1–4) и индуцированной примесной (5–8) фотопроводимости в образцах чистых (1, 2, 5 и 6) и легированных (3, 4, 7 и 8) кристаллов p-GaSe: Т = 77 К; ρ77 = 104 (1, 5), 6 × 107 Ом см (2, 6); NРЗЭ = 5 × 10–4 (3, 7), 10–1 ат. % (4, 8).

Рис. 2.
Вольтамперная характеристика (а), пульсации (б) и кинетика импульса (в) темнового тока в образцах чистых кристаллов p-GaSe: Т = 77 К, ρ77 ≈ 6 × 107 Ом см.
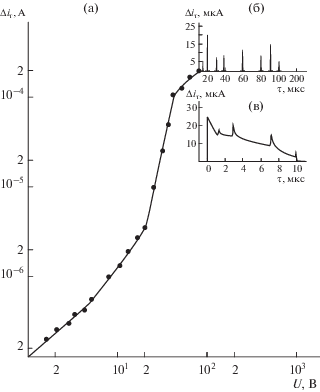
Влияние электрического поля и легирования Gd, Er на собственную фотопроводимость в монокристаллах р-GaSe (рис. 1, кривые 1–4) исследованы в [9]. Поэтому в данной статье основное внимание уделено влиянию легирования (NРЗЭ) и величины исходного удельного темнового сопротивления (ρ77) на индуцированную электрическим полем примесную фотопроводимость (рис. 1, кривые 5–8) в этом полупроводнике. Установлено, что при слабых освещенностях как величина $\Delta {{i}_{{{\text{пп}}}}} = \frac{{{{i}_{{\text{c}}}} - {{i}_{{\text{т}}}}}}{{{{i}_{{\text{т}}}}}}$ (iт и ic – стационарные значения тока через образец в темноте и при воздействии света соответственно), так и положение длинноволнового края спектра обнаруженной ИПФ (λк) зависят от ρ77 и NРЗЭ. В образцах чистых кристаллов с ростом ρ77 спектр ИПФ немного расширяется в сторону более длинных волн (рис. 1, кривые 1 и 2), а величина Δiпп плавно увеличивается (рис. 3, кривая 1). В легированных кристаллах расширение спектра ИПФ в сторону более длинных волн (рис. 1, кривые 5, 7 и 8) и величина Δiпп (рис. 3, кривая 2) немонотонно зависят от NРЗЭ, достигая наибольших значений при NРЗЭ≈10–4–5 × 10–4 ат. % (рис. 1, кривая 7 и рис. 3, кривая 2).
Рис. 3.
Зависимости ИПФ от ρ77 в чистых (1) и от NРЗЭ в легированных (2) кристаллах p-GaSe: Т = 77 К, λ ≈ 1.80 мкм.
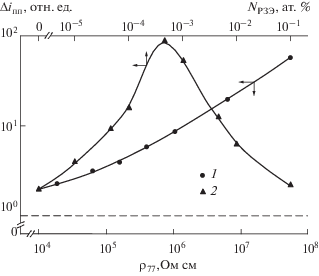
В интервале UПЗЛ < U < Uп, где Uп – значение электрического напряжения, при котором начинаются спонтанные пульсации темнового тока, с ростом U ИПФ постепенно исчезает. Оба обнаруженных явления более отчетливо наблюдаются в образцах с припаянными на воздухе без флюса индиевыми контактами, инжектирующая способность основных носителей тока которых сравнительно больше, чем у серебряных контактов [9, 10, 12].
Значения Uп, а также Δiт и частота появления спонтанных пульсаций темнового тока (f), кроме инжектирующей способности токовых контактов, зависят также от расстояния между токовыми контактами (lk), температуры, ρ77 и NРЗЭ. В зависимостях Uп, Δiт и f от ρ77 и NРЗЭ не наблюдается никаких закономерностей. С уменьшением lk и повышением инжектирующей способности контактов Uп уменьшается, а Δiт и f увеличиваются. При повышении температуры до ~235–240 К обнаруженные ИПТ постепенно исчезают.
В кристаллах p-GaSe〈РЗЭ〉 при рассмотренных значениях NРЗЭ, собственная фотопроводимость [9], электрофизические [8] и люминесцентные [10] свойства, ИПФ и ИПТ не зависят от химической природы введенной примеси. Однако при определенных внешних условиях наблюдается их зависимость от содержания введенной примеси: с ростом NРЗЭ сначала (до NРЗЭ ≈ 10–4–5 × 10–4 ат. %) амплитуды пульсаций увеличиваются, далее уменьшаются и приближаются к значениям в наиболее низкоомных чистых образцах.
Переходя к обсуждению полученных экспериментальных результатов, прежде всего следует отметить, что обнаружение ИПФ и ИПТ лишь при напряжениях U ≥ U1–2, зависимости их от расстояния между токовыми контактами исследуемого образца, инжектирующей способности контактов, температуры однозначно показывают, что оба этих процесса индуцированы электрическим полем – инжекцией, и каждый из них состоит из двух этапов. Аналогично сказанному в [6, 7] для индуцированной фоновой подсветкой примесной фотопроводимости при этом на первом этапе существующие в запрещенной зоне исследуемого образца уровни прилипания [12–14] заполняются инжектированными основными носителями заряда – дырками, а на втором этапе эти неравновесно заполненные уровни прилипания опустошаются под действием света из определенной области примесного поглощения или электрического поля, что обусловливает возникновение ИПФ или ИПТ соответственно.
Однако при этом открытыми остаются вопросы, связанные с зависимостями этих явлений от удельного темнового сопротивления (ρ77) в чистых образцах и уровня легирования (NРЗЭ) в легированных. По всей вероятности, при этом, как и в [8–10, 12], необходимо учитывать также наличие в образцах, имеющих одинаковые химический состав и кристаллическую структуру, случайных макроскопических дефектов (СМД) [15–17] с более высоким удельным сопротивлением относительно основной матрицы (М) и созданных ими в свободных энергетических зонах рекомбинационных и дрейфовых барьеров. При этом рекомбинационные барьеры, обусловливая туннелирование неравновесных носителей заряда между М и СМД, вызывают обнаруженное в эксперименте слабое расширение спектра ИПФ в более длинноволновую сторону, зависящее от ρ77, NРЗЭ и U, а дрейфовые барьеры, препятствуя дрейфу носителей заряда, определяют величину проводимости образца. Поэтому при опустошении неравновесно заполненных уровней прилипания, т.е. при переходе захваченных на этих уровнях дырок в валентную зону, проводимость образца увеличивается как за счет создания избыточной концентрации носителей заряда, так и из-за частичного спрямления дрейфовых барьеров вследствие компенсации объемного заряда СМД зарядом избыточных носителей.
Естественно, что из-за экспоненциальной зависимости высоты дрейфовых барьеров от величины избыточного заряда [17] при определенных условиях дрейфовый компонент фотопроводимости может оказаться значительным. Как и в других пространственно-неоднородных кристаллических полупроводниках с СМД [18, 19], в кристаллах p-GaSe структура М–СМД при низких температурах и слабых освещенностях проявляется в долговременной релаксации проводимостей, а также в активационном характере электропроводности и подвижности свободных носителей заряда. Обнаружение к настоящему времени в p-GaSe целого комплекса явлений долговременной релаксации проводимостей (остаточной фотопроводимости, спектральной памяти, аномальной фотопроводимости, фотоэлектрической и электрической утомляемости, стимулированной электрическим полем проводимости, накоплении воздействий последовательных слабых световых сигналов) однозначно свидетельствует о применимости к кристаллам этого полупроводника модели М–СМД. Наличие в кристаллах p-GaSe СМД доказано также непосредственными способами [16].
В рамках предложенной модели (низкоомная М с высокоомными СМД) предполагается, что в кристаллах p-GaSe〈РЗЭ〉 влияние введенных примесей на ИПФ и ИПТ не обусловлено внутрицентровыми (примесными) эффектами [6, 7]. Оно связано с изменением размеров СМД и, соответственно, расстояния между областями пространственных зарядов (ОПЗ) соседних СМД вследствие скопления на них ионов введенных примесей под действием внутреннего электрического поля р+–р-перехода на границе М–СМД. В частности, ионы введенных примесей, скапливаясь на исходных СМД, увеличивают их размеры. Соответственно, с ростом NРЗЭ влияние рекомбинационных и дрейфовых барьеров на ИПФ и ИПТ сначала (при NРЗЭ ≤ 5 × 10–4 ат. %) усиливается, а далее (при NРЗЭ > 5 × 10–4 ат. %) из-за уменьшения расстояния между ОПЗ соседних СМД – ослабляется [20] и ситуация приближается к таковой в чистых кристаллах с наименьшим ρ77 (рис. 3, кривая 2).
В интервале UПЗЛ ≤ U < Uп с ростом U вследствие частичной компенсации пространственного заряда СМД избыточным зарядом возбужденных из уровней прилипания на свободную зону носителей влияние рекомбинационных барьеров на ИПФ уменьшается. При U ≥ Uп из-за спонтанного туннельного опустошения уровней прилипания наблюдаются соответствующие пульсации темнового тока (рис. 2б), а ИПФ исчезает.
Что касается происхождения СМД в исследуемых образцах, то скорее всего слоистость кристаллов p-GaSe и, следовательно, слабость химической связи между слоями (низкая механическая прочность) приводят к хаотическим локальным нарушениям упорядоченности слоистой структуры – образованию СМД в массивных образцах [8, 16].
При легировании ионы Gd (Er) не только изменяют размеры областей пространственного заряда СМД, но также благодаря ковалентной связи между находящимися в соседних слоях ионами в какой-то мере усиливает межслойную связь, повышая механическую прочность образца. По-видимому, именно из-за этого в образцах p-GaSe〈РЗЭ〉 с NРЗЭ ≥ 10–2 ат. % физические параметры более стабильны.
Установленные значения верхней границы температурного диапазона, при котором наблюдаются ИПФ и ИПТ, а также длинноволновой границы спектрального распределения ИПФ [6, 7] позволяют предполагать, что причиной этих явлений в образцах p-GaSe являются уровни прилипания с глубиной залегания εt ≈ εv + 0.42 эВ [12–14].
ЗАКЛЮЧЕНИЕ
На основе экспериментального исследования ИПФ и ИПТ в нелегированных специально (чистых) и легированных РЗЭ (гадолинием и эрбием) монокристаллах селенида галлия (p-GaSe) при различных внешних условиях установлено следующее.
Оба явления непосредственно связаны с перезарядкой существующих в запрещенной зоне уровней прилипания с глубиной залегания εt ≈ ≈ εv + 0.42 эВ инжектированными основными носителями заряда. В более высокоомных чистых и легированных с NРЗЭ ≤ 10–2 ат. % кристаллах на эти явления значительно влияют также макроскопические дефекты (СМД).
ИПФ и ИПТ в кристаллах p-GaSe c NРЗЭ ≤ ≤ 10–1 ат. % не зависят от химической природы введенной примеси, а определяются лишь ее количеством.
В кристаллах p-GaSe〈РЗЭ〉 вследствие суммирования заряда ионов РЗЭ с исходным пространственным зарядом СМД с ростом NРЗЭ влияние легирования на обнаруженные индуцированные электрическим полем примесные явления сначала (при NРЗЭ ≤ 5 × 10–4 ат. %) усиливается, а далее (при NРЗЭ > 5 × 10–4 ат. %) вследствие уменьшения расстояния между ОПЗ соседних СМД постепенно ослабляется и исчезает.
При NРЗЭ ≈ 10–2–10–1 ат. % обеспечивается высокая стабильность и воспроизводимость отдельных физических параметров образцов. Полученные экспериментальные результаты удовлетворительно объясняются проявлением различных центров прилипания, захвата и рекомбинации.
Список литературы
Feng Z.S., Kang Z.H., Wu F.G., Gao J.Y., Jiang Y., Zhang H.Z., Andreev Y.M., Lanskii G.V., Atuchin V.V., Gavrilova T.A. SHG in Doped GaSe:In Crystals // Opt. Express. 2008. V. 16. № 13. P. 9978–9985.
Guo J., Xie J., Zhang L., Jiang K., Chen F., Andreev Yu.M., Atuchin V.V., Kokh K.A., Lanskii G.V., Losev V.F., Shaiduko A.V. Interaction of High Intensity Optical Pulses with Modified Nonlinear GaSe Crystals // Proc. SPIE. 2013. V. 8796. P. 87962D.
Ho C.H., Hsieh M.H., Wu C.C. Photoconductance and Photoresponse of Layer Compound Photodetectors in the UV-Visible Region // Rev. Sci. Instrum. 2006. V. 77. № 11. P. 113102.
Huang W.C., Horng C.T., Chen Y.M., Chen C.C. The Study on Schottky Contact between Ti and GaSe // Phys. Status. Solidi. C. 2010. V. 7. № 9. P. 2326–2330.
Late D.J., Liu B., Luo J., Yan A., Ramakrishna Mat-te H.S.S., Grayson M., Rao C.N.R., Dravid V.P. GaS and GaSe Ultrathin Layer Transistors // Adv. Mater. 2012. V. 24. № 26. P. 3549–3554.
Рывкин С.М. Фотоэлектрические явления в полупроводниках. М.: Наука, 1963. 429 с.
Воробьев Л.Е., Данилов С.Н., Зегря Г.Г., Фирсов Д.А., Шалыгин В.А., Яссиевич И.Н., Берегулин Е.В. Фотоэлектрические явления в полупроводниках и размерно-квантовых структурах. Санкт Петербург: Наука, 2001. 248 с.
Абдинов А.Ш., Бабаева Р.Ф. Особенности кинетических коэффициентов монокристаллов слоистого полупроводника p-GaSe // Изв. вузов. Физика. 2018. Т. 61. № 9(729). С. 102–107.
Абдинов А.Ш., Бабаева Р.Ф. Влияние легирования Gd и Er и электрического поля на фотопроводимость монокристаллов р-GaSe // Неорг. материалы. 2021. Т. 57. № 2. С. 125–129.
Абдинов А.Ш., Бабаева Р.Ф. Электролюминесценция монокристаллов p-GaSe〈РЗЭ〉 // Неорган. материалы. 2019. Т. 55. № 4. С. 355–360.
Ламперт М., Марк П. Инжекционные токи в твердых телах. М.: Мир, 1973. 416 с.
Абдинов А.Ш., Гасанов Я.Г., Мамедов Ф.И. ВАХ высокоомных монокристаллов слоистых соединений АIIIBVI // ФТП. 1982. Т. 16. № 6. С. 993–998.
Тагиев Б.Г., Нифтиев Г.М. Энергетический спектр дырочных уровней в монокристаллах GaSe // Изв. АН Аз. ССР. Сер. физ-техн. и мат. наук. 1976. № 4. С. 34–37.
Тагиев Б.Г., Нифтиев Г.М., Баширов С.М. Термостимулированная проводимость в монокристаллах GaSe〈Ni〉 // ФТП. 1983. Т. 17. № 7. С. 1320–13223.
Шик А.Я. Фотопроводимость случайно-неоднородных полупроводников // ЖЭТФ. 1975. Т. 68. Вып. 5. С. 1859–1867.
Kokh A., Atuchin V.V., Gavrilova T.A., Kozhukhov A., Maximovskiy E.A., Pokrovsky L.D., Tsygankova A.R., Saprykin A.I. Defects in GaSe Grown by Bridgman Method // J. Microscopy. 2014. V. 256. № 3. P. 208–212.
Кязым-заде А.Г., Панахов М.М., Тагиров В.И. Неравновесное световое спрямление зон в барьерах Шоттки на основе широкозонных полупроводников. // Письма в ЖТФ. 1980. Т. 6. № 17. С. 1040–1044.
Шейнкман М.К., Шик А.Я. Долговременные релаксации и остаточная проводимость в полупроводниках // ФТП. 1976. Т. 10. № 2. С. 209–232.
Рывкин С.М. О природе так называемой “аномальной” фотопроводимости // ФТП. 1974. Т. 8. № 2. С. 373–382.
Шкловский Б.И., Эфрос А.Л. Электронные свойства легированных полупроводников. М.: Наука. 1979. 416 с.
Дополнительные материалы отсутствуют.
Инструменты
Неорганические материалы


