Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 1, стр. 3-13
Состояние разработки микроскопа на длину волны 3.37 нм в ИФМ РАН
И. В. Малышев 1, *, А. Е. Пестов 1, В. Н. Полковников 1, Н. Н. Салащенко 1, М. Н. Торопов 1, Н. И. Чхало 1
1 Институт физики микроструктур,
603950 Нижний, Новгород, Россия
* E-mail: ilya-malyshev@ipm.sci-nnov.ru
Поступила в редакцию 21.04.2018
После доработки 29.04.2018
Принята к публикации 21.04.2018
Аннотация
Работа посвящена разработке микроскопа на длину волны 3.37 нм из “окна прозрачности воды”. В качестве изображающего объектива используется объектив Шварцшильда с многослойным покрытием. Микроскоп имеет расчетное разрешение до 13 нм и поле зрения 7.3−97.5 мкм в зависимости от увеличения. Малая глубина фокуса (±37.5 нм) позволяет реализовать z-томографию образцов. Приводятся схема микроскопа, результат асферизации зеркала-коллектора и результаты измерения шероховатостей подложек для зеркал. Описываются трехточечный способ крепления зеркал и магнитный демпфер на токах Фуко. Делается оценка времени экспозиции.
ВВЕДЕНИЕ
Для детального изучения клеток при решении современных биологических и медицинских задачах требуется получить изображение их внутренней структуры с разрешением в десятки нанометров [1, 2]. Традиционная флуоресцентная микроскопия, работающая в видимом свете, не позволяет исследовать наноструктуру живых клеток с деталями менее 200−300 нм [3]. Электронная микроскопия обладает достаточным разрешением (порядка одного нанометра), но исследуемые образцы приходится высушивать и резать на пленки толщиной в сотни нанометров, т.е. данный метод является разрушающим и не может быть применен для изучения живых клеток. Атомно-силовая и сканирующая туннельная микроскопия позволяют изучать лишь поверхность образцов. В последние 20 лет активно развивается мягкая рентгеновская микроскопия в “окне прозрачности воды” на длинах волн 2.3−4.4 нм [4–6]. Достаточно высокое отличие в коэффициентах поглощения этих длин волн для углерода (основа белка) и воды позволяет видеть углеродосодержащие (белковые) структуры в живых образцах, а низкое рассеяние предоставляет возможность изучать образцы толщиной в единицы, десятки микрометров. При этом дифракционный предел разрешения в этом диапазоне длин волн составляет единицы нанометров на поле зрения примерно до 100 мкм.
Обычно мягкие рентгеновские микроскопы (МРМ) в качестве изображающей оптики используют зонные пластинки Френеля (ЗПФ) с глубиной фокуса (DOF) в единицы микрометров, сравнимой с толщиной исследуемых образцов, поэтому в таких микроскопах возможна только угловая томография [7–9]. Образец вращают на определенные углы и делают серию снимков. При этом лучшее разрешение изображений объемных образцов, полученное в работах [2, 8], составляет 100–200 нм, что чуть лучше разрешения микроскопов видимого света и значительно хуже дифракционного предела на длинах волн 2.3−4.4 нм. Дальнейшее улучшение разрешения связано с отсутствием возможности измерения аберраций ФЗП и со сложностью угловой томографии. Во-первых, при поворотах образца возникает его децентровка и ошибка по углу. Даже с использованием математических инструментов выравнивания изображений угол поворота удается восстановить (в лучшем случае) с точностью ±0.1° [8]. Во-вторых, при повороте образца на большие углы его крайние точки (удаленные от оптической оси на 10–100 мкм) уходят из предметной плоскости объектива на расстояние больше глубины фокуса ЗПФ. Поэтому эти точки видят расфокусированными, а используемые программы обработки томографических изображений, первоначально предназначенные для сканирующих электронных микроскопов, работают в приближении параллельных лучей и не учитывают расфокусировку. В-третьих, есть тепловой дрейф положения образца и предметной плоскости микроскопа из-за долгого накопления (1−60 минут) для каждого снимка [4, 5 , 7–9]. В-четвертых, существующая методика учета аберраций зонных пластин [10, 11], основанная на анализе изображения “звезды Сименса”, позволяет оценить лишь одномерную модуляционную передаточную функцию (МПФ), а для полной характеризации зонной пластинки нужна двумерная МПФ.
Данная работа посвящена разработке светосильного зеркального МРМ на основе многослойных зеркал нормального падения в ИФМ РАН. Глубина фокуса DOF = ±λ/NA2 = ±0.61 × × 3.37 нм/0.32 = ±37.5 нм (k – параметр когерентности света, λ – длина волны, NA – числовая апертура объектива) гораздо меньше толщины изучаемых образцов в единицы–десятки микрон, поэтому в микроскопе может быть реализована z-томография образцов. При этом сдвиг образца по z осуществляется с помощью пьезокерамической подвижки с минимальным шагом 2 нм, контроль сдвига по z с точностью 1 нм – с помощью емкостного датчика. Для деконволюционной обработки z-томографической серии изображений образца используют свободно доступное программное обеспечение ImageJ. Deconvolution Lab2 [3], которое обычно применяется для обработки флуоресцентных изображений в видимом свете. Механизм формирования изображения в МР-диапазоне отличается от флуоресценции, появляется поглощение излучения в образце [12]. Для учета поглощения авторами сейчас разрабатывается программа обработки 3D-изображений после их деконволюции. Учет аберраций микроскопа в нашем случае может быть сделан в полной мере, так как в отличие от зонных пластин, объектив работает не только в мягком рентгене, но и в видимом свете, и его аберрации могут быть измерены на интерферометре.
СХЕМА И ПРИНЦИП РАБОТЫ МИКРОСКОПА
Схема микроскопа с указанными основными габаритными размерами представлена на рис. 1. Лазерно-плазменный источник рентгеновского излучения (ЛПИ) состоит из неодимового (Nd:YAG) лазера, имеющего следующие параметры: длина волны λ = 1064 нм, энергия в импульсе до 800 мДж, длительность 3−6 нс, и двухпотоковой импульсной газовой мишени, состоящей из струи углеродосодержащего газа и гелия (1 на рис. 1). В качестве рабочей используется интенсивная узкая линия (λ/Δλ > 500) иона C+5 с длиной волны 3.37 нм [4]. Эллиптическое зеркало-коллектор собирает излучение ЛПИ на образце, формируя квазиравномерное пятно засветки в предметной области микроскопа (3). Покрытие коллектора – многослойное Cr/Sc зеркало, оптимизированное на отражение излучения с длиной волны λ = 3.37 нм с коэффициентом отражения на уровне 7–10% [13, 14]. Между источником и образцом, а также перед детектором устанавливаются фильтры (5): подавляющий длинноволновое излучение и пропускающие λ = 3.37 нм [15]. Кювета с образцом устанавливается на пьезокерамическую подвижку обеспечивающую 3D-томографию за счет перемещения вдоль оптической оси z. Увеличенное в 46 раз изображение образца строится двухзеркальным объективом Шварцшильда (4) на цифровом детекторе, разработанном авторами ранее в работе [16], который состоит из сцинтиллятора YAG:Ce (6), преобразующего рентгеновское излучение в видимый свет и оптической системы, передающей изображение поверхности сцинтиллятора с увеличением на ПЗС-камеру. За счет замены объектива Mitutoio Plan Apo оптическая система позволяет дискретно менять увеличение: ×1.96, ×4.23 и ×20 (8). Поле зрения микроскопа определяется размером ПЗС-матрицы BMR-1400HM-U (6.708−8.772 мм), деленным на общее увеличение микроскопа (×90, ×194.5, ×920), и составляет от 7.3−9.5 до 74.5−97.5 мкм (табл. 1). В работе [16] было измерено пространственное разрешение и поле зрения детектора для всех объективов. Как видно из табл. 1, предельное разрешение составило 0.58 мкм с объективом NA = 0.55, поэтому ограничение на разрешение микроскопа, связанное с возможностями цифрового детектора, составляет 0.58 мкм/46 = 12.6 ≈ 13 нм на поле зрения от 7.3−9.5 мкм. При этом размер пикселя в предметной плоскости равен 6.45 мкм/920 = = 7 нм.
Рис. 1.
Конструкция микроскопа: 1 − лазерно-плазменный источник, 2 − зеркало-коллектор, 3 − исследуемый образец на пьезокерамической подвижке и 5d-столике, 4 − двухзеркальный объектив Шварцшильда, 5 − фильтры для подавления длинноволнового излучения, 6 − сцинтиллятор, 7 − вакуумное окно, 8 − оптическая система, 9 – ПЗС-камера, 10 − пружинный подвес, 11 − магниты, 12 − медные пластины, 13 − виброизолирующий стол, 14 − патрубок к вакуумному насосу.
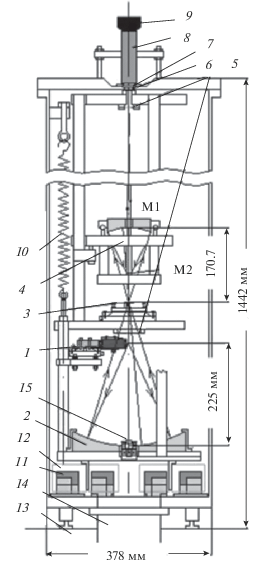
ОПИСАНИЕ ЭЛЕМЕНТОВ МИКРОСКОПА
Коллектор. Зеркало-коллектор имеет форму эллипса. Первый фокус эллипса совпадает с центром газовой струи ЛПИ, второй фокус совпадает с центром образца. При изготовлении этого зеркала мы использовали развиваемый нами подход, заключающийся в асферизации исходно сферических подложек методом ионно-пучкового травления [17, 18]. Для данного коллектора была выбрана сферическая подложка с радиусом кривизны Rкр = 273 мм. Профиль асферизации (съем материала) для этой подложки имеет максимальный перепад высот PV = 8 мкм на D = 220 мм (рис. 2). Коэффициенты полиномов Цернике коллектора: α2 = −2.987 × 10−6, α4 = 2.3246 × 10−10, α6 = = 4.3980 × 10−15.
Эллипсоид изображает каждую точку источника на образце в виде пятна фокусировки с размером 1–6 мкм на поле зрения до ±100 мкм (рис. 3), поэтому позволяет эффективно собрать свет источника на образце.
Рис. 3.
Концентрация энергии в пятнах фокусировки на образце в зависимости от радиуса на нем в случае с идеальным эллипсоидом. Подписи на графиках (х, у) − координаты на образце.
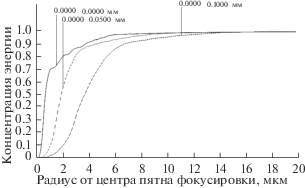
Процедура изготовления коллектора заключалась в следующем. С учетом рассчитанного профиля съема материала и распределения тока пучка изготавливалась диафрагма, через которую на установке [19] осуществлялось травление. Далее по методике, предложенной в работе [20], с помощью интерферометра с дифракционной волной сравнения (ИДВС) [21] измерялся профиль отклонения поверхности подложки от идеального эллипсоида. Фотография, иллюстрирующая методику измерений, приведена на рис. 4. Волоконные источники сферической волны (ВИСВ) (1) устанавливались в анаберационные точки (фокусы эллипсоида), поэтому аберрации волнового фронта, отразившегося от коллектора, были связаны только с ошибкой его формы.
Рис. 4.
Измерение формы эллипсоида и его ФРТ на интерферометре с дифракционной волной сравнения. 1 – ВИСВ, установленные в фокусы эллипсоида; 2 – измеряемый эллипсоид; 3 – наблюдательная система; 4 – ПЗС-камера.
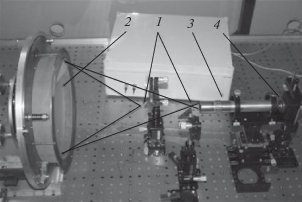
После первой процедуры коррекции были получены следующие статистические параметры отклонения формы поверхности от эллипсоида: RMS (root-mean-square) = 104 нм и PV = 812 нм. Дополнительно на этом же интерферометре было получено изображение квазиточечного ВИСВ (диаметр выходной апертуры 0.25 мкм). По сути – это функция рассеяния точки (ФРТ) получившегося эллипсоида (рис. 5). Иными словами, эллипсоид будет изображать каждую точку ЛПИ в виде ФРТ на образце. В итоге получаем, что интенсивность подсветки образца является сверткой интенсивности ЛПИ (рис. 6, a) с измеренной ФРТ (рис. 6, б). Размер ФРТ, приблизительно равный 30 мкм, приводит к падению интенсивности в среднем на 10% на поле зрения 2r = 97.5 мкм. Для уменьшения тени от ЛПИ (рис. 1, 1) увеличение эллипсоида было принято равным 1.5. Из-за увеличения интенсивность падает еще на 20% (рис. 6, в). Таким образом, коэффициент падения интенсивности из-за ошибки формы и коэффициента увеличения коллектора равен Tcol l = 0.5 в среднем на образце на поле зрения 97.5 мкм. Этот коэффициент будет использован далее для оценки вычисления необходимого времени экспозиции.
Рис. 5.
Изображение пятна фокусировки коллектора, являющегося его ФРТ. Пунктиром обозначена тень от ВИСВ, задающая масштаб.
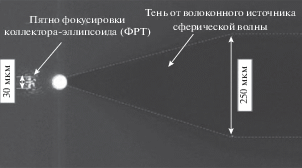
Рис. 6.
Зависимость интенсивности подсветки образца от радиус-вектора на нем: а − моделируемая интенсивность ЛПИ, б − падение интенсивности подсветки образца из-за размера ФРТ, в − падение интенсивности подсветки образца из-за размера ФРТ и увеличения эллипсоида.

В настоящее время начата работа по нанесению на поверхность коллектора многослойного Cr/Sc-покрытия, отражающего излучение с рабочей длиной волны 3.37 нм.
Объектив Шварцшильда ×46. Описание и основные характеристики. Ключевым элементом, определяющим пространственное разрешение микроскопа, является проекционный объектив. Была выбрана двухзеркальная схема Шварцшильда (ОШ) с одним асферическим зеркалом. Объектив рассчитывался в программе “Zemax” так, чтобы на поле зрения 10 мкм разрешались полосы шириной 13 нм (рис. 7а). При этом на ПЗС-матрице ширина полос составляет 13 нм × × 920 ≈ 12 мкм ≈ 2 пикселя. А на поле зрения 100 мкм разрешаются полосы шириной 72 нм (рис. 7б). При этом на ПЗС-матрице ширина полос составляет 72 нм × 90 ≈ 6.5 мкм ≈ 1 пиксель. В табл. 2 приведены параметры ОШ (вогнутое зеркало М1 – асферическое, а выпуклое зеркало М2 − сферическое). По аналогии с коллектором асферизация зеркала, а также коррекция локальных ошибок формы будут производиться ионными пучками. Коэффициенты полиномов Цернике асферического зеркала М2: α2 = −1.919 × 10−6, α4 = 7.3144 × 10−10, α6 = 3.9214 × 10−14, α8 = 1.7221 × × 10−18, α10 = −1.4635 × 10–22.
Рис. 7.
Изображение полос объективом Шварцшильда: а − ширина полосы 13 нм (период полос 26 нм) на поле зрения 10 мкм, б − ширина полосы 72 нм (период полос 144 нм) на поле зрения 100 мкм.

Таблица 2.
Параметры объектива Шварцшильда ×46
| Расстояние до следующего элемента, мм | Радиус кривизны, мм | Диаметр, мм | |
|---|---|---|---|
| Образец | 170.703 | ∾ | 0.1 |
| Зеркало М1 | 102.485 | 137 | 100 |
| Зеркало М2 | 812.401 | −24 | 10 |
| Изображение на сцинтилляторе | − | ∾ | 4.6 |
Для того чтобы остаточные аберрации ОШ не ухудшали его разрешение, согласно критерию Марешаля, должно выполняться условие:
(1)
$RM{{S}_{{{\text{aber}}}}} \leqslant {\lambda \mathord{\left/ {\vphantom {\lambda {14}}} \right. \kern-0em} {14}} = {{3.37\,{\text{н м }}} \mathord{\left/ {\vphantom {{3.37\,{\text{н м }}} {14}}} \right. \kern-0em} {14}} \approx 0.24\,{\text{н м }}{\text{.}}$Такое требование реализовать на практике крайне сложно. Например, в работе [22] нам удалось скорректировать ошибки формы асферического зеркала до уровня RMS = 0.8 нм, поэтому мы ожидаем, что аберрации ОШ будут скорректированы до уровня RMS = 1–2 нм. Затем на основе измеренных остаточных аберраций для ОШ и для цифрового детектора мы сгенерируем функцию рассеяния точки (ФРТ) для каждого из увеличений. Полученную ФРТ мы будем использовать при деконволюционной обработке изображений, что позволит приблизиться к дифракционному ограничению на разрешение 13 нм.
Следующий важный вопрос – юстировка ОШ. Как показывают расчеты, центровка зеркал объектива относительно друг друга должна быть не хуже 0.2 мкм, тогда контраст 13 нм-полос упадет всего на 5%. В работах [1, 23] такая точность центровки реализовывалась с помощью дополнительных юстировочных каналов, основанных на отражении лучей от поверхностей зеркал и приходящих на дополнительную ПЗС-камеру. Наши расчеты показывают, что децентровка зеркал на 0.2 мкм приводит к коме отраженного объективом волнового фронта с RMS = 0.22 нм и PV = 1.24 нм. Точность измерений на интерферометре ИДВС на уровне RMS = 0.1 нм позволяет увидеть аберрации с такими параметрами, поэтому мы будем центровать зеркала объектива прямо в интерферометре.
На данный момент времени сферические заготовки для зеркал ОШ изготовлены и изучена их шероховатость. Измерение шероховатости производилось на стенде атомно-силового микроскопа, позволяющем изучать криволинейные поверхности [24]. Измерения проводились в широком диапазоне пространственных частот шероховатостей (ν = 0.05–65 мкм–1). На рис. 8a, 8б приведены спектральные плотности мощности шероховатостей подложек, измеренные в различных точках поверхности для подложек зеркал М1 и М2, соответственно. Меньший номер точки соответствует области в центре подложки и по мере удаления от центра этот номер растет. Как следует из приведенных графиков для выпуклой поверхности эффективная шероховатость σeff изменяется в довольно узких пределах (0.52−0.6 нм). Шероховатость вогнутой поверхности изменяется в более широких пределах. Для оптики дифракционного качества для мягкого рентгеновского диапазона требуется эффективная шероховатость на уровне σeff = 0.2 нм [24]. Для решения этой проблемы подложки будут полироваться ионным пучком до значений σeff ≈ 0.2 нм [19, 24–26]. После ионной полировки подложки будут подвергнуты асферизации и коррекции локальных ошибок формы.
Рис. 8.
Спектральная плотность мощности шероховатости, измеренная в разных точках подложек: а − подложка для зеркала М1; б − подложка для зеркала M2. Меньший номер точки соответствует области в центре подложки и по мере удаления от центра этот номер растет.

Крепление зеркал объектива. Коррекция аберраций объектива Шварцшильда производили путем коррекции формы верхнего зеркала М1 диаметром 100 мм. Коррекция и измерение ошибок формы является процессом многоэтапным. Зеркало М1 снимают и вставляют в объектив много раз. При этом оно должно всегда однозначно вставать в тоже положение. На рис. 9 приведена схема установки зеркала в металлическую оправу. К зеркалу на эпоксидный клей “3m Scotch-WeldDP 190” приклеиваются бобышки с шариками. Шарики устанавливаются на три площадки. Первый шарик всегда однозначно устанавливается в кольцо. Второй шарик опирается на две точки в треугольной призме, необязательно в ее центре из-за погрешности приклеивания бобышек к зеркалу. А третий шарик автоматически занимает неопределенное положение на плоской площадке. Такой способ, как показала практика, позволяет устанавливать зеркало всегда в одно положение с нанометровой точностью. После установки бобышки поджимаются через верхние шарики (рис. 10) пружинными прижимами с общей нагрузкой до 18 кгс. Все шарики и площадки сделаны из особо прочного материала (нитрида кремния) для того, чтобы они не деформировались под нагрузкой, и их деформации не передавались на зеркало.
Рис. 9.
Зеркало М1, установленное на три “точки”: Si3N4 – шарики (1), кольцо (2), треугольная призма (3) и плоская площадка (4).

Рис. 10.
Конструкция корпуса объектива Шварцшильда с расстояниями для расчета компенсаторов теплового расширения: a – внутренний стакан, б – внешний стакан, в – подставка.

Нижнее зеркало М2 вклеивается в стакан на съемной оправе со спицами (рис. 10), который (по аналогии с рис. 9) устанавливается в объектив с использованием трех шариков и трех различных площадок.
Компенсаторы теплового расширения объектива. Для уменьшения теплового дрейфа расстояний между зеркалами и предметной плоскостью объектива, металлические конструкции сделаны из инвара с низким коэффициентом температурного расширения ТКЛР = 1.2 × 10−6(1/°С). Однако этого недостаточно для практики. При изменении температуры на 0.5° за время экспозиции расстояние между зеркалами изменится примерно на 100 нм, поэтому предметная плоскость сдвинется на 160 нм, что существенно больше глубины фокуса объектива, и изображение размоется. Для минимизации этого дрейфа в конструкции объектива предусмотрены компенсаторы теплового расширения объектива по вертикали. Принцип работы компенсаторов показан на рис. 10. Компенсатор состоит из внутреннего стакана (“а” на рис. 10), приваренного в верху к внешнему стакану (“б” на рис. 10), и подставки (“в” на рис. 10). Внутренний стакан из ковара с относительно высоким ТКЛР (4.8 × 10–6(1/°С) расширяется вниз больше, чем внешний стакан и подставка, удлиняющиеся вверх. Разница компенсирует расширение корпуса.
Запишем уравнение компенсации теплового расширения частей объектива при увеличении температуры на 1°С:
(1)
$\begin{gathered} ({{h}_{{\text{1}}}} \times {{\alpha }_{{{\text{kov}}}}}) \times {\text{1}}{{0}^{{ - {\text{3}}}}}\left( {\text{м }} \right) = \\ = ({{h}_{{{\text{3 }}}}} \times {{\alpha }_{{{\text{inv}}}}} + {\text{32}}{{\alpha }_{{{\text{piezo}}}}} + {\text{2}} \times 0.0{\text{5}}{{\alpha }_{{{\text{glue}}}}} + \\ + \,\,{\text{12}}.{\text{1}}{{\alpha }_{{{\text{S}}{{{\text{i}}}_{{\text{3}}}}{{{\text{N}}}_{{\text{4}}}}}}} + {\text{3}}.{\text{6}}{{\alpha }_{{{\text{inv}}}}} - {\text{12}}.{\text{5}}{{\alpha }_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}} + \\ + \,\,{{h}_{{\text{2}}}} \times {{\alpha }_{{{\text{inv}}}}} + {\text{45}}{{\alpha }_{{{\text{inv}}}}} + {\text{6}}.{\text{9}}{{\alpha }_{{{\text{S}}{{{\text{i}}}_{{\text{3}}}}{{{\text{N}}}_{{\text{4}}}}}}} - {\text{2}}{{\alpha }_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}}) \times {\text{1}}{{0}^{{ - {\text{3}}}}}\left( {\text{м }} \right). \\ \end{gathered} $Подставим αkov = 4.9 × 10–6(1/°С), αinv = 1.2 × × 10–6(1/°С), αpiezo = 2 × 10–6(1/°С) для ПКР-7М при T ≈ 300 K [27], αglue = 62 × 10–6(1/°С) [DP190], ${{\alpha }_{{{\text{S}}{{{\text{i}}}_{{\text{3}}}}{{{\text{N}}}_{{\text{4}}}}}}}$ = 3.4 × 10–6(1/°С), ${{\alpha }_{{{\text{Si}}{{{\text{O}}}_{{\text{2}}}}}}}$ = 0.55 × 10–6(1/°С). В результате получим
Расстояние между зеркалами М1 и М2 составляет ≈102.5 мм (табл. 1), поэтому:
(2)
$\begin{gathered} --{{h}_{1}} + {{h}_{3}} + 32 + 2 \times 0.05 + 12.1 + \\ + \,\,3.6 - 12.5 + {{h}_{2}} + 45 + 6.9--2 = 102.5, \\ \end{gathered} $Крепление зеркала (бобышки) не должны упираться в компенсатор, поэтому:
Решение h1 = 57 мм, h2 = 55 мм, h3 = 19.3 мм удовлетворяет (1'), (2'), (3).
ТКЛР выбранных прецизионных сплавов, согласно действующему ГОСТ 14 080-78, имеет разброс в значениях. Для ковара 29 НК он равен 4.6 × 10–6–5.2 × 10–6 для температуры 20–400°С. Оценим погрешность расширения ковара при изменении температуры на 0.5°С в этом случае:
(4)
$\begin{gathered} \delta {{H}_{{{\text{kov}}}}} = 0.5(^\circ {\text{С }}) \times {{h}_{{{\kern 1pt} 1}}} \times {{10}^{{--3}}}\left( {\text{м }} \right) \times \delta ({{\alpha }_{{{\text{kov}}}}})\left( {{1 \mathord{\left/ {\vphantom {1 {^\circ {\text{С }}}}} \right. \kern-0em} {^\circ {\text{С }}}}} \right) = \\ = 0.5{\kern 1pt} (^\circ {\text{С }}) \times 57 \times {{10}^{{--3}}}\left( {\text{м }} \right) \times \\ \times \,\,\left( {5.2 - 4.8} \right) \times {{10}^{{--6}}}\left( {{1 \mathord{\left/ {\vphantom {1 {^\circ {\text{С }}}}} \right. \kern-0em} {^\circ {\text{С }}}}} \right) \approx 11.4\,{\text{н м }}{\text{.}} \\ \end{gathered} $Для инвара 36 Н тоже есть разброс по отношению к табличному ТКЛР: ≤1.2 × 10–6 ( ≤ 1.5 × 10–6) по ГОСТ 14 080-78. Оценим погрешность расширения инвара при изменении температуры на 0.5°С в этом случае:
(5)
$\begin{gathered} \delta {{H}_{{{\text{inv}}}}} = 0.5\left( {^\circ {\text{С }}} \right) \times ({{h}_{3}} + {{h}_{2}} + 45) \times \\ \times \,\,{{10}^{{--3}}}\left( {\text{м }} \right) \times \delta ({{\alpha }_{{{\text{kov}}}}})\left( {{1 \mathord{\left/ {\vphantom {1 {^\circ {\text{С }}}}} \right. \kern-0em} {^\circ {\text{С }}}}} \right) = \\ = 0.5\left( {^\circ {\text{С }}} \right) \times 118.8 \times {{10}^{{--3}}}\left( {\text{м }} \right) \times \\ \times \,\,\left( {1.5 - 1.2} \right) \times {{10}^{{--6}}}\left( {{1 \mathord{\left/ {\vphantom {1 {^\circ {\text{С }}}}} \right. \kern-0em} {^\circ {\text{С }}}}} \right) \approx 17.8\,\,{\text{н м ,}} \\ \end{gathered} $СИСТЕМА ВИБРОЗАЩИТЫ
Качество изображений с микроскопа существенно зависит от механических колебаний оптической схемы. Так как глубина фокуса составляет десятки нанометров, то относительные колебания между элементами на нанометровом уровне могут существенно ухудшить разрешение. Для уменьшения вибраций в приборе предусмотрена трехступенчатая система подавления вибраций. Она включает оптический виброизолирующий на воздушной подушке стол от компании “Standa” [28], пружинный подвес и магнитный демпфер на токах Фуко. Такая трехступенчатая система обеспечивает подавление вибраций в среднем на шесть порядков на частотах 1–100 Гц и обычно используется в сканирующих туннельных микроскопах (СТМ) [29].
Подробнее остановимся на магнитном демпфере. Пружинный подвес эффективно давит вибрации на частотах выше резонансной частоты, но на резонансной частоте их усиливает, поэтому нужен магнитный демпфер, который значительно увеличивает коэффициент затухания резонансных колебаний. В итоге резонансные колебания пружинного подвеса затухают не за десятки, а за единицы секунд [30]. На дно вакуумной камеры микроскопа устанавливаются магниты (11, рис. 1). В зазор между ними помещаются проводящие медные пластины (12, рис. 1), связанные с фермой микроскопа, подвешенной на пружины (10, рис. 1).Магнитный демпфер работает следующим образом. При вертикальном смещении медных пластин относительно магнитов в пластинах возникают вихревые токи Фуко, рождающие магнитное поле, препятствующее изменению магнитного потока (рис. 11). На движущиеся электрические заряды, поток которых образует вихревой ток, действует сила Лоренца, направленная навстречу смещению медных пластин.
Амплитуда колебаний:
(7)
$\begin{gathered} {{\omega }_{{{\text{res}}}}} = \surd ({{{{k}_{{{\text{sum}}}}}} \mathord{\left/ {\vphantom {{{{k}_{{{\text{sum}}}}}} m}} \right. \kern-0em} m}) = \surd ({{3k} \mathord{\left/ {\vphantom {{3k} m}} \right. \kern-0em} m}) = \\ = \surd \left( {3 \times {{231\left( {{{\text{Н }} \mathord{\left/ {\vphantom {{\text{Н }} {\text{м }}}} \right. \kern-0em} {\text{м }}}} \right)} \mathord{\left/ {\vphantom {{231\left( {{{\text{Н }} \mathord{\left/ {\vphantom {{\text{Н }} {\text{м }}}} \right. \kern-0em} {\text{м }}}} \right)} {40}}} \right. \kern-0em} {40}}\left( {{\text{к г }}} \right)} \right) = 4.16\left( {{{{\text{р а д }}} \mathord{\left/ {\vphantom {{{\text{р а д }}} {\text{с }}}} \right. \kern-0em} {\text{с }}}} \right), \\ {{\nu }_{{{\text{res}}}}} = {{{{\omega }_{{{\text{res}}}}}} \mathord{\left/ {\vphantom {{{{\omega }_{{{\text{res}}}}}} {2\pi }}} \right. \kern-0em} {2\pi }} = 0.66\left( {{\text{Г ц }}} \right), \\ \end{gathered} $Коэффициент затухания в случае с магнитным демпфером, как показано в работах [29, 30], равен ζ = с/сс, где ${{с }_{с }} = 2m{{\omega }_{{{\text{res}}}}}$ (Н · с/м). В нашем случае, для m = 40 кг и ωres = 4.16 (рад/с) коэффициент сс = 333. Коэффициент с определяется соотношением:
(8)
$c = K\frac{{{{{\bar {B}}}^{2}}hA}}{\rho }\frac{1}{{2(1 + {L \mathord{\left/ {\vphantom {L h}} \right. \kern-0em} h})}}N,$Рис. 12.
Магнитное поле в зазорах между неодимовыми магнитами, расположенными на дне вакуумной камеры микроскопа.

Подставляя эти значения в (8), находим, что с = 32.4 (Н · с/м).
Тогда ζ = 32.4/333 ≈ 0.1, следовательно, используя (6'), получаем амплитуду резонансных колебаний через 2.4 с:
Таким образом, постоянная времени затухания резонансных колебаний на частоте 0.66 Гц составляет 2.4 с.
ОЦЕНКА ВРЕМЕНИ ЭКСПОЗИЦИИ
В связи с необходимостью снятия большого числа снимков (обычно, более 100) при томографии образцов важным параметром микроскопа является время получения каждого снимка. Время экспозиции в МРМ на зонных пластинках, использующих ЛПИ, составляет 1−60 мин. Оценим необходимое время экспозиции для разрабатываемого полно зеркального МРМ на длину волны 3.37 нм. Для этого оценим число фотонов “n”, приходящих на каждый пиксель ПЗС детектора за один лазерный импульс и дающих вклад в фототок:
(10)
$\begin{gathered} n = {{E}_{S}} \times {{R}_{\sum }} \times {\text{ }}\eta {\text{ }} \times {\text{ }}\Omega {\text{ }} \times {{T}_{{{\text{coll}}}}} \times {{T}_{{{\text{filter}}}}} \times {\text{ }}{{\eta }_{{{\text{detector}}}}} \times \\ \times \,\,{{Q{{E}_{{CCD}}}} \mathord{\left/ {\vphantom {{Q{{E}_{{CCD}}}} {\left( {{{E}_{{{\text{photon}}}}} \times {{N}_{{{\text{pixels}}}}}} \right)}}} \right. \kern-0em} {\left( {{{E}_{{{\text{photon}}}}} \times {{N}_{{{\text{pixels}}}}}} \right)}}, \\ \end{gathered} $(11)
$\begin{gathered} \eta = {{{{E}_{{3.37}}}} \mathord{\left/ {\vphantom {{{{E}_{{3.37}}}} {{{E}_{{{\text{laser}}}}}}}} \right. \kern-0em} {{{E}_{{{\text{laser}}}}}}} = \frac{{({{hc} \mathord{\left/ {\vphantom {{hc} \lambda }} \right. \kern-0em} \lambda }) \times {{n}_{{{\text{photons}}}}}}}{{{{E}_{{{\text{laser}}}}}}} = \\ = \frac{{(6.62 \times {{{10}}^{{ - 34}}} \times 3 \times {{{{{10}}^{8}}} \mathord{\left/ {\vphantom {{{{{10}}^{8}}} {3.37}}} \right. \kern-0em} {3.37}} \times {{{10}}^{{ - 9}}}) \times {{{10}}^{{12}}}}}{{0.1}} = \\ = 6 \times {{10}^{{ - 4}}}\,\,\left( {{{\text{1}} \mathord{\left/ {\vphantom {{\text{1}} {{\text{с р }}\, \cdot \,{\text{л и н и я }}\, \cdot \,{\text{и м п у л ь с }}}}} \right. \kern-0em} {{\text{с р }}\, \cdot \,{\text{л и н и я }}\, \cdot \,{\text{и м п у л ь с }}}}} \right), \\ \end{gathered} $QECCD = 0.7 – квантовая эффективность ПЗС камеры BMR-1400HM-Uв видимом спектре,
(12)
${{E}_{{{\text{photon}}}}} = 5.9{\text{ }} \times {\text{ }}{{10}^{{--17}}}\left( {{\text{Д ж }}} \right)$– энергия одного фотона, Npixels = 2448 × 2048 ≈ ≈ 5 × 106 – число пикселей камеры. Подставив эти цифры в (10), получим: n ≈ 7.4 (фотонов/линия · импульс · пиксель) для увеличения ×920 на поле зрения 7.3 × 9.5 мкм.
В работе [8] изображения клеток были получены со временем экспозиции 60 с, при этом на каждый пиксель ПЗС матрицы обратной засветки попало 1000 (фотонов/линия · пиксель) с λ = 2.28 нм (500 эВ), вклад в фототок дали только 1000 × QECCD = 1000 × 0.85 = 850 фотонов, так как использовалась ПЗС обратной засветки фирмы “Princeton Instruments” [31]. В [4] изображение на λ = 3.37 нм было также получено при сборе 1000 (фотонов/линия · пиксель). Следовательно, время экспозиции МРМ можно оценить как $t_{{{\text{exp}}}}^{{ \times {\text{92}}0}}$ = 850 (фотонов)/(7.4 (фотонов/импульс) × × 10 (Гц)) ≈ 11.5 (с) для увеличения ×920 на поле зрения 7.3−9.5 мкм;
$t_{{{\text{exp}}}}^{{ \times {\text{194}}.{\text{5}}}} = t_{{{\text{exp}}}}^{{ \times {\text{92}}0}}{{\eta _{{{\text{detector}}}}^{{ \times {\text{92}}0}}} \mathord{\left/ {\vphantom {{\eta _{{{\text{detector}}}}^{{ \times {\text{92}}0}}} {\eta _{{{\text{detector}}}}^{{ \times {\text{194}}.{\text{5}}}}}}} \right. \kern-0em} {\eta _{{{\text{detector}}}}^{{ \times {\text{194}}.{\text{5}}}}}}$ = 11.5 (с) × × ${{0.0{\text{72}}} \mathord{\left/ {\vphantom {{0.0{\text{72}}} {0.0{\text{14}}}}} \right. \kern-0em} {0.0{\text{14}}}} \approx $ 60 (с) – для увеличения ×194.5 на поле зрения 34.5−45.1 мкм;
$t_{{{\text{exp}}}}^{{ \times {\text{9}}0}} = {\text{ }}t_{{{\text{exp}}}}^{{ \times {\text{92}}0}}{{\eta _{{{\text{detector}}}}^{{{\text{ }} \times {\text{92}}0}}} \mathord{\left/ {\vphantom {{\eta _{{{\text{detector}}}}^{{{\text{ }} \times {\text{92}}0}}} {\eta _{{{\text{detector}}}}^{{ \times {\text{9}}0}}}}} \right. \kern-0em} {\eta _{{{\text{detector}}}}^{{ \times {\text{9}}0}}}}$ = 11.5 (с) × × ${{0.0{\text{72}}} \mathord{\left/ {\vphantom {{0.0{\text{72}}} {0.00{\text{3}}}}} \right. \kern-0em} {0.00{\text{3}}}}$ ≈ 275 (с) – для увеличения ×90 на поле зрения 74.5−97.5 мкм.
Таким образом, для увеличения ×920 время экспозиции составляет 11.5 с, что значительно меньше, чем в МРМ на ФЗП. Для увеличений ×194.5 и ×90 время экспозиции 60–275 с, что сравнимо со временем экспозиции в МРМ на ФЗП.
ЗАКЛЮЧЕНИЕ
Работа посвящена разработке светосильного зеркального МРМ на основе многослойных зеркал нормального падения для длины волны λ = = 3.37 нм из “окна прозрачности воды”. Из-за большой числовой апертуры (NAin = 0.3) и малой глубины фокуса = ±23 нм в таком микроскопе возможна z-томография образца, которая с точки зрения реализации проще угловой томографии. Кроме того, имеется возможность учета остаточных аберраций микроскопа в интерферометре, в отличие от МРМ на зонных пластинках. Микроскоп имеет двухступенчатое сменное увеличение: 90, 194.5 и 920 крат и поля зрения, соответственно, 74.5−97.5, 34.5−45.1, 7.3−9.5 мкм. Первая ступень – увеличение объективом Шварцшильда с многослойным отражающим покрытием из Cr/Sc. Рассчитана предельная разрешающая способность микроскопа в поперечной плоскости: от 13 до 72 нм в зависимости от поля зрения. Вторая ступень увеличения – цифровой детектор со сменными объективами разработан и описан в [16]. Сделана и аттестована асферическая подложка для коллектора. Остаточная ошибка формы уменьшает интенсивность подсветки образца всего на 10%. Рассчитано время экспозиции. Оно составило 11.5 секунд для увеличения ×920 на поле зрения 7.3−9.5 мкм, которое в пять раз меньше времени экспозиции, достигнутого на микроскопах с зонными пластинками на аналогичных полях зрения. Уменьшение времени экспозиции снижает влияние теплового дрейфа на качество изображения. Произведен расчет магнитного демпфера на токах Фуко, предназначенного для гашения колебаний на резонансной частоте пружинного подвеса, которые эффективно гасят колебания (в “е” раз за 2.4 с). Рассчитаны компенсаторы теплового расширения объектива вдоль оптической оси, позволяющие стабилизировать расстояние между зеркалами на уровне 10–20 нм, т.е. меньше глубины фокуса. Описано “трехточечное” крепление для верхнего зеркала М1, позволяющее прецизионно устанавливать его в объектив. Запуск микроскопа в работу планируется в конце 2019 г.
БЛАГОДАРНОСТИ
Работа выполнена с использованием оборудования ЦКП “Физика и технология микро- и наноструктур” ИФМ РАН, в рамках выполнения государственного задания ИФМ РАН, тема № 0035-2014-0204, при поддержке Программ РАН I.1 “Физика конденсированных сред и материалы нового поколения”, I.1 “Экстремальные световые поля и их взаимодействие с веществом”, I.2 “Наноструктуры: физика, химия, биология, основы технологий” и грантов РФФИ: № 18-32-00149 мол_а, № 17-02-00640, № 16-07-00306 А, № 18-32-00671 мол_а.
Список литературы
Артюков И.А., Виноградов А.В., Бугаев Е.А. и др. // ЖЭТФ. 2009. Т. 136. № 5(11). С. 1009.
Hanssen E., Knoechel C., Dearnley M. et al. // Journal of Structural Biology. 2012. V. 177. P. 224.
Sage D., Donati L., Soulez F. et al. // Methods. 2017. V. 115. P. 28.
Berglund M., Rymell L., Peuker M. et al. // Journal of Microscopy. 2000. V. 197(3). P. 268
Legall H., Blobel G., Stiel H. et al. // Optics Express. 2012. V. 20(16). P. 18362.
Wachulak P., Torrisi A., Bartnik A. et al. // Proc. of SPIE. 2016. V. 10159. P. 101590W.
Dehlinger A., Blechschmidta A., Grotzschc D. et al. // Proc. of SPIE. 2015. V. 9589. P. 95890M.
Bertilson M., Hofsten O., Vogt U. et al. // Optics Express. 2009. V. 17(13). P. 11057.
Müller M., Mey T., Niemeyer J. et al. // Optics Express. 2014. V. 22(19). P. 23489.
Oton J., Sorzano C., Marabini R. et al. // Optics Express. 2015. V. 23(8). P. 9567.
Oton J., Pereiro E., Perez-Berna A. et al. // Biomed. Opt. Express. 2016. V. 7(12). P. 5092.
Oton J., Sorzano C., Pereiro E. et al. // Journal of Structural Biology. 2012. V. 178. P. 29.
Bogachev S.A., Chkhalo N.I., Kuzin S.V. et al. // Applied Optics. 2016. V. 55(9). P. 21262135.
Andreev S.S., Akhsakhalyan A.D., Bibishkin M.A. et al. // Central European Journal of Physics. 2003. V. 1. P. 191.
Kluenkov E.B., Lopatin A.Ya., Luchin V.I. et al. // Quantum Electronics. 2013. V. 43(4). P. 388.
Chkhalo N.I., Pestov A.E., Salashchenko N.N. et al. // Review of Scientific Instruments. 2015. V. 86. P. 063701.
Зорина М.В., Нефедов И.М., Пестов А.Е. и др. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 8. С. 9.
Brychikhin M.N., Chkhalo N.I., Eikhorn Ya.O. et al. // Applied Optics. 2016. V. 55(16). P. 4430.
Chkhalo N.I., Kaskov I.A., Malyshev I.V. et al. // Precision Engineering. 2017. V. 48. P. 338.
Malyshev I.V., Chkhalo N.I., Akhsahalian A.D. et al. // J. of Modern Optics. 2017. V. 64(4). P. 413.
Chkhalo N.I., Klimov A.Y., Rogov V.V. et al. // Rev. Sci. Instrum. 2008. V. 79. P. 033107.
Chkhalo N.I., Malyshev I.V., Pestov A.E. et al. // Applied Optics. 2016. V. 55(3). P. 619.
Takeo E., Fumihiko I., Hiromichi M. et al. // Optics Express. 2010. V. 18(7). P. 7203.
Chkhalo N.I., Salashchenko N.N. and Zorina M.V. et al. // Rev. Sci. Instrum. 2015. V. 86. P. 016102.
Chkhalo N.I., Churin S.A., Pestov A.E. et al. // Optics Express. 2014. V. 22(17). P. 20094.
Chkhalo N.I., Churin S.A., Mikhaylenko M.S. et al. // Applied Optics. 2016. V. 55(6). P. 1249.
Каллаев С.Н., Омаров З.М., Митаров Р.Г., Садыков С.А. и др. // Физика твердого тела. 2011. Т. 53(7). С. 1307.
http://www.standa.lt/products/catalog/optical_tables.
http://www.aspe.net/publications/Spring_2006/spr06abs/ 1876.pdf.
Chikkamaranahalli S., Vallance R.R, Damazo B.N. et al. // Proceedings of the Annual conference of the American Society for Precision Engineering (ASPE), Norfolk, VA, October 2005.
https://www.princetoninstruments.com/products/SOPHIA-XO-xray-cameras.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования