Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 1, стр. 107-112
Особенности свойств поверхности полупроводникового твердого раствора (GaAs)1 – x – у(Ge2)x(ZnSe)y с квантовыми точками ZnSe
С. З. Зайнабидинов a, *, А. С. Саидов b, А. Й. Бобоев a, **, Ж. Н. Усмонов a
a Андижанский государственный университет им. З.М. Бабура
170100 Андижан, Узбекистан
b Физико-технический институт НПО “Физика–Солнце” АН РУз
100084 Ташкент, Узбекистан
* E-mail: prof_sirojiddin@mail.ru
** E-mail: aboboevscp@gmail.com
Поступила в редакцию 20.01.2020
После доработки 14.03.2020
Принята к публикации 17.03.2020
Аннотация
Впервые выращены пленки (GaAs)1 –x–у(Ge2)x(ZnSe)y с квантовыми точками ZnSe методом жидкофазной эпитаксии. Выращенные слои имели р-тип проводимости с концентрацией носителей тока 5.8 × 1015 см–3, подвижностью μ = 359 см2/(В · с) и удельным сопротивлением 3 Ом ⋅ см. Рентгенодифракционное исследование показало, что полученная пленка является монокристаллической, состоит из блоков с размерами 52 нм, имеет ориентацию (100) и структуру типа сфалерита (типа ZnS). Обнаружено, что парные атомы Ge частично заменяют молекулы GaAs в дефектных областях матричной решетки и образуют нанокристаллы с размерами 44 нм. Установлено, что молекулы селенида цинка растут на поверхности твердого раствора GaAs1 –xGex в форме островков-куполов – квантовых точек с размерами R = 25–35 нм, высотой h = 7–12 нм и плотностью 3.7 × 109 см–2.
ВВЕДЕНИЕ
Полупроводниковые квантовые точки чаще всего изготавливают, используя спонтанное возникновение периодически упорядоченных структур, т.е. механизм Странского–Крастанова при образовании смачивающего слоя на поверхности и в объеме эпитаксиальных пленок полупроводниковых гетероструктур. Основным фактором для формирования таких нанообъектов является различие постоянных кристаллических решеток материалов квантовой точки и матрицы. Спонтанное упорядочение наноструктур позволяет получать включения узкозонных полупроводников в широкозонной матрице и тем самым создавать локализующий потенциал для носителей тока. Периодические структуры таких включений могут создавать массивы квантовых точек, квантовых проволок или сверхрешетки. Особенности жидкофазного роста узкозонных квантовых точек InSb на подложке InAs рассмотрены в [1], а также квантовые точки InSb на подложке GaSb в [2]. Формирование квантовых точек в системе InSb/GaSb методами молекулярно-пучковой эпитаксии (МПЭ) и газофазной эпитаксии из металлорганических соединений (МОГФЭ) были подробно рассмотрены в [3, 4]. При стандартном процессе выращивания материалов на основе InSb как методом МПЭ, так и методом МОГФЭ плотность массивов когерентных квантовых точек на поверхности бинарной подложки не превышала 3 × 109 см–2. В [5] показано, что полученные методом МПЭ самоорганизованные квантовые точки GaSb/GaP состоят из практически полностью релаксированного GaSb. Установлено, что они имеют зонную структуру первого рода с основным электронным состоянием, соответствующим непрямой долине зоны проводимости GaSb. Проводились исследования фотолюминесценции полупроводниковых квантовых точек InAs, поверх которых был выращен слой GaAs в низкотемпературном режиме, с использованием различных разделительных слоев GaAs или AlAs, выращенных при нормальных для молекулярно-лучевой эпитаксии температурах [6]. В [7] изучена температурная зависимость спектра фотолюминесценции асимметричных систем двойных квантовых ям CdSe/ZnSe с различной номинальной толщиной слоев самоорганизованных квантовых точек, разделенных барьером ZnSe различной ширины. Обнаружено, что передача энергии между состояниями мелких и глубоких квантовых ям растет с температурой и носит ярко выраженный активационный характер. Передача энергии из состояний квантовой точки мелкой ямы в состояния квантовой точки глубокой ямы слабо меняется с увеличением расстояния между квантовыми ямами, что свидетельствует о резонансной связи между состояниями соседних ям. Авторы [8], исходя из энергии ковалентной связи атомов материалов нановключений и матрицы, предлагают разделить квантовые точки и квантовые ямы следующим образом: если ширина запрещенной зоны нановключений больше, чем ширина запрещенной зоны базового полупроводника, то образуется квантовая точка, а если наоборот, то квантовая яма. Отсюда следует, что создание новых многослойных гетероструктур с нанообъектами, исследование особенностей поверхностных свойств и их связь с объемными параметрами является актуальной задачей современного этапа развития физики полупроводников.
МЕТОДИКА ЭКСПЕРИМЕНТА
Эпитаксиальные пленки (GaAs)1 ‒ x ‒ у(Ge2)x(ZnSe)y получены методом жидкофазной эпитаксии. Подложками служили пластины из арсенида галлия диаметром 20 мм и толщиной 350 мкм, вырезанные в кристаллографическом направлении [100], легированные оловом с концентрацией (3–5) × 1017 см–3. Состав раствора-расплава был получен на основе предварительных исследований системы GaAs–Ge–Sn–ZnSe и литературных данных [9–11]. Температурный интервал кристаллизации составлял 730–640°С при скорости роста 0.1 мкм/мин. Выращенные эпитаксиальные слои имели р-тип проводимости с концентрацией носителей тока 5.8 × 1015 см–3, подвижностью μ = 359 см2/В · с и удельным сопротивлением 3 Ом ⋅ см.
Структурные исследования подложек и эпитаксиальных пленок были выполнены на дифрактометре XRD-6100 (Shimadzu, Япония) (CuKα-излучение). Напряжение на трубке составляло 40 кВ, а ток 30 мА. Диапазон сканирования 8°–90°, скорость сканирования 2 град/мин, шаг 0.02°. Полученные данные обрабатывали методом Ритвельда с использованием программы Fullprof. Был определен фазовый состав поверхности эпитаксиальных слоев. Показано, что распределение составляющих компонентов пленок по поверхности однородное, а по толщине пленки содержание Ge2 и ZnSe изменяется в пределах 0 ≤ х ≤ 0.17, 0 ≤ у ≤ 0.14, что снижает упругие напряжения из-за несоответствия параметров решетки подложки и пленки. На рис. 1 показано распределение растворообразующих компонентов (GaAs, Ge2, ZnSe) по толщине эпитаксиальных слоев (GaAs)1 – x – у(Ge2)x(ZnSe)y. Как видно из рис. 1, содержание арсенида галлия уменьшается, а Ge, ZnSe увеличивается до толщины 4 мкм. Начиная с 4–6 мкм содержание компонентов твердого раствора остается постоянным.
Рис. 1.
Распределение GaAs, Ge2, ZnSe по толщине пленок d в эпитаксиальных слоях твердого раствора (GaAs)1 –x–у(Ge2)x(ZnSe)y [12].
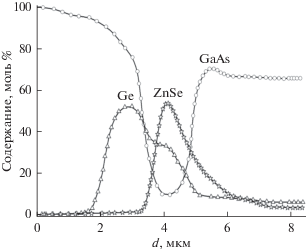
Свойства поверхности пленок изучали с использованием промышленного атомно-силового микроскопа (АСМ) Solver-NEXT, позволяющего исследовать рельеф поверхности.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На рис. 2а представлена дифрактограмма подложки GaAs. Видно, что на дифракционной картине присутствуют несколько рефлексов различной интенсивности. Анализ показал, что поверхность подложки соответствует кристаллографической плоскости (100). На дифрактограмме наблюдается серия рефлексов типа h00 (h = 1, 2, 3, …) большой интенсивности: 200GaAs с d/n = 0.2814 нм, 400GaAs с d/n = 0.1412 нм и 600GaAs с d/n = 0.09422 нм. Их Kβ-составляющие видны при углах рассеяния 2θ = = 28.2°, 58.8°, 95.2° соответственно. При средних углах рассеяния наблюдается еще один слабый рефлекс 220GaAs c d/n = 0.1998 нм при 2θ = 45.4°. Большая интенсивность основного рефлекса 400GaAs (2 × 105 имп./с), сравнительно узкая его ширина (FWHM = 0.0039 рад) и ровный минимальный уровень фона неупругого рассеяния свидетельствуют о высокой степени совершенства кристаллической решетки подложки. Экспериментально определенный параметр решетки подложки aGaAs = 0.56532 нм, что очень близко к ее табличному значению aGaAs = 0.5646 нм [13].
На рис. 2б представлена дифрактограмма эпитаксиальной пленки твердого раствора (GaAs)1 ‒ x –у(Ge2)x(ZnSe)y Она существенно отличается от дифрактограммы подложки: наблюдаются увеличение интенсивности основного рефлекса 400 на 4.5%, интенсивности рефлексов 200 и 600 увеличены 1.7 и 1.4 раза соответственно, а интенсивность рефлекса 220 увеличена незначительно. Одновременно появляются новые пики с d/n = 0.1268 нм (2θ = 74.9°), 0.1263 нм (2θ = = 75.2°) и 0.1001 нм (2θ = 100.8°), прослеживается немонотонный характер уровня фона неупругого рассеяния в областях малых и средних углов. Сравнительно узкая ширина (FWHM = 4.36 × 10–3 рад) и большая интенсивность основного рефлекса 400 (2 × 105 имп./с), а также присутствие на дифрактограмме других отражений четных порядков свидетельствуют о достаточно высокой степени совершенства кристаллической решетки пленки, т.е. она имеет структуру типа сфалерита (ZnS) и является монокристаллической с ориентацией (100). Размер субкристаллитов (блоков) пленки, оцененный по ширине данного пика, составляет около 52 нм.
Заметное расщепление рефлекса на α1- и α2-компоненты излучения, но значительно меньшее, чем их расчетные значения (I(α1) = 2I(α2)), указывает на незначительные упругие микронапряжения решетки приповерхностной области пленки. Микроискажения решетки и несколько бóльшие интенсивности рефлексов h00 (h = 2, 4, 6), чем интенсивности этих же отражений подложки, свидетельствуют о частичном замещении некоторых молекул арсенида галлия парными атомами Ge в дефектных областях решетки пленки, где имеются узлы с высоким потенциалом, т.е. на границе и приграничной областях раздела блоков. Об этом свидетельствует параметр решетки пленки, определенный по трем рефлексам (200, 400 и 600): af = 0.56568 нм, что несколько больше, чем параметр решетки подложки as = 0.56532 нм. Это позволяет предположить, что базовая решетка исследуемого твердого раствора состоит из двойного полупроводникового соединения – GaAs и элементарного полупроводника Ge, т.е. GaAs1 – xGex. Близость параметров решеток GaAs и Ge, порядкового номера в периодической системе и факторов атомного рассеяния элементов As, Ga и Ge делает неразличимыми дифрактограммы GaAs и GaAs1 – xGex, что и наблюдается в эксперименте. Этот вывод подтверждается уровнем фона неупругого рассеяния пленки в окрестностях рефлексов h00. Она на 22% выше, чем уровень фона в аналогичных угловых диапазонах подложки, что свидетельствует о локальном характере механических напряжений на поверхности, которые связаны с неоднородным распределением атомов германия в матричной решетке пленки. Наличие атомов германия в решетке твердого раствора соответствует дифракционному отражению 220 с d/n = 0.2000 нм (2θ = 45.3°) нанокристаллов Ge с другой ориентацией (рис. 3а), нежели ориентация подложки. Из рис. 3а видно, что форма этого рефлекса – триплет, образованный двумя пиками, частично перекрывающимися по α1- и α2-линиям излучения от одинаково ориентированных нанокристаллитов Ge и ZnSe. Размеры нанокристаллов Ge составляли ∼44 нм. Дополнительным подтверждением этого служит присутствие на дифрактограмме двух слабых запрещенных отражений 211 с d/n = 0.2305 нм (2θ = = 38.5°) и 500 с d/n = 0.1128 нм (2θ = 86.1°) для структур типа сфалерита. Их интенсивности относятся к интенсивности основного рефлекса 400 как I211/I400 = 4.73 × 10–4 и I500/I400 = 2.74 × 10–4 соответственно. Эти значения несколько больше, чем величина 10–4, соответствующая равномерному распределению примесей в алмазаподобной решетке [14]. На дифрактограмме (рис. 2б) также наблюдается рефлекс 440 (d/n = 0.1001 нм, 2θ = = 100.8°) от матричной решетки эпитаксиального слоя. Следовательно, примеси Ge в решетке GaAs распределены неравномерно, и в дефектоспособных областях матричной решетки эти примеси самообразуются в нанокристаллы германия. Видимо, рост нанокристаллитов германия другой ориентации связан со скоростью релаксационного процесса упругого напряжения в эпитаксиальном слое при выращивании. Параметр решетки нанокристаллов Ge, определенный по дифрактограмме, составил aGe = 0.5662 нм, что близко к его табличному значению aGe = 0.5657 нм [13].
В многокомпонентных твердых растворах искажение решетки выращенной пленки стимулирует формирование нановключений различных фаз для энергетической стабилизации пленки. Также на дифрактограмме пленки наблюдаются еще два сильных рефлекса. Анализ показал, что они соответствуют нанокристаллитам селенида цинка (ZnSe): 220, d/n = 0.2010 нм (2θ = 45.1°) и 420, d/n = 0.1230 нм (2θ = 74.95°). Несмотря на различие в направлениях роста, оценки показали, что для этих нанокристаллитов характерны почти одинаковые размеры ∼59 нм. Этот факт позволяет предположить, что нанокристаллиты селенида цинка растут на поверхности твердого раствора GaAs1 –xGex в форме островков – квантовых точек. Было обнаружено, что при многослойном росте полупроводников с параметрами кристаллической решетки, отличающимися от параметров решетки подложки, можно получить на поверхности роста почти одинаковые по размеру островки (квантовые точки) [15, 16]. Оказывается, энергетически более выгодным становится формирование квантовых точек другой фазы на поверхности матричной решетки пленки по сравнению с однородно напряженным слоем. Свидетельством этого служит форма дифракционного отражения 600 (рис. 3б). Видно, что дифракционное отражение 600 четко разрешается по α1- и α2-компонентам излучения для решеток GaAs1 –xGex и ZnSe соответственно. Экспериментально определенные параметры решетки селенида цинка и арсенида галлия aZnSe = 0.5669 и aGaAsGe = 0.5668 нм, что близко к их табличным значениям aZnSe = 0.5661 и aGaAs = 0.5646 нм соответственно [13].
На рис. 4 показано двумерное и трехмерное изображение поверхности эпитаксиальной пленки (GaAs)1 –x–у(Ge2)x(ZnSe)y. Видно, что на поверхности пленок образуются отдельные наноостровки различного размера. Анализ показал, что диаметр основания наноостровков варьируется в интервале от 50 до 70 нм, а высота – от 7 до 12 нм. При эпитаксиальном наращивании различных полупроводниковых материалов энергия деформации, вызванная несоответствием параметров кристаллических решеток контактирующих полупроводников, является основным факторам для формирования самоорганизующихся трехмерных островков [17]. Поскольку рассогласование постоянных решеток для систем GaAs/ZnSe и GaAs/Ge (менее 1%) одинаково, возможно формирование квантовых точек как ZnSe, так и Ge на поверхности GaAs. На рис. 2 показано, что в пленке присутствовали равномерно расположенные нанокристаллиты ZnSe с параметром решетки aZnSe = 0.5669 нм и с размерами 59 нм в направлении [100], а также Ge с параметром решетки aGe = 0.5662 нм и размерами 44 нм в направлении [100] соответственно. Заметим, что параметр решетки нанокристаллитов ZnSe в эпитаксиальной пленке на 0.22% больше, чем его табличное значение, что, возможно, обусловлено деформацией кристаллической решетки эпитаксиальной пленки. Размеры наноконусов ZnSe (квантовых точек), определенные по данным АСМ на поверхности пленки и нанокристаллитов и данным рентгеновской дифракции в эпитаксиальной пленке, близки. Данные АСМ показывают, что на этапе роста наноостровки ZnSe в твердом растворе (GaAs)1 –х(Ge2)х имеют геометрическую форму купола с характерным латеральным размером 50–70 нм и с круглым основанием. На основе этих данных, а также результатов структурного анализа можно сделать вывод о том, что наблюдаемые наноостровки на поверхности эпитаксиальных слоев обусловлены квантовыми точками ZnSe с размерами R = 25–35 нм, высотой 3–12 нм и плотностью 3.7 × 109 см–2.
Рис. 4.
Двумерное (а) и трехмерное (б) изображения поверхности эпитаксиальной пленки (GaAs)1 –x–у(Ge2)x(ZnSe)y.

Также был измерен спектр фотолюминесценции поверхности твердого раствора (GaAs)1 –x–у(Ge2)x(ZnSe)y при температуре 4 К (рис. 5). Фотолюминесценцию возбуждали лазерным излучением (λл = 325 нм) со стороны эпитаксиального слоя, сигнал регистрировали на установке СДЛ-2. Как видно из рис. 5, спектр фотолюминесценции твердого раствора (GaAs)1 –x–y(Ge2)х(ZnSe)у имеет широкую полосу, охватывающую практически весь видимый диапазон излучения с максимумом при λmax= 457 нм. Этот пик соответствует ширине запрещенной зоны ZnSe, равной 2.7 эВ. Явное выделение пика излучения ZnSe на фоне широкого спектра фотолюминесценции, по-видимому, свидетельствует о возникновении уровня с энергией ионизации 2.7 эВ, расположенного на ΔEi = Eg, ZnSe – Eg,GaAs = 1.26 эВ ниже потолка валентной зоны базового полупроводника GaAs [18].
Рис. 5.
Спектр фотолюминесценции поверхности твердого раствора (GaAs)1 –x–y(Ge2)х(ZnSe)у, при температуре 4 К.

Поскольку подаваемое лазерное излучение с энергией 3.82 эВ практически полностью поглощается на приповерхностной области эпитаксиального слоя толщиной ∼1 мкм, фотолюминесцентное излучение возникает именно с этой области пленки. Однако до глубины 1.5 мкм содержание ZnSe в пленке составляет 12–14 мол. % (рис. 1). Следовательно, при содержании такого количества молекул ZnSe в твердом растворе (GaAs)1 –x–у(Ge2)x(ZnSe)y они представляют собой изовалентную примесь с уровнем, расположенным в валентной зоне GaAs.
ЗАКЛЮЧЕНИЕ
Таким образом, на основе результатов проведенных исследований можно сделать следующие выводы. Выращенные эпитаксиальные слои твердого раствора (GaAs)1 –x – у(Ge2)x(ZnSe)у имеют структуру типа сфалерита и являются монокристаллическими, с размерами блоков 52 нм и с ориентацией (100), соответствующей ориентации подложки. Парные атомы Ge частично заменяют молекулы GaAs в дефектных областях матричной решетки на границах и поверхностных слоях раздела с последующей сегрегацией ионов германия и образованием нанокристаллов размером 44 нм. Молекулы селенида цинка образуют наноостровки на поверхностном слое твердого раствора GaAs1 – xGex. Наноостровки ZnSe в твердом растворе (GaAs)1 – х(Ge2)х имеют геометрическую форму купола с латеральными размерами 55–65 нм. Результаты исследования методом АСМ подтверждают данные рентгеноструктурного анализа о формировании наноостровков на поверхности твердого раствора GaAs1 – xGex. Определены квантовые точки (наноостровки) ZnSe с размерами R = 25–35 нм, высотой h = 7–12 нм и плотностью 3.7 × 109 см–2 на поверхности твердого раствора GaAs1 –xGex.
Список литературы
Моисеев К.Д., Пархоменко Я.А., Гущина Е.В. и др. // Физика и техника полупроводников. 2009. Т. 43. № 8. С. 1142.
Пархоменко Я.А., Дементьев П.А., Моисеев К.Д. // Физика и техника полупроводников. 2016. Т. 50. № 7. С. 993.
Tasco V., Deguffroy N., Baranov A.N. et al. // Cryst. Growth. 2007. V. 301. P. 713.
Mock P., Booker G.R., Mason N.J. et al. // Mater. Sci. Eng. 2001. V. 80. P. 112.
Абрамкин Д.С., Путято М.А., Гутаковский А.К. и др. // Физика и техника полупроводников. 2012. Т. 46. № 12. С. 1571.
Косарев А.Н., Чалдышев В.В., Преображенский В.В. и др. // Физика и техника полупроводников. 2016. Т. 50. № 11. С. 1519.
Резницкий А.Н., Клочихин А.А., Еременко М.В. // Физика и техника полупроводников. 2014. Т. 48. № 3. С. 345.
Saidov A.S., Amonov K.A., Kutlimurotov B.R. // Appl. Sol. En. 2016. V. 52. № 1. P. 1.
Бобоев А.Й. Структурные особенности, электрофизические и фотоэлектрические свойства гетероструктур n-(GaAs)-р-(GaAs)1 –х–у(Ge2)х(ZnSe)у: Дис. … PhD по физ.-мат. наукам. Ташкент: ИФПиМ, 2019.120 с.
Усмонов Ш.Н. Взаимодействие примесей в твердых растворах на основе кремния, арсенида-галлия, селенида-цинка, сернистого-кадмия и электрофизические свойства гетероструктур, полученных на их основе: Дис. … DSc по физ.-мат. наукам. Ташкент: ФТИ, 2018. 221 с.
Давлатов У.Т. Гетероструктуры Si–Si1 –xGex, Si–Si1 –xGex–GaAs, Si–(Si2)1 –x(GaAs)x, (0 ≤ x ≤ 1), полученные методом жидкофазной эпитаксии, их электрофизические и фотоэлектрические характеристики: Дис. … к.ф.-м.н. Ташкент: ФТИ, 2006. 125 с.
Зайнабидинов С.З., Саидов А.С., Каланов М.У., Бобоев А.Й. // Гелиотехника. 2019. № 4. С. 295.
Равдель А.А., Пономарева А.М. Краткий справочник физико-химических величин. С.-Пб.: Иван Федоров, 2003. 240 с.
Шулпина И.Л., Кютт Р.Н., Ратников В.В. и др. // Журн. тех. физ. 2010. Т. 80. № 4. С. 105.
Кульбачинский В.А. // Сорос. образ. журн. 2001. Т. 7. № 4. С. 98.
Берт Н.А., Колесникова А.Л., Королев И.К. и др. // Физика твердого тела. 2011. Т. 53. Вып. 10. С. 1986.
Дубровский В.Г. Теория формирования эпитаксиальных наноструктур. М.: Физматлит, 2009. 364 с.
Зайнабидинов С.З., Бобоев А.Й., Усмонов Ж.Н. // Альтернативная энергетика и экология. 2019. № 10–12. С. 43.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования