Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2021, № 6, стр. 75-79
Об образовании пленок силицидов металлов (Li, Cs, Rb, Ba) при ионной имплантации в Si и последующем термическом отжиге
А. С. Рысбаев a, *, М. Т. Нормуродов b, **, Ж. Б. Хужаниёзов a, А. А. Рысбаев b, Д. А. Нормуродов b
a Ташкентский государственный технический университет
100095 Ташкент, Республика Узбекистан
b Каршинский государственный университет
180103 Карши, Республика Узбекистан
* E-mail: rysbaev@mail.ru
** E-mail: m.normurodov@mail.ru
Поступила в редакцию 24.09.2020
После доработки 22.12.2020
Принята к публикации 27.12.2020
Аннотация
В работе методами электронной спектроскопии и дифракции медленных электронов исследованы процессы образования тонких монокристаллических пленок силицидов Li, Cs, Rb, Ba, формирующихся при имплантации ионов в Si(111) и Si(100) с низкой энергией (<5 кэВ) и большой дозой (~1017 см–2). Установлено, что имплантация ионов Li, Cs, Rb, Ba с энергией 1 кэВ и дозой 2 × 1017 см–2 с последующим кратковременным прогревом приводит к образованию пленок, имеющих следующие сверхструктуры Si (111)–2 × 2Rb, Si (111)–4 × 4Cs и Si (111)–4 × 4Li. Описано влияние ионной имплантации и последующего прогрева на частоту поверхностных и объемных плазменных колебаний валентных электронов кремния.
ВВЕДЕНИЕ
Значительный интерес к исследованию силицидов (особенно наноразмерных пленок силицидов) обусловлен большой потенциальной возможностью их применения в качестве материала для низкоомных контактов, p–n-переходов, элементов кремниевых интегральных схем, что подтверждается интенсивным ростом публикаций по этой тематике [1–3]. Технология получения, структура и свойства силицидов металлов достаточно хорошо изучены [4, 5]. В настоящее время бурно развивается направление по созданию тонкопленочных структур на поверхности кремния. Причем преимущество отдается системам “пленка–подложка”, имеющим близкие значения параметров кристаллической решетки и температурного коэффициента расширения [6–9].
МЕТОДИКА
Экспериментальные измерения проводили в приборе с анализатором типа сферического зеркала с тормозящим полем, позволяющим исследовать поверхность методами электронной спектроскопии и дифракции медленных электронов при давлении остаточных газов не более 10–7 Па [10, 11]. В качестве объектов исследования были выбраны монокристаллы Si(111) и Si(100) n- и р‑типа с удельным сопротивлением 6000 Ом · см. В технологической камере проводилась очистка поверхности исследуемых материалов термическим прогревом, электронной бомбардировкой, ионным травлением, а также имплантация ионов Ва и щелочных элементов с энергией 0.5–5 кэВ и с различной дозой: от 1013 до 2 × 1017 см–2. Очистку образцов Si проводили термическим прогревом в два этапа: длительно при температуре 1200 K в течение 60 мин и кратковременно при 1500 K в течение 1 мин. Кроме того, использовался разработанный авторами новый способ очистки поверхности монокристаллов Si, который заключается в предварительной имплантации ионов Ва или щелочных элементов с низкой энергией и большой дозой в очищенный традиционным способом кремний и в последующем кратковременном прогреве при 1550 К [12]. В результате внедренные атомы щелочных металлов удаляются из приповерхностной области Si, образуя соединения с атомами Si, C, O, S и др., и в итоге происходит к дополнительная очистка Si.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Изменения элементного состава приповерхностной области Si при имплантации Ва и щелочных элементов исследовали методом электронной оже-спектроскопии (ЭОС). На рис. 1 приведены оже-спектры кремния, имплантированного ионами Rb с Е0 = 1 кэВ с различной дозой D. Как следует из спектров ЭОС, при имплантации ионов Rb+ до дозы 1015 см–2 пики, характерные для Rb, практически отсутствуют. Это, вероятно, связано с глубоким проникновением ионов Rb+ при малых дозах облучения (за счет каналирования). Начиная с дозы 5 × 1015 см–2 (спектр 4), в спектре появляются оже-пики, характерные для Rb: 28, 31, 57, 76, 106 и 114 эВ. При этом также присутствует основной низкоэнергетический пик кремния SiL2, 3VV (92 эВ).
Рис. 1.
Оже-спектры кремния при имплантации ионов Rb+ с E0 = 1 кэВ и с различной дозой облучения D, см–2: 0 – спектр 1; 5 × 1013 – 2; 5 × 1014 – 3; 5 × 1015 – 4; 1016 – 5; 8 × 1016 – 6; 2 × 1017 – 7.
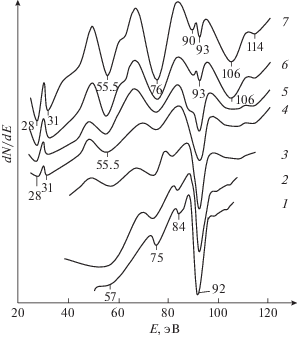
С увеличением дозы ионов Rb+ (D > 1016 см–2) в спектре наблюдается превращение оже-пика SiL2, 3VV из синглентной формы в дублетную (рис. 1, спектры 5–7). При этом сохраняются оже-пики Rb при 28, 31, 55.5 и 76 эВ.
Такое изменение формы оже-пика кремния при 92 эВ, как мы полагаем, связано с образованием химического соединения атомов Rb с атомами Si. При этом связь осуществляется sp3-гибридизированными электронами Si с s-электронами Rb. Аналогичное раздвоение оже-пика кремния SiL2, 3VV нами наблюдалось также при имплантации ионов Li+, Сs+ и Ba+. На рис. 2 приведены спектры ЭОС для чистого Si (спектр 1) и Si, имплантированного ионами Li (спектр 2), Cs (спектр 3), Ba (спектр 4) c энергией 1 кэВ и с большой дозой облучения (D = 2 × 10 17 см–2), из которых следует, что в ионно-имплантированном слое Si атомы внедренной примеси образуют химическое соединение с кремнием.
Рис. 2.
Спектры ЭОС для чистого Si (спектр 1) и Si, имплантированного ионами Li (2), Cs (3), Ba (4) c E0 = 1 кэВ и D = 2 × 1017 см–2.

Для оценки типа образующихся соединений нами были определены концентрационные профили распределения внедренных атомов по глубине, полученные расчетным способом с учетом коэффициентов элементной оже-чувствительности с помощью компьютерной программы. На рис. 3 приведены концентрационные профили распределения атомов Ba, Cs, Rb и Li, имплантированных в Si с Е0 = 1 кэВ с максимальной дозой облучения, полученные после кратковременного отжига образцов в интервале температур 600–800 К в течение 1–2 мин. Из сравнения профилей следует, что ионы Li проникают в Si(111) гораздо глубже, чем другие ионы. Глубина проникновения Li при имплантации с энергией 1 кэВ составляет 15 нм. Это связано с тем, что ковалентный радиус атомов Li является наименьшим по сравнению с остальными выше перечисленными элементами и составляет 1.23 Å, что значительно меньше межатомного расстояния атомов Si на грани (111). Для того, чтобы довести концентрацию Li в приповерхностной области Si до 50 ат. %, после имплантации ионов Li c дозой 5 × 1017 см–2 необходим прогрев при Т = 1000 К в течение 1 минуты. При этом за счет диффузии атомов Li к поверхности в приповерхностном слое толщиной 6 нм образуется моносилицид лития. В процессе получения профилей распределения атомов Ва и щелочных элементов в Si(100) было установлено, что глубина проникновения ионов при одинаковых условиях имплантации больше, чем в Si(111). Это очевидно связано с тем, что грань (111) кремния является наиболее плотной, а (100) – наименее плотной. Экспериментально также установлено, что кратковременный отжиг ионно-имплантированных с большой дозой образцов Si в течение 2–4 мин при температуре Т = 700–1000 К приводит к десорбции несвязанных атомов примеси, при этом оставшиеся атомы полностью вступают в химическое соединение с атомами Si. Следует отметить, что соединение ВаSi (а также соединения CsSi, LiSi и RbSi), образованное в имплантированном слое, не соответствует правилу нормальной валентности (в противном случае должно было образоваться соединение Bа2Si) и характеризуется укороченными расстояниями между атомами кремния, что свидетельствует о ковалентном типе связи Si–Si.
Рис. 3.
Концентрационные профили распределения атомов Ba (1), Cs (2), Rb (3) и Li (4), имплантированных в Si с Е0 = 1 кэВ с максимальной дозой облучения, полученные после кратковременного отжига имплантированных образцов Si в интервале температур 600–800 К в течение 1–2 мин.
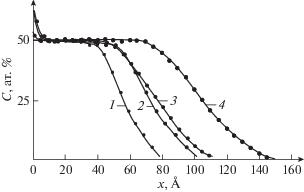
Барий, как и все щелочные элементы, выступая в кремнии в качестве донора, оказывает стабилизирующее действие на sp3-конфигурации атомов кремния и тем самым упрочняет ковалентные связи Si–Si.
Согласно [13] в кристаллических структурах силицидов щелочных металлов (NaSi, КSi, RbSi, CsSi) атомы кремния образуют тетраэдрические изолированные группировки с электронной конфигурацией sp3, представляющие (Si4)4 – полианионы, окруженные 16 атомами щелочного металла. Таким образом, в данном случае характерно сочетание ионной связи (между атомами металлов и атомами кремния) с ковалентной связью между атомами Si. Однако полученные нами ионно-имплантированные слои BaSi оказались более термически устойчивыми, чем пленки силицидов щелочных элементов. Это вероятно является следствием того, что связь между атомами бария и Si является более ковалентной, чем связь между кремнием и щелочными элементами.
Исследование поверхности силицидов металлов методом ДМЭ показало, что они обладают следующими структурами: Si(111)–2 × 2Rb (рис. 4а), Si(111)–4 × 4Cs (рис. 4б), Si(111)–4 × × 4Li (рис. 4в), полученными при энергии падающих электронов Ер = 43, 45 и 42 эВ соответственно.
Рис. 4.
Картины ДМЭ поверхности Si(111), имплантированного ионами Rb, Cs, Li и последующего прогрева: а – Si(111)–2 × 2Rb, б – Si(111)–4 × 4Cs, в – Si(111)–4 × 4Li.

Примечательно, что на картинах ДМЭ для CsSi (рис. 4б) помимо основных и дробных рефлексов, свидетельствующих об образовании поверхностной структуры Si(111)–4 × 4Cs присутствуют дополнительные рефлексы, связанные с наличием плоскостей (104), ограняющих фасетки. Наличие фасеток легко устанавливается по характеру их смещения при изменении энергии электронов Ер: если основные рефлексы смещаются к центру, то рефлексы от фасетированных плоскостей смещаются от центра. На рис. 4а и 4в для Si(111)–2 × × 2Rb и Si(111)–4 × 4Li фасетки отсутствуют, однако на ДМЭ картине для силицида лития наблюдаются двойниковые рефлексы (дублеты), что говорит о доменном характере пленки лития.
Об образовании силицидных соединений при имплантации ионов в Si и последующем отжиге также свидетельствуют изменения в спектрах характеристических потерь энергии (ХПЭ). На рис. 5 приведены спектры ХПЭ для чистого Si и Si, имплантированного ионами Rb с Е0 = 1 кэВ и различной дозой D, см–2. Спектр (7) получен после отжига имплантированного Si при 800 К в течение 1 мин. Из рис. 5 следует, что начиная с дозы 5 × 1014 см–2 (рис. 5, спектр 3) пики потерь энергии при 11 и 17 эВ, обусловленные возбуждением поверхностных (ħωS) и объемных (ħωV) плазмонов, смещаются в область меньших энергий, что связано, как мы полагаем, с сильным затуханием плазменных колебаний электронов из-за разупорядочения кристаллической структуры имплантированного слоя Si [14]. Кратковременный прогрев ионно-имплантированного Si при 800 К в течение 1 мин. приводит к смещению в спектрах ХПЭ (рис. 5, спектр 7) пиков потерь на возбуждение объемных и поверхностных плазмонов в сторону больших энергий, что, по видимому, связано с увеличением концентрации валентных электронов в монокристаллических силицидных пленках по сравнению с чистым Si.
ЗАКЛЮЧЕНИЕ
В работе показано, что имплантация ионов Ва и щелочных элементов с низкой энергией приводит к частичному образованию химического соединения вводимой примеси с Si, а при дозах ≥2 × 1017 см–2 практически все атомы примеси образуют химическое соединение с Si.
Кратковременный (1–2 мин) постимплантационный прогрев ионно-имплантированных образцов Si при Т = 600–800 К приводит к формированию тонких силицидных пленок RbSi, CsSi, LiSi, BaSi с следующими сверхструктурами: Si(111)–2 × 2Rb, Si(111)–4 × 4Cs и Si(111)–4 × 4Li и Si(111)–1 × 1 Ва.
Уменьшение частоты поверхностных и объемных плазменных колебаний валентных электронов Si(111) при имплантации щелочных ионов авторами объясняется сильным затуханием плазменных колебаний электронов вследствие разупорядочения кристаллической структуры имплантированного слоя Si.
Увеличение энергии пиков потерь на возбуждение объемных и поверхностных плазмонов после кратковременного прогрева ионно-имплантированного Si объясняется образованием химического соединения и соответственно, увеличением концентрации валентных электронов в монокристаллических силицидных пленках по сравнению с чистым Si.
Список литературы
Климов В.В. // Наноплазмоника. М.: Изд-во Физматлит, 2009. С. 76.
www. sciencedirect.com.
Иваненко Л.И. // Доклады БГУИР, 2005. № 2. С. 90.
Ivanenko L.I., Shaposhnikov V.L., Filonov A.B., Krivosheeva A.V. // Thin Solid Films. 2004. V. 461. P. 141.
Петрова Л.И., Федоров М.И., Зайцев В.К., Енгалычев А.Э. // Неорганические материалы. 2013. Т. 49. № 4. С. 367.
Суворова Е.И., Клечковская В.В. // Кристаллография. 2013. Т. 58. № 6. С. 855.
Orekhov A.S., Kamilov T.S., Orekhov A.S., Arkharova N.A., Rakova E.V., Klechkovskaya V.V. // Nanotechnol. Russ. 2016. V. 11. № 9–10. P. 610.
Bezbabnyi D.A. Study of the formation, structure and properties of films of semiconductor calcium silicides on Si (111): Extended Abstract of Doctoral Dissertation. Vladikavkaz, 2014. 25 p.
Kamilov T.S., Rysbaev A.S., Klechkovskaya V.V., Orekhov A.S., Igamov B.D., Bekpulatov I.R. // Applied Solar Energy. 2019. V. 55. № 6. P. 380.
Рысбаев А.С., Нормуродов М.Т., Насриддинов С.С. // Радиотехника и электроника. 1997. Т. 42. № 1. С. 125.
Нормуродов М.Т., Руми Д.С., Рысбаев А.С. // Изв. АН УзССР. Сер. физ.-мат. 1986. № 4. С. 70.
Рысбаев А.С., Хужаниязов Ж.Б., Рахимов А.М., Бекпулатов И.Р., РУз. Патент № IAP 05720, 2018.
Самсонов Г.В., Дворнина Л.А., Рудь Б.М. Силициды. Москва: Изд-во Металлургия, 1979. С. 120.
Либенсон Б.Н., Нормурадов М.Т., Рысбаев А.С. // Физика и техника полупроводников. 1990. Т. 24. № 1. С. 166.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



