Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2022, № 12, стр. 48-52
Структурные особенности твердого раcтвора (ZnSe)1 – x – y(Ge2)x(GaAs1 – δBiδ)y c различными нановключениями
С. З. Зайнабидинов a, *, Ш. Б. Утамурадова b, **, А. Й. Бобоев a, b
a Андижанский государственный университет им. З.М. Бабура
170100 Андижан, Узбекистан
b Научно-исследовательский институт физики полупроводников и микроэлектроники при Национальном университете Узбекистана
100057 Ташкент, Узбекистан
* E-mail: prof_sirojiddin@mail.ru
** E-mail: sh-utamuradova@yandex.ru
Поступила в редакцию 25.04.2022
После доработки 22.05.2022
Принята к публикации 22.05.2022
- EDN: XIACAE
- DOI: 10.31857/S1028096022120342
Аннотация
Пленки твердых растворов замещения (ZnSe)1– x – y(Ge2)x(GaAs1–δBiδ)y (0 ≤ x ≤ 0.725 и 0 ≤ у ≤ 0.638) c различными нановключениями были выращены в температурном интервале кристаллизации висмутсодержащего раствора-расплава 750–650°С при скорости охлаждения подложки 1 град./мин. Тонкий слой, обогащенный Ge и GaAs1–δBiδ, образуется между подложкой и приповерхностной областью пленки. Полученные пленки монокристаллические, имеют ориентацию (100) и p-тип проводимости, их толщина составляет 10 мкм. Они имеют структуру сфалерита с параметром решетки 0.5663 нм. Обнаружено, что парные атомы Ge частично замещают молекулы ZnSe в дефектных областях матричной решетки пленки, а остальные атомы формируют нанокристаллы германия с параметром решетки aGe = 0.5659 нм и размером 47 нм на границах раздела субкристаллитов пленки. Установлено, что в процессе кристаллизации в соединениях GaAs1–δBiδ образуются нановключения, т.е. квантовые ямы с размерами 43 нм в приповерхностных областях пленки.
ВВЕДЕНИЕ
Одной из актуальных проблем сегодняшнего дня является решение ряда научно-технических задач, связанных с расширением функциональных возможностей нано- и микроэлектронных систем полупроводниковых электронных изделий в широком диапазоне температур [1, 2]. В настоящее время имеется достаточное число публикаций, посвященных данной проблеме, например легированию примесными атомами, создающими различные энергетические уровни в запрещенной зоне полупроводниковых монокристаллов Si, Ge, GaAs и других, а также дефектам, вводимым при выращивании и нейтронно-трансмутационном легировании. Однако вопросы поведения дефектов и их влияния на токоперенос как в полупроводниковых материалах, так и полупроводниковых многослойных структурах остаются малоизученными. В то же время определение оптимальных технологических условий легирования и создания совершенных структур эпитаксиальных тонких пленок, подбор необходимых компонентов и примесных атомов, которые позволяют целенаправленно управлять их свойствами, представляют большой научный и практический интерес. Особенно мало сведений о результатах исследований молекулярных примесей, поведении нанокристаллитов в твердом растворе, зависимости процессов токопереноса от состава базового материала, взаимодействия нанокристаллитов в полупроводниковых материалах.
В настоящей работе представлены результаты исследования некоторых структурных особенностей пленок твердых растворов (ZnSe)1– x – y(Ge2)x · · (GaAs1–δBiδ)y, выращенных на подложке n-GaAs(100).
МЕТОДИКА ЭКСПЕРИМЕНТА
Эпитаксиальные слои (ZnSe)1– x – y(Ge2)x · · (GaAs1–δBiδ)y были выращены методом жидкостной эпитаксии по технологии, изложенной в [3]. В вертикальной графитовой кассете укрепляли две горизонтально расположенные подложки. Арсенид-галлиевые подложки, вырезанные из монокристаллического GaAs с ориентацией (100) в форме шайбы диаметром 20 мм и толщиной ~350 мкм, имели n-тип проводимости и концентрацию носителей 5 × 1017 см–3. Процесс кристаллизации тонкой пленки состоял в принудительном охлаждении оловянного раствора-расплава в атмосфере водорода, очищенного палладием. Состав раствора-расплава был выбран на основе данных [4, 5] и первоначальных исследований системы GaAs–Ge–ZnSe–Sn. Образцы выращивали при различных параметрах жидкостной эпитаксии. Пленки с заданными заранее физическими свойствами были получены в температурном интервале кристаллизации висмутосодержащего раствора-расплава 750–650°С и скорости охлаждения подложки 1 град/мин. Выращенные пленки имели p-тип проводимости и толщину 10 мкм.
Химический состав выращенных эпитаксиальных слоев (ZnSe)1– x – y(Ge2)x(GaAs1–δBiδ)y исследовали на рентгеновском микроанализаторе Jeol JSM 5910 LV. Проведен фазовый анализ гетероструктур n-GaAs–р-(ZnSe)1– x – y (Ge2)x(GaAs1–δBiδ)y с помощью рентгеновского дифрактометра третьего поколения типа Empyrean Malvern. Для определения максимума пика использована программа OriginPro2019. Рентгенодифракционные измерения проводили в геометрии Брэгга–Брентано в диапазоне 2θБ = 15°–100°, скорость сканирования 1 град/мин.
РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
На основе результатов рентгеновского микрозондового анализа был определен профиль распределения молекул ZnSe, Ge2 и GaAs1 – δBiδ в зависимости от глубины эпитаксиального слоя (рис. 1). Как видно из рисунка, молярное содержание GaAs и ZnSe сначала плавно увеличивается по толщине пленки (ZnSe)1– x – y(Ge2)x · · (GaAs1–δBiδ)y, достигая максимальных значений х = 0.725 и у = 0.638, соответственно, что свидетельствует о высоком перенасыщении раствора-расплава на фронте кристаллизации Ge2 и GaAs1 – δBiδ. Далее молярное содержание Ge2 и GaAs1 – δBiδ медленно уменьшается, достигая значений х = 0.23 и у = 0.3 в приповерхностной области пленки.
Рис. 1.
Профиль распределения молекул ZnSe (1), Ge2 (2) и GaAs1 – δBiδ (3) в эпитаксиальном слое (ZnSe)1– x – y(Ge2)x(GaAs1–δBiδ)y, d = 0 соответствует границе подложки и пленки.
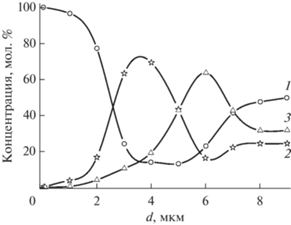
Поскольку рост эпитаксиального слоя осуществляется из ограниченного объема раствора-расплава и растворимость GaAs1–δBiδ в три раза меньше растворимости ZnSe в висмуте, а Ge – в два раза, после интенсивного введения Ge и GaAs1–δBiδ в твердую фазу раствор-расплав обедняется, что в дальнейшем вызывает постепенное уменьшение молярного содержания Ge и GaAs1–δBiδ в направлении роста. На глубине 1 мкм от поверхности пленки молярное содержание Ge и GaAs1–δBiδ не превышает 23 и 30% соответственно. Таким образом, выращенная пленка представляет собой твердый раствор замещения (ZnSe)1– x – y(Ge2)x(GaAs1–δBiδ)y (0 ≤ x ≤ 0.725 и 0 ≤ ≤ у ≤ 0.638) с постепенно изменяющимся составом. Тонкий слой, обогащенный Ge и GaAs1–δBiδ, образуется между подложкой и приповерхностной областью пленки.
На рис. 2 показана дифрактограмма подложки GaAs, на которой наблюдается серия отражений типа h00 (h = 1, 2, 3, …), что соответствует кристаллографической ориентации (100). Основное отражение 400GaAs с d/n = 0.1412 нм и его β-составляющие видны при углах рассеяния 2θ = 66.25° и 58.8° соответственно. Расщепление профиля 400GaAs на компоненты излучения α1 и α2 и их расчетные значения, определенные с помощью соотношения I(α1) = 2I(α2), свидетельствуют о незначительных упругих микроискажениях решетки монокристалла GaAs. Такие области искажений приводят к увеличению параметра решетки подложки, который был определен по основному рефлексу 400 с помощью экстраполяционной функции Нельсона–Рейли [6]:
(1)
$f = {1 \mathord{\left/ {\vphantom {1 2}} \right. \kern-0em} 2}{{{\text{co}}{{{\text{s}}}^{2}}\theta } \mathord{\left/ {\vphantom {{{\text{co}}{{{\text{s}}}^{2}}\theta } \theta }} \right. \kern-0em} \theta } + {{{\text{co}}{{{\text{s}}}^{2}}\theta } \mathord{\left/ {\vphantom {{{\text{co}}{{{\text{s}}}^{2}}\theta } {{\text{sin}}\theta }}} \right. \kern-0em} {{\text{sin}}\theta }},$На рис. 3 приведена дифрактограмма полученного эпитаксиального слоя (ZnSe)1– x – y(Ge2)x · · (GaAs1–δBiδ)y. Как видно, поверхность выращенной пленки соответствует кристаллогарфической ориентации (100). На дифрактограмме пленки видно, что интенсивность отражения 400 уменьшилась на 11%, и наблюдается его сдвиг в сторону меньших углов рассения (рис. 4), а интенсивность отражения 200 уменьшилась в 2.8 раза по сравнению с интенсивностью таких же рефлексов подложки монокристалла GaAs. Наблюдаемые эффекты свидетельствуют об изменении кристаллической решетки твердого раствора (ZnSe)1– x – y(Ge2)x(GaAs1–δBiδ)y. В связи с этим был определен параметр решетки эпитаксиальной пленки по двум рефлексам 200 и 400 с помощью формулы (1), который оказался равным 0.5663 нм. Это значение несколько больше, чем параметр решетки аs = 0.5653 нм монокристалла GaAs, что очень близко к табличному значению параметра решетки аZnSe = 0.5661 селенида цинка. Это указывает на то, что решетка базового материала приближается к кристаллической решетке другого компонента твердого раствора (ZnSe)1– x – y · · (Ge2)x(GaAs1–δBiδ)y, т.е. подтверждается тот факт, что матричный слой состоит из полупроводникового соединения ZnSe. Поэтому при углах рассения 2θ = 56.1° и 89.6° на дифрактограмме наблюдаются слабые отражения 222ZnSe с d/n = = 0.1636 нм и 333ZnSe с d/n = 0.2831 нм соответственно. Для структур типа сфалерита на основе монокристалла ZnSe с кристаллографической ориентацией [100] по законам погасания рефлексов отражения 222 и 333 являются запрещенными [11, 12], и это указывает на появление микроискажений кристаллической решетки пленки. Дополнительным подтверждением этого служит уровень фона неупругого рассеяния на дифрактограмме твердого раствора (ZnSe)1– x – y(Ge2)x · · (GaAs1–δBiδ)y, который на 9% выше, чем уровень фона на дифрактограмме подложки при малых и средних углах рассеяния (в пределах от 10° до 60°). Это свидетельствует о возникновании микроискажений под влиянием накопления энергии упругой деформации в решетке пленки. Существование таких микроискажений кристаллической решетки, возможно, является причиной различных нанообразований. Подтверждением формирования нанообразований в кристаллической решетке является появление рефлекса 220 с d/n = 0.1001 нм при углах рессеяния 2θ = 45.3° на дифрактограмме пленки, который принадлежит нанокристаллам Ge. Из следующего выражения были определены размеры блоков (субкристаллитов) пленки и нанокристаллитов Ge по полуширине профилей рефлексов 400 и 220 соответственно [13]:
(2)
$D = {{K\lambda } \mathord{\left/ {\vphantom {{K\lambda } {\left( {\beta {\kern 1pt} {\text{cos}}{\kern 1pt} \theta } \right)}}} \right. \kern-0em} {\left( {\beta {\kern 1pt} {\text{cos}}{\kern 1pt} \theta } \right)}},$Рис. 4.
Профиль дифракционного отражения 400 подложки (1) и эпитаксиальной пленки (ZnSe)1 ‒ x ‒ y(Ge2)x(GaAs1–δBiδ)y (2).
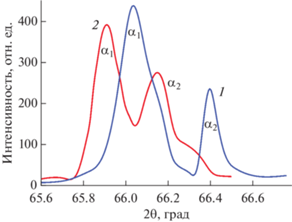
Расчеты значений D по приведенной формуле показали, что размер субкристаллитов твердого раствора 60 нм, а размер нанокристаллитов Ge 47 нм. Экспериментально определен параметр решетки нанокристаллитов Ge с помощью формулы (1), который составлял aGe = 0.5659 нм, что также близко к его табличному значению aGe = = 0.5657 нм. Таким образом, парные атомы Ge частично замещают молекулы ZnSe в дефектных областях матричной решетки пленки, а остальные атомы участвуют в формировании нанокристаллов германия размером 47 нм на границах раздела субкристалитов пленки.
На дифрактограмме пленки еще наблюдаются два слабых отражения 311 с d/n = 0.1791 нм и 511 с d/n = 0.1143 нм при углах рассеяния 2θ = 50.9° и 84.8° соответственно. Анализ показал, что эти отражения соответствуют соединению типа GaAs1 – δBiδ. Экспериментально определен параметр решетки GaAs1 – δBiδ по рефлексам 311 и 511 с помощью формулы (1), который составил 0.5941 нм. Рассогласование постоянных решеток матричного слоя амс и соединений GaAs1 – δBiδ определено из следующего выражения [14, 15]:
(4)
${\mathbf{\xi }} = 2{{\left| {{{a}_{{{\text{мс}}}}} - {{a}_{{{\text{GaAsBi}}}}}} \right|} \mathord{\left/ {\vphantom {{\left| {{{a}_{{{\text{мс}}}}} - {{a}_{{{\text{GaAsBi}}}}}} \right|} {\left( {{{a}_{{{\text{мс}}}}} + {{a}_{{{\text{GaAsBi}}}}}} \right),}}} \right. \kern-0em} {\left( {{{a}_{{{\text{мс}}}}} + {{a}_{{{\text{GaAsBi}}}}}} \right),}}$(5)
${{E}_{{{\text{GaAsBi}}}}} = \left( {1 - \delta } \right){{E}_{g}}_{{{\text{GaAs}}}} + \delta {{E}_{g}}_{{{\text{GaBi}}}} - \xi \delta \left( {1 - \delta } \right),$ЗАКЛЮЧЕНИЕ
Таким образом, выращенные монокристаллические пленки с ориентацией (100) и параметром решетки 0.5663 нм представляют собой твердые растворы замещения (ZnSe)1– x – y(Ge2)x(GaAs1–δBiδ)y (0 ≤ x ≤ 0.725 и 0 ≤ у ≤ 0.638) с постепенно изменяющимся составом. Тонкий слой, обогащенный Ge и GaAs1–δBiδ, образуется между подложкой и приповерхностной областью пленки. Парные атомы Ge частично замещают молекулы ZnSe в дефектных областях матричной решетки пленки, а остальные атомы формируют нанокристаллы гермния с параметром решетки aGe = 0.5659 нм размерами 47 нм на границах раздела субкристаллитов пленки. Соединение GaAs1–δBiδ образует нановключение, т.е. квантовые ямы, в приповерхностных областях пленки. Размеры этих квантовых ям определены из эксперименталных данных по рефлексам 311 и 511 с помощью соотношения Селякова–Шеррера и составляют 43 нм.
Список литературы
Белоус А.И, Ефименко С.А., Турцевич А.С. Полупроводниковая силовая электроника. М.: Техносфера, 2013. 216 с.
Марков В.Ф., Мухамедзянов Х.Н., Маскаева Л.Н. Материалы современной электроники. Екатеринбург: Изд-во Уральского ун-та, 2014. 272 с.
Раззаков А.Ш. Исследования условий эпитаксиального роста новых варизонных твердых растворов (Ge2)1 –x(ZnSe)x и их некоторых электрических, фотоэлектрических свойств: Дис. … канд. физ.-мат. наук. Ташкент: ФТИ, 1998. 153 с.
Бобоев А.Й. Структурные особенности, электрофизические и фотоэлектрические свойства гетероструктур n-(GaAs)–р-(GaAs)1 –х–у(Ge2)х(ZnSe)у. Дис. … канд. физ.-мат. наук. Ташкент: ИФПМ, 2019. 127 с.
Усмонов Ш.Н. Взаимодействие примесей в твердых растворах на основе кремния, арсенида-галлия, селенида-цинка, сернистого кадмия и электрофизические свойства гетероструктур, полученных на их основе: Дис. … д-ра физ.-мат. наук. Ташкент: ФТИ, 2018. 220 с.
Сетюков О.А., Самойлов А.И. // Научные публикации сотрудников ВИАМ. 2011. Т. 77. Вып. 8. С. 4.
Равделя А., Пономаревой А.М. Краткий справочник физико-химических величин. Л.: Химия, 1983. 138 с.
Зайнабидинов С.З., Саидов А.С., Лейдерман А.Ю., Каланов М.У., Усмонов Ш.Н., Рустамова В.М., Бобоев А.Й. // Физика и техника полупроводников. 2016. Т. 50. Вып. 1. С. 60.
Зайнабидинов С.З., СаидовА.С., Бобоев А.Й., Усмонов Ж.Н. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2021. № 1. С. 107.
Шулпина И.Л., Кютт Р.Н., Ратников В.В., Прохоров И.А., Безбах И.Ж., Щеглов М.П. // Журн. тех. физики. 2010. Т. 80. Вып. 4. С. 105.
Ширяев А.А., Золотов Д.А., Супрун Е.М., Дьячкова И.Г., Ивахненко С.А., Асадчиков В.Е. // Письма в ЖЭТФ. 2020. Т. 111. Вып. 9. С. 597.
Овчинникова Е.Н., Дмитриенко В.Е., Козловская K.A., Рогалев А. // Письма в ЖЭТФ. 2019. Т. 110. Вып. 8. С. 563.
Иванов А.Н., Расторгуев Л.Н., Скаков Ю.А., Уманский Я.С. Кристаллография, рентгенография и электронная микроскопия. М.: Металлургия, 1982. 632 с.
Saidov A.S., Saidov M.S., Usmonov Sh.N., Leiderman A.Yu. Kalanov M.U., Gaimnazarov K.G., Kurmantaev A.N. // Phys. Solid State. 2011. V. 53. № 10. P. 2012.
Константинов О.В., Котельников Е.Ю., Матвеенцев А.В., Романов А.Е. Письма в ЖТФ. 2001. Т. 27. Вып. 16. С. 40.
Дубровский В.Г. Теория формирования эпитаксиальных наноструктур. М.: Физматлит, 2009. 486 с.
Saidov A.S., Usmonov Sh.N., Amonov K.A., Saidov M.S., Kutlimuratov B.R. // Appl. Sol. En. 2017. № 53. P. 287.
Комков О.С. Расчет полупроводниковых гетеропереходов. Учеб.-метод. пособие. СПб.: ЛЭТИ, 2018. 52 с.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования




