Приборы и техника эксперимента, 2019, № 4, стр. 42-46
ИССЛЕДОВАНИЕ ПРОЦЕССА ВЫКЛЮЧЕНИЯ ИНТЕГРАЛЬНОГО ТИРИСТОРА СО ВСТРОЕННОЙ СИСТЕМОЙ УПРАВЛЕНИЯ
И. В. Грехов a, *, А. Г. Люблинский a, Е. М. Михайлов a, А. А. Скиданов b
a Физико-технический институт им. А.Ф. Иоффе РАН
194012 Санкт-Петербург, ул. Политехническая, 26, Россия
b АО “ВЗПП-Микрон”
394033 Воронеж, Ленинский просп., 119а, Россия
* E-mail: grekhov@mail.ioffe.ru
Поступила в редакцию 01.11.2018
После доработки 01.11.2018
Принята к публикации 24.11.2018
Аннотация
Приводятся результаты исследования процесса выключения недавно разработанного в “ВЗПП-Микрон чипа интегрального тиристора с размерами 13.5 × 13.5 мм, рабочей площадью ~1 см2 и блокируемым напряжением 2.5 кВ. Тиристор испытывался в силовой цепи с индуктивной нагрузкой и запирался импульсом базового тока с амплитудой, равной силовому току. Для уменьшения индуктивности запирающей цепи формирователь запирающего импульса расположен непосредственно рядом с тиристорным чипом. Испытания показали, что при рабочем напряжении 1200 В разрушение тиристора происходит при амплитуде выключаемого тока 107 A вследствие инжекции электронов из эмиттерного перехода в область объемного заряда коллектора. Для устранения этого эффекта и увеличения максимального выключаемого тока необходимо увеличивать скорость нарастания запирающего импульса тока в цепи управляющего электрода.
Исследования возможности создания силовых приборов тиристорного типа, кремниевый чип которых, состоящий из большого числа включенных параллельно микротиристоров, мог бы производиться методами силовой микроэлектроники, начались довольно давно [1, 2 и др.]. Возможным преимуществом такого прибора перед основным прибором силовой микроэлектроники – биполярно-полевым транзистором (IGBT – Insulated Gate Bipolar Transistor) – является существенно меньшее остаточное напряжение во включенном состоянии, особенно для высоковольтных приборов с блокируемым напряжением 1500 В и выше. Кроме того, существенно меньшие, чем у IGBT, требования к топологическому разрешению позволяют организовать производство чипов этих приборов – интегральных тиристоров (и.т.) на имеющихся в России технологических линиях с топологическим разрешением 1.5–2 мкм. Существенным недостатком и.т. по сравнению с IGBT является более сложная и энергоемкая система управления и защиты от перегрузок.
Процесс включения и.т. исследовался, например, в [3, 4], где было показано, в частности, что кремниевый чип, состоящий из микротиристоров с шириной эмиттерной области ~15 мкм и длиной ~100 мкм, позволяет формировать в силовой цепи импульс тока с очень высокой плотностью и малым временем нарастания вследствие практически одновременного переключения всей рабочей площади прибора.
Выключение и.т., в принципе, может быть проведено путем замыкания цепи катод – управляющий электрод полевым транзистором с малым сопротивлением канала [2]. Однако эффективен этот способ только в случае работы и.т. на резистивную нагрузку, когда возрастание напряжения на приборе сопровождается одновременным спадом тока в силовой цепи. В цепи же с индуктивной нагрузкой ток начинает спадать только после роста анодного напряжения до напряжения источника питания. При этом в образующуюся у коллекторного перехода область объемного заряда (о.о.з.) с высокой напряженностью поля попадает поток свободных дырок из электронно-дырочной плазмы, накопленной в широком базовом слое тиристорной структуры, а также поток электронов из медленно запирающегося катодного эмиттера, что приводит в конечном счете к шнурованию тока и разрушению прибора при относительно малой плотности выключаемого тока.
В [5] было показано экспериментально, что для повышения предельной плотности выключаемого тока инжекция электронов в о.о.з. из катодного эмиттера должна быть полностью прервана раньше начала формирования о.о.з. у коллектора. Это можно осуществить с помощью быстро нарастающего импульса запирающего тока в цепи катод – управляющий электрод, причем амплитуда тока в импульсе должна быть не меньше амплитуды выключаемого тока.
Время задержки начала формирования о.о.з. определяется, в основном, процессом удаления электронно-дырочной плазмы из приколлекторной области N-базы; дырки удаляются в цепь управляющего электрода, а электроны, перемещаясь в область N-базы, вызывают встречную инжекцию дырок из p+-анодного эмиттера. В высоковольтном интегральном тиристоре время задержки составляет обычно несколько сотен наносекунд, соответственно, импульс запирающего тока должен нарастать значительно быстрее.
Поскольку обратное напряжение в запирающей цепи не должно превышать напряжение пробоя эмиттерного перехода (~7 В), то паразитные параметры этой цепи должны быть минимизированы, и, следовательно, систему, формирующую импульс запирающего тока, необходимо размещать непосредственно у выключаемого и.т. В [5] была предложена относительно простая схема драйвера и.т. с дополнительным конденсатором в цепи управления. Эта схема хорошо зарекомендовала себя при работе с интегральными тиристорами с размерами чипов 3.5 × 2.6 и 7.8 × 5.8 мм. Однако при переходе на чипы большего размера емкость вышеуказанного конденсатора также должна быть пропорционально увеличена. Для чипа 13.5 × 13.5 мм размеры и емкость конденсатора становятся чрезмерными. Поэтому нами была разработана и испытана новая схема драйвера и.т. с дополнительным встроенным отрицательным источником питания.
Схема предлагаемого драйвера для управления и.т. приведена на рис. 1. Он состоит из входного усилителя сигнала управления со схемой сдвига уровня на MOSFET-транзисторах T1 и T2; транзистора T3, формирующего импульс включения и.т.; транзистора T4, обеспечивающего совместно с конденсаторами С1–С4 выключение и.т., а также источников питания +5 В и –5 В. Транзистор T4 и конденсаторы С1–С4 должны быть расположены непосредственно у чипа интегрального тиристора.
Рис. 1.
Схема драйвера с дополнительным отрицательным источником питания для управления интегральными тиристорами.

В современной мощной преобразовательной технике для увеличения коммутируемой мощности обычно используют IGBT-модули, содержащие несколько параллельно включенных IGBT-чипов. В аналогичных силовых модулях на основе интегральных тиристоров у каждого и.т. должны быть расположены выключающие транзисторы и конденсаторы, а входной усилитель-формирователь, транзистор включения и источники питания могут быть общими для всех тиристорных чипов, входящих в модуль. Средняя мощность и габариты этих источников питания допускают их интеграцию непосредственно в силовые тиристорные модули.
Интегральный тиристор с такой системой управления является, по сути, микроэлектронным аналогом мощного запираемого тиристора – так называемого IGCT (Integrated Gate Commutated Thyristor), в котором кремниевая структура запираемого тиристора монтируется на одной плате с системой управления [6] и др.
В данной работе исследуется недавно разработанный в “ВЗПП-Микрон” высоковольтный чип интегрального тиристора размерами 13.5 × 13.5 мм; чипы именно с такими размерами на сегодня являются промышленным стандартом для установки в силовых модулях для преобразовательной техники. Внешний вид чипа показан на рис. 2, на одной микроплате с чипом размещены транзистор Т4 и конденсаторы С1–С4. Испытания проводятся в классической схеме с индуктивной нагрузкой.
Рис. 2.
Внешний вид чипа интегрального тиристора 13.5 × 13.5 мм, установленного на микроплате с выключающим транзистором и конденсаторами. 1 – чип интегрального тиристора; 2 – конденсаторы; 3 – MOSFET-транзистор.
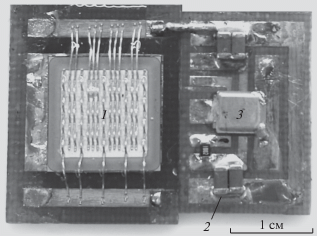
Фрагмент топологии чипа (без охранных колец) после нанесения первого слоя металлизации толщиной 2 мкм показан на рис. 3 (вторая металлизация толщиной ~6 мкм и межслойная изоляция (полиимид) на рисунке не показаны). В n+–p'–N–n'–p+-структуре тиристора сильнолегированные n+-катодные эмиттеры и объединяющие их эмиттерные шины показаны белым цветом, а управляющие электроды и объединяющие их шины – черным. Эмиттерные полосы имеют ширину ~15 мкм, толщина базового p'-слоя с уровнем легирования 1016–1017 cм–3 составляет 2–3 мкм.
Рис. 3.
Фрагмент топологии чипа интегрального тиристора. Белым цветом показаны эмиттерные шины, черным – управляющие электроды и объединяющие их шины.

Параметры N- и n'-слоев, а также конструкция системы охранных колец обеспечивают получение блокируемого напряжения до 3 кВ. Время жизни дырок в N-слое после γ-облучения собранных на плату приборов составляло ~10–15 мкс. Напряжение пробоя эмиттерного n+–p'-перехода ~7 В. Рабочая площадь прибора (внутри охранных колец) ~100 мм2, причем значительная часть этой площади перекрывается шинами.
В высоковольтном интегральном тиристоре толщина N-базы существенно больше полуширины эмиттерных полос, и во включенном состоянии потоки инжектируемых эмиттерами носителей смыкаются вследствие боковой диффузии; поэтому модуляция проводимости N-базы и, следовательно, протекание силового тока происходит практически по всей площади внутри охранных колец. Высокий уровень легирования (~1020 см–3) n+-эмиттера обеспечивает приемлемый коэффициент инжекции даже в условиях очень высокой плотности тока.
На рис. 4 приведены осциллограммы процесса выключения чипа при амплитуде выключаемого тока 60 A и анодном напряжении 1.2 кВ. Транзистор T4 включается в момент времени, обозначенный на рис. 4 цифрой 1, и к цепи катод – управляющий электрод прикладывается отрицательное напряжение от конденсаторов С1–С4 (рис. 1), которое является запирающим для эмиттерного n+–p'-перехода. Процесс переключения силового тока в цепь управляющего электрода (и соответственно обрыв инжекции катодного эмиттера) заканчивается в момент времени 2 (рис. 4). Длительность этого процесса прямо пропорциональна паразитной индуктивности замыкающей цепи, состоящей из транзистора T4, конденсаторов С1–С4, а также соединительных проводов, приваренных к чипу и.т., и межсоединений на микроплате:
где dt – длительность процесса переключения тока, L – паразитная индуктивность замыкающей цепи, dI – переключаемый силовой ток, U – напряжение заряда конденсаторов С1–С4.Рис. 4.
Осциллограмма процесса выключения анодного тока 60 A при анодном напряжении 1.2 кВ. CH1 – напряжение на аноде и.т. (масштаб по вертикали 200 В/деление); CH2 – анодный ток (20 A/деление); CH3 – ток через управляющий электрод (20 A/деление); CH4 – напряжение на управляющем электроде (1 В/деление). Масштаб по горизонтали – 500 нс/деление.

Видно, что даже при значении выключаемого тока 60 А к моменту полного запирания эмиттерного n+–p'-перехода уже происходит запирание коллекторного p'–N-перехода и формирование о.о.з. в приколлекторной области.
При дальнейшем повышении амплитуды выключаемого тока до 100 A при блокируемом напряжении 1200 В (см. рис. 5) запирание эмиттерного перехода происходит уже при значительном напряжении на и.т. (~200 В). Дальнейшее незначительное повышение выключаемого тока до 107 A привело к разрушению образца. Осциллограмма этого процесса приведена на рис. 6. Видно, что при выключении тока с такой амплитудой напряжение на приборе до разрушения успевает вырасти только до ~700 В. По-видимому, именно инжекция электронов из эмиттера в о.о.з. и является причиной разрушения.
Рис. 5.
Осциллограмма процесса выключения анодного тока 100 A при анодном напряжении 1.2 кВ. CH1 – напряжение на аноде и.т. (масштаб по вертикали 200 В/деление); CH2 – анодный ток (20 A/деление); CH3 – ток через управляющий электрод (20 A/деление); CH4 – напряжение на управляющем электроде (1 В/деление). Масштаб по горизонтали – 1 мкс/деление.

Рис. 6.
Осциллограмма разрушения и.т. при выключении анодного тока 107 A при анодном напряжении 1.2 кВ. CH1 – напряжение на аноде и.т. (масштаб по вертикали 200 В/деление); CH2 – анодный ток (20 A/деление); CH3 – ток через управляющий электрод (20 A/деление); CH4 – напряжение на управляющем электроде(1 В/деление). Масштаб по горизонтали – 1 мкс/деление.

Таким образом, приведенные результаты показывают, что увеличение предельной плотности выключаемого тока может быть получено путем существенного уменьшения паразитной индуктивности в цепи катод – управляющий электрод, а также путем увеличения напряжения пробоя эмиттерного n+–p'-перехода. Это позволит ускорить процесс выведения плазмы из p'-базы и запереть n+–p'-инжектор раньше начала формирования о.о.з. коллектора даже при существенно большей плотности выключаемого тока. В этом случае основным ограничивающим механизмом может стать, вероятно, динамический пробой, инициируемый свободными дырками, выводимыми через о.о.з. коллектора из электронно-дырочной плазмы в широкой области N-базы [7–9].
Работа выполнена в рамках Программы фундаментальных исследований Президиума РАН № 31 “Фундаментальные исследования физико-технических проблем энергетики”.
Список литературы
Temple V.A.K. Proceedings of European Pulsed Power Symposium. 22–24 Oct. 2002. P. 19/1.
Грехов И.В., Костина Л.С., Рожков А.В., Зитта Н.Ф., Матвеев В.И. // ЖТФ. 2008. Т. 78. Вып. 12. С. 78.
Грехов И.В., Жмодиков А.Л., Коротков С.В. // ПТЭ. 2015. № 1. С. 67. https://doi.org/doi 10.7868/S0032816215010292
Грехов И.В., Жмодиков А.Л., Коротков С.В., Прижимов С.В., Фоменко Ю.Л. // ПТЭ. 2016. № 3. С. 32. https://doi.org/10.7868/S0032816216020208
Грехов И.В., Люблинский А.Г., Скиданов А.А. // ЖТФ. 2017. № 1. С. 155. https://doi.org/10.21883/JTF.2017.01. 44034.1930
Gruening H., Odegard B., Ress J. // Proc. PCIM. 1996. P. 169.
Wachutka G.K. // IEEE Trans. ED. 1991. V. 18. № 6. P. 1516.
Oetjen J., Jungblut R., Kuhlmann U., Arkenun J., Sittig R. // Solid-state El. 2000. V. 44. P. 117.
Lutz J., Baburske R. // Microelectronics Reliability. 2012. V. 52. P. 475.
Дополнительные материалы отсутствуют.
Инструменты
Приборы и техника эксперимента


