Приборы и техника эксперимента, 2019, № 5, стр. 119-124
УПРАВЛЕНИЕ ПРОФИЛЕМ И КРИВИЗНОЙ ПОВЕРХНОСТИ МОНОКРИСТАЛЛИЧЕСКИХ ПЛАСТИН РЕНТГЕНООПТИЧЕСКИХ ЭЛЕМЕНТОВ С ИСПОЛЬЗОВАНИЕМ ПЬЕЗОЭЛЕКТРИЧЕСКИХ БИМОРФОВ
В. В. Грибко a, *, А. С. Маркелов a, В. Н. Трушин a, Е. В. Чупрунов a
a Нижегородский государственный университет им. Н.И. Лобачевского, физический факультет
603950 Н. Новгород, просп. Гагарина, 23, Россия
* E-mail: gribkovladimir@icloud.com
Поступила в редакцию 25.12.2018
После доработки 05.03.2019
Принята к публикации 07.03.2019
Аннотация
Исследована возможность управления кривизной профилей поверхности рентгенооптических элементов, в качестве которых использовались монокристаллические пластины SiO2(011) прямоугольной и трапециевидной форм. В регуляторах изгиба (р.и.) различной формы активным элементом служил пьезоэлектрический биморф, приклеенный к монокристаллической пластине. Приведены экспериментальные и расчетные данные изменений профиля и радиуса кривизны поверхности используемой пластины. Показано влияние форм составных частей р.и. на исходный профиль и кривизну поверхности рентгенооптических элементов.
ВВЕДЕНИЕ
В последние годы приложены большие усилия для разработки и производства рентгенооптических элементов с высокой разрешающей способностью, используемых в таких отраслях науки, как рентгеновская астрономия [1–4], медицина, материаловедение, а также при изучении биологических объектов, в микро- и наноэлектронике, в наземных объектах, таких как синхротроны и рентгеновские лазеры на свободных электронах (free-electron laser, FEL). Основной характеристикой таких оптических элементов является размер фокального пятна.
В настоящее время для управления параметрами сходимости рентгеновского излучения применяются зонные пластины Френеля, многослойные зеркала, конические капилляры, а также изогнутые кристаллы. Наиболее используемыми являются изогнутые кристаллы/зеркала, принцип действия которых основан на полном внешнем отражении рентгеновских лучей от изогнутой поверхности, в частности эллиптической (для фокусировки точка-точка) и параболической (в случае коллимации пучка). В идеальном случае геометрии фокусировки точка-точка профиль поверхности оптического элемента представляет собой короткую секцию эллипсоида с источником и его изображением, находящимся в фокусах эллипса. Обычно меридиональный (параллельный плоскости падения) радиус кривизны Rm больше сагиттального (перпендикулярного плоскости падения) радиуса кривизны Rs, что следует из следующих выражений [5]:
(1)
${{R}_{m}} = \frac{{2rr{\text{'}}}}{{\sin {{{\theta }}_{c}}(r + r{\text{'}})}};\quad {{R}_{s}} = 2\sin {{\theta }_{c}}\left( {\frac{{rr{\text{'}}}}{{r + r{\text{'}}}}} \right),$Наиболее распространенными методами придания рентгенооптическим элементам заданного профиля является их упругий изгиб [6, 7] и шлифование заданных поверхностей, в частности, с помощью электролитической обработки поверхности (ELID-шлифовка) [8]. Одним из недостатков данных методов является сложность их применения для создания двумерных профилей поверхности. Для формирования последних было предложено использовать пластически деформированные кристаллы [9]. В связи с задачей повышения точности контроля оптических поверхностей популярность набирают адаптивные рентгенооптические элементы [1–3, 10], управляемые с помощью механических или пьезоэлектрических приводов. Для подобных систем в литературе [11] приведены данные по влиянию прилагаемого к электродам напряжения на радиус кривизны верхней отражающей пластины. Показано, что на кривизну ее поверхности в основном влияет величина пьезомодуля d31; вид зависимости описывается следующим образом:
где h – общая толщина системы; U – прилагаемое напряжение к биморфу; α – постоянная для конкретной системы, определяемая физическими параметрами каждого слоя и его толщиной. Однако в случае сложных форм зеркал на биморфных подложках и при учете влияния анизотропии отражающей пластины необходимо проводить численные расчеты.В данной работе исследуется влияние форм составных частей регуляторов изгиба (р.и.), приведены расчетные и экспериментальные данные по влиянию электрического поля, приложенного к пьезоэлектрическому биморфу, на кривизну и профиль поверхности монокристаллической пластины SiO2(011).
РАСЧЕТ ИЗМЕНЕНИЙ ПРОФИЛЯ
Расчет изменений профиля и радиуса кривизны поверхности монокристаллической пластины SiO2 в составе р.и. проводился с использованием уравнения пьезодеформации совместно с уравнением упругого равновесия с учетом упругих и электрических характеристик системы:
(3)
${{\varepsilon }_{{ij}}} = c_{{ijkl}}^{E}{{\sigma }_{{kl}}} + {{d}_{{ijk}}}{{E}_{k}};\quad {{D}_{i}} = {{k}_{{ijk}}}{{\sigma }_{{jk}}} + {{e}_{{ij}}}{{E}_{j}},$Для численного решения системы (3) нами использовался программный пакет COMSOL Multiphysics, позволяющий решать дифференциальные уравнения методом конечных элементов.
В качестве модельного образца был выбран р.и., представляющий собой многослойную структуру, состоящую из основания – пьезокерамического биморфа с пьезокерамикой PZT-5H, заключенной между алюминиевыми электродами, слоя клея (парафина) толщиной 30 мкм и пластины SiO2(011) толщиной 300 мкм. Пьезоэлектрический биморф состоит из пьезокерамики PZT-5H (d31 = 7.41 ⋅ 10–10 Кл/Н, модуль Юнга E = 1.27 ⋅ 1011 Па, диэлектрическая проницаемость ε = 3400) толщиной 190 мкм, среднего латунного электрода толщиной 212 мкм и внешних алюминиевых электродов толщиной 14 мкм. Форма р.и. имела вид прямоугольника (рис. 1а) размером 28 × 15 мм, толщиной 0.95 мм.
Рис. 1.
Изменение профиля поверхности пластины SiO2 прямоугольной формы от величины приложенного к биморфу электрического поля: а – схематическое изображение модельного образца; б и в – расчетные зависимости изменения профилей поверхности пластины в сечениях плоскостями I (z0x) (б) и II (z0y) (в) при приложении к биморфу электрического поля напряженностью 52 (1), 104 (2) и 261 (3) В/мм.
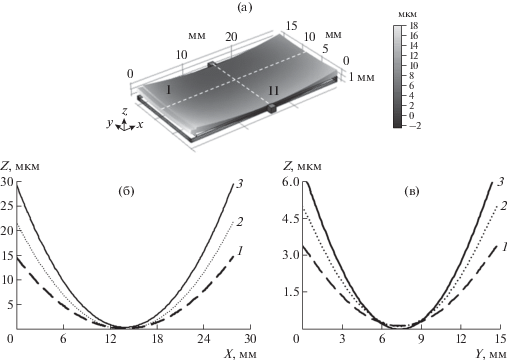
Начальным условием являлась нулевая кривизна р.и. и пластины SiO2. Возможность создания р.и. с нулевой кривизной нами была показана в работах [12, 13]. Модельный образец жестко фиксировался с двух противоположных сторон. На средний электрод подавался потенциал +U, внешние электроды имели нулевой потенциал. Указанные профили строились по смещению ΔZ точек поверхности исходного профиля пластины SiO2 вдоль координаты Y, проходящей через середину образца.
На рис. 1 приведен рассчитанный профиль поверхности монокристаллической пластины SiO2, сформированный под воздействием на пьезокерамический биморф электрического поля разной напряженности. Поверхность пластины SiO2 в составе р.и. (рис. 1а) представляет собой параболоид с рассчитанными в центре пластины локальными радиусами кривизны: вдоль большей ее стороны (ось OX, рис. 1б) Rm = 2.25 м (E = 52 В/мм), 1.93 м (E = 104 В/мм), 1.37 м (E = 261 В/мм); вдоль оси OY (рис. 1в) Rs = 1.5 м (E = 52 В/мм), 1.36 м (E = = 104 В/мм), 0.98 м (E = 261 В/мм).
Аналогичные расчеты были выполнены для образца, составные части которого имели форму равнобедренной трапеции с размерами оснований 15 и 5 мм. Профиль поверхности пластины SiO2 трапециевидного р.и. и ее сечения показаны на рис. 2. При приложении к биморфу электрического поля напряженностью 52 В/мм профиль поверхности пластины SiO2 описывается параболоидом с локальными радиусами кривизны в центре образца вдоль оси OX 2.13 м (рис. 2б, сечение I), а вдоль оси OY 1.35 м (рис. 2в, сечение II).
Рис. 2.
Изменение профиля поверхности пластины SiO2 трапециевидной формы от величины приложенного к биморфу электрического поля: а – схематическое изображение модельного образца; б, в – расчетные зависимости изменения профиля пластины в сечениях плоскостями I (z0x) (б) и II (z0y) (в) при приложении к биморфу электрического поля напряженностью 52 (1), 104 (2) и 261 (3) В/мм.
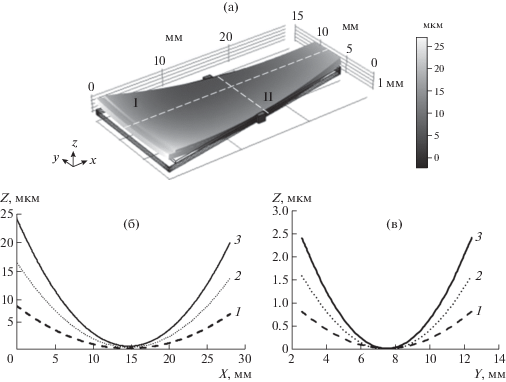
На форму и кривизну профиля поверхности пластины SiO2 влияет способ крепления р.и. На рис. 3б показано изменение профиля сечения (положение сечения показано штриховой линией на рис. 3а) поверхности пластины SiO2 в зависимости от положений точек крепления р.и. при приложении к биморфу электрического поля E = = 52 В/мм. Величина отступа точки крепления от края образца составляла: 0 (случай консольного крепления), 4, 10 и 14.5 мм (середина образца). Сечения профиля поверхности описываются дугами парабол с радиусами кривизны в центре от 1.1 до 5.3 м.
Рис. 3.
Изменение профиля поверхности пластины SiO2 от положения точек крепления р.и. при приложении к биморфу электрического поля E = 52 В/мм: а – регулятор изгиба; б – расчетные зависимости изменения профиля поверхности пластины в зависимости от положения (отступа от края образца) точек крепления регулятора изгиба: 1 – 0 (случай консольного крепления); 2 – 4; 3 – 10; 4 – 14.5 мм (середина образца).
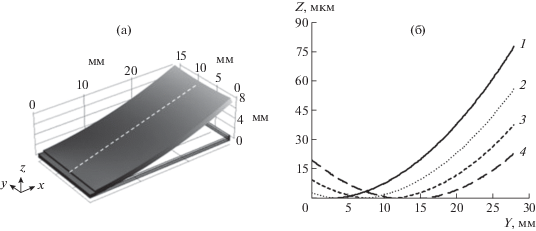
ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Исследовалось влияние напряжения, приложенного к пьезоэлектрическому биморфу, на радиус кривизны поверхности пластины SiO2(011) в составе прямоугольного и трапециевидного р.и. Пластина SiO2(011) толщиной 315 мкм крепилась с помощью парафина на пьезоэлектрический биморф. Кривизну профиля поверхности пластины измеряли на дифрактометре Bruker D8 Discover (CuKα1-излучение, диаметр падающего рентгеновского пучка 1 мм). Сечение профиля поверхности определяли по смещению центра тяжести серии кривых качания SiO2(011), полученных при последовательном перемещении области засветки по поверхности пластины вдоль оси OX, проходящей через середину пластины (на вставках к рис. 1–3 показана выбранная система координат). Полученные профили аппроксимировались методом наименьших квадратов с коэффициентами корреляции не ниже 0.999. Напряжение на подложке изменяли программируемым источником постоянного тока.
Гистерезис и ползучесть (крип) пьезокерамики могут оказывать влияние на зависимость углового положения кривых качания пластины SiO2(011) от приложенного к пьезоэлектрическому биморфу напряжения. Для уменьшения этого влияния съемка кривых качания проводилась с интервалом времени не менее 15 мин после изменения напряженности электрического поля.
Образцы, параметры которых соответствовали параметрам расчетных образцов, крепились консольно, трапециевидный образец крепился со стороны большего основания. На рис. 4 показаны изменения сечения исходного профиля поверхности пластины SiO2, полученные для трапециевидного (кривая 1) и прямоугольного (кривая 2) образцов в случае их консольного крепления при приложении к биморфу электрического поля 104 В/мм (сплошными линиями обозначены экспериментальные данные, штриховыми – расчетные). Сечения профилей поверхности на рис. 4 описываются параболами с радиусами кривизны и фокусами, указанными в табл. 1.
Рис. 4.
Изменения сечения z0x (см. рис. 1, 2) профилей поверхности пластины SiO2, полученные для трапециевидного (1) и прямоугольного (2) образцов в случае их консольного крепления при приложении к биморфу электрического поля напряженностью 104 В/мм. Сплошные линии – экспериментальные данные, штриховые – расчетные.
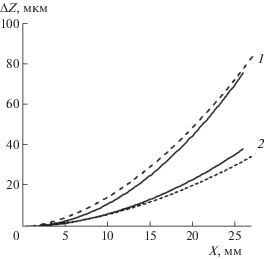
Таблица 1.
Расчетные и экспериментальные параметры сечений профилей поверхности пластины SiO2, полученные в результате приложенного электрического поля напряженностью 104 В/мм к регуляторам изгиба прямоугольной и трапециевидной форм
| Форма р.и. | Rm, м | F, м | ||
|---|---|---|---|---|
| Эксперимент | Расчет | Эксперимент | Расчет | |
| Прямоугольная | 8.63 | 8.5 | 10.6 | 10.8 |
| Трапециевидная | 6.42 | 6.16 | 10.12 | 9.89 |
Расчет локального радиуса кривизны проводился в вершине параболы по формуле [14]:
где y – аппроксимирующая функция полученных сечений; y' и y'' – ее производные первого и второго порядка соответственно.Полученные значения радиусов кривизны соответствовали значениям, рассчитанным по формуле (5) [15]:
где s – расстояния между точками съемки кривых качания; Δθ – угловой сдвиг кривых качания.При используемых в экспериментах небольших напряженностях гистерезис практически отсутствовал, на что указывало восстановление кривизны поверхности кристаллической пластинки и, следовательно, самого биморфа после снятия с него напряжения.
ВЫВОДЫ
На примере р.и. прямоугольной и трапециевидной форм, активным элементом в которых служил пьезоэлектрический биморф из пьезокерамики PZT, показана возможность управления кривизной профилей поверхности рентгенооптических элементов, что может быть использовано для коллимации рентгеновских пучков.
В ходе расчетов было показано, что на форму и кривизну профиля поверхности рентгенооптических элементов в составе р.и., кроме толщины слоев и величины пьезомодуля d31 [11], оказывает влияние форма слоев р.и., а также способ его крепления. В частности, показано, что при использовании р.и. прямоугольной и трапециевидной форм можно получить параболические профили с радиусами кривизны от ∞ до 1 м и фокусами до 0.95 м.
Отличие экспериментальных данных от расчетных можно объяснить неоднородностью толщины слоя клея при наклеивании пластины SiO2 на биморф. Также отличие может быть связано с неточным соответствием положений линий на исследуемых образцах, вдоль которых проходила съемка кривых качания, и линий, вдоль которых проводился расчет по смещению ΔZ точек поверхности образца. В работе показано, что при использовании р.и. трапециевидной формы можно получить меньший радиус кривизны поверхности пластины по сравнению р.и. прямоугольной формы. Минимальный радиус кривизны пластины достигается в случае консольного крепления р.и. и составляет 1.1 м при подаче на биморф электрического поля напряженностью 52 В/мм (рис. 3б, сечение 1).
Список литературы
Carolyn Atkins // Proc. of SPIE. 2008. V. 6721. 67210T-2. https://doi.org/10.1117/12.782955
Weisskopf M.C. // Adv. Space Res. 2003. V. 32. № 10. P. 2005.
Jansen F., Lumb D., Altieri B., Clave J., Ehle M., Erd C., Gabriel C., Guainazzi M., Gondoin P., Much R., Munoz R., Santos M., Schartel N., Texier D., Vacanti G. // Astronomy & Astrophysics. 2001. V. 365. P. L1–L6. https://doi.org/https://doi.org/10.1051/0004-6361:20000036
Windhorst R.A., Cameron R.A., Brissenden R.J., Elvis M.S., Fabbiano G., Gorenstein P., Reid P.B., Schwartz D.A., Bautz M.W., Figueroa-Feliciano E., Petre R., White N.E., Zhang W.W. // New Astronomy Reviews. 2006. V. 50. P. 121. https://doi.org/10.1016/j.newar. 2005.11.019
Susini J. // Optical Engineering. 1995. V. 34. № 2. P. 361.
Блохин М.А. Методы рентгеноспектральных исследований. М.: Гос. изд. физ.-мат. лит-ры., 1959.
Matsushita T. // Handbook on Synchrotron Radiation. 1983. V. 1. P. 261.
Lin W., Morita S., Uehara Y., Ohmori H. // International Journal of Abrasive Technology. 2008. V. 1. № 3/4. P. 274. https://doi.org/10.1504/IJAT.2008.020562
Akshakhalyan A.D., Chkhalo N.I., Kharitonov A.I. // Nucl. Instrum. and Methods in Phys. Res. A. 2001. V. 470. P. 142. https://doi.org/10.1016/S0168-9002(01)01027-0
Roche J.M., Elsner R.F., Ramsey B.D., O’Dell S.L., Kolodziejczak J.J., Weisskopf M.C., Gubarev M.V. // Proc. of SPIE. 2016. V. 9965. P. 99650I-1. doi.https://doi.org/10.1117/ 12.2238171
Zang Y., Li M., Tang S., Gao J., Zhang W., Zhu P. // Nucl. Instrum. and Methods in Phys. Res. A. 2017. V. 860. P.13. https://doi.org/10.1016/j.nima.2017.03.053
Грибко В.В., Маркелов А.С., Трушин В.Н., Чупру-нов Е.В. // ПТЭ. 2018. № 1. С. 136. https://doi.org/10.7868/ S0032816218010196
Грибко В.В., Маркелов А.С., Трушин В.Н., Чупру-нов Е.В. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. № 5. 2017. С. 28. https://doi.org/10.7868/S0207352817050079
Погорелов А.В. Дифференциальная геометрия. М.: Наука, 1974.
Боуэн Д.К., Таннер Б.К. Высокоразрешающая рентгеновская дифрактометрия и топография. М.: Наука, 2002.
Дополнительные материалы отсутствуют.
Инструменты
Приборы и техника эксперимента



