Приборы и техника эксперимента, 2021, № 2, стр. 132-138
СПЕКТРОМЕТР ДЛЯ ИССЛЕДОВАНИЙ КРИСТАЛЛОВ МЕТОДОМ ДИФРАКЦИИ СИНХРОТРОННОГО ИЗЛУЧЕНИЯ НА УГЛЫ, БЛИЗКИЕ К ОБРАТНЫМ
П. В. Гурьева a, *, Н. В. Марченков a, b, А. Н. Артемьев a, Н. А. Артемьев c, А. Д. Беляев a, А. А. Демкив a, В. А. Шишков b
a Национальный исследовательский центр “Курчатовский институт”
123182 Москва, пл. Академика Курчатова, 1, Россия
b Федеральный научно-исследовательский центр “Кристаллография и фотоника” РАН
119333 Москва, Ленинский просп., 59, Россия
c KLA Corporation
95032 Milpitas, Technology Drive, 3, CA, USA
* E-mail: poli.b3@gmail.com
Поступила в редакцию 05.08.2020
После доработки 26.08.2020
Принята к публикации 07.09.2020
Аннотация
Спектрометр разработан для экспериментальной станции EXAFS-D Курчатовского источника синхротронного излучения в НИЦ “Курчатовский институт” в целях прецизионного измерения относительных вариаций постоянной решетки монокристаллов. Спектрометр позволяет регистрировать малые (до 3 · 10–7) относительные изменения параметра решетки, которые могут возникать при нарушении стехиометриометрического состава материала или в результате эффектов, вызванных внешними воздействиями, например, обратного пьезоэффекта. Основным методом, реализуемым на спектрометре, является метод дифракции рентгеновского излучения в геометрии, близкой к геометрии “обратного рассеяния”, на углы вплоть до 179.5°. Использование синхротронного источника обеспечивает возможность выбора длины волны излучения, что необходимо для настройки геометрии дифракции, близкой к обратной. Конфигурация спектрометра позволяет одновременно с измерением вариации параметра решетки осуществлять картирование элементного состава по поверхности кристалла.
ВВЕДЕНИЕ
Монокристаллы пьезоэлектриков широко применяются в электронной технике. Работы по синтезу широкого спектра пьезокристаллов, нацеленные на улучшение их функциональных характеристик, потребовали развития все более точных и обладающих более высокой локальностью методов контроля структуры и свойств кристаллов [1–4]. Наряду с традиционными методами структурных исследований, такими как интерферометрия [5–8], оптическая призменная спектроскопия [9, 10], нейтронная дифракция [11, 12] и других, особую актуальность имеют рентгеновские методы диагностики.
Так, например, работы [13–19] посвящены изучению пьезоэффекта в кристаллах лангасита и лангатата на лабораторных рентгеновских установках. Стоит отметить, что в этих работах наблюдается разброс величин измеренных пьезомодулей, при этом величина указанной авторами относительной ошибки составляет единицы процентов. Наблюдаемые различия требуют дополнительных, прецизионных методов измерения. В работах [15, 16, 20–22] отмечается, что такой разброс величин пьезомодулей может быть связан с условиями роста и составом кристаллов.
Использование синхротронного излучения за счет более высокой по сравнению с рентгеновскими трубками яркости позволяет существенно улучшить пространственное разрешение измерений. В работе [23] дифракция синхротронного излучения (HASYLAB/DESY, Германия) использовалась для изучения пьезоэлектрических свойств монокристалла трибората висмута BiB3O6. Методы высокоразрешающей рентгеновской дифрактометрии и топографии (BESSY, Германия) были применены в исследованиях акустических [24] и пьезоэлектрических свойств [13] кристаллов лангатата. Внутренние деформации в пьезоэлектрических кристаллах BiB3O6, вызванные внешним электрическим полем в результате обратного пьезоэффекта, были изучены в работе [25] (HASYLAB/DESY, Германия).
Методом высокоразрешающей трехкристальной рентгеновской дифрактометрии обнаружено наличие обратимой перестройки доменной структуры в приповерхностных слоях кристаллов парателлурита под действием внешнего электрического поля [26–28]. Отклик пьезоэлектрического кристалла на быстрые изменения приложенного электрического поля изучался методом дифракции с временным разрешением [14, 29]. Однако в рассматриваемых работах авторы либо вовсе не указывают точность определения пьезоэлектрических модулей, либо приводимые величины ошибок составляют единицы процентов и выше.
Величина пьезомодуля напрямую определяется в рентгенодифракционных экспериментах путем измерения углового сдвига кривой дифракционного отражения (к.д.о.), следовательно, дальнейшее развитие данного направления связано с повышением углового разрешения и чувствительности дифракционной картины к изменению межплоскостного расстояния исследуемого кристалла.
Преимуществом использования дифракции на углы, близкие к π, по сравнению с вышеперечисленными методами, является сверхвысокая чувствительность дифракционной картины к малейшим искажениям кристаллической структуры. На данный момент не было обнаружено работ по применению данной методики при изучении влияния внешних воздействий на пьезокристалл.
В данной работе приводится описание спектрометра для исследований деформаций кристаллической структуры методом дифракции рентгеновского излучения на углы, близкие к π, вплоть до 179.5°. Данный спектрометр уже прошел экспериментальную проверку в процессе прецизионных измерений пьезоэлектрического модуля d11 кристалла лангасита [19].
Вместе с тем потенциал геометрии дифракции на углы, близкие π, подтверждается, к примеру, работами по прецизионной монохроматизации синхротронного излучения. В работе [30] удалось в такой схеме достичь высокой (до единиц миллиэлектронвольт) степени монохроматизации пучка синхротронного излучения (с.и.) на синхротронном источнике DESY (Германия), при этом дальнейшее улучшение разрешения по энергии было ограничено только интенсивностью самого излучения.
Реализация обратной дифракции на ондуляторном излучении [31] позволила достичь разрешения ΔE/E = 10–8 и открывает возможности проведения экспериментов по спектроскопии неупругого рассеяния рентгеновского излучения при изучении слабо упорядоченных структур и жидкостей, которая ранее была доступна только нейтронным методам [32]. В работе [33] рассмотрена возможность реализации метода обратной дифракции на лазере на свободных электронах, что на порядки увеличит энергетическое разрешение метода.
СПЕКТРОМЕТР
Разработанный в НИЦ “Курчатовский институт” спектрометр для исследований методом дифракции рентгеновского излучения на углы, близкие к π, установлен на экспериментальной станции EXAFS-D Курчатовского источника с.и. [34]. Для достижения больших углов дифракции в спектрометре использован прием выноса детектора от исследуемого образца на большое расстояние [30, 31, 35]. Конструкция станции EXAFS-D позволяет выносить детектор от образца на расстояние до 2 м, что соответствует углу дифракции 179.5°.
Рентгенооптическая схема спектрометра приведена на рис. 1. Белый пучок с критической энергией 7.1 кэВ из поворотного магнита ускорительно-накопительного комплекса проходит через узел стабилизации вертикального положения [36]. Размещение узла стабилизации на расстоянии 22 м от точки излучения позволяет получить высокую степень стабилизации вертикального положения пучка на входе в спектрометр. Отклонение вертикального положения орбиты пучка не превышает нескольких микрометров, а ошибка отклонения вертикального угла порядка 1 мкрад. Это, в свою очередь, обеспечивает стабильность углового положения падающего пучка по вертикали. В выбранной рентгенооптической схеме плоскость дифракции образца вертикальна, и возможная нестабильность вертикального положения падающего пучка непосредственно влияет на погрешность измерений.
Рис. 1.
Рентгенооптическая схема спектрометра. СП – узел стабилизации вертикального положения “белого” пучка с.и., Щ – щели пучка с.и., M1 – предварительный монохроматор Si (111), M2 – прорезной монохроматор Si (440), X–Z – сканер исследуемого образца (условно показанный), Об – образец, ФЭУ1 – фотоэлектронный умножитель (ф.э.у.) на кронштейне дифрактометра, ФЭУ2 – в положении регистрации дифрагированного излучения на углы, близкие к π, ППД – полупроводниковый детектор, IP (Image Plate) – пластина изображения на вертикальной подвижке.
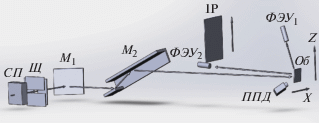
Пройдя блок щелей, пучок падает на вертикально стоящий предварительный монохроматор М1, представляющий собой плоский монокристалл. Плоскость дифракции этого монохроматора горизонтальна. Монохроматором М1 из спектра с.и. выбирается требуемая длина волны излучения, кроме того, он уменьшает тепловую нагрузку на далее установленный прорезной монохроматор М2. Для уменьшения влияния атмосферы предварительный монохроматор М1 находится в вакуумном защитном кожухе.
Далее следующие вдоль направления распространения с.и. элементы спектрометра (прорезной монохроматор, узел дифрактометра, детекторы, узел пластины изображения) находятся на поворотной скамье, которая может поворачиваться вокруг оси предварительного монохроматора. Углы дифракции на нем ограничиваются выходным бериллиевым окном вакуумной защитной камеры и составляют от 6° до 30°, что соответствует энергетическому диапазону излучения 7.6–37 кэВ. Энергетическая ширина пучка ΔЕ после предварительного монохроматора определяется размерами источника с.и., расстоянием до спектрометра и щелями “белого” пучка с.и. Для описываемой в данной работе экспериментальной схемы величина ΔЕ/Е ~ 10–4.
Предварительно монохроматизированный пучок попадает на прорезной монохроматор М2 – монокристалл Si (nn0). Плоскость дифракции этого монохроматора вертикальна. Энергетическая ширина пучка после прорезного монохроматора М2 составляет ΔЕ/Е ~ 10–5. Прорезной монохроматор установлен на узле поворота. Узел поворота, описанный в работе [37], представляет собой гониометрическое устройство, приводимое в движение пьезодвигателем, с шагом 1''.
В целом выбор описанных выше монохроматоров М1 и М2 спектрометра нацелен на то, чтобы обеспечить:
– возможность выделения из “белого” пучка с.и. фотонов с энергией, соответствующей углам дифракции излучения на образце, близким к π;
– минимизацию разности углов Брэгга монохроматоров и образца с целью уменьшения влияние дисперсии на ширину к.д.о. [38, 39];
– стабильность энергии фотонов, падающих на образец.
В случае одновременного изучения элементного состава образца энергия фотонов, падающих на него, должна быть достаточной для возбуждения флуоресценции элементов, входящих в состав исследуемого кристалла.
Далее пучок освещает исследуемый образец, установленный на дифрактометре. Плоскость дифракции образца вертикальна. Вращение образца вокруг оси θ обеспечивается поворотными механизмами двух уровней. Первый уровень – червячный привод с шаговым двигателем (43.2''/шаг). Второй уровень – поворотный модуль на основе пьезостолба с шагом 1.2'' в диапазоне 120'' (рис. 2).
Рис. 2.
Блок дифрактометра в составе спектрометра. ЧП – червячное колесо привода оси θ, ПС – поворотный пьезомодуль, X–Z – сканер исследуемого образца Об, детектор – ф.э.у. на кронштейне оси 2θ.

Накопленная ошибка дифрактометра оценивалась на основании сравнения расчетных и измеренных положений дифракционных пиков эталонного образца кремния. Так, на диапазоне 100'' определенная таким способом накопленная ошибка составила 0.03''. Выбранный для оценки накопленной ошибки диапазон 100'' является характерным при измерении сдвига кривой качания пьезокристалла, обусловленного изменением параметра решетки вследствие приложения к этому кристаллу внешнего электрического поля.
Исследуемый образец крепится на ручной гониометрической головке, установленной на узле сканирования дифрактометра. Вывод поверхности образца на ось θ и подстройка его по углу наклона φ (так, чтобы падающий и отраженный лучи находились в вертикальной плоскости) осуществляется вручную гониометрической головкой. Узел сканирования позволяет локально изучать степень совершенства кристалла по относительным изменениям межплоскостного расстояния Δd/d. Диапазон сканирования определяется имеющимся диапазоном перемещения блока подвижек и составляет 10 × 10 мм. Пространственное разрешение обуславливается минимальным размером источника излучения (200 мкм) и составляет 20 мкм. Время сканирования при предельном разрешении определяется набранной статистикой для получения желаемого разрешения.
Детектор представляет собой ф.э.у. со сцинтиллятором NaI и регистрирует дифрагировавшие пучки в счетном режиме. Расстояние от кристалла до детектора при использовании вращения детектора на кронштейне дифрактометра 2θ может меняться от 200 до 600 мм, обеспечивая возможность работы на углах дифракции вплоть до 2θ = 178.5°. Вращение детектора вокруг оси 2θ дифрактометра имеет червячный привод с шаговым двигателем (шаг 51''). Для измерений с еще большими углами дифракции детектор снимается с кронштейна, вращающегося вокруг оси 2θ дифрактометра, и устанавливается на стойке, которая может перемещаться вдоль поворотной скамьи на различных расстояниях от оси дифрактометра. При расстоянии детектора 2 м от исследуемого образца достигается угол дифракции 2θ = 179.5°.
Полупроводниковый энергодисперсионный детектор (БДЕР-КИ-11К, Институт физико-технических проблем, Дубна) установлен неподвижно. Энергетическое разрешение детектора составляет 200 эВ. Он регистрирует флуоресцентное излучение образца, возбуждаемое падающим пучком с.и. Важно отметить, что флуоресцентные спектры регистрируются одновременно с измерениями кривых качания.
Для отдельных экспериментов в спектрометре может использоваться двумерный детектор Image Plate (IP). С помощью него могут решаться следующие задачи:
– уточнение угла между осью дифрактометра и монохроматизированным пучком, падающим на исследуемый образец; необходимость в решении этой задачи возникает после перемещения узла дифрактометра вдоль поворотной скамьи;
– тонкая юстировка образца на оси дифрактометра;
– прецизионное измерение угла дифракции.
Все узлы спектрометра объединены в единую систему управления. На рис. 3 приведена блок-схема системы управления спектрометром.
Рис. 3.
Блок-схема управления спектрометром. БНК – большое накопительное кольцо, ПМ – поворотный магнит, CCTV – closed-circuit television (закрытые системы кабельного телевидения), ШД – шаговый двигатель, ППД – полупроводниковый детектор, ЦСП – цифровой сигнальный процессор, ВН – высокое напряжение, ЛИР – инкрементный преобразователь угловых перемещений.
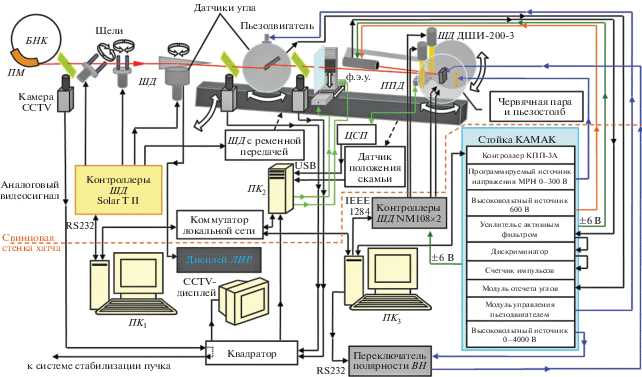
Система управления спектрометром построена по клиент-серверной архитектуре и включает три управляющих компьютера. Первый из них (ПК1) расположен на рабочем месте экспериментатора и является клиентом. Ко второму (ПК2) подключены высокоточные подвижки для перемещения IP, плата видео захвата и флуоресцентный детектор. Третий (ПК3) обеспечивает взаимодействие с контроллерами моторов дифрактометра и привода образца. С этого компьютера экспериментатор выполняет выбор энергии монохроматора М1 (рис. 1) и настройку других узлов экспериментальной установки. В режиме эксперимента он выполняет функцию сервера.
РЕЗУЛЬТАТЫ
В работе [19] нами было проведено прецизионное измерение пьезоэлектрического модуля d11 монокристалла лангасита (LGS – La3Ga5SiO14) на описанном выше спектрометре. Измерения проводились методом дифракции синхротронного излучения на углах, близких к обратному рассеянию. Измерялся сдвиг к.д.о. исследуемого образца при приложении к нему внешнего электрического поля в следующей последовательности: без электрического поля, с отрицательным полем, без поля, с положительным полем (рис. 4). Такая последовательность измерений повторялась многократно для повышения точности измерений за счет уменьшения статистической погрешности. Перед измерением каждой кривой выдерживалась временная пауза 2 мин для релаксации кристалла после внешнего воздействия. Продолжительность измерения одной к.д.о. составляла около 8 мин.
Рис. 4.
Пример серии к.д.о., измеренных в автоматическом режиме с переключением высокого напряжения на исследуемом пьезокристалле LGS.
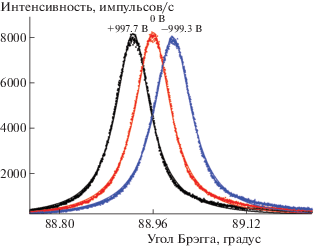
Измеряемый угловой сдвиг дифракционного максимума соответствовал изменению Δd/d ~ 10–5. Погрешность измерения углового сдвига к.д.о. составила ~1%. Приняв утроенный доверительный интервал, граница обнаружения относительного изменения межплоскостного расстояния составит 3 · 10–7.
С целью определения связи величины пьезоэлектрического модуля исследуемого образца с его стехиометрией в спектрометр был включен энергодисперсионный детектор. Был проведен предварительный эксперимент по элементному картированию исследуемого образца (LGT – La3Ga5.5Ta0.5O14). Соотношение интенсивностей линий флуоресценции позволяет определить состав исследуемого образца.
На рис. 5 в качестве примера приведен спектр LGT. В спектре присутствуют линии флуоресценции всех (кроме кислорода) элементов, входящих в состав кристалла. Хорошо разрешаются линии лантана Lα и Lβ1, линия галлия Kα и линия тантала Lα. Так же хорошо видна линия хрома E(CrKα) = = 5.41 кэВ. В процессе напыления на образец серебряных металлических электродов для создания в его объеме однородного электрического поля на его поверхности был нанесен слой хрома для лучшей адгезии. Кислород же флуоресцирует на энергии 520 эВ, которая практически не может быть зарегистрирована в существующей экспериментальной схеме.
Рис. 5.
Пример спектра флуоресцентного излучения кристалла лангатата (La3Ga5.5Ta0.5O14), измеренный полупроводниковым детектором во время измерения кривой качания этого кристалла с помощью ф.э.у. (NaI).
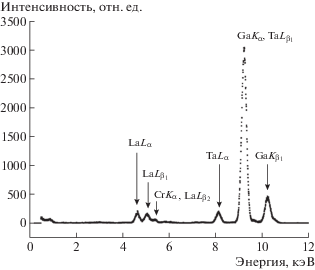
Сформированный оптической схемой спектрометра монохроматический пучок с.и. с энергией 10.5497 кэВ падал на образец LGT размерами 8 × 16 × 0.26 мм. На поверхности образца были выбраны точки размерами 1 × 1 мм с шагом 2 мм. На рис. 6 приведены отношения площади флуоресцентных линий лантана (LaLα) к площади линий галлия (GaKα), что может характеризовать изменение относительного стехиометрического состава на поверхности образца.
ВЫВОДЫ
На синхротронной станции EXAFS-D НИЦ “Курчатовский институт” разработан спектрометр для регистрации кривых дифракционного отражения при углах дифракции вплоть до 2θ = = 179.5°. Предельная чувствительность метода при измерении относительной вариации параметра решетки при нарушении стехиометрического состава или под влиянием внешних воздействий составила 3 · 10–7. Показано, что данный спектрометр позволяет определять относительное изменение параметра решетки под внешним электрическим полем с точностью не хуже 1%. Как было обнаружено ранее, наибольший вклад в итоговую погрешность дает статистическая ошибка измерений. Суммарный вклад в результат измерений остальных погрешностей оказывается практически несущественным. Предварительный эксперимент по картированию элементного состава образцов показал вариацию состава в выбранных точках. Дальнейшие эксперименты позволят определить связь между стехиометрией и функциональными свойствами исследуемых образцов и дадут возможность получать уникальную информацию, имеющую практическое значение для отработки технологии синтеза новых материалов с заданными свойствами.
Список литературы
Андреев И.А. // Журнал техн. физики. 2004. Т. 74. № 9. С. 1.
Iwataki T., Ohsato H., Tanaka K., Morikoshi H., Sato J., Kawasaki K. // J. European Ceramic Society. 2001. V. 21. P. 1409. https://doi.org/10.1016/S0955-2219(01)00029-2
Roshchupkin D.V., Irzhak D.V., Roshchupkina E.D., Buzanov O.A. // Crystallography Reports. 2004. V. 49. Suppl. 1. P. S80.
Каурова И.А., Кузьмичева Г.М., Рыбаков В.Б., Дубовский А.Б. Неорганические материалы. 2010. Т. 46. № 9. С. 1100.
Stade J., Bohaty L., Hengst M., Heimann R.B. // Crystal Research and Technology. 2002. V. 37. № 10. P. 1113. https://doi.org/10.1002/15214079(200210)37:10<1113::AID-CRAT1113>3.0.CO;2-E
Kong H., Wang J., Zhang H., Yin X., Zhang S., Liu Y., Cheng X., Gao L., Hu X., Jiang M. // J. Crystal Growth. 2003. V. 254. P. 360. https://doi.org/10.1016/S0022-0248(03)01106-0
Xin Y., Jiyang W., Huaijin Z., Shaojun Z., Rongjiang H., Tingxiou C. // Jpn. J. Appl. Phys. 2002. V. 41. Pt. 1. № 12. P. 7419. https://doi.org/10.1143/JJAP.41.7419
Haussuhl S., Bohaty L., Becker P. // Appl. Phys. A. 2006. V. 82. P. 495. https://doi.org/10.1007/s00339-005-3443-6
Kaminskii A.A., Mill B.V., Khodzhabagyan G.G., Konstantinova A.F., Okorochkov A.I., Silvestrova I.M. // Phys. Status Solidi A. 1983. V. 80. P. 387. https://doi.org/10.1002/pssa.2210800142
Buzanov O., Didenko I.S., Kozlova N.S., Zabelina E.V. // Moldavian J. Phys. Sci. 2006. V. 5. № 1. P. 33.
Кузьмичева Г.М., Каурова И.А., Рыбаков В.Б., Дубовский А.Б., Куссон А., Захарко О. // Кристаллография. 2010. Т. 55. № 6. С. 1126.
Кузьмичева Г.М., Захарко О., Тюнина Е.А., Рыбаков В.Б., Каурова И.А., Доморощина Е.Н., Дубовский А.Б. // Кристаллография. 2009. Т. 54. № 2. С. 303.
Благов А.Е., Марченков Н.В., Писаревский Ю.В., Просеков П.А., Ковальчук М.В. // Кристаллография. 2013. Т. 58. № 1. С. 49. https://doi.org/10.7868/S0023476113010050
Марченков Н.В., Куликов А.Г., Аткнин И.И., Петренко А.А., Благов А.Е., Ковальчук М.В. // Успехи физ. наук. 2019. Т. 189. № 2. С. 187. https://doi.org/10.3367/UFNr.2018.06.038348
Fukuda T., Takeda H., Shimamura K., Kawanaka H., Kumatoriya M., Murakami S., Sato J., Sato M. // 1998 IEEE – EIT Int. Freguency Control Symp. and Exhibition. 1988. P. 315. https://doi.org/10.1109/ISAF.1998.786697
Mill B.V., Pisarevsky Yu.V. // IEEE – EIA Int. Frequency Control Symp. and Exhibition. 2000. P. 133. https://doi.org/10.1109/FREQ.2000.887343
Bohm J., Chilla E., Flannery C., Frohlich H.-J., Hauke T., Heimann R.B., Hengst M., Straube U. // J. Crystal Growth. 2000. V. 216. Issues 1–4. P. 293. https://doi.org/10.1016/S0022-0248(00)00440-1
Irzhak D., Roshchupkin. D. // Appl. Cryst. 2018. V. 51. P. 1174. https://doi.org/10.1107/S1600576718009184
Gureva P.V., Marchenkov N.V., Artemev A.N., Artemiev N.A., Belyaev A.D., Demkiv A.A., Shishkov V.A. // J. Appl. Cryst. 2020. V. 53. P. 734. https://doi.org/10.1107/S1600576720005154
Доморощина Е.Н., Дубовский А.Б., Кузьмичева Г.М., Семенкович Г.В. // Неорганические материалы. 2005. Т. 41. № 11. С. 1378.
Дубовский А.Б., Тюнина Е.А., Доморощина Е.Н., Кузьмичева Г.М., Рыбаков В.Б. // Неорганические материалы. 2008. Т. 44. № 5. С. 601.
Каурова И.А., Кузьмичева Г.М., Кауссон А. // Поверхность. Рентгеновские, синхротронные и нейтронные исследования. 2014. № 7. С. 5. https://doi.org/10.7868/S0207352814070087
Gorfman S., Schmidt O., Pietsch U., Becker P., Bohaty L. // Z. Kristallogr. 2007. V. 222. P. 396. https://doi.org/10.1524/zkri.2007.222.8.396
Рощупкин Д.В., Иржак Д.В., Пунегов Д.В. // Изв. РАН. Серия физическая. 2008. Т. 72. № 2. С. 201.
Schmidt O., Gorfman S., Pietch U. // Cryst. Res. Technol. 2008. V. 43. № 11. P. 1126. https://doi.org/10.1002/crat.200800335
Ковальчук М.В., Благов А.Е., Куликов А.Г., Марченков Н.В., Писаревский Ю.В. // Кристаллография. 2014. Т. 59. № 6. С. 950. https://doi.org/10.7868/S0023476114060149
Куликов А.Г., Благов А.Е., Марченков Н.В., Ломонов В.А., Виноградов А.В., Писаревский Ю.В., Ковальчук М.В. // Письма в ЖЭТФ. 2018. Т. 107. № 9. С. 684. https://doi.org/10.7868/S0370274X18100119
Kulikov A.G., Blagov A.E., Ilin A.S., Marchenkov N.V., Pisarevsky Yu.V., Kovalchuk M.V. // J. Appl. Phys. 2020. V. 127. P. 065106. https://doi.org/10.1063/1.5131369
Gorfman S., Schmidt O., Ziolkowski M., Kozierowski M., Pietsch U. // Appl. Phys. 2010. V. 108. P. 064911. https://doi.org/10.1063/1.3480996
Graeff W., Materlik G. // Nucl. Instrum. and Methods. 1982. V. 195. P. 97. https://doi.org/10.1016/0029-554X(82)90764-9
Verbeni R., Sette F., Krisch H., Bergmann U., Gorges B., Halcoussis C., Martel K., Masciovecchio C., Ribois J.F., Ruocco G., Sinn H. // J. Synchrotron Rad. 1996. V. 3. P. 62. https://doi.org/10.1107/S0909049595015883
Sette F., Ruocco G., Krisch M., Bergmann U., Masciovecchio C., Mazzacurati V., Signorelli G., Verbeni R. // Phys. Rev. Lett. 1995. V. 75. P. 850. https://doi.org/10.1103/PhysRevLett.75.850
Colella R., Luccio A. // Opt. Commun. 1984. V. 50. P. 41. https://doi.org/10.1016/0030-4018(84)90009-9
http://kcsni.nrcki.ru/pages/en/source/index.shtml
Freund A., Schneider J. // J. Crystal Growth. 1972. V. 13/14. P. 247. https://doi.org/10.1016/0022-0248(72)90163-7
Резвов В.А., Артемьев А.Н., Демкив А.А., Валентинов А.Г., Забелин А.В., Ковачев Г.А., Корчуганов В.Н., Крылов Ю.Н., Юпинов Ю.Л. // ПТЭ. 2008. № 2. С. 47.
Artemiev A.N., Krupin S.V., Podshibyakin V.D., Kharitonov A.D. // Nucl. Instrum. and Methods. 1991. V. A308. P. 459. https://doi.org/10.1016/0168-9002(91)90694-L
Марченков Н.В., Чуховский Ф.Н., Благов А.Е. // Кристаллография. 2015. Т. 60. № 2. С. 194. https://doi.org/10.7868/S0023476115020198
Honnicke M.G., Cusatis C. // J. Phys. D: Appl. Phys. 2005. V. 38. P. A73. https://doi.org/10.1088/0022-3727/38/10A/014
Дополнительные материалы отсутствуют.
Инструменты
Приборы и техника эксперимента



