Радиотехника и электроника, 2019, T. 64, № 10, стр. 1019-1024
Формирование массива мемристивных кроссбар-структур на базе нанокомпозита (Co40Fe40B20)x(LiNbO3)100 – x
К. Э. Никируй 1, 2, А. В. Емельянов 1, 2, В. В. Рыльков 1, 3, *, **, А. В. Ситников 1, 4, М. Ю. Пресняков 1, Е. В. Кукуева 1, Ю. В. Грищенко 1, А. А. Миннеханов 1, К. Ю. Черноглазов 1, С. Н. Николаев 1, И. А. Черных 1, М. Л. Занавескин 1, В. А. Демин 1, 2
1 Национальный исследовательский центр “Курчатовский институт”
123182 Москва, пл. Академика Курчатова, 1, Российская Федерация
2 Московский физико-технический институт
141700 Долгопрудный, Московской обл., Институтский переулок, 9, Российская Федерация
3 Фрязинский филиал Института радиотехники и электроники им. В.А. Котельникова РАН
141190 Фрязино, Московской обл., пл. Введенского, 1, Российская Федерация
4 Воронежский государственный технический университет
394026 Воронеж, Московский просп., 14, Российская Федерация
* E-mail: vvrylkov@mail.ru
** E-mail: rylkov_vv@nrcki.ru
Поступила в редакцию 26.11.2018
После доработки 28.12.2018
Принята к публикации 15.01.2019
Аннотация
Продемонстрирована возможность масштабирования недавно разработанных нами нового типа мемристоров на базе нанокомпозита (Co40Fe40B20)x(LiNbO3)100 – x путем формирования массива элементов с площадью 50 × 50 мкм2. Показано, что разброс сопротивлений в высокомном (“выключенном”; Roff) и низкоомном (“включенном”; Ron) состояниях при резистивных переключениях (РП) не превышает 25%, а отдельные элементы демонстрируют устойчивость к циклическим переключениям, превышающим 2 × 105 раз при Roff/Ron > 10. Впервые в области РП продемонстрирована возможность квазинепрерывного изменения резистивного состояния структур путем пошаговых его изменений с точностью не хуже 0.2% (256 шагов в диапазоне 0.5…3 МОм).
ВВЕДЕНИЕ
В последнее время резко возрос интерес к разработке нейроморфных вычислительных систем (НВС) для решения, так называемых, антропоморфных задач: распознавание образов и естественного языка, принятие решений, обобщение, прогнозирование и др. [1–6]. При решении такого рода задач НВС обладают очень малым энергопотреблением и могут существенно превосходить по эффективности обработки информации (скорости и достоверности) современные вычислительные системы, базирующиеся на архитектуре фон Неймана. Например, суперкомпьютер IBM Blue Gene при моделировании в течение 5 с мозговой деятельности кошки потребляет 1.4 МВт, тогда как человеческий мозг потребляет мощность не превышающую нескольких десятков Ватт [7].
Толчком к развитию биоподобных НВС послужило сравнительно недавнее обнаружение запоминающих (мемристивных) свойств структур металл/диэлектрик/металл (М/Д/М) на основе диэлектрических нанослоев TiO2 – x с вакансиями кислорода [8]. В результате движения в таких структурах кислородных вакансий в сильном импульсном электрическом поле оказывается возможным непрерывно не только изменять, но и сохранять электрическое сопротивление структуры после снятия импульса напряжения, что позволяет всего лишь одним двухэлектродным элементом моделировать действие синапса (контакта между двумя нейронами), играющего ключевую роль в построении НВС [5, 6]. Существенно, что в современных мемристорах резистивное переключение (РП) из одного состояния в другое требует очень малых затрат энергии (~5 фДж [9]), сравнимых с потреблением энергии при изменении весов биологических синапсов, что в сочетании с высокой плотностью упаковки мемристорных элементов, достигаемой, например, в топологии кроссбар (элементы находятся на пересечениях взаимно перпендикулярных электродных шин “битов” и “слов”) [10], делает их весьма привлекательными для разработки НВС.
За последнее десятилетие обнаружено большое количество различных материалов, обладающих эффектом РП, которые можно классифицировать в зависимости от механизма РП [10, 11]. Наблюдаемые в М/Д/М структурах эффекты РП обычно объясняют процессами электрополевого дрейфа вакансий кислорода VO в слое диэлектрического оксида (TiOx, HfOx, TaOx и др.) [1, 9–13] или электромиграции катионов металлов типа Cu, Ag из активного электрода М/Д/М структуры в диэлектрик (например, SiO2, органика) [14, 15]. Как результат, в диэлектрическом слое образуются (разрушаются) нитевидные хорошо проводящие каналы либо металлические мостики, формирование (разрушение) которых обусловлено передвижением вакансий кислорода или катионов металла, соответственно. Существуют также случаи, когда оба механизма ионного транспорта могут играть существенную роль в РП М/Д/М структурах [11, 12]. Кроме того, отметим, что встречаются и другие механизмы, ответственные за РП: фазовые переходы [10, 11], спин-поляризованный транспорт [16] или электрохимическая реакция в органических материалах [17–19]. Однако на практике наибольший интерес уделяется конденсаторным М/Д/М структурам, в которых эффект РП обусловлен процессами передвижения вакансий кислорода в слое оксида и/или катионов металлов из активного электрода в диэлектрик мемристивной структуры [1, 3–15]. Такие структуры обладают хорошими мемристивными характеристиками: большим числом стабильных (без деградации) циклов РП из высокоомного (Roff) в низкоомное (Ron) состояние и обратно, возможностью подбора произвольного резистивного состояния структуры в интервале между Ron и Roff (пластичность) и его длительного хранения.
Весьма перспективными в этом отношении представляются мемристорные М/Д/М структуры на основе сегнетоэлектрика LiNbO3 [20, 21]. Нами было показано [22, 23], что при введении наночастиц сплава Co40Fe40B20 в матрицу LiNbO3 и формировании структур металл/нанокомпозит/металл (М/НК/М) на основе НК (Co40Fe40B20)x (LiNbO3)100– x удается существенно увеличить число стабильных циклов РП: с 500 циклов [20, 21] до более 105 при отношении Roff/Ron около 50. Важно, что при этом также обеспечивается возможность задания резистивного состояния М/НК/М структур в диапазоне Ron…Roff с точностью не хуже 0.5%, а также длительность хранения резистивных состояний более 104 с [23, 24]. Однако эти результаты были получены на одиночных М/НК/М структурах довольно большой площади S = 0.2 × 0.5 мм2, что, безусловно, не позволяет использовать их для оценки перспектив применения при построении НВС [1–6]. В связи с этим основная цель данной работы – изучить возможность масштабирования М/НК/М структур при уменьшении S до 50 × 50 мкм2, а также определить разброс их параметров от элемента к элементу при формировании массива в “кроссбар”-геометрии.
1. КРОССБАР-СТРУКТУРЫ И МЕТОДЫ ИССЛЕДОВАНИЯ
Набор пленочных мемристивных устройств в топологии кроссбар с числом элементов 3 × 3 и размером устройства (с контактными площадками) 6 × 6 мм2 создавали на подложках кремния ∅51 мм, покрытых слоем SiO2. Эскиз отдельного устройства представлен рис. 1а.
Рис. 1.
Эскиз мемристивного устройства с числом кроссбар-структур 3 × 3 (а) и темнопольное ПРЭМ-изображение сечения кроссбар-структуры (б).
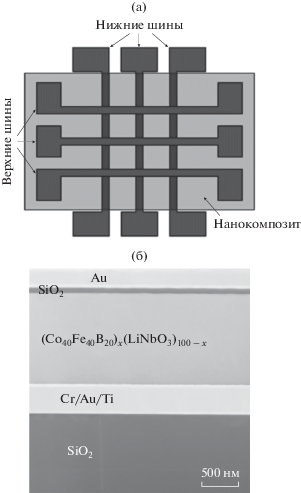
Мемристивные устройства были изготовлены с использованием лазерной фотолитографии (литограф Heidelberg 66fs), атомно-слоевого осаждения (ALD-система Beneq TF S200) и ионно-лучевого распыления составной мишени на оригинальной установке, позволяющей в едином цикле получать слои НК различного состава [25]. Важная особенность при создании ансамбля М/НК/М структур заключалась в использовании при осаждении НК пленок теневых масок, что позволяло сформировать НК полоски необходимых размеров и при этом избежать использования химического травления, которое трудно контролируемо при различных составах НК с толщиной ~1 мкм. Кроме того, мы ввели высокоомный SiO2-слой у верхнего электрода М/НК/М-структур, чтобы увеличить устойчивость структур к циклическим РП по аналогии со структурами на основе слоев Al2O3/TiO2– x [26].
Технологический маршрут включал следующие операции.
1. На подложках SiO2/Si с использованием фоторезиста взрывного типа и лазерной литографии были сформированы трехслойные нижние шины – пленки Cr/Au/Ti с толщинами слоев 0.02, 0.3 и 0.02 мкм соответственно. Трехслойные пленки Cr/Au/Ti создавались методом термического испарения.
2. Поверх нижних металлических шин методом атомно-слоевого осаждения был нанесен изолирующий слой диэлектрика Al2O3 толщиной 0.01 мкм, который затем был удален химическим травлением с использованием фотолитографической техники в местах пересечения нижней и верхней шин, а также контактных площадок нижней шины.
3. Методом ионно-лучевого распыления через теневые маски между контактными площадками нижних шин были сформированы полоски функционального слоя НК (Co40Fe40B20)x(LiNbO3)100– x шириной 4.8 мм и толщиной 1.5 мкм. Осаждение осуществляли при комнатной температуре одновременно на две вертикально расположенные подложки. Всего было сформировано 10 полосок НК (по пять на подложке), концентрация металлической фазы в которых была одинаковой. При этом содержание металла от верхней (первой) до нижней (десятой) полоски (строки) увеличивалось от ≈9 до 20 ат. %.
4. Поверх слоя НК методом ионно-лучевого распыления был нанесен изолирующий слой диэлектрика SiO2 толщиной 0.15 мкм, в котором химическим травлением с использованием фотолитографической техники были созданы “окна” глубиной 0.1 мкм в областях пересечения нижней и верхней шин.
5. На заключительном этапе с использованием фоторезиста взрывного типа и лазерной литографии были сформированы двухслойные верхние шины Au/Cr с толщинами слоев 0.8 и 0.02 мкм соответственно. Пленки Au/Cr создавались методом термического испарения.
В результате этих операций на одной подложке SiO2/Si было сформировано 21 устройство с общим числом кроссбар-элементов 189 для исследований мемристивных свойств ансамбля М/НК/М-структур.
Элементный состав НК определялся на образцах-свидетелях с использованием энергодисперсионной рентгеновской приставки Oxford INCA Energy 250 на сканирующем электронном микроскопе JEOL JSM-6380 LV. Микроструктура кроссбар-элементов с нанометровым разрешением была изучена методами энергодисперсионного рентгеновского микроанализа (ЭРМ), просвечивающей электронной микроскопии (ПЭM) и просвечивающей растровой электронной микроскопии (ПРЭМ) с использованием электронного микроскопа (TEM/STEM) TITAN 80–300 (FEI, США) (подробнее см. в [27]).
Исследования мемристивных свойств М/НК/М кроссбар-структур проводили при комнатной температуре с помощью многофункционального источника-измерителя NI PXI-4141 (National Instruments) и аналитической зондовой станции PM5 (Cascade Microtech), снабженной оптической системой микрометрического перемещения зондов PSM-100 (Motic) (подробнее см. в [23]).
2. РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Темнопольное ПРЭМ-изображение вертикального сечения кроссбар-структуры представлено на рис. 1б. Данные ПРЭМ и ЭРМ показывают, что синтезированная структура соответствует многослойной композиции Au/Cr/SiO2/Co40Fe40B20-LiNbO3/Cr/Au/Ti/SiO2/Si. Толщины верхнего изолирующего слоя SiO2 ≈0.05 мкм и активного слоя НК (Co40Fe40B20)x (LiNbO3)100– x ≈ 1.2 мкм совпадают с технологически заданными толщинами (см. выше). Результаты ПЭМ свидетельствуют также о том, что НК состоит из гранул CoFeB размером a = 2…3 нм (точный состав гранул не удается определить существующими методами ЭРМ), расположенных в изолирующей матрице состава B–Li–Nb–O. На масштабах (≥30 нм), заметно превышающих a, гранулы распределены однородно как по толщине полоски НК, так и вдоль ее длины.
Согласно нашим недавним исследованиям [22, 23] наиболее сильные и устойчивые РП в М/НК/М структурах на основе НК (Co40Fe40B20)x (LiNbO3)100– x наблюдаются при некотором оптимальном содержании сплава хопт ниже порога перколяции (на диэлектрической стороне перехода металл–изолятор). Конкретная величина хопт может зависеть от размера гранул и анизотропии их формы (вытянутости вдоль оси роста НК). В случае кроссбар-элементов на основе М/НК/М-структур значение хопт оказалось ≈14 ат. % (6-я полоска), что близко к величине хопт ≈ 11 ат. %, полученной для М/НК/М-структур большой площади, выращенных на ситалловых подложках [23].
Рассмотрим результаты исследований мемристивных свойств кроссбар-структур с оптимальной концентрацией металлической фазы x ≈ 14 ат. %. Рисунок 2a демонстрирует устойчивость структур к деградации при циклических переключениях структуры между Ron и Roff. Для РП в состояния ON и OFF использовались, соответственно, импульсы положительной и отрицательной полярности амплитудой UРП = ±10 В длительностью tРП = 100 мс. После каждого РП производилось чтение импульсами с амплитудой Ur = 2 В длительностью tr = 50 мс. Мы не смогли наблюдать заметных эффектов деградации при числе циклов РП, превышающем 2 × 105 (см. рис. 2a), что больше, чем для Si Flash памяти.
Рис. 2.
Зависимость сопротивления кроссбар-структуры от количества циклов (N) резистивного переключения в состояния “ON” (1) и “OFF” (2) (а), а также гистограммы распределений сопротивлений Ron (б) и Roff (в) в нормированном виде при μ = 4.4 × × 106 Ом, σ = 7.7 × 105 Ом и μ = 3.9 × 108 Ом, σ = 9.6 × × 107 Ом соответственно и их аппроксимация (сплошные кривые); штриховые линии показывают среднеквадратичные отклонения резистивных состояний.
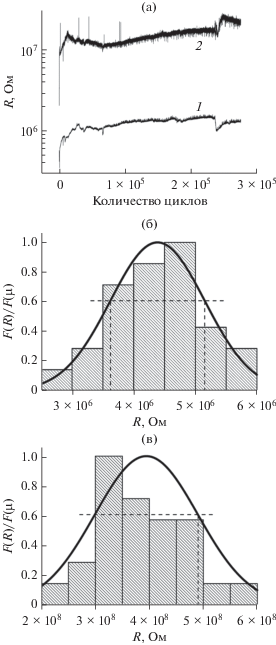
Разброс характеристик мемристивных кроссбар-структур в массиве также изучался при РП структуры в ON и OFF состояния импульсами напряжения UРП = ±10 В (tРП = 100 мс) и чтения Ur = = 2 В (tr = 50мс). Последовательность таких импульсов повторялась 10 раз для 27 кроссбар-структур, принадлежащих трем устройствам; затем определяли средние значения Ron и Roff по 10 выборкам. На рис. 2б и 2в представлены гистограммы распределений сопротивлений Ron и Roff в нормированном виде, а также аппроксимация полученных распределений функцией Гаусса. При средних значениях (μ) сопротивлений Ron ≈ 4.4 МОм и Roff ≈ 400 МОм относительные среднеквадратичные отклонения составляют σ/μ ≈ 18 и 25% соответственно, что заметно меньше чем в случае, например, матрицы мемристоров 40 × 40 на основе a-Si (σ/μ ≈ 50%), хорошо интегрируемой с КМОП-технологией [28]. Вероятнее всего, это обусловлено наличием в нашем случае изолирующих SiO2-прослоек, увеличивающих сопротивление М/НК/М-структур и подавляющих токи растекания, которые влияют на резистивное состояние мемристивных элементов [28], а кроме того, с меньшим количеством элементов в используемой нами мемристорной матрице (3 × 3). Отметим также, что разброс синаптических весов не более ~50% считается приемлемым для нейроморфных применений (см. [28]), а для построения криптографических примитивов определенный разброс даже необходим [29].
Для использования мемристорных матриц в НВС важна также способность принимать произвольное резистивное состояние отдельных элементов матрицы в окне между Ron и Roff и хранить его в течение длительного времени. На рис. 3a показана зависимость сопротивления от времени, после переключения кроссбар-структуры в два заданных состояния с помощью алгоритма, описанного в работе [24]. Из рисунка явствует, что изменение сопротивления в этих состояниях незначительно на протяжении времени ≥104 с. Рисунок 3б демонстрирует возможность квазинепрерывного изменения сопротивления приблизительно в течение 8 ч в диапазоне 0.5…3 МОм путем пошаговых его изменений (256 шагов) также с использованием алгоритма [24]. Точность задания сопротивления на каждом шаге составляла 0.2% (±1000 Ом), а шум в сопротивлении не превышал 0.1% (см. вставку). Насколько нам известно, столь плавный характер изменения сопротивления мемристивных структур в области РП ранее не демонстрировался.
Рис. 3.
Временные зависимости сопротивления структуры в резистивных состояниях “on” (1) и “off” (2) (а), а также демонстрация возможности квазинепрерывного изменения сопротивления в диапазоне 0.5…3 МОм путем пошаговых его изменений (256 шагов) (б).

Наконец отметим, что при использованном технологическом маршруте формирования массива мемристивных кроссбар-структур наблюдается довольно высокий процент выхода годных элементов (не менее 95%).
ЗАКЛЮЧЕНИЕ
Таким образом, в разработанных матрицах мемристивных структур на базе нанокомпозита (CoFeB)x(LiNbO3)100 – x типичный разброс сопротивлений в заданных резистивных состояниях не превышает 25%, что вполне приемлемо для их применений при создании НВС. Кроме того, существенно, что отдельные элементы демонстрируют устойчивость к циклическим переключениям, число которых превышает 2 × 105 при Roff/Ron > 10, а также возможность плавного задания резистивного состояния в области РП с точностью не хуже 0.2%. Определенным недостатком мемристивных элементов является высокий уровень напряжений РП (≈10 В), обусловленный, вероятно, используемыми относительно толстыми SiO2-слоями (≈50 нм) в М/НК/М-структурах. Поэтому необходимы дальнейшие работы, направленные на оптимизацию отдельных элементов и увеличение их количества в матрице (>100).
Список литературы
Prezioso M., Bayat F.M., Hoskins B. et al. // Sci. Rep. 2016. V. 6. P. 21331.
Emelyanov A.V., Lapkin D.A., Demin V.A. et al. // AIP Advances. 2016. V. 6. P. 111301.
Yao P., Wu H., Gao B. et al. // Nat. Commun. 2017. V. 8. P. 15199.
Mikhaylov A.N., Morozov O.A., Ovchinnikov P.E. et al. // IEEE Trans. 2018. V. ETCI-2. № 5. P. 371.
Burr G.W., Shelby R.M., Sebastian A. et al. // Advances in Physics: X. 2017. V. 2. P. 89.
Zidan M.A., Strachan J.P., Lu. W.D. // Nature Electr. 2018. V. 1. P. 22.
Sengupta A., Azim Z.A., Fong X. et al. // Appl. Phys. Lett. 2015. V. 106. P. 093704.
Strukov D.B., Snider G.S., Stewart D.R. et al. // Nature. 2008. V. 453. P. 80.
Yin J., Zeng F., Wan Q. et al. // Adv. Funct. Mater. 2018. P. 1706927.
Ielmini D. // Semicond. Sci. Technol. 2016. V. 31. P. 063002.
From Fundamentals of Nanoionic Redox Processes to Memristive Device Applications / Ed. Ielmini D., Waser R. Resistive Switching. Weinheim: Wiley-VCH Verlag GmbH & Co, 2016.
Jiang H., Han L., Lin P. et al. // Sci. Rep. 2016. V. 6. P. 28525.
Yang M.K., Ju H., Kim G.-H. et al. // Sci. Rep. 2015. V. 5. P. 14053.
Mehonic A., Shluger A.L., Gao D. et al. // Adv. Mater. 2018. V. 30. P. 1801187.
Lin M., Chen Q., Wang Z. et al. // Polymers. 2017. V. 9. P. 310.
Grollier J., Querlioz D., Stiles M.D. // Proc. IEEE. 2016. V. 104. P. 2024.
Das B.C., Pillai R.G., Wu Y. et al. // ACS Appl. Mater. Inter. 2013. V. 5. № 21. P. 11052.
Lapkin D.A., Korovin A.N., Demin V.A. et al. // BioNanoSci. 2015. V. 5. P. 181.
Lapkin D.A., Emelyanov A.V., Demin V.A. et al. // Appl. Phys. Lett. 2018. V. 112. № 4. P. 043302-1-4.
Pan X., Shuai Y., Wu C. et al. // Appl. Phys. Lett. 2016. V. 108. № 3. P. 032904.
Yakopcic C., Wang S., Wang W. et al. // Neural Comput. & Applic. 2017. V. 30. № 12. P. 3773.
Рыльков В.В., Николаев С.Н., Демин В.А. и др. // ЖЭТФ. 2018. Т. 153. № 3. С. 424.
Леванов В.А., Емельянов А.В., Демин В.А. и др. // РЭ. 2018. Т. 63. № 5. С. 489.
Никируй К.Э., Емельянов А.В., Демин В.А. и др. // Письма в ЖТФ. 2018. Т. 44. № 10. С. 20.
Rylkov V.V., Demin V.A., Emelyanov A.V. et al. // Novel Magnetic Nanostructures: Unique Properties and Applications / Ed. Domracheva N., Caporali M., Rentschler E. Amsterdam: Elsevier, 2018. Ch. 13. P. 427.
Hudec B., Paskaleva A., Jančovičet P. et al. // Thin Solid Films. 2014. V. 563. P. 10.
Rylkov V.V., Nikolaev S.N., Chernoglazov K.Yu. et al. // Phys. Rev. B. 2017. V. 95. P. 144202.
Kim K.-H., Gaba S., Wheeleret D. et al. // Nano Lett. 2012. V. 12. P. 389.
Nili H., Adam G.C., Hoskins B. et al. // Nature Electronics. 2018. V. 1. P. 197.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника


