Радиотехника и электроника, 2019, T. 64, № 10, стр. 1029-1033
Определение параметров туннельных барьеров сверхпроводящих туннельных структур для приемников субмиллиметрового диапазона
М. Е. Парамонов 1, *, Л. В. Филиппенко 1, П. Н. Дмитриев 1, М. Ю. Фоминский 1, В. П. Кошелец 1
1 Институт радиотехники и электроники им. В.А. Котельникова РАН
125009 Москва, ул. Моховая, 11, стр. 7, Российская Федерация
* E-mail: paramonov@hitech.cplire.ru
Поступила в редакцию 07.05.2019
После доработки 17.05.2019
Принята к публикации 21.05.2019
Аннотация
Проведена оценка параметров туннельного барьера джозефсоновских переходов Nb/Al–AlOx/Nb в широком диапазоне значений плотностей тока с использованием метода Симмонса. Показано, что при увеличении значения удельного сопротивления RnS от 60 до 2100 Ом мкм2 (уменьшении плотности туннельного тока перехода J от 3.5 до 0.1 кА/см2) возрастают значения высоты туннельного барьера от 0.85 до 1.18 эВ, а его ширина увеличивается с 10.7 до 13.3 Å. Экспериментально наблюдаемая линейная зависимость параметров туннельного барьера от RnS позволила оценить емкость переходов в области значений RnS 10…30 Ом мкм2, требуемых для создания малошумящих приемников субмиллиметрового диапазона.
ВВЕДЕНИЕ
Для проведения исследований в субмиллиметровом диапазоне длин волн необходимо спектрометрическое оборудование высокого разрешения, работающее на терагерцовых (ТГц) частотах и имеющее очень низкий уровень собственных шумов. Самыми эффективными в этой области являются сверхпроводящие гетеродинные приемные системы. Одним из основных элементов гетеродинного приемника является смеситель, имеющий нелинейную вольт-амперную характеристику (ВАХ). В качестве смесителя в таком приемнике выступает переход сверхпроводник–изолятор–сверхпроводник (СИС) [1–10]. Присутствие тонкого слоя изолятора в СИС – структуре определяет наличие заметной емкости, которая шунтирует нелинейное сопротивление смесителя на высокой частоте. Для реализации смесителя с малыми потерями преобразования и, как следствие, снижения собственных шумов смесителя до уровня, близкого к hf/k, емкость СИС-перехода должна быть скомпенсирована введением дополнительной индуктивности. Таким образом, для проектирования качественных и чувствительных гетеродинных приемников необходимо знание точного значения емкости используемых СИС-переходов.
Для оценки емкости можно использовать измерение геометрических и электрических параметров туннельного перехода. Одним из таких параметров является толщина изоляционного слоя d. Поскольку в процессе изготовления СИС-смесителя на основе трехслойной структуры Nb/Al–AlOx/Nb слой изолятора AlOx формируется путем окисления Al, некоторая часть металла остается неокисленной. Тем самым реальная толщина слоя AlOx остается неизвестной. Существует универсальный метод определения толщины туннельного барьера d, а также его средней высоты φ из ВАХ при больших напряжениях, основанный на измерении зависимости плотности туннельного тока от напряжения. Эта зависимость была предложена Дж. Симмонсом [11] и обобщена В. Бринкманом [12] для туннельных переходов в пределе малых напряжений смещения.
Основными характеристиками туннельного барьера типа металл–изолятор–металл являются средняя высота барьера φ и его ширина d, по этим параметрам можно судить о характеристиках изготовленных переходов, в частности, свойств его тонкого изоляционного слоя. При этом полагается, что реальный асимметричный туннельный барьер можно в первом приближении аппроксимировать прямоугольником шириной d и высотой φ (рис. 1). Как показано в работе [11], ток через переход для эквивалентного прямоугольного барьера вычисляется по формуле
(1)
$\begin{gathered} j = {{j}_{0}}\left( {{\varphi }\exp \left( { - B\sqrt {{\bar {\varphi }}} } \right)} \right. \\ \left. { - \,\,\left( {{\bar {\varphi }} + eV} \right){\text{exp}}\left( { - B\sqrt {{\bar {\varphi }} + eV} } \right)} \right). \\ \end{gathered} $(2)
$G = {{dI} \mathord{\left/ {\vphantom {{dI} {dV}}} \right. \kern-0em} {dV}} = \alpha \left( {1 + 3\gamma {{V}^{2}}} \right),$(3)
$\alpha = 3.16 \times {{10}^{{10}}}\frac{{\sqrt {\varphi } }}{d}{\text{exp}}\left( { - 1.025d\sqrt {{\bar {\varphi }}} } \right),$(4)
$\gamma = 0.0115\frac{{{{d}^{2}}}}{{{\bar {\varphi }}}} - 0.0315\frac{d}{{{{{{\bar {\varphi }}}}^{{{3 \mathord{\left/ {\vphantom {3 2}} \right. \kern-0em} 2}}}}}}.$Рис. 1.
Схематическое изображение потенциального барьера в СИС-структурах: а) асимметричный барьер (пунктир) и аппроксимирующий его прямоугольный барьер (сплошная линия) при V = 0; б) случай промежуточных напряжений смещения (eV < φ).
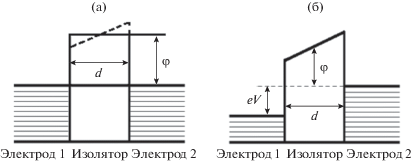
Технология изготовления высококачественных туннельных переходов субмикронных размеров была разработана и оптимизирована в ИРЭ им. В.А. Котельникова РАН [8–10]; эта технология успешно использовалась для создания интегральных приемных устройств ТГц-диапазона [13–15]. В настоящее время проводится разработка приемных систем для новых радиоастрономических проектов [15–17], в том числе для приемного комплекса космической обсерватории “Миллиметрон” [18], работающей в диапазоне 211…275 ГГц. Были разработаны, изготовлены и исследованы экспериментальные образцы СИС-смесителей данного диапазона; на рис. 2 представлены ВАХ СИС-смесителя: автономная кривая и ВАХ под воздействием излучения генератора гетеродина на частоте 265 ГГц (эффект Джозефсона подавлен магнитным полем). Сопротивление перехода: Rn = 38 Ом, площадь S = 0.73 мкм2, параметр качества Rj/Rn = 27, щелевое напряжение Vg = 2.85 мВ.
Рис. 2.
Вольт-амперные характеристики – автономная (сплошная линия) и под воздействием излучения гетеродина на частоте 265 ГГц (пунктир) – СИС-смесителя на основе переходов Nb/Al-AlOx/Nb, критический ток подавлен магнитным полем.
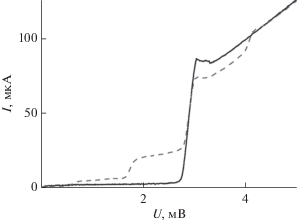
При измерении параметров туннельного барьера использовались переходы Nb/Al–AlOx/Nb. Данный тип переходов является самым распространенным и используется в большинстве устройств и схем низкотемпературной сверхпроводящей электроники. Значения удельного сопротивления RnS для исследуемых переходов лежали в диапазоне от 20 до 2100 Ом мкм2.
Образцы изготавливали методами тонкопленочных технологий на подложке из высокоомного кремния. Все основные слои перехода наносили на подложку в едином вакуумном цикле методом магнетронного распыления. Туннельный слой AlOx создавали путем оксидирования тонкого слоя Al при постоянном давлении кислорода в камере. Далее методами фотолитографии и плазмохимического травления была сформирована геометрия переходов и подводящих электродов. Готовый образец содержал в себе до 14 СИС-переходов различной площади. Измерения проводили при температуре жидкого гелия. Для каждого перехода измеряли ВАХ в диапазоне напряжений ±0.6 В.
На рис. 3 показаны ВАХ переходов, изготовленных на одной из подложек. Характеристики представлены для двух переходов – с наибольшим и наименьшим сопротивлением, остальные ВАХ лежат между ними. Видно, что при увеличении напряжения плавно начинает расти дифференциальная проводимость перехода.
Рис. 3.
Вольт-амперные характеристики туннельных СИС-переходов, изготовленных на одной подложке и измеренных в большом диапазоне напряжений, показаны кривые с наибольшим (1) и наименьшим (2) сопротивлением.

Производная по напряжению (см. рис. 2) имеет параболический характер и аппроксимируется полиномом 2-й степени. На рис. 4 видно, что только правая ветвь достаточно точно ложится на теоретическую зависимость. Обычно это объясняется тем, что данная аппроксимация, связанная с представлением барьера прямоугольной формы, далека от реальной ситуации; близкие результаты наблюдались в работе [19], в которой исследовались переходы Nb/Al–AlOx/Nb. Измерения в более широком диапазоне напряжений (до 1 В) и последующая аппроксимация, показали наличие области с более сильным изменением дифференциальной проводимости на одной из ветвей кривой. То есть теоретическая кривая в целом совпадает с экспериментальной зависимостью, за исключением некоторого участка левой ветви, который в нашем случае и выглядит как “перекос” зависимости.
Рис. 4.
Зависимость дифференциальной проводимости туннельного СИС-перехода dI/dU от напряжения (точки) и аппроксимация квадратичным полиномом (штриховая кривая).

Для расчета параметров барьера данного перехода используется теоретическая кривая только для правой ветви. Из ее уравнения можно получить значения α и γ, где α, по сути, является значением проводимости перехода при нулевом смещающем напряжении – минимум параболы; параметр γ – в свою очередь пропорционален отношению коэффициента при квадратичном члене в уравнении полинома к α. Значения высоты и ширины туннельного барьера φ и d получаются в результате решения системы уравнений (2)–(4) численными методами. В работах [19, 20] оценки высоты и ширины туннельного барьера по формуле Дж. Симмонса сравниваются с результатами более точного расчета и исследуется влияние различия эффективных масс в металле и барьере. По оценкам, эффективная масса электрона в барьере равна половине массы электрона в металле, поэтому в наших расчетах использовался дополнительный параметр mэф = 0.5m0. Данные с результатами измерений и расчетов приведены в таблице 1. Для каждого образца произведен расчет параметров d и ϕ с учетом эффективной массы. Для переходов с достаточно большим значением RnS (порядка 100 Ом мкм2) определение параметров туннельного барьера не составляло особой сложности – кривые легко аппроксимировались параболой по одной из ветвей, сложности возникли для переходов, у которых было малое значение RnS. В качестве примера на рис. 5 показана зависимость проводимости от напряжения для образца U06#1 с RnS = 61 Ом мкм2. В целом кривая имеет параболический характер, но на графике четко видны участки резкого падения проводимости перехода при одинаковых значениях напряжения выше и ниже нуля. Эти особенности не связаны с перегревом и разрушением образца или c влиянием измерительной электроники. Эксперименты для проверки искажений, связанных с перегревом, были проведены с помощью импульсного источника напряжения с изменяемой скважностью прикладываемого сигнала. Искажения формы параболической зависимости становятся более заметными для образцов с еще меньшим значением RnS (<50 Ом мкм2). Возможной причиной этих эффектов может быть электрон-фононное взаимодействие; для выяснения природы этих явлений планируется проведение дополнительных экспериментов. Таким образом, можно сделать вывод, что описанный выше метод определения параметров туннельных барьеров имеет некоторые ограничения для образцов с низким значением RnS.
Таблица 1.
Измеренные и рассчитанные данные для разных СИС-переходов
| Имя образца | Измерения | Расчет | |
|---|---|---|---|
| RnS, Ом мкм2 | φ, В | d, Å | |
| U06#1 | 61 | 0.85 | 10.71 |
| SQ#1 | 141 | 0.88 | 11.49 |
| SQ#4 | 247 | 1.03 | 11.52 |
| LT07 | 1300 | 1.19 | 13.21 |
| U05 | 1377 | 1.14 | 12.86 |
| U03_05#01 | 1453 | 1.17 | 12.78 |
| U12#2 | 1663 | 1.1 | 13.64 |
| U12_2#2 | 2025 | 1.18 | 13.27 |
| U12_2#1 | 2112 | 1.18 | 13.3 |
Рис. 5.
Зависимость дифференциальной проводимости туннельного СИС-перехода dI/dU от напряжения с особенностями на напряжениях ±400 мВ.

По данным, полученным в результате расчетов, были построены зависимости высоты и ширины туннельного барьера от значения RnS (рис. 6). Вертикальными линиями на рисунках обозначены диапазоны погрешностей, связанных с неточностью при аппроксимации зависимостей дифференциальной проводимости перехода от приложенного напряжения G(V) идеальной параболой, и проведена линейная аппроксимация для всей серии образцов, показывающая характерный рост высоты и ширины барьера при увеличении RnS. Из рис. 6 видно, что графики зависимостей высоты и ширины барьера от параметра RnS имеют четкий линейный характер в полулогарифмическом масштабе и позволяют оценить емкость туннельных структур, что необходимо для проектирования приемных систем субмиллиметрового диапазона. Следует отметить, что параметр эффективной массы электрона сильно влияет на конечные результаты расчетов. Без введения данной поправки значения высоты барьера были бы на 0.2 эВ больше приведенных, а ширина барьера – меньше на 3.7 Å.
Рис. 6.
Зависимость высоты (а) и ширины (б) туннельного барьера от значения RnS: точки – эксперимент, штриховые кривые – линейная аппроксимация.
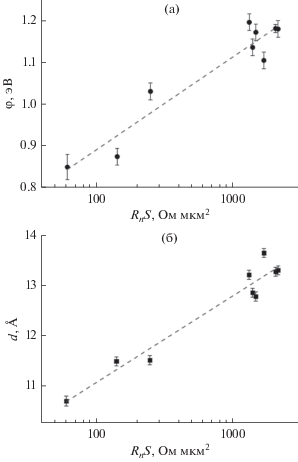
Известно, что для получения достаточно широкой полосы согласования смесительного элемента требуются переходы с очень высокой плотностью тока. Сложности, возникшие при определении параметров барьеров, имеющих высокие плотности туннельного тока (удельное сопротивление менее 100 Ом мкм2), связанные с особенностями ВАХ, не позволили оценить параметры в области, наиболее важной для ТГц-смесителей [17, 18]. Однако линейность графиков в выбранном масштабе позволяет экстраполировать зависимости в область малых значений RnS. Значения реальной толщины туннельного барьера, определенные таким образом, использовались для оценки емкостей переходов при проектировании приемных устройств.
Оценка емкости туннельного перехода, основанная на реальных значениях толщины туннельного слоя, позволила разработать более совершенные и правильно согласованные приемные системы. К примеру, для СИС-перехода площадью 0.73 мкм2 и значением RnS = 27.9 Ом мкм2, выступающего в роли смесителя в интегральном приемнике диапазона частот 211…275 ГГц с центральной частотой 240 ГГц, значение рассчитанной удельной емкости составило 88 фФ/мкм2. Для достижения низкой шумовой температуры приемника потребовалось компенсировать емкость СИС-перехода в рабочем диапазоне частот и согласовать импеданс СИС-перехода на высокой частоте (порядка 30 Ом) с импедансом волновода порядка 400 Ом. Это достигалось посредством включения СИС-перехода в планарную структуру, состоящую из отрезков копланарных и микрополосковых линий Nb/SiO2/Nb; такая конструкция позволила компенсировать емкость перехода на рабочей частоте и согласовать получившийся низкий импеданс с волноводом. Шумовая температура приемника (измеренная в двухполосном режиме, DSB) составила 25 К на частоте 265 ГГц [21], что лишь вдвое превышает уровень квантового предела чувствительности hf/kB.
ЗАКЛЮЧЕНИЕ
Проведены измерения характеристик туннельных переходов Nb/Al–AlOx/Nb, которые широко используются в большинстве устройств и схем низкотемпературной сверхпроводящей электроники, в том числе для создания сверхчувствительных приемных устройств субмиллиметрового диапазона. Найдена зависимость высоты туннельного барьера и его ширины от плотности туннельного тока (удельного сопротивления переходов); показано, что линейный характер зависимостей позволяет определить емкость туннельных структур с удельным сопротивлением 10…30 Ом мкм2, для которых прямые измерения становятся невозможными. Правильная оценка емкости СИС-смесителей позволила уже в первых экспериментах получить шумовую температуру приемника 25 К на частоте 265 ГГц, что лишь вдвое превышает величину hf/kB.
Список литературы
Rowell J.M., Gurvitch M., Geerk J. // Phys. Rev. B. 1981. V. 24. № 4. P. 2278.
Huggins H.A., Gurvitch M. // J. Appl. Phys. 1985. V. 57. № 6. P. 2103.
Gurvitch M., Washington M.A., Huggins H.A. // Appl. Phys. Lett. 1983. V. 42. № 5. P. 472.
Morohashi S.I., Shinoki F., Shoji A. et al. // Appl. Phys. Lett. 1985. V. 46. № 12. P. 1179.
Imamura T., Hasuo S. // IEEE Trans. 1992. V. AS-2. № 2. P. 84.
Tucker J.R. // IEEE J. Quantum Electron. 1979. V. 15. № 11. P. 1234.
Tucker J.R., Feldman M.J. // Rev. Mod. Phys. 1985. V. 57. P. 1055.
Koshelets V.P., Kovtonyuk S.A., Serpuchenko I.L. et al. // IEEE Trans. 1991. V. MAG.-27. № 2. Pt. 4. P. 3141.
Filippenko L.V., Shitov S.V., Dmitriev P.N. et al. // IEEE Trans. 2001. V. AS-11. № 1. P. 816.
Dmitriev P.N., Lapitskaya I.L., Filippenko L.V. et al. // IEEE Trans. 2003. V. AS-13. № 2. P. 107.
Simmons J.G. // J. Appl. Phys. 1963. V. 34. № 6. P. 1793.
Brinkman W.F., Dynes R.C., Rowell J.M. // J. Appl. Phys. 1970. V. 41. № 5. P. 1915.
Koshelets V.P., Shitov S.V., Ermakov A.B. et al. // IEEE Trans. 2005. V. AS-15. № 2. Pt. 1. P. 960.
Koshelets V.P., Ermakov A.B., Filippenko L.V. et al. // IEEE Trans. 2007. V. AS-17. № 2. Pt. 1. P. 336.
Koshelets V.P., Dmitriev P.N., Faley M.I. et al. // IEEE Trans. 2015. V. TST-5. № 4. P. 687.
Khudchenko A., Baryshev A.M., Rudakov K.I. et al. // IEEE Trans. 2016. V. TST-6. № 1. P. 127.
Rudakov K.I., Koshelets V.P., Baryshev A.M. et al. // Radiophysics and Quantum Electronics. 2017. V. 59. № 8/9. P. 711.
Smirnov A.V., Baryshev A.M., de Bernardis P. et al. // Radiophysics and quantum electronics. 2012. V. 54. № 8/9. P. 557.
Tolpygo S.K., Cimpoiasu E., Liu X. et al. // IEEE Trans. 2003. V. AS-13. № 2. P. 99.
Булат Л.П., Конопелько В.В., Пшенай-Северин Д.А. // Вестн. Междунар. академии холода. 2013. № 3. С. 46.
Rudakov K.I., Baryshev A.M., Hesper R. et al. // Program and Abstract Book 30th Int. Symp. on Space Terahertz Technology. 15–17 Apr. 2019. Gothenburg: Chalmers Univ. of Technology, 2019. P. 61.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника


