Радиотехника и электроника, 2020, T. 65, № 10, стр. 1008-1014
Резистивное переключение мемристоров на основе нанокомпозита (Co40Fe40B20)x(LiNbO3)100 – x с прослойкой LiNbO3: пластичность и временные характеристики
А. Н. Мацукатова a, b, К. Э. Никируй a, А. А. Миннеханов a, С. Н. Николаев a, А. В. Емельянов a, c, В. А. Леванов a, b, К. Ю. Черноглазов a, А. В. Ситников a, d, А. С. Веденеев e, А. С. Бугаев c, e, В. В. Рыльков a, e, *, **
a Национальный исследовательский центр “Курчатовский институт”
123182 Москва, пл. Академика Курчатова, 1, Российская Федерация
b Московский государственный университет им. М.В. Ломоносова, Физический факультет
119991 Москва, Ленинские горы, 1, Российская Федерация
c Московский физико-технический институт
141700 Долгопрудный, Московской обл., Институтский пер., 9, Российская Федерация
d Воронежский государственный технический университет
394026 Воронеж, Московский просп., 14, Российская Федерация
e Фрязинский филиал Института радиотехники и электроники им. В.А. Котельникова РАН
141190 Фрязино, Московской обл., просп. Введенского, 1, Российская Федерация
* E-mail: vvrylkov@mail.ru
** E-mail: rylkov_vv@nrcki.ru
Поступила в редакцию 09.12.2019
После доработки 09.12.2019
Принята к публикации 11.12.2019
Аннотация
Изучено резистивное переключение (РП) мемристивных структур металл/наномпозит/металл (М/НК/М) на основе НК (Co40Fe40B20)x(LiNbO3)100– x с содержанием ферромагнитного сплава х ≈ ≈ 8…20 ат. %. Структуры синтезированы методом ионно-лучевого распыления при повышенном содержании кислорода (≈2 × 10–5 Торр) на начальном этапе роста НК, в результате чего у нижнего электрода возникает тонкая (15…18 нм) LiNbO3 прослойка. Установлено, что структуры обладают многоуровневым характером РП (не менее четырех уровней) и временем хранения возникающих резистивных состояний (РС) более 104 с, а также демонстрируют возможность изменения РС по биоподобным правилам типа STDP (Spike-Timing-Dependent Plasticity – пластичности, зависящей от времени прихода импульсов). Обнаружена необычная кинетика РП в низкоомное состояние: РП возникает с задержкой около 70 мкс, при этом время РП достигает ~5 нс, а энергозатраты на переключение составляют ~1 нДж.
ВВЕДЕНИЕ
Мемристоры (резисторы с памятью) являются перспективными элементами при построении нового типа энергонезависимой памяти типа RRAM и нейроморфных вычислительных систем (НВС), поскольку обладают малым энергопотреблением при записи/считывании информации, многоуровневым характером резистивного переключения (РП) и потому способны эмулировать ключевые элементы НВС – синапсы [1–4].
Эффекты РП обычно наблюдают в мемристивных структурах металл/диэлектрик/металл (МДМ), в которых они обусловлены процессами электромиграции вакансий кислорода или катионов металлов [1–4]. В результате в диэлектрическом слое образуются (или разрушаются) нитевидные проводящие каналы (филаменты), характер формирования которых в значительной степени случаен, что является одной из основных причин деградации свойств мемристоров при циклических РП [2, 3]. В случае структур металл/нанокомпозит/металл (М/НК/М) переход в проводящее состояние определяется перколяционными цепочками, заданными пространственным положением и концентрацией наногранул металла в НК, и потому их устойчивость к РП выше [5]. В частности, ощутимых результатов удалось достичь в структурах М/Pt–SiO2/М, в которых активный слой состоял из атомарных нанокластеров Pt, диспергированных в SiO2 [6]. Показано, что в этом случае максимальное число РП Nmax превышает 3 × 107 при времени хранения резистивных состояний более шести месяцев. В наших недавних исследованиях М/НК/М-структур на основе НК (Co40Fe40B20)x(LiNbO3)100 – x наблюдался эффект РП с отношением сопротивлений в высокоомном (выключенном) и низкоомном (включенном) состояниях Roff/Ron ~ 100 при некотором оптимальном значении x = xопт ≈ 11…15 ат. % ниже порога перколяции НК [7, 10]. Эффект хорошо воспроизводился при числе циклов РП > 105 и практически не зависел от типа контактов [5, 7, 8]. Кроме того, синтезированные М/НК/М-структуры обладали высокой степенью пластичности (плавным характером задания резистивного состояния в окне Ron–Roff), что позволило эмулировать важные свойства биологических синапсов [8, 9]. Недавно нами также была продемонстрирована возможность масштабирования данных мемристивных структур путем формирования массива элементов площадью 50 × 50 мкм2 в топологии кроссбар с разбросом сопротивлений Roff и Ron менее 25% [10].
Однако исследований быстродействия мемристивных М/НК/М-структур на базе НК (Co40Fe40B20)x(LiNbO3)100 – x в работах [5, 7–10] не проводилось. Между тем время резистивного переключения tРП из высокоомного в низкоомное состояние и обратно является безусловно важным параметром, характеризующим, в частности, энергопотребление структур при РП. Быстродействие РП играет ключевую роль для практических применений мемристоров в качестве элементов RRAM памяти или в процессорах с архитектурой типа “вычисления в памяти” [11]. И хотя в МДМ-структурах РП связывается в основном с движением ионов, во многих типах оксидных систем достигнуты довольно малые времена РП при толщинах оксидного слоя d ~ 10…50 нм (tРП ≈ 100 нс для SrTiO3 [12] и TaOx [13], 20 нс для HfOx/AlOx [14] и 10 нс для TiO2 [15]). В структуре с активным слоем, состоящим из нанокластеров Pt, диспергированных в SiO2, времена переключения достигали 100 пс при d ~ 7…10 нм [6].
Цель данной работы – исследование мемристивных свойств и кинетики РП структур М/(Co40Fe40B20)x(LiNbO3)100 – x/М с толщиной слоя НК d ~ 1.5 мкм, содержащего тонкую прослойку LiNbO3.
1. ОБРАЗЦЫ И МЕТОДИКА ИХ ИССЛЕДОВАНИЯ
Структуры М/НК/М на базе НК (Co40Fe40B20)x (LiNbO3)100 – x синтезированы методом ионно-лучевого распыления с использованием композитной мишени, состоящей из литой пластины Co40Fe40B20 и 14…15 полосок сегнетоэлектрика LiNbO3 (подробнее см. в [5, 7]). Была использована вытянутая прямоугольная мишень с неравномерным расположением полосок LiNbO3, позволяющая в едином цикле формировать НК с различным соотношением металлической фазы в диапазоне x = 6…43 ат. %. Нанокомпозит осаждался в атмосфере аргона (PAr ≈ 8 × 10–4 Торр) при комнатной температуре на ситалловые подложки.
Особенность данных структур заключалась в том, что на начальном этапе осаждение производили в режиме заданного потока кислорода при довольно высоком парциальном давлении, ${{P}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ ≈ ≈ 2.5 × 10–5 Торр, в течение ≈10 мин, после чего поток О2 уменьшался. Дальнейшее осаждение осуществлялось в течение ≈120 мин при среднем давлении ${{P}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ ≈ 1 × 10–5 Торр (значения ${{P}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ приведены для предельного вакуума в камере P ≈ 6 × 10–6 Торр). В результате описанной процедуры у нижнего электрода формировалась развитая оксидная прослойка преимущественно из аморфного LiNbO3 толщиной 15…18 нм (см. рис. 1). Толщина слоя НК в структурах составила d ≈1.6 мкм. Электродами структур служила трехслойная металлическая пленка Cr/Cu/Cr толщиной 1…2 мкм (размер верхнего электрода S = 0.5 × 0.2 мм2).
Рис. 1.
Темнопольные ПРЭМ изображения сечениия структуры М/(CoFeB)x(LiNbO3)100 − x/М (а) и области структуры у нижнего электрода (б).
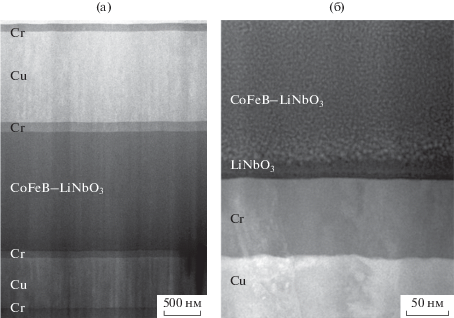
Следует отметить, что приведенная выше формульная запись НК использовалась нами для нахождения х по данным энергодисперсионного рентгеновского микроанализа (ЭРМ) [5]. В действительности, значительная часть бора при синтезе НК оказывается в изолирующей матрице, вне гранул [5, 16]. При этом определить, какая часть бора остается в гранулах, существующими методами ЭРМ невозможно. Поэтому в дальнейшем, как и в [5], будем использовать формульную запись НК, отражающую состав мишени, и обозначим ее для краткости как (CoFeB)x(LiNbO3)100 – x или CoFeB–LiNbO3.
Микроструктура образцов М/НК/М с нанометровым разрешением была изучена методами просвечивающей электронной микроскопии (ПЭM), просвечивающей растровой электронной микроскопии (ПРЭМ) и ЭРМ. Образцы исследовали в просвечивающем растровом электронном микроскопе (TEM/STEM) TITAN 80–300 (FEI, США) с корректором сферической аберрации зонда в режимах светлого и темного поля с использованием (в последнем случае) высокоуглового темнопольного кольцевого детектора рассеянных электронов. Исследования методом ЭРМ выполнены с помощью приставки EDAX (CША). Изображения и спектры обрабатывали с использованием программного обеспечения Digital Micrograph (Gatan, США) и TIA (FEI, США). Детали приготовления образцов для структурных исследований с атомарным разрешением описаны в [16].
Исследования мемристивных свойств М/НК/М-структур, включая измерения их вольт-амперных характеристик (ВАХ), выполнялись с помощью четырехканального источника-измерителя PXIe-4140 (National Instruments) на аналитической зондовой станции PM5 (Cascade Microtech). При исследованиях ВАХ структур ток I измеряли при заземленном нижнем электроде и развертке напряжения смещения U верхнего электрода по линейному закону в последовательности от 0 → + U0 → – U0 → 0 В с шагом 0.1 В, амплитудой пилообразной развертки до U0 = 15 В и периодом развертки напряжения T = 12 с. Были выполнены также эксперименты по изучению возможности изменения резистивного состояния структуры по биоподобным правилам типа STDP (Spike-Timing-Dependent Plasticity – пластичность, зависящая от времени прихода импульсов) [17] и его хранения во времени. Заданное в этом случае сопротивление измеряли при напряжении чтения Uчт = 0.1 В.
Исследования кинетики РП проводили с помощью генератора Keysight 81150A (передний фронт нарастания импульса напряжения 2.5 нс) и двухканального осциллографа Agilent MSO6052A (500 МГц, 4 GSa/s) по стандартной схеме (см., например, [12]). Верхний и нижний электроды структуры были подключены к измерительным каналам осциллографа с 50-омными входными сопротивлениями. На верхний электрод мемристора подавался относительно земли одиночный импульс напряжения, который измеряли с помощью первого канала осциллографа, а возникающий ток через мемристор при РП структуры регистрировали посредством второго его канала.
Все исследования были выполнены при комнатной температуре.
2. РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Темнопольные ПРЭМ-изображения вертикального сечения структуры M/(CoFeB)x(LiNbO3)100– x/M с оптимальным значением хопт ≈ 15 ат. % при разных увеличениях показаны на рис. 1. Анализ данных ПРЭМ (рис. 1а) и ЭРМ показывают, что синтезированная структура соответствует многослойной композиции Cr/Cu/Cr/(CoFeB)x(LiNbO3)100 – x/Cr/Cu/Cr с толщинами металлических электродов Cr/Cu/Cr от 1.5 до 2 мкм и толщиной слоя НК около 1.6 мкм. Темнопольное ПРЭМ-изображение (рис. 1б) демонстрирует в увеличенном масштабе область М/НК/М-структуры у нижнего электрода. Видно, что на расстояниях ~50 нм от нижнего электрода структуры формируется слой НК с однородным распределением гранул, размеры которых составляют около 3 нм. Между тем у нижнего электрода слой НК сильно неоднороден. В процессе роста НК вначале возникает оксидная прослойка толщиной ≈15…18 нм, в которой гранулы практически отсутствуют; затем формируется прослойка НК с крупными гранулами размером до 7 нм, переходящая в однородный слой НК c 3 нм гранулами на расстояниях от электрода, превышающих ~50 нм. Анализ ЭРМ данных показывает, что оксидная прослойка состоит преимущественно из аморфного LiNbO3.
Особенностью М/НК/М-структур является сильная зависимость формы и гистерезиса их ВАХ от состава НК, т.е. величины x [7]. ВАХ структур со встроенной прослойкой LiNbO3 были изучены в режиме ограничения по току на уровне 50 мА. Оказалось, что, как и в [7], гистерезис в ВАХ, характерный для эффекта РП, наиболее сильно наблюдается при некотором оптимальном значении x ≈ 15 ат. % (рис. 2а). При этом достигается отношение Roff/Ron ≈ 300 при Uчт = 0.1 В. При значениях x, больших порога перколяции (для данных структур xp ≈ 17 ат. % ), петля гистерезиса исчезает и ВАХ становится линейной, как для металлических систем [7], а при x < xp петля оказывается сильно вытянутой, что свидетельствует о слабом эффекте РП (рис. 2б).
Рис. 2.
ВАХ структуры M/(CoFeB)x(LiNbO3)100 –x/M c содержанием ферромагнитного сплава x ≈ 15 (а) и 10 ат. % (б).

Важную роль для применений мемристивных структур, в частности при создании нейроморфных систем, играет их пластичность, т.е. способность под действием напряжения принимать произвольное резистивное состояние в окне (Ron – Roff) и хранить его во времени [1–4]. Это важное свойство позволяет эмулировать синапсы (контакты между нейронами) в биологических нейронных системах, в которых обучение происходит благодаря способности синапсов изменять свой вес, т.е. за счет их пластичности [1–4, 18].
В созданных структурах М/(CoFeB)x(LiNbO3)100–x/М с прослойкой LiNbO3 при x ≈ 15 ат. % удается с использованием метода [19] задать не менее четырех различных резистивных состояния с точностью лучше 1%, которые сохраняются на протяжении времени, превышающем 104 с (рис. 3). Пластичность и высокая временная стабильность образцов позволили продемонстрировать возможность изменения их резистивного состояния по биоподобным правилам типа STDP. Согласно STDP синаптический вес увеличивается в случае, если постсинаптический нейрон генерирует импульс (спайк) сразу после пресинаптического, указывая на наличие причинно-следственной связи; в обратном случае вес падает (см. [17] и ссылки там). Проводимость G мемристора можно связать с синаптическим весом W, тогда изменение проводимости ΔG будет эквивалентно изменению W.
Рис. 3.
Зависимость электрического сопротивления R от времени для структуры М/(CoFeB)x(LiNbO3)100 – x/М с содержанием ферромагнитного сплава x ≈ 15 ат. % в различных резистивных состояниях (Ом): 1 – 2.9 × 105, 2 – 1.7 × 104, 3 – 3.4 × 103, 4 – 3.3 × 102. Напряжение чтения Uчт = 0.1 В. На вставках: справа – окно STDP для данных структур при амплитуде импульсов (спайков) 3 В и их длительности 60 мс; слева – иллюстрация импульсов, использованных в эксперименте для получения окна STDP.
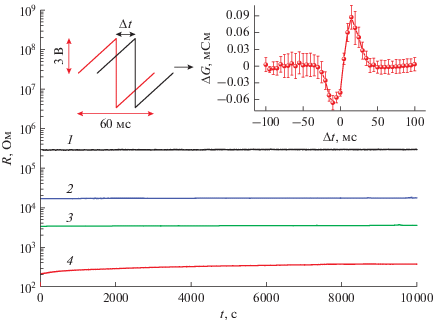
Для проверки возможности изменения проводимости НК мемристоров по правилам STDP нижний электрод М/НК/М-структуры был использован как пресинаптический вход, а верхний – как постсинаптический. Длительность спайков составляла 60 мс, а величина их амплитуды была выбрана равной 3 В, при которой одиночный спайк не приводит к изменению резистивного состояния структуры. Однако если два спайка с малой задержкой между ними по времени Δt будут поданы на мемристор (см. вставку к рис. 3), падение напряжения на нем может оказаться достаточным для изменения его резистивного состояния. Для получения окна STDP (зависимость изменения веса синапса от ∆t) измеряли проводимость мемристора до (G1) и после (G2) подачи последовательности пре- и постсинаптических спайков. Зависимость изменения проводимости ∆G = G2 − G1 от Δt показана на вставке к рис. 3. Из рисунка видно, что при Δt > 0 наблюдается синаптическая потенциация (ΔG > 0), а при Δt < 0, наоборот, – депрессия (ΔG < 0). Подобный вид зависимости W(Δt) наблюдается и в биологических системах [20].
Неожиданной оказалась кинетика РП при переходе мемристивной М/НК/М-структуры из высоко- в низкоомное состояние после подачи на ее импульса напряжения амплитудой 6 В, которое заведомо превышает напряжение РП для выбранной структуры (≈5 В; см. рис. 2). На рис. 4 показаны импульс напряжения, подаваемый на верхний электрод структуры (кривая 1), и переходной ток (кривая 2), возникающий в цепи и регистрируемый на нагрузочном 50-омном входном сопротивлении осциллографа. Обращает на себе внимание довольно значительная задержка tз в РП после подачи импульса (tз ≈ 70 мкс) и резкое переключение структуры в низкомное состояние, достигающее tРП ≈ 5 нс (см. вставку к рис. 4). Несложно оценить, что затраты энергии на РП структуры на стадии резкого уменьшения сопротивления довольно малы (<1 нДж) при токах переключения ~10 мА и площади структур S = 0.5 × 0.2 мм2. Однако при площади структур 50 × 50 мкм2 токи переключения снижаются до ≤0.1 мА [10]. Поэтому можно ожидать, что и энергопотребление снизится до ~1 пДж, т.е. будет удовлетворять современным требованиям к мемристивным структурам для их применений в НВС (см. [21, табл. 1 ]).
Рис. 4.
Кинетика резистивного переключения структуры M/(CoFeB)x(LiNbO3)100 –x/M с х ≈ 15 ат. % из высокоомного состояния в низкоомное: 1 – импульс напряжения от генератора, подаваемый на верхний электрод структуры; 2 – напряжение, регистрируемое на нагрузочном 50-Омном входном сопротивлении осциллографа. На вставке показана область РП в увеличенном масштабе (отмечена штриховой линией).
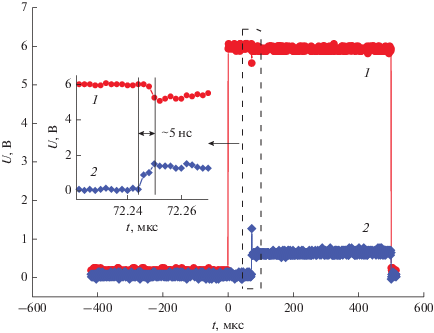
Задержки при РП в низкоомное состояние наблюдали в структурах на основе пленок TaOx толщиной 5 нм, типичное время которых tз не превышало 1 мкс при tРП ≈ 20 нс, что объяснялось движением вакансий, формирующих проводящие филаменты [13]. В М/НК/М-структурах толщина прослойки LiNbO3 (15…18 нм; см. рис. 1) всего лишь в три раза превышает толщину пленок TaOx. При этом tз в нашем случае почти на два порядка выше, а tРП в четыре раза меньше, чем в [13]. По-видимому, это связано с двухступенчатым характером РП в М/НК/М-структурах, предсказанным в [5], а именно:
1) с формированием изолированных цепочек из наногранул и аномально сильным уменьшением их сопротивления в полях E >104 В/см, вследствие подавления эффектов кулоновской блокады и генерации кислородных вакансий;
2) с инжекцией (или экстракцией) вакансий (в зависимости от знака напряжения) в сильно окисленную прослойку НК у электрода структуры, контролирующую ее сопротивление.
Первый процесс определяется всей толщиной НК пленки и может быть длительным, целиком контролируя задержку между поданным на М/НК/М-структуру импульсом напряжения и ее РП в низкоомное состояние. Изучение возможности контроля этого процесса и детализация его механизма требуют дальнейших исследований.
ЗАКЛЮЧЕНИЕ
Таким образом, в работе изучено РП мемристивных М/НК/М-структур на базе НК (Co40Fe40B20)x (LiNbO3)100 –x (х = 8…20 ат. %), синтезированных методом ионно-лучевого распыления при повышенном содержании кислорода (≈2 × 10−5 Торр) на начальном этапе роста НК. Методами ПРЭМ установлено, что полученный НК состоит из трех областей: тонкая аморфная прослойка LiNbO3 (15…18 нм) у нижнего электрода, далее слой НК с крупными гранулами CoFe размером до 7 нм, переходящий на расстоянии 50 нм от нижнего электрода в однородный слой НК c 3 нм гранулами. Структуры демонстрируют стабильные РП с отношением сопротивлений Roff/Ron > 300, обладают возможностью задания промежуточных состояний в данном окне и способностью изменять сопротивление по биоподобным правилам типа STDP. Показано, что время хранения резистивных состояний превышает 104 с. Обнаружена необычная кинетика РП структур при их переходе из высоко- в низкоомное состояние, а именно: РП возникает с большой задержкой ~70 мкс, при этом время переключения достигает ~5 нс. В этих условиях затраты энергии на РП структуры составляют около 1 нДж при площади структур S = 0.5 × 0.2 мм2 и токах переключения ~10 мА, которые, однако, могут быть понижены до ≤0.1 мА при площади структур 50 × 50 мкм2. Поэтому можно ожидать, что энергопотребление снизится до ~1 пДж и будет удовлетворять современным требованиям к мемристивным структурам для их применений в НВС.
Список литературы
Handbook of Memristor Networks / Ed. Chua L., Sira-koulis G.Ch., Adamatzky A. Cham: Springer, 2019.
Ielmini D. // Semicond. Sci. Technol. 2016. V. 31. № 6. P. 063002.
del Valle J., Ramírez J.G., Rozenberg M.J. et al. // J. Appl. Phys. 2018. V. 124. P. 211101.
Xia Q., Yang J.J. // Nature Materials. 2019. V. 18. P. 309.
Рыльков В.В., Николаев С.Н., Демин В.А. и др. // ЖЭТФ. 2018. Т. 153. № 3. С. 424.
Choi B.J., Antonio C.T., Kate J.N. et al. // Nano Lett. 2013. V. 13. P. 3213.
Леванов В.А., Емельянов А.В., Демин В.А. и др. // РЭ. 2018. Т. 63. № 5. С. 489.
Nikiruy K.E., Emelyanov A.V., Demin V.A. et al. // AIP Advances. 2019. V. 9. № 6. P. 065116.
Emelyanov A.V., Nikiruy K.E., Serenko A.V. et al. // Nanotechnology. 2020. V. 31. № 4. P. 045201.
Никируй К.Э., Емельянов А.В., Рыльков В.В. и др. // РЭ. 2019. Т. 64. № 10. С. 1019.
Ielmini D., Wong H.-S.P. // Nature Electronics. 2018. V. 1. P. 333.
Menzel S., Waters M., Marchewka A. et al. // Adv. Funct. Mater. 2011. V. 21. P. 4487.
Nishi Y., Menzel S. // IEEE Electron Device Lett. 2014. V. 35. № 2. P. 259.
Yu S., Wu Y., Wong H.-S.P. // Appl. Phys. Lett. 2011. V. 98. № 10. P. 103514.
Choi B.J., Choi S., Kim K.M. et al. // Appl. Phys. Lett. 2006. V. 89. № 1. P. 012906.
Rylkov V.V., Nikolaev S.N., Chernoglazov K.Yu. et al. // Phys. Rev. B. 2017. V. 95. P. 144202.
Zarudnyi K., Mehonic A., Montesi L. et al. // Front. Neurosci. 2018. V. 12. P. 57.
Prezioso M., Merrikh-Bayat F., Hoskins B.D. et al. // Sci. Rep. 2016. V. 6. P. 21331.
Никируй К.Э., Емельянов А.В., Рыльков В.В. и др. // Письма в ЖТФ. 2019. Т. 45. № 8. С. 19.
Hennequin G., Agnes E.J., Vogels T.P. // Annu. Rev. Neurosci. 2017. V. 40. № 1. P. 557.
Lanza M., Wong H.-S. P., Pop E. et al. // Adv. Electron. Mater. 2019. V. 5. P. 1800143.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника


