Радиотехника и электроника, 2020, T. 65, № 2, стр. 174-182
Формирование отверстий в алмазной подложке гибридно-монолитных интегральных схем СВЧ
А. М. Темнов *
Научно-производственное предприятие “Исток” им. А.И. Шокина
141190 Московской обл., Фрязино, ул. Вокзальная, 2а, Российская Федерация
* E-mail: alexandertemnov@mail.ru
Поступила в редакцию 02.04.2019
После доработки 17.05.2019
Принята к публикации 24.05.2019
Аннотация
Исследован технологический процесс разделения гетеропластины из поликристаллической алмазной пленки (ПАП-Si) и отделения целой пластины от жертвенного кремния. Исследован процесс формирования отверстий в алмазной подложке из ПАП методами лазерного фрезерования, и плазмохимического травления. Показано, что плазмохимическое травление обеспечивает групповое изготовление отверстий на основе планарной технологии и прецизионной литографии. Оптимизированы технологические режимы травления отверстий через алюминиевую маску методом реактивного ионного травления с источником индуктивно связанной плазмы (РИТ-ИСП) и получена скорость травления отверстий в ПАП порядка 1.1 мкм/мин. Найдена математическая модель технологического процесса и показано, что травление происходит преимущественно в среде кислорода. Технологический процесс адаптирован на установку плазмохимического травления “Плазма ТМ5”. Исследована возможность травления отверстий в ПАП диаметром 100 мкм и глубиной более 300 мкм. Показано, что скорость травления зависит от глубины отверстий и носит нелинейный характер, при этом происходит травление как стенок отверстий, так и алюминиевой маски.
ВВЕДЕНИЕ
Гибридно-монолитные интегральные сверхвысокочастотные схемы11 (ГМИС СВЧ) работают в сантиметровом и миллиметровом диапазоне длин волн и предназначены для создания модулей СВЧ [1, 2].
Вся пассивная часть ГМИС (содержащая R-, L-, C-элементы, линии передачи и выводы) выполняется монолитной на одной изолирующей подложке по групповой технологии, в едином технологическом цикле на основе планарной технологии и прецизионной литографии. Активными компонентами в ГМИС СВЧ являются кристаллы диодов, транзисторов и МИС СВЧ, отобранные по низкочастотным и СВЧ-параметрам.
В работах [3–5] показано, что ГМИС СВЧ успешно развиваются и созданы три конструктивных технологических решения – базовое, мозаичное и миниатюрное. Однако ГМИС СВЧ базовой конструкции имеют ограниченную выходную мощность, так как изготавливаются на подложках, имеющих малый коэффициент теплопроводности (Вт м–1 К–1): сапфир – 40, арсенид галлия – 46, который не позволяет эффективно отвести тепло от кристаллов диодов, транзисторов и МИС, расположенных на ее поверхности. Для создания ГМИС СВЧ с большой выходной мощностью необходима подложка с высокой теплопроводностью, обеспечивающая эффективный отвод тепла от кристаллов СВЧ-компонентов. Отверстия в подложке необходимы для “заземления” элементов в соответствии с электрической схемой ГМИС СВЧ.
Среди известных материалов изолирующих подложек наибольший коэффициент теплопроводности – 490, 5000 и 1000…2000 Вт м–1 К–1 – имеют соответственно карбид кремния SiC, графен Gr и алмаз C.
Подложки SiC со своими уникальными характеристиками используются для создания высокочастотных, высокомощных и высокотемпературных электронных приборов – полевых транзисторов на гетероструктурах AlGaN/GaN, и производятся только фирмой Cree (США) (см.: www.prochip.ru). Подложки графена Gr не производятся ни за рубежом, ни в России. Подложки алмаза С производятся и за рубежом, и в России. Монокристаллические алмазные подложки изготавливаются как из естественного, так и искусственного алмаза, при этом они имеют малые размеры (порядка 3 × 3 мм) и не пригодны для группового изготовления ГМИС СВЧ.
В связи со сказанным основой современной алмазной электроники стал искусственный алмаз, а именно поликристаллическая алмазная пленка (ПАП), получаемая из газовой фазы водорода и метана методом химического разложения (Chemical Vapov Depotion, CVD) в СВЧ-плазме. Процесс CVD основан на разложении метана в смеси с водородом и последующем осаждении ПАП на нагретую подложку (см.: twinn_plasma@mail.ru, а также [6–8]). В настоящее время методом CVD получают чистые ПАП толщиной 1…3000 мкм на жертвенной пластине кремния Si диаметром до 100 мм и используют для создания, например, прочных покрытий на режущих инструментах, шестерен сверхточных механизмов, конструкционных компонентов, алмазных теплоотводов и алмазных подложек.
Отечественные алмазные подложки из ПАП разрабатывают и изготавливают такие организации, как Институт общей физики РАН и “ТВИНН” (Москва); “СВД Спарк” (Троицк); Институт прикладной физики РАН (Нижний Новгород).
Цель данной работы – исследовать и оптимизировать технологический процесс изготовления отверстий в ПАП для включения его в технологический процесс изготовления ГМИС СВЧ на ПАП.
1. ПОСТАНОВКА ЗАДАЧИ
Для проведения экспериментов были изготовлены в ИОФ РАН и “ТВИНН” гетеропластины ПАП на подложке кремния диаметром 57 мм, толщиной 3 мм и ПАП на подложке монокристаллического кремния ориентацией (111), диаметром 50 мм, толщиной 0.35 мм и поверхностным сопротивлением более 10 000 Ом. Параметры гетеропластин ПАП-Si приведены в табл. 1.
Таблица 1.
Параметры гетеропластин ПАП-Si
| Параметры гетеропластин | Не менее | Не более |
|---|---|---|
| Толщина ПАП, мкм | 100 | 250 |
| Шероховатость зародышевой стороны ПАП, нм | – | 100 |
| Шероховатость ростовой стороны ПАП, мкм | – | 15 |
| Неравномерность толщины ПАП, % | – | ±15 |
| Прогиб ПАП-Si, мкм (на Si толщиной 3 мм) | – | 10 |
| Прогиб ПАП-Si, мкм (на Si толщиной 0.35 мм) | – | 30 |
| Количество трещин на ПАП, шт. | – | 0 |
| Поверхностное сопротивление ПАП-Si, Ом см | 108 | – |
| Объемное сопротивление ПАП-Si, Ом см | 108 | – |
| Теплопроводность ПАП, Вт/м К | 1000 | – |
В гетеропластине ПАП-Si пленка ПАП очень напряжена из-за разного температурного коэффициента линейного расширения (ТКЛР): алмаза – 1 × 10–6 K–1 и кремния – 5 × 10–6 K–1, и поэтому после отделения от жертвенного кремния ПАП ломается на куски. В связи с этим было необходимо исследовать процесс отделения целой пленки ПАП и процесс формирования отверстий в ПАП различными методами, выбрать и оптимизировать базовый метод для включения его в процесс изготовления ГМИС СВЧ на ПАП.
1.1. Исследование процесса разделения ПАП-Si
Как известно, в технологическом процессе ПАП растет как на поверхности, так и по периметру жертвенной подложки кремния, образуя жесткое кольцо. Температура роста ПАП составляет порядка 800…900°С, поэтому после остывания и удаления жертвенного кремния кольцо сжимается и ломает ПАП на несколько бесформенных кусков, имеющих малую площадь. Для предотвращения разрушения ПАП, бережного разделения гетеропластины ПАП-Si и отделения целой пластины необходимо разорвать связь между пленкой и кольцом. Наиболее простым способом решения этой задачи является метод лазерного фрезерования (рис. 1).
Рис. 1.
Технологический процесс разделения гетеропластины ПАП-Si и отделения целой ПАП: поставляемая гетеропластина ПАП-Si (а), паз с ростовой стороны ПАП-Si глубиной 500 мкм на расстоянии 1 мм от края пластины (б), шлифовка и утончение ростовой стороны ПАП до толщины 100…150 мкм (в), удаление жертвенного кремния и отделение ПАП (г).
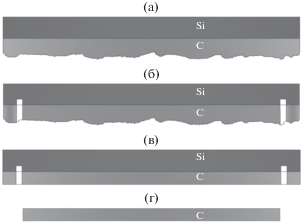
Для шлифовки и утончения ПАП используется процесс термохимической шлифовки [9, 10]. Этапы практического разделения гетеропластины ПАП-Si и отделения целой пластины ПАП показаны на рис. 2; диаметр отделенной пластины ПАП уменьшается на 2 мм.
Рис. 2.
Этапы практического разделения гетеропластины ПАП-Si и отделения целой пластины ПАП: паз глубиной 500 мкм с ростовой стороны пластины (а), ростовая сторона после шлифовки и утончения (б), ПАП с ростовой стороны после отделения (в), ПАП с ростовой стороны после отделения без шлифовки (г), ПАП с ростовой стороны после шлифовки (д).

Предложенный технологический процесс отделения пластины ПАП (см. рис. 2а–2в) включает формирование паза, шлифовку и последующее травление кремния и позволяет отделить целую ПАП правильной геометрии, пригодную для группового изготовления ГМИС СВЧ.
Если отделить ПАП без шлифовки (см. рис. 2г, 2д), то она будет иметь правильную геометрию, но значительный прогиб, поэтому после процесса термохимической шлифовки получаются пластины, имеющие неправильную геометрию, уменьшенную площадь и большую неравномерность толщины ПАП. Процесс термохимической шлифовки необходим для успешного проведения последующих процессов литографии. При этом шероховатость ростовой стороны ПАП после термохимической шлифовки составляет порядка 3 мкм. Шероховатость лицевой стороны отделенных ПАП определяется качеством полировки поверхности жертвенного кремния, который имеет чистоту поверхности 14-го класса (шероховатость 10 нм). Ожидаемая шероховатость по ТУ должна быть не более 100 нм, однако фактическая шероховатость лицевой стороны ПАП после отделения от жертвенного кремния имеет большой разброс и не повторяется от пластины к пластине.
Выход годных ПАП с шероховатостью зародышевой стороны, соответствующей ТУ, составляет порядка 10%.
1.2. Исследование и оптимизация процесса изготовления отверстий в ПАП
Методы изготовления отверстий в ПАП – лазерного фрезерования и плазмохимического травления – были рассмотрены в работах [11, 12].
1. Метод лазерного фрезерования широко применяется при изготовлении отверстий в диэлектрических и металлических пластинах. Формируемые отверстия имеют четкую геометрию и практически вертикальные стенки со скосом стенок порядка 5%. Однако лазерное фрезерование не может обеспечить групповую обработку алмазных пластин, имеет низкую производительность, высокую стоимость изготовления одного отверстия и приводит к появлению проводящей пленки графита только по линии реза.
2. Метод плазмохимического травления на установке реактивного ионного травления (РИТ) с источником индуктивно связанной плазмы (ИСП) (Inductively Coupled Plasma, ICP) Corial 200IL позволяет изготавливать отверстия в ПАП групповым способом на основе планарной технологии и прецизионной литографии. Процесс РИТ-ИСП зависит от множества технологических факторов, и решить задачу в аналитическом виде оказалось затруднительно. Поэтому с помощью метода планирования эксперимента найдена экспериментальная зависимость скорости травления ПАП у от технологических факторов процесса РИТ-ИСП, т.е. построена математическая модель вида
где xi – факторы технологического процесса: x1 – скорость потока элегаза SF6; x2 – скорость потока кислорода О2; x3 – скорость потока аргона Ar; x4 – мощность радиочастотного генератора Г1; x5 – мощность генератора индуктивно связанной плазмы Г2; x6 – давление в камере р.
Предварительные эксперименты показали, что скорость травления отверстий в ПАП зависит от мощности генератора Г1: чем больше мощность, тем выше скорость травления. Максимальная мощность генератора Г1 ограничена 250 Вт, но его работа на максимальной выходной мощности оказалась неустойчивой, поэтому в эксперименте мощность была ограничена 230 Вт.
Скорость травления отверстий в ПАП зависит также от интенсивности плазмы, которая в свою очередь зависит от мощности генератора Г2 и выбрана равной максимальной величине 1000 Вт.
Кроме того, скорость травления отверстий в ПАП зависит от рабочего давления в камере, которое на основе априорной информации о технологическом процессе и возможностей технологической установки выбрано равным 10 мТор. Диапазон изменения факторов x1, x2, x3 в эксперименте приведен в табл. 2.
Таблица 2.
Диапазон изменения факторов x1, x2, x3 в эксперименте
| Уровень фактора | Скорость потоков газа, см3/мин | ||
|---|---|---|---|
| х1 | х2 | х3 | |
| –1 | 0.3 | 40 | 20 |
| 0 | 0.4 | 60 | 35 |
| +1 | 0.5 | 80 | 50 |
Проведенный полный трехфакторный эксперимент позволил рассчитать коэффициенты уравнения по каждому фактору и с учетом парных и тройных взаимодействий и получить уравнение скорости травления отверстий в ПАП:
(2)
$\begin{gathered} y = (1.0125 + 0.025{{x}_{1}} + \\ + \,\,0.0625{{x}_{2}}--0.055{{x}_{3}}--0.04{{x}_{1}}{{x}_{2}} - ) \times \\ \times \,\,( - {\text{ }}0.023{{x}_{1}}{{x}_{3}} + 0{{x}_{2}}{{x}_{3}}--0.033{{x}_{1}}{{x}_{2}}{{x}_{3}}). \\ \end{gathered} $Анализ уравнения показывает, что фактор х2 дает наибольший вклад в увеличение скорости, фактора х1 – в три раза меньше, а фактор х3 – уменьшает скорость травления ПАП, поэтому влияние этого фактора необходимо уменьшить до минимума. При х1 = 1, х3 = –1 технологический процесс травления отверстий в ПАП будет функцией х2 – скорости потока кислорода:
Максимальная скорость травления отверстий в ПАП равна 1.17 мкм/мин при х2 = 1. Процесс травления отверстий в ПАП происходит преимущественно в среде кислорода и продуктом реакции является углекислый газ CO2. Оптимальные технологические режимы травления отверстий в ПАП наблюдаются при скорости потоков 0.5, 80 и 20 см3/мин для SF6, O2 и Ar соответственно. Отверстия имеют четкую геометрию и практически вертикальные стенки со скосом порядка 3%, при диаметре отверстий 100 мкм и толщине ПАП также 100 мкм.
Процесс плазмохимического травления отверстий в ПАП является экологически чистым, не наносящим вреда окружающей среде, поэтому он был выбран в качестве базового для работы на установке РИТ-ИСП.
Установка плазмохимического травления РИТ-ИСП – Corial 200IL в составе пилотной линии предприятия НПП “Исток им. Шокина” включена в технологический процесс изготовления МИС СВЧ на арсениде галлия. Для травления арсенида галлия использовали хлор, который травит алюминиевую маску. Перед травлением отверстий в ПАП через алюминиевую маску требуется тщательная очистка установки Corial 200IL, при этом необходимо изменять режимы установки Corial 200IL (мощность генераторов Г1 и Г2, а также состав газов и скорости их потоков), что создает неудобства и приводит к потере технологического времени, поэтому был создан отечественный аналог – установка Плазма ТМ5 (организация НИИТМ, Зеленоград). Сравнение технических параметров установок Corial 200IL и Плазма ТМ5 приведено в табл. 3.
Таблица 3.
Сравнение технических параметров установок Corial 200IL и Плазма ТМ5
| Параметры | Corial 200IL | Плазма ТМ5 |
|---|---|---|
| Мощность генератора Г1, Вт | 250 | 1000 |
| Мощность генератора Г2, Вт | 1000 | 1000 |
| Частота генератора Г1, МГц | 13.56 | 13.56 |
| Частота генератора Г2, МГц | 2 | 13.56 |
Из табл. 3 видно, что технические параметры установки Плазма ТМ5 не уступают параметрам Corial 200IL. При этом оптимальный технологический процесс, разработанный на установке Corial 200IL, адаптированный на установку Плазма ТМ5, позволил получить скорость травления отверстий в ПАП порядка 1.1 мкм/мин.
Дополнительные исследования на установке Плазма ТМ5 показали, что скорость травления отверстий в ПАП порядка 1…1.1 мкм/мин является оптимальной. При этом повышение скорости травления отверстий в ПАП за счет повышения мощности генератора Г1 приводит к перегреву ПАП и ускоренному травлению маски алюминия, а снижение скорости травления приводит к увеличению длительности технологического процесса.
Для исследования и измерения глубоких отверстий малого диаметра промышленных приборов нет, поэтому автор изготовил специальный стенд, позволяющий измерять глубину отверстий диаметром более 50 мкм в подложке толщиной до 500 мкм с точностью ±1 мкм (рис. 3).
Рис. 3.
Стенд для измерения глубины отверстий: основание 1, двухкоординатная каретка 2; рабочий стол 3; индикатор глубины 4 с упором 5; однокоординатная каретка 6 с упором 7 в виде шарикоподшипника; однокоординатная каретка 8 с упором 9 в виде клина; коромысло 10, низмерительный зонд 11, изолированный контакт 12 и заземленный контакт 13; винт 14 для настройки нуля индикатора; индикаторный светодиод 15; кулачковый механизм подъема зонда 16.

Принцип действия стенда основан на использовании коромысла 10, на одном конце которого размещен измерительный зонд 11, а на другом – изолированный контакт 12. Коромысло является уравновешенным и имеет плечи одинаковой длины. Разбаланс коромысла обеспечивает давление на зонд менее 1 г. Разбаланс коромысла создается за счет того, что его плечи выполняют из разного материала – латуни и дуралюминия.
Измерительный зонд является наиболее хрупким элементом конструкции устройства. Он изготавливается из вольфрамовой проволоки диаметром 500 мкм, при этом конец зонда затачивается до диаметра менее 25 мкм с помощью процесса электрохимической полировки. Конструкция и внешний вид рабочей части измерительного зонда для измерения отверстий показан на рис. 4.
Общая длина измерительной части зонда порядка 1000 мкм. Зонд круглый, поэтому малая толщина зонда 9…50 мкм требует аккуратного обращения и плавного опускания его на измеряемую поверхность пластины.
В исходном положении зонд 11 (см. рис. 3) всегда поднят над поверхностью стола. Поднятие осуществляется с помощью кулачкового механизма 16. Индикаторный светодиод 15 служит для индикации момента касания зонда с поверхностью пластины. До момента касания с пластиной контакты 12 и 13 замкнуты и светодиод 15 горит, а при контакте с пластиной контакты 12 и 13 размыкаются и светодиод 15 гаснет. Для обеспечения надежного контактирования контакты 12, 13 выполнены из платины.
Измерение глубины одного отверстия проводится методом двух отсчетов. Сначала зонд ставится на поверхность пластины рядом с отверстием и производится первый отсчет h1, затем зонд ставится в отверстие и производится второй отсчет h2 (рис. 5), в результате определяется глубина отверстия: Н = h2 – h1.
Рис. 5.
Процесс измерения глубины отверстий диаметром 100 мкм с помощью измерительного зонда: первый отсчет h1 (а), второй отсчет h2 (б).
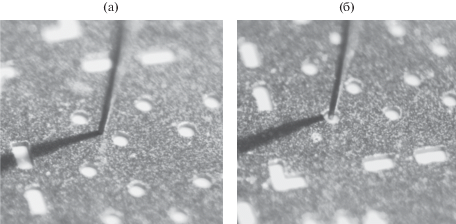
На установке Плазма ТМ5 исследована возможность изготовления отверстий в ПАП различной формы: круглой, квадратной и треугольной (рис. 6).
Исследованные отверстия, сформированные в ПАП групповым способом, имеют четкую геометрию. Травление отверстий проводилось с зародышевой стороны ПАП толщина которой 100 мкм, круглые отверстия в ПАП диаметром 100 мкм имеют четкую геометрию, а отверстия квадратной и треугольной формы имеют скругленные углы, при этом скос вертикальных стенок отверстий составляет порядка 3%.
Для определения возможностей установки Плазма ТМ5 исследовано травление глубоких (более 300 мкм) отверстий в ПАП. Для этого изготовлена ПАП толщиной 340 мкм, на которой сформирована алюминиевая маска толщиной 8 мкм с отверстиями диаметром 100 мкм. Процесс формирования алюминиевой маски следующий: нанесение на пластину вакуумным напылением последовательно в одном технологическом процессе слоев Ti и Al толщиной 0.1 и 8 мкм соответственно; проведение фотолитографии и создание отверстий в резистивной маске и последующее мокрое травление Al и сухое травление Ti в отверстиях резистивной маски. Адгезия алюминиевой маски обеспечивается подслоем Ti.
Процесс травления отверстий в ПАП через алюминиевую маску проводился с зародышевой стороны последовательно в несколько этапов. На каждом этапе ПАП помещали в реактор установки Плазма ТМ5, травление шло в течение 30 или 60 мин, после чего ПАП вынимали и измеряли глубину отверстий. Результаты исследования внешнего вида отверстий в пластине ПАП показаны на рис. 7.
Рис. 7.
Внешний вид отверстий пластин с отверстиями: с зародышевой стороны (а, в) и с ростовой стороны (б, г) в разном масштабе.
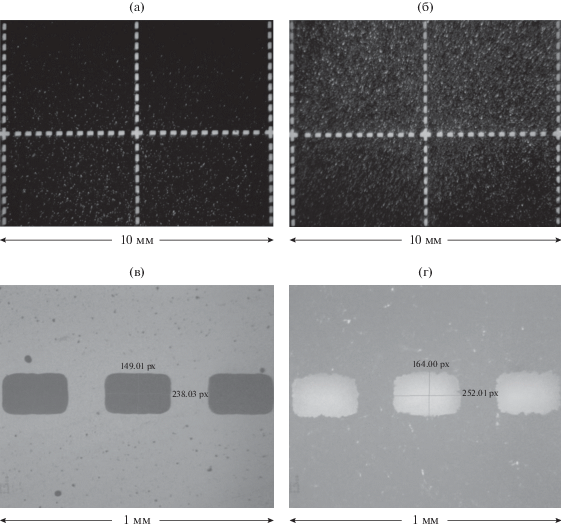
Исследование показало, что в пластине ПАП толщиной 340 мкм отверстия протравлены насквозь. При этом отверстия в алюминиевой маске имели размер 200 × 100 мкм и были строго прямоугольной формы, а в результате травления ПАП размеры отверстий увеличились и углы округлились. Отверстия с зародышевой стороны ПАП имеют размер 238 ×149 мкм, а с ростовой стороны 252 × 164 мкм соответственно.
Увеличение линейных размеров отверстий в ПАП идет неравномерно:
− с лицевой стороны по широкой стенке 38 мкм, а по узкой 49 мкм,
− с ростовой стороны по узкой стенке 64 мкм, а по широкой 52 мкм.
Отверстия в ПАП имеют скругленную форму и практически вертикальные стенки, скос стенок отверстий порядка 4%.
Исследование внешнего вида стенки отверстия и его шероховатости проводилось на сколе отверстия, результаты приведены на рис. 8. При диаметре отверстия порядка 100 мкм шероховатость стенок отверстия составляет порядка 3 мкм.
Рис. 8.
Шероховатость отверстия в пластине ПАП с зародышевой стороны (а) и размер шероховатости (б); изображения получены на растровом электронном микроскопе.
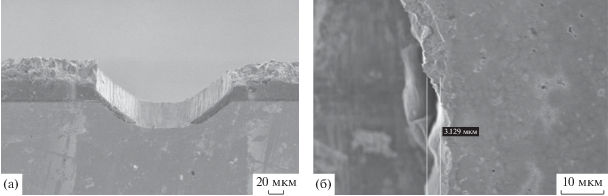
Результаты исследования зависимости глубины и скорости травления отверстий в пластине ПАП показаны на рис. 9.
Рис. 9.
Зависимость глубины отверстий в ПАП от времени травления (а) и зависимость скорости травления от глубины отверстий в ПАП (б).
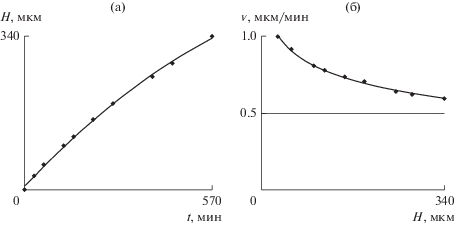
Исследованные зависимости глубины Н травления отверстий в ПАП от времени травления t, а также скорости травления v от глубины Н отверстий в ПАП носят нелинейный характер. При этом скорость травления уменьшается с увеличением глубины отверстия. Причиной уменьшения скорости травления отверстий в ПАП является снижение концентрации активных частиц плазмы в отверстии в связи с уменьшением скоростей подачи реагентов и отвода продуктов реакции из отверстий.
Травление отверстий идет в глубину, и одновременно идет процесс травления стенок отверстий со скоростью 0.06…0.1 мкм/мин, а травление алюминиевой маски со скоростью 10 нм/мин. Глубина травления отверстий в ПАП приближенно аппроксимируется полиномиальной функцией второго порядка:
Скорость травления $v$ (мкм/мин) отверстий в ПАП приближенно аппроксимируется логарифмической функцией:
где H – глубина отверстия, мкм.
Для изготовления плат мощных ГМИС СВЧ используются пластины ПАП толщиной 100…150 мкм, поэтому при скорости травления 1 мкм/мин время травления составит порядка 100…150 мин.
ЗАКЛЮЧЕНИЕ
Таким образом, показано, что поликристаллическая алмазная пленка пригодна для группового изготовления ГМИС СВЧ, метод плазмохимического травления обеспечивает групповое изготовление отверстий в ПАП с помощью планарной технологии и прецизионной литографии. Поэтому реактивное ионное травление с источником индуктивно связанной плазмы (РИТ-ИСП) выбрано базовым методом. Создана установка Плазма ТМ5 плазмохимического травления отверстий в ПАП (отечественный аналог установки Corial 200IL), на которой в оптимальных технологических режимах получена скорость травления ПАП порядка 1…1.1 мкм/мин.
Для исследования и измерения глубоких отверстий малого диаметра создан специальный стенд, позволяющий измерять глубину отверстий диаметром более 50 мкм в подложке толщиной до 500 мкм с точностью ±1 мкм.
На установке Плазма ТМ5 исследована возможность изготовления отверстий в ПАП различной формы – круглой, квадратной и треугольной, при этом круглые отверстия в ПАП диаметром 100 мкм имеют четкую геометрию и практически вертикальные стенки, скос стенок отверстий порядка 3%, а отверстия квадратной и треугольной формы имеют скругленные углы.
На установке Плазма ТМ5 исследована возможность травления отверстий в ПАП диаметром 100 мкм и глубиной 340 мкм. Показано, что скорость травления отверстий зависит от глубины и эта зависимость носит нелинейный характер. Отверстия имеют практически вертикальные стенки со скосом порядка 4%. При этом травление отверстий идет как в глубину, так и в стороны. Скорость травления стенок отверстий составляет 0.06…0.1 мкм/мин, при этом травление алюминиевой маски идет со скоростью 10 нм/мин.
Технологический процесс изготовления отверстий в ПАП на установке Плазма ТМ5 адаптирован с технологическими процессами изготовления ГМИС СВЧ на пилотной линии “НПП “Исток им. Шокина”.
Список литературы
Борисов А.А., Королев А.Н. // История отечественной электроники. М.: ИД Столичная энциклопедия, 2012. Т. 1. С. 311.
Михальченков А.Г., Темнов А.М. // Фрязинская школа электроники. М.: “Янус-К”, 2012. С. 275.
Темнов А.М., Дудинов К.В., Емельянов А.М. и др. // Электрон. техника. Сер. 1. СВЧ-техника. 2015. Вып. 2. С. 4.
Темнов А.М., Дудинов К.В., Емельянов А.М. и др. // Электрон. техника. Сер. 1. СВЧ-техника. 2016. Вып. 2. С. 45.
Темнов А.М., Дудинов К.В., Емельянов А.М. и др. // Электрон. техника. Сер. 1. СВЧ-техника. 2017. Вып. 2. С. 54.
Ральченко В.Г., Большаков А.П. Углеродная фотоника. М.: Наука, 2017. С. 9.
Седов В.С. Синтез тонких микро- и нано кристаллических алмазных пленок в СВЧ плазме. Дис. … канд. физ.-мат. наук. М.: ИОФ РАН, 2013. С. 126.
Совык Д.Н. Плазмохимический синтез трехмерных структур из алмаза методом реплики. Дис. … канд. физ.-мат. наук. М.: ИОФ РАН, 2014. С. 111.
Дерябкин А.В. // Электроника и электрооборудование транспорта. 2018. № 4. С. 35.
Духновский М.П., Ратникова А.К., Леонтьев И.А. // Электрон. техника. Сер. 1. СВЧ-техника. 2008. Вып. 2. С. 41.
Голованов А.В., Бормашов В.С., Волков А.П. // Труды МФТИ. 2013. Т. 5. № 1. С. 31.
Темнов А.М., Дудинов К.В., Емельянов А.М. и др. // Электрон. техника. Сер. 1. СВЧ-техника. 2017. Вып. 2. С. 68.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника