Радиотехника и электроника, 2020, T. 65, № 8, стр. 820-826
Высоковольтные быстровосстанавливающиеся лавинные диоды на основе карбида кремния
П. А. Иванов a, *, Т. П. Самсонова a, А. С. Потапов a, М. Ф. Кудояров a
a Физико-технический институт им. А.Ф. Иоффе РАН
194021 Санкт-Петербург, ул. Политехническая, 26, Российская Федерация
* E-mail: Pavel.Ivanov@mail.ioffe.ru
Поступила в редакцию 04.06.2018
После доработки 02.08.2019
Принята к публикации 15.08.2019
Аннотация
Представлены лабораторные образцы высоковольтных (1560 В) быстровосстанавливающихся (20 нс) лавинных диодов на основе карбида кремния. Показано, что изготовленные диоды способны рассеивать в режиме одиночных лавинных импульсов тока (длительность импульса 1 мкс) энергию до 2.9 Дж/см2. Численный расчет нестационарного теплового процесса показал, что в результате саморазогрева лавинным импульсом локальная температура в базовой области диодов достигает величины не менее 1100 K.
ВВЕДЕНИЕ
Развитие силовой электроники постоянно сопровождается внедрением новых технологий, повышающих эффективность и надежность работы преобразовательных устройств. В ближайшие годы следует ожидать широкого внедрения в силовую электронику приборов на основе материалов с большой шириной запрещенной зоны, в первую очередь на основе карбида кремния политипа 4H (4H-SiC) (см., например, [1]). Как полупроводниковый материал 4H-SiC по основным электрофизическим свойствам – ширине запрещенной зоны, предельной скорости носителей тока, напряженности поля лавинного пробоя, теплопроводности – в несколько раз превосходит кремний [2]. Использование силовых диодов и транзисторов на основе 4H-SiC взамен Si-приборов позволит более чем в 100 раз улучшить соотношение между мощностью и быстродействием [3]. В импульсных преобразователях большой эффект может дать переход на более высокие частоты коммутации. Так, преобразователь на основе силовых 4H-SiC-диодов и транзисторов может иметь в 5–10 раз большую частоту преобразований по сравнению с Si-приборами за счет более высокой теплопроводности 4H-SiC. Кроме того, возможность работы 4H-SiC-приборов при высоких температурах позволяет резко уменьшить габариты систем охлаждения и упростить конструкцию преобразователей. Все это дает возможность снизить массогабаритные показатели последних, что, в свою очередь, обеспечит создание более компактных схем с повышенными характеристиками по надежности.
В настоящее время широкое распространение получили высоковольтные (600…1700 В) диоды Шоттки (ДШ) на основе 4H-SiC (см., например, [https://www.wolfspeed.com/power/products]), которые предназначены для работы в составе силовых импульсных преобразователей. Достоинствами 4H-SiC-ДШ являются предельно высокое быстродействие (ДШ работают на основных носителях) и относительно небольшое напряжение включения в прямом направлении (высота барьера Шоттки составляет около 1 эВ). Однако 4H-SiC-ДШ имеют ограничения по максимальной рабочей температуре (175°C) и демонстрируют сравнительно высокий уровень утечек в обратном направлении (до нескольких сотен микроампер). Кроме того, планарные 4H-SiC-ДШ не предназначены для работы в лавинном режиме, поскольку для них существует проблема создания высокоэффективной охранной системы, предотвращающей деструктивный краевой пробой. Диоды с p–n-переходом на основе 4H-SiC потенциально способны работать при температурах до 700°C (диффузионная разность потенциалов p–n-перехода около 3 эВ) и имеют чрезвычайно малый уровень утечек (в наноамперном диапазоне). Для них можно создать эффективную охранную систему, позволяющую диодам работать в лавинном режиме. Быстродействие диодов с p–n-переходом принципиально может быть приближено к быстродействию ДШ за счет уменьшения времени жизни инжектированных носителей, например, с помощью радиационных методов (такие диоды будут работать без модуляции сопротивления базы неосновными носителями, как и диоды Шоттки).
В силовой электронике востребованы диоды, способные к работе в режиме мощного контролируемого лавинного пробоя. Такие диоды необходимы для импульсных преобразователей с повышенными требованиями по надежности. Лавинные диоды могут применяться в качестве быстродействующих ограничителей импульсных перенапряжений, возникающих, например, в схемах с индуктивной нагрузкой. Также лавинные диоды могут применяться в качестве ограничителей СВЧ-мощности. Необходимо также отметить применение лавинных диодов для изготовления высоковольтных столбов. Лавинные диоды, соединенные последовательно в столб, позволяют более равномерно распределять напряжение между обратносмещенными диодами и тем самым предотвращать выход всей линейки из строя в случае перенапряжения на одном или нескольких диодах одновременно. Для всех перечисленных выше применений желательно, чтобы диод, работающий в лавинном режиме, обладал способностью рассеивать большую мощность.
В данной работе продемонстрированы лабораторные образцы высоковольтных быстровосстанавливающихся лавинных диодов (БВЛД) с p–n-переходом на основе 4H-SiC, имеющих быстродействие, сравнимое с промышленными 4H-SiC-ДШ, и способных рассеивать в режиме одиночных лавинных импульсов большую энергию.
1. ОБРАЗЦЫ ДИОДОВ
Диоды были изготовлены на основе пластины 4H-SiC n-типа с эпитаксиальными p- и n-слоями, пластина была изготовлена по нашему заказу фирмой Wolfspeed (США) [https://www.wolfspeed.com/ materials/products/sic-epitaxy]. Постростовая технология изготовления диодов состояла из следующих основных процессов:
1) формирование омических контактов к верхнему эпитаксиальному p-слою и к n-подложке. Были изготовлены структуры c площадью анодных контактов 0.049 и 1 мм2;
2) формирование охранной системы на периферии анодных контактов для предотвращения преждевременного краевого пробоя;
3) резка пластины с диодными структурами на чипы;
4) облучение чипов высокоэнергетичными протонами на уникальной научной установке (УНУ) “Циклотрон ФТИ” для уменьшения заряда обратного восстановления диодов. Диоды на основе 4H-SiC способны блокировать большое обратное напряжения при сравнительно высоком уровне легирования базы. Это позволяет 4H-SiC-диодам с p–n-переходом эффективно работать и без модуляции проводимости блокирующей базы инжектированными носителями. В этом случае для повышения быстродействия диодов целесообразно уменьшать время жизни неравновесных носителей заряда (ННЗ), например, облучением протонами. При облучении протонами генерируются дополнительные рекомбинационные центры и, соответственно, уменьшается время жизни ННЗ. А чем меньше время жизни, тем меньше заряд, вносимый в базу диода прямым током, и, соответственно, заряд обратного восстановления;
5) напаивание чипов в металлостеклянный корпус и распайку проволочных выводов (рис. 1);
Рис. 1.
Быстровосстанавливающийся лавинный диод на основе 4H-SiC, смонтированный в маломощном металлостеклянном корпусе с помощью пайки свинцово-оловянным припоем; площадь анода 1 мм2.

6) заливка корпуса силиконовым гелем.
2. ВОЛЬТ-АМПЕРНЫЕ ХАРАКТЕРИСТИКИ 4H-SiC-БВЛД
На рис. 2 представлены типовые вольт-амперные характеристики (ВАХ) диодов в прямом направлении (при токах до 10 A) (рис. 2a) и в обратном направлении (при токах 2 мА) (рис. 2б), записанные с помощью цифрового характериографа Л2-100 (запись проводилась в режиме однократного запуска развертки по напряжению). В прямом направлении напряжение открывания диодов составляет около 2.8 В (эта величина приблизительно равна контактной разности потенциалов 4H-SiC p–n-перехода). Дифференциальное сопротивление диодов в открытом состоянии составляет около 0.3 Ом. Как видно из рис. 2б, резкий пробой диодов в обратном направлении наступает при напряжении 1560 В.
Рис. 2.
Прямая (a) и обратная (б) ВАХ изготовленных 4H-SiC БВЛД; площадь p–n-перехода 1 мм2; температура комнатная.

На рис. 3 показана типовая обратная ВАХ, измеренная на постоянном токе при напряжениях до 1500 В и построенная в двойном логарифмическом масштабе. Как видно, при комнатной температуре обратный ток относительно слабо растет при увеличении напряжения приблизительно до 800 В, не превышая при этом величины 0.5 нА. Далее обратный ток начинает увеличиваться резче, но вплоть до напряжения 1500 В его величина не превышает 100 нА.
3. ОБРАТНОЕ ВОССТАНОВЛЕНИЕ 4H-SiC-БВЛД
Измерения характеристик обратного восстановления (ОВ) диодов проводились с помощью импульсной схемы, показанной на рис. 4. В исходном состоянии МОП-транзистор T закрыт, а накопительный конденсатор C заряжен до напряжения источника питания положительной полярности. На затвор транзистора T подаются парные положительные открывающие импульсы. Во время первого импульса транзистор T открывается, БВЛД оказывается под обратным напряжением, а индуктивность L заряжается током разряда накопительного конденсатора через открытый транзистор Т и ограничительный резистор R2. Когда транзистор T закрывается, индуктивность L разряжается через прямосмещенный БВЛД и резистор R3, формируя прямой ток накачки. Во время второго импульса транзистор T вновь открывается, БВЛД вновь оказывается под обратным напряжением, и через него течет обратный ток вплоть до полного восстановления блокирующей способности. Временная зависимость тока через измерительный резистор R3 регистрируется цифровым осциллографом. Заряд обратного восстановления определяется как интеграл от обратного тока диода по времени.
На рис. 5 показаны типовые характеристики ОВ необлученных (кривая 1) и облученных (кривая 2) диодов при их переключении с прямого тока 3 А на обратное напряжение 500 В. (Скорость переключения тока с прямого на обратный составляла 300 А/мкс.) Заряды ОВ необлученных и облученных диодов составляют 63 и 20 нКл соответственно. После облучения диоды сохраняют “мягкий” характер восстановления, что свидетельствует о том, что облучение приводит к снижению коэффициента инжекции p–n-перехода [4]. Времена ОВ необлученных и облученных диодов составляют 35 и 20 нс соответственно. Таким образом, протонное облучение является эффективным инструментом для коррекции динамических характеристик высоковольтных p–n-диодов на основе 4H-SiC.
4. ИСПЫТАНИЯ 4H-SiC-БВЛД В ИМПУЛЬСНОМ ЛАВИННОМ РЕЖИМЕ
Ранее в работах [5, 6] нами были проведены физические исследования лавинного пробоя в высоковольтных p–n-диодах на основе 4H-SiC. Определены такие параметры, как лавинное сопротивление диодов, насыщенная скорость дрейфа электронов в блокирующей n-базе при высоких полях, температурный коэффициент напряжения пробоя.
В данном разделе продемонстрированы испытания изготовленных БВЛД на основе 4H-SiC на отказ при работе в импульсном лавинном режиме. Испытания проводили с помощью переключающей схемы с индуктивной нагрузкой (Unclamped Inductive Switching, UIS) (рис. 6) [https:// www.intersil.com/content/dam/Intersil/documents/ an19/an1968.pdf]. Источником импульсного питания в схеме служит конденсатор $C$ большой емкости, заряженный до напряжения ${{V}_{0}}$, которое выбирают намного меньше, чем напряжение пробоя диода ${{V}_{b}}$. Исходно к диоду приложено обратное напряжение ${{V}_{0}}$. Это же напряжение приложено к стоку закрытого МОП-транзистора (T). Когда транзистор T открывается импульсом ${{V}_{{\text{G}}}}$ на затворе, конденсатор $C$ разряжается через транзистор, индуктивность $L$ и сопротивление ${{R}_{2}}$. Пиковый зарядный ток в индуктивности $L$ может варьироваться изменением длительности открывающего импульса ${{V}_{{\text{G}}}}$. После закрывания транзистора T ток из него быстро перебрасывается в исследуемый БВЛД вместе с последовательно включенным измерительным резистором ${{R}_{3}}$. При этом на диоде генерируется обратное напряжение, превышающее напряжение пробоя ${{V}_{b}}$. Далее, по мере разряда индуктивности $L$ ток падает, а напряжение остается выше ${{V}_{b}}$. И, наконец, когда ток уменьшается практически до нуля, напряжение также снижается до исходной величины ${{V}_{b}}$. Временные диаграммы напряжения на диоде и тока через него записываются двухканальным цифровым осциллографом. (Измеряемые импульсные напряжения передаются на входы осциллографа через широкополосные аттенюаторы.) Мгновенная мощность $P\left( t \right)$, которая рассеивается во время лавинного процесса, рассчитывается путем перемножения мгновенных величин тока $I\left( t \right)$ и напряжения $~V\left( t \right)$. Полная энергия, рассеянная при прохождении импульса лавинного тока, определяется как интеграл от мощности по времени.
Для тестирования изготовленных БВЛД в лавинном режиме были выбраны диоды малой площади (диаметр анода 250 мкм, площадь 4.9 × 10–2 мм2), чтобы увеличить плотность мощности. На рис. 7 показаны осциллограммы тока и напряжения, измеренные с помощью схемы UIS. На рис. 7a пиковый лавинный ток составляет 3.5 А (плотность тока 71 A/мм2), максимальное обратное напряжение достигает 1700 В. Представленные на рис. 7a осциллограммы свидетельствуют об обратимом характере лавинного пробоя (ВАХ диода, показанная на рис. 2б, после пропускания лавинного импульса не деградировала). На рис. 7б пиковый лавинный ток (3.7 A) несколько больше, чем ток на рис. 7a. При этом в момент времени, близком к окончанию лавинного импульса, наблюдается резкий всплеск тока при уменьшении напряжения до нуля, что свидетельствует о катастрофическом отказе диода (контроль ВАХ после пропускания лавинного импульса подтвердил, что произошла потеря блокирующей способности диода). Лавинная энергия, рассчитанная из зависимостей $~I\left( t \right)$ и $V\left( t \right)$ (см. рис. 7a), составляет ${{E}_{{av,{\text{max}}}}}$ = 1.4 мДж (2.9 Дж/см2). Как мы полагаем, катастрофический отказ диода происходит вследствие нарушения баланса выделяемой и отводимой в диоде мощности и развития теплового пробоя.
Рис. 7.
Осциллограммы тока и напряжения, измеренные в схеме UIS при пиковом лавинном токе 3.5 (а) и 3.7 А (б).
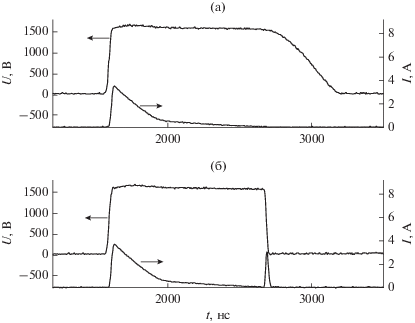
Важно отметить, что изготовленные 4H-SiC-БВЛД не уступают диодам Шоттки на основе 4H-SiC по быстродействию (см. табл. 1, в которой проводится сравнение изготовленных 4H-SiC-БВЛД с промышленными 4H-SiC-диодами Шоттки CPW4-1200-S005B фирмы Wolfspeed [https://www.wolfspeed.com/media/downloads/19/ CPW4-1200-S005B.pdf]).
Таблица 1.
Сравнение электрических параметров промышленных 4H-SiC-диодов Шоттки CPW4-1200-S005B и изготовленных 4H-SiC-БВЛД (при комнатной температуре)
| Параметр | CPW4-1200-S005B | 4H-SiC БВЛД |
|---|---|---|
| S, мм2 | 1.54 | 1 |
| ${{V}_{{R~{\text{max}}}}},{\text{\;В}}$ | 1200 | 1200 |
| ${{V}_{F}}$, В | 1.8 | 4.5 |
| ${{I}_{R}}$, мкА/мм2 | 100 | 0.01 |
| ${{Q}_{{rr}}},{\text{\;нКл}}/{\text{мм}}$2 | 18* | 20** |
| ${{C}_{0}}$, пФ/мм2 | 167 | 180 |
| ${{E}_{{av,{\text{max}}}}}$, Дж/см2 | – | 2.9 *** |
Примечание: S – площадь анода, VR max – максимальное постоянное обратное напряжение, VF – прямое падение напряжения при токе IF = 3 А/мм2, IR – обратный ток при обратном напряжении VR = 1200 В, Qrr – заряд ОВ при токе IF = 3 А/мм2, C0 – емкость при нулевом смещении, Eav,max – лавинная энергия. * При ${{V}_{R}}$ = 800 В, $~{{dI} \mathord{\left/ {\vphantom {{dI} {dt}}} \right. \kern-0em} {dt}}$ = 200 А/мкс. **При $~{{V}_{R}}$ = 500 В, $~{{dI} \mathord{\left/ {\vphantom {{dI} {dt}}} \right. \kern-0em} {dt}}$ = 300 А/мкс. ***При длительности импульса 1 мкс.
5. РАСЧЕТ НЕСТАЦИОНАРНОГО ТЕПЛОВОГО ПРОЦЕССА В 4H-SiC-БВЛД
Расчет нестационарного теплового процесса производился с помощью компьютерной программы, реализующей моделирование тепловых полей методом конечных элементов. Были приняты следующие упрощающие допущения: 1) электрическая мощность, рассеиваемая диодом в режиме лавинного пробоя, равномерно выделяется в области пространственного заряда (ОПЗ) p–n-перехода (в режиме лавинного пробоя ОПЗ занимает всю толщину n-базы), 2) поверхность 4H-SiC-кристалла теплоизолирована (отдачи тепла с поверхности нет). Очевидно, что в реальной ситуации мощность в силу ряда физических причин выделяется в n-базе неравномерно, а с поверхности кристалла все-таки происходит незначительная отдача тепла. Однако принятые допущения позволяют оценить нижнюю границу локального температурного перегрева в структуре диода.
На рис. 8 показана аксиальная геометрия моделируемой структуры. На рис. 9 показана измеренная временная зависимость мощности, выделяемой в области n-базы при прохождении импульса лавинного тока (сплошная линия), и численная аппроксимация этой зависимости полиномом 9-й степени (пунктир). Теплофизические параметры 4H-SiC-диода – зависимости коэффициента теплопроводности $C$ и теплоемкости $K$ 4H-SiC от температуры – были взяты из работы [7]:
(1)
$C\left( T \right) = 0.48 + 0.023\exp ({T \mathord{\left/ {\vphantom {T {262}}} \right. \kern-0em} {262}})\,\,~~{{{\text{Дж}}} \mathord{\left/ {\vphantom {{{\text{Дж}}} {\left( {{\text{г}}\,\,{\text{град}}} \right)}}} \right. \kern-0em} {\left( {{\text{г}}\,\,{\text{град}}} \right)}},$(2)
$K\left( T \right) = 2.67 \times {{10}^{3}}{{T}^{{ - 1.26}}}\,{{\,{\text{Вт}}} \mathord{\left/ {\vphantom {{\,{\text{Вт}}} {\left( {{\text{см}}\,\,{\text{град}}} \right)}}} \right. \kern-0em} {\left( {{\text{см}}\,\,{\text{град}}} \right)}}.$Рис. 8.
Геометрия моделируемой структуры. 1 – ОПЗ (область выделения тепла), 2 – квазинейтральная часть кристалла 4H-SiC, 3 – поверхность эпитаксиальной структуры.

Рис. 9.
Временная зависимость мощности, выделяемой в n-базе (сплошная кривая) и численная аппроксимация этой зависимости полиномом 9-й степени (штриховая).

На рис. 10 представлена рассчитанная временная зависимость локальной температуры (в середине базовой области) при прохождении импульса лавинного тока. Как видно, локальная температура в середине базовой области достигает около 1100 К. В реальности локальный температурный перегрев может быть еще сильнее по той причине, что тепло выделяется в базовой области неравномерно.
ЗАКЛЮЧЕНИЕ
Как известно, работоспособность полупроводниковых диодов с p–n-переходом при нагревании имеет фундаментальное ограничение, связанное с тем, что при повышении температуры увеличивается концентрация собственных носителей. Критической является температура, при которой концентрация собственных носителей в полупроводнике становится сравнимой с концентрацией легирующих примесей в базовых областях диода. В 4H-SiC, имеющем ширину запрещенной зоны 3.24 эВ, концентрация собственных носителей при комнатной температуре чрезвычайно мала – по разным оценкам она находится в пределах 10–8…10–7 см–3. В высоковольтных 4H-SiC-диодах уровень легирования блокирующей базы находится в пределах 1015…1016 см–3. Концентрация собственных носителей достигает таких величин при нагреве до температуры около 1350 K. Как мы полагаем, в изготовленных в данной работе 4H-SiC-БВЛД реализуется именно такое фундаментальное ограничение на величину максимальной рассеиваемой энергии лавинного импульса. Важно отметить и то, что изготовленные 4H-SiC-БВЛД не уступают диодам Шоттки на основе 4H-SiC по быстродействию. При этом диоды с p–n-переходом ожидаемо имеют существенно меньшие по величине допробойные утечки. И хотя они уступают диодам Шоттки по величине прямого падения напряжения, такие 4H-SiC БВЛД могут найти применение во многих областях силовой электроники.
Список литературы
Лебедев А.А., Иванов П.А., Левинштейн М.Е. и др.// Успехи физ. наук. 2019. Т. 189. № 8. С. 803.
Kimoto T., Cooper J.A. Fundamentals of Silicon Carbide Nechnology: Growth, Characterization, Devices, and Applications. Wiley-IEEE Press, 2014.
Полищук А. // Компоненты и технологии: Электронные компоненты. 2004. № 8. https:// www.kit-e.ru/assets/files/pdf/2004_08_40.pdf.
Козловский В.В. Модифицирование полупроводников пучками протонов. СПб.: Наука, 2003.
Иванов П.А., Грехов И.В., Ильинская Н.Д., Самсонова Т.П. // ФТП. 2005. Т. 39. № 12. С. 1475.
Иванов П.А., Потапов А.С., Самсонова Т.П., Грехов И.В. // ФТП. 2017. Т. 51. № 3. С. 390.
Wei R., Song S., Yang K. et al. // J. Appl. Phys. 2013. V. 113. № 5. P. 053503.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника