Радиотехника и электроника, 2021, T. 66, № 5, стр. 490-499
Исследованиe трансформации приповерхностных слоев арсенида галлия под воздействием света с помощью поверхностных акустических волн
Т. А. Брянцева a, *, И. А. Марков a, Ю. А. Тен a
a Фрязинский филиал Института радиотехники и электроники им. В.А. Котельникова РАН
141120 Фрязино, Московской обл., пл. Введенского, 1, Российская Федерация
* E-mail: tatiana@ms.ire.rssi.ru
Поступила в редакцию 26.09.2020
После доработки 10.10.2020
Принята к публикации 23.10.2020
Аннотация
С помощью поверхностных акустических волн (ПАВ) в работе исследовались изменения состояния приповерхностного слоя полуизолирующего (111) GaAs, находящегося на воздухе, под воздействием белого света. Показано, что в зависимости от величины интенсивности света и уровня мощности ПАВ усиливаются или ослабляются реакции взаимодействия с молекулами, атомами и заряженными частицами воздушной среды. Рассмотрена роль стоячих акустических волн, возникающих в приповерхностных слоях арсенида галлия, а именно концентрация эффектов взаимодействия в местах наибольшей освещенности в результате дифракции света на стоячих акустических волнах. Найдено, что при этом в пятнах дифракции формируются зародыши (Ga + As), покрытые слоями соединений с кислородом и углеродом, либо растущие, либо растекающиеся, и формирование слоя оксида приводит к переориентации поверхности GaAs.
ВВЕДЕНИЕ
Изготовление полупроводниковых приборов на основе GaAs во многих случаях включает в себя процессы, связанные с интенсивным воздействием света на поверхность кристалла. Примером может служить процесс осаждения пленок металла путем термического испарения в вакууме [1]. В связи с этим возникает потребность в исследованиях процессов взаимодействия поверхности полупроводника с окружающей средой на различных этапах изготовления и использования приборов. Известно, что стремление к понижению свободной энергии поверхности подложки или тонкопленочной системы является стимулом ее перестройки. Перестройка поверхности возможна под воздействием внешних корпускулярных и электромагнитных облучений, акустических, электрических и магнитных полей [1–7]. Параметры распространения поверхностных акустических волн существенным образом зависят от состояния приповерхностного слоя образца, что является основой метода контроля ПАВ-диагностики [1].
Соприкасающиеся фазы окружающая среда–полупроводник приобретают заряды различного знака. Взаимное отталкивание одноименных зарядов или притяжение разноименных зарядов, концентрирующихся на поверхности со стороны каждой фазы, влияют на стягивающие силы в приповерхностном слое, при этом изменяется и плотность приповерхностных слоев [8]. Происходит перемещение структурных единиц. Изменяется поверхностное натяжение, поверхностное давление, величина поверхностного заряда и потенциала. Поскольку Ga+ и As– – потенциалообразующие ионы в GaAs, следует ожидать, что двойной электрический слой изменяется также за счет изменения их движения. В растянутые области перемещается галлий, как имеющий больший радиус, тогда как в сжатые области – мышьяк.
Перемещение структурных единиц, в свою очередь, связано с ползучестью – процессом пластической деформации и определяется процессами диффузии. Процессы диффузии в определенных случаях, влияя на состав, контролируют деформацию материала [9]. Таким образом, на поверхности GaAs образуется двойной электрический слой с соответствующими электрическими потенциалами и другими свойствами, обусловливающий различные электроповерхностные явления. Этот слой образуется как на поверхности природного слоя оксида арсенида галлия, так и на идеально чистой поверхности.
При освещении образца GaAs в атмосфере комнаты изменяется окружающая среда, а, следовательно, и двойной электрический слой. Изменяется и переход электронов с поверхности арсенида галлия с образованием электронного облака со стороны воздуха (воздушная прослойка). Количественной характеристикой процесса служит работа выхода электронов. Интенсивность ухода электронов с поверхности зависит от температуры, концентрации электронов в образце и от кривизны поверхности. В некоторых случаях возникший электрический потенциал на границе раздела фаз может препятствовать переходу электронов и тогда возникает равновесие: поверхностный заряд полупроводника компенсируется зарядом, созданным электронами в газовой фазе. Работа выхода электронов зависит также от кристаллографической плоскости кристалла. В частности, как известно, работа выхода электронов с плоскости (100) GaAs намного меньше работы выхода с поверхности (111) GaAs [10]. Таким образом, можно считать, что первоначально поверхность образца GaAs представляет собой метастабильный двумерный слой, сформированный за счет образования квазиравновесного ионизированного облака вблизи поверхности полупроводника [8].
Цель данной работы – выявить процессы, происходящие с приповерхностным слоем GaAs, испытывающим возмущение со стороны ПАВ и под воздействием света (белого).
1. МЕТОДИКА И ТЕХНИКА ЭКСПЕРИМЕНТА
Возможность использования поверхностных акустических волн (ПАВ) для исследования свойств поверхности арсенида галлия была показана нами ранее [1]. При этом использовалось то обстоятельство, что арсенид галлия обладает свойствами пьезоэлектрика и имеется возможность возбуждения ПАВ непосредственно в кристалле с помощью встречно-штыревых преобразователей (ВШП).
Исследуемые образцы (111) GaAs (ρ ∼ 108 Ом см) представляли собой пластинки толщиной 300 мкм, размером 30 × 23 мм2, вырезанные из слитка кристалла, выращенного по методу Чохральского. Пластинки подвергали предэпитаксиальной подготовке, включающую в себя химико-динамическую полировку и очистку поверхности GaAs. Исследования с помощью электронографии, Оже-спектроскопии и тонкого химического анализа показали, что изначально структура природного слоя оксида на (111)GaAs – аморфная и имеет комплексный состав, состоящий из Ga, As, C и O и их соединений. При этом при осаждении тонкого слоя металла (Au, Al) наиболее характерными кислородсодержащими соединениями, входящими в состав оксида, являются Ga2O3, GaAsO4, Ga2(OH)4. Встречно-штыревые преобразователи (ВШП) наносили на поверхность GaAs в виде тонкопленочной структуры из Al. Поскольку поверхность GaAs с ВШП выдерживали на воздухе в течение более двух–четырех часов, ее покрывали достаточно толстым окисным слоем природного оксида толщиной ≥100 Å [12]. Перед измерениями поверхность образцов с нанесенными ВШП предварительно промывали в неорганических растворителях, таких как изопропиловый спирт, диметил-формамид, что приводило к уменьшению содержания углерода в слое оксида.
Облучение светом (белым) на воздухе. Для исследований трансформации поверхности GaAs под воздействием облучения (белого света) был использован медицинский источник света ОВС-1, у которого отсекается инфракрасная часть спектра. Площадь облучения составляла 10 × 15 мм2. Источник света для всех рассматриваемых случаев размещали непосредственно по центру образца. Освещенность Е ~ I/r2 (I – интенсивность света) задавалась расстоянием r от источника света до центра образца (r = 5 или 25 см). Измерения проводили в атмосфере комнаты. Влажность составляла ~40%.
В то же время воздействие света на поверхность GaAs на воздухе может вызывать нагревание приповерхностного слоя, возбуждение и ионизацию атомов, или молекул, фотохимические реакции и другие процессы в веществе. Источником ионов и электронов может быть ионизация воздуха при освещении за счет таких реакций как:
(1)
$\begin{gathered} {{{\text{H}}}_{{\text{2}}}}{\text{O}} + {{e}^{ - }} \leftrightarrow {{(1} \mathord{\left/ {\vphantom {{(1} {2){{{\text{H}}}_{2}} + {\text{O}}{{{\text{H}}}^{ - }}}}} \right. \kern-0em} {2){{{\text{H}}}_{2}} + {\text{O}}{{{\text{H}}}^{ - }}}}; \\ {{{\text{H}}}_{{\text{2}}}} + 2{{e}^{ - }} \leftrightarrow 2{{{\text{H}}}^{ - }}; \\ 2{\text{H}} + 2{{e}^{ - }} \leftrightarrow {{{\text{H}}}_{2}}, \\ \end{gathered} $(2)
$\begin{gathered} {{{\text{H}}}_{{\text{2}}}}{{{\text{O}}}_{{\text{2}}}} + 2{{{\text{H}}}^{ + }} + 2{{e}^{ - }} \leftrightarrow 2{{{\text{H}}}_{2}}{\text{O;}} \\ {{{\text{H}}}_{{\text{2}}}}{\text{O}} \leftrightarrow {{{\text{O}}}^{ - }} + {{{\text{H}}}^{ + }}; \\ {{{\text{H}}}^{{\text{ + }}}} + {{{\text{H}}}_{2}}{\text{O}} \leftrightarrow {{{\text{H}}}_{3}}{{{\text{O}}}^{ + }}. \\ \end{gathered} $Те же самые реакции могут иметь место для углерода и ${\text{CO}}_{3}^{{ - 2}}$, ${\text{CO}}_{4}^{{ - 2}}$, ${\text{C}}{{{\text{O}}}_{3}}{{{\text{H}}}^{ - }}$ – продуктов этих реакций [11].
Температуру поверхности GaAs под воздействием света контролировали с помощью планарной термопары. Температура поверхности GaAs оставалась неизменной и при всех исследованиях с помощью ПАВ соответствовала температуре комнаты, приблизительно 20°С.
Морфологию поверхности после проведенных экспериментов по распространению ПАВ изучали с помощью оптического микроскопа с использованием метода селективного травления.
ПАВ-диагностика. Исследовали образцы GaAs, на поверхность которых были нанесены ВШП ПАВ, работающие на центральной частоте 65.3 МГц. Апертура ВШП – W = 3.5 мм, расстояние между ВШП – L = 15.5 мм. Амплитуда и фаза выходного сигнала ПАВ измерялись через равные промежутки времени ∼0.5 с. Максимальное значение выходного сигнала синтезатора частоты Uвых = 0.7 В, волновое сопротивление всего тракта R = 50 Ом. Параметры ПАВ измеряли с помощью следующих приборов:
а) синтезатор частоты РЧ6-05 в качестве источника гармонического сигнала с задаваемой амплитудой и частотой,
б) векторный вольтметр ФК2-29, позволяющий измерять амплитуды и фазы относительно опорного канала,
в) персональный компьютер, задающий временные интервалы считывания информации (амплитуда, фаза) и фиксирующий результаты измерений в привязке к основным параметрам измерений: время, частота.
При рассмотрении полученных характеристик ПАВ следует учитывать, что упругие свойства и плотность твердых тел и жидкостей зависят от физико-химического состояния среды [13]. В первом приближении можно считать, что скорость упругих волн в каждой из этих сред постоянна. Однако при распространении ПАВ в одной и той же среде скорость волны зависит от кристаллографического направления, например, для GaAs она является наибольшей в направлении [2$\bar {1}\bar {1}$] на (111) поверхности [10].
ПАВ реагирует на изменения состояния приповерхностного слоя (структуры, состава и т.д.) изменениями амплитуды и фазовой скорости [14]. При этом нужно отметить следующие факты:
– амплитуда волны отмечает фазовые превращения в приповерхностном слое перпендикулярном к поверхности GaAs;
– скорость распространения волны фиксирует физико-химическое состояние (в том числе зарядовые свойства) в плоскости приповерхностного слоя арсенида галлия;
– изменение скорости ПАВ обратно пропорционально изменению вязкости приповерхностных слоев;
– относительное изменение скорости ПАВ ${{\Delta v} \mathord{\left/ {\vphantom {{\Delta v} v}} \right. \kern-0em} v}$ преимущественно является функцией отклонения скорости распространения волны от основного направления.
Таким образом, изменение параметров распространения ПАВ позволяет определять параметры структуры и состава оксидной пленки и ее границы с подложкой. Кроме того, поглощение ПАВ при распространении по кристаллу обусловлено преобразованием ее энергии в другие виды энергии и, в конечном счете, в тепло [14]. В однородной среде поглощение упругих волн обусловлено, главным образом, процессами внутреннего трения и теплопроводности. Кроме того, возможна диссипация энергии вследствие химических реакций.
1.1. Оценка изменения мощности и фазовой скорости зондирующей ПАВ
Мощность акустической волны можно определить [14, 19] как
(3)
${{P}_{{{\text{ав}}}}} = {{{{P}_{{{\text{вых}}}}}} \mathord{\left/ {\vphantom {{{{P}_{{{\text{вых}}}}}} {{{X}_{0}}}}} \right. \kern-0em} {{{X}_{0}}}},$где ${{P}_{{{\text{вых}}}}} = {{U_{{{\text{вых}}}}^{2}} \mathord{\left/ {\vphantom {{U_{{{\text{вых}}}}^{2}} R}} \right. \kern-0em} R}$ − выходная мощность генератора (синтезатора частоты), Uвых − выходное напряжение синтезатора частоты (в нашем эксперименте Uвых = 0.7 В, R = 50 Ом), Х0 − потери на преобразование ВШП.
Измеряемая на опыте величина А − амплитуда (относительно опорного сигнала)
(4)
$A = - 10\lg \left( {{{{{P}_{0}}} \mathord{\left/ {\vphantom {{{{P}_{0}}} {{{P}_{{\text{м}}}}}}} \right. \kern-0em} {{{P}_{{\text{м}}}}}}} \right)$связана с потерями в тракте Х соотношением $X = {{10}^{{ - \left( {{A \mathord{\left/ {\vphantom {A {10}}} \right. \kern-0em} {10}}} \right)}}}$. При отсутствии внешних воздействий на кристалл и при допущении, что возможные потери Х обусловлены только потерями преобразования для двух идентичных преобразователей ВШП, тогда получаем
(5)
${{X}_{0}} = {{10}^{{ - \left( {{{{{A}_{0}}} \mathord{\left/ {\vphantom {{{{A}_{0}}} {20}}} \right. \kern-0em} {20}}} \right)}}};$(6)
${{P}_{{{\text{ав}}\,{\text{0}}}}} = \left( {{{{{P}_{{{\text{вых}}}}}} \mathord{\left/ {\vphantom {{{{P}_{{{\text{вых}}}}}} {{{X}_{0}}}}} \right. \kern-0em} {{{X}_{0}}}}} \right) = \left( {{{U_{{{\text{вых}}}}^{2}} \mathord{\left/ {\vphantom {{U_{{{\text{вых}}}}^{2}} R}} \right. \kern-0em} R}} \right) \times {{10}^{{\left( {{{{{A}_{0}}} \mathord{\left/ {\vphantom {{{{A}_{0}}} {20}}} \right. \kern-0em} {20}}} \right)}}}.$В условиях внешнего воздействия, если все процессы протекают только между ВШП, А = А0– А1, где А1 − измеренная амплитуда под воздействием:
(7)
${{X}_{1}} = {{10}^{{ - \left( {{{\left( {{{A}_{0}} - {{A}_{1}}} \right)} \mathord{\left/ {\vphantom {{\left( {{{A}_{0}} - {{A}_{1}}} \right)} {{{{10}}_{1}}}}} \right. \kern-0em} {{{{10}}_{1}}}}} \right)}}},$а
(8)
${{P}_{{{\text{ав}}1}}} = \frac{{{{P}_{{{\text{ав}}0}}}}}{{{{X}_{1}}}}{{{{P}_{{{\text{ав}}0}}}} \mathord{\left/ {\vphantom {{{{P}_{{{\text{ав}}0}}}} {{{X}_{1}}}}} \right. \kern-0em} {{{X}_{1}}}} = \left( {{{U_{{{\text{вых}}}}^{2}} \mathord{\left/ {\vphantom {{U_{{{\text{вых}}}}^{2}} R}} \right. \kern-0em} R}} \right) \times {{10}^{{\left( {{{\left( {3{{A}_{0}} - 2{{A}_{1}}} \right)} \mathord{\left/ {\vphantom {{\left( {3{{A}_{0}} - 2{{A}_{1}}} \right)} {20}}} \right. \kern-0em} {20}}} \right)}}}.$Выражение, позволяющее оценить энергию, поглощаемую в приповерхностном слое GaAs в области между преобразователями имеет вид
где t1 − время. Кроме того, можно рассчитать фазовую скорость по выражению
(10)
${{v}_{{{\varphi }}}} = \frac{{2\pi f\ell }}{{{{\varphi }_{{\text{p}}}} + {{\varphi }_{0}} - \varphi }},$где f − частота, φ0 − фаза в начальный момент времени, φр − фаза расчетная, φ − фаза измеренная. В рассматриваемом случае φ0 = 0, $\ell $ − расстояние между ВШП, следовательно:
где ${{\varphi }_{{\text{p}}}} = 2\pi \frac{\ell }{\lambda }$, длина волны равна $\lambda = {{{{v}_{0}}} \mathord{\left/ {\vphantom {{{{v}_{0}}} f}} \right. \kern-0em} f}$, ${{v}_{0}}$ − скорость ПАВ на свободной поверхности. В нашем случае на поверхности (111) GaAs вдоль оси [2$\bar {1}\bar {1}$] ${{v}_{0}}$ = 3.0826 × 105 см/с [9]. Поскольку λ = $ = 47.2 \times {{10}^{{ - 3}}}\,\,{\text{мм}}$, ${{\varphi }_{{\text{p}}}} = 1.9968 \times {{10}^{3}}\,\,{\text{рад}}$, а
(12)
${{v}_{{{\varphi }}}} = \frac{{2\pi f\ell }}{{2\pi f\left( {{\ell \mathord{\left/ {\vphantom {\ell {{{v}_{0}}}}} \right. \kern-0em} {{{v}_{0}}}}} \right) - \varphi }},$изменение ${{\Delta v} \mathord{\left/ {\vphantom {{\Delta v} v}} \right. \kern-0em} v}$ (отношение фазовых скоростей $\Delta v$ – между скоростью без облучения и скорости под воздействием света, к $v$ – фазовой скорости без облучения) оценивалось как:
(13)
${{\Delta v} \mathord{\left/ {\vphantom {{\Delta v} v}} \right. \kern-0em} v} = \frac{{{{v}_{{{\varphi }}}} - {{v}_{0}}}}{{{{v}_{0}}}}.$Выбранная схема измерений [1] параметров ПАВ позволяла определять изменение амплитуды и фазы выходного сигнала (Ав = Авых − Авх, φв = = φвых − φвх) через задаваемые интервалы времени освещения светом. Данная схема позволяла фиксировать основные параметры изменений величин в следующих пределах чувствительности: по амплитуде − 0.04 дБ, по фазе − 2°, по времени − 10 мс, динамический диапазон установки 90 дБ. Потери всего тракта с включенным образцом составляли ∼18 дБ.
2. ЭКСПЕРИМЕНТАЛЬНЫЕ ДАННЫЕ
Данные по измерению комплексного коэффициента прохождения ПАВ в условиях атмосферы комнаты и освещения светом для различных условий распространения представлены в табл. 1. Измерения № 1–11 проводились в едином цикле, когда эксперименты следовали друг за другом (рис. 1–3). Отдельно проводились эксперименты по освещению светом поверхности в условиях опыта № 12 (см. табл. 1, рис. 3б).
Таблица 1.
Условия распространения ПАВ на (111) GaAs
| Номера кривых на рис. 1 | Включения лампы по отсчету времени, с | Выключения лампы по отсчету времени, с |
Авых, дБ | Расстояние до лампы, см |
|---|---|---|---|---|
| 1 | 22.5 | 90.25 | 20 | 5 |
| 2 | 182.4 | 250.4 | 20 | 25 |
| 3 | 369 | 460.2 | 0 | 25 |
| 4 | 574.2 | 618.3 | 30 | 25 |
| 5 | 646.5 | 661.3 | 40 | 25 |
| 6 | 702.5 | 739.5 | 10 | 25 |
| 7 | 774.7 | 800.4 | 3 | 25 |
| 8 | 837.3 | 858.1 | 1 | 25 |
| 9 | 889 | 914 | 15 | 25 |
| 10 | 941 | 953.7 | 17 | 25 |
| 11 | 991.2 | 1026.4 | 12 | 25 |
| 12 | 25 | 740 | 0 | 5 |
Рис. 1.
Изменения амплитуды (А) и фазы ПАВ (φ) в зависимости от времени облучения светом при различных условиях ее прохождения ПАВ (значения 1‒12 см. табл. 1);
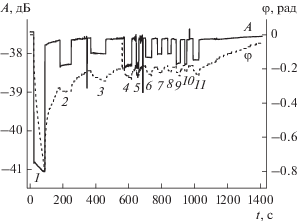
Рис. 2.
Временные зависимости амплитуды и скорости ПАВ при r = 25 см и Авых= 40 (а), 20 (б) и 0 дБ (в).

Как следует из рис. 1, сводный график изменения амплитуды и фазы, отличаясь для каждого временного промежутка условиями прохождения ПАВ, в целом имеет вид, аналогичный временной зависимости деформации под воздействием постоянной нагрузки [15].
На начальном этапе наблюдается увеличение поглощения акустической волны. Поглощение волны с течением времени (под воздействием света) уменьшается и при выключении света возвращается к первоначальным характеристикам.
Оказалось, что с увеличением времени выдержки под воздействием света лампочки происходят заметные изменения характеристик прохождения ПАВ, причем амплитуда и фаза меняются по своим индивидуальным закономерностям.
На рис. 2, 3 приведены характерные зависимости параметров ПАВ от времени подсветки при различных значениях освещенности и мощности зондирующей ПАВ (Аген) в зависимости от времени облучения.
При r = 25 см зависимость амплитуды от времени освещения отличается заметными пульсациями, Характер пульсаций и их шаг зависит от величины мощности зондирующей ПАВ (см. рис. 2). Размах колебаний амплитуды при этом либо увеличивается со временем облучения при Авых = 40 дБ, Авых = = 20 дБ (см. рис. 2а, 2б), либо уменьшается ступенчато при Авых = 0 дБ (см. рис. 2в).
В этом случае фазовая скорость также зависит от величины вводимого ослабления мощности ПАВ. Величина фазовой скорости может колебаться в противофазе к амплитуде при Авых = 40 дБ (см. рис. 2а) вблизи линии относительного равновесия. При Авых = 20 дБ (см. рис. 2б), с увеличением времени облучения величина фазовой скорости, имея постоянное значение, отличается одним резким импульсным сбросом по величине. В то же время при Аген = 0 дБ (см. рис. 2в), фазовая скорость может ступенчато уменьшаться.
При r = 5 см (с увеличением освещенности, рис. 3а, 3б) характер пульсации амплитуды имеет более сглаженный вид. Амплитуда при этом характеризуется мелкими пульсациями и плавно снижается (Авых = 20 дБ, см. рис. 3а). При Авых = 0 дБ (см. рис. 3б), амплитуда вначале резко (скачком) падает и затем относительно плавно снижается.
3. ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
3.1. Зависимости характеристик ПАВ от условий проведения экспериментов
Как следует из рис. 2, 3 на измеряемые характеристики ПАВ помимо времени подсветки оказывают существенное влияние освещенность:
где I – сила света источника, r – расстояние от источника до облучаемой поверхности, θ – угол падения света [16], а также мощность ПАВ. Из зависимостей, представленных на рис. 1–3, можно сделать вывод, что в рассматриваемых случаях значительный вклад в поведение характеристик ПАВ вносят эффекты физико-химического взаимодействия, происходящие как на поверхности арсенида галлия, так и на поверхности слоя оксида.
На воздухе под воздействием тестирующей ПАВ на поверхности GaAs формируются периодически распространяемые сжатые или растянутые области GaAs. Между этими областями возникает электрическое напряжение и периодическое противоположно направленное движение электронов и дырок. Поверхность оксида периодически либо нагревается (обогащается электронами), либо охлаждается (обедняется электронами), что является причиной возникновения собственных колебаний решетки GaAs. С увеличением времени облучения изменяется и давление на поверхность оксида со стороны воздуха, и осаждение заряженных частиц из воздуха на поверхность оксида. В результате незначительно увеличивается и рассеяние энергии ПАВ.
Под действием света в атмосфере комнаты появляются дополнительные ионы и электроны (ионизация воздуха), вследствие чего меняется электропроводность воздушной прослойки. На соприкасающихся поверхностях перераспределяются электроны и ионы, создавая движение ионов среды. Следует отметить, что энергия и количество заряженных частиц, поступающих на поверхность, зависят от расстояния r. Перераспределение зарядов формирует разность потенциалов, которая зависит от диэлектрических свойств соприкасающихся сред, их взаимного давления, влажности (для воздушной прослойки) и от температуры. Поверхностная разность потенциалов при этом может достигать высоких значений (десятков киловольт) при низких токах. За счет высоких напряжений может произойти электростатический разряд. Указанные явления могут служить причиной инжекции или эмиссии электронов с поверхности (автоэлектронная эмиссия), вследствие чего возникают стоячие акустические волны.
При освещении на поверхности возникают эффекты интерференции и, как следствие, рассеяния света на акустических волнах, дифракция света [16]. Эти эффекты возможны за счет того, что пленки оксида и подлежащие слои арсенида галлия имеют разные коэффициенты преломления. При этом коэффициенты преломления, поглощения и отражения зависят от состава и структуры приповерхностных слоев. Следовательно, меняется и степень освещенности поверхности самого арсенида галлия.
Вводимые уровни мощности ПАВ изменяют степень возбуждения молекул, что влияет на степень нарушения связей между атомами и их реактивную способность [17].
В итоге взаимодействие с ионизированными радикалами, как со стороны воздушной прослойки, так и со стороны арсенида галлия вызывает различные резонансно-релаксационные процессы передачи энергии возбуждения окружающей среде, что выражается в пульсациях амплитуды.
При r = 25 см (рис. 2а–2в) на поверхности, судя по всему, наибольшую роль играют эффекты интерференции, дифракции, отражения и поглощения света. При этом эффекты интерференции и дифракции связаны с формированиями стоячих акустических волн в приповерхностных слоях, так называемые эффекты рассеяния света Мандельштама– Бриллюэна [16].
При Авых= 40 дБ (см. рис. 2а) возможны такие эффекты как периодическое гашение – усиление интенсивности света за счет эффектов абсорбции и дисперсии в пленках оксида, что приводит к периодическому просветлению окисных пленок. При Авых= 20 дБ (см. рис. 2б), судя по всему, происходит нарастание слоя оксида, сжатие приповерхностного слоя GaAs с выходом электронов с поверхности GaAs в слой оксида. При Авых= 0 дБ (см. рис. 2в), возникает ступенчатый эффект просветления пленок оксида, что связано, скорее всего, с изменениями состава и совершенства слоя оксида.
При r = 5 см (рис. 3а, 3б) с увеличением интенсивности освещения также возникают эффекты просветления. В результате при Авых = 0 дБ на (111) GaAs резко с включением света увеличивается количество электронов в образце, затем с увеличением времени облучения увеличивается потеря (эмиссия) электронов.
Таким образом, эффекты ионизации атомов поверхности и взаимодействие с ионизированными молекулами воздуха с выделением (поглощением) энергии приводят к изменению структуры, состава и толщины оксида. В конечном итоге меняется его механическая и оптическая плотность, что вызывает колебания слоя (пластинки) оксида [16]. В зависимости от толщины слоя колебания могут быть продольными или изгибными (поперечными). Меняется и давление на поверхность GaAs.
С изменением состава, структуры и толщины слоя оксида меняется степень просветления, а, следовательно, и освещенность арсенида галлия. Под воздействием освещения светом поверхность арсенида галлия либо обогащается электронами (увеличивается концентрация электронов за счет фотоэффекта), либо обедняется за счет эмиссии или диффузии электронов при деформации. При этом переход приповерхностного слоя GaAs из состояния “1” к состоянию поверхности в “2”, как известно, приводит к собственным колебаниям решетки GaAs [18].
Кроме того, при освещении возможно движение двух диэлектриков (слоя оксида и приповерхностного слоя GaAs) относительно друг друга. В результате трения на поверхности движущихся тел возникают заряды, обусловленные диффузией электронов и ионов (эффект трибоэлектричества). При трении существенную роль начинает играть разное нагревание тел, что, в свою очередь, может вызвать переход носителей с локальных неоднородностей более нагретой поверхности [16].
3.2. Аппроксимация и интерпретация зависимостей характеристик ПАВ
Изменение амплитуды. Из данных, представленных на рис. 1-3, можно было определить энергию волны, поглощенную за время подсветки и интенсивность $I = {P \mathord{\left/ {\vphantom {P S}} \right. \kern-0em} S}$, где $S \approx a\lambda $, a − поперечный размер области распространения ПАВ, λ − длина ПАВ. При этом из соотношения ${P \mathord{\left/ {\vphantom {P {{{P}_{0}}}}} \right. \kern-0em} {{{P}_{0}}}}$ можно оценить изменение эффективной массы (GaAs) в мольных долях, учитывая, что λ = 47 × 10–4 см – первоначальная толщина слоя, а площадь образца между преобразователями 3.5 × 0.9 см2. Зная Р0, можно определить энергию активации данного процесса согласно [14, 19].
Следует отметить, что при r = 25 см, Авых = 40 дБ (см. рис. 2а) поведение акустической волны, скорее всего, отражает эффекты, которые являются следствием возникновения периодических электрических разрядов между слоями оксида и арсенида галлия. По мере накопления зарядов эти разряды могут быть направлены как с поверхности пленки оксида в сторону арсенида галлия, так и с поверхности арсенида галлия в сторону пленки оксида. Этот эффект приводит к периодическому обеднению зарядов на поверхности оксида и изменению амплитуды ПАВ. Вместе с тем обогащение поверхности арсенида галлия электронами приводит к падению фазовой скорости. При этом возникает так называемое состояние химического равновесия, когда между пленкой оксида и GaAs периодически происходит обмен ионами и электронами: Ga+ + дырка и As– + электрон. Была определена энергия активации квазиравновесного процесса, она составляет 3.6 ккал/моль.
В случае r = 25 см, Авых = 20 дБ (см. рис. 2б), т.е. при увеличении интенсивности звуковой волны, зависимость поглощаемой мощности от времени освещения приобретает другой вид: P = $ = {{P}_{0}}\exp \left( { - 0.03\ln t} \right)$.
В данном случае амплитуда сигнала увеличивается со временем облучения. Картины морфологии поверхности, полученные с помощью оптической микроскопии, показывали, что сплошность слоя оксида, так же, как и его толщина, растет. Окисная пленка при этом становится более совершенной и прозрачной для ПАВ.
Было найдено значение энергии активации процесса, равное D = 4759 кал/моль, что соответствует энергии активации диффузии атомов Ga. То есть большее совершенство пленки оксида обеспечивается за счет заполнения границ зерен галлием, который сам, как известно, легко окисляется, а также взаимодействует с такими радикалами, как СО–, OH– и т.д., присутствующими в воздушной атмосфере.
При r = 5 см и Авых = 20 дБ (см. рис. 3а) зависимость поглощенной мощности Р от времени подсветки t имеет вид: $P = {{P}_{0}} + k{{t}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}$, где $k = {{{{P}_{0}}} \mathord{\left/ {\vphantom {{{{P}_{0}}} {t_{0}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}}} \right. \kern-0em} {t_{0}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}}$, ${{\left( {P - {{P}_{0}}} \right)} \mathord{\left/ {\vphantom {{\left( {P - {{P}_{0}}} \right)} {{{P}_{0}} = {{{{t}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}} \mathord{\left/ {\vphantom {{{{t}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}} {t_{0}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}}} \right. \kern-0em} {t_{0}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}}}}} \right. \kern-0em} {{{P}_{0}} = {{{{t}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}} \mathord{\left/ {\vphantom {{{{t}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}} {t_{0}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}}} \right. \kern-0em} {t_{0}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}}}}$.
Энергия активации изменения поглощенной мощности волны (амплитуды) составляет qв = dU ~ ~ 17.8 ккал/моль и соответствует энергии образования GaAs [18]. Это указывает на то, что в данном случае осуществляется изохорный (при постоянном объеме) процесс и процесс взаимодействия с окружающей средой происходит при изменяющемся давлении р.
На поверхности GaAs, скорее всего, осуществляются два конкурирующих процесса: процесс образования слоя оксида и его разрушение. Поскольку теплота образования пленки оксида была близка к энергии смешения (Ga + As) и соответствовала 22.6 ккал/моль [20], dU = Hсм − D = 22.6 – – 4.8 =17.8 ккал/моль, то сделан вывод, что рассеивание мощности ПАВ отражает эффекты миграции Ga и химической реакции образования GaAs. Данные эффекты связаны с тем, что парциальное давление заряженных частиц со стороны окружающей среды превышают давление заряженных частиц, покидающих поверхность GaAs. Причем зависимость рассеиваемой энергии Е от времени t соответствует выражению:
(15)
$E = - 1.45875 \times {{10}^{{ - 5}}} + 1.48024 \times {{10}^{{ - 8}}}{{t}^{{{{11} \mathord{\left/ {\vphantom {{11} 5}} \right. \kern-0em} 5}}}}.$Выражения для Р и Е показывают, что в данном случае рассеивание мощности осуществляется за счет зернограничной диффузии галлия с образованием соединения GaAs, поскольку известно, что при этом концентрация С мигрирующих атомов пропорциональна длине [21]: $C \sim {{x}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}{{t}^{{{6 \mathord{\left/ {\vphantom {6 5}} \right. \kern-0em} 5}}}}$.
Когда r = 5 см, Авых = 0 дБ (см. рис. 3б) (с увеличением интенсивности света и звуковой волны), амплитуда сигнала уменьшается со временем по сравнению с начальной. Энергия активации процесса изменения Р составляет qp = dH = 15.5 ккал/моль, что соответствует теплоте изобарного процесса и совпадает с величиной энтропии для GaAs при 293°С. Разница между теплотой смешения и энергии активации миграции Ga и As равна 7.2 ккал/моль.
Наблюдаемые эффекты, скорее всего, связаны с тем фактом, что в данном случае парциальное давление заряженных частиц, поступающих из газовой среды на поверхность GaAs, практически равны давлению заряженных частиц, покидающих поверхность. При этом реакции взаимодействия с окружающей средой (воздушная атмосфера – поверхность образца) обусловлены возникновением электрических разрядов.
В данном случае наблюдаются разрывы в структуре пленки оксида, и в них можно наблюдать образование холмиков GaAs по границам зерен.
Поведение окисной пленки не может не сказаться на состоянии поверхности приграничных слоев GaAs и вызывает в нем эффекты сжатия или растяжения, что, скорее всего, приводит к изменению ориентации поверхности GaAs.
Изменения фазовой скорости. На графиках временных зависимостей при различных степенях освещенности и мощности ПАВ наблюдается снижение фазовой скорости. При этом обнаруживаются либо отдельные резонансно-релаксационные всплески падения скорости (см. рис. 1) и возвращение к прежнему значению, либо следующие друг за другом ступеньки падения скорости (см. рис. 2б) и возвращения к первоначальным значениям. Наблюдаемые эффекты являются, скорее всего, также следствием возникновения электрических разрядов между слоями оксида и арсенида галлия, в то время как плавная зависимость от времени освещения (см. рис. 3а, 3б) связана с эффектами диффузии заряженных частиц (электронами и дырками). Оказалось, что отношение ${{\Delta v} \mathord{\left/ {\vphantom {{\Delta v} v}} \right. \kern-0em} v}$ зависит от времени экспозиции как
(16)
$\operatorname{tg} \left( {t\frac{{\Delta v}}{v}} \right) = 0.245 - {{9.97}^{{ - 7}}}{{t}^{{{{11} \mathord{\left/ {\vphantom {{11} 5}} \right. \kern-0em} 5}}}}.$Энергия активации процесса, найденная из тангенциальной зависимости Q = 180 кал, что соответствует энергии перехода (111) GaAs ↔ (100) GaAs, [00$\bar {1}$] → [2$\bar {1}$$\bar {1}$] [11]. В случае ступенчатой зависимости (см. рис. 2в) энергия, определенная из зависимости огибающей ступеньки кривой от времени облучения, также была равна 180 кал.
Наблюдения дискретной зависимости ${{\Delta v} \mathord{\left/ {\vphantom {{\Delta v} v}} \right. \kern-0em} v}$ от времени облучения связано, по-видимому, с изменением состава слоя оксида под воздействием излучения. Это подтверждается известными фактами образования окисных слоев на поверхности GaAs [18], когда возможны следующие превращения: ${\text{Ga}} + 4{\text{O}}{{{\text{H}}}^{ - }} = {\text{Ga}}({\text{OH}})_{4}^{ - } + 3e$. При температуре 20°С образуется гидроокись ${\text{Ga}}{{({\text{OH}})}_{3}}$, при 80°С − ${\text{G}}{{{\text{a}}}_{{\text{2}}}}{{{\text{O}}}_{{\text{3}}}} \cdot {\text{2H}}{{{\text{O}}}_{{\text{2}}}}$, при 160°С − ${\text{3G}}{{{\text{a}}}_{{\text{2}}}}{{{\text{O}}}_{{\text{3}}}} \cdot {\text{4H}}{{{\text{O}}}_{{\text{2}}}}$, или GaOOH (кристаллический гидрат). Разложение гидрата GaOOH при 300°С приводит к образованию β-модификации Ga2O3, при 400°С − Ga2O3 α-модификации со структурой типа корунда. Исходя из изложенного ранее следует, что разложение гидратов в рассматриваемом случае может осуществляться под воздействием энергии, рассеиваемой при прохождении ПАВ, и под воздействием света. При этом может меняться и проводимость окисных слоев, поскольку известно, например, что ${\text{G}}{{{\text{a}}}_{2}}{{{\text{O}}}_{3}}$ обладает полупроводниковыми свойствами и под воздействием света может иметь электрическую проводимость, что естественно оказывает значительное влияние на поглощение ПАВ. Все эти окисные модификации метастабильны и переходят в устойчивую β-модификацию ${\text{G}}{{{\text{a}}}_{2}}{{{\text{O}}}_{3}}$. Таким образом, можно сделать вывод, что независимо от того, как осуществляется уменьшение ${{\Delta v} \mathord{\left/ {\vphantom {{\Delta v} v}} \right. \kern-0em} v}$ (дискретно или плавно), энергия перехода составляет 180 кал/моль.
Из тангенциальной зависимости был определен угол поворота плоскости измененного приповерхностного слоя GaAs относительно базового (111) GaAs. Угол поворота составил 60°, что соответствует углу между плоскостями (111) и (100).
Исследования изменения величины омического сопротивления в диодных структурах под воздействием света показали аналогичные результаты. Исходя из величины сопротивления и приложенного напряжения, зная толщину окисного слоя, а также ее изменение, определялась энергия, затраченная на переход системы из состояния сплошной окисной пленки к блочной (с вкраплениями островков GaAs). Оказалось, что она равна 21 ккал/моль, что соответствует энергии смешения Ga + As.
ЗАКЛЮЧЕНИЕ
Под воздействием света на поверхности GaAs, покрытого слоем природного оксида, возникают эффекты интерференции из-за разницы в коэффициентах преломления в пленках оксида и арсенида галлия. В результате интерференции на поверхности формируются узоры – выделенные наиболее освещенные места, которые становятся, с одной стороны, стоком для точечных дефектов, в частности свободных ионов Ga и/или As, с другой – местами преимущественного осаждения заряженных частиц из окружающего воздуха.
В случае малой интенсивности света и малой мощности ПАВ осаждение заряженных частиц из воздушной прослойки приводит к накоплению поверхностного заряда, повышению поверхностного потенциала и, как следствие, к микроразрядам, обеспечивая периодическую эмиссию или инжекцию электронов с поверхности GaAs.
С увеличением мощности ПАВ при малой интенсивности света возникает поверхностная диффузия элементов из более освещенных мест в более темные. При этом величина поглощения ПАВ определяется диффузией заряженных частиц и ионов Ga. Повышаются реактивная способность поверхности и возможность взаимодействия с частицами из воздуха. При этом с увеличением интенсивности света повышается и количество заряженных частиц в воздушной прослойке. Указанные эффекты служат причиной возбуждения на поверхности арсенида галлия стоячих акустических волн с собственной частотой или частотой колебаний пластинки оксида и, как следствие, возникновения дифракции света.
В случае более высокой интенсивности света и большей мощности ПАВ в результате явлений интерференции и дифракции формируются максимально освещенные пятна, расположенные по узорам окружностей интерференции, которые и являются преимущественными местами стока дефектов. В результате на поверхности в выделенных местах образуются и растут зародыши – зерна.
Образованные зерна представляют собой микросферы, содержащие помимо Ga и As соединения углерода и кислорода. Под воздействием ПАВ с большой мощностью легколетучие компоненты, такие как CO, As2O, Ga2O и т.д., улетучиваются, противодействуя парциальному давлению заряженных частиц со стороны воздушной прослойки. Степень противодействия, а, следовательно, и реакции взаимодействия будут определяться уровнем интенсивности света и мощностью волны.
Взаимодействие поверхности GaAs с окружающей средой приводит, с одной стороны, к росту микрокапель (Ga + As), покрытых слоем оксида, с другой стороны, к их вынужденному растеканию и выравниванию слоя оксида с выпадением зерен GaAs. При этом величина поглощения ПАВ определяется либо диффузией Ga, либо образованием и/или разрушением GaAs с одновременной диффузией Ga и As.
Из сказанного выше следует, что ПАВ чувствительны как к состоянию слоев природных оксидов GaAs, так и к состоянию поверхности GaAs. Наблюдаемые электрокинетические эффекты при этом зависят и от освещенности поверхности, и от уровня мощности ПАВ. Образование достаточно плотного окисного слоя приводит к переориентации поверхности GaAs с изменением направления наибольшей скорости акустической волны [2$\bar {1}\bar {1}$] → [00$\bar {1}$], что отражается в изменении фазовой скорости. При этом может быть определен угол смены ориентации, который составляет ∼60° [22].
Список литературы
Брянцева Т.А., Любченко В.Е., Любченко Д.В. и др. // РЭ. 2009. Т. 54. № 5. С. 621.
Брянцева Т.А., Любченко Д.В., Марков И.А. и др. // Неорганические материалы. 2009. Т. 45. № 8. С. 901.
Lioubtchenko D.V., Briantseva T.A., Lebedeva Z.M., Bullough T.J. // Defect and Diffusion Forum. 2010. V. 307. P. 75.
Lioubtchenko D.V., Briantseva T.A., Lebedeva Z.M., Bullough T.J. // Defect and Diffusion Forum. 2011. V. 316–317. P. 89.
Брянцева Т.А., Любченко Д.В., Марков И.А., Тен Ю.А. // ФТП. 2011. Т. 45. № 12. С. 1585.
Брянцева Т.А., Любченко Д.В., Лебедева З.М., Бобылев М.А. // Физикохимия поверхности и защита материалов. 2012. Т. 48. № 1. С. 1.
Брянцева Т.А., Любченко Д.В., Любченко В.Е. и др. // ФТП. 2014. Т. 48. № 2. С. 196.
Фролов Ю.Г. Курс коллоидной химии. Поверхностные явления и дисперсные системы. М.: Химия, 1982.
Бокштейн Б.С. Диффузия в металлах. М.: Металлургия, 1978.
Физические величины. Справочник / Под ред. И.С. Григорьева, Е.З. Мейлихова. М.: Энергоатомиздат, 1991.
Рабинович В.А., Хавин З.Я. Краткий химический справочник / Под ред. В.А. Рабиновича. Л.: Химия, 1978.
Брянцева Т.А., Бобылев М.А., Лебедева З.М., Любченко Д.В. // Завод. лаб. 2012. № 2. С. 41.
Детлаф А.А., Яворский Б.М. Курс физики. М.: Высш. школа, 1989.
Терстон Р. Физическая акустика / Под ред. Л.Д. Розенберга. М.: Мир, 1965. Т. 1А.
Урусовская А.А. Современная кристаллография. Т. 4. Физические свойства кристаллов. М.: Наука, 1981.
Физический энциклопедический словарь. М.: Сов. энциклопедия, 1983.
Гладков С.О. Физика композитов. Термодинамические и диссипативные свойства. М.: Наука, 1999.
Фридкин В.М. Современная кристаллография. Т. 2. Структура кристаллов. М.: Наука, 1979.
Волькенштейн Ф.Ф. Электронные процессы на поверхности полупроводников при хемосорбции. М.: Наука, 1987.
Плющев Б.Е., Степина С.Б., Федоров П.И. Химия и технология редких и рассеянных элементов. Ч. 1. М.: Высш. школа, 1976.
Каур И., Густ В. Диффузия по границам зерен и фаз. М.: Машиностроение, 1991.
Горелик С.С., Расторгуев Л.Н., Скаков Ю.А. Рентгенографический и электронно-оптический анализ. М.: Металлургия, 1970.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника



