Радиотехника и электроника, 2022, T. 67, № 7, стр. 715-721
Фотодетекторы видимой части спектра на основе ZnSe и ZnCdSe/ZnSe: сравнительные характеристики
С. В. Аверин a, *, Л. Ю. Захаров a, В. А. Житов a, В. М. Котов a
a Фрязинский филиал Института радиотехники и электроники им. В.А. Котельникова РАН
141190 Фрязино, Московской обл., пл. Введенского, 1, Российская Федерация
* E-mail: sva278@ire216.msk.su
Поступила в редакцию 16.12.2021
После доработки 16.12.2021
Принята к публикации 19.01.2022
- EDN: OSTLSU
- DOI: 10.31857/S003384942207004X
Аннотация
Экспериментально исследованы характеристики спектрального отклика и квантовой эффективности фотодетекторов видимой части спектра на основе ZnSe и гетероструктуры ZnCdSe/ZnSe. Спектральный отклик детекторов охарактеризован при различных условиях смещения. Для объяснения механизма внутреннего усиления детекторов использована модель уменьшения эффективной высоты обратносмещенного контакта Шоттки при его освещении.
ВВЕДЕНИЕ
Детектирование УФ- и видимого излучения до недавнего времени выполнялось почти исключительно на Si- и GaAs-детекторах [1]. Основной недостаток таких детекторов – деградация параметров при воздействии излучения с энергией фотона, существенно превышающей ширину запрещенной зоны Si и GaAs. Кроме того, максимальная чувствительность фотоприемных устройств на Si и GaAs находится в инфракрасной области и при работе в голубой и фиолетовой части спектра должна быть скорректирована соответствующим фильтром, что приводит к усложнению приемной системы и снижению ее чувствительности [1–3]. По этим причинам в качестве активных слоев фотодетекторов УФ- и видимой части спектра в настоящее время интенсивно исследуются широкозонные полупроводниковые материалы GaN, ZnO, ZnSe и их твердые растворы [1, 4]. Широкозонный полупроводник позволяет реализовать низкий темновой ток и высокую надежность при освещении высокоэнергетичными фотонами, а подбором параметров гетероэпитаксиальных слоев может быть реализован узкополосный отклик детектора. Это обеспечивает фильтрацию принимаемого полезного сигнала и, тем самым, повышает помехозащищенность оптической информационной системы [4]. Также известно, что широкозонные полупроводниковые материалы в сравнении с Si и GaAs обладают существенно большей теплопроводностью и радиационной стойкостью. Это позволяет использовать устройства на их основе при значительно более высоких температурах и мощностях принимаемого излучения, в то время как прочность химических связей широкозонных полупроводников обеспечивает повышенную радиационную стойкость [1].
Во многих работах были изготовлены и исследованы различные типы фотодетекторов на основе широкозонных полупроводниковых материалов и гетероструктур, такие как детекторы на p–n-переходе [5], p–i–n-фотодиоды [6, 7], фотодиоды на барьере Шоттки [8], фотодетекторы в системе контактов металл–полупроводник–металл (МПМ) [9, 10]. Особое внимание при этом уделялось узкополосным детекторам. Узкополосный отклик с полной шириной сигнала отклика, измеренной на половине его амплитуды (full width at half maximum) FWHM = 14 нм, был реализован на AlGaN/GaN MПM-диодах на длине волны 361 нм [11]. Еще более узкополосный отклик с FWHM = 7 нм на длине волны ~370 нм был получен на MПM-детекторах на основе гетероструктуры (Mg,Zn)O [12]. В работе [13] исследованы детектирующие свойства MПM-диодов на низкоразмерных гетероструктурах с ZnCdS квантовыми ямами, разделенными ZnMgS и ZnS барьерными слоями. Детекторы обеспечивали двухцветное детектирование оптических сигналов на длинах волн 350 и 450 нм с FWHM, равной 18 и 50 нм соответственно. Как видим, узкополосные фотодетекторы видимой и УФ-части спектра на широкозонных полуроводниковых материалах являются предметом интенсивных исследований последних лет.
В данной работе исследованы характеристики спектрального отклика и квантовой эффективности МПМ-детекторов видимого излучения. Для целей сравнения были изготовлены два вида МПМ-фотодетекторов: на ZnSe и на гетеробарьерной структуре ZnCdSe/ZnSe. МПМ-детектор на ZnSе позволяет реализовать широкополосный отклик в диапазоне длин волн 330…465 нм с максимумом токовой чувствительности 0.14 А/Вт на длине волны 460 нм, что соответствует квантовой эффективности детектора 38%. МПМ-детектор на гетеропереходе ZnCdSe/ZnSe обеспечивает эффективный узкополосный отклик с FWHM = 4.3 нм, ампер-ваттную чувствительность 2.27 А/Вт и квантовую эффективность 612% на длине волны 460 нм.
1. ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ
Селенид цинка и твердые растворы на его основе (ZnSSе, ZnSTe, ZnMgBeSe) являются перспективными полупроводниковыми материалами оптоэлектронных устройств, работающих в видимой и УФ-части спектра [1]. Они могут быть выращены решеточно-согласованными с подложкой на основе GaAs, что обеспечивает интеграцию фотодетектора со схемами усиления и обработки сигнала на GaAs-электронике. При создании p–n- и p–i–n-фотодиодов на оcнове ZnSe, ZnSSe возникают трудности формирования качественного омического контакта к p-области детектора [14]. Получение сильнолегированного ZnSe, ZnSSe p‑типа до сих пор остается проблемой, которая ограничивает возможности создания оптоэлектронных устройств на этих широкозонных материалах. По этой причине в качестве базовой структуры фотодиодов в данной работе была выбрана планарная, поверхностно-барьерная диодная структура на основе двойных выпрямляющих контактов в системе МПМ [15, 16]. В таком детекторе может быть использован полупроводниковый материал только одного типа проводимости, а омические контакты отсутствуют. Площадь активной области МПМ-диода при равной емкости в четыре раза больше площади p–i–n-диода. Это заметно облегчает фокусирование принимаемого оптического излучения на светочувствительную область детектора. Кроме того, благодаря расположению области обеднения обратносмещенного контакта Шоттки непосредственно под поверхностью полупроводниковой структуры, такая конструкция детектора является предпочтительной в УФ- и видимой части спектра по сравнению с p–i–n-диодом и детектором на p–n-переходе, в которых свет проходит через область р-перехода диода, где значительная его часть теряется.
Были исследованы два типа МПМ-детекторов, Д1 и Д2. Фотодиод Д1 изготовлен в виде встречно-штыревых барьерных контактов Шоттки к эпитаксиальной пленке ZnSe толщиной 550 нм, выращенной методом химического газофазного осаждения из металлоорганических соединений (MOVPE) на полуизолирующей подложке GaAs толщиной 300 нм (рис. 1а). Для изготовления барьерных контактов Шоттки MПM-диода напыляли два слоя – барьерный Ni (90 нм) и защитный Au (70 нм). Затем на поверхности структуры методами фотолитографии были сформированы встречно-штыревые контакты MПM-диода с шириной 2.8 мкм, длиной 100 мкм и расстоянием между ними 3 мкм. Фоточувствительная область MПM-детектора равна 100 × 100 мкм2.
Рис. 1.
Последовательность эпитаксиальных слоев и встречно-штыревые контакты MПM-диодов Д1 (а) и Д2 (б).
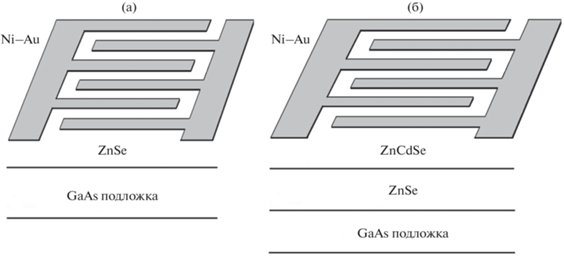
Фотодиод Д2 изготовлен аналогичным образом и с той же геометрией встречно-штыревых контактов, но в качестве активного слоя детектора использовали гетеробарьерную структуру ZnCdSe/ZnSe. Толщина слоев – ZnCdSe 132 нм и ZnSe 805 нм – рассчитана по спектрам отражения. Детальное описание процесса осаждения эпитаксиальных пленок приведено в работе [17].
Морфология поверхности выращенных эпитаксиальных пленок диодов Д1 и Д2 исследована на атомно-силовом микроскопе Smart SPM (AIST-NT). Поверхность полупроводниковых структур диодов Д1 и Д2 была достаточно плотной и состояла из равномерно распределенных монокристаллических блоков. Согласно измерениям шероховатость ростовой поверхности полупроводниковой структуры диода Д2 на площади 20 × 20 мкм2 составила (root mean square) RMS = 22 нм. На рис. 2 представлена микрофотография фрагмента поверхности изготовленного MПM-фотодиода Д2.
Рис. 2.
Микрофотография фрагмента поверхности MПM-фотодетектора Д2; длина Ni–Au встречно-штыревых контактов 100 мкм, ширина 2.8 мкм, расстояние между ними 3 мкм.

1.1. Характеристики МПМ-диодов
Вольт-амперные характеристики МПМ-диодов были исследованы при комнатной температуре на анализаторе параметров полупроводниковых приборов. Они показаны на рис. 3 при различных полярностях напряжения смещения. За счет поверхностного слоя ZnCdSe диод Д2 демонстрирует несколько более низкий темновой ток. При напряжении смещения 30 В темновой ток этого диода составляет 2 × 10–10 А, что сравнимо с темновым током МПМ-диода на основе низкоразмерной гетероструктуры ZnCdS/ZnMgS/GaP [18]. Темновой ток гомоэпитаксиальных ZnSe фотодетекторов Д1 при таком же смещении равен 5 × 10–10 А. Поскольку и дробовой шум, и шум 1/f пропорциональны величине тока, протекающего через переход, низкий темновой ток позволяет улучшить отношение сигнал/шум детектирующей системы. Темновой ток в диодной структуре зависит от высоты барьерного контакта. МПМ-диод состоит из двух последовательно включенных барьерных контактов Шоттки. При подаче напряжения на диод один из контактов оказывается прямосмещенным, а другой смещен в обратном направлении и, несмотря на то что полярность напряжения смещения, прикладываемого к диоду, можно поменять, в любом случае можно измерить только обратные ветви зависимости тока от напряжения для каждого из этих контактов.
Таким образом, в структурах МПМ нельзя использовать стандартный метод оценки параметров барьера Шоттки, основанный на измерении прямой ветви его вольт-амперной характеристики [19, 20]. Мы измерили высоту барьера Шоттки в МПМ-системе контактов диодов Д1 и Д2 в соответствии с методикой, подробно описанной в работе [21]. Анализ показал, что темновой ток исследуемых барьерных контактов хорошо описывается в рамках теории термоэлектронной эмиссии. Высота потенциального барьера Шоттки в диодах Д1 и Д2 согласно измерениям и вычислениям составляет соответственно 1.15 и 1.3 эВ, а коэффициент идеальности перехода в обоих случаях равен n ~ 1.2. Эти параметры свидетельствуют об отсутствии достаточно толстого промежуточного окисного слоя в исследуемых контактах металл–полупроводник и о высоком качестве барьеров Шоттки в изготовленных МПМ-диодах. Измеренная высота потенциального барьера контакта Ni/Au–ZnSe близка к ранее опубликованным данным, 1.17 эВ [22] и 1.20 эВ [23], для контакта Au–ZnSe.
Мы также должны отметить небольшую асимметрию кривых вольт-амперных характеристик MПM-диода Д2 для прямых и обратных смещений вследствие незначительных различий высот потенциальных барьеров двух последовательно включенных барьерных встречно-штыревых контактов Шоттки. Предположительно, это связано с различной плотностью состояний на границе раздела металл–полупроводник двух смежных барьерных контактов и неизбежными дефектами роста, приводящими к неоднородности поверхности выращенной полупроводниковой структуры и, как следствие, к неравным эффективным площадям двух соседних контактов. Для диода Д1 различий в поведении ВАХ при приложении прямого и обратного смещения не наблюдалось. Пробивные напряжения детекторов Д1 и Д2 находятся в пределах 90…100 В, демонстрируя их потенциальную устройчивость к возможным броскам напряжений смещения при работе в реальных условиях. Кроме того, высокие пробивные напряжения и, как следствие, большие электрические поля в таких полупроводниковых структурах позволяют их использовать в МПМ-диодах с субмикронными межконтактными зазорами для увеличения широкополосности фотодетектора за счет увеличения дрейфовой скорости фотогенерированных носителей заряда при больших полях [24].
1.2. Спектральная фоточувствительность детекторов
Спектральную фоточувствительность исследуемых диодных структур измеряли при комнатной температуре, используя в качестве источника излучения ксеноновую лампу, излучение которой, проходя через монохроматор, прерывалось с частотой 400 Гц и фокусировалось на активную. область MПM-диода системой оптических линз. Результирующий фототок измеряли синхронным усилителем PAR-124A. Мощность падающего на фотодиод оптического излучения измеряли калиброванным кремниевым фотодиодом. Ампер-ваттную чувствительность фотодетектора рассчитывали как отношение измеренного сигнального тока МПМ-диода к мощности излучения ксеноновой лампы, попадающей на диод на соответствующей длине волны.
Зависимость спектральной чувствительности детектора Д1 от напряжения смещения представлена на рис. 4. Детектор обеспечивает широкополосный отклик в диапазоне длин волн 330…465 нм. Сигнал отклика детектора резко растет с увеличением смещения в области 5…15 В, что является следствием расширения области обеднения между встречно-штыревыми контактами диода. Максимум сигнала отклика детектора находится на длине волны 460 нм и соответствует ширине запрещенной зоны ZnSe 2.7 эВ. Одним из практических применений детектора Д1 может быть его использование для детектирования вредного для человека УФ-излучения. Хорошо известно, что избыточная доза излучения Солнца может привести к болезненному состоянию [4]. Область фоточувствительности детектора Д1 совпадает с областью максимального эффекта пигментационного излучения Солнца (0.36…0.44 мкм), и поэтому фотоприемник на основе МПМ-диода Д1 может служить датчиком загара.
Рис. 4.
Зависимость спектральной фоточувствительности МПМ-детектора Д1 от напряжения смещения: 5 (1), 15 (2), 20 (3) и 30 В (4).

На рис. 5 представлена зависимость сигнала фотоотклика МПМ-детектора Д2 на гетероструктуре ZnCdSe/ZnSe/GaAs от длины волны оптического излучения. Такой детектор обеспечивает достаточно узкополосный отклик. На длине волны 460 нм полная ширина, измеренная на полувысоте отклика детектора (FWHM), составляет 4.3 нм. Ранее было показано, что ZnSe, ZnSSe фотодетекторы на основе барьера Шоттки обеспечивают резкий спад фоточувствительности в длинноволновой части сигнала отклика (красная граница отклика детектора) [1, 25]. Это также наблюдается в нашем эксперименте (см. рис. 5). При переходе к детектированию оптических сигналов на более коротких длинах волн с увеличением энергии кванта света резко растет коэффициент поглощения излучения, падающего на детектор. Оно поглощается в этом случае все ближе к поверхности гетероструктуры [19, 26]. При этом концентрация фотогенерированных электронов и дырок в узкой приповерхностной области ZnCdSe очень велика, что резко увеличивает вероятность поверхностной и объемой рекомбинации и уменьшает время жизни носителей заряда [27–29]. Носители заряда рекомбинируют в тонком слое ZnCdSe раньше, чем они уходят к встречно-штыревым контактам MПM-диода.
На рис. 6 представлена зависимость сигнала отклика МПМ-диодов Д1 и Д2 от напряжения смещения. Отклик детектора на сигнал оптического излучения сначала линейно увеличивается с увеличением смещения, а затем появляется участок насыщения фототока. Двумерное моделирование МПМ-диода показывает, что при зазоре между встречно-штыревыми контактами 3 мкм и при напряжении смещения <10 В детектор работает в условиях частичного обеднения активной межэлектродной области диода [30]. Это подтверждается низким уровнем сигнала отклика детектора в диапазоне напряжений смещения 5…10 В (рис. 6). Увеличение напряжения смещения приводит к расширению области обеднения обратносмещенного контакта Шоттки, и максимальная ампер-ваттная чувствительность детектора Д2 на длине волны 460 нм быстро растет с 0.05 А/Вт при 5 В до 1.5 А/Вт при 20 В (см. рис. 6). Это приводит к увеличению квантовой эффективности фотодетектора с 13.5% до 400%. Напряжение, которое определяет начало процесса насыщения фототока детектора (условие плоских зон контакта металл–полупроводник), рассчитывается по уравнению [31]
где ${{N}_{d}}$ – концентрация свободных носителей заряда поверхностного слоя полупроводника, εs – диэлектрическая проницаемость, $t$ – межконтактный зазор.Уровень легирования поверхностного слоя гетероструктуры ZnCdSe/ZnSe диода Д2 был определен из вольтфарадной характеристики контакта Шоттки и составил ${{N}_{d}}$ = 2 × 1015 cм–3. Тогда, при $t$ = 3 мкм получаем V$~$= 20 В , что находится в хорошем соответствии с нашим экспериментом. Концентрация свободных носителй заряда в поверхностном слое полупроводниковой структуры диода Д1 согласно измерениям равна 1015 см–3. Это привело к снижению напряжения смещения, соответствующего условию плоских зон для диода Д1 до ~10 В (см. рис. 6).
При напряжении смещения 30 В измеренная ампер-ваттная чувствительность MПM-диода Д1 составляет 0.14 А/Вт, а расчетная квантовая эффективность 38%, что находится в хорошем соответствии с результатами других авторов [22, 32, 33]. Токовая чувствительность детектора Д2 на той же длине волны равна 2.27 А/Вт, а квантовая эффективность 612%. Таким образом, при том же напряжении смещения гетеробарьерный МПМ-диод Д2 обеспечивает в ~16 раз большую чувствительность в сравнении с гомоэпитаксиальным диодом Д1. Квантовая эффективность детектора Д2 существенно выше 100%, это указывает на внутреннее усиление фототока в такой диодной структуре. Несколько теорий было предложено для объяснения механизма усиления фототока в MПM-детекторах на основе барьера Шоттки, в частности, одна из них предполагает усиление туннелирования электронов через барьер [19, 34]. Однако коэффициент идеальности барьерного контакта в нашей структуре близок к единице, что свидетельствует о надбарьерной эмиссии электронов как основного механизма токопроводимости в диоде. Мы полагаем, что фотоусиление, наблюдаемое в исследуемом детекторе Д2, обусловлено захватом неосновных носителей заряда (дырок) на центрах захвата гетероперехода ZnCdSe/ZnSe. Существование центров захвата на границе раздела двух полупроводников хорошо известно [12, 35]. При освещении перехода дырки, фотогенерированные в области обеднения обратносмещенного контакта, улавливаются на центрах захвата гетероперехода ZnCdSe/ZnSe и производят положительный заряд Qги= qNги, где Nги – концентрация центров захвата на гетероинтерфейсе. Наряду с отрицательным зарядом электронов Qm на поверхности металла, формирующего барьер Шоттки, и положительным зарядом Qd, обусловленным нескомпенсированными донорами в полупроводнике, общий заряд перехода должен удовлетворять условию электронейтральности Qm + Qd + Qги= 0 [36, 37]. Таким образом, положительный заряд центров захвата гетероперехода приводит к уменьшению положительного заряда области обеднения Qd. Соответственно, при этом уменьшается ширина области обедения контакта, его диффузионный потенциал и эффективная высота барьера Шоттки [35, 37]. Понижение высоты барьера определяется по формуле
где ${{N}_{{{\text{ги}}}}}$– плотность центров захвата, d – ширина области обеднения обратносмещенного контакта, ε – диэлектрическая проницаемость полупроводника, q – заряд электрона. Уже при $~{{N}_{{{\text{ги}}}}} = {{10}^{{10}}}\,\,{\text{с}}{{{\text{м}}}^{{ - 2}}}$ понижение высоты барьера Шоттки в условиях полного обеднения межконтактной области MПM-детектора составляет 0.25 эВ что приводит к добавочной компоненте фототока детектора Д2 при его освещении по сравнению с барьерным контактом диода Д1, в котором центры захвата носителей отсутствуют и в котором понижения барьера нет и, следовательно, нет и усиления фототока. Известно, что захват носителей заряда увеличивается с приложенным смещением [35]. Таким образом, сигнал отклика фотодиода Д2 растет при увеличении внешнего смещения, что ведет к квантовой эффективности детектора, превышающей ее теоретическое значение. Точный расчет усиления фототока диода Д2 требует измерить распределение плотности состояний (центров захвата) на границе раздела ZnCdSe/ZnSe и учета неоднородного пространственного распределения электрического поля в планарных поверхностно-барьерных диодных структурах [30].Значения токовой чувствительности и квантовой эффективности изготовленных детекторов Д1 и Д2 находятся в хорошем соответствии с результатами, полученными в других работах. В частности, в работе [38] ZnSe диод на барьере Шоттки работает в режиме отсутствия внутреннего усиления и на длине волны 460 нм пик сигнала фотоотклика детектора соответствует ампер-ваттной чувствительности 0.1 А/Вт и квантовой эффективности 27%. Токовая чувствительность вертикального диода Шоттки на ZnSе на длине волны 460 нм равна 0.1 А/Вт [33]. МПМ-детектор на ZnSe показал ампер-ваттную чувствительность 0.128 А/Вт и квантовую эффективность 36% на длине волны 448 нм [32], что находится в хорошем соответствии с характеристиками диода Д1. Узкополосный пик спектральной чувствительности ZnSe p–i–n-фотодиода соответствовал токовой чувствительности 0.17 А/Вт на длине волны 450 нм [22].
Вместе с тем максимальный сигнал фотоотклика MПM-диода на основе встречно-штыревых Ni-контактов к ZnO на длине волны 385 нм соответствовал ампер-ваттной чувствительности 1.6 A/Вт, а темновой ток был равен 1.04 × 10–6 A [28]. Токовая чувствительность MПM-детектора на основе гетероструктуры (Mg,Zn)O на длине волны 369 нм составила 1.8 A/Вт [12]. Сравнительно недавно планарные фотодетекторы металл–диэлектрик–полупроводник–металл, изготовленные на подложке кремний-на-изоляторе с кремниевым активным слоем n-типа, продемонстрировали рекордную чувствительность для кремниевых детекторов, 1.77 А/Вт на длине волны 405 нм [39]. Следует отметить, что во всех этих детекторах вследствие эффектов внутреннего усиления квантовая эффективность была выше теоретического значения. Таким образом, результаты, достигнутые в наших исследованиях, находятся в хорошем соответствии с результатами других авторов, а иногда их превышают.
ЗАКЛЮЧЕНИЕ
Изготовлены и исследованы МПМ-детекторы видимого излучения на ZnSe и гетеробарьерной структуре ZnCdSe/ZnSe и установлены различия в характеристиках сигнала фотоотклика и квантовой эффективности двух типов детекторов. МПМ-детектор на ZnSе реализует широкополосный отклик в диапазоне длин волн 330…465 нм с максимумом токовой чувствительности 0.14 А/Вт и квантовой эффективностью 38%. Одним из практических применений детектора может быть его использование для детектирования УФ-излучения, вредного для человека. Экспериментально установлен эффективный узкополосный спектральный отклик МПМ-детектора на основе гетероструктуры ZnCdSe/ZnSe/GaAs. Пик сигнала отклика детектора с FWHM = 4.3 нм и ампер-ваттной чувствительностью 2.27 А/Вт был измерен на длине волны 460 нм. Захват дырок на гетероинтерфейсе ZnCdSe/ZnSe приводит к уменьшению эффективной высоты барьера Шоттки при освещении обратносмещенного перехода MПM-диода, внутреннему усилению фототока детектора и увеличению квантовой эффективности. Узкополосный отклик детектора может обеспечить эффективную фильтрацию полезного входного сигнала и, как следствие, высокую помехозащищенность оптической информационно-измерительной системы.
Авторы заявляют об отсутствии конфликта интересов.
Список литературы
Monroy E., Omnes F., Calle F. // Semicond. Sci. Technol. 2003. V. 18. № 4. P. R33 and references therein.
Qin Z., Song D., Xu Zh. et al. // Organic Electronics. 2020. V. 76. P. 105417.
Metzger R.A. // Comp. semiconductors. 1996. May/June. P. 29.
Бланк Т.Б., Гольдберг Ю.А. // ФТП. 2003. Т. 37. № 9. С. 1025.
Monroy E., Munoz E., Sanchez F.J. et al. // Semicond. Sci. Technol. 1998. V. 13. № 9. P. 1042.
Parish G., Keller S., Kozodoy P. et al. // Appl. Phys. Lett. 1999. V. 75. № 2. P. 247.
Monroy E., Hamilton M., Walker D. et al. // Appl. Phys. Lett. 1999. V. 74. № 8. P. 1171.
Chen Q., Yang J.W., Osinsky A. et al. // Appl. Phys. Lett. 1997. V. 70. № 17. P. 2277.
Ozbay E., Biyikli N., Kimukin I. et al. // IEEE J. Selected Topics in Quant. Electron. 2004. V. 10. № 4. P. 742.
Аверин С.В., Кузнецов П.И., Житов В.А. и др. // РЭ. 2005. Т. 50. № 3. P. 394.
Huang Y., Chen D.J., Lu H. et al. // Appl. Phys. Lett. 2010. V. 96. № 24. P. 243503.
Zhang Z., Wenckstern H., Schmidt M., Grundmann M. // Appl. Phys. Lett. 2011. V. 99. № 8. P. 083502.
Averin S.V., Kusnetzov P.I., Zhitov V.A. et al. // Opt. Quant. Electron. 2016. V. 48. № 5. P. 303.
Hong H., Anderson W.A., Haetty J. et al. // J. Appl. Phys. 1998. V. 84. № 4. P. 2328.
Ito M., Wada M. J. // Quantum Electron. 1986. V. 22. P. 1073.
Averine S.V., Chan Y.C., Lam Y.L. // Solid-State Electron. 2001. V. 45. № 3. P. 441.
Аверин С.В., Кузнецов П.И., Житов В.И., Захаров Л.Ю. и др. // РЭ. 2021. Т. 66. № 2. С. 181.
Averin S.V., Kuznetzov P.I., Zhitov V.A. et al. // Solid- State Electron. 2015. V. 114. P. 135.
Sze S.M. Physics of Semiconductor Devices. N.Y.: Wiley-Interscience, 1981.
Schroder D.K. Semiconductor Material and Device Characterization. N.Y.: Wiley-Interscience, 1990.
Averine S., Chan Y.C., Lam Y.L. // Appl. Phys. Lett. 2000. V. 77. № 2. P. 274.
Bouhdada A., Hanzaz M., Vigue F., Faurie J.P. // Appl. Phys. Lett. 2003. V. 83. № 1. P. 171.
Corartger R., Girardin C., Beauvillain J. et al. // J. Appl. Phys. 1999. V. 81. № 12. P. 7870.
Joshi R.P., Dharamsi A.N., McAdoo J. // Appl. Phys. Lett. 1994. V. 64. № 26. P. 3611.
Sou I.K., Ma Z.H., Wong G.K.L. // Appl. Phys. Lett. 1999. V. 75. № 23. P. 3707.
Gerhard A., Nurnberger J., Schull K. // J. Crystal Growth. 1998. V. 184/185. P. 1319.
Vigue F., Tournie E., Faurie J.-P. et al. // Appl. Phys. Lett. 2001. V. 78. № 26. P. 4190.
Jandow N.N., Yam F.K., Thahab S.M. et al. // Current Appl. Phys. 2010. V. 10. № 6. P. 1452.
Redaelli L., Mukhtarova A., Valdueza-Felip S. et al. // Appl. Phys. Lett. 2014. V. 105. № 13. P. 131105.
Averin S., Sachot R., Hugi J. et al. // Appl. Phys. 1996. V. 80. № 9. P. 1553.
Sze S., Coleman D. J. Loya A. // Solid-State Electron. 1971. V. 14. № 12. P. 1209.
Lin T.K., Chan, S.J., Su Y.K. et al. // Mat. Sci. Eng.: B. 2005. V. 119. № 2. P. 202.
Monroy E., Vigue F., Galle F. et al. // Appl. Phys. Lett. 2000. V. 77. № 17. P. 2761.
Sciuto A., Roccaforte F., Di Franco S. et al. // Appl. Phys. Lett. 2007. V. 90. № 22. P. 223507.
Rhoderick E.H., Williams R.H. Metal-Semiconductor Contacts. Oxford: Claredon Press, 1988.
Katz O., Garber V., Meyler B. et al. // Appl. Phys. Lett. 2001. V. 79. № 10. P. 1417.
Liang S., Sheng H., Liu Y. et al. // J. Crystal Growth. 2001. V. 225. № 2–4. P. 110.
Vigue F., Tournie T., Faurie J.P. // Electron. Lett. 2000. V. 36. № 3. P. 252.
Mikelashvili V., Shneider Y., Sherman A. et al. // Appl. Phys. Lett. 2019. V. 114. № 7. P. 073504.
Дополнительные материалы отсутствуют.
Инструменты
Радиотехника и электроника





