Химия высоких энергий, 2022, T. 56, № 3, стр. 223-226
Кинетика травления кремния в плазме трифторметана
С. А. Пивоваренок a, *, Д. Б. Мурин a
a Ивановский государственный химико-технологический университет
153000 Иваново, просп. Шереметевский, 7, Россия
* E-mail: sap@isuct.ru
Поступила в редакцию 07.09.2021
После доработки 27.10.2021
Принята к публикации 02.11.2021
- EDN: IKFQXG
- DOI: 10.31857/S0023119322020127
Аннотация
Проведено исследование кинетики реактивно-ионного травления кремния в ВЧ-плазме CHF3. Показано, что с увеличением как мощности, вкладываемой в разряд, так и мощности смещения на подложкодержателе, процесс травления протекает в кинетическом режиме. Сделано предположение, что источниками атомарного фтора являются радикалы CF3 и фторуглеродная пленка, а доминирующим ионом является ${\text{CF}}_{3}^{ + }.$
ВВЕДЕНИЕ
Процессы ионно-плазменной обработки в вакууме обеспечивают высокий уровень решения многих технологических задач в производстве изделий электронной техники (процессы травления и нанесения материалов, создания материалов с разнообразными электрофизическими характеристиками).
Для реализации процессов реактивного ионно-плазменного травления в технологии интегральной электроники используется большая номенклатура газов и газовых смесей. Первыми плазмообразующими средами для обработки неорганических материалов были фторсодержащие газы семейства фреонов CxHyFz. Наиболее характерными представителями являются CF4, CHF3, CH2F2, которые обеспечивают приемлемые характеристики процессов травления кремния, диоксида кремния и нитрида кремния. Современная технология травления для оптимизации управления процессом и получения лучшей селективности для маскирования и защиты от травления слоев переходит на использование разрядов с более низким содержанием фтора.
В работах [1–3] было показано, что по селективности травления в системе SiO2/Si трифторметан (CHF3) существенно превосходит тетрафторметан (CF4), что обусловливает высокий интерес к изучению физико-химических свойств плазменных систем на основе CHF3.
Также известно, что если основной плазмообразующий газ разбавлять вторым газом (инертным или химически активным), то это может позволить получить дополнительные эффекты при травлении ряда материалов за счет изменения электрофизических параметров плазмы [4–6], т.е. приводить к увеличению или незначительному уменьшению скорости травления материала [7–9].
В данной работе для травления кремния в качестве плазмообразующего газа был использован трифторметан (фреон R-23, CHF3). Фреон R-23 – бесцветный газ, без запаха, инертен в химическом отношении, поэтому не горит на воздухе, невзрывоопасен даже при контакте с открытым пламенем, обладает нулевым потенциалом разрушения озонового слоя.
МЕТОДИКА ЭКСПЕРИМЕНТА
Для исследования плазмохимических процессов в условиях ВЧ-разряда (13.56 МГц, 1.25 кВт) использовалась установка “Платран-100ХТ”. Она предназначена для плазмохимического травления полупроводниковых материалов, а также металлических пленок. Установка обеспечивает возможность обработки пластин диаметром до 100 мм, а также меньших размеров толщиной от 0.3 до 2 мм.
Откачка системы производилась механическим пластинчато-роторным (Leybold BCS, производительность 30 м3/ч) и турбомолекулярным (TMP 803 LMTC, производительность 800 л/с) насосами. Контроль рабочего давления в реакторе осуществлялся баратроном с верхним пределом измерения 0.1 Торр. Измерение и контроль расхода плазмообразующего газа проводились при помощи расходомеров с верхним пределом 200 см3/мин. Фреон R-23 брали из баллона с маркой “чистый” (МРТУ 51–77–66), содержание основного газа не менее 99.985%.
В рамках данной работы варьирование внешних (задаваемых) параметров осуществлялось следующим образом: вкладываемая в разряд мощность (WRF) изменялась в интервале от 550 до 950 Вт с шагом 100 Вт; давление газа (p) составляло 2.8 мТорр; расход плазмообразующего газа CHF3 являлся величиной постоянной и составлял 40 см3/мин. Время травления (τ) изменялось от 40 до 150 с. Величины мощностей смещения (Wbias) на подложкодержателе составляли 150 и 300 Вт.
Образцы кремния вырезались из кремниевой пластины марки КЭФ–4.5 (100), которые на выходе получались квадратной формы со стороной ~1 см (площадь образца ~1 см2). До помещения в реактор поверхность образцов очищалась от масленых, пылевых и жировых загрязнений в толуоле и ацетоне.
Эмиссионные измерения были реализованы непосредственно с использованием плазмохимического реактора с помощью оптоволоконных спектрометров AvaSpec–2048–2 и AvaSpec–3648 с фотоэлектрической системой регистрации сигнала и накоплением данных на ЭВМ. Рабочий диапазон длин волн составлял 200–1000 нм. К торцевой части разрядника, содержащей кварцевое стекло, подводился световод. Он был закреплен на платформе, которая снабжена двумя микровинтами, позволяющими осуществлять вертикальную и горизонтальную юстировку световода на область разряда. Регистрация излучения осуществлялась обратно освещенным детектором с CCD матрицей (2048 элементов) с высокой чувствительностью в ультрафиолетовом (UV) диапазоне длин волн. Далее свет с детектора через оптоволоконный SMA коннектор поступал на спектрометр, а после на ЭВМ. При расшифровке спектров излучения использовались справочники [10, 11].
Определение скоростей травления проводилось гравиметрическим методом: путем взвешивания образцов до и после обработки на аналитических весах WA-34 с точностью ±5 × 10–5 г.
РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
В технологии микро- и наноэлектроники фреоны могут использоваться как среды для “сухого” плазмохимического травления ряда материалов, поскольку являются источниками химически активных частиц. Например, фреон R-23 при разложении образует химически активные радикалы (CF3, CF2, CF и т.д.) и свободные атомы (F, H) (табл. 1). Атомы фтора являются основными химически активными частицами, обеспечивающими взаимодействие плазмы фреона с обрабатываемой поверхностью.
Таблица 1.
Пороговые энергии диссоциации CHF3 под действием электронного удара
| № | Реакция | ε, эВ |
|---|---|---|
| 1 | CHF3 + e → CF3 + H + e | 4.5 |
| 2 | CHF3 + e → CHF2 + F + e | 6.9 |
| 3 | CHF3 + e → CF + H + 2F + e | 13.3 |
| 4 | CHF2 + e → CHF + F + e | 4.8 |
| 5 | CHF2 + e → CF2 + H + e | 2.7 |
| 6 | CHF + e → CF + H + e | 3.3 |
| 7 | CHF + e → C + H + F + e | 8.9 |
| 8 | CF3 + e → CF2 + F + e | 3.8 |
| 9 | CF3 + e → CF + 2F + e | 9.2 |
| 10 | CF2 + e → CF + F + e | 5.4 |
| 11 | CF2 + e → C + 2F + e | 11 |
| 12 | CF + e → C + F + e | 5.6 |
| 13 | HF + e → H + F + e | 5.9 |
Известно, что во фторуглеродной плазме возможен процесс полимеризации, в результате чего на поверхности обрабатываемого материала формируется полимерная пленка, которая способна остановить процесс травления материала. Параметр F/C характеризует отношение числа атомов фтора к числу атомов углерода в исходной молекуле, тем самым определяет соотношение концентраций F/CFx в газовой фазе и говорит о том, какой из процессов (травление или полимеризация) будет доминировать. Из табл. 1 видно, что соотношение F/CFx невелико, а также, учитывая, что в качестве основной частицы, которая будет образовывать полимерную структуру, следует рассматривать радикал CF2, можно ожидать высокую вероятность образования полимерной пленки на поверхности образца [12, 13].
На рис. 1 и 2 представлены кинетические зависимости скорости травления кремния и относительной интенсивности излучения SiF в плазме CHF3, характер изменения которых в пределах погрешности измерений является линейным (хотя на начальном этапе присутствовал небольшой индукционный период ~40 с), что свидетельствует о стационарном режиме протекания процесса травления. Данный факт может быть обусловлен следующим:
Рис. 1.
Кинетические зависимости скорости травления кремния в ВЧ-плазме CHF3 (p = 2.8 мТорр, WRF = 950 Вт: 1 – Wbias = 150 Вт; 2 – Wbias = 300 Вт).

Рис. 2.
Кинетические зависимости относительной интенсивности излучения SiF (336.3 нм) при травлении кремния в ВЧ-плазме CHF3 (p = 2.8 мТорр, WRF = 950 Вт: 1 – Wbias = 150 Вт; 2 – Wbias = 300 Вт).

1) индукционный период, по нашему мнению, обусловлен деструкцией пассивирующей оксидной пленки c образованием летучих соединений вида SiF4 за счет процессов химического взаимодействия пленки SiO2 с радикалами CFx (где x = 1–3) (табл. 1) и ионной бомбардировки поверхности образца (табл. 2):
(1)
${\text{Si}}{{{\text{O}}}_{2}} + {\text{C}}{{{\text{F}}}_{x}} \to {\text{Si}}{{{\text{F}}}_{4}} + ({\text{CO,}}\,\,{\text{C}}{{{\text{O}}}_{{\text{2}}}}{\text{,}}\,\,{\text{CO}}{{{\text{F}}}_{2}});$Таблица 2.
Пороговые энергии ионизации CHF3 под действием электронного удара
| № | Реакция | ε, эВ |
|---|---|---|
| 1 | CHF3 + e → ${\text{CF}}_{3}^{ + }$ + H + 2e | 13.8 |
| 2 | CHF3 + e → ${\text{CHF}}_{2}^{ + }$ + F + 2e | 16.8 |
| 3 | CHF3 + e → CHF+ + 2F + 2e | 19.8 |
| 4 | CHF3 + e → CF+ + H + 2F + 2e | 21.4 |
| 5 | CHF2 + e → ${\text{CHF}}_{2}^{ + }$ + 2e | 3.8 |
| 6 | CHF2 + e → CHF+ + F + 2e | 14.3 |
| 7 | CHF2 + e → CF+ + H + F + 2e | 14.6 |
| 8 | CHF2 + e → ${\text{CF}}_{2}^{ + }$ + H + 2e | 17.2 |
| 9 | CHF + e → CHF+ + 2e | 9.6 |
| 10 | CHF + e → CF+ + H + 2e | 10 |
| 11 | CF3 + e → ${\text{CF}}_{3}^{ + }$ + 2e | 10 |
| 12 | CF3 + e → ${\text{CF}}_{2}^{ + }$ + F + 2e | 17.1 |
| 13 | CF3 + e → CF+ + 2F + 2e | 21.4 |
2) после удаления оксидной пленки происходит химическое и физическое взаимодействие активных частиц плазмы с поверхностью кремния. Исходная молекула CHF3 при диссоциации в плазме под действием электронного удара образует активные частицы, такие как CFx (где x = 1–3) (табл. 1). Концентрация частиц CF3 будет относительно высокой при различных мощностях источника плазмы, поскольку связь C–H слабее, чем связь C–F [12] (см. табл. 1 реакции (1) и (2)), поэтому атомы фтора на поверхность кремния будут поступать в виде фторуглеродных радикалов CF3 (индекс g – газообразное состояние, s – адсорбированное состояние):
(2)
${\text{CH}}{{{\text{F}}}_{{\text{3}}}}({\text{g}}) + {\text{e}} \to {\text{C}}{{{\text{F}}}_{3}}({\text{g}}) + {\text{H}}({\text{g}}) + {\text{e}};$(3)
${\text{C}}{{{\text{F}}}_{3}}{\text{(g}}) + {\text{Si}} \to {\text{C}}{{{\text{F}}}_{3}}({\text{s}}) + {\text{Si}};$(4)
${\text{C}}{{{\text{F}}}_{3}}{\text{(s}}) + {\text{Si}} \to 3{\text{F(s)}} + {\text{Si}} + {\text{C(s}});$Параллельно с химическим взаимодействием будет происходить ионная бомбардировка поверхности образца. Согласно данным работы [12] и табл. 2 (реакции (1) и (11)) можно сделать предположение, что основными ионами в газовой фазе будут ${\text{CF}}_{3}^{ + }.$ При мощностях смещения 150 и 300 Вт ионы приобретают достаточную энергию для удаления полимерной пленки/продуктов взаимодействия с поверхности, в результате чего процесс травления не прекращался, и убыль массы образца от времени обработки имела линейную зависимость. В работе [14] авторы делают вывод о том, что существует корреляция между скоростью травления подложки и толщиной фторуглеродной пленки при изменении смещения на подложкодержателе. С увеличением смещения происходит рост как дефторирования пленки, так и скорости травления, что говорит о том, что фтор из фторуглеродной пленки используется для травления кремния.
На рис. 3 представлены зависимости скорости травления кремния от мощности, вкладываемой в разряд. Вид зависимостей носит линейный характер, так как скорость травления зависит как от мощности, вкладываемой в разряд (WRF), так и от мощности смещения на подложкодержателе (Wbias). Первая определяет концентрацию активных частиц в плазме, а вторая генерирует кинетическую энергию активных частиц.
Рис. 3.
Зависимости скорости травления кремния в плазме CHF3 от мощности, вкладываемой в разряд (p = 2.8 мТорр, τ = 60 с: 1 – Wbias = 150 Вт; 2 – Wbias = = 300 Вт).
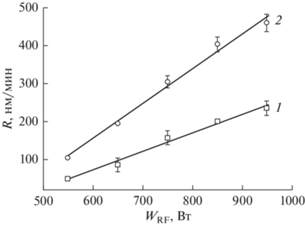
Концентрация активных частиц плазмы (CF3, F) увеличивается с увеличением мощности, вкладываемой в разряд, за счет диссоциации молекул плазмообразующего газа (например, процесс (2)), которые имеют малую вероятность адсорбции на поверхности материала, что приведет к увеличению скорости травления материала. Ионная бомбардировка частицами с большой кинетической энергией $\left( {{\text{CF}}_{3}^{ + }} \right)$ делает обрабатываемую поверхность более активной за счет разрыва связей поверхностных атомов (а также распыления фторуглеродной пленки) и, тем самым, увеличивает хемосорбцию активных частиц плазмы, ускоряя поверхностные реакции, участвующие в процессе травления, и, соответственно, увеличивает скорость травления (процессы (3)–(6)).
ЗАКЛЮЧЕНИЕ
Проведено экспериментальное исследование кинетики реактивно-ионного травления кремния в ВЧ-плазме CHF3. Сделано предположение, что основным источником атомарного фтора являются радикалы CF3 и фторуглеродная пленка, а доминирующим ионом является ${\text{CF}}_{3}^{ + }.$ В ходе экспериментального исследования было выявлено, что кинетические зависимости носят линейный характер, что свидетельствует о стационарном режиме протекания процесса травления кремния. На начальном этапе процесса травления наблюдался индукционный период, который связан, на наш взгляд, с удалением естественного оксида на поверхности кремния посредством фторуглеродных радикалов и ионной бомбардировки. После удаления данного оксида при химическом и физическом взаимодействии активных частиц плазмы с кремнием на поверхности образовывались летучие соединения вида SiF4, что приводило к интенсивной газификации продуктов взаимодействия с обрабатываемой поверхности.
Список литературы
Yeom G.Y., Kushner M.J. // Appl. Phys. Lett. 1990. V. 56. P. 857.
Rossnagel S.M., Cuomo J.J., Westwood W.D. (Eds.). Handbook of plasma processing technology. Noyes Publications, Park Ridge, 1990. 338 p.
Gaboriau F., Cartry G., Peignon M.-C., Cardinaud Ch. // J. Vac. Sci. Technol. B. 2002. V. 20. P. 1514.
Pivovarenok S.A., Bakshina P.I. // High Energy Chemistry. 2021. V. 55. № 3. P. 233.
Мурин Д.Б., Ефремов А.М., Светцов В.И., Пивоваренок С.А., Овцын А.А., Шабадаров С.С. // Известия высших учебных заведений. Серия: Химия и химическая технология. 2013. Т. 56. № 4. С. 29.
Мурин Д.Б., Ефремов А.М., Светцов В.И., Пивоваренок С.А., Годнев Е.М. // Известия высших учебных заведений. Серия: Химия и химическая технология. 2013. Т. 56. № 8. С. 41.
Пивоваренок С.А., Королькова К.А. // Сборник тезисов докладов на III Всероссийской молодежной конференции “Успехи химической физики”. М.: Издательство “Граница”, 2016. С. 124.
Пивоваренок С.А. // Микроэлектроника. 2017. Т. 46. № 3. С. 231.
Пивоваренок С.А. // Микроэлектроника. 2019. Т. 48. № 4. С. 279.
Пирс Р., Гейдон А. Отождествление молекулярных спектров. М.: Изд. иностр. лит, 1949. 540 с.
Свентицкий А.Р., Стриганов Н.С. Таблицы спектральных линий нейтральных и ионизованных атомов. М.: Атомиздат, 1966. 900 с.
Weichao Wang, Pil-Ryung Cha, Sang ho Lee, Gyoodong Kim, Moon J. Kim, Kyeongjae Cho // Applied Surface Science. 2011. V. 257. P. 8767.
Anand J. Bariya, Hongqing Shan, Curtis W. Frank, Sidney A. Self and James P. McVittie // J. Vac. Sci. Technol. B. 1991. V. 9. № 1. P. 1.
Standaert T.E.F.M., Hedlund C., Joseph E.A., Oehrlein G.S. // J. Vac. Sci. Technol. A. 2004. V. 22. № 1. P. 53.
Дополнительные материалы отсутствуют.
Инструменты
Химия высоких энергий


