Поверхность. Рентгеновские, синхротронные и нейтронные исследования, 2019, № 8, стр. 64-70
Особенности формирования изображений в РЭМ в режиме вторичных медленных электронов. 1. Структуры с большими углами наклона боковых стенок
Ю. А. Новиков *
Институт общей физики им. А.М. Прохорова РАН
119991 Москва, Россия
* E-mail: nya@kapella.gpi.ru
Поступила в редакцию 04.12.2018
После доработки 22.01.2019
Принята к публикации 24.02.2019
Аннотация
Проведено исследование формирования изображений кремниевых микроструктур в растровом электронном микроскопе, работающем в режимах сбора вторичных медленных и обратно рассеянных электронов. В качестве исследуемого объекта использовался тест-объект МШПС-2.0К. Тест-объект состоит из шаговых структур (выступов и канавок в кремнии), профиль которых имеет трапециевидную форму с большими углами наклонов боковых стенок. Показано, что сигнал вторичных медленных электронов формируется по-разному на рельефной и безрельефной поверхностях. В то же время сигнал обратно рассеянных электронов формируется одинаковым образом на рельефной и безрельефной поверхностях.
ВВЕДЕНИЕ
Развитие нанотехнологии требует наличия разных методов диагностики нанообъектов и наноструктур. Среди таких методов выделяется растровая электронная микроскопия. Это связано с тем, что растровый электронный микроскоп (РЭМ) определяет главные характеристики наноструктур и наноматериалов – форму и размеры элементов рельефа поверхности (например, [1–6]). Для измерения этих параметров в РЭМ были разработаны тест-объекты [7–12] для калибровки РЭМ и сами методы калибровки РЭМ [7, 13–15], доведенные до российских национальных стандартов (ГОСТ Р) [16, 17]. Созданы методы измерения линейных размеров [7, 10, 18–24] в микрометровом (1–1000 мкм) и нанометровом (1–1000 нм) диапазонах, обеспеченных прослеживаемостью измерений от Первичного эталона длины (метра) до измеряемого размера [23, 24]. Не последней причиной является наличие высококачественных растровых электронных микроскопов высокого разрешения [25, 26], на которых реализовано большое количество [1, 6] современных методов нанодиагностики.
Растровые электронные микроскопы могут работать в нескольких диапазонах энергий электронов зонда: низковольтном (НВ) при энергии электронов E ≤ 2 кэВ и двух высоковольтных (E > > 2 кэВ) при регистрации вторичных медленных электронов (ВМЭ) и обратно рассеянных электронов (ОРЭ). В настоящее время широкое распространение получили низковольтный режим и высоковольтный режим при регистрации ВМЭ [7–26]. Это связано с тем, что именно для этих режимов разработаны методы калибровки РЭМ и измерения на нем линейных размеров микро- и наноструктур. Режим регистрации обратно рассеянных электронов не получил широкого распространения из-за трудностей, связанных со слабой изученностью механизмов формирования изображения в режиме ОРЭ [27, 29].
В последнее время удалось решить эти проблемы и создать хорошо работающую модель формирования РЭМ-изображений в режиме сбора обратно рассеянных электронов [30, 34]. Однако это поставило новые вопросы уже для режима регистрации вторичных медленных электронов.
Настоящая работа посвящена особенностям формирования ВМЭ-изображений, обусловленных результатами работ [30, 34], и связи этих особенностей с положениями, изложенными в работе [1].
МОДЕЛИ ФОРМИРОВАНИЯ РЭМ-ИЗОБРАЖЕНИЙ
В работе [1] утверждается, что в сигнал вторичных медленных электронов дают вклад медленные электроны двух сортов, образованные первичными электронами и обратно рассеянными электронами. В работах [35–37] было показано экспериментально, что сигнал вторичных медленных электронов VSSE формируется двумя сигналами: сигналом VBSE, полученным в результате регистрации обратно рассеянных электронов, и сигналом VLE, полученным в низковольтном режиме работы РЭМ,
(1)
${{V}_{{{\text{SSE}}}}}\left( t \right) = {{A}_{{{\text{BSE}}}}}{{V}_{{{\text{BSE}}}}}\left( t \right) + {{A}_{{{\text{LE}}}}}{{V}_{{{\text{LE}}}}}\left( t \right).$В работе [34] описана модель формирования изображения в режиме регистрации обратно рассеянных электронов. Согласно этой модели вклад в ОРЭ сигнал дают четыре механизма формирования изображения:
(2)
${{V}_{{{\text{BSE}}}}}\left( t \right) = {{A}_{1}}{{V}_{1}}\left( t \right) + {{A}_{2}}{{V}_{2}}\left( t \right) + {{A}_{3}}{{V}_{3}}\left( t \right) - {{A}_{4}}{{V}_{4}}\left( t \right),$(3)
${{V}_{i}}\left( t \right) = \int\limits_{ - \infty }^\infty {S\left( {x,y} \right){{F}_{i}}\left( {x,y,t} \right)dxdy} .$(4)
${{F}_{i}}\left( {x,y,t} \right) = \frac{1}{{d_{i}^{2}}}\exp \left( { - \frac{{{{{\left( {x - t} \right)}}^{2}} + {{y}^{2}}}}{{{{d_{i}^{2}} \mathord{\left/ {\vphantom {{d_{i}^{2}} \pi }} \right. \kern-0em} \pi }}}} \right),$Для структур с трапециевидным профилем и большими углами наклона боковых стенок [7, 10–12], выполненных из дырочного кремния [33, 34], вклад в ОРЭ-сигнал дают только первый и четвертый механизмы [33, 34]:
(5)
${{V}_{{{\text{BSE}}}}}\left( t \right) = {{A}_{1}}{{V}_{1}}\left( t \right) - {{A}_{4}}{{V}_{4}}\left( t \right).$Если элемент рельефа (выступ или канавка) находится в середине рельефной структуры, то в этом случае A4 = 0 [33, 34] и ОРЭ сигнал формируется только за счет первого механизма:
Моделирование низковольтного сигнала VLE(t) осуществляется в соответствии с моделью, представленной в работах [35, 36]. В этом случае НВ сигнал можно описать выражением:
(7)
${{V}_{{{\text{LE}}}}}\left( t \right) = \int\limits_{ - \infty }^\infty {\left| {gradS\left( {x,y} \right)} \right|F\left( {x,y,t} \right)dxdy} ,$На рис. 1а приведены модельные ВМЭ, ОРЭ и НВ-сигналы для выступа с трапециевидным профилем и большими углами наклона боковых стенок, выполненного из дырочного кремния, которые описываются формулами (3), (4), (6) и (7). При этом модельный ВМЭ-сигнал был получен суммированием сигналов ОРЭ и НВ при равенстве их вкладов в ВМЭ-сигнал.
Рис. 1.
Модельные (а) и реальные (б) ВМЭ, ОРЭ и НВ-сигналы (1, 2 и 3 соответственно), полученные при сканировании выступа тест-объекта МШПС-2.0К и его модельного аналога.
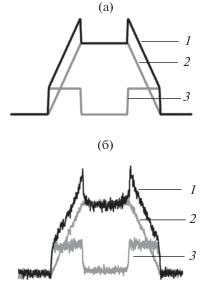
Рис. 1б демонстрирует реальные ВМЭ, ОРЭ и НВ-сигналы, полученные при сканировании на РЭМ S-4800 выступа тест-объекта МШПС-2.0К, лежащего в середине шаговой структуры. Сигналы отнормированы и наложены друг на друга. Хорошо видно, что реальные ВМЭ, ОРЭ и НВ-сигналы подтверждают выражение (1), а модельные сигналы (3), (4), (6) и (7) правильно описывают реальные сигналы.
ЭКСПЕРИМЕНТАЛЬНАЯ АППАРАТУРА И ИССЛЕДУЕМЫЕ ОБЪЕКТЫ
Наибольшее применение растровая электронная микроскопия получила в микро- и наноэлектронике [2–5], в которых профиль рельефа объектов имеет форму трапеции с большими и малыми углами наклона боковых стенок. Кроме того, структуры с большими углами наклона боковых стенок применяются в качестве тест-объектов – объектов, параметры которых хорошо известны, в том числе и из альтернативных источников.
Для того чтобы структура с трапециевидным профилем считалась структурой с большими углами φ наклона боковых стенок [40], необходимо выполнить условие:
где d – диаметр электронного зонда РЭМ [38, 39], h – глубина канавки. Однако более удобно пользоваться другим условием: которое указывает, что диаметр d зонда РЭМ много меньше проекции s боковой наклонной стенки структуры.В качестве структур с трапециевидным профилем и большими углами наклона боковых стенок будем рассматривать элементы тест-объекта МШПС-2.0К, представляющие собой шаговые структуры, состоящие из выступов и канавок в кремнии. Этот тест-объект используется для калибровки РЭМ [7, 8, 10–15, 23, 24], работающих в режиме сбора вторичных медленных электронов и низковольтном режиме [41]. Аттестация тест-объекта МШПС-2.0К была осуществлена на электронно-оптической метрологической системе [42] в Физико-техническом институте Германии (Physikalisch-Technische Bundesanstalt) с помощью интерференции лазерного излучения. При номинальной величине шага 2000 нм аттестованное значение шага составило 2001 ± 1 нм. Кроме того, тест-объект МШПС-2.0К прошел международные сличения [43].
Тест-объект МШПС-2.0К состоит из 15 шаговых структур, каждая из которых представляет собой 11 канавок в кремнии. Канавки имеют трапециевидный профиль с большими углами наклона боковых стенок. Подробное описание этого тест-объекта приведено в работах [7, 8, 10–12].
На рис. 2 показаны ОРЭ (рис. 2а) и ВМЭ (рис. 2б) изображения пятого и шестого выступов и канавки между ними центральной шаговой структуры тест-объекта МШПС-2.0К. Именно в этом месте аттестуется размер шага структуры [11, 12]. Сигналы, приведенные на рис. 1б, соответствуют 5-ому выступу шаговой структуры.
Рис. 2.
ОРЭ (а) и ВМЭ (б) изображения шага, состоящего из двух выступов и канавки между ними, шаговой структуры тест-объекта.
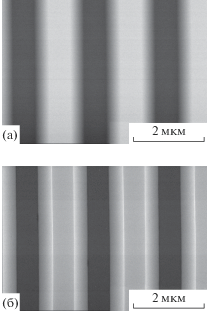
Эксперименты проводились в РЭМ S-4800 при энергии электронов зонда 20 кэВ. Размер изображений 2560 × 1920 pix. Калибровка РЭМ [7, 8, 10–12] осуществлялась с помощью самого тест-объекта по методу, изложенному в работах [7, 8, 10]. Она дала размер пикселя m = 2.250 ± ± 0.002 нм/pix (значение размера пикселя, представленное фирмой изготовителем РЭМ, было равно 2.254972), диаметр электронного зонда d = = 15 ± 2 нм и величину проекции боковой наклонной стенки s = 395 нм при стандартном отклонении σ = 2 нм. Видно, что неравенство (9) хорошо выполняется и элементы данной структуры (выступы и канавки) являются структурами с большими углами наклона боковых стенок.
ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
На рис. 3б приведены ОРЭ- и ВМЭ-сигналы (1 и 2 соответственно), из которых состоят изображения, показанные на рис. 2. Сигналы нормированы и наложены друг на друга. Нормировка сигналов необходима в связи с тем, что изображения в РЭМ получаются в режиме автоконтраста, и, поэтому, реальная амплитуда сигналов неизвестна. Видно, что ВМЭ-сигнал состоит из двух сигналов: ОРЭ-сигнала и сигнала, похожего на сигнал низковольтного РЭМ [35] (рис. 1б). Это подтверждает правильность выражения (1). Но это в центре шаговой структуры.
В работах [33, 34] было показано, что модель формирования ОРЭ-сигнала (5) хорошо описывает реальные ОРЭ-сигналы как в центре шаговой структуры, так и на ее краях. В то же время НВ-сигналы [35, 36] не зависят (7) от положения рельефного элемента в шаговой структуре. Поэтому, в силу (1) модельные ВМЭ-сигналы должны хорошо описывать реальные ВМЭ-сигналы как в центре шаговой структуры, так и на ее краю.
На рис. 4 приведены ОРЭ (рис. 4а) и ВМЭ (рис. 4б) изображения концевых участков шаговой структуры тест-объекта МШПС-2.0К. На каждом изображении указаны положения двух сигналов, используемых для анализа. Сигналы 1 на рис. 5а, б соответствуют сканированию электронным зондом области около конца шаговой структуры [33, 34]. При этом сам электронный зонд РЭМ не задевает шаговую структуру, а область многократного рассеяния (ОМР) электронов зонда сканирует шаговую структуру. Согласно работам [33, 34], размер ОМР значительно больше величины шага структуры, поэтому на сигналах 1 (рис. 5) не видны элементы шаговой структуры, как для ОРЭ-сигнала (рис. 5а), так и для ВМЭ-сигнала (рис. 5б). Сигналы 2 на рис. 5а, б соответствуют сканированию электронным зондом шаговой структуры далеко от ее конца [33, 34]. При этом сканирование рельефа осуществляется как зондом первичных электронов, так и областью многократного рассеяния. В обоих случаях (ОРЭ и ВМЭ) сигналы 1 и 2 отнормированы и наложены друг на друга соответственно для ОРЭ (рис.5а) и ВМЭ (рис. 5б). Видно, что сигналы 1 являются фоном для сигналов 2, как в случае ОРЭ, так и в случае ВМЭ. Уровень фона в обоих случаях соответствует верху сигналов как в центре шаговой структуры, так и в области краев структуры. Причем совпадение происходит как справа, так и слева от границ структуры.
Рис. 4.
Изображения концевого участка шаговой структуры тест-объекта в РЭМ, работающего в режимах сбора ОРЭ (а) и ВМЭ (б), на которых указаны положения сигналов (1 и 2), используемых для анализа.
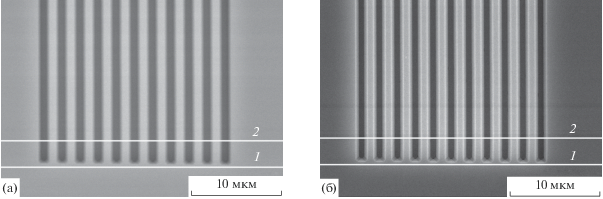
Рис. 5.
ОРЭ (а) и ВМЭ (б) сигналы, наложенные друг на друга, которые получены при сканировании канавок шаговой структуры тест-объекта в положениях 1 и 2 на рис. 4.

На рис. 6 показаны отнормированные и наложенные друг на друга ОРЭ и ВМЭ- сигналы. При этом сигналы на рис. 6а взяты в положениях 1 на рис. 4, а на рис. 6б показаны сигналы, взятые в положениях 2 на рис. 4. Видно, что ОРЭ и ВМЭ-сигналы (рис. 6а), полученные при сканировании канавок электронами из области многократного рассеяния, в пределах шумов совпадают.
Рис. 6.
ОРЭ и ВМЭ сигналы (1 и 2 соответственно), наложенные друг на друга, которые получены при сканировании канавок шаговой структуры тест-объекта в положениях 1 (а) и 2 (б) на рис. 4.

Однако для ОРЭ и ВМЭ-сигналов, представленных на рис. 6б (эти сигналы получены сканированием как зондом первичных электронов, так и электронами из области многократного рассеяния), ситуация совсем другая. Сигналы делятся на две части. Первая часть соответствует рельефу шаговой структуры. Здесь верхняя часть ОРЭ и ВМЭ-сигналов от выступов и нижняя часть сигналов от канавок совпадают, как это происходит с сигналами, показанными на рис. 3, причем даже там, где сигналы искажаются за счет их близости к краю рельефа. Вторая часть соответствует той части структуры, где рельеф отсутствует. В этой области сигналов совпадений нет. ОРЭ и ВМЭ-сигналы различаются очень сильно. Отметим, что на рис. 6а различий не наблюдаются. Хотя на сигналах, представленных на рис. 6а, очень большой шум и трудно делать какие-либо заключения.
Для решения возникшей проблемы были получены ОРЭ (рис. 7а) и ВМЭ (рис. 7б) изображения в области начала шаговой структуры (область без рельефа, первая и вторая канавки, первый выступ). Сигналы, из которых состоят эти изображения, приведены на рис. 8б. На эти сигналы наложены модельные сигналы, полученные с помощью полуэмпирической модели [36]. Параметры структуры, используемые при моделировании, и параметры самого моделирования приведены в табл. 1 и 2. В модельный ОРЭ-сигнал дают вклады только первый и четвертый механизмы (выражение (5)) формирования ОРЭ-изображения. Более подробно об этом написано в работах [33, 34].
Рис. 7.
ОРЭ (а) и ВМЭ (б) изображения крайних канавки и выступа (первая и вторая канавки и первый выступ) шаговой структуры тест-объекта.
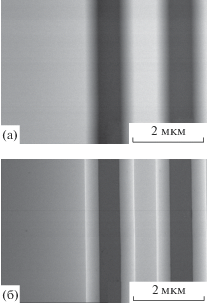
Рис. 8.
ОРЭ (а) и ВМЭ (б) сигналы, из которых состоят изображения на рис. 7, и наложенные на них модельные сигналы.
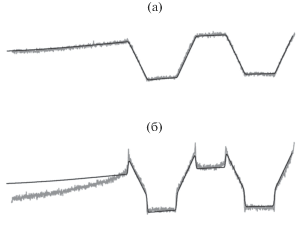
Таблица 1.
Параметры структур для модельного описания экспериментальных сигналов на рис. 8
| Элемент | Параметр | Размер |
|---|---|---|
| 1-я канавка | Верх, нм | 1396 |
| Низ, нм | 606 | |
| 1-й выступ | Верх, нм | 611 |
| Низ, нм | 1401 | |
| 2-я канавка | Верх, нм | 1396 |
| Низ, нм | 606 | |
| s, нм | 395 | |
| h, нм | 559 |
Таблица 2.
Параметры моделирования для описания экспериментальных сигналов на рис. 8
| Параметр | ОРЭ | НВ |
|---|---|---|
| ABSE, LE, % | 65 | 35 |
| d1, нм | 30 | 30 |
| d4, нм | 4500 | – |
| A1, % | 50 | – |
| A4, % | 50 | – |
Хорошо видно, что для ОРЭ-сигналов совпадение идеальное. В то же время для ВМЭ сигналов хорошее совпадение осуществляется только в области рельефа. В области, где нет рельефа, сигналы существенно различаются. Это совпадает с результатами, представленными на рис. 6б.
Отнормируем реальные ОРЭ и ВМЭ-сигналы, из которых состоят изображения, показанные на рис. 7, и наложим их друг на друга так же, как это было сделано на рис. 3. Наблюдается совпадение сигналов в области верха и низа элементов рельефа. Полученный результат представлен на рис. 9а, 9б. Хорошо видно, что в области трапециевидного рельефа (справа от стрелки, которая указывает границу рельефа) результат такой же, как и на рис. 3: выражение (1) хорошо выполняется даже на границе рельефа, где сигналы искажаются. В то же время, слева от стрелки (в этой области нет рельефа) выражение (1) не выполняется.
Рис. 9.
ОРЭ и ВМЭ-сигналы (1 и 2 соответственно), полученные при сканировании одного и того же места шаговой структуры тест-объекта, изображения которых показаны на рис. 7, при разных нормировках сигналов: а – нормировка по рельефу, б – нормировка по безрельефной поверхности.
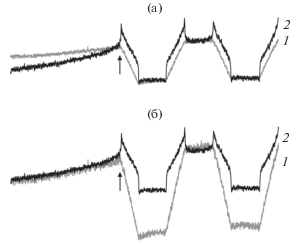
Сделаем другую нормировку сигналов: таким образом, чтобы сигналы по возможности совпадали слева от стрелки. Этот результат представлен на рис. 9б. Хорошо видно, что совпадение ВМЭ и ОРЭ-сигналов слева от стрелки очень хорошее. В то же время справа от стрелки сигналы сильно различаются. Однако оба сигнала совпадают в области верха выступов. Как было показано в работах [33, 34], ОРЭ-сигнал в области верха выступа соответствует уровню фона ОРЭ сигнала при работе по рельефу.
Таким образом, ВМЭ сигнал состоит из двух областей: там, где есть рельеф, и там, где нет рельефа. Причем граница перехода очень мала: не более размера зонда первичных электронов. Такие свойства ОРЭ и ВМЭ-сигналов указывают на то, что выражение (1) выполняется для сигналов и справа и слева от стрелки, но, по-видимому, вклады ABSE и ALE сигналов справа и слева от стрелки разные. И этот переход очень резкий. Можно предположить, что есть еще, по крайней мере, один механизм формирования ВМЭ-изображения, отличный от представленных в выражении (1). Необходимы дальнейшие исследования.
ЗАКЛЮЧЕНИЕ
Представлены результаты исследования формирования изображений канавок в кремнии, имеющих трапециевидный профиль, и большие углы наклона боковых стенок, в РЭМ, работающем в режимах сбора вторичных медленных и обратно рассеянных электронов. Показано, что формирование ВМЭ-сигналов осуществляется по-разному на рельефной и безрельефной поверхностях.
Список литературы
Reimer L. Scanning electron microscopy: physics of image formation and microanalysis / Ed. Springer-Verlag. Berlin, Heidelberg, N.Y. 1998.
Marchman H.M., Griffith J.E., Guo J.Z.Y., Frackoviak J., Celler G.K. // J. Vac. Sci. Technol. 1994. V. B12. № 6. P. 3585.
Новиков Ю.А., Раков А.В. // Микроэлектроника. 1996. Т. 25. № 6. С. 417.
Новиков Ю.А., Раков А.В. // Измерительная техника. 1999. № 1. С. 14.
Postek M.T., Vladar A.E. Critical Dimension Metrology and the Scanning Electron Microscope. / Handbook of Silicon Semiconductor Metrology. Ed. A.C. Diebold. Marcel Dekker Inc. N.Y. – Basel. 2001. P. 295.
Растровая электронная микроскопия для нанотехнологий. Методы и применение / Под ред. Жу У. и Уанга Ж.Л. Пер. с англ. М.: БИНОМ. Лаборатория знаний. 2013. 582 с.
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Прохоров А.М., Раков А.В. // Микроэлектроника. 2002. Т. 31. № 4. С. 243.
Novikov Yu.A., Gavrilenko V.P., Rakov A.V., Todua P.A. // Proc. SPIE. 2008. V. 7042. P. 704208-1. https://doi.org/10.1117/12.794834
Gavrilenko V.P., Mityukhlyaev V.B., Novikov Yu.A., Ozerin Yu.V., Rakov A.V., Todua P.A. // Measurement science and technology. 2009. V. 20. P. 20. https://doi.org/10.1088/0957-0233/20/8/084022
Frase C.G., Hassler-Grohne W., Dai G., Bosse H., Novikov Yu.A., Rakov A.V. // Measurement science and technology. 2007. V. 18. P. 439. https://doi.org/10.1088/0957-0233/18/2/S16
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2017. Т. 46. № 11. С. 77. https://doi.org/10.7868/S0207352817110105
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2018. № 12. С. 86.
Новиков Ю.А., Стеколин И.Ю. // Труды ИОФАН. 1995. Т. 49. С. 41.
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Озерин Ю.В., Плотников Ю.И., Раков А.В. // Микроэлектроника. 2004. Т. 33. № 6. С. 419.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A., Volk Ch.P. // Proc. SPIE. 2009. V. 7272. P. 72720Z. https://doi.org/10.1117/12.813514
Гавриленко В.П., Лесновский Е.Н., Новиков Ю.А., Раков А.В., Тодуа П.А., Филиппов М.Н. // Известия РАН. Серия Физическая. 2009. Т. 73. № 4. С. 454.
Gavrilenko V.P., Filippov M.N., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7378. P. 737812. https://doi.org/10.1117/12.821760
Gavrilenko V.P., Kalnov V.A., Novikov Yu.A., Orlikovsky A.A., Rakov A.V., Todua P.A., Valiev K.A., Zhikharev E.N. // Proc. SPIE. 2009. V. 7272. P. 727227. https://doi.org/10.1117/12.814062
Данилова М.А., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Тодуа П.А. // Измерительная техника. 2008. № 8. С. 20.
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Известия РАН. Серия Физическая. 1998. Т. 62. № 3. С. 543.
Filippov M.N., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2010. V. 7521. P. 752116-1. https://doi.org/10.1117/12.854696
Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2006. V. 6260. P. 626015. https://doi.org/10.1117/12.683401
Гавриленко В., Новиков Ю., Раков А., Тодуа П. // Наноиндустрия. 2009. № 4. С. 36.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2009. V. 7405. P. 740504. https://doi.org/10.1117/12.826164
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2013. № 5. С. 105. https://doi.org/10.7868/S0207352813050107
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2013. № 8. С. 105. https://doi.org/10.7868/S0207352813080131
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Труды ИОФАН. 1998. Т. 55. С. 100.
Новиков Ю.А., Раков А.В., Филиппов М.Н. // Известия вузов. Электроника. 1998. № 1. С. 91.
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2011. № 10. С. 5.
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2014. № 8. С. 46. https://doi.org/10.7868/S0207352814080101
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 5. С. 78. https://doi.org/10.7868/S0207352815050091
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2015. № 10. С. 59. https://doi.org/10.7868/S0207352815100170
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2016. № 2. С. 66. https://doi.org/10.7868/S0207352816020086
Новиков Ю.А. // Поверхность. Рентген., синхротр. и нейтрон. исслед. 2016. № 9. С. 12. https://doi.org/10.7868/S0207352816090110
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 4. С. 263. https://doi.org/10.7868/S0544126914040073
Новиков Ю.А. // Микроэлектроника. 2014. Т. 43. № 6. С. 456-467. https://doi.org/10.7868/S0544126914060076
Новиков Ю.А. // Микроэлектроника. 2015. Т. 44. № 4. С. 306. https://doi.org/10.7868/S0544126915030072
Волк Ч.П., Горнев Е.С., Новиков Ю.А., Плотников Ю.И., Раков А.В., Тодуа П.А. // Труды ИОФАН. 2006. Т. 62. С. 77.
Gavrilenko V.P., Novikov Yu.A., Rakov A.V., Todua P.A. // Proc. SPIE. 2008. V. 7042. P. 70420C. https://doi.org/10.1117/12.794891
Новиков Ю.А., Раков А.В., Тодуа П.А. // Измерительная техника. 2009. № 2. С. 22.
Волк Ч.П., Новиков Ю.А., Раков А.В., Тодуа П.А. // Измерительная техника. 2009. № 1. С. 15.
Haessler-Grohne W., Bosse H. // Measurement Science and Technology. 1998. V. 9. P. 1120.
Волк Ч.П., Горнев Е.С., Календин В.В., Митюхляев В.Б., Новиков Ю.А., Озерин Ю.В., Раков А.В., Bosse H., Frase C.G. // 12 Российский симпозиум по растровой электронной микроскопии и аналитическим методам исследования твердых тел. Черноголовка. 2001. Тезисы докладов. С. 128.
Дополнительные материалы отсутствуют.
Инструменты
Поверхность. Рентгеновские, синхротронные и нейтронные исследования



