Физика плазмы, 2019, T. 45, № 6, стр. 513-523
СВЧ плазменный факел при атмосферном давлении в технологии CVD-синтеза алмаза
К. Ф. Сергейчев a, *, Н. А. Лукина a, Н. Р. Арутюнян a, b
a Институт общей физики им. А.М. Прохорова РАН
Москва, Россия
b Национальный исследовательский ядерный университет МИФИ
Москва, Россия
* E-mail: k-sergeichev@yandex.ru
Поступила в редакцию 19.11.2018
После доработки 12.12.2018
Принята к публикации 20.12.2018
Аннотация
Рассматривается факельный СВЧ-источник свободной безэлектродной плазмы и возможности его разнообразного использования в технологии газофазного химического осаждения алмазных пленок и наращивания объема небольших монокристаллов алмаза, синтезируемых при высоком давлении и высокой температуре. Плазменный факел зажигается в струе несущего газа (аргона) при атмосферном давлении с введенными в струю водородом и метаном. Дается описание работы СВЧ факельного реактора, представлены характеристики плазмы по данным эмиссионной спектроскопии. Ярко светящийся плазменный факел зажигается и устойчиво горит при атмосферном давлении и относительно низкой СВЧ-мощности ≤1 кВт от магнетрона бытовой СВЧ-печи. Самосжатая форма плазменного факела имеет высокую удельную плотность поглощаемой СВЧ-мощности ≤104 Вт/см3, сравнимую с удельной плотностью в дуге постоянного тока. Скорость роста поликристаллического алмазного слоя достигает значений 40 мкм/час. Процессом осаждения пленок на подложки можно управлять путем сканирования факелом по их поверхности.
1. ВВЕДЕНИЕ
Синтез алмаза газофазным химическим осаждением (CVD) на поверхности твердого тела [1, 2] происходит в результате химических реакций, протекающих в газовой среде с участием молекул-предшественников, содержащих углерод. Активация осуществляется термическими методами горячей нити [3], пламенем оксиацетиленовой горелки [4], плазмой струйно-дуговых разрядов постоянного тока [5, 6], плазмой разрядов переменного тока разных ВЧ [7] и СВЧ [8–11] частотных диапазонов и, наконец, плазмой разряда в луче CO2-лазера [12]. В возбужденной реактивной среде газы-предшественники (углеводороды CH4, C2H2, или пары органических жидкостей) разбавляются водородом (Н2), атомы которого удаляют с поверхности неалмазные фазы углерода, возвращая их в газовую среду. Образование алмазной фазы углерода на поверхности подложек протекает при температуре $700 \leqslant {{T}_{S}} \leqslant 1000$°С.
Распространенными MPACVD (microwave plasma assisted chemical vapor deposition) реакторами для получения алмазных пленок являются коммерческие реакторы с мощностью непрерывной генерации до 6 кВт и частотой 2.45 ГГц-модели AX 6500 компании SEKI Diamond (сайт www.sekidiamond.com) [9], а также российский реактор ARDIS [10] с улучшенным по сравнению с реактором AX 6500 [9] согласованием камеры реактора с волноводным трактом. Другие типы распространенных реакторов описаны в обзоре [8]. В этих реакторах активация газовой среды происходит в безэлектродном разряде при давлении ниже атмосферного (от 7 × 103 до 3 × 104 Па) с участием плазмы, создаваемой СВЧ-излучением. ТЕМ-колебания коаксиальной линии возбуждают образованную стенками осесимметричной камеры и коаксиальным диском радиальную линию, над которой расположена цилиндрическая полость, образующая с диском резонатор, способствующий зажиганию разряда. Плазма представляет собой полусферическое облако диаметром ~6 см ~ λ/2, где λ – длина СВЧ-волны.
На кремниевых подложках диаметром более 2 дюймов на молибденовых дисках-держателях, установленных в центре охлаждаемого медного диска под плазменным облаком, осаждается алмазная пленка. СВЧ-мощность, используемая в этих системах, дает скорость роста поликристаллической алмазной пленки 1–10 мкм/час на подложках. Контролируемая температура подложек, нагреваемых плазмой разряда, изменяется в пределах от 700 до 1000°С.
Плазма безэлектродного СВЧ-разряда, в отличие от других типов разрядов, позволяет выращивать поли- и монокристаллические алмазные образцы высокой чистоты, благодаря отсутствию посторонних примесей в углеводородной плазме, которые присущи другим методам генерации плазмы с участием электродов (горячей нити, дуговому или тлеющему разрядам), в которых плазма загрязнена испарением материала электродов.
В данной работе предлагается использовать иной тип MPACVD-источника, в котором плазма зажигается в струе несущего газа (аргона) при атмосферном давлении с введенными в струю водородом и метаном, СВЧ факельный разряд хорошо известен в оптической эмиссионной спектроскопии (ОЭС) как компактный ярко светящийся источник чистой плазмы [13–15], удобный для возбуждения и анализа газообразных сред. Благодаря малому объему факел устойчиво горит при атмосферном давлении при относительно низкой СВЧ-мощности ≤1 кВт, которая может быть получена от магнетронов бытовых СВЧ-печей. Самосжатая форма плазменного факела имеет более высокую удельную плотность СВЧ-мощности ≤104 Вт/см3, поглощаемой в компактной плазменной струе, сравнимую с удельной плотностью мощности, поглощаемой в дуге постоянного тока.
Цель эксперимента в том, чтобы показать возможность использования плазмы факельного СВЧ-разряда для MPACVD синтеза поликристаллических алмазных пленок на площади размером ≤1 см2. Плазменная струя может быть использована для увеличения толщины синтетических монокристаллов, получаемых методом высокого давления и высокой температуры (ВДВТ), и, вероятно, также для коррекции формы и сращивания кристаллов алмаза. В работе представлены характеристики плазмы факельного разряда: концентрация электронов, газовая и электронная температуры. Даны примеры получения поли- и нанокристаллических алмазных пленок и эпитаксиального роста поверхности НРНТ монокристалла алмаза.
2. ЭКСПЕРИМЕНТАЛЬНАЯ УСТАНОВКА
В качестве СВЧ-источника энергии факельного плазмотрона (рис. 1) использован магнетрон (1) Samsung OM 75 P(31) (частота 2.45 ГГц, длина волны 12.24 см, мощность 900 Вт) в режиме непрерывной генерации. Волна низшего типа ТЕ10 возбуждается в прямоугольном волноводе (2) и затем преобразуется в волну ТЕМ коаксиального волновода (3). Центральный проводник коаксиального волновода представляет собой медную трубку (4) с наружным диаметром 6 мм, которая заканчивается узким соплом с отверстием диаметром 1.5 мм. Струя плазмообразующего газа аргона (5), вытекающая из сопла при давлении р > 1 атм. с высокими скоростями потока (3–5 л/мин) в результате ионизации под действием СВЧ-поля становится низкотемпературной плазмой. Плазма факела оторвана от сопла потоком вытекающей из него струи газа, скорость истечения которой (∼30–50 м/с) оказывается выше скорости распространения фронта ионизации по газовой струе навстречу соплу. СВЧ-мощность транслируется в факел через коаксиальный волновод благодаря емкостной связи внутреннего проводника коаксиального волновода с плазмой факела. Это определяет основное отличие свойств факельного СВЧ-плазмотрона от высокочастотной горелки с индуктивно связанной плазмой (ИСП) [16].
Рис. 1.
Схема установки: 1 – магнетрон OM 75 P(31), 2 – прямоугольный волновод (45 × 90 мм2), 3 – коаксиальный волновод, 4 – центральный проводник, 5 – плазменный факел, 6 – настроечный поршень, 7 – циркулятор, 8 – кварцевая трубка, 9 – камера реактора, 10 – смеситель, 11 – держатель подложки, 12 – подвижный стержень, 13 – пирометр “Проминь-М1”, 14 – кварцевое окно, 15 – выхлопной патрубок, 16 – спектрометр FSD 8, 17 – спектрометр Ava Spec-3648-USB2, 18 – оптоволокно, 19 – фокусирующая линза в окне камеры.

Ярко светящееся ядро плазменной струи в зоне СВЧ-разряда диаметром ∼0.2 см длиной ∼λ/4 ≈ 3 см (рис. 2), несет в себе химически активные атомы и радикалы, движущиеся к подложке с большой направленной скоростью. Для согласования импеданса волновода и плазмотрона (5) используется волноводный поршень (6). Защита магнетрона от отраженной волны обеспечивается волноводным циркулятором BФBB2-42 (7), охлаждаемым водой, который до зажигания факела направляет отраженную мощность в поглощающую нагрузку. Связь коаксиального волновода (3) с полым волноводом (2) осуществляется через центральный проводник (4). Вместо удаленной части экрана (3), вставлена радиопрозрачная кварцевая трубка (8), отделяющая пространство волновода (2), наполненного атмосферным воздухом, от коаксиальной части плазмотрона, работающей в вакуумно-изолированном пространстве реактора (9). Факел формируется в одноатомном аргоне. Для синтеза алмаза в аргон дополнительно вводятся водород с примесью метана (носителя атомов углерода). Метан добавляется в струю аргона через смеситель (10). Водород подается между проводником (4) и кварцевой трубкой (8) в пространство, окружающее факел. Алмазная пленка осаждается под факелом на подложку, которая закреплена на держателе, охлаждаемом водой (11), и может перемещаться по вертикали подвижным штоком (12). Температура подложки регулируется высотой ее расположения под факелом, поскольку подложка нагревается до рабочей температуры (750–1000°С) плазмой самого факела. Подложка размещается за пределами области активного поглощения СВЧ-мощности в факеле, что позволяет вести локальное осаждение алмазных пленок на подложки произвольной формы и размера, а также дает возможность сканирования подложек факелом по произвольной траектории.
Контроль температуры поверхности подложки проводится оптическим пирометром (13) через кварцевое окно (14). В работе пирометра использован принцип уравнивания яркости изображения объекта с яркостью нити пирометрической лампы. Погрешность измерения температуры в указанном диапазоне ~20°С.
Площадь осаждения алмазной пленки ∼1 см2, заметно превышает площадь поперечного сечения плазменного ядра факела площадью ≈0.1 см2. Это происходит благодаря газодинамике струи, которая растекается радиально по поверхности подложки, преграждающей течение струи. Углеводородные специи, формирующиеся в СВЧ-факеле, переносятся струей газа к подложке. При работе плазмотрона в камере реактора (9) устанавливается равновесное давление газа за счет естественного баланса между притоком газовой смеси и ее вытеснением в систему вытяжной вентиляции через выпускной патрубок (15), благодаря небольшому избыточному давлению над атмосферой. Расходы газов измеряются поплавковыми расходомерами на выходе баллонных редукторов DINFLOW N10-3-30. Расход водорода измеряется расходомером ZYIA Instr. Co. Скорости расхода аргона в этих экспериментах изменялись в пределах 2.5–5 ст. л/мин (литров стандартной атмосферы за минуту), водорода в пределах 0.5–1 ст. л/мин. Метан в данных экспериментах добавлялся в аргон в виде примеси от 1 до 4% (по отношению к водороду). Вариацией содержания газов в смеси можно управлять морфологией поликристаллических алмазных пленок от микрокристаллической до нано- и ультра-нанокристаллической структуры.
Для оценки параметров плазмы разряда в экспериментах использовались спектральные приборы в диапазоне длин волн 300–1000 нм с различным разрешением: спектрометр FSD-8 (16) с низким разрешением 10 нм и AvaSpec-3648-USB2 с разрешением 0.3 нм. FSD-8 служил для мониторинга режимов “горения” плазменного факела. В процессе CVD-синтеза алмаза для определения электронной концентрации и газовой температуры плазмы факела были измерены контуры бальмеровских линий атомарного водорода и снят вращательный спектр молекулы С2 полосы Свана колебательного перехода 0–0. Для этого использовался спектрометр с высоким разрешением ∼0.04 нм. Изображение плазменного факела проецировалось на входной торец кварцевого световода, другой конец которого располагался вблизи входных щелей спектральных приборов. Перемещением торца световода можно было зондировать факел по координатам с разрешением, определяемым диаметром световода спектрометра FSD-8 – 0.3 мм.
3. ЗАЖИГАНИЕ ФАКЕЛЬНОГО РАЗРЯДА И ОПИСАНИЕ ЕГО СВОЙСТВ
Зажигание разряда и установление его рабочего режима проводилось тремя последовательными шагами. Для удаления из камеры воздуха, камера заполнялась азотом в проточном режиме при давлении выше атмосферного. Затем через сопло подавался аргон и с включением СВЧ-генератора зажигался факел. На начальной стадии азот использовался в качестве флегматизатора для того, чтобы исключить взрыв горючих газов при смешении с остатками кислорода воздуха. Затем после отключения азота подавался водород, который постепенно замещал азот в камере. Наконец, в аргон добавлялся метан и по мере убыли азота, происходило установление газового баланса и переход к стационарному режиму горения факела. Состав газа в стационарном режиме пропорционален расходам газов: Ar : H2 : CH4 = = 4.5 : 1.0 : (0.02–0.04) ст. л/мин (литров в минуту стандартной атмосферы).
На рис. 3 показаны спектры, снятые спектрометром низкого разрешения FSD-8 на разных стадиях зажигания и установления разряда. Спектры свечения усреднены по сечению. При горении факела в атмосфере азота (рис. 3а) в синей области спектра видно достаточно яркое свечение линий аргона, не разрешаемых спектрометром FSD-8. При этом заметного возбуждения азота не наблюдается. После отключения азота и его замещения водородом (рис. 3б) линии аргона исчезают, и появляется линия водорода Нα (654 нм). При введении метана в газовую среду в присутствии азота (рис. 3в) появляется сильное свечение в области 380 нм, нарастающее в течение 8 мин и менее интенсивное свечение вблизи длин волн 400, 516, 654 нм. Спектр свечения вблизи 380 нм, полученный спектрометром “AvaSpec”, квалифицирован как полосы молекул CN 385–388 нм с фиолетовым оттенением [17]. В этой области спектра возможно дополнительное наложение относительно слабого свечения полос С2 (канты 382.5 и 385.2 нм с фиолетовым оттенением, переход 1П → 1П) и СН (канты 362.8 388.9 нм, красное оттенение, переход 2Σ → 2П). При подаче метана наблюдается небольшой спад интенсивности линии Нα и появление линии Нβ (486 нм) водорода и зеленого свечения молекул С2 (перехода 3Пu, с кантом 516 нм), интенсивности которых синхронно растут, достигая максимума к ~15-й минуте от момента включения метана. В установившемся режиме спектр характеризуется интенсивным свечением линий водорода Нα, Нβ и полос радикалов С2 и СН (2Δ–2П, кант 431 нм). Выход интенсивности свечения полосы CN к минимальному значению наступает только после 40-й минуты, когда азот полностью замещается водородом.
Рис. 3.
ОЭС-спектры СВЧ-факела на разных стадиях зажигания разряда, измеренные спектрометром FSD-8 в едином масштабе: зажигание факела в аргоне, вытекающем в азотную атмосферу (а); замещение азота водородом (б); добавление метана в аргон (в); спектр факела в установившемся режиме (г); спектр молекул CN, измеренный спектрометром “AvaSpec” (д).

Качественно процессы, протекающие в плазме СВЧ-факела на различных стадиях горения, можно представить так. При зажигании разряда азот не вступает во взаимодействие с плазмой факела, не давая развиться поперечному дуговому СВЧ-пробою между соплом и краем внешней коаксиальной трубки горелки плазмотрона, так как факел в окружающей атмосфере чистого аргона срывается из-за пробоя между электродами. Свечение второй положительной системы азота и линий аргона в азотной среде настолько слабы, что на спектрометре FSD-8 не видны. С подачей водорода аргон вступает с ним во взаимодействие, азот по-прежнему остается нейтральным. Энергия возбужденного в факеле аргона расходуется, главным образом, на диссоциацию водорода и возбуждение его атомов. Этим объясняется падение интенсивности излучения аргона и появление интенсивного свечения линии Нα. При подаче метана, поступающего в разряд с аргоном, азот активно взаимодействует с метаном с образованием новых продуктов: CN, С2 и углеводородов СxHy, происходит перераспределение энергии возбужденного аргона между водородом и метаном. В установившемся режиме горения факела после полного замещения азота водородом остается слабое излучение CN, которое свидетельствует о наличии в камере остатка азота, который может присутствовать в виде примеси в используемых нами технических газах.
Динамика установления стационарного режима разряда с течением времени показана на рис. 4. До 6-й минуты от зажигания СВЧ-разряда все главные составляющие спектра растут по мере убыли азота и его замещения водородом. Затем, интенсивность свечения аргона переходит в режим экспоненциального спада по времени, тогда как интенсивности излучения атомарного водорода и димера С2 стабилизируются. Стационарный режим разряда наступает через 40 минут, когда азот уходит из камеры и наступает баланс состава газов в факеле и в остальном объеме камеры.
Рис. 4.
Динамика разряда от зажигания к стационарному режиму по поведению интенсивности спектральных линий Ar(1), Нα(2) и полосы С2 (кант-перехода 3Пu, 516 нм) (3) с течением времени при соотношении расхода газов Ar : H2 : CH4 = 5 : 1 : 0.06 ст. л/мин.
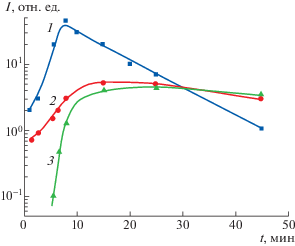
Было найдено, что при осаждении алмаза интенсивности излучения линии Нα водорода и полосы С2 по измерениям спектрометром FSD-8 оказываются одного порядка.
Водород играет важную роль в процессе формирования алмаза. Его присутствие обеспечивает приоритетный рост алмазной фазы sp3 по отношению к графиту, благодаря тому, что атомарный водород с высокой скоростью газифицирует графит, возвращая его в газовую среду в виде углеводородных соединений, практически не затрагивая алмаз.
Оптимальное соотношение содержания водорода в аргоне было найдено в эксперименте с варьируемым расходом водорода при двух значениях расхода аргона 3 и 5 ст. л/мин как параметра при постоянной СВЧ-мощности (рис. 5а). Интенсивность свечения линии Нα, которая пропорциональна концентрации возбужденных атомов, в зависимости от скорости поступления водорода немонотонно изменяется: растет c увеличением скорости до ∼0.5 ст. л/мин, но при ее увеличении более 1 ст. л/мин спадает, причем тем быстрее, чем ниже расход аргона (ср. кривые 1 и 2 на рис. 5а). Обе зависимости имеют максимум при ∼1 ст. л/мин, из чего можно заключить, что при этом значении, содержание атомов водорода в плазме оптимально. Спад зависимостей, по-видимому, объясняется тем, что запасенной энергии в метастабильных атомах аргона в плазме факела уже не хватает для максимальной диссоциации молекулярного водорода при большем его расходе. Интересно, что увеличение расхода аргона приводит к увеличению генерации атомарного водорода, что согласуется с предположением о роли метастабильных состояний атомов аргона в диссоциации водорода.
Рис. 5.
Зависимости интенсивности излучения линии атомарного водорода Нα (654 нм) и полосы димера углерода С2 (516 нм) от расхода газов: (а) зависимости интенсивности Нα от расхода водорода при скорости расхода аргона как параметра: 1 – 5 ст. л/мин и 2 – 3 ст. л/мин; (б) зависимости интенсивности излучения: 1 – Нα и 2 – С2 от расхода метана в смеси с аргоном при постоянном отношении скорости расхода аргона и водорода Ar : H2 = 4.5 : 1 ст. л/мин (б).
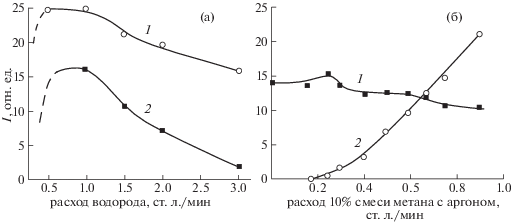
Расход метана по отношению к водороду для оптимального роста алмазной пленки определялся по интенсивности излучения полосы С2 от расхода метана. Скорость роста алмазной пленки достигает максимального значения, когда интенсивность полосы при С2 достигает уровня интенсивности линии Нα при спектральном разрешении спектрометра FSD-8 (рис. 5б). Измерения проводились на оси факела при z = 1.5 см. Расходы аргона и водорода в этом опыте были параметром: Ar : H2 = 4.5 : 1 ст. л/мин, а содержание метана в водороде варьировалось изменением его расхода от 0 до 0.09 ст. л/мин. Установлено оптимальное значение расхода метана для роста алмазной пленки при уровне 6% по отношению к водороду.
Поперечное и продольное распределения интенсивности свечения линий и полос основных компонентов спектра, сопровождающих синтез алмаза в стационарном режиме, показаны на рис. 6. Распределения интенсивности излучения полос С2, CH и линий Нα и Ar с разрешением спектрометра FSD-8 даны на рис. 6а в направлении, поперечном к оси факела на расстоянии 1.5 см от сопла. На рис. 6б дано продольное распределение интенсивности излучения основных составляющих роста алмаза С2 и Нα по оси факела z с отсчетом от сопла. Измерения интенсивности излучения, выполненные FSD-8 в условиях осаждения микрокристаллической алмазной пленки на подложку, даны в относительных единицах.
Наиболее ярким свечением в спектре СВЧ-факела в установившемся режиме обладают линии Нα и полосы С2. По интенсивности свечения Нα нами качественно оценивалась степень диссоциации водорода, а по ширине профиля линии определялась концентрация электронов плазмы. Излучение полос С2 и СН (431 нм) указывает на преобразование метана в разряде и формирование молекул С2 и, вероятно, метильных радикалов СН3, которым часто приписывается роль посредников в формировании алмаза. Излучение полосы СН3 вблизи 16.2 мкм в длинноволновой части ИК-спектра нами не регистрировалось, так как было за пределами диапазонов длин волн спектрометров.
Плазма разряда неоднородна, поэтому рост алмазной пленки чувствителен как к составу плазмы, так и к температуре подложки, которые зависят от выбора положения подложки под факелом. Для оптимальных условий осаждения алмаза необходимо контролировать расходы газов и мощность магнетрона.
Итак, ширина ядра факела визуально находится в интервале значений 2 < 2r < 3 мм, а протяженность по оси ≥30 мм. Оптимальный рост алмазной пленки происходит в той зоне, где интенсивности С2 и Нα по показаниям спектрометра FSD‑8 оказываются максимальными и имеют один порядок величины (рис. 6б). Расстояние, на котором размещалась подложка, соответствует z ≤ 25 мм.
Рис. 6.
Характеристики плазмы СВЧ-факела по измерениям интенсивности свечения спектральных линий и полос атомов и молекул: (а) распределения интенсивности излучения: 1 – С2, 2 – Нα, 3 – Ar (763.5 нм) и 4 – CH поперек факела и (б) распределение интенсивности излучения 1 – полосы С2 и 2 – линии Нα вдоль оси факела в стационарном режиме горения факела при соотношении расхода газов Ar : H2 : CH4 = 5 : 1 : 0.06 ст. л/мин.

4. ПАРАМЕТРЫ ПЛАЗМЫ В СВЧ-ФАКЕЛЕ АТМОСФЕРНОГО ДАВЛЕНИЯ. ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ ИЗМЕРЕНИЙ
Большое влияние на процессы алмазного роста оказывает газовая температура Tg в плазменном факеле [18]. Наилучшее приближение к газовой температуре может быть получено из вращательных температур, определяемых по вращательному спектру колебательной полосы 0–0 электронного перехода d3Пg–a3Пu радикала С2 [19, 20]. Радикал С2 согласно современным представлениям [21] по концентрации превалирует над СН3 при формировании алмазной решетки. Вопросу измерения газовой температуры в неравновесной плазме посвящен обзор [22]. Диагностика температуры по вращательным линиям спектра радикала С2 проведена в нижней части факела вблизи поверхности подложки в процессе CVD-синтеза поликристаллической алмазной пленки [18]. Вращательная температура, измеренная по верхнему уровню, составила ∼4000 K. Согласно [22] в неравновесной плазме распределение плотности вращательного спектра двухатомной молекулы не должно обязательно находиться в равновесии с температурой (газа), определяемой поступательным движением молекул. Наличие равновесия более свойственно плазме низкого давления с низкой плотностью, без столкновений за время существования возбужденного состояния. В этом случае электронное возбуждение часто является доминирующим механизмом возбуждения. Факельный разряд при атмосферном давлении является другим крайним случаем с высокой частотой столкновений при относительно долго живущих электронных состояниях. В течение времени жизни происходит несколько столкновений возбужденной молекулы с другими молекулами газа. Эти столкновения термализуют потенциально нетепловое вращательное распределение заселенности уровней перед испусканием фотона.
Электронная температура также является важным параметром, имеющим большое влияние на процессы CVD-синтеза алмаза. По уширению водородных линий Hα, Hβ серии Бальмера обычно определяют концентрацию электронов плазмы. Однако в работе [23] была показана возможность одновременного диагностирования электронной плотности ne и электронной температуры Te водородной плазмы спектральным методом на основе зависимостей ne(Te), которые строились для трех водородных линий Hα, Hβ и Hγ при постоянном значении штарковского уширения как параметра. Δλ1/2 = const. Этот метод диагностики, названный методом пересечения ne(Te), позволил по пересечению зависимостей ne(Te) при СВЧ-мощности 600 Вт определить значения ne, так и Te. Измерения [23] были проведены для СВЧ-разряда в протоке аргона с примесью водорода при атмосферном давлении в условиях, близких к нашему эксперименту, что позволило использовать данные [23] для оценки средней температуры электронов: Te ≥ 1.5 эВ. Средняя концентрация электронов, определенная по штарковскому уширению линии Нβ [24], составила $\left\langle {{{n}_{e}}} \right\rangle \approx 4 \times {{10}^{{15}}}$ см–3.
5. АЛМАЗНЫЕ ПЛЕНКИ В РЕЖИМАХ ГОМОЭПИТАКСИАЛЬНОГО, НАНО- И ПОЛИКРИСТАЛЛИЧЕСКОГО РОСТА АЛМАЗА В ПЛАЗМЕ СВЧ-ФАКЕЛА
С помощью факельного СВЧ плазмотрона проведено осаждение при атмосферном давлении микрокристаллических [25, 26] и нанокристаллических пленок на подложки из кремния [27] и молибдена (рис. 7), а также гомоэпитаксиальное осаждение алмаза на (ВДВТ) – монокристаллические подложки [28] (рис. 8).
Рис. 7.
Изображения и КР-спектры осажденных алмазных пленок: микрокристаллическая пленка (на молибдене) (а) и нанокристаллическая пленка (на кремнии) (б).

Рис. 8.
(в цвете онлайн) Макроскопическое (а, г) и микроскопическое (б, в) и изображения морфологии алмазных слоев выращенных на (ВДВТ)-монокристаллах алмаза (д); КР-спектр выращенных слоев имеет узкий алмазный пик 1332 см–1(е).
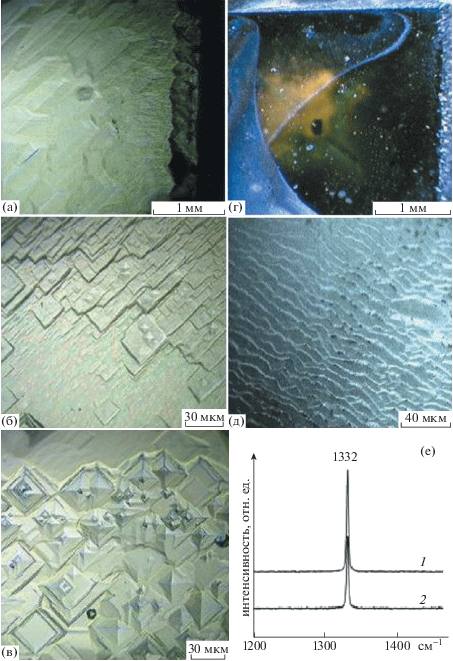
Подложка из молибдена размером 15 × 15 × 2 мм (рис. 7а) предварительно засевалась в суспензии алмазного порошка в растворе спирта с ацетоном в УЗ-ванне в течение 14 мин и затем помещалась на подвижном держателе в камеру реактора под факел. Осаждение проводилось при температуре подложки 850–1000°С на расстоянии от сопла 25 мм. Расход рабочих газов –Ar : H2 : CH4 = 5 : 1 : : 0.01 ст. л/мин. Осаждение продолжалось 3 ч. Средняя толщина микрокристаллического покрытия составила 60 мкм в пятне диаметром ~1 см. Микроструктура пленки – кристаллы с ориентацией (100) и размерами сторон ∼3–4 мкм. Под фотографиями пленок показаны спектры их комбинационного рассеяния. На спектрах микрокристаллической пленки, зондированной лазером в трех разных точках, виден узкий пик 1332 см–1, соответствующий алмазу. Осаждение нанокристаллической пленки (рис. 7б) проводилось на полированную поверхность подложки из кремния размером 16 × 16 × 3, с предварительным засевом ее поверхности суспензией алмазного нанопорошка в УЗ-ванне мощностью 50 Вт в течение 20 мин. Осаждение проводилось при температуре подложки ~800°С на расстоянии от сопла 35 мм. Расход рабочих газов Ar : H2 : CH4 = 3 : 0.6 : : 0.01 ст. л/мин. Время осаждения 4 ч. Морфология пленки имеет вид “цветной капусты”. На КР‑спектрах наблюдаются типичные для наноалмазной пленки D и G-выступы, а также выступы, характерные для трансполиацетилена (TPA).
Опыты по гомоэпитаксиальному наращиванию алмаза на (ВДВТ)-кристаллах проводились на образцах с размерами 4 × 4 × 1 мм3 и 4 × 4 × 2 мм3. На рис. 8а, г показаны фотографии общего вида кристаллов, под которыми показана морфология выращенных гомоэпитаксиальных слоев рис. 8б, в, д, а также КР-спектр выращенного алмазного слоя рис. 8е. Для удержания под газовой струей кристаллы закреплялись на молибденовых держателях термостойким клеем на основе графита.
Осаждение гомоэпитаксиального слоя на кристалл алмаза (рис. 8а) проводилось на расстоянии от сопла 30 мм при температуре 900–1000°С. Ра-сход рабочих газов Ar : Н2 : СН4 = 4.7 : 1 : : 0.04 ст. л/мин. Продолжительность осаждения 3.5 ч. На грани (100) выращен прозрачный эпитаксиальный слой с характерно ориентированными “ступенями” рис. 8б и “пирамидами” рис. 8в. Высота выращенного слоя 65 мкм. Прозрачный эпитаксиальный алмазный слой, выращенный на НРНТ-образце рис. 8г при малом увеличении подобен виду “разлитой воды” (по краю вверху и по краю слева). Алмазный слой нарастал от края к центру поскольку факел был смещен от центра кристалла. Образец в процессе роста был повернут на 90° вокруг оси. Температура осаждения 800–900°С. Расстояние от сопла 30 мм. Расход рабочих газов Ar : Н2 : СН4 = 5 : 1 : 0.25 ст. л/мин. Время осаждения 2 ч. На грани (100) выращена прозрачная эпитаксиальная алмазная пленка с характерно ориентированными “ступенями” роста шириной 6–10 мкм и высотой ~1 мкм. Морфология растущей поверхности в виде ступеней лестницы (рис. 8д) связана с косым срезом кристалла по отношению к кристаллографической ориентации (100). При совпадении среза и ориентации (100) морфология поверхности имеет вид пирамид (рис. 8в). КР-спектр выращенных слоев имеет узкий алмазный пик 1332 см–1.
6. ЗАКЛЮЧЕНИЕ
Изучен безэлектродный СВЧ-разряд факельного типа, в котором плазма свободно “горит” в струе аргона, истекающей из сопла плазмотрона. Плазменная струя не касается металлического сопла, так как фронт волны ионизации, движущийся по струе аргона навстречу соплу, постоянно относится от сопла быстрым течением газа. Передача СВЧ-энергии полю поверхностной СВЧ-волны, питающей разряд в струе, осуществляется через емкостную связь в газовом “зазоре” между плазмой и соплом коаксиальной горелки. Свободно горящий факел является источником чистой плазмы. В плазменной струе с газовой температурой, достигающей 4000 К, введенные в нее метан и водород формируют реактивную среду над подложкой, на которой создаются условия роста алмаза. При этом подложка нагревается до температуры не выше 1000°С, что достигается установлением баланса температур между подложкой и плазменной струей. По спектрам излучения проведены измерения характеристик неравновесной плазмы, ее концентрации, температуры газа в струе, оценена температура электронов. Показано, что размер пятна поликристаллической пленки, осажденной на подложку, имеет диаметр ∼10 мм. Сталкиваясь с препятствием, узкая струя плазмы, подчиняясь законам газовой динамики, растекается по поверхности подложки. Скорости роста алмаза, определенные по толщине слоя достигают 40 мкм/час.
Небольшая площадь осаждения может рассматриваться как недостаток струйного СВЧ-плазмотрона по сравнению с распространенными СВЧ-реакторами, предназначенными, главным образом, для осаждения поликристаллических алмазных пластин на подложках большой площади. Однако, когда ставится задача гомоэпитаксиального наращивания синтетических (ВДВТ) монокристаллов алмаза с первоначальными размерами существенно меньшими 1 см в поперечнике, то в этих реакторах приходится сталкиваться с проблемой неравномерного роста кристаллов с образованием поликристаллической “шубы”, ограничивающей рост монокристалла.
Свободный плазменный СВЧ-факел может оказаться более привлекательным инструментом для наращивания и сращивания алмазных монокристаллов до размеров, которые вписываются в размер пятна. Влияние фонового СВЧ-поля вблизи факела оказывается слабым, не способным влиять на рост алмаза, в то же время направленное движение струи плазмы в сторону подложки ускоряет его рост.
Плазма СВЧ-факела позволяет сканированием по поверхности подложки обрабатывать поверхности любой формы и размеров, что может быть также использовано для роста монокристаллов алмаза с размерами, большими диаметра пятна, оставляемого факелом, что отличает СВЧ-факел от реакторов, в которых осаждение алмаза ведется в резонаторах при строгом соблюдении граничных условий, чтобы не нарушить структуру поля. Сканированием факела можно реализовать фигурные и профильные алмазные поликристаллические покрытия, включая нанокристаллические покрытия, на плоских и цилиндрических поверхностях, что можно использовать для упрочнения режущих кромок металлообрабатывающих инструментов, в частности, режущих вставок из карбида вольфрама.
Список литературы
Derjaguin B.V., Fedoseev D.V., Lukyanovich V.M., Spitzin B.V., Ryabov V.A., Lavrentyev A.V. // J. Crystal Growth.1968. V. 2. P. 380.
Diamond Films Handbook / Eds. J. Asmussen, D. Reinhard. CRC Press, 2002.
Matsumoto S., Kamo M., Setaka N. // Japan J. Appl. Phys. 1982. V. 21. P. L183.
Matsui Y. // Japan J. Appl. Phys. 1990. V. 29. P. 155.
Kurihara K., Sasaki K.-I., Kawarada M. // Fujitsu Sci. Tech. J. 1989. V. 25. P. 44.
Olson J.M., Dawes M.J. // J. Mater. Res. 1996. V. 11. P. 1765.
Baldwin S.K., Owano T.G., Kruger C.H. // Plasma Chem. Plasma Processing. 1994. V. 14. P. 383.
Silva F., Hassouni K., Bonnin X., Gicquel A. // J. Phys.: Condens. Matter. 2009. V. 21. P. 364202.
Besen M.M., Sevillano E., Smith D.K. US Patent March 26, 1996. No. 5,501,740.
Конов В.И., Ральченко В.Г., Сергейчев К.Ф., Хава-ев В.Б., Вартапетов С.К., Атежев В.В. // Патент “СВЧ плазменный реактор” № 2299929. Заявка № 2005125464 приоритетот 11.08.2005.
Bolshakov A.P., Konov V.I., Prokhorov A.M., Uglov S.A. // Diamond Related Materials. 2001. V. 10. P. 1559.
Vikharev A.L., Gorbachev A.M., Kozlov A.V., Radi-shev D.B., Muchnikov A.B. // Diamond Related Materials. 2008. V. 17. P. 1055.
Garcıa M.C., Rodero A., Sola A., Gamero A. // Spectrochimica Acta. Part B. 2000. V. 55. P. 1733.
Власов Д.В., Сергейчев К.Ф., Сычев И.А. // Физика плазмы. 2002. Т. 28. С. 484.
Mitsuda Y., Yoshida T., Akashi K. // Rev. Sci. Instruments. 1989. V. 60. P. 249.
Timmermans E.A.H., Thomas I.A.J., Jonkers J., Hart-gers E., vander Mullen J.A.M., Schram D.C. // Fresenius J. Anal. Chem. 1998. V. 362. P. 440.
NIST Atomic Spectra Database Lines Form. https://physics.nist.gov/PhysRefData/ASD/lines_form.html.
Летунов А.А., Скворцова Н.Н., Лукина Н.А., Сергейчев К.Ф., Петровский Н.С. // VIII Междун. симп. по теоретической и прикладной плазмохимии, Иваново, 10–15 сентября 2018. Тез. докл.
Pellerin S., Musiol K., Motret O., Pokrzywka B., Chapelle J. // J. Phys. D: Appl. Phys. 1996. V. 29. P. 2850.
Bushuev E.V., Yurov V.Yu., Bolshakov A.P., Ralchenko V.G., Khomich A.A., Antonova I.A., Ashkinazi E.E., Shershulin V.A., Pashinin V.P., Konov V.I. // Diamond Related Materials. 2017. V. 72. P. 61.
Rond C., Hamann S., Wartel M., Lombardi G., Gic-quel A., Röpcke J. // J. Appl. Phys. 2014. V. 116. P. 093301.
Bruggeman P.J., Sadeghi N., Schram D.C., Lins V. // Plasma Sources Sci. Techn. 2014. V. 23. P. 023001-1/32.
Torres J., Palomares J.M., Sola A., van der MullenJ.J.A.M., Gamero A. // J. Phys. D: Appl. Phys. 2007. V. 40. P. 5929.
Griem H.R. Plasma Spectroscopy. N.Y.: McGraw-Hill, 1964 (Грим Г. Спектроскопия плазмы. М.: Атомиздат, 1969).
Сергейчев К.Ф., Лукина Н.А., Большаков А.П., Ральченко В.Г., Арутюнян Н.Р., Бокова С.Н., Конов В.И. // Прикладная физика. 2008. № 6. С. 39.
Sergeichev K.F., Lukina N.A., Bolshakov A.P., Ralchenko V.G., Arutyunyan N.R., Vlasov I.I. // Plasma Phys. Rep. 2010. V. 36. P. 1272.
Anpilov A.M., Arutyunyan N.R., Barkhudarov E.M., Belashov I.V., Bolshakov A.P., Borisenko M.A., Ivanov V.A., Kossyi I.A., Lukina N.A., Milovich Ph.O., Sedov V.S., Abakumov M.A., Sergeichev K.F. // IOP Conf. Ser. J. Phys. Conf. Ser. 2018. V. 1094. P. 012030.
Sergeichev K.F., Lukina N.A. // Plasma Phys. Rep. 2011. V. 37. P. 1224.
Дополнительные материалы отсутствуют.



