Физика плазмы, 2022, T. 48, № 1, стр. 41-53
Исследование переходов между режимами и генерации отрицательных ионов в плазменном источнике на основе геликонового разряда в водороде
N. Sharma a, M. Chakraborty a, *, A. Mukherjee a, P. K. Saha a, N. K. Neog a, M. Bandyopadhyay b,
a Centre of Plasma Physics-Institute for Plasma Research, Tepesia, Sonapur
Assam, Kamrup, India
b Institute for Plasma Research, HBNI, Bhat
Gujarat, Gandhinagar, India
* E-mail: monojit@cppipr.res.in
Поступила в редакцию 11.06.2021
После доработки 20.08.2021
Принята к публикации 25.08.2021
- EDN: ILCFFT
- DOI: 10.31857/S0367292122010139
Аннотация
Детально изучаются переходы между режимами и генерация отрицательных ионов в источнике с плазмой геликонового разряда в водороде. Переходы между режимами исследуются в первой камере источника, где создается плазма, а образование отрицательных ионов изучается в расположенной вниз по потоку расширительной камере. Для ионизации молекулы водорода, являющейся наименьшей двухатомной молекулой, требуется гораздо больше энергии, чем для ионизации молекулы кислорода. Кроме того, из-за высокой подвижности ионов водорода потери заряженных частиц в разрядной водородной плазме значительно больше, чем в случае других газов. В связи с этим, в отличие от других газов типа кислорода, для достижения критической плотности, при которой происходят переходы между режимами, в случае разряда в водороде требуется электромагнитная волна очень высокой частоты (ВЧ). Исследования генерации отрицательных ионов H− в расширительной камере показывают, что доля отрицательных ионов α = n- /ne меняется между ~0.07 и ~0.5 и растет с увеличением подводимой ВЧ-мощности и рабочего давления. Наблюдаемые зависимости концентраций электронов и отрицательных и положительных ионов объясняются на основе реакций, контролирующих рождение и гибель отрицательных ионнов. Переходы между режимами поясняются с помощью уравнения баланса энергии.
1. ВВЕДЕНИЕ
В геликоновых источниках для создания плазмы высокой плотности используются газовые разряды с относительно низким энерговкладом по сравнению с обычными ВЧ-источниками [1, 2]. Источники на основе геликоновой плазмы могут работать даже при низком рабочем давлении и, следовательно, характеризуются пониженными потерями ионов ${{{\text{H}}}^{ - }}$ из-за столкновений с другими частицами [3].
Наряду с генерацией отрицательных ионов у водородной плазмы есть много других применений в различных областях техники типа травления, нанесения покрытий и т.д. [4–11]. Важно уметь описывать динамику водородной плазмы, которая содержит отрицательные ионы наряду с электронами и положительными ионами, что отличает ее от обычной плазмы аргона, где присутствуют только электроны и положительные ионы [12]. ВЧ-источники отрицательных ионов водорода являются перспективными, поскольку они рассматриваются как возможное средство для создания энергичных пучков нейтральных частиц, способных нагревать плазму в будущих термоядерных реакторах типа ИТЕР (международный термоядерный экспериментальный реактор) [13]. Поэтому газовые разряды типа ВЧ-разрядов в водороде привлекают внимание исследователей в этой области [14–16].
Энергия сродства атомов водорода к электрону составляет всего лишь 0.75 эВ, что гораздо меньше аналогичной величины для атомов других электроотрицательных газов; например, у атомов кислорода она равна 1.46 эВ. Потенциал ионизации атомов водорода, равный 13.6 эВ, гораздо больше их энергии сродства к электрону (0.75 эВ). Это значит, что внешний электрон у ионов ${{{\text{H}}}^{ - }}$ слабо связан, и его легко оторвать [17]. Поэтому обеспечить генерацию и существование отрицательных ионов водорода гораздо сложнее, чем ионов кислорода. Имеется два метода создания отрицательных ионов водорода – поверхностная генерация и объемная генерация [17, 18]. В методе поверхностной генерации отрицательные ионы водорода образуются на поверхности материала с низкой работой выхода электронов, обычно это поверхности, покрытые цезием [17]. При объемной генерации отрицательные ионы ${{{\text{H}}}^{ - }}$ создаются в две стадии. На первой стадии, обычно в первой камере источника, где генерируется плазма, образуются колебательно-возбужденные молекулы водорода. На второй стадии образуются ионы ${{{\text{H}}}^{ - }}$ при диссоциатвном прилипании электронов с низкой энергией к колебательно-возбужденным молекулам водорода. Как правило, эта стадия реализуется в расширительной камере, куда плазма диффундирует из первой камеры [18].
Хотя исследования в инертных газах типа аргона проводились многократно, экспериментов с геликоновым разрядом в газах типа водорода гораздо меньше [8, 15, 19, 20]. Среди этих работ [8, 15, 19, 20], рассматривающих ВЧ-разряд в водороде, переходы от емкостного режима к индукционному и потом к геликоновому упоминались только в работе [8], причем без детального обсуждения. В данной статье приводятся результаты детального наблюдения и обсуждения переходов между различными режимами, а также измерения концентрации отрицательных ионов водорода в геликоновом плазменном источнике.
В представленной работе измеряются параметры плазмы в первой камере источника для изучения характеристик переходов между режимами разряда в водороде и концентрация ионов ${{{\text{H}}}^{ - }}$ в расширительной камере. Статья организована следующим образом. В разделе 2 приводится механизм образования отрицательных ионов водорода и указывается на важность в этом механизме электронов с низкой энергией. Экспериментальная установка, работа источника и техника измерений для отрицательных ионов водорода обсуждаются в разделе 3. В разделе 4 приводится обсуждение результатов измерений и наблюдений, а в разделе 5 описываются выводы проведенного исследования.
2. МЕХАНИЗМ ОБЪЕМНОЙ ГЕНЕРАЦИИ ${{{\text{H}}}^{ - }}$
Объемная генерация ионов ${{{\text{H}}}^{ - }}$ обычно включает две стадии. Первая стадия сводится к образованию сильно-возбужденных колебательно-вращательных состояний молекул водорода при столкновениях молекул H2 в основном состоянии с высокоэнергичными электронами. На второй стадии происходит диссоциативное прилипание холодных (Te < 2 эВ) электронов к колебательно-возбужденным молекулам водорода с образованием отрицательных ионов [18]. Основные реакции, отвечающие за образование и разрушение ионов ${{{\text{H}}}^{ - }}$ и соответствующие константы скорости (K) приведены в табл. 1.
Таблица 1.
Основные реакции, в которых происходит образование и разрушение ионов ${{{\text{H}}}^{ - }}$
| Реакция | Константа скорости (м3/с) | Ссылка |
|---|---|---|
1.  |
${{K}_{{EV1}}} = 2 \times {{10}^{{ - 15}}}$ | [8, 21–23] |
2.  |
${{K}_{{EV2}}} = 5 \times {{10}^{{ - 17}}}$ | [23] |
3.  |
${{K}_{{ion}}} = 9 \times {{10}^{{ - 16}}}$ | [23] |
4.  |
${{K}_{{Dis}}} = 3 \times {{10}^{{ - 16}}}$ | [23] |
5.  |
${{K}_{{DA}}} = 3 \times {{10}^{{ - 14}}}{\text{/}}(1 + T_{e}^{{1.5}})$ | [24] |
| 6. $e + {{{\text{H}}}^{ - }} \to {\text{H}} + 2e$ | ${{K}_{{ED}}} = 2.32 \times {{10}^{{ - 14}}}T_{e}^{2}\exp ( - 0.13{\text{/}}{{T}_{e}})$ | [24] |
| 7. ${{{\text{H}}}^{ + }} + {{{\text{H}}}^{ - }} \to 2{\text{H}}$ | ${{K}_{{MN}}} = 1.8 \times {{10}^{{ - 13}}}{{(300{\text{/}}{{T}_{g}})}^{{0.5}}}$ | [25] |
| 8. ${\text{H}} + {{{\text{H}}}^{ - }} \to {{{\text{H}}}_{2}} + e$ | ${{K}_{{Det}}} = 1.3 \times {{10}^{{ - 15}}}$ | [25] |
В реакциях 1 и 2 происходит колебательно-вращательное возбуждение молекул водорода при их столкновениях с быстрыми (>20 эВ) электронами. Возбуждение молекул требует высоких электронных температур. Поэтому это возбуждение обычно происходит в первой камере источника, где присутствуют высокоэнергичные ионы, характеризуемые высокими температурами. В реакциях 3 и 4 снижается заселение возбужденных молекул водорода. Объемная генерация отрицательных ионов происходит, как правило, в реакции 5. Следующие три реакции (процессы 6–8) отвечают за убыль отрицательных ионов в столкновениях с высокоэнергичными электронами, при взаимной рекомбинации с положительными ионами и при взаимодействии с нейтральными атомами водорода. На рис. 1 приведены коэффициенты KDA и KED в зависимости от температуры электронов, в то время как константы скорости остальных реакций, собранных в табл. 1, не зависят от этой температуры. Другие реакции, которые не приведены в табл. 1, также могут идти в водородном разряде. Здесь рассматриваются только процессы, наиболее важные для рождения и гибели отрицательных ионов. Информацию об этих реакциях и их параметрах можно найти по ссылкам [23, 26]. Из рис. 1 следует, что скорость образования отрицательных ионов при диссоциативном прилипании (KDA) превышает скорость разрушения этих ионов при столкновении с энергичными электронами (KED) при низкой (<1 эВ) электронной температуре. При более высоких температурах отрыв электронов от ионов оказывается более эффективным, чем образование этих ионов при диссоциативном прилипании. В связи с этим для эффективной генерации отрицательных ионов в водородном разряде электронная температура должна быть низкой. Следовательно, чтобы обеспечить успешную наработку ионов ${{{\text{H}}}^{ - }}$ в объемном источнике, необходимо использовать внутри камеры магнитный фильтр, который делит плазменный источник на две части. В первой части (первая камера) электроны имеют высокую энергию, и создаются колебательно-возбужденные молекулы, а во второй части (расширительная камера) образуются отрицательные ионы при диссоциативном прилипании электронов к колебательно-вращательно-возбужденным молекулам Н2 [27, 28]. Таким образом, магнитный фильтр обычно необходим в источниках отрицательных ионов водорода.
3. ЭКСПЕРИМЕНТАЛЬНАЯ УСТАНОВКА И ТЕХНИКА ИЗМЕРЕНИЙ
3.1. Экспериментальная установка
Изучение свойств плазмы ВЧ-разряда в водороде выполняется в геликоновом плазменном источнике, в котором роль первой камеры выполняет стеклянная камера длиной 60 см и диаметром 10 см. С помощью спиралеобразной антенны длиной 18 см в первую камеру источника вводится ВЧ электромагнитная волна, обеспечивающая вкладываемую мощность от 100 до 2700 Вт. Для этого используется источник мощностью 3000 Вт на частоте 13.56 МГц, от которого энергия подводится через емкостные соединения L-типа с автоматическим согласованием, чтобы уменьшить ВЧ-потери на отражение. Шесть последовательно соединенных электромагнитов с водяной циркуляцией используются для создания однородного магнитного поля вдоль оси первой камеры источника. Стеклянная камера соединена с расширительной камерой из нержавеющей стали длиной 43 см и диаметром 30 см. К этой камере присоединена система накачки, состоящая из турбомолекулярного и центробежного насосов. На рис. 2 приведена схема установки, используемая в экспериментах с ВЧ-разрядом в водороде и при генерации отрицательных ионов водорода. Детальное описание экспериментальной установки с размерами и техническими характеристиками можно найти в прежних публикациях [29, 30]. На рис. 3 показаны профили магнитного поля вдоль первой оси источника, измеренные при токах 40 и 60 А в обмотках шести магнитов.
Рис. 2.
Схема геликонового источника, используемая для изучения ВЧ-разряда в водороде и образования отрицательных ионов. MF – магнитный фильтр.

Рис. 3.
Профили магнитного поля, измеренные вдоль оси первой камеры источника с помощью магнитометра для токов 40 и 60 А, протекающих через шесть последовательно соединенных электромагнитов.

Для генерации отрицательных ионов в разряде за счет диссоциативного прилипания к молекулярному водороду температура электронов должна быть понижена. Как показано на рис. 1, константа скорости отлипания растет с электронной температурой, поскольку при этом увеличивается количество высокоэнергичных электронов. В линейных плазменных системах охлаждение электронов достигается главным образом за счет расширения плазмы из области, где она создается, в расширительную область с большим объемом [31]. Другим методом, принятым в данном эксперименте для уменьшения температуры электронов, является использование магнитного фильтра [27, 28, 31], который помещается в расширительной камере сразу после окончания камеры, где плазма рождается. С помощью магнитов фильтра создается поперечное магнитное поле, через которое заряженные частицы должны диффундировать, чтобы попасть в расширительную камеру. Коэффициент диффузии заряженных частиц поперек магнитного поля равен [1, 32]
(1)
${{D}_{ \bot }} = 2 \times {{10}^{{ - 5}}}\frac{{{{k}_{B}}T_{e}^{{ - 1/2}}{{m}_{i}}{{n}_{e}}}}{{{{e}^{2}}{{B}^{2}}}},$3.2. Техника измерений
Характеристики плазмы измеряются в первой камере источника с помощью ВЧ компенсированного цилиндрического зонда Ленгмюра (изготовитель – фирма HIDEN) с вольфрамовым острием диаметром 0.15 мм и длиной 10 мм. В расширительной камере концентрация отрицательных ионов измеряется по методу, описанному в [33], из обработки вольтамперной характеристики планарного зонда радиусом 1.5 мм.
Концентрация электронов вычисляется посредством измеренной зондом Ленгмюра функции распределения электронов по энергиям (Ф-РЭЭ). Температура электронов определяется по наклону логарифмической кривой вольтамперной характеристики зонда Ленгмюра. По току насыщения положительных ионов (I+) на зонд, записываемому в виде [33, 34]
выполняется оценка концентрации положительных ионов. Здесь A – площадь зонда, n+ – концентрация положительных ионов и M+ – их масса. Плазма в электроотрицательном водороде содержит электроны и положительные и отрицательные ионы. Здесь предполагается, что критерий Бома в отношении образования слоя выполняется даже при наличии отрицательных ионов [33]. Хотя это предположение является недостатком используемого подхода, но его преимущество состоит в том, что для определения концентрации отрицательных ионов не требуется знать их температуру. При вычислении концентрации электронов по ФРЭЭ и концентрации положительных ионов по измеренному току насыщения этих ионов вычисляется концентрация отрицательных ионов на основе условия квазинейтральности (n+ = n– + ne).4. ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Камера для плазмы откачивается до давления (5–6) × 10–6 мбар с помощью турбомолекулярного и центробежного насосов. Газообразный водород инжектируется в камеру, в которой во время эксперимента поддерживается постоянное давление. Эксперимент проводится при давлении в диапазоне от ~5 × 10–3 до ~1 × 10–2 мбар. ВЧ электромагнитная волна, обеспечивающая мощность от 100 до 2700 Вт, вводится через емкостные соединения L-типа в объем с помощью спиралеобразной антенны. В первой камере источника измеряются концентрация плазмы и температура электронов (см. рис. 5 и 6). Измерения выполняются с помощью компенсированного цилиндрического зонда Ленгмюра диаметром острия 0.15 мм и длиной 10 мм.
Рис. 5.
Концентрация плазмы в зависимости от приложенной ВЧ-мощности для разряда в водороде в первой камере источника при давлении 5 × 10–3 мбар и аксиальных магнитных полях 200 и 300 Гс.

Рис. 6.
Температура электронов в зависимости от приложенной ВЧ-мощности для разряда в водороде в первой камере источника при рабочем давлении 5 × 10–3 мбар и аксиальных магнитных полях 200 и 300 Гс.
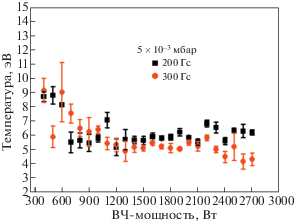
На рис. 5 демонстрируется переход между различными режимами разряда в водороде. Показано, что емкостной режим имеет место при мощностях от ~300 до 1250 Вт, индукционный режим – от ~1250 до 2500 Вт и геликоновый режим – выше ~2500 Вт. Молекула водорода, являясь наименьшей двухатомной молекулой, обладает относительно высоким потенциалом ионизации. Также, из-за высокой подвижности водородных ионов, потери заряженных частиц в плазме водорода больше, чем в других газах. Поэтому, по сравнению с другими газами типа кислорода, для водородной плазмы требуется более высокая мощность электромагнитной волны, чтобы достичь критической концентрации плазмы и обеспечить переход между разными режимами. Как следует из наблюдений, критические значения подводимой мощности, при которых достигаются переходы между режимами, одни и те же при разных магнитных полях.
На рис. 6 показано изменение температуры электронов в первой камере источника с ростом ВЧ-мощности при магнитных полях 200 и 300 Гс и рабочем давлении 5 × 10–3 мбар для разряда в водороде. Поскольку температура электронов измеряется в камере вблизи антенны, то наблюдаются флуктуации ее величины из-за высокой частоты подводимого излучения. Температура электронов составляет ~9 эВ при подводимой ВЧ-мощности ~300–600 Вт и далее падает до ~6–4 эВ. При низкой мощности эта температура очень высокая, а концентрация плазмы в емкостном режиме, наоборот, очень низкая. Таким образом, в емкостном режиме разряда в водороде вложенная в разряд ВЧ-энергия приводит к росту температуры электронов без увеличения их концентрации. Аналогичным образом, высокие значения температуры электронов при низкой ВЧ-мощности наблюдались в разряде для водорода и ранее [35]. При переходе к индуктивному или геликоновому режимам происходит уменьшение температуры электронов, дающее в результате рост концентрации электронов, что указывает на эффективное поглощение подводимой энергии в разряде.
На рис. 7 приведена зависимость потенциала плазмы от ВЧ-мощности для разряда в водороде в первой камере источника при рабочем давлении 5 × 10–3 мбар и магнитных полях 200 и 300 Гс. Из рис. 7 и 5 видно, что снижение потенциала плазмы и рост ее концентрации происходят примерно при одних и тех же значениях вводимой ВЧ-мощности. Резкое падение потенциала плазмы происходит из-за быстрого роста концентрации плазмы, вызванного сменой режима. Это снижение потенциала плазмы является дополнительным индикатором перехода между режимами ВЧ-разряда в водороде. Об аналогичном падении потенциала плазмы вместе с ростом ее концентрации сообщалось ранее в [36].
Рис. 7.
Потенциал плазмы в зависимости от приложенной ВЧ-мощности для разряда в водороде в первой камере источника при рабочем давлении 5 × 10–3 мбар и аксиальных магнитных полях 200 и 300 Гс.
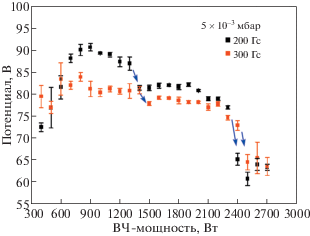
Для подтверждения перехода к геликоновому режиму при ~2600 Вт (см. рис. 5) была сделана оценка ВЧ-мощности, необходимой для этого перехода в разряде в водороде. Оценка производилась на основе уравнения баланса энергии [1]
где n0 – концентрация плазмы, μB – скорость Бома, Aeff – полная эффективная площадь для потерь частиц и εT – энергия, теряемая при уходе одной электрон-ионной пары из плазмы.Как показано на рис. 5, концентрация плазмы после перехода к геликоновому режиму приблизительно равна 2.25 × 1017 м–3. Согласно рис. 6, температура электронов в геликоновом режиме составляет ~3 эВ. Расчет для скорости Бома дает 1 × 104 м/с. Для цилиндрической камеры с плазмой радиусом R и длиной l эффективная площадь потерь частиц равна
где hl = ns,L/n0 – отношение концентраций на краю (ns,L) и в центре (n0) слоя для направления вдоль оси, hR = ns,R/n0 – отношение концентраций на краю (ns,R) и в центре слоя для радиального направления [1, 37]. Приближенные формулы для этих отношений, полученные в модели Годяка, имеют вид [37] где λi – средняя длина пробега ионов по отношению к столкновениям с нейтральными частицами в системе.Полная энергия, теряемая при уходе одной электрон-ионной пары из плазменного объема, равна сумме энергии, теряемой при уходе на стенку камеры электрона, энергии, теряемой при уходе иона, и энергии, необходимой для создания электрон-ионной плазмы в объеме:
где εe = 2Te – потеря энергии на один ушедший электрон и ${{\varepsilon }_{i}} = {{T}_{e}}{\text{/}}2 + {{V}_{s}}$ – потеря энергии на один ушедший ион [1]. Здесь Vs – напряжение на слое для ВЧ-тока, когда это напряжение не слишком велико [1]. Столкновительная потеря энергии εc в зависимости от температуры электронов получена для набора реакций, приведенных в [38] и указанных там ссылках. Зависимости εc от Te для атомарного водорода H и молекул H2 приведены на рис. 8. Из этого рисунка следует, что для температуры электронов ~3 эВ значения столкновительной потери энергии равны ~220 и ~300 эВ в плазме атомарного и молекулярного водорода соответственно. Подставляя в формулу (3) значения Aeff и εT, получаем значения поглощаемой мощности, равные ~1.9 кВт в случае плазмы атомарного водорода и ~2.6 кВт в случае плазмы молекулярного водорода. Разряд в водороде должен содержать и атомарный водород, и молекулярный. Поэтому поглощаемая мощность должна лежать приблизительно между 1.9 и 2.6 кВт. Следовательно, скачок в концентрации на рис. 3 при мощности ~2600 Вт вызван переходом от индуктивного режима к геликоновому. Переход от емкостного режима к индукционному происходит при меньших ВЧ-мощностях, которые, как видно на рис. 5, близки к ~1250 Вт.Рис. 8.
Столкновительная потеря энергии εс в зависимости от температуры электронов Te при ее изменении от 1 до 10 эВ [38].

Далее рассматриваемая система будет характеризоваться сопротивлением плазмы и эффективностью передачи энергии (η). Стандартное уравнение баланса энергии имеет вид ${{P}_{{for}}} - {{P}_{{ref}}} = $ $ = I_{{RMS}}^{2}{{R}_{{eff}}}$, где Pfor – подводимая ВЧ-мощность, Pref – отраженная мощность и IRMS – среднеквадратичный ток через антенну. Из этого уравнения можно вычислить полное эффективное сопротивление (Reff). Оно определяется, если известны параметры устройства согласования в системе ВЧ-генератора. Сопротивление антенны (RAnt), вычисленное для подводимой к ней ВЧ-мощности и используемой системы согласования, оказывается равным ~0.5 Ом [39]. При вычитании сопротивления антенны из эффективного сопротивления получаем сопротивление плазмы (RP). Эффективность передачи энергии (η) равна [40, 41]
Поведение сопротивления плазмы (RP) и эффективности передачи энергии (η) при изменении ВЧ-мощности от 300 до 2700 Вт показано на рис. 9. Сопротивление плазмы равно 0.6 Ом при мощности ниже 1200 Вт, ~0.65 Ом в диапазоне от 1200 до 2500 Вт и близко к ~0.7 Ом при мощности более 2600 Вт. Аналогичным образом, эффективность передачи энергии оказывается вблизи ~0.55 при низкой ВЧ-мощности, слегка увеличивается до ~0.56 при промежуточных значениях мощности и становится равной ~0.58 в геликоновом режиме. В отличие от плазмы аргона, в водороде сопротивление плазмы и эффективность передачи энергии остаются постоянными в широком диапазоне ВЧ-мощностей. Это означает, что в широком диапазоне ВЧ-мощностей концентрация плазмы почти не меняется, и нет необходимости подбирать емкости нагрузки и согласования в устройстве согласования для экспериментов с разрядом в водороде. Малые, но конечные скачки плотности плазмы (Rp) и эффективности передачи энергии имеют место для ВЧ-разряда в водороде при переходе от емкостного (E) режима к индукционному (H), а также от индукционного режима к геликоновому.
Рис. 9.
Сопротивление плазмы (RP) и эффективность передачи энергии (η) в зависимости от приложенной ВЧ-мощности при ее изменении от 300 до 2700 Вт для магнитного поля 300 Гс и рабочего давления 5 × 10–3 мбар.

На рис. 10 приведено изменение тока через антенну и поглощаемой ВЧ-мощности при увеличении приложенной ВЧ-мощности от 300 до 2700 Вт. Поглощаемая мощность вычисляется по формуле ${{P}_{{abs}}} = R{}_{p}I_{a}^{2}{\text{/}}2$ [41, 42], где Ia – максимальный ток через антенну. Видно, что ток в антенне слабо меняется при переходах между режимами, а поглощаемая ВЧ-мощность растет почти линейно с увеличением подводимой мощности. Это происходит так, поскольку скачок сопротивления плазмы мал при смене режима разряда в водороде, в отличие от разряда в аргоне, а изменение ВЧ-тока с ростом приложенной ВЧ-мощности почти линейное. Таким образом, переход между режимами разряда в водороде лучше всего идентифицировать по изменению концентрации плазмы с ростом ВЧ-мощности. В то же время смена режима может мало влиять на ток через антенну и поглощаемую ВЧ-мощность.
Рис. 10.
Ток через антенну и поглощаемая ВЧ-мощность в зависимости от подводимой ВЧ-мощности при ее изменении от 300 до 2700 Вт для аксиального магнитного поля 300 Гс и рабочего давления 5 × 10–3 мбар.

После изучения переходов между разными режимами поддержания водородной плазмы в первой камере источника выполнены исследования генерации отрицательных ионов в расположенной вниз по потоку расширительной камере. Концентрация отрицательных ионов вычисляется методом, описанным в разделе 3.2 на основе измерений планарным зондом. Как сказано в разделе 2, образование отрицательных ионов при диссоциативном прилипании и их разрушение при отрыве электронов зависят от температуры электронов. Поэтому при изучении образования отрицательных ионов важно знать, как меняется электронная температура. На рис. 11 представлена зависимость этой температуры от рабочего давления в диапазоне от 1 × 10–3 и до 1 × 10–2 мбар. Данные приводятся для случаев, когда подводимая ВЧ-мощность равна 500, 1000 и 1500 Вт, а аксиальное магнитное поле в расширительной камере составляет 300 Гс.
Рис. 11.
Температура электронов в расширительной камере в зависимости от рабочего давления при его изменении от 1 × 10–3 до 1 × 10–2 мбар для магнитного поля 300 Гс и подводимой ВЧ-мощности 500, 1000 и 1500 Вт.

Более высокая (~2 эВ) температура наблюдается при более низком давлении, и она падает до ~1 эВ с ростом давления. Уменьшение температуры электронов с давлением связано с большим числом столкновений и с более высокой концентрацией плазмы. С увеличением давления растет количество молекул в камере и число ионизационных столкновений. В результате увеличивается концентрация плазмы и, в конце концов, уменьшается температура электронов. Хотя она в расширительной камере меньше, чем в первой камере источника, значение этой температуры все же достаточно для эффективной генерации отрицательных ионов за счет диссоциативного прилипания.
На рис. 12 приведены концентрации положительных и отрицательных ионов, а также электронов, в расширительной камере в зависимости от рабочего давления. Эти данные получены при магнитном поле 300 Гс и ВЧ-мощности, равной 500, 1000 и 1500 Вт. Видно, что в разряде в водороде концентрация электронов близка к концентрации положительных ионов, а концентрация отрицательных ионов значительно ниже. Однако с ростом давления различие между концентрациями положительных ионов и электронов слегка увеличивается, что свидетельствует о росте концентрации отрицательных ионов при высоких давлениях газа. Хотя электроны и положительные ионы – основные заряженные компоненты для разряда в водороде, значительное количество отрицательных ионов все же там присутствует. При ВЧ-мощности 500 и 1000 Вт концентрация отрицательных ионов лежит между 2–3 × 1013 и 7–8 × × 1014 м–3, а при мощности 1500 Вт она возрастает до ~1 × 1015 м–3. Это связано с общим ростом концентрации плазмы в первой камере источника во время смены режима при 1500 Вт. Следовательно, более высокие значения концентрации отрицательных ионов реализуются при более высоких значениях ВЧ-мощности и рабочего давления. При увеличении давления, как следует из рис. 11, температура электронов уменьшается, и это создает более благоприятные условия для образования отрицательных ионов при диссоциативном прилипании электронов. Также при больших давлениях благодаря меньшей температуре падает скорость отрыва электронов от отрицательных ионов при столкновениях с энергичными электронами (реакция 6 в табл. 1). Оба эти фактора приводят к росту концентрации отрицательных ионов с повышением давления. Также изменение концентрации других заряженных частиц (особенно положительных ионов и электронов) в расширительной камере с ростом ВЧ-мощности оказывается малым. Это является следствием малого изменения концентрации плазмы в первой камере источника и больших потерь частиц и энергии благодаря высокой подвижности легких водородных ионов.
Рис. 12.
Концентрации положительных ионов, отрицательных ионов и электронов в расширительной камере в зависимости от рабочего давления для магнитного поля 300 Гс и подводимой ВЧ-мощности 500 (а), 1000 (б) и 1500 (в) Вт.

Изменения полученной экспериментально концентрации отрицательных водородных ионов при вариации давления и ВЧ-мощности сравниваются с теоретическими значениями, полученными на основе модели баланса частиц [8, 23]. В этой модели заселение колебательно-возбужденных молекул определяется вначале и на более поздней стадии, а также оценивается концентрация отрицательных ионов в расширительной камере. Как упомянуто в разд. 2, отрицательные ионы образуются в два этапа. На первом этапе происходит наработка колебательно-возбужденных молекул водорода $({{{\text{H}}}_{2}}(v{\kern 1pt} '{\kern 1pt} '))$ в первой камере источника, где температура электронов высокая. Колебательно-возбужденные молекулы образуются при столкновении молекул в основном колебательном состоянии с быстрыми электронами, чья энергия превышает 20 эВ [8]. Концентрация молекул H2 (v'') вычисляется по формуле [8, 23]
(9)
$\begin{gathered} {{n}_{v}}({{{\text{H}}}_{2}}(v{\kern 1pt} '{\kern 1pt} ')) = \\ \, = {{n}_{{{{{\text{H}}}_{2}}}}}\frac{{{{f}_{e}}{{K}_{{EV}}}}}{{[(1 - {{f}_{e}}){{K}_{{DA}}} + {{f}_{e}}({{K}_{{Dis}}} + {{K}_{{ion}}})] + \frac{1}{{{{n}_{e}}{{\tau }_{{v}}}}}}}, \\ \end{gathered} $На втором этапе электроны, имеющие низкую энергию, прилипают к колебательно-возбужденным молекулам в процессе, который называется диссоциативным прилипанием. В этом процессе образуются отрицательные ионы водорода (реакция 5 в табл. 1). Выражение для концентрации отрицательных ионов в рамках модели баланса частиц записывается в виде [8, 23]
(10)
${{n}_{ - }} = {{n}_{e}}\frac{{ - \left[ {{{K}_{{Dest}}} + \frac{1}{{{{n}_{e}}{{\tau }_{ - }}}}} \right] + \sqrt {{{{\left[ {{{K}_{{Dest}}} + \frac{1}{{{{n}_{e}}{{\tau }_{ - }}}}} \right]}}^{2}} + 4\left[ {{{K}_{{MN}}}{{K}_{{DA}}}\frac{{{{n}_{{v}}}}}{{{{n}_{e}}}}} \right]} }}{{2{{K}_{{MN}}}}},$Рис. 13.
Сравнение измеренной (зондом Ленгмюра) и вычисленной (с помощью модели баланса частиц) концентрации отрицательных ионов в зависимости от давления, меняющегося между 1 × 10–3 и 1 × 10–2 мбар при ВЧ-мощности 1500 Вт (а) и в зависимости от ВЧ‑мощности, меняющейся между 500 и 1500 Вт при рабочем давлении 1 × 10–2 мбар (б).

Вычисленное значение концентрации отрицательных ионов находится в согласии с измеренной величиной. Как следует из рис. 13а и б и вычисленные, и измеренные концентрации отрицательных ионов показывают одни и те же зависимости от рабочего давления и ВЧ-мощности. В модели на основе баланса частиц не учитываются перенос и диффузия частиц, участвующих в образовании отрицательных ионов (${{{\text{H}}}_{2}}(v{\kern 1pt} '{\kern 1pt} ')$, H+, ${{{\text{H}}}^{ - }}$ и так далее), в магнитном фильтре, и рассматриваются только основные реакции образования и гибели отрицательных ионов. Поэтому расчетные значения концентрации отрицательных ионов значительно отличаются от измеренных величин. Более того, дополнительное различие между экспериментом и расчетом на основе уравнения баланса частиц может следовать из предположения о справедливости критерия Бома и в отношении образования слоя при наличии отрицательных ионов (см. разд. 3.2). Таким образом, имеются ограничения, как в измерениях, так и в модели, использующей баланс частиц.
С ростом рабочего давления или ВЧ-мощности повышается и общая концентрация заряженных частиц в плазме. При этом, следовательно, ожидается и увеличение концентрации отрицательных ионов. Поэтому, чтобы сравнение было более показательным, на рис. 14 приведена зависимость доли отрицательных ионов (α = n– /ne) от рабочего давления при ВЧ-мощности 500, 1000 и 1500 Вт. Из рис. 14 видно, что доля отрицательных ионов находится в диапазоне между ~0.07 и ~0.5. Эта доля медленно и почти линейно растет с рабочим давлением. Данный факт указывает на то, что рост концентрации электронов с увеличением рабочего давления намного меньше по сравнение с ростом концентрации отрицательных ионов. Поэтому, как показано на рис. 12, изменение давления для разряда в водороде оказывает большее влияние на концентрацию отрицательных ионов, чем на концентрации электронов и положительных ионов.
5. ЗАКЛЮЧЕНИЕ
В работе выполнено детальное исследование переходов между режимами ВЧ-разряда в водороде в первой камере источника отрицательных ионов. Также изучалось образование отрицательных ионов в расширительной камере источника. Для перехода между индуктивным и геликоновым режимами в первой камере для разряда в водороде требуется ВЧ-мощность ~2500 Вт при магнитном поле 300 Гс и рабочем давлении 5 × × 10–3 мбар. Эта мощность гораздо больше аналогичной величины для разряда в аргоне, в котором она приблизительно равна 500 Вт [30] или для разряда в кислороде, где она составляет 1200 Вт [39]. Причина такого высокого значения в том, что атом водорода имеет наименьшие размеры и обладает высоким потенциалом ионизации. Также, из-за малых размеров положительных и отрицательных ионов водорода, их подвижность и потери велики. Оба эти фактора: более высокий потенциал ионизации атомов водорода и более высокие потери заряженных частиц в водородной плазме по сравнению с другими газами, приводят к более высоким значениям критической энергии, необходимой для переходов между режимами разряда. Из оценок с помощью уравнения баланса частиц следует, что геликоновый режим должен наступить при мощности 1.9 кВт в случае атомарного водорода и при мощности 2.6 кВт в случае молекулярного водорода. В согласии с этим экспериментально показано, что переход между индуктивным и геликоновым режимами осуществляется при мощности ~2.5 кВт. Скачок сопротивления плазмы и эффективности передачи энергии здесь гораздо меньше, чем в случае разрядов в других газах. Из-за этого поглощаемая ВЧ-мощность меняется с ростом приложенной мощности почти линейно. Образование отрицательных ионов исследуется в расширительной камере источника. Здесь измеренная концентрация отрицательных ионов лежит в диапазоне между 1014 и 1015 м–3. Температура электронов выше при более низких значениях давления и падает с его увеличением. Изменение концентрации электронов и положительных ионов с ростом давления гораздо меньше, чем изменение концентрации отрицательных ионов. Доля отрицательных ионов (отношение их концентрации к концентрации электронов) находится в диапазоне между ~0.07 и ~0.5. Наблюдения показывают, что в случае объемной генерации предпочтительнее создавать отрицательные ионы при более высоких рабочих давлениях.
Авторы благодарны Институту плазменных исследований (Institute for Plasma Research), Gandhinagar, India, за финансовую поддержку проведенных исследований в рамках проекта A30704.
Список литературы
Liebermann M.A., Lichtenberg A.J. Principles of Plasma Discharges and Materials Processing (John Wiley and Sons, New York, 1994).
Chen F.F. Phys. Plasmas. 1996. V. 3. P. 1783.
Briefi S., Fantz U. AIP Conference Proceedings. 2013. V. 1515. P. 278; https://doi.org/10.1063/1.4792795
Marini C., Agnello R., Duval B.P., Furno I., Howling A.A., Jacquier R., Karpushov A.N., Plyushchev G., Verhaegh K., Guittienne Ph. et al., Nucl. Fusion. 2017. V. 57. P. 036024.
Wang S.J., Kwak J.G., Kim C.B., Kim S.K. Phys. Lett. A. 2003. V. 313. P. 278.
Takahashi H., Kasuya T., Wada M. Thin Solid Films. 2006. V. 506–507. P. 575.
Turner I., Holmes A.J.T. AIP Conference Proceedings. 2017. V. 1869. P. 020013.
Pandey A., Mukherjee D., Borah D., Bandyopadhyay M., Tyagi H., Yadav R., Chakraborty A. Plasma Phys. Control. Fusion. 2019. V. 61. P. 065003.
Grill A., Sternhagen V., Neumayer D., Patel V. J. Appl. Phys. 2005. V. 98. P. 074502.
Sauvain E.V., Kroll U., Meier J., Shah A. J. Appl. Phys. 2000. V. 87. P. 3137.
Cielaszyk E.S., Kirmse K.H.R., Stewart R.A., Wendt A.E. Appl. Phys. Lett. 1995. V. 67. P. 3099.
Lee M.H., Jang S.H., Chung C.W. Phys. Plasmas. 2006. V. 13. P. 053502.
Bacal M. Nucl. Fusion. 2006. V. 46. P. S250.
Caneses J.F., Blackwell B.D. Plasma Sources Sci. Technol. 2016. V. 25. P. 055027.
Santoso J., Manoharan R., O’Byrne S., Corr C.S. Phys. Plasmas. 2015. V. 22. P. 093513.
Takahashi K., Takayama S., Komuro A., Ando A. Phys. Rev. Lett. 2016. V. 116. P. 135001.
Faircloth D., Lawrie S. New J. Phys. 2018. V. 20. P. 025007.
Bacal M., Hatayama A.J. Peters, IEEE Trans. Plasmas Sci. 2005. V. 33. P. 6.
Simonin A., Agnello R., Bechu S., Bernard J.M., Blon-del C., Boeuf J.P., Bresteau D., Cartry G., Chaibi W., Drag C. et al., New J. Phys. 2016. V. 18. P. 125005.
Furno I., Agnello R., Fantz U., Howling A., Jacquier R., Marini C., Plyushchev G., Guittienne Ph., Simonin A. EPJ Web of Conferences. 2017. V. 157. P. 03014.
Toader E.I., Covlea V.N., Graham W.G. Plasma Sources Sci. Technol. 2006. V. 15. P. 288.
Mosbach T. Plasma Sources Sci. Technol. 2005. V. 14. P. 610.
Bandyopadhyay M. Studies of an inductively coupled negative hydrogen ion radio frequency source through simulations and experiments, PhD Thesis (Max-Planck-Institut fur Plasmaphysik, Garching, Germany, 2004).
Surrey E., Holmes A.J.T. Plasma Sources Sci. Technol. 2015. V. 24. P. 015035.
Redondo M.J., Carrasco E., Herrero V.J., Tanarro I. Plasma Sources Sci. Technol. 2015. V. 24. P. 015029.
Kraus W., Bandyopadhyay M., Falter H., Franzen P., Heinemann B., McNeely P., Riedl R., Speth E., Tanga A., Wilhelm R. Rev. Sci. Instrum. 2004. V. 75. P. 1832.
Cho W.H., Dang J.J., Kim J.Y., Chung K.J., Hwang Y.S. Rev. Sci. Instrum. 2016. V. 87. P. 02B136.
Fukano A., Ogasawara M. Japan J. Appl. Phys. 2001. V. 40. P. 7072.
Sharma N., Chakraborty M., Neog N.K., Bandyopadhyay M. Fusion Eng. Des. 2017. V. 117. P. 30.
Sharma N., Chakraborty M., Neog N.K., Bandyopadhyay M. Rev. Sci. Instrum. 2018. V. 89. P. 083508.
Aanesland A., Bredin J., Chabert P., Godyak V. Appl. Phys. Lett. 2012. V. 100. P. 044102.
Das B.K., Chakraborty M., Bandyopadhyay M. Phys. Plasmas. 2012. V. 19. P. 092104.
Seo D.C., Chung T.H., Yoon H.J., Kim G.H. J. Appl. Phys. 2001. V. 89. P. 4218.
Johnson J.D., Holmes A.J.T. Rev. Sci. Instrum. 1990. V. 61. P. 2628.
Mukhopadhyay D., Pandey A., Bandyopadhyay M., Tyagi H., Yadav R., Chakraborty A. Rev. Sci. Instrum. 2019. V. 90. P. 083103.
Kaeppelin V., Carrère M., Faure J.B. Rev. Sci. Instrum. 2001. V. 72. P. 4377.
Zorat R., Goss J., Boilson D., Vende D. Plasma Sources Sci. Technol. 2000. V. 9. P. 161.
Hjartarson A.T., Thorsteinsson E.G., Gudmundsson J.T. Plasma Sources Sci. Technol. 2010. V. 19. P. 065008.
Sharma N., Chakraborty M., Neog N.K., Bandyopadhyay M. Plasma Res. Express. 2020. V. 2. P. 015005.
Lafleur T., Charles C., Boswell R.W. J. Phys. D: Appl. Phys. 2011. V. 44. P. 055202.
Soltani B., Habibi M., Zakeri-khatir H. Phys. Plasmas. 2016. V. 23. P. 023507.
Cho S., Kwak J.G. Phys. Plasmas. 1997. V. 4. P. 4167.
Дополнительные материалы отсутствуют.





