Физика плазмы, 2022, T. 48, № 11, стр. 1094-1101
Подавление генерации тяжелых ионов в вакуумном диоде с пассивным анодом
А. И. Пушкарев a, b, *, С. П. Чжу b, Ю. И. Егорова a, А. Прима a, С. С. Полисадов a, М. К. Лэй b
a Томский политехнический университет
Томск, Россия
b Surface Engineering Laboratory, School of Materials Science and Engineering, Dalian University of Technology
Dalian, China
* E-mail: aipush@mail.ru
Поступила в редакцию 06.06.2022
После доработки 12.07.2022
Принята к публикации 18.07.2022
- EDN: BCUOVA
- DOI: 10.31857/S0367292122700202
Аннотация
Представлены результаты моделирования и экспериментального исследования генерации мощного ионного пучка в ионном диоде с пассивным анодом (ускоряющее напряжение 250–300 кВ, длительность импульса 150 нс, энергия пучка в импульсе ≈50 Дж). Выполнены исследования диода с анодом из нержавеющей стали при работе в режиме сдвоенных разнополярных импульсов и формировании плазмы при взрывной эмиссии электронов в течение первого импульса. Получено, что диод с металлическим анодом генерирует ионы азота, содержание более тяжелых ионов материала анода (Fe+) незначительно. Показано, что подавление генерации тяжелых ионов в ионном диоде с пассивным анодом вызвано более высокой скоростью расширения легкого ионного компонента анодной плазмы. Глубина проникновения электрического поля в анодную плазму меньше толщины слоя более легких ионов на ее эмиссионной границе, поэтому происходит эмиссия из анодной плазмы только легких ионов и их ускорение в A–K зазоре. Подавление генерации тяжелых ионов в диоде с пассивным анодом является положительным эффектом, который обеспечивает увеличение ионного тока при работе в режиме ограничения тока объемным зарядом и снижение концентрации примесных ионов.
1. ВВЕДЕНИЕ
Совершенствование продукции машиностроения затруднено без применения новых технологических процессов, позволяющих повысить ресурс и надежность деталей и узлов в самых жестких условиях эксплуатации. Этим вызвано развитие методов поверхностного упрочнения лазерным излучением, электронным пучком, ионной имплантацией, мощными ионными пучками (МИП) и импульсными потоками плазмы. Воздействие МИП длительностью 100–150 нс и плотностью энергии 1–3 Дж/см2 обеспечивает нагрев и охлаждение приповерхностного слоя обрабатываемого изделия со скоростью 108–109 К/с (сверхскоростная закалка), давление при этом достигает (2–6) × 108 Па (сверхмощная ковка). Толщина такого слоя составляет 1–2 мкм и объемная плотность мощности радиационного воздействия достигает 1011 Вт/см3. Это позволяет получать в поверхностных слоях составы и наноразмерные структуры, недоступные другими методами. В результате улучшаются свойства материалов: твердость, прочность, износостойкость; повышаются эксплуатационные характеристики изделий из них. Использование сильноточных электронных пучков для модификации материалов требует значительно более высокой плотности энергии из-за большого пробега электронов, превышающего сотни микрон в металлах.
При генерации МИП в вакуумном диоде возникают коллективные эффекты и ионный ток ограничивается объемным зарядом ионов в анод-катодном (A–K) зазоре [1, 2]. При ускоряющем напряжении 250–300 кВ, длительности импульса 0.1 мкс и A–K зазоре 7–8 мм поверхностная плотность энергии МИП (далее плотность энергии МИП) не превышает 0.1–0.2 Дж/см2 [3]. Однако для модификации поверхностного слоя металлической мишени (нагрев и плавление), плотность энергии МИП должна превышать 2–3 Дж/см2 при длительности импульса не более 0.1 мкс [4]. Увеличение длительности импульса приводит к увеличению глубины прогрева мишени без существенного роста температуры. Увеличение плотности энергии МИП без изменения длительности импульса можно получить увеличением ускоряющего напряжения. Однако генерация ионов в вакуумном диоде сопровождается генерацией электронов с той же энергией, при этом КПД диода (отношение полной энергии МИП за импульс к энергии, потребленной диодом) не превышает 30%. Интенсивность тормозного рентгеновского излучения при поглощении в металлах электронов с энергией выше 500 кэВ значительно возрастает [5], что требует дополнительной радиационной защиты.
В вакуумном диоде при работе в режиме ограничения тока объемным зарядом плотность ионного тока обратно пропорциональна массе ионов, j ∼ (mi)–0.5 [1] и для увеличения ионного тока необходимо ускорять легкие ионы. Состав МИП зависит от состава анодной плазмы и для генерации протонного пучка необходимо использовать диод с газоразрядным источником анодной плазмы. В генераторе RHEPP-1 (1 МэВ, 0.1 мкс) [6] используется ионный диод с внешним магнитным полем, анодная плазма формируется при высокочастотном пробое потока водорода или дейтерия в A–K-зазоре. В работе [7] представлен анодный источник плазмы для генерации МИП (150 кВ, 100 А/см2, 1 мкс). Этот источник использует высокочастотный разряд в газовой сверхзвуковой струе. Ионный диод с магнитной изоляцией и конической баллистической фокусировкой ионов представлен в [8]. Источник плазмы расположен внутри анодной полости и включает в себя электродинамический клапан, сопло Лаваля для напуска газа и ударную катушку для ионизации газа. Сложные системы напуска в A–K зазор газа со сверхзвуковой скоростью и его ионизации, необходимость синхронизации разных устройств значительно усложняют конструкцию ускорителя с газоразрядным анодом, снижают КПД ускорителя и частоту следования импульсов.
Ионные диоды с пассивным анодом не требуют предварительного формирования анодной плазмы и сложной системы синхронизации, особенно диоды с магнитной самоизоляцией электронов [2]. В ионном диоде с диэлектрическим покрытием на аноде образование плазмы происходит за счет пробоя на поверхности диэлектрика [2, 9]. При работе ионного диода в режиме сдвоенных разнополярных импульсов образование плазмы происходит за счет взрывной электронной эмиссии во время первого импульса отрицательной полярности [10]. Однако ионный диод с пассивным анодом формирует пучок тяжелых ионов, его состав определяется материалом анода [2, 11]. Даже при использовании полиэтилена (CnH2n+ 1) в качестве диэлектрического покрытия на аноде содержание протонов не превышает 50% [9]. Целью работы является моделирование и экспериментальное исследование генерации импульсного ионного пучка сложного состава в диоде с пассивным анодом, анализ условий снижения концентрации тяжелых ионов.
2. ЭКСПЕРИМЕНТАЛЬНЫЙ СТЕНД
Эксперименты проводили на ускорителе ТЕМП-6 [12], который состоит из генератора Аркадьева–Маркса, двойной формирующей линии (ДФЛ) и вакуумного ионного диода с пассивным анодом. Анод полуцилиндрической фокусирующей конфигурации выполнен из нержавеющей стали, имеет радиус изгиба 14 см, длину 20 см и ширину 10 см. Катод изготовлен из металлической полосы шириной 5 см, длиной 25 см и толщиной 2 мм, радиус изгиба 13 см. Катод имеет пазы размером 0.4 × 2 см и прозрачность 70%. На катоде установлен металлический экран, который устраняет паразитные электромагнитные поля в области дрейфа ионов. A–K-зазор выбран из условия согласования импеданса диода с волновым сопротивлением ДФЛ (4.9 Ом), он составлял 8 мм в начале диода и 10 мм в конце диода. На рис. 1 показана схема диодной камеры и фотография диода.
Исследования выполнены при работе ускорителя в режиме формирования двух импульсов: первый (плазмообразующий) отрицательный (200−300 кВ, 450 нс) и второй (генерирующий) положительный (250−300 кВ, 150 нс). Ускоряющее напряжение измеряли с помощью делителя напряжения, который был установлен в переходной камере между ДФЛ и диодной камерой. Полный ток в диоде измеряли поясом Роговского. Электрические сигналы от датчиков регистрировали осциллографом Tektronix DPO 2024B (200 МГц, 5 × 109 отсчетов/с).
Для анализа состава МИП использовали времяпролетную диагностику с коллимированным цилиндром Фарадея (КЦФ) с магнитной отсечкой электронов (B = 0.2 Тл) в качестве регистрирующего устройства для ионов, разрешение по времени 1 нс [13]. Распределение плотности энергии МИП по сечению определяли с помощью тепловизионной диагностики, пространственное разрешение 2 мм [13, 14]. Для регистрации теплового изображения МИП на мишени (нержавеющая сталь 125 × 150 мм2, толщина 0.1 мм) использовали тепловизор Fluke Ti400 в режиме видео, 11 кадров в секунду.
3. ЭКСПЕРИМЕНТАЛЬНОЕ ИССЛЕДОВАНИЕ СОСТАВА ИОННОГО ПУЧКА
В первой серии экспериментов давление в диодной камере составляло 2–3 мПа и остаточный газ состоял в основном из азота. На рис. 2 показана осциллограмма ускоряющего напряжения и результаты времяпролетной диагностики состава МИП, КЦФ расположен на расстоянии 13 см от катода, в фокусе диода. Цифра перед обозначением иона соответствует коэффициенту усиления плотности ионного тока в соотношении (1).
Рис. 2.
Осциллограммы ускоряющего напряжения и плотности ионного тока (точки). Расчетная плотность ионов (линия).
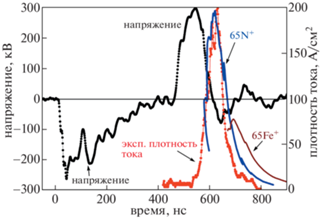
При времяпролетной диагностике состава МИП для каждого момента времени (шаг 1 нс) рассчитывалась плотность тока определенного типа ионов и задержка поступления этих ионов в КЦФ [13]. Рассчитанные кривые сопоставляли с экспериментальными данными. Такой метод позволяет более точно определять состав МИП, чем по задержке максимальной плотности ионного тока от максимальной амплитуды ускоряющего напряжения [15–18].
В режиме ограничения ионного тока объемным зарядом ионов [1] и в нерелятивистском приближении, принимая во внимание уменьшение A–K-зазора из-за расширения плазмы и эффект плазменной эрозии при изменении полярности ускоряющего напряжения [2], плотность ионного тока равна [3, 13]
(1)
$j(t) = \frac{{4K{{\varepsilon }_{0}}\sqrt {2z} }}{{9\sqrt {{{m}_{i}}} }}\frac{{{{U}^{{3/2}}}}}{{{{{[{{d}_{0}} - v(t - {{t}_{0}})]}}^{2}}}}\;{\text{A/с}}{{{\text{м}}}^{{\text{2}}}},$Коэффициент усиления в уравнении (1) учитывает увеличение плотности ионного тока по сравнению с одномерным соотношением Чайлда–Ленгмюра [1] и фокусировку МИП, его значение в расчетах было постоянным в течение импульса. Коэффициент усиления ионного тока определялся из сравнения расчетной плотности тока с экспериментальными данными (см. рис. 2). Скорость расширения плазмы (1.2 см/мкс) определялась по импедансу диода методом, описанным в [3].
Результаты времяпролетной диагностики можно использовать для расчета плотности энергии МИП, равной интегралу произведения ускоряющего напряжения на расчетную плотность ионного тока:
(2)
$\begin{gathered} {{q}_{{расч}}} = \int\limits_{{{t}_{0}}}^\infty {U(t)j(t)dt} = \\ \, = \frac{{4K{{\varepsilon }_{0}}\sqrt {2z} }}{{9\sqrt {{{m}_{i}}} }}\int\limits_{{{t}_{o}}}^\infty {\frac{{{{U}^{{5/2}}}(t)dt}}{{{{{[{{d}_{0}} - v(t - {{t}_{0}})]}}^{2}}}}} \;{\text{Дж/с}}{{{\text{м}}}^{{\text{2}}}}. \\ \end{gathered} $Выполненные исследования показали, что ионный диод с анодом из нержавеющей стали генерирует в основном ионы N+, содержание ионов материала анода незначительно. Молекулы азота составляют более 80% остаточной газовой атмосферы, поэтому в ионном пучке регистрируются в основном ионы азота, вклад ионов кислорода, водорода и углерода в анодную плазму незначителен и не превышает погрешность времяпролетной диагностики.
Измерение плотности энергии МИП подтверждает корректность времяпролетной диагностики. На рис. 3 показаны результаты тепловизионной диагностики. Мишень помещали на расстоянии 13 см от катода, в фокусе диода. Плотность энергии МИП рассчитывали по соотношению [13]
где ${{c}_{{v}}}$ – удельная теплоемкость материала мишени; Δ и ρ – толщина и плотность мишени; Т0 и Т(x, y) – температура мишени до и после облучения; K1 – коэффициент прозрачности оптического окна; K2 – коэффициент, учитывающий вклад радиационных дефектов [13]. K1 = 1.4 для окна из BaF2 толщиной 8 мм, K2 = 1.22 для мишени из нержавеющей стали.Рис. 3.
Термограмма МИП и распределение плотности энергии в фокусе в вертикальном и горизонтальном сечениях.

Для экспериментальных данных рис. 2 плотность энергии МИП, рассчитанная по соотношению (2) (для ионов N+ при K = 65), составляет 3.4 Дж/см2, что на ≈10% меньше результатов тепловизионной диагностики (см. рис. 3). Это несоответствие вызвано вкладом в нагрев мишени атомов, полученных в результате перезарядки ускоренных ионов [13].
Наши исследования показали, что с увеличением амплитуды первого импульса кратность ионизации ионов азота в анодной плазме возрастает от N+ до N2+ (см. рис. 4). Плотность энергии МИП, рассчитанная по данным рис. 4 (ионы N2+, K = 100), равна 4.3 Дж/см2, что на ≈18% ниже результатов тепловизионной диагностики, см. рис. 5. Плотность энергии МИП при этом составляла 5.1 Дж/см2 при среднеквадратичном отклонении 4%.
Рис. 4.
Осциллограммы ускоряющего напряжения и плотности ионного тока (точки). Расчетная плотность ионов (линия).

В следующей серии экспериментов мы изменили состав остаточного газа в диодной камере. Камеру предварительно откачали до давления 2–3 мПа, а затем напустили аргон с парциальным давлением 87 мПа. На рис. 6 показаны результаты времяпролетной диагностики состава МИП, КЦФ расположен на расстоянии 13 см от катода, в фокусе диода.
Рис. 6.
Осциллограммы ускоряющего напряжения, второй импульс, и плотности ионного тока (точки). Расчетная плотность ионов (линия).
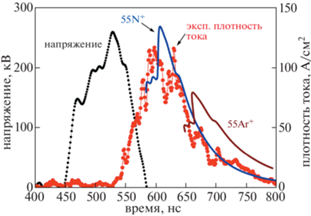
При исследовании генерации МИП при напуске аргона мы уменьшили амплитуду первого импульса напряжения с 300 кВ (см. рис. 4) до 250 кВ. Это изменило условия формирования взрывоэмиссионной плазмы, кратность ионизации ионов азота уменьшилась, однако их концентрация в пучке также превышала 95%.
4. МОДЕЛИРОВАНИЕ ГЕНЕРАЦИИ МИП
Согласно современным представлениям о генерации МИП в диоде с пассивным анодом состав ионного пучка должен соответствовать составу материала анода [2]. Ионный диод с полиэтиленовым (CnH2n + 1) покрытием на аноде генерирует ионы углерода (≈50%) и протоны [9]. При использовании графитового анода и взрывной эмиссии электронов для формирования плазмы ионный пучок содержит в основном ионы углерода [13]. Однако наши исследования показали, что ионный диод с металлическим анодом генерирует в основном ионы рабочего газа в диодной камере, содержание ионов материала анода незначительно [19]. При этом генерации пучка ионов инертного газа не происходит.
Генерация импульсного ионного пучка в вакуумном диоде с пассивным анодом сопровождается расширением анодной плазмы с поверхности анода в A–K-зазор. Подавление генерации тяжелых ионов в ионном диоде с пассивным анодом может быть вызвано разной скоростью расширения разных компонент анодной плазмы. Более тяжелые ионы имеют меньшую скорость и при расширении анодной плазмы ее внешняя (эмиссионная) граница будет содержать в основном легкие ионы. В ионном диоде эмиссия ионов происходит из поверхностного слоя анодной плазмы, глубина которого определяется глубиной проникновения электрического поля. Если эта глубина не превышает толщину внешнего слоя легких ионов, то концентрация тяжелых ионов в МИП будет низкой [19].
В работе [20] приведены результаты моделирования (method of particle-in-cell) распределения компонент катодной плазмы, содержащей протоны и ионы С+, в A–K-зазоре вакуумного диода. Показано, что через 5 нс после приложения напряжения протоны составляют внешний слой толщиной ≈40 мкм на эмиссионной границе плазмы.
При формировании взрывоэмиссионной плазмы в вакуумном диоде можно выделить два режима: режим дискретной эмиссионной поверхности и режим ограничения объемным зарядом [21]. С момента приложения напряжения к диоду до формирования сплошной плазменной поверхности на катоде (режим дискретной эмиссионной поверхности) ток диода ограничивается эмиссионной способностью катода, так как взрывоэмиссионная плазма на рабочей поверхности катода формируется в виде отдельных эмиссионных центров [21]. После формирования первых эмиссионных центров происходит подавление формирования других центров из-за выравнивания напряженности электрического поля (эффект экранировки) [22]. После формирования сплошного плазменного слоя процесс взрывной эмиссии прекращается, так как толщина плазменного слоя существенно превышает высоту микроострий и локальное усиление электрического поля отсутствует. Генерация новых эмиссионных центров в результате усиления ионного тока из анодной плазмы на микроострия на поверхности катода [11, 21, 23] возможна только до формирования сплошного плазменного слоя на катоде. Зарядка диэлектрических включений и пленок на аноде потоком ионов из плазмы и их последующий пробой [23, 24] также возможны только в режиме дискретной эмиссионной поверхности. В работе [25] показано, что концентрация взрывоэмиссионной плазмы в прикатодной области составляет ≈1014 см–3, а затем спадает обратно пропорционально квадрату расстояния. Тогда в течение генерации МИП, через 500–600 нс (см. рис. 2), ее концентрация на эмиссионной границе составит ≈1012 см–3.
При работе ускорителя в режиме разнополярных сдвоенных импульсов и формировании плазмы при взрывной эмиссии электронов в течение первого импульса, в течение генерации МИП (второй импульс) ионный компонент анодной плазмы будет находиться в термодинамическом равновесии и распределение ионов по скоростям описывается распределением Максвелла
(4)
${{F}_{M}}({{v}_{i}}) = 4\pi v_{i}^{2}{{\left( {\frac{{{{m}_{i}}}}{{2\pi k{{T}_{{ион}}}}}} \right)}^{{3/2}}}\exp \left( { - \frac{{mv_{i}^{2}}}{{2k{{T}_{{ион}}}}}} \right),$На рис. 7 показано распределение концентрации ионов в A–K-зазоре через 15 нс после изменения полярности ускоряющего напряжения (t = t0 + 15 нс, см. рис. 2) при температуре взрывоэмиссионной плазмы 4 эВ [11, 26].
Рис. 7.
Распределение концентрации ионов и напряженности электрического поля в A–K-зазоре. Анод из нержавеющей стали.
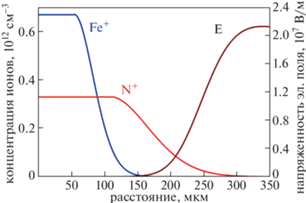
Расчет распределения концентрации i-го компонента ионов выполнен по соотношению
где $x = {{v}_{i}}\left( {t - {{t}_{0}}} \right)$, n0 – концентрация анодной плазмы, $F_{M}^{{\max }}$ – максимальное значение ${{F}_{M}}\left( {{{{v}}_{i}}} \right)$, Ai – относительная концентрация i-го компонента ионов в анодной плазме.Расчет выполнен при условии, что при t = t0 внешняя граница анодной плазмы находится в точке x = 0, при этом концентрация плазмы равна 0 при x > 0 и 1012 см–3 при x < 0. Состав анодной плазмы – 67% ионы Fe+ и 33% ионы N+ (взрывная эмиссия Fe2N).
Расстояние, на котором напряженность электрического поля в плазме снижается в 2.7 раза (радиус Дебая) равно [2, 27]
где e – заряд электрона.На рис. 7 показано распределение напряженности электрического поля в A–K-зазоре при ускоряющем напряжении 200 кВ и A–K-зазоре 9 мм. Расчет напряженности электрического поля выполнен по соотношению
(7)
$E(x) = \frac{{{{U}_{0}}}}{{{{d}_{0}} - vt}}\exp \left( { - \frac{{L - x}}{{{{\lambda }_{D}}(x)}}} \right),$Соотношение (7) учитывает ослабление электрического поля в приповерхностном слое анодной плазмы за счет экранирования и увеличения концентрации плазмы с ростом глубины проникновения электрического поля.
Выполненное моделирование показало, что глубина проникновения электрического поля в анодную плазму меньше толщины слоя более легких ионов на ее эмиссионной границе, поэтому в течение генерации МИП должна происходить эмиссия из анодной плазмы только более легких ионов и их ускорение в A–K-зазоре.
Аналогичные результаты подавления генерации тяжелых ионов были получены при исследовании генерации МИП в вакуумном диоде с алюминиевым анодом в режиме разнополярных сдвоенных импульсов и формировании плазмы при взрывной эмиссии электронов в течение первого импульса [28]. Пучок содержал ионы алюминия (30%), ионы углерода и протоны. На рис. 8 показано распределение концентрации ионов в A–K-зазоре диода при $t - {{t}_{0}} = 15$ нс, температуре плазмы 4 эВ и концентрации ионов 1012 см−3. Состав анодной плазмы 57% ионов Al+ и 43% ионов C+ (взрывная эмиссия карбида алюминия Al4C3). На рис. 8 также показано распределение электрического поля в A–K-зазоре при ускоряющем напряжении 200 кВ и зазоре 9 мм.
Рис. 8.
Распределение концентрации ионов и напряженности электрического поля в A–K-зазоре. Алюминиевый анод.
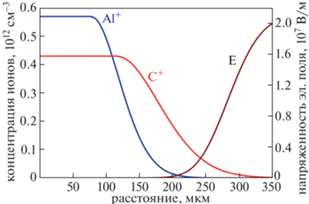
Моделирование показало, что для диода с алюминиевым анодом глубина проникновения электрического поля в анодную плазму больше толщины слоя ионов углерода на его эмиссионной границе, поэтому в течение генерации МИП ионы Al+ также эмитируют из анодной плазмы и ускоряются в A–K-зазоре.
5. ЗАКЛЮЧЕНИЕ
Выполненные исследования показали, что ионный диод с пассивным анодом из нержавеющей стали генерирует ионы азота, содержание более тяжелых ионов материала анода (Fe+) в МИП незначительно. Корректность времяпролетной диагностики подтверждают результаты измерения плотности энергии МИП. При этом генерации пучка ионов инертного газа не происходит. Подавление генерации тяжелых ионов в ионном диоде с пассивным анодом вызвано разной скоростью расширения разных компонент анодной плазмы. Более тяжелые ионы имеют меньшую скорость и при расширении анодной плазмы ее внешняя (эмиссионная) граница будет содержать в основном легкие ионы. Глубина проникновения электрического поля в анодную плазму меньше толщины слоя более легких ионов на ее эмиссионной границе, поэтому в течение всего времени генерации МИП в основном происходит эмиссия из анодной плазмы более легких ионов и их ускорение в A–K-зазоре.
Подавление генерации тяжелых ионов является положительным эффектом, он обеспечивает увеличение плотности ионного тока при работе в режиме ограничения объемным зарядом и снижение концентрации примесных ионов. Кроме того, новый эффект позволяет легко регулировать состав ионного пучка изменением рабочего газа (кроме инертных газов) в диодной камере без изменения конструкции диода. Ионный диод с анодом из нержавеющей стали обеспечивает высокую стабильность параметров МИП в серии импульсов; стандартное отклонение полной энергии и плотности энергии в фокусе не превышает 10%.
Эксперименты на ускорителе TEMP-6 и анализ экспериментальных данных выполнены при поддержке National Natural Science Foundation of China under Grant No. 51621064. Моделирование подавления генерации тяжелых ионов выполнено при поддержке гранта РФФИ № 19-38-90001.
Список литературы
Langmuir I. // Phys. Rev. 1913. V. 2. P. 450.
Humphries S. Charged Particle Beams. N. Y.: Wiley, 1990.
Пушкарев А.И., Егорова Ю.И., Прима А.И., Корусенко П.М., Несов С.Н. Генерация, диагностика и применение мощных ионных пучков с высокой плотностью энергии. Новосибирск: АНС “СибАК”, 2019.
Yu X., Shen J., Isakova Y.I., Zhong H., Zhang J., Yan S., Zhang G., Zhang X., Le X. // Vacuum. 2015. V. 122. P. 12.https://doi.org/10.1016/j.vacuum.2015.09.006
Sigmund P. Particle Penetration and Radiation Effects. General Aspects and Stopping of Swift Point Charges. Springer Series Solid-state sciences. Springer, 2005.
Renk T.J., Schall M., Cooper G.W. // SANDIA REPORT SAND2009-8165, 2009. https://digital.library.unt.edu/ark:/67531/metadc1014854/.
Greenly J.B., Ueda M., Rondeau G.D., Hammer D.A. // J. Applied Phys. 1988. V. 63. P. 1872.https://doi.org/10.1063/1.339884
Bystritsky V.M., Dudkin G.N., Nechaev B.A., Padal-ko V.N. // Phys. Particles and Nuclei. 2017. V. 48(4). P. 659.https://doi.org/10.1134/S1063779617040025
Pushkarev A. // Phys. Plasmas. 2015. V. 22. P. 103106.https://doi.org/10.1063/1.4933215
Логачев Е.И., Ремнев Г.Е., Усов Ю.П. // Письма в ЖТФ. 1980. Т. 6. С. 1404.
Месяц Г.А., Проскуровский Д.И. Импульсный электрический разряд в вакууме. Новосибирск: Наука, 1984.
Ремнев Г.Е. Получение мощных ионных пучков для технологических целей // Автореферат дисс… д-ра техн. наук в форме научного доклада. Томск, 1994.
Пушкарев А.И., Прима А.И., Егорова Ю.И., Ежов В.В. // ПТЭ. 2020. Вып. 3. С. 5.https://doi.org/10.31857/S0032816220030143
Davis H.A., Bartsch R.R., Olson J.C., Rej D.J., Waganaar W.J. // J. Appl. Phys. 1997. V. 82. P. 3223.https://doi.org/10.1063/1.365629
Paperny V.L., Chernih A.A., Astrakchantsev N.V., Lebe-dev N.V. // J. Phys. D: Appl. Phys. 2009. V.42. P. 155201.https://doi.org/10.1088/0022-3727/42/15/155201
Yushkov G.Yu., Vodopyanov A.V., Nikolaev A.G., Izo-tov I.V., Savkin K.P., Golubev S.V., Oks E.M. // Rev. Sci. Instrum. 2014. V. 85. P. 02B902.https://doi.org/10.1063/1.4824644
Фурман Э.Г., Степанов А.В., Фурман Н.Ж. // ЖТФ. 2007. Т. 77. С. 86.
Шаманин В.И., Степанов А.В., Рысбаев К.Ж. // Известия высших учебных заведений. Физика. 2017. Т. 60. С. 53.
Pushkarev A.I., Prima A.I., Zhu X.P., Zhang C.C., Li Y., Egorova Yu., Lei M.K. // Proc. 15th Int. Conf. Gas Discharge Plasmas and Their Applications. Ekaterinburg, 2021. P. 216.
Xu Q.F., Liu L. // Phys. Plasmas. 2012. V. 19. 093111.https://doi.org/10.1063/1.4752075
Месяц Г.А. Импульсная энергетика и электроника. М.: Наука, 2004.
Беломытцев С.Я., Коровин С.Д., Месяц Г.А. // Письма в ЖТФ. 1980. Т. 6. С. 1089.
Озур Г.Е., Проскуровский Д.И. Источники низкоэнергетических сильноточных электронных пучков с плазменным анодом. Новосибирск: Наука, Изд-во СО РАН, 2018.
Месяц Г.А. // ПМТФ. 1980. Вып. 5. С. 138.
Yarmolich D., Vekselman V., Gurovich V., Gleizer J.Z., Felsteiner J., Krasik Ya.E. // Phys. Plasmas. 2008. V. 15. 123507.https://doi.org/10.1063/1.3041162
Li L.M., Chang L., Zhang L., Liu J., Chen G., Wen J. // Laser Particle Beams. 2012. V. 30. P. 541.https://doi.org/10.1017/S0263034612000468
Морозов А.И. Введение в плазмодинамику. М.: Физматлит, 2006.
Шаманин В.И., Ремнёв Г.Е., Тарбоков В.А. // ПТЭ. 2020. Вып. 4. С. 35.
Дополнительные материалы отсутствуют.




