Известия РАН. Серия физическая, 2019, T. 83, № 6, стр. 747-749
Зависимость формы дислокационных ямок травления в эпитаксиальных пленках GеSi (001) на Si от толщины пленки
А. С. Дерябин 1, Л. В. Соколов 1, Е. М. Труханов 1, *
1 Федеральное государственное бюджетное учреждение науки Институт физики полупроводников
имени А.В. Ржанова Сибирского отделения Российской академии наук
Новосибирск, Россия
* E-mail: trukh@isp.nsc.ru
Поступила в редакцию 20.11.2018
После доработки 16.12.2018
Принята к публикации 25.02.2019
Аннотация
С помощью атомно-силового микроскопа и структурно-чувствительного травления эпитаксиальных пленок GeSi на Si(001) исследована кристаллография четырехугольного контура, ограничивающего дислокационную ямку травления в плоскости поверхности пленки. В зависимости от таких характеристик пленки как ее толщина и наличие дислокационных полос скольжения стороны контура могут быть параллельными как направлениям типа 〈110〉, так и направлениям 〈010〉. Ямки травления ограничены низкоиндексными фасетками {111} и {110}, и согласно электрохимической гипотезе их формирование обусловлено распределением напряжений вблизи полос скольжения.
ВВЕДЕНИЕ
Поле напряжений эпитаксиальной пленки обычно снимается дислокациями несоответствия (ДН), которые расположены в границе раздела. Их удлинение обусловлено скольжением пронизывающих дислокаций (ПД), играющих принципиально важную роль при протекании процесса пластической релаксации напряжений несоответствия. Вследствие различных причин ПД останавливаются, накапливаясь в пленке. Они частично сохраняются после полного завершения релаксационного процесса, что ухудшает электронные свойства полупроводников. Важной проблемой эпитаксиального материаловедения является уменьшение количества ПД в выращенной пленке. Ее решение требует всестороннего изучения как природы пронизывающих дислокаций, так и особенностей их выявления.
1. ФОРМА ДИСЛОКАЦИОННЫХ ЯМОК ТРАВЛЕНИЯ
Распространенным способом обнаружения ПД является использование химического структурно-чувствительного травления. С его помощью формируются ямки травления в местах выхода ПД на поверхность пленки. На рисунках представлены полученные с помощью атомно-силовой микроскопии (АСМ) картины поверхности эпитаксиальных пленок GeSi. Использовался травитель Шиммеля, содержащий HF 250 г ∙ л–1 и Cr2O3 10 г ∙ л–1. У ямок травления стороны контура параллельны направлениям типа 〈110〉 (рис. 1а) или направлениям типа 〈010〉 (рис. 2). Наиболее отчетливо это выражено для ямок, указанных стрелками. Отметим, что варианты ориентации сторон, представленные на указанных рисунках, известны в литературе (см., например, [1–3]), однако в условиях использования травителя одного состава смена ориентации сторон в зависимости от режима получения пленки зарегистрирована впервые. Природа явления, обусловливающего различную кристаллографическую ориентацию сторон контура, обсуждается в предлагаемой работе с привлечением эффекта электрохимического травления.
Рис. 1.
Ямки травления (указаны стрелками) со сторонами контура, параллельными направлениям типа 〈110〉, и поверхностные ступени 1 и 2 (а); схема расположения параллельных направлению [110] ступеней 1 (б); схема расположения параллельных [–110] ступеней 2 (в). Эпитаксиальная пленка Ge0.57Si0.43 толщиной 1 мкм на Si(001).
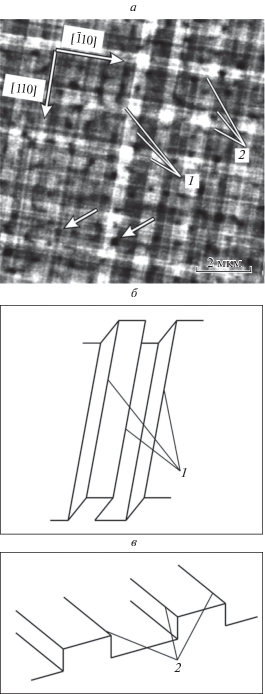
2. ОБРАЗОВАНИЕ СТУПЕНЕЙ НА ПОВЕРХНОСТИ GeSi ПЛЕНКИ
Одиночная ПД, скользящая в наклонной плоскости и удлиняющая ДН, формирует на поверхности пленки моноатомную ступень, которая параллельна ДН. Если же в общей наклонной плоскости скользит значительное количество ДН, то возникает многоатомная ступень, которую можно зарегистрировать с помощью АСМ. Такие ступени представлены на рис. 1а. Они расположены между чередующимися светлыми и темными полосами шириной доли микрометра. Светлые полосы демонстрируют террасы, уровень которых выше среднего уровня свободной поверхности пленки, а темные полосы – пониженные террасы. Для приблизительно вертикальных (1) и горизонтальных (2) многоатомных ступеней, которые разделяют полосы-террасы противоположного контраста, соответствующие пояснения их геометрии представлены на схемах рис. 1б и рис. 1в. Отметим, что образование возвышающихся или пониженных террас объясняется присутствием краевой составляющей вектора Бюргерса ДН, которая перпендикулярна границе раздела [4].
На рис. 2 также зарегистрированы приблизительно вертикальные (1) и горизонтальные (2) ступени, высоты которых превышают моноатомные. Ступени выражены менее отчетливо, чем на рис. 1а. Выполненный нами экспериментальный анализ позволяет утверждать, что стороны контура ямок травления параллельны направлениям типа 〈010〉, если, во-первых, толщина h эпитаксиальной пленки GeSi меньше 1 мкм, и во-вторых, если присутствуют дислокационные полосы скольжения, сопровождающиеся возникновением СТМ изображений ступеней типа представленных на рис. 1а и рис. 2. Если же h > 1 мкм, или если отсутствует СТМ изображение ступеней, то стороны контура ямок параллельны направлениям 〈110〉. В работе предложена гипотеза, объясняющая это оригинальное явление в рамках электрохимического механизма травления. Отметим, что на образце (рис. 1) также были зарегистрированы отдельные ямки травления, имеющие ребра 〈010〉.
3. ЭЛЕКТРОХИМИЧЕСКАЯ МОДЕЛЬ ФОРМИРОВАНИЯ ФАСЕТОК {111} и {011}
Можно предположить, что обсуждаемые ребра 〈110〉 и 〈010〉 ограничивают фасетки, соответственно, типа {111} и {110}. В соответствии с изложенным текстом, по мере увеличения толщины пленки h образование фасеток {110} прекращается, и возникают только фасетки {111}. Аналогичная особенность была установлена для фасеток {111} и {110} (см. [5] а также [1, Fig. 28]): в процессе электро-химического травления пассивированной поверхности монокристаллов различных сплавов Сr–Fе с уменьшением скорости растворения сохранялись только фасетки {111}. Обратим внимание, что в наших исследованиях травление Ge выполнялось при отсутствии искусственно наложенного электрического поля. Однако в работе [6, стр. 341] П. Холмс пишет о возможности возникновения “гальванического” эффекта, при структурно-чувствительном травлении поверхности полупроводника, которая содержит выходы дислокаций. Разность потенциалов возникает между областью вблизи пронизывающей дислокации, на которой присутствует атмосфера Коттрела, и областью кристалла, удаленной от ПД. Для объяснения экспериментальных данных, представленных на рис. 1 и 2, примем, что фасетки типа {011} возникают, когда существует зависимость потенциала Е от толщины пленки. Естественно предположить, что вблизи ПД потенциал Е не зависит от толщины пленки h и определяется преимущественно характером атмосферы Коттрела на пронизывающей дислокации. Для варианта толстой пленки (h ≥ 1 мкм) из-за значительного удаления свободной поверхности пленки от дислокационной границы раздела потенциал Е вдали от пронизывающей дислокации также не зависит от h. Однако в случае h < 1 мкм вдали от ПД, по-видимому, возникает существенная зависимость Е(h), если эпитаксиальная пленка содержит группы дислокаций несоответствия, которые скользят в общей плоскости и формируют немоноатомные ступени на поверхности пленки. Обратим внимание, что если наклонная плоскость скольжения содержит одиночную ДН, то дислокация располагается строго в границе раздела. Если же в общей плоскости скользят две ДН, то одна из них смещается от границы раздела в пленку, а другая – в подложку. Чем больше дислокаций скользят в общей плоскости, тем значительней создаваемое ими поле напряжений отличается от поля одиночной ДН. На свободной поверхности пленки при этом формируется многоатомная ступень. При наличии немоноатомной ступени в окрестности наклонной плоскости скольжения, по-видимому, возникает такая особенность дислокационной структуры пленки, которая и обусловливает зависимость Е(h), необходимую для возникновения фасеток {110}, вытравливаемых вблизи ПД.
ЗАКЛЮЧЕНИЕ
В завершение статьи укажем, что в большой обзорной работе [3] представлены экспериментальные данные о нетипичном характере дислокационных ямок травления в эпитаксиальных слоях GeSi на Si, когда стороны ямок параллельны направлениям 〈010〉. На стр. 190 работы [3, Fig. 6.19] приведен оптический снимок картины дефектов травления в образце 75051. Хорошо видны полосы скольжения, расположенные вдоль направлений типа 〈110〉. Рисунок содержит несколько десятков изображений четырехугольных ямок травления. Отчетливо видно, что все стороны ямок параллельны направлениям 〈010〉. Смена направления сторон ямок в зависимости от условий роста пленок авторами не наблюдалась. Обсуждаемая в нашей работе зависимость ориентации сторон ямок травления от электрохимического потенциала в пленке требует своего дальнейшего исследования.
Авторы выражают благодарность К.Б. Фрицлеру за помощь на различных этапах исследований.
Список литературы
Heimann R.D. // In Chemical etching. Berlin; New-York: Springer-Verlag, 1982. P. 175.
Yang E.H. // J. Electrochem. Soc. Sol. St. Sci. Techn. 1984. V. 131. № 5. P. 1140.
https://warwick.ac.uk/fac/sci/physics/research/condensedmatt/silicon/papers/theses/Lee_Nash_Thesis.pdf.
Колесников А.В., Труханов Е.М., Ильин А.С., Лошкарев И.Д. // Поверхность. Рентген., синхротр. и нейтр. иссл. 2014. № 7. С. 30.
Hisamatsu Y., Ichikawa K. // Boshoku Gijutsu. 1974. V. 23. P. 117.
Holmes P. // In The electrochemistry of semiconductors. London–New York: Acad. Press, 1962. P. 329.
Дополнительные материалы отсутствуют.
Инструменты
Известия РАН. Серия физическая