Известия РАН. Серия физическая, 2022, T. 86, № 7, стр. 972-975
Полуполярные III-N слои на нано-структурированной кремниевой подложке: технология, люминесценция
В. Н. Бессолов 1, Е. В. Коненкова 1, С. Д. Коненков 1, *, В. Н. Пантелеев 1
1 Федеральное государственное бюджетное учреждение науки
“Физико-технический институт имени А.Ф. Иоффе Российской академии наук”
Санкт-Петербург, Россия
* E-mail: steven1999@yandex.ru
Поступила в редакцию 14.02.2022
После доработки 28.02.2022
Принята к публикации 23.03.2022
- EDN: BCYLJQ
- DOI: 10.31857/S0367676522070092
Аннотация
Апробирован синтез слоев AlN методом хлорид-гидридной газофазной эпитаксии и GaN методом эпитаксии из металлoорганических соединений на наноструктурируемой подложке Si(100). Показано, что при образовании блочных слоев AlN(10–11) и GaN(10–11) с полуширинами кривой качания рентгеновской дифракции 60 и 45 угл. мин, соответственно, поверхности слоев имеют ступени, высота которых определяется размером блока при коалесценции.
Полуполярные и неполярные слои GaN привлекают внимание исследователей начиная с работы, в которой авторы доложили об увеличение интенсивности фотолюминесценции в светодиодных InGaN/GaN структурах свободных от пьезоэлектрической поляризации гетероэпитаксиально выращенных на чужеродных подложках [1]. Полуполярный GaN в сравнении с полярным GaN имеет ряд преимуществ. Эффективность светодиодов на основе полярных кристаллов GaN ограничена из-за электрического поля, которое приводит к разделению электронов и дырок в квантовых ямах (квантово-размерный эффект Штарка). Встроенное поле препятствует созданию транзисторов для комплементарной металл-оксид-полупроводниковой логики (КМОП). Напротив, слабое проявление или полное отсутствие встроенного поля в полуполярном GaN открывает перспективу создания эффективных лазеров и высокотемпературной КМОП-логики на данном материале [2].
Пьезоэлектрическая поляризация возникает в напряженных структурах (например, InGaN/GaN или AlGaN/GaN), и оказывает влияние на общую поляризацию в гетероструктурах. Это может быть значительно изменено выбором ориентации кристалла.
Одним из возможных решений этой проблемы является выращивание III-нитридных структур вдоль полуполярных ориентаций, поскольку ожидается, что они обладают большим потенциалом в снижении поляризации [3], в повышении внутренней квантовой эффективности светодиодов [4], и более эффективным внедрением атомов индия особенно в полуполярных GaN(11–22) слоях [5]. Из-за отсутствия эпитаксиальной связи между полуполярным GaN и любыми ориентированными кремниевыми подложками чрезвычайно трудно вырастить полуполярный GaN на плоской кремниевой подложке. Поэтому полуполярные GaN(11–22) или GaN(1–101) на кремниевых подложках выращивают в основном на структурированной подложке с полосатыми канавками [6, 7].
Предпринимаются попытки синтезировать полуполярные нитриды алюминия на микро [8] и нано-cтруктурированных подложках Si(100) [9] и было показано, во-первых, что методом HVPE возможно синтезировать AlN(10–11) и, во-вторых, что образование полуполярных III-N слоев на симметричных кремниевых нанохребтах обусловлено свойствами наномаски [10].
Данная работа посвящена эпитаксиальному росту слоев AlN(10–11) методом хлорид-гидридной газофазной эпитаксии (HVPE) и GaN(10–11), выращенного эпитаксией из металлoорганических соединений (MOCVD) на подложке Si(100), на поверхности которой сформирована V-образная структура с размером элементов <100 нм (NanoPatterned Si(100)-NP-Si(100)) и изучению люминесцентных свойств полуполярных GaN слоев.
Для достижения поставленной цели на кремниевой подложке ориентации (100) создавалась V-образная наноструктура NP-Si(100). Эта структура состояла из “нанохребтов” с периодом около 70 нм, и высотой около 50 нм аналогично работе [10].
Эпитаксиальный рост толстых слоев AlN(10–11) осуществлялся методом HVPE. В качестве исходных веществ использовали водород, аммиак, галлий, хлористый водород. Соотношение потоков H2/NH3 было ∼2/1. Расход аммиака составлял 1 л/мин, а хлористого водорода над Ga-источником в пределах 20–50 мл/мин. Наноструктурированные подложки промывались стандартным способом и травились в растворе плавиковой кислоты с водой в соотношении 1 : 5 в течение 1 мин. Толщина слоев AlN была около 7 мкм.
Слои GaN были выращены методом MOCVD аналогично [11, 12]. Нагрев реактора от комнатной температуры до температуры эпитаксии составлял около 30 мин. Методом MOCVD растили вначале подслои AlN толщиной ∼15–30 нм, затем GaN толщиной 1 мкм. Структуры исследовались методами сканирующей электронной микроскопии (РЭМ), а GaN/Si(100) еще и фотолюминесценцией.
Рентгенодифракционный анализ показал, что слои имели полуполярную структуру: AlN(10–11) имел полуширину кривой качания рентгеновской дифракции ωϴ ~ 60 угл. мин, а слой GaN(10–11) – ωϴ ~ 45 угл. мин. На изображениях, полученных при помощи РЭМ, видно, что слои AlN(10-11) и GaN(10–11) имеют поверхностные ступени величиной около 150 нм (рис. 1 и 2), причем расстояние между ступенями AlN(10–11) составляет величину около 15 мкм в направлении роста слоя и 5 мкм в перпендикулярном направлении (рис. 1).
Рис. 1.
РЭМ изображение поверхности полуполярного AlN(10–11) на NP-Si(100) (а) и ступеней AlN на поверхности (б).
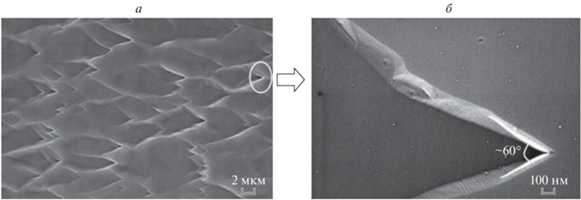
Механизм образования ступенчатой поверхности полуполярных III-N слоев на подложке NP-Si(100) основан на их блоковом зарождении. Слой зарождается на наклонных гранях Si(111), которые имеют угол 54° к плоскости Si(100). На начальной стадии процесса эпитаксии AlN на NP-Si(100) происходит свободный симметричный рост на смежных гранях V-наноканавок преимущественно в направлении c-оси перпедикулярно плоскостям Si(111) и Si(1–1–1). Дальнейший рост слоя AlN до толщины ~50–100 нм cохраняет симметрию склонов, однако у вершины нанохребта происходит соединение боковых граней растущего слоя с формированием плоскостей AlN(10–11) и AlN(10–1–1) (рис. 3). Для того чтобы достичь понимания на какой из этих двух плоскостей возникнет предпочтительное направления роста GaN обратимся к величинам поверхностной энергии плоскостей GaN(10–11) и GaN (10–1–1). Следует отметить, что известные в литературе результаты поверхностных энергий приводятся довольно усредненными, и, кроме того, влияние структурированной нано размерной поверхности не учитывается.
Рис. 3.
Схематическое изображение процесса формирования ступенчатой поверхности III-N(10–11) слоев на NP-Si(100).
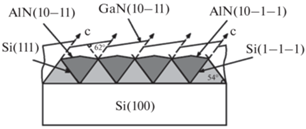
Поверхностная энергия идеальных поверхностей GaN с GaN(10–11) и GaN (10–1–1) ориентацией составляет 0.224 и 0.257 эВ/A2 [13]. Поверхностная энергия грани GaN(10–11) имеет меньшую величину и при одинаковых технологических условиях эксперимента (величина пересыщения атомов Ga, температура эпитаксии) и это различие может обеспечить разную скорость роста граней GaN в двух разнонаправленных направлениях, что в свою очередь должно привести к формированию слоя GaN в одном направлении (10–11) (рис. 3).
В процессе роста формируется грань GaN (10–11), которая имеет угол около 62° к наклонной грани Si(111) (рис. 3) и соответственно угол ~26° к плоскости Si(100) и поэтому при коалесценции соседних блоков на поверхности полуполярного слоя GaN (10–11) возникает поверхностная ступенька (рис. 3). Следует отметить, что размер ступеньки около 150 нм для AlN(10–11) и GaN(10–11), синтезированных обоими методами, дает нам информацию, что размер блоков, при которых происходит коалесценция на начальном этапе роста больше, чем расстояние между канавками подложки NP-Si(100). При дальнейшем синтезе слоев размер ступеньки сохраняется, а их количество уменьшается. Это подтверждает значительное влияние наноструктурированной поверхности подложки на морфологию слоев AlN. Одинаковое значение величины ступеньки для полуполярных слоев AlN(10–11) и GaN(10–11), полученных нами методами HVPE и MOCVD, можно сравнить с одинаковым значением среднеквадратичной шероховатости поверхности при формировании слоя AlN(0001) на различных подложках – Si(111) и Si(100) – при отжиге слоев при температуре Т = 1050°С [14].
На поверхности AlN(10–11) (рис. 3) видно, что сама ступенька имеет 60° изломы, характерные для блоковой коалесценции.
В обзоре [15] подробно изложены оптические свойства полуполярного нитрида галлия. Спектральные характеристики структур GaN(10–11) при синтезе на разориентированной подложке Si(100) описываются в работе [16], где авторы наблюдали люминесценцию, связанную с рекомбинацией на дефектах BSFs. Спектры слоев GaN(10–11) при синтезе на NP-Si(100) содержат максимумы с hν1 = 3.45 эВ, hν2 = 3.40 эВ; hν3 = = 3.32 эВ (рис. 4), которые аналогичны полученным нами спектрам для структур GaN(10–12)/NP-Si(100) [11]. Пик при hν = 3.45 эВ мы связываем с люминесценцией экситона, связанного на доноре, аналогично [11]. Линия при hν = 3.40–3.42 эВ, связанная с дефектами BSFs [15] обычно наблюдаются в спектрах люминесценции полуполярных кристаллов и возникает при зарождении слоя по механизму Волмера–Вебера [17]. Впервые такая модель люминесценции предложена в [18] и предполагает, что нитриде галлия экситоны могут связываться с дефектами упаковки в идеальной квантовой яме кубического GaN, окруженного вюрцитным GaN. Сравнивая наши спектры с литературными данными, можно заключить, что пик при hν2 = 3.40 эВ в слоях GaN(10–11) обусловлен дефектами BSFs и не противоречит модели. Пик hν3 = 3.32 эВ, возможно, обусловлен донорно-акцепторной рекомбинацией, связанной с атомами кремния в GaN.
Таким образом, рассмотренный способ синтеза полуполярных AlN и GaN слоев на NP-Si(100) подложке перспективен для создания полуполярных кремниевых “квазиподложек”.
Исследования выполнены при частичной финансовой поддержке Российского фонда фундаментальных исследований (проект № 20-08-00096).
Список литературы
Waltereit P., Brandt O., Trampert A. et al. // Nature. 2000. V. 406. P. 865.
Takagi S., Ueno M., Katayama K. et al. // SEI Tech. Rev. 2013. V. 77. P. 102.
Wang T. // Semicond. Sci. Technol. 2016. V. 31. Art. No. 93003.
Zhao Y., Oh S.-H., Wu F. et al. // Appl. Phys. Express. 2013. V. 6. Art. No. 062102.
Zhao Y., Yan Q., Huang C.-Y. et al. // Appl. Phys. Lett. 2012. V. 100. Art. No. 201108.
Honda Y., Yamaguchi M., Amano H. // Phys. Stat. Sol. A. 2011. V. 208. P. 1175.
Izyumskaya N., Zhang F., Okur S. et al. // J. Appl. Phys. 2013. V. 114. Art. No. 113502.
Liu J.-M., Zhang J., Lin W.-Y. et al. // Chin. Phys. B. 2015. V. 24. Art. No. 057801.
Бессолов В.Н., Коненкова Е.В., Пантелеев В.Н. // ЖТФ. 2020. Т. 90. № 12. С. 2123. Bessolov V.N., Konenkova E.V., Panteleev V.N. // Tech. Phys. 2020. V. 65. No. 12. P. 2031.
Бессолов В.Н., Коненкова Е.В. Родин С.Н. и др. // ФТП. 2021. Т. 55. № 4. С. 356; Bessolov V.N., Konenkova E.V., Rodin S.N. et al. // Semiconductors. 2021. V. 55. No. 4. P. 471.
Бессолов В.Н., Коненкова Е.В., Орлова Т.А. и др. // ФТП. 2019. Т. 53. № 7. С. 1006. Bessolov V.N., Konenkova E.V., Orlova T.A. et al. // Semiconductors. 2019. V. 53. No. 7. P. 989.
Бессолов В.Н., Компан М.Е., Коненкова Е.В. и др. // Письма в ЖТФ. 2019. Т. 45. № 11. С. 3; Bessolov V.N., Kompan M.E., Konenkova E.V. et al. // Tech. Phys. Lett. 2019. V. 45. No. 6. P. 529.
Kawamura T., Akiyama T., Kitamoto A. et al. // J. Cryst. Growth. 2020. V. 549. Art. No. 125868.
Bae M.K., Shin D.H., Yi S.N. et al. // J. Korean Phys. Soc. 2007. V. 51. No. 1. P. 209.
Lahnemann J., Jahn U., Brandt O. et al. // J. Phys. D. 2014. V. 47. Art. No. 423001.
Dihn D.V., Parbrook P.J. // J. Cryst. Growth. 2018. V. 501. P. 34.
Vennegu’es P., Chauveau J.M., Bougrioua Z. et al. // J. Appl. Phys. 2012. V. 112. Art. No. 113518.
Rieger W., Dimitrov R., Brunner D. et al. // Phys. Rev. B. 1996. V. 54. Art. No. 17596.
Дополнительные материалы отсутствуют.
Инструменты
Известия РАН. Серия физическая