Кристаллография, 2020, T. 65, № 1, стр. 11-16
Магнитопластический эффект в монокристаллах GaAs, легированных теллуром
Т. Г. Югова 1, *, А. Г. Белов 1, С. Н. Князев 1
1 АО “Гиредмет”
Москва, Россия
* E-mail: P_Yugov@mail.ru
Поступила в редакцию 20.09.2018
После доработки 30.10.2018
Принята к публикации 08.11.2018
Аннотация
Исследовано влияние постоянного магнитного поля на движение ростовых дислокаций с плотностью (0.7–7.0) × 104 см–2 и концентрацию электронов в интервале 5 × 1017–2.5 × 1018 см–3 в монокристаллах GaAs, легированных теллуром. В процессе исследования индукция магнитного поля составляла 0.18, 0.33 и 0.50 Тл при времени обработки 5 мин. В магнитном поле с индукцией 0.50 Тл образцы находились в течение 3, 5 и 10 мин. Показано, что наибольший сдвиг дислокаций происходит при наименьшем значении индукции магнитного поля и меньшем времени обработки. В этих условиях наблюдается также наибольшее изменение концентрации электронов. При увеличении времени обработки дислокации стремятся к исходному положению, а концентрация электронов уменьшается.
ВВЕДЕНИЕ
Интенсивные исследования пластической деформации при внешних воздействиях начались в 60-х годах XX века. В настоящее время установлено влияние электрических и магнитных полей (МП) на металлы, полупроводники и сплавы. Магнитопластическим эффектом [1, 2] названо влияние относительно малых МП на различные микро- и макропластические характеристики ионных, ковалентных, молекулярных кристаллов некоторых металлов, полупроводников и органических соединений.
Обнаружено новое явление – движение дислокаций в постоянном МП в немагнитных кристаллах в отсутствие механической нагрузки [1]. За последние годы опубликовано большое количество работ, исследующих движение дислокаций в постоянном МП. Известно, что поле с индукцией В ∼ 1 Tл способно влиять на подвижность линейных дефектов в ионных кристаллах, металлах и полупроводниках [3–12]. Объясняя физику воздействия энергетически слабого МП на динамику дислокационной структуры, исследователи склоняются к модели спин-зависимых реакций [12]. В ее основе – магнитостимулированная эволюция электронных спинов примесных центров, снимающих спиновый запрет на определенные электронные переходы. Это влияет на изменение скорости перемещения линейных дефектов в поле внутренних напряжений кристалла немагнитных кристаллов. Суть эффекта заключается в том, что однородное постоянное МП инициирует депиннинг (открепление) дислокаций. Процесс депиннинга происходит под действием внутренних напряжений кристалла, является пороговым и носит эстафетный характер. Пороговость процесса означает, что дислокации, движимые внутренними напряжениями, распределившись и закрепившись на стопорах, находятся в условиях, “близких” для отрыва. Отрыв одной из дислокаций вызывает изменение полей напряжений в кристалле и делает возможным депиннинг от стопоров других дислокаций.
Большое значение имеют дефекты в кристаллах Si и других полупроводниках, используемых в электронной промышленности. Одна из главных проблем – неуправляемое самопроизвольное “старение” кристаллов, приводящее к изменению электрофизических свойств микросхем и обусловленное релаксацией дефектной структуры. Обнаружение магнитопластического эффекта в полупроводниках позволяет надеяться, что и в этой области МП может быть применено для стабилизации свежеприготовленных полупроводниковых структур, как известно, не допускающих нагрева и других “грубых” вмешательств.
Несмотря на обширную экспериментальную информацию о магнитопластичности различных материалов, в том числе кремния, практически не изучено влияние слабого постоянного МП на движение дислокаций и концентрацию носителей заряда в монокристаллах GaAs, легированных теллуром.
МЕТОДИКИ
Исследования проводили на шайбах ориентации (100), вырезанных перпендикулярно оси роста монокристаллов арсенида галлия, полученных методом Чохральского. В исследованных образцах концентрация электронов была в интервале 5 × 1017–2.5 × 1018 см–3. В этом диапазоне концентрация электронов совпадает с концентрацией примеси теллура в этих образцах при T = = 295 K. Плотность дислокаций в кристаллах находилась на уровне (0.7–7.0) × 104 см–2. Исследовали движение ростовых дислокаций в поле постоянного магнита. Из соседних областей в каждом кристалле вырезали по две шайбы. На одной исследовали движение дислокаций под действием МП, а на другой измеряли концентрацию электронов по спектрам отражения в дальней ИК-области под действием того же поля. Из каждой шайбы вырезали пять квадратов сечением 10 × 10 мм. Измерения проводили таким образом, что на отдельных квадратах при одном значении индукции постоянного МП 0.50 Тл изменяли время обработки – 3, 5 и 10 мин. Кроме этого, изменяли значение индукции 0.18, 0.33 и 0.50 Тл при одинаковом времени обработки (5 мин). Обработку проводили с использованием постоянного магнита на установке для измерения эффекта Холла (рис. 1).
Рис. 1.
Схема проведения обработки образцов в магнитном поле: а – в режиме измерения эффекта Холла, б – в режиме магнитопластических измерений: 1 – магниты, 2 – образец, 3 – дислокации в образце, 4 – ямки травления на дислокациях, идущих перпендикулярно поверхности образца.
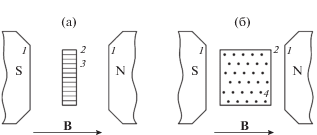
Концентрацию свободных электронов определяли по спектрам отражения в дальней ИК-области. С помощью фурье-спектрометра Tensor-27 записывали зависимость коэффициента отражения от волнового числа при Т = 295 K. Далее с помощью дисперсионных соотношений Крамерса–Кронига строили зависимость f(ν) = Im(–1/ε) и определяли волновое число ν+, отвечающее максимуму этой зависимости.
При анализе спектров отражения учитывали плазмонно-фононное взаимодействие. Вычисляли частоты смешанных плазмонно-фононных мод и строили градуировочную зависимость, позволяющую по известному значению ν+ определить концентрацию свободных электронов N. Был использован подход, аналогичный подходу, изложенному в [13] применительно к материалу n-InSb. Для материала n-GaAs при расчетах брали следующие значения параметров: эффективная масса электрона mn = 0.067m0, где m0 – масса свободного электрона; статическая диэлектрическая проницаемость ε0 = 12; высокочастотная диэлектрическая проницаемость ε∝ = 10.9; волновое число, отвечающее энергии продольного оптического фонона, νLO = 246 см–1.
Полученная градуировочная зависимость может быть описана полиномом второй степени:
Минимальное значение концентрации электронов nмин, которое может быть получено описываемым методом, определяется краем рабочего диапазона используемого спектрального прибора. Для фурье-спектрометра Tensor-27 nмин$ \cong $ 8 × × 1017 см–3. Показано также, что если плазмонно-фононное взаимодействие не учитывать, то это приводит к завышению значения n на 25–30%. При использовании упомянутого метода случайная относительная погрешность определения значения n не превышает 1%. Время проведения измерения составляло 1 мин.
Величину сдвига индивидуальных дислокаций в результате воздействия МП наблюдали методом двухстадийного химического травления путем измерения 20 сдвигов дислокаций на одном образце для каждой точки на графиках. После шлифовки и химической полировки шайбу травили в расплаве KOH для выявления дислокационных ямок травления на поверхности GaAs(100) (рис. 2а). После соответствующей обработки поверхность отдельных квадратов травили повторно. Типичные ямки травления после обработки показаны на рис. 2б. На рис. 2в изображена ямка после повторного травления образца, который не подвергался обработке.
ЭКСПЕРИМЕНТАЛЬНЫЕ РЕЗУЛЬТАТЫ И ИХ ОБСУЖДЕНИЕ
Движение дислокаций в постоянном магнитном поле
Установлено [12] анизотропное движение дислокаций под действием МП: средний пробег зависит от взаимной ориентации линии дислокаций и вектора магнитной индукции В.
Магнитная обработка по схеме измерения эффекта Холла (рис. 1а) не выявила изменений ни в дислокационной структуре, ни в концентрации носителей заряда, т.е. МП, параллельное линии дислокации, не вызывает ее движения. Другая картина наблюдается, когда МП направлено перпендикулярно линии дислокации (рис. 1б). Происходит сдвиг дислокаций, и изменяется концентрация носителей заряда.
На рис. 2в хорошо видно, что при повторном травлении необработанного образца центр дислокационной ямки остается на прежнем месте, хотя общий вид ямки изменяется. В случае повторного травления образцов, прошедших магнитную обработку, центр новой ямки сдвигается относительно центра прежней ямки травления (рис. 2б). На рис. 2б прямыми линиями показано положение центра ямки травления до обработки и после повторного травления обработанного образца. Расстояние между линиями L соответствует расстоянию, на которое сместилась дислокация под действием МП. При сравнении рис. 2б и 2в хорошо виден сдвиг центра дислокационной ямки травления. Отметим, что сдвиг центра ямки всегда происходит параллельно короткой оси дислокационной ямки, которая ориентирована вдоль направления 〈0$\bar {1}$1〉. Это направление соответствует пересечению плоскости А(111) с плоскостью (100). Таким образом, перемещение центра ямки вдоль этого направления свидетельствует о том, что дислокации скользят в плоскости А(111), причем в противоположных направлениях (рис. 3). То есть в кристалле наблюдаются дислокации различного знака. Кроме того, только незначительная доля дислокаций движется под действием МП.
Рис. 3.
Дислокационные ямки травления, выявленные на дислокациях, имеющих различный знак: прямая 1 проходит через центр ямки травления до обработки, прямая 2 – через центр ямки травления после магнитной обработки.
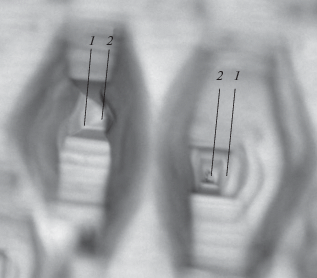
Распределение плотности дислокаций ρ по поверхности шайб, вырезанных перпендикулярно оси роста, очень неоднородно, также ρ существенно меняется по длине кристалла. Чтобы можно было сравнивать данные о сдвигах дислокаций в этих образцах под действием МП, использовали нормирование пробегов на корень из плотности дислокаций ($\sqrt \rho $), широко применяемое в [10] при исследовании магнитопластического эффекта.
Были построены концентрационные зависимости безразмерных величин L$\sqrt \rho $ (рис. 4, 5). На рис. 4 показаны зависимости нормированного пробега дислокаций (L$\sqrt \rho $) от концентрации электронов при различных значениях индукции МП. На графике видно, что максимальные величины L$\sqrt \rho $ во всем интервале концентраций наблюдаются в поле 0.18 Тл. Кроме этого, L$\sqrt \rho $ возрастает с увеличением концентрации электронов.
Рис. 4.
Концентрационные зависимости нормированных пробегов дислокаций L$\sqrt \rho $ под действием магнитного поля при различных значениях индукции магнитного поля: 0.18 (1), 0.33 (2), 0.50 Тл (3). Время обработки 5 мин.
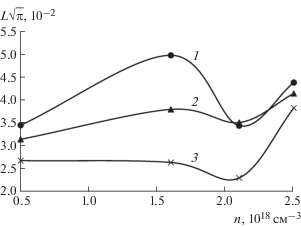
Рис. 5.
Концентрационные зависимости нормированных пробегов дислокаций L$\sqrt \rho $ под действием магнитного поля 0.50 Тл при времени обработки 3 (1), 5 (2), 10 мин (3).

Теория магнитопластичности предсказывает обратно пропорциональную зависимость L$\sqrt \rho $ от квадратного корня из концентрации легирующей примеси [14], т.е. значение L$\sqrt \rho $ должно уменьшаться при увеличении концентрации носителей заряда из-за увеличения количества атомов примеси, осажденных на дислокациях и препятствующих отрыву дислокаций от них под воздействием МП. Однако в данном случае наблюдается рост величины L$\sqrt \rho $ с ростом концентрации примеси (концентрации электронов). Исключение составляет кристалл с концентрацией электронов n ~ 1.6 × 1018 см–3. Причину такого поведения в этом кристалле рассмотрим ниже.
На рис. 5 показаны зависимости нормированного пробега дислокаций (L$\sqrt \rho $) от концентрации электронов при различных временах магнитной обработки. Значения L$\sqrt \rho $ уменьшаются с увеличением времени магнитной обработки всех образцов, кроме образцов с концентрацией электронов n ∼ 1.6 × 1018 см–3. Также наблюдается незначительный рост L$\sqrt \rho $ при увеличении концентрации электронов.
В начале обработки МП дислокации открепляются от стопорящих их примесных атомов и начинают перемещаться. Однако при увеличении времени обработки поле перестает действовать на дислокации, и под действием внутренних напряжений и взаимодействия дислокаций друг с другом они сдвигаются ближе к своему исходному положению, уменьшая наблюдаемое значение L$\sqrt \rho $. Такое поведение L$\sqrt \rho $ в зависимости от времени обработки, по-видимому, свидетельствует о том, что дислокации сдвигаются только в начальный момент магнитной обработки.
Из рассмотрения рис. 4 и 5 можно сделать вывод, что увеличение концентрации электронов в кристаллах арсенида галлия приводит к росту L$\sqrt \rho $ как в экспериментах с различной индукцией МП, так и в экспериментах с различным временем обработки. По-видимому, это связано с тем, что с увеличением концентрации электронов в образцах, вырезанных из краевых участков кристаллов, существенно возрастает плотность дислокаций. Это, в свою очередь, приводит к возрастанию уровня напряжений в кристаллах. Так как дислокации, открепленные от примесных атомов, под действием МП, движутся в поле внутренних напряжений в кристалле, то возрастание этих напряжений приводит к увеличению пробега дислокаций.
Особое место занимает кристалл с концентрацией электронов n ∼ 1.6 × 1018 см–3. Отметим, что в этом кристалле наблюдается пониженная плотность дислокаций (0.7–1.6) × 104 см–2 по сравнению с другими кристаллами, в которых при этой же концентрации электронов она находится на уровне (3–4) × 104 см–2. Такая низкая плотность дислокаций свидетельствует о том, что релаксация термических напряжений прошла недостаточно полно. По-видимому, достаточно высокий уровень остаточных упругих напряжений в кристалле способствует более энергичному движению дислокаций в них.
Из приведенных результатов становится понятно, почему в установках Чохральского для выращивания монокристаллов полупроводников применяется только переменное МП с низкой напряженностью [15].
Изменение концентрации носителей заряда под действием магнитного поля
Наблюдаемое движение дислокаций под действием постоянного МП в пластинах GaAs, легированного теллуром, свидетельствует о том, что под действием поля происходит процесс депиннинга (открепления) дислокаций от стопоров. Этот процесс заключается в отрыве дислокаций от находящихся на них примесных атомов и других точечных дефектов. Появление в объеме материала дополнительных примесных атомов может приводить к изменению концентрации носителей заряда. Для выявления этого эффекта был выбран метод измерения концентрации носителей заряда по спектрам отражения в дальней ИК-области, которые не связаны с воздействием МП. В некоторых случаях также использовали метод измерения эффекта Холла, так как выше было показано, что в процессе измерения эффекта Холла движения дислокаций не наблюдается.
Обнаружено, что в процессе обработки слабым постоянным МП изменяется концентрация носителей заряда – электронов в монокристаллах GaAs, легированных теллуром. На рис. 6 показаны типичные спектры отражения в дальней ИК-области образцов, в которых в процессе магнитной обработки концентрация электронов возросла (рис. 6а) и уменьшилась (рис. 6б).
Рис. 6.
Типичные спектры отражения в дальней ИК-области образцов, в которых в процессе магнитной обработки концентрация электронов возросла (сдвиг влево) (а) и уменьшилась (сдвиг вправо) (б): 1 – исходное состояние, 2 – после магнитной обработки.
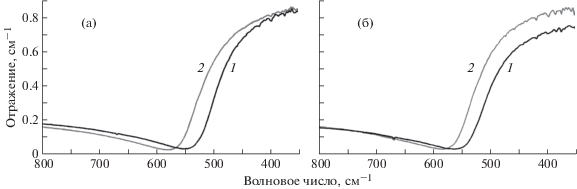
Данные, полученные при измерении спектров отражения, о зависимости величины Δn (изменения концентрации носителей заряда) в образцах от времени обработки в МП 0.50 Тл и от значения магнитной индукции при времени обработки 5 мин представлены в табл. 1.
Таблица 1.
Изменение концентрации электронов Δn в образцах в зависимости от времени обработки t в магнитном поле с индукцией 0.5 Тл и от магнитной индукции В при обработке в течение 5 мин
| Δn, 1017 см–3 | ||||||
|---|---|---|---|---|---|---|
| Концентрация носителей заряда, 1018 см–3 | t, мин | В, Тл | ||||
| 3 | 5 | 10 | 0.18 | 0.33 | 0.50 | |
| 1.6 | 0 | 0 | 0 | 0 | 0 | 0 |
| 2.1 | 0.5 | 0.5 | 0.2 | 1.0 | 0 | –0.5 |
| 2.5 | 6.0 | 0.2 | –1.3 | 0.2 | 0.2 | 0.2 |
Из таблицы следует, что в образцах с n ∼ 1.6 × × 1018 см–3 концентрация электронов не изменяется, хотя наблюдается сдвиг дислокаций под действием МП. В образцах c n ∼ 2.1 × 1018 см–3 величина Δn изменяется немонотонно как с увеличением времени обработки в МП с индукцией 0.50 Тл, так и при увеличении значения магнитной индукции. В образцах с концентрацией электронов n ∼ 2.5 × 1018 см–3 при увеличении времени обработки вплоть до 10 мин наблюдается монотонное уменьшение концентрации электронов. Анализируя такое движение дислокации при увеличении времени обработки, можно понять характер изменения величины Δn. Отрыв дислокаций от примесных атомов на начальном этапе обработки приводит к тому, что освободившиеся примесные атомы начинают проявлять электрическую активность, что приводит к увеличению концентрации электронов в образце. По мере дальнейшего возвращения дислокаций на исходные позиции примесные атомы начинают вновь на них осаждаться, концентрация электронов уменьшается. При длительной обработке на дислокации, которые двигались в кристалле, начинает высаживаться дополнительное количество примесей, что приводит к уменьшению концентрации электронов до значения ниже исходного. Изменение магнитной индукции не влияет на Δn.
Информация, полученная из спектров отражения, относится к узкому (десятые доли микрометра) приповерхностному слою исследуемого образца, в то время как данные традиционных гальваномагнитных измерений относятся ко всему объему образца. Чтобы оценить правомерность использования спектров отражения для определения концентрации электронов, были измерены концентрации в одних и тех же образцах двумя различными методами. В табл. 2 приведены значения концентрации электронов, полученные с помощью эффекта Холла и оптическим методом по спектрам отражения в дальней ИК-области. Из табл. 2 видно, что без учета случайной относительной погрешности значения n в левой колонке превосходят аналогичные значения в правой колонке. Однако если принять во внимание случайную относительную погрешность холловской (∼±10%) и оптической (~±1%) методик, то результаты этих измерений можно считать совпадающими.
Таблица 2.
Концентрация электронов в одних и тех же образцах, полученная в результате измеренний эффекта Холла и спектров отражения в дальней ИК-области
| Концентрация носителей заряда, 1018 см–3 | |
|---|---|
| Эффект Холла | Спектры отражения |
| 1.50 ± 0.1 | 1.48 ± 0.01 |
| 1.96 ± 0.2 | 1.71 ± 0.01 |
| 2.10 ± 0.2 | 1.95 ± 0.02 |
| 2.50 ± 0.2 | 2.29 ± 0.02 |
ЗАКЛЮЧЕНИЕ
Установлена зависимость величины сдвига дислокаций под действием постоянного магнитного поля от времени обработки, значения магнитной индукции, концентрации электронов и плотности дислокаций в образцах. Показано, что эффект анизотропный: средний сдвиг значений L зависит от взаимной ориентации дислокаций и вектора магнитной индукции В. Магнитное поле, параллельное дислокации, не вызывает ее движения. Наибольший сдвиг дислокаций, а также наибольшее изменение концентрации электронов наблюдается при минимальном времени воздействия магнитного поля и при малых значениях индукции.
Авторы выражают благодарность Е.И. Кладовой за проведение оптических измерений.
Список литературы
Альшиц В.И., Даринская Е.В., Перекалина Т.М., Урусовская А.А. // ФТТ. 1987. Т. 29. С. 467.
Альшиц В.И., Даринская Е.В., Колдаева М.В., Петржик Е.А. // Кристаллография. 2003. Т. 48. № 4. С. 826.
Даринский Б.М., Фёклин В.Н. // Вестн. ВГУ. Сер. Физика, математика. 2006. № 1. С. 21.
Левин М.Н., Татаринцев А.В., Косцова О.А., Косцов А.М. // Журн. техн. физики. 2003. Т. 73. С. 85.
Боярская Ю.С., Грабко Д.З., Мединская М.И. и др. // Физика и техника полупроводников. 1997. Т. 31. № 2. С. 179.
Макара В.А., Стебленко Л.П., Обуховский В.В. и др. // ФТТ. 2000. Т. 42. № 5. С. 854.
Даринская Е.В., Петржик Е.А., Ерофеева С.А. и др. // Письма в ЖЭТФ. 1999. Т. 70. Вып. 4. С. 298.
Скворцов А.А., Каризин А.В., Миршавка Ю.А. // Вестн. ТГУ. 2013. Т. 18. С. 1769.
Скворцов А.А., Корячко М.В., Волкова Л.В. International Scientific and Practical Conf. “World Science”. 2016. V. 1. Р. 63.
Головин Ю.И. // ФТТ. 2004. Т. 46. С. 769.
Макара В.А., Стебленко Л.П., Плющай И.В. и др. // ФТТ. 2014. Т. 56. С. 1531.
Моргунов Р.Б., Бучаченко А.Л. // ЖЭТФ. 2009. Т. 136. С. 505.
Белова И.М., Белов А.Г., Каневский В.Е., Лысенко А.П. // Изв. вузов. Электроника. 2017. Т. 22. № 3. С. 201.
Даринская Е.В. Дис. “Магнитопластический эффект: основные свойства и физические механизмы” … д-ра физ.-мат. наук. М.: ИК РАН, 2004. 280 с.
Rudolph P., Czupalla M., Lux B. // J. Cryst. Growth. 2009. V. 311. P. 4543.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография



