Кристаллография, 2021, T. 66, № 6, стр. 930-932
Определение параметров пленок, формируемых на жидкой субфазе, по данным рефлектометрии
С. Б. Астафьев 1, *, Л. Г. Янусова 1
1 Институт кристаллографии им. А.В. Шубникова ФНИЦ “Кристаллография и фотоника” РАН
Москва, Россия
* E-mail: serge@crys.ras.ru
Поступила в редакцию 09.02.2021
После доработки 16.02.2021
Принята к публикации 16.02.2021
Аннотация
Рассмотрены методы определения толщины тонких пленок, основанные на обработке данных рефлектометрического рассеяния. Предложен метод, использующий вейвлет-преобразование интенсивности зеркального рассеяния и не требующий никаких специальных предположений и модельных построений. Результаты расчетов толщины реальной пленки совпадают со значениями, получаемыми при помощи других известных методов определения толщин. Все рассматриваемые в работе методы реализованы в программном аналитическом комплексе BARD.
Одной из важнейших характеристик тонких пленок, формируемых на жидкой субфазе (пленок Ленгмюра–Блоджетт), является их толщина. Этот параметр важен как для технологического использования пленок, так и для обратной связи с изготовителем таких объектов, а также для анализа структурной организации молекул в слое пленки. При исследовании свойств пленок с использованием измерений рентгеновской рефлектометрии в качестве единственного метода определения толщины принято использовать полуэмпирический метод расчета, основанный на учете интерференционных осцилляций от общей толщины слоя (осцилляций Киссига), проявляющихся на кривой угловой зависимости интенсивности зеркального рассеяния рентгеновского луча от поверхности слоя (рефлектометрической кривой) [1]. Опуская промежуточные выкладки, приведем конечную формулу для определения толщины пленки в этом случае:
где m2, m1 – порядки экстремумов (минимумов) кривой I(qz), q1, q2 – их координаты, q – модуль вектора рассеяния.В программном комплексе БАРД – Базовый анализ рефлектометрических данных (BARD – Basic Analysis of Reflectivity Data) [2] – реализованы два метода определения толщины тонких пленок. Первый базируется на решении обратной задачи рефлектометрии – определении электронного профиля плотности пленки в рамках ступенчатой модели [2]. Второй метод не требует никаких дополнительных предположений и модельных построений и основывается на прямом вейвлет-преобразовании интенсивности рефлектометрического рассеяния [3].
На рис. 1 приведена рефлектометрическая кривая реальной пленки Ленгмюра–Блоджетт. На ней отмечены два соседних экстремума (минимума) осцилляций Киссига, координаты которых использовались для определения толщины пленки по формуле (1). Отметим, что в слабоупорядоченных тонких пленках удается фиксировать не более 1–3 порядков интерференционных отражений, представляющих собой малые по величине и уширенные пики, которые к тому же могут искажаться шумами различного происхождения. Это ограничивает применимость данного метода расчета.
Рис. 1.
Рефлектометрические кривые I(qz) рентгеновского рассеяния пленки на водной субфазе: экспериментальная кривая (обозначена точками) и кривая, полученная подгоном при помощи ступенчатой модели (рис. 2) профиля электронной плотности.

Толщину слоя также можно оценить из модели профиля электронной плотности пленки, вычисляемой путем подгона соответствующей этой модели интенсивности рассеяния к экспериментальной кривой. Однако без предварительного знания структурной организации объекта требуется проводить поиск в несколько этапов, постепенно увеличивая количество ступеней-слоев разной плотности и добиваясь наилучшего приближения расчетной и экспериментальной кривых. При этом за толщину пленки обычно принимают среднее по всем найденным моделям значение. Чем неоднороднее пленка, тем большее количество слоев (участков с постоянной электронной плотностью) требуется для ее описания. В настоящей работе неоднородность в поперечном сечении пленки была подтверждена невозможностью получить модельную кривую, соответствующую экспериментальной (рис. 1), используя лишь однослойную или двухслойную модели профиля.
Увеличивая количество слоев (ступеней) модели от одного до шести, удалось получить хорошее приближение, начиная с трехслойной модели (рис. 2). Однако этот процесс достаточно трудоемкий и не всегда приводит к однозначному результату.
Рис. 2.
Трехслойная модель профиля электронной плотности пленки на водной субфазе, полученная подгоном расчетной рефлектометрической кривой от модели к экспериментальной кривой: ступенчатый профиль без учета шероховатости межфазных границ (точки) и профиль, сглаженный при учете шероховатости (сплошная линия).
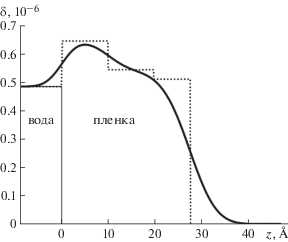
В этом случае предлагаемый метод вейвлет-преобразования оказывается наиболее подходящим. На рис. 3 приведена картина двухмерного вейвлет-преобразования (в координатах (qz, z)) рефлектометрической кривой (рис. 1), домноженной на параметр $q_{z}^{6}$. Преобразование проводилось по формуле
(2)
$WT(q,z) = {\text{\;}}\int {W((q - q{\kern 1pt} {\text{'}})z)I(q{\kern 1pt} {\text{'}})q{\kern 1pt} {{'}^{6}}dq{\kern 1pt} {\text{'}}} $Рис. 3.
Двухмерное распределение вейвлет-преобразования интенсивности рассеяния I(qz)$q_{z}^{6}$ в координатах (qz, z) с использованием вейвлета Морли (2).

Таблица 1.
Результаты определения толщины пленки по данным рефлектометрии с использованием комплекса BARD
| Способ вычисления | Толщина, Å | Точность, Å |
|---|---|---|
| Осцилляции Киссига | 28.5 | 3.0 |
| Вейвлет-преобразование | 28.3 | 2.0*/4.0** |
| Подгонка ступенчатой моделью (1/3/6 слоев); | 24.0/29.0/31.0 | 4.0 |
| среднее значение | 27.8 |
Как видно из таблицы, результирующие числовые значения толщин совпадают между собой с точностью, свойственной каждому из методов. Важно отметить тот факт, что точность определения параметра толщины (z в данном случае) при использовании вейвлет-преобразования повышается с уменьшением абсолютной величины z. Чем тоньше пленка, тем точнее расчет [4].
Совпадение расчетных значений, полученных различными независимыми методами, позволяет сделать вывод об их достоверности и о надежности предлагаемого метода. Все методы определения толщин тонких пленок, рассматриваемых в данной работе, в полной мере реализованы в аналитическом программном комплексе БАРД (BARD) [2].
Работа выполнена при поддержке Министерства науки и высшего образования в рамках выполнения работ по Государственному заданию ФНИЦ “Кристаллография и фотоника” РАН.
Список литературы
Алиханов А.И. // Проблемы новейшей физики. Л.; М.: Гос. техн.-теоретич. изд-во, 1933. Вып. III. С. 5.
Астафьев С.Б., Щедрин Б.М., Янусова Л.Г. // Кристаллография. 2012. Т. 57. № 1. С. 141.
Mallat S. A Wavelet Tour of Signal Processing. San Diego, California: Academic Press, 2008. 851 p.
Najmi A., Sadowsky J. // Johns Hopkins APL technical digest. 1997. V. 18. № 1. P. 134.
Дополнительные материалы отсутствуют.
Инструменты
Кристаллография


