Микроэлектроника, 2021, T. 50, № 2, стр. 100-109
Кинетика реактивно-ионного травления Si, SiO2 и Si3N4 в плазме C4F8 + O2 + Ar: эффект соотношения C4F8/O2
А. М. Ефремов a, *, K.-H. Kwon b
a ФГБОУ ВО “Ивановский государственный химико-технологический университет”
г. Иваново, Шереметевский проспект, 7, Россия
b Korea University, Department of Control and Instrumentation Engineering
339-700 Sejong, South Korea
* E-mail: amefremov@mail.ru
Поступила в редакцию 14.05.2020
После доработки 14.05.2020
Принята к публикации 14.05.2020
Аннотация
Проведено исследование кинетики реактивно-ионного травления Si, SiO2 и Si3N4 в смеси C4F8 + + O2 + Ar с переменными соотношением C4F8/O2 в условиях индукционного ВЧ (13.56 МГц) разряда. При использовании методов диагностики и моделирования плазмы получены данные по влиянию начального состава смеси на а) параметры электронной и ионной компонент плазмы; и б) концентрации и плотности потоков нейтральных частиц. Установлено, что немонотонные (с максимумом при ∼15% O2) изменения скоростей травления для всех трех материалов с ростом доли O2 в смеси обеспечиваются увеличением плотности потока атомов фтора при снижении эффективной вероятности гетерогенной химической реакции с их участием. Показано, что поведение последнего параметра не отражает изменений кинетики полимеризациина обрабатываемой поверхности, но может быть обусловлено гетерогенными процессами с участием атомов кислорода.
1. ВВЕДЕНИЕ
В настоящее время кремниевая электроника сохраняет лидирующие позиции в мировом производстве изделий электронной техники. Базовые материалы кремниевой электроники – Si, SiO2 и Si3N4 – находят широкое применение в качестве подложек интегральных микросхем, функциональных слоев активных элементов, пассивирующих покрытий и неорганических масок, обладающих высокой стойкостью к химическим травителям [1–3]. Все эти применения требует прецизионного структурирования предварительно сформированного сплошного слоя, основным инструментом которого являются процессы реактивно-ионного травления в плазме фторуглеродных газов [2–4]. Газификация атомов поверхности в таких процессах обеспечивается физическим распылением и химическим взаимодействием с атомами фтора, при этом в случае SiO2 и Si3N4 гетерогенная химическая реакция протекает по ионно-стимулированному механизму [5]. Причиной этого является высокий энергетический порог реакции, требующий разрыва оксидных и нитридных связей ионной бомбардировкой. Из литературы известно, что перспективными травителями для кремния и его соединений являются фторуглеродные газы с высокой полимеризационной способностью, в частности – C4F8 [1, 2]. Комбинирование этого газа в смесях с аргоном и/или кислородом обеспечивает гибкое регулирование кинетики травления и поверхностной полимеризации, в результате чего достигаются а) анизотропное травление кремния за счет пассивации фторуглеродным полимером боковых стенок формируемого рельефа [4, 5]; и б) высокая селективность травления SiO2/Si и SiO2/Si3N4 из-за различной толщины фторуглеродной полимерной пленки на кислородсодержащей и без кислородной поверхностях [3–5].
Очевидно, что эффективная реализация и оптимизация процессов реактивно-ионного травления с использованием плазмы C4F8 невозможны без понимания взаимосвязей между условиями обработки, параметрами газовой фазы и кинетикой гетерогенных процессов на обрабатываемой поверхности. В настоящее время существует ряд экспериментальных и теоретических работ [6–11], результаты которых позволили а) определить ключевые физико-химические процессы, формирующие стационарные электрофизические параметры и состав плазмы в смесях C4F8 с аргоном и/или кислородом; б) выявить зависимости концентраций активных частиц и кинетики поверхностной полимеризации от условий возбуждения разряда; и в) сформировать реакционные схемы (наборы реакций и соответствующих констант скоростей) для моделирования плазмы в смесях C4F8 с различными газами-добавками. Кроме этого в работах [12–17] было проведено исследование кинетики реактивно-ионного травления Si, SiO2 и Si3N4 в плазме бинарных смесей C4F8 + Ar и C4F8 + O2 переменного начального состава. Установлено, что для системы C4F8 + Ar кинетические характеристики гетерогенного взаимодействия (эффективная вероятность, выход травления) всех трех материалов определяются толщиной фторуглеродной полимерной пленки [12–14], при этом стационарная толщина пленки снижается в ряду Si–Si3N4–SiO2 [18]. Было найдено также, что увеличение доли кислорода в смеси C4F8 + O2 сопровождается а) снижением концентраций радикалов CF и CF2 при одновременном увеличении концентрации CF2O; б) изменением кинетики поверхностной полимеризации, вызывающем уменьшение толщины фторуглеродной полимерной пленки на обрабатываемой поверхности; и в) немонотонными (с максимумом) изменениями скоростей травления Si и SiO2 при одновременном снижении селективности процесса [15–17]. К сожалению, имеющиеся данные не обеспечивают достоверных выводов о причинах и механизмах последнего эффекта из-за неясности взаимосвязей кинетики процессов на обрабатываемой поверхности с электрофизическим параметрами и составом плазмы. Очевидно, что такая ситуация затрудняет соотношение макроскопических (наблюдаемых) эффектов травления с вызывающими их причинами и не обеспечивает эффективного целенаправленного воздействия на результат процесса варьированием условий обработки. Отметим также, что проведение аналогий с хорошо изученными системами CF4+ O2 [19–21] и CF4 + O2 + Ar [11, 22, 23] не представляется целесообразным из-за существенных различий в кинетике нейтральных частиц. В частности, в нашей работе [11] было показано, что варьирование соотношения O2/Ar в смесях CF4 + O2 + Ar и C4F8 + O2 + Ar оказывает качественно различный эффект на баланс скоростей процессов образования и гибели атомов фтора, что отражается на противоположных зависимостях их концентрации от содержания кислорода в смеси. Таким образом, существует необходимость дополнительных исследований системы C4F8 + O2 + Ar, направленных на выявление механизмов влияния начального состава смеси на параметры газовой фазы и кинетику гетерогенных процессов. Еще одним проблемным моментом является отсутствие возможности прямого (в одинаковых условиях, в одном плазмохимическом реакторе) сравнения кинетики реактивно-ионного травления Si, SiO2 и Si3N4 в смесях C4F8 с кислородом. Такая ситуация затрудняет понимание особенностей механизмов травления для каждого из материалов и, как следствие, не способствует выявлению оптимальных режимов обработки комбинированных структур.
Цель данной работы – исследование кинетики и механизмов реактивно-ионного травления основных материалов кремниевой электроники – Si, SiO2 и Si3N4 – в плазме смеси C4F8 + O2 + Ar с переменным соотношением компонентов C4F8/O2. Основное внимание было направлено на 1) анализ макроскопической кинетики травления, определяемой его режимом и лимитирующей стадией; 2) изучение влияния начального состава смеси на электрофизические параметры плазмы и концентрации активных частиц; и 3) установление взаимосвязей между характеристиками газовой фазы и кинетическими характеристиками гетерогенного взаимодействия.
2. МЕТОДИЧЕСКАЯ ЧАСТЬ
2.1. Оборудование и методика эксперимента
Эксперименты проводились в плазмохимическом реакторе планарного типа, конструкция которого подробно описана в наших работах [10, 11, 13, 14]. Плазма возбуждалась на частоте 13.56 МГц с помощью спирального индуктора, расположенного в верхней части разрядной камеры. В качестве неизменных параметров эксперимента выступали давление плазмообразующего газа ($p$ = 10 мтор), его расход ($q$ = 40 см3/мин при станд. усл.), вкладываемая мощность ($W$ = 700 Вт) и мощность смещения на нижнем электроде (${{W}_{{dc}}}$ = = 200 Вт), источником которой являлся независимый ВЧ (12.56 МГц) генератор. Величина напряжения смещения $ - {{U}_{{dc}}}$, определяющая энергию ионов ${{\varepsilon }_{i}}$ на выходе из двойного электрического слоя на границе “плазма-поверхность”, измерялась высоковольтным зондом AMN-CTR (Youngsin Eng., Korea). В качестве варьируемого параметра выступал начальный состав смеси C4F8 + O2 + Ar, задаваемый соотношением парциальных расходов первых двух компонентов при постоянном значении ${{q}_{{{\text{Ar}}}}}$ = 20 см3/мин. Таким образом, содержание Ar в смеси всегда составляло 50%, при этом варьирование ${{q}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ в диапазоне 0–15 см3/мин обеспечивало увеличение доли O2 (${{y}_{{{{{\text{O}}}_{{\text{2}}}}}}} = {{{{q}_{{{{{\text{O}}}_{{\text{2}}}}}}}} \mathord{\left/ {\vphantom {{{{q}_{{{{{\text{O}}}_{{\text{2}}}}}}}} q}} \right. \kern-0em} q}$) до 38% за счет пропорционального снижения ${{y}_{{{{{\text{C}}}_{{\text{4}}}}{{{\text{F}}}_{{\text{8}}}}}}}.$
Для диагностики плазмы применялся двойной зонд Лангмюра (DLP2000, Plasmart Inc., Korea) со встроенной системой импульсной очистки зондов ионной бомбардировкой. В дополнение к этому, перед каждым измерением проводилось кондиционирование разрядной камеры плазмой 50% Ar + 50% O2 в течение ∼2 мин. Эффективность использованных приемов подтверждается удовлетворительной воспроизводимостью зондовых вольтамперных характеристик (ВАХ), последовательно измеряемых в независимых экспериментах в течении ∼5 мин с момента зажигания разряда. Обработка зондовых ВАХ с использованием известных положений теории двойного зонда [5, 24] обеспечивала данные по температуре электронов (${{T}_{e}}$) и плотности ионного тока (${{J}_{ + }}$).
Подвергаемые травлению образцы представляли собой фрагменты пластин Si(100), в в том числе – покрытые слоями SiO2 и Si3N4 толщиной ∼500 нм. Средний размер образца составлял ∼4 см2. Температура образцов в процессе обработки поддерживалась на постоянном уровне с помощью системы водяного охлаждения, встроенной в нижний электрод. Высота ступеньки травления $\Delta h$ на границе маскированной и немаскированной областей обрабатываемой поверхности измерялась профилометром Alpha-step D-500 (KLA-Tencor, USA). В качестве маскирующего покрытия использовался позитивный фоторезист AZ1512 толщиной ∼1.5 мкм. В предварительных экспериментах было найдено, что при временах обработки $~\tau $ ≤ 5 мин характер зависимостей $\Delta h = f\left( \tau \right)$ для любой комбинации входных параметров близок линейному. Данный факт свидетельствует о стационарном процессе, протекающем с постоянной скоростью $R = {{\Delta h} \mathord{\left/ {\vphantom {{\Delta h} \tau }} \right. \kern-0em} \tau }$. Было установлено также, что увеличение числа одновременно загружаемых образцов для каждого из исследованных материалов не сопровождается заметными изменениями как скорости травления, так и электрофизических параметров плазмы, извлекаемых из зондовых ВАХ. Это позволяет во всех случаях говорить о кинетическом режиме травления, отличающемся пренебрежимо малым влиянием продуктов гетерогенного взаимодействия на параметры газовой фазы.
2.2. Анализ состава плазмы и кинетики гетерогенных процессов
Для получения данных по составу плазмы в системе C4F8 + O2 + Ar использовалась 0-мерная кинетическая модель с маквэлловской аппроксимацией функции распределения электронов по энергиям (ФРЭЭ) [10, 11]. Алгоритм моделирования базировался на совместном решении уравнений химической кинетики для нейтральных и заряженных частиц в квазистационарном приближении. Принципы создания таких моделей и вопросы их применимости для описания плазмы низкого ($p$ < 50 мторр) давления в газах-компонентах исследуемой смеси подробно рассмотрены в предшествующих работах [6–9]. Кинетическая схема (набор реакций и соответствующих констант скоростей) была заимствована из нашей работы [11] и дополнена реакциями с участием метастабильных молекул O2(a1Δ) и O2(b1Σ) [25]. Входными параметрами служили экспериментальные данные по ${{T}_{e}}$ и ${{J}_{ + }}$. В качестве выходных параметров выступали средние по объему плазмы концентрации нейтральных и заряженных частиц, а также плотности их потоков на поверхность обрабатываемого материала.
Анализ кинетики гетерогенного взаимодействия базировался на известных фактах по механизмам реактивно-ионных процессов для Si, SiO2 и Si3N4 в плазме фторуглеродных газов и смесей на их основе [5, 18, 26–28]. С учетом обобщений этих данных, проведенных ранее в наших работах [6, 11, 13, 14], основные предпосылки для такого анализа могут быть сформулированы в виде следующих положений:
− Наблюдаемая скорость реактивно-ионного процесса может быть представлена как R = Rphys + $ + \,\,{{R}_{{{\text{chem}}}}}$. Слагаемое ${{R}_{{{\text{phys}}}}}$ представляет скорость распыления химически не модифицированных атомов поверхности ионной бомбардировкой, численно равную ${{Y}_{S}}{{{\Gamma }}_{ + }}$, где ${{Y}_{S}}$ – выход распыления (атом/ион), а ${{{\Gamma }}_{ + }} \approx {{{{J}_{ + }}} \mathord{\left/ {\vphantom {{{{J}_{ + }}} e}} \right. \kern-0em} e}$ – плотность потока ионов. Слагаемое ${{R}_{{{\text{chem}}}}}$ – это скорость ионно-стимулированной химической реакции, скорость которой определяется как ${{\gamma }_{R}}{{{\Gamma }}_{{\text{F}}}}$, где ${{\gamma }_{R}}$ – эффективная вероятность взаимодействия, и ${{{\Gamma }}_{{\text{F}}}}$ – плотность потока атомов фтора. В условиях постоянства температуры обрабатываемой поверхности ${{\gamma }_{R}}$ зависит условий обработки через а) баланс процессов образования, заполнения и очистки центров адсорбции для атомов фтора, определяющих долю свободных центров; и б) баланс процессов высаживания и деструкции фторуглеродной полимерной пленки, определяющих ее толщину ${{h}_{{{\text{pol}}}}}$.
− Скорость любого канала физического взаимодействия плазмы с поверхностью (распыление атомов поверхности, ионно-стимулированная десорбция продуктов гетерогенных химических реакций, деструкция фторуглеродной полимерной пленки) отслеживается параметром $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$, где ${{M}_{i}}$ – эффективная молярная масса ионов, ${{\varepsilon }_{i}} = e\left| { - {{U}_{f}} - {{U}_{{dc}}}} \right|$, и ${{U}_{f}}$ – плавающий потенциал.
− Скорость высаживания фторуглеродной полимерной пленки на обрабатываемой поверхности отслеживается параметром ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}}$, где ${{{\Gamma }}_{{{\text{pol}}}}}$ – суммарная плотность потока полимер образующих радикалов CFx (х = 1, 2). Соответственно, относительное изменение ${{h}_{{{\text{pol}}}}}$ за счет влияния условий обработки (в том числе – начального состава плазмообразующей смеси) на эффективности физического и химического механизмов деструкции полимерной пленки характеризуется параметрами ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}}}$ и ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}$, где ${{{\Gamma }}_{{\text{O}}}}$ – плотность потока атомов кислорода.
3. ОБСУЖДЕНИЕ РЕЗУЛЬТАТОВ
На рис. 1 представлены экспериментальные данные по влиянию начального состава смеси на скорости травления Si, SiO2 и Si3N4. Можно видеть, что все три материала характеризуются однотипными немонотонными зависимостями $R = f\left( {{{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}} \right)$, при этом абсолютные значения скоростей травления при любом фиксированном составе смеси возрастают в ряду Si–SiO2–Si3N4. Последний факт хорошо согласуется с литературными данными [14, 29]. Отметим также, что дальнейшее увеличение ${{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ сопровождается монотонным снижением скоростей травления, которые достигают минимальных значений (∼9 нм/мин для Si, ∼10 нм/мин для SiO2 и ∼3.5 нм/мин для Si3N4) при полном замещении фторуглеродного компонента кислородом. Полученные результаты позволяют формулировать несколько предположений об особенностях кинетики травления Si, SiO2 и Si3N4 в исследованном диапазоне условий:
Рис. 1.
Скорость травления (сплошные линии) и доля химической составляющей в общей скорости процесса (пунктир) для Si (1), SiO2 (2) и Si3N4 (3) в зависимости от содержания кислорода в смеси C4F8 + O2 + 50% Ar.

− Ненулевые скорости травления в плазме 50% O2 + 50% Ar не могут быть обусловлены химическим механизмом и представляют собой ${{R}_{{{\text{phys}}}}}$. Корректировка этих величин с учетом изменения параметра $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$ (рис. 2) и последующий расчет ${{R}_{{{\text{chem}}}}} = R - {{R}_{{{\text{phys}}}}}$ позволяет заключить, что в исследованном диапазоне ${{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ выполняется условие ${{{{R}_{{{\text{chem}}}}}} \mathord{\left/ {\vphantom {{{{R}_{{{\text{chem}}}}}} R}} \right. \kern-0em} R}$ > 0.8 (рис. 1). Таким образом, доминирующим механизмом травления во всех случаях является ионно-стимулированная химическая реакция.
Рис. 2.
Электрофизические параметры плазмы в зависимости от содержания кислорода в смеси C4F8 + O2 + 50% Ar: 1 – температура электронов; 2 – концентрации заряженных частиц; 3 – отрицательное смещение на нижнем электроде; 4 – параметр $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$, характеризующий эффективность ионной бомбардировки.

− Качественно подобные зависимости с R = $ = f\left( {{{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}} \right)$ указывают на то, что для всех трех материалов реализуется одинаковый режим ионно-стимулированной химической реакции, определяемый типом основных активных частиц и лимитирующей стадией процесса. Принимая во внимания существенные различия в механизмах травления Si и SiO2 атомами фтора [5, 27, 28], можно полагать, чтов условиях наших экспериментов деструкция Si–O связей ионной бомбардировкой не является лимитирующей стадией травления SiO2. Это указывает на протекание ионно-стимулированной химической реакции в режиме лимитирования потоком нейтральных частиц, когда макроскопическая (наблюдаемая) кинетика процесса определяется скоростью гетерогенного взаимодействия Si + xF → SiFx.
− Немонотонная зависимость скорости химической реакции Si + xF → SiFx от содержания кислорода в смеси может быть обусловлена двумя факторами, а именно: а) аналогичной зависимостью ${{{\Gamma }}_{{\text{F}}}} = f\left( {{{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}} \right)$, как это неоднократно отмечалось ранее для систем CF4 + O2 [19] и CF4 + O2 + + Ar [23]; и б) монотонными, но противоположными тенденциями изменения плотности потока атомов фтора и эффективной вероятности гетерогенного взаимодействия. Очевидно, что выяснение этих вопросов требует анализа влияния начального состава смеси на электрофизические параметры и состав плазмы.
При диагностике плазмы было найдено, что увеличение ${{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ сопровождается снижением температуры электронов (${{T}_{e}}$ = 4.3–3.8 эВ при 0–38% O2), но увеличением концентрации заряженных частиц (${{n}_{ + }}$ ≈ ${{n}_{е}}$ = 5.0 × 1010–6.2 × 1010 см–3 при 0–38% O2) (рис. 2а). Причиной снижения ${{T}_{e}}$ является более широкий диапазон потерь энергии электронов при столкновениях с молекулами O2 за счет процессов низкопорогового возбуждения R1: O2 + + e → O2(a1Δ) + e (${{\varepsilon }_{{th}}}$ ∼ 1.0 эВ) и R2: O2 + e → → O2(b1Σ) + e (${{\varepsilon }_{{th}}}$ ∼ 1.6 эВ). Поэтому результатом замещения C4F8 на O2 является деформация ФРЭЭ, приводящая к уменьшению доли “быстрых” электронов. Рост концентраций заряженных частиц определяется изменением частот гетерогенной гибели (снижением коэффициента диффузии электронов и скорости ионов на внешней границе двойного электрического слоя у стенок реактора из-за соответствующего изменения ${{T}_{e}}$) на фоне малых изменений суммарной скорости ионизации. Постоянство последней обеспечивается близкими значениями констант скоростей ионизации для доминирующих нейтральных частиц и заметным вкладом процессов R3: O2(a1Δ) + + e → ${\text{O}}_{2}^{ + }$ + 2e, R4: O2(b1Σ) + e → ${\text{O}}_{2}^{ + }$ + 2e и R5: O(1D) + e → O+ + 2e в области ${{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ > 25%. Изменение плотности потока ионов (${{{\Gamma }}_{ + }}$ = 8.5 × 1015–1.2 × × 1016 см–2 с–1 при 0–38% O2) с ростом доли кислорода в смеси следует поведению ${{n}_{ + }}$, но сопровождается снижением $ - {{U}_{{dc}}}$ (298–252 В при 0–38% O2, см. рис. 2б) и энергии ионной бомбардировки. В результате, параметр $\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}$, отражающий эффективность ионно-стимулированных стадий процесса травления, сохраняет практически постоянное значение ∼1.2 × 1017 эВ1/2 см–2 с–1 (рис. 2б).
Анализ кинетики нейтральных частиц показал, что для исследованного диапазона условий характерны все основные особенности, отмеченные по результатам предшествующих исследований [6, 10, 11]. В частности, было найдено, что:
1) Доминирующими компонентами газовой фазы в отсутствии кислорода являются радикалы C2Fx (x = 3, 4) и CFx (x = 1, 2, 3), при этом концентрация атомов фтора ниже на порядок величины (рис. 3). Продуктами прямой диссоциации исходных молекул являются C2F4 и CF2, образующиеся по механизмам R6: C4F8 + e → 2C2F4 + e (${{k}_{6}}$ ∼ 5.0 × 10–9 см3/с при ${{T}_{e}}$ = 3 эВ) и R7: C4F8 + e → → C3F6 + CF2 + e (${{k}_{7}}$ ∼ 5.5 × 10–10 см3/с при ${{T}_{e}}$ = = 3 эВ). Выполнение соотношения ${{n}_{{{\text{C}}{{{\text{F}}}_{{\text{2}}}}}}}$ > ${{n}_{{{{{\text{C}}}_{{\text{2}}}}{{{\text{F}}}_{{\text{4}}}}}}}$ в условиях ${{k}_{6}}$ < ${{k}_{7}}$ обеспечивается за счет R8: C2F4 + + e → 2CF2 + e и R9: C2F4 + F → CF2 + CF3.
Рис. 3.
Стационарные концентрации нейтральных частиц в зависимости от содержания кислорода в смеси C4F8 + + O2 + 50% Ar.
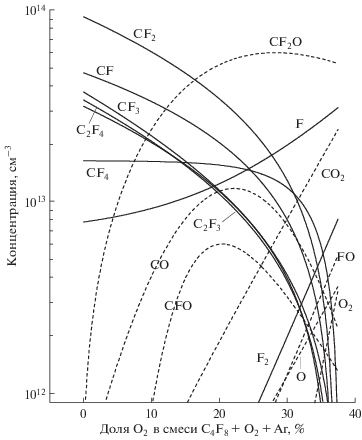
2) Основным источником атомов фтора является группа процессов R10: CFx + e → CFx– 1 + + F + e (x = 1–3), при этом вклад R11: F2 + e → → 2F + e в общую скорость образования атомов не превышает 1% из-за ${{n}_{{{\text{C}}{{{\text{F}}}_{x}}}}}$ $ \gg $ ${{n}_{{{{{\text{F}}}_{{\text{2}}}}}}}$. Основным каналом гибели атомов фтора является R9, скорость которой превышает суммарный эффект гетерогенных процессов вида R12: CFx + F → CFx+ 1. Последняя особенность и обеспечивает выполнение условия ${{n}_{{{\text{C}}{{{\text{F}}}_{x}}}}}$ > ${{n}_{{\text{F}}}}$ (рис. 3).
3) Добавление кислорода приводит к появлению новых газофазных механизмов разрушения радикалов CFx и образования атомов фтора. Наиболее эффективными реакционными схемами здесь являются R13: CFx + O/O(1D) → CFx– 1O + F, R14: CFO + O/O(1D) → CO2 + F, R15: FO + O/O(1D) → → O2 + F и R16: CFxO + e → CFx– 1O + F + e. В то же время, максимальный вклад R13–R16 в общую скорость генерации атомов F лимитируется а) скоростями образования O и O(1D) по R17: O2 + + e → 2O + e, R18: O2 + e → O + O(1D) + e и R19: O + e → O(1D) + e, в том числе – из-за гибели молекул O2 в реакциях R20: CF + O2 → CFO + O и R21: C + O2 → CO + O; и б) потерями атомарного кислорода в объемных и гетерогенных процессах вида R22: CFx + O → CFxO.
Из рис. 3 можно видеть, что увеличение доли кислорода в смеси при ${{y}_{{{\text{Ar}}}}}$ = const сопровождается резким снижением концентраций радикалов CFx (в ∼450 раз для CF3, в ∼1200 раз для CF2 в ∼520 раз для CF при 0–38% O2), котороене обеспечивается эффектом разбавления (снижением содержания фторуглеродного компонента в плазмообразующем газе), но обусловлено действием R13. Эффективность последнего канала является результатом с быстрого нарастания концентраций O и O(1D) из-за снижения скоростей гибели молекул O2 в R20 и R21. Образующиеся в R10 и R13 атомы фтора в присутствии кислорода активно трансформируются в CFO и CF2O по R22, однако молекулы CFO быстро разрушаются при взаимодействии с атомами кислорода по механизму R14. В результате уже при 20% O2 основным компонентом газовой фазы становится CF2O, при этом вклад R16 в общую скорость образования атомов фтора становится сравнимым с R10. В то же время, переход к смесям с более высоким содержанием O2 увеличивает скорость связывания атомарного кислорода в СO и CO2 по механизмам R14, R21 и R23: C + O → CO. Так как константы скоростей R24: CO + e → C + O + e и R25: CO2 + + e → CO + O + e существенно (в пределах порядка величины) ниже по сравнению с R17 и R18, рост концентраций СO и CO2 с ростом ${{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ приводит к дефициту атомов кислорода в процессах R13–R15 и R22. В результате, суммарный эффект R13–R16 лишь компенсирует снижение скорости R10, обеспечивая ${{R}_{{10}}}$ + $\sum\nolimits_{i = 13}^{16} {{{R}_{i}}} $ ≈ const в исследованном диапазоне состава смеси. Параллельно с этим, резкое уменьшение концентрации C2F4 (более чем на три порядка величины из-за R26: C2F4 + O/O(1D) → CF2O + CF2) подавляет эффективность доминирующего канала гибели атомов фтора, что приводит к уменьшению эффективной частоты гибели ${{k}_{{12}}} + {{k}_{9}}{{n}_{{{{{\text{C}}}_{{\text{2}}}}{{{\text{F}}}_{{\text{4}}}}}}}$ (1500–60 с–1, или в ∼25 раз при 0–38% O2). В результате, концентрация атомов фтора (рис. 3) и плотность их потока на обрабатываемую поверхность (рис. 4) монотонно возрастают в диапазоне 0–38% O2.
Рис. 4.
Потоки (1–3) и отношения потоков (4–6 ) активных частиц в зависимости от содержания кислорода в смеси C4F8 + O2 + 50% Ar: 1 – атомы фтора; 2 – полимер образующие радикалы (CF + CF2); 3 – атомы кислорода; 4 – ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} }}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} }}{{{\Gamma }}_{ + }}{{{\Gamma }}_{{\text{F}}}}$ (×10–16); 5 – ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}$ (×10–13); 6 – ${{{{{\Gamma }}_{{\text{O}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{\text{O}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}}}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}}}.$
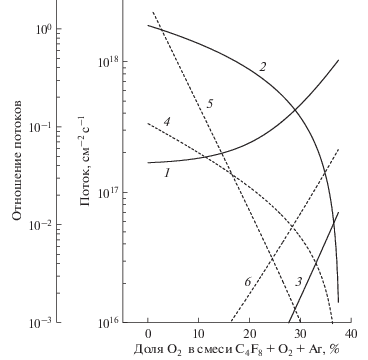
Очевидно, что отсутствие корреляции между изменениями ${{R}_{{{\text{chem}}}}}$ и ${{{\Gamma }}_{{\text{F}}}}$ для каждого их исследованных материалов позволяет однозначно отнести немонотонное поведение скорости травления к изменению эффективной вероятности взаимодействия ${{\gamma }_{R}} = {{{{R}_{{{\text{chem}}}}}} \mathord{\left/ {\vphantom {{{{R}_{{{\text{chem}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}}$ (рис. 5а). По нашему мнению, такая зависимость ${{\gamma }_{R}} = f\left( {{{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}} \right)$ не может быть объяснена в рамках ионно-стимулированной химической реакции, включающей только стадии травления кремния атомами фтора (R27), высаживания фторуглеродной полимерной пленки (R28) и ее разрушения под действием физического (R29) и химического (R30) факторов:
(R27)
${\text{Si(s}}{\text{.}}) + x{\text{F}} \to {\text{Si}}{{{\text{F}}}_{x}}({\text{s}}.) \to {\text{Si}}{{{\text{F}}}_{x}},$(R28)
${\text{Si(s}}{\text{.}}) + {\text{C}}{{{\text{F}}}_{x}} \to {{( - {\text{C}}{{{\text{F}}}_{x}} - )}_{n}}{\kern 1pt} :{\kern 1pt} {\text{Si(s}}.),$(R29)
${{\left( { - {\text{C}}{{{\text{F}}}_{x}}{\kern 1pt} - } \right)}_{n}}{\kern 1pt} :{\kern 1pt} {\text{Si}}\left( {{\text{s}}{\text{.}}} \right)\xrightarrow{{{\text{ионы}}}}{\text{Si}}\left( {{\text{s}}{\text{.}}} \right) + {\text{C}}{{{\text{F}}}_{x}},$(R30)
${{\left( { - {\text{C}}{{{\text{F}}}_{x}}{\kern 1pt} - } \right)}_{n}}{\kern 1pt} :{\kern 1pt} {\text{Si}}\left( {{\text{s}}{\text{.}}} \right) + {\text{O}} \to {\text{Si}}\left( {{\text{s}}{\text{.}}} \right) + {\text{C}}{{{\text{F}}}_{x}}{\text{O}}.$Рис. 5.
Эффективная вероятность взаимодействия атомов фтора для Si (1), SiO2 (2) и Si3N4 (3) в зависимости от содержания кислорода в смеси C4F8 + O2 + 50% Ar (а) и параметра ${{{{{\Gamma }}_{{\text{O}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{\text{O}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}}}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} {{{\Gamma }}_{ + }}}}$ (б).

Действительно, данные рис. 4 однозначно свидетельствуют о том, что увеличение доли кислорода в смеси подавляет образование полимерной пленки по R28 (из-за снижения плотности потока полимеробразующих радикалов и отношения ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{F}}}}}}$), но сопровождается ростом скоростей R29 и R30, как это следует из изменений отслеживающих параметров ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} }}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} }}{{{\Gamma }}_{ + }}{{{\Gamma }}_{F}}$ и ${{{{{\Gamma }}_{{{\text{pol}}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{{\text{pol}}}}}} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}} \right. \kern-0em} {{{{\Gamma }}_{{\text{O}}}}{{{\Gamma }}_{{\text{F}}}}}}$. Это должно способствовать снижению ${{h}_{{{\text{pol}}}}}$, облегчению доступа атомов фтора к обрабатываемой поверхности (фактически, к поверхностным атомам кремния Si (s.), которые выступают в качестве центров адсорбции) и, как следствие, росту ${{\gamma }_{R}}$. Отметим, что корреляции вида “чем меньше толщина пленки, тем выше вероятность взаимодействия и выход травления” неоднократно отмечались в литературе при экспериментальном исследовании процессов травления Si, SiO2 и Si3N4 во фторуглеродной плазме [18, 26, 27]. Поэтому можно предположить, что в исследованном диапазоне условий существуют дополнительные каналы гетерогенного взаимодействия, приводящие к снижению ${{\gamma }_{R}}$, но не связанные ни с полимеризационными процессами, ни с ионной бомбардировкой. По нашему мнению, в качестве таких каналов могут выступать:
1) Изменение состава продуктов травления, приводящее к снижению их эффективной летучести. Известно, в частности, что окси-хлориды и окси-бромиды кремния отличаются значительно меньшей летучестью по сравнению со своими бескислородными аналогами [30, 31]. Таким образом, если подобное правило действует и для фторидов кремния, гетерогенный процесс вида
(R31)
${\text{Si}}{{{\text{F}}}_{x}}\left( {{\text{s}}.} \right) + y{\text{O}} \to {\text{Si}}{{{\text{F}}}_{x}}{{{\text{O}}}_{y}}\left( {{\text{s}}.} \right)$(R32)
${\text{Si}}{{{\text{F}}}_{x}}{{{\text{O}}}_{y}}\,({\text{s}}.)\xrightarrow{{{\text{ионы}}}}{\text{Si}}{{{\text{F}}}_{x}}{{{\text{O}}}_{y}},$2) Конкурентная адсорбция атомов кислорода, приводящая к уменьшению доли свободных центров адсорбции для атомов фтора за счет образования оксидных связей:
Очевидно, что восстановление центров адсорбции возможно только в ионно-стимулированном процессе(R34)
${\text{SiO}}\,{\text{(s}}{\text{.)}}\xrightarrow{{{\text{ионы}}}}{\text{Si}}\,{\text{(s}}.) + {\text{O}},$В простейшем случае можно предположить, что степень влияния предложенных механизмов на величину ${{\gamma }_{R}}$ для каждого из исследованных материалов прямо пропорциональна плотности потока атомов кислорода и обратно пропорциональна интенсивности ионной бомбардировки обрабатываемой поверхности. Таким образом, изменение суммарного эффекта R31–R34 при варьировании начального состава смеси может быть отслежено отношением ${{{{{\Gamma }}_{{\text{O}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{\text{O}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} }}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} }}{{{\Gamma }}_{ + }}$. Расчеты показали, что увеличение ${{y}_{{{{{\text{O}}}_{{\text{2}}}}}}}$ приводит к монотонному росту параметра ${{{{{\Gamma }}_{{\text{O}}}}} \mathord{\left/ {\vphantom {{{{{\Gamma }}_{{\text{O}}}}} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} }}} \right. \kern-0em} {\sqrt {{{M}_{i}}{{\varepsilon }_{i}}} }}{{{\Gamma }}_{ + }}$ (6.9 × 10–5–6.7 × × 10–2 эВ–1/2, или в ∼1000 раз при 1–38% O2, см. рис. 5), при этом имеет место однозначная корреляция соответствующей зависимости с изменением ${{\gamma }_{R}}$ (рис. 5б). На наш взгляд, последний факт является подтверждением адекватности предложенных механизмов. Таким образом, можно с высокой степенью достоверности утверждать, что а) немонотонные зависимости скоростей травления Si, SiO2 и Si3N4 от содержания кислорода в смеси являются результатом снижения эффективной вероятности взаимодействия на фоне роста плотности потока атомов фтора; и б) изменение эффективной вероятности взаимодействия обусловлено гетерогенными процессами с участием атомов кислорода.
4. ЗАКЛЮЧЕНИЕ
Изучено влияние соотношения C4F8/O2 в смеси C4F8 + O2 + 50% Ar на электрофизические параметры плазмы, концентрации активных частиц и кинетику реактивно-ионного травления основных материалов кремниевой электроники (Si, SiO2 и Si3N4) в условиях индукционного ВЧ (13.56 МГц) разряда. Показано, что варьирование начального состава смеси в диапазоне 0–38% O2 а) не оказывает принципиального влияния на эффективность ионной бомбардировки из-за противоположных изменений концентрации и энергии ионов; и б) вызывает монотонный рост концентрации атомов фтора. Причиной последнего эффекта является резкое снижение частоты объемной гибели атомов на фоне малых изменений суммарной скорости их образования. При исследовании кинетики травления установлено, что а) абсолютные значения скоростей травления возрастают в ряду Si–SiO2–Si3N4 при любом постоянном составе смеси; и б) немонотонные зависимости скоростей травления от доли O2 в смеси обусловлены снижением эффективной вероятности взаимодействия атомов фтора. Предположено, что снижение эффективной вероятности взаимодействия не связано с изменением кинетики поверхностной полимеризации, но может быть объяснено гетерогенными процессами с участием атомов кислорода. В качестве таких процессов следует рассматривать изменение состава продуктов травления и/или конкурентное заполнение кислородом центров адсорбции атомов фтора, приводящее, в том числе, к увеличению энергетического порога химической реакции за счет формирование связей Si–O.
Исследование выполнено при финансовой поддержке РФФИ в рамках научного проекта 19-07-00804А.
Список литературы
Wolf S., Tauber R.N. Silicon Processing for the VLSI Era. Volume 1. Process Technology. Lattice Press, New York, 2000. 416 p.
Nojiri K. Dry etching technology for semiconductors. Springer International Publishing, Tokyo. 2015. 116 p.
Donnelly V.M., Kornblit A. Plasma etching: Yesterday, today, and tomorrow // J. Vac. Sci. Technol. 2013. V. 31. P. 050825-48.
Advanced plasma processing technology. John Wiley & Sons Inc., New York. 2008. 479 p.
Lieberman M.A., Lichtenberg A.J. Principles of plasma discharges and materials processing. New York, John Wiley & Sons Inc. 2005. 757 p.
Ефремов А.М., Мурин Д.Б., Kwon K.-H. Особенности кинетики объемных и гетерогенных процессов в плазме смесей CHF3 + Ar и C4F8 + Ar // Микроэлектроника. 2019. Т. 48. № 2. С. 125–133.
Rauf S., Ventzek P.L.G. Model for an inductively coupled Ar/c-C4F8 plasma discharge // J. Vac. Sci. Technol. A. 2002. V. 20. P. 14–23.
Kokkoris G., Goodyear A., Cooke M., Gogolides E. A global model for C4F8 plasmas coupling gas phase and wall surface reaction kinetics // J. Phys. D: Appl. Phys. 2008. V. 41. P. 195 211.
Vasenkov A.V., Li X., Oehrlein G.S., Kushner M.J. Properties of c-C4F8 inductively coupled plasmas. II. Plasma chemistry and reaction mechanism for modeling of Ar/c-C4F8/O2discharges // J. Vac. Sci. Technol. A. 2004. V. 22. P. 511–530.
Lee J., Efremov A., Yeom G.Y., Lim N., Kwon K.-H. Application of Si and SiO2 Etching Mechanisms in CF4/C4F8/Ar Inductively Coupled Plasmas for Nanoscale Patterns // J. Nanosci. Nanotechnol. 2015. V. 15. P. 8340–8347.
Chun I., Efremov A., Yeom G.Y., Kwon K.-H. A comparative study of CF4/O2/Ar and C4F8/O2/Ar plasmas for dry etching applications // Thin Solid Films. 2015. V. 579. P. 136–148.
Li X., Ling L., Hua X., Oehrlein G.S., Wang Y., Anderson H.M. Characteristics of C4F8 plasmas with Ar, Ne, and He additives for SiO2 etching in an inductively coupled plasma (ICP) reactor // J. Vac. Sci. Technol. A. 2003. V. 21. P. 1955–1963.
Efremov A., Murin D., Kwon K.-H. Plasma parameters, densities of active species and etching kinetics in C4F8 + + Ar gas mixture // Известия вузов. Химия и хим. технология. 2019. V. 62. № 2. P. 31–37.
Lim N., Efremov A., Kwon K.-H. Gas-phase chemistry and etching mechanism of SiNx thin films in C4F8 + Ar inductively coupled plasma // Thin Solid Films. 2019. V. 685. P. 97–107.
Shankaran A., Kushner M.J. Etching of porous and solid SiO2 in Ar/c-C4F8, O2/c-C4F8 and Ar/O2/c-C4F8 plasmas // J. Appl. Phys. 2005. V. 97. P. 023 307 (1–10).
Li X., Ling L., Hua X., Fukasawa M., Oehrlein G.S., Barela M., Anderson H.M. Effects of Ar and O2 additives on SiO2 etching in C4F8-based plasmas // J. Vac. Sci. Technol. A. 2003. V. 21. P. 284–293.
Krastev V., Reid I., Galassi C., Hughes G., Mcglynn E. Influence of C4F8/Ar/O2 plasma etching on SiO2 surface chemistry // J. Mater. Sci. Mater. Electron. 2005. V. 16. P. 541–547.
Standaert T.E.F.M., Hedlund C., Joseph E.A., Oehrlein G.S. Role of fluorocarbon film formation in the etching of silicon, silicon dioxide, silicon nitride, and amorphous hydrogenated silicon carbide // J. Vac. Sci. Technol. A. 2004. V. 22. P. 53–60.
Kimura T., Noto M. Experimental study and global model of inductively coupled CF4/O2 discharges // J. Appl. Phys. 2006. V. 100. P. 063 303 (1–9).
Venkatesan S.P., Trachtenberg I., Edgar T.F. Modeling of silicon etching CF4/O2 and CF4/H2 plasmas // J. Electrochem. Soc. 1990. V. 137. № 7. P. 2280–2290.
Schoenborn P., Patrick R., Baltes H.P. Numerical simulation of a CF4/O2 plasma and correlation with spectroscopic and etch rate data // J. Electrochem. Soc. 1989. V. 136. № 1. P. 199–205.
Son J., Efremov A., Chun I., Yeom G.Y., Kwon K.-H. On the LPCVD-Formed SiO2 Etching Mechanism in CF4/Ar/O2 Inductively Coupled Plasmas: Effects of Gas Mixing Ratios and Gas Pressure // Plasma Chem. Plasma Proc. 2014. V. 34. P. 239–257.
Efremov A., Lee J., Kim J. On the control of plasma parameters and active species kinetics in CF4 + O2 + Ar gas mixture by CF4/O2 and O2/Ar mixing ratios // Plasma Chem. Plasma Process. 2017. V. 37. P. 1445–1462.
Shun’ko E.V. Langmuir probe in theory and practice. Universal Publishers. Boca Raton. 2008. 245 p.
Hsu C.C., Nierode M.A., Coburn J.W., Graves D.B. Comparison of model and experiment for Ar, Ar/O2 and Ar/O2/Cl2 inductively coupled plasmas // J. Phys. D Appl. Phys. 2006. V. 39. № 15. P. 3272–3284.
Stoffels W.W., Stoffels E., Tachibana K. Polymerization of fluorocarbons in reactive ion etching plasmas // J. Vac. Sci. Tech. A. 1998. V. 16. P. 87–95.
Matsui M., Tatsumi T., Sekine M. Relationship of etch reaction and reactive species flux in C4F8–Ar–O2 plasma for SiO2 selective etching over Si and Si3N4 // J. Vac. Sci. Technol. A. 2001. V. 19. P. 2089–2096.
Gray D.C., Tepermeister I., Sawin H.H. Phenomenological modeling of ion enhanced surface kinetics in fluorine-based plasma etching // J. Vac. Sci. Technol. B. 1993. V. 11. P. 1243–1257.
Lee K.H., Chung K.S., Yu J. Selective etching of thick Si3N4, SiO2 and Si by using CF4/O2 and C2F6 gases with or without O2 and Ar addition // J. Korean Phys. Soc. 2009. V. 54. № 5. P. 1816–1823.
Cunge G., Kogelschat Z.M., Joubert O., Sadeghi N. Plasma-wall interactions during silicon etching processes in high-density HBr/Cl2/O2 plasmas // Plasma Sources Sci. Technol. 2005. V. 14. № 2. P. S42–S51.
Tinck S., Boullart W., Bogaerts A. Modeling Cl2/O2/Ar inductively coupled plasmas used for silicon etching: effects of SiO2 chamber wall coating // Plasma Sources Sci. Technol. 2011. V. 20. P. 045 012 (1-10).
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника


