Микроэлектроника, 2021, T. 50, № 3, стр. 228-235
Электромагнитное моделирование монолитной интегральной схемы СВЧ аттенюатора на AlGaN/GaN гетероструктурах
А. С. Адонин a, b, *, А. Ю. Евграфов a, Ю. В. Колковский a, b, В. М. Миннебаев a, b
a АО “НПП “Пульсар”,
105187 Москва, Окружной проезд, 27, Россия
b МИРЭА
119454 Москва, Проспект Вернадского, 78, строение 4, Россия
* E-mail: adonin@pulsarnpp.ru
Поступила в редакцию 20.07.2020
После доработки 04.08.2020
Принята к публикации 15.10.2020
Аннотация
Рассмотрены особенности электромагнитного моделирования МИС СВЧ 5-ти разрядного аттенюатора для частотного диапазона 5–15 ГГц на AlGaN/GaN гетероструктурах. Реализация устройства предусматривает использование контактов с емкостной связью. Аттенюатор обеспечивает ослабление 1, 2, 4, 8 и 16 дБ в полосе частот от 5 до 15 ГГц и управление амплитудой сигнала в диапазоне 0–31 дБ с шагом 1 дБ и начальные потери до 5 дБ.
1. ВВЕДЕНИЕ
Совершенствование характеристик радиолокационных систем невозможно без улучшения параметров приемо-передающих модулей (ППМ). Требование неизменности фазового сдвига при регулировании коэффициента передачи определяет качество ППМ активных фазированных решеток. Изменение фазового сдвига или группового времени запаздывания обусловлено влиянием паразитных реактивностей элементов. Поэтому при проектировании одного из основных элементов ППМ-аттенюатора, обеспечивающего управление сигналом по амплитуде, предъявляется повышенное требование в части стабильности фазового сдвига выходного сигнала относительно входного при регулировании коэффициента передачи [1]. Эта задача усложняется при работе аттенюатора в широкой полосе частот. Уменьшить влияние паразитных реактивностей технологически можно только до определенного предела. Некоторые методы коррекции разработаны на p-i-n-диодах [2, 3]. В современных разработках наблюдается тенденция к созданию широкополосных цифровых аттенюаторов, перекрывающих несколько частотных диапазонов, позволяя инженерам унифицировать свои разработки под различные применения. Структурно-цифровой аттенюатор представляет собой линейку фиксированных аттенюаторов с возможностью управления каждой секцией последовательным или параллельным кодом [4]. Кроме того, интенсивное развитие СВЧ устройств [1, 5, 6] на базе GaN HEMT с высокими напряжениями питания (28–50 В) требует появления управляющих устройств (ключи, аттенюаторы, фазовращатели) с аналогичными питающими напряжениями, что приведет к уменьшению источников вторичного электропитания, снижению массогабаритных размеров устройств и повышению их надежности. К недостаткам аттенюаторов на p-i-n и ПТШ ключах можно отнести:
–дополнительные потери в открытом режиме, что не позволяет реализовать высокую чувствительность при малом уровне сигнала;
–достаточно большой ток управления, из-за чего снижается эффективность МИС.
Преимущества проектируемого аттенюатора состоят в возможности реализации МИС СВЧ на AlGaN/GaN гетероструктурах по упрощенной технологии и изготовлении контактов с емкостной связью, используя главные характеристики широкозонного полупроводника GaN: высокую подвижность электронов (выше 2500 см2/В ⋅ с) и низкое слоевое сопротивление канала 2-х мерного электронного газа (2DEG) (ниже 300 Ом/кв), при этом исключается необходимость формирования барьера Шоттки и омических контактов, что повышает надежность и экономичность изделия, а также в цепи управления используется не постоянный ток, а напряжение.
2. ВЫБОР КОНСТРУКЦИИ И РАЗРАБОТКА МИС СВЧ АТТЕНЮАТОРА
Разработка конструкции МИС СВЧ проводилась с использованием электромагнитного моделирования на базе САПР Microwave Office, поскольку традиционные методы проектирования на основе верифицированных библиотек элементов, широко используемые в микроэлектронике, при проектировании СВЧ устройств не могут гарантировать положительный результат из-за специфики СВЧ устройств. В стандартных методах проектирования при использовании гетероструктур AlGaN/GaN возникает необходимость корректировки математической модели транзистора, например, для учета поляризации заряда, влияющего на общий заряд в канале и, в конечном итоге, на выражение тока стока. Эквивалентная схема транзистора должна учитывать виртуальные внутренние узлы для выравнивания потенциалов внутреннего транзистора. Внесение дополнительных уточнений в математические модели не позволяет учесть электромагнитное взаимодействие между смежными элементами схемы и элементами всей конструкции кристалла, контурами металлизации, заземления и др. Элементы схемы на высоких частотах имеют распределенные параметры, паразитные составляющие которых зависят от индивидуальных особенностей отдельных элементов и конструкции устройства в целом. Технологический маршрут изготовления сложных МИС СВЧ GaN на базе транзисторов обязывает выполнения повышенных требований к производственным мощностям и вложения дополнительных финансовых затрат [7, 8].
В последние же годы развивается и в работах [9–12] показана эффективность применения технологии с емкостными контактами при использовании гетероструктур AlGaN/GaN для изготовления управляющих СВЧ устройств. В настоящей работе рассматриваются особенности проектрования СВЧ МИС 5-ти разрядного аттенюатора по данной технологии. Простой ключ, у которого контакты с емкостной связью (можно сравнить с варактором) имеет два контакта, расположенных на поверхности AlGaN/GaN структуры. Входной и выходной изолированные контакты являются верхними электродами конденсатора, а канал 2DEG является нижней обкладкой конденсатора, и при наличии отрицательного или положительного смещения превышающего пороговое напряжение, которое обеспечивает наноразмерный диэлектрик (Al2O3, HfO2) расположенный между металлическими контактами и поверхностью AlGaN/GaN, при f ≥ 1 ГГц между контактами и каналом 2DEG возникает сильная емкостная связь. Компонент вертикального тока является исключительно емкостным, а компонент горизонтального тока проходит через канал 2DE, что обеспечивает низкий импеданс между контактами. На рис. 1 показана схема распределения двухмерного электронного газа для этого ключа, когда емкостная связь образуется между управляющими металлическими электродами и двухмерным электронным газом с управлением по затвору в режимах “включено” и “выключено”.
Рис. 1.
Распределение 2-х мерного электронного газа под металлическими электродами ключа с управлением по затвору в режиме “включено” и “выключено”.
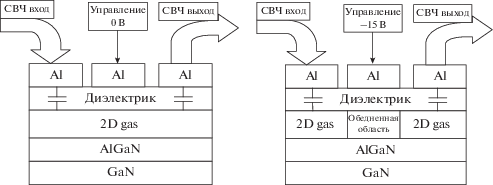
Разработка модели проводилась, начиная с простой 2-х электродной конструкции рис. 2.
Уточнение модели проводилось с учетом измерений работы SPST переключателя на частоте 10 ГГц с раздельным вводом СВЧ сигнала и управляющих напряжений.
Это позволило разработать модель 3-х электродной конструкции GaN МИС СВЧ SPDT переключателя с учетом его конструктивных особенностей: длинна “пальца”, ширина “пальца”, количество затворов, толщина подложки, расстояние между последовательно подключенным ключом по направлению СВЧ сигнала и параллельным и др., которые учитывались в процессе проектирования.
Технология изготовления МИС СВЧ с применением емкостных парных контактов позволяет использовать вариативности конструкции СВЧ переключателя и возможности оптимизировать параметры SPDT переключателя для каждой секции отдельно с учетом требуемого уровня ослабления без изменения структурной схемы.
Основные параметры аттенюатора
При проектировании аттенюатора основное внимание уделялось следующим параметрам:
▪ Ослабление, соответствующее разряду каскада аттенюатора должно равняться величине ${{а}_{k}} = a_{1}^{{2k - 1}}{\text{,}}$ где а1 – ослабление первого каскада, k = = 1, 2 … n, номер каскада (1);
▪ минимальное значение “нулевого ослабления” А0 – ослабление, когда все каскады аттенюатора выключены.
▪ Рабочий диапазон частот ΔF – максимально широкий.
▪ Инвариантность изменения фазы аттенюатора Inv(Δφатт) относительно всех его возможных состояний ослаблений Аn.
▪ Мощность Pвх атт максимальная.
Проектирование
Для разработки сложной схемы, включающей несколько десятков ключей, удобно использовать модель ключа в состояниях “On” и “Off” в виде RLC эквивалентной схемы (риc. 3) с параметрическими зависимостями элементов RLC от геометрических размеров и конструкционных параметров, таких как: n – количество встречных пальцев, w – ширина пальца, s – зазор между пальцами, l – длина пальца.
Структурная схема аттенюатора
Схема ступенчатого аттенюатора (рис. 4) предполагает наличие k каскадов, каждый из которых переключается в соответствии с поданным не него управляющим сигналом Ck между состоянием “без ослабления” или “Off” и состоянием “с ослаблением” или “On”. Переключение осуществляется синфазно ключами SPDT Kik по входу и Kok по выходу каскада.
Блоки ak, отвечающие за ослабления каскадов аттенюатора, могут представлять собой резистивные секции (рис. 5) типа “Т”, “П” или “М” (мостовые).
“М” тип не удобен для применения в СВЧ ИС в силу излишней схемной сложности. В табл. 1 показаны расчетные значения резисторов в “Т” и “П” схемах, для разных уровней ослаблений и согласованных с 50 Ом нагрузками по входу и выходу. “Т” тип требует экстремально низких значений Rs для ослабления L = 1 дБ и Rp для L = 32 дБ, что может быть проблемой при производстве, в виду большой относительной величины разброса номинала. Поэтому для ослаблений А = 4, 8, 16 удобнее использовать “Т” тип аттенюатора. А для ослаблений А = 1, 2, 32 удобней использовать “П” тип.
Таблица 1.
Расчетные значения резисторов Т и П секций аттенюатора
| А, дБ | “Т” АТТ | “П” АТТ | ||
|---|---|---|---|---|
| Rs, Oм | Rp = Oм | Rs, Oм | Rp = Oм | |
| 1 | 2.88 | 433.34 | 5.77 | 869.55 |
| 2 | 5.73 | 215.24 | 11.61 | 463.21 |
| 4 | 11.31 | 104.83 | 23.85 | 220.97 |
| 8 | 21.53 | 47.31 | 52.84 | 116.14 |
| 16 | 36.32 | 16.36 | 153.78 | 68.43 |
| 32 | 47.55 | 2.51 | 994.64 | 52.58 |
Конструкция ключей Kik и Kok определяется величиной необходимой развязки каналов ak.
Как было отмечено, изменение фазового сдвига или группового времени запаздывания обусловлено влиянием паразитных реактивностей элементов, поэтому для уменьшения паразитных реактивностей элементов использовались дополнительные цепи коррекции реактивностей.
На рис. 6 показан худший случай сложения сигнала по каналу ослабления и по нулевому каналу. В этом случае фаза на выходе отличается от входа на максимальную величину φ.
Рис. 6.
Худший случай сложение сигнала по каналу ослабления и не окончательно подавленного сигнала по опорному выключенному каналу приводит к добавлению неконтролируемой фазы на выходе каскада на неопределенной частоте.
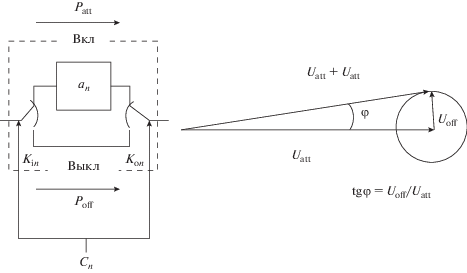
В табл. 2 представлены результаты расчета необходимой развязки плеч для заданного минимального значения φ. Развязка $\beta $ рассчитывается по формуле:
(1)
$\beta = 20{\kern 1pt} {{\log }_{{10}}}\left( {{{{10}}^{{\frac{ \propto }{{20}}}}}} \right){\text{tg}}\varphi ,$Таблица 2.
Соотношение ослабления каскада “α” в состоянии “включено” и необходимой величины развязки “β” в состоянии “выключено” для обеспечения минимального паразитного фазового набега “φ”
| α, дБ | φ, град | β, дБ |
|---|---|---|
| –32 | 1 | –67.16 |
| –16 | 1 | –51.16 |
| –32 | 2 | –61.1 |
| –16 | 2 | –45.13 |
| –32 | 5 | –53.16 |
| –16 | 5 | –37.16 |
| –32 | 10 | –47.07 |
| –16 | 10 | –31.07 |
В общем виде схема SPDT ключа на входе и выходе каскада аттенюатора показана на рис. 7. Количество N последовательных (KsN) и параллельных (KpN) ключей, а также их параметры, зависят от требуемого значения развязки β (табл. 2). Использование RLC (l, w, s, n) SPDT модели позволяет провести синтез SPDT ключей на входе и выходе каскада аттенюатора. Для упрощения решения примем следующие допущения:
• Вход и выход (SPDTin и SPDTout) идентичны.
• Количество ключей в плече SPDT равно двум, что обусловлено технологией и требованием к минимальной величине нулевого ослабления.
Отметим, что вместе с требованием по развязке каналов, одновременно необходимо, чтобы потери в состоянии “On” были минимальные.
Проведенный синтез ключей позволил получить параметры l, w, s, n для последовательных и параллельных ключей. Одновременно было установлено, что SPDTin/out, состоящий из плеч с одним последовательным и одним параллельным ключом, исходя из технологии HFET GaN 2 DEG channel с удельным сопротивлением 300 Ом/кв, w = 2mic, s = 2mic, позволяют достичь развязки плеч для каскада 16 дБ с фазовым сдвигом не более 2 град. Потери в состоянии “выключено” не более 1.0 дБ. Поэтому на следующем этапе синтеза каскада аттенюатора проводился анализ схемы рис. 8 и определялись следующие элементы:
• ML1 – длина линии между последовательным и параллельным ключом;
• Ind – индуктивность параллельную ключу Kp1, необходимую для компенсации емкости разомкнутого ключа для улучшения потерь и рабочей полосы плеча SPDT в состоянии “On”;
• MLφ – длину линии в нулевом плече отвечающую за компенсацию фазы при переключении аттенюатора.
Оптимизация элементов ML1, Ind и MLφ проводилась с учетом влияния индуктивности заземляющих отверстий при толщине подложки Al2O3 200 мкм.
Анализ каскада аттенюатора с ослаблением L = 16 дБ представленный эквивалентными элементами и проведенный при помощи “NI “Microwave Office” с последующей оптимизацией показал, что достигаются следующие характеристики:
• рабочая полоса ΔF = 5–15 ГГц,
• ослабление аттенюатора Latt = 17 ± 0.2 дБ,
• ослабление по “нулевому каналу” L0 = 1.0 ± ± 0.2 дБ,
• максимальная разность фаз при переключении каналов Δφ ≤ 2○.
Оптимизируемые элементы:
Длина ML 10 мкм
Ind = 1.5 nH – зависит от параметров параллельного ключа.
Длина MLφ уточняется при электромагнитном моделировании физической топологии каскада.
Расчет допустимой мощности, подаваемой на аттенюатор
Максимальная рабочая мощность аттенюатора зависит от возможности рассеяния тепла в СВЧ МИС.
• Рассеяние мощности в резисторах, составляющих секцию аттенюатора. Наиболее критические каскады а32 и а16. При предположении, что “нулевые” потери в каждом каскаде равны Lk = 1 дБ, то пять каскадов дают ∑5Lk = 5 дБ. Следовательно, максимальная мощность аттенюатора равна Patt_max = Pa32_max × 3, если этот каскад разместить последним.
где gn = 0.01 $~\left[ {\frac{{\text{W}}}{{{{{\text{C}}}_{{{\text{grad}}}}}}}} \right]$ удельная тепловая проводимость резистора; (t1 – t0) [Cgrad] – температура перегрева резистора; L [мм] – периметр резистора; h [мм] – толщина подложки.При размере резистора Rp 0.1 × 0.1 мм, толщине GaN подложки h = 0.2 мм и перегреве 25°C получаем Pa32_max = 0.5 В непрерывной мощности. Тогда получаем Patt_max = 1.5 В непрерывной мощности. В случае импульсной модуляции и импульсах (Ти ≤ 100 мкс) максимальная мощность возрастает в пропорционально скважности.
• Рассеяние мощности в ключах, составляющих SPDT секцию. Наиболее критические элементы в SPDT – последовательные ключи в состоянии “включено”. Моделирование аттенюатора привело к следующим размерам последовательного ключа:
Тип ключа – трехэлектродный многозатворный
L (длина) = 350 мкм, получено в результате моделирования
W (ширина) = 2 ммк, задано топологией
S (зазор) = 2 мкм, задано топологией
ρ (удельное сопротивление) = 300 Ом/кв
ng (количество затворов) = 2.
Получаем величину эквивалентного резистора Re
(3)
${{R}_{e}} = \frac{{\rho \left( {2W + S} \right) \times 1.5{\text{\;}}}}{{L{{n}_{g}}}} = 5\,\,{\text{Ом}},$С учетом потерь в нем –0.4 дБ, максимальная непрерывная мощность на входе ключа:
(4)
$~{{P}_{{{\text{maxin}}}}}~\,\, = \,\,~\frac{{{{{\text{P}}}_{{{\text{max\;switch}}}}}{\text{\;}}}}{{1 - {{{10}}^{{{L \mathord{\left/ {\vphantom {L {10}}} \right. \kern-0em} {10}}}}}}} = 9.9\,\,{\text{Вт}}.$Результаты проектирования аттенюатора
В соответствии с подходом, показанным на рис. 4 и 8, разработана топология 5-каскадного аттенюатора с ступенчаты ослаблением с шагом 1 дБ с диапазоном ослаблений 0–31 дБ с начальным ослаблением 5 дБ. Топология аттенюатора показана на рис. 9.
На рис. 10, 11, 12, 13 приведены расчетные АЧХ и ФЧХ аттенюатора в полосе частот 5–15 ГГц.
3. ЗАКЛЮЧЕНИЕ
Разработана топология МИС СВЧ 5-ти разрядного аттенюатора для частотного диапазона 5–15 ГГц на AlGaN/GaN гетероструктурах. Ее реализация возможна по новой технологии с формированием слоя high-k диэлектрика нанометровой толщины на поверхности AlGaN-структуры и изготовлением контактов с емкостной связью. Аттенюатор обеспечивает ослабление 1, 2, 4, 8 и 16 дБ в полосе частот от 5 до 15 ГГц и управление амплитудой сигнала в диапазоне 0–31 дБ с шагом 1 дБ, начальные потери до 5 дБ. Размер кристалла 2 × 5 мм. Технологический маршрут изготовления МИС СВЧ с проектными нормами 2 мкм позволяет использовать оптическую литографию, не предусматривает формирование барьера Шоттки и омических контактов, а также в цепи управления используется напряжение вместо постоянного тока.
Список литературы
Белолипецкий А.В., Борисов О.В., Колковский Ю.В., Легай Г.В., Миннебаев В.М., Редька Ал.В., Редька Ан.В. Антенный электронный блок для спутниковой АФАР Х-диапазона // Электронная техника. Серия 2: Полупроводниковые приборы. 2017. № 3(246). С. 15–25.
Стукач О.В. Условие минимальной зависимости фазового сдвига от амплитудно-частотной характеристики в устройствах с переменными состояниями // Известия Томского политехнического университета. 2005. Т. 308. № 4. С. 157–160.
Авдоченко Б.И. Цифровые и аналоговые быстродействующие устройства. Томск: ТУСУР. 2007.
Beб-pecypc: https://www.qorvo.com/products/control-products/attenuators
Васильев А.Г., Глыбин А.А., Иванов К.А., Колковский Ю.В., Мещерякова К.С., Миннебаев В.М. Твердотельный нитридгаллиевый 500-ваттный импульсный усилитель мощности Х-диапазона // Электронная техника. Серия 2: Полупроводниковые приборы. 2011. № 1(226). С. 83–88.
Груздов В.В., Колковский Ю.В., Миннебаев В.М. Электронные блоки на основе AlGaN/GaN/SiC СВЧ-гетеротранзисторов для космических систем // Известия Тульского государственного университета. Технические науки. 2016. № 12-2. С. 201–208.
Гнатюк Д.Л., Федоров Ю.В. и др. Опыт проектирования СВЧ МИС миллиметрового диапазона длин волн в ИСВЧПЭ РАН // Материалы научной конф. “Пульсар-2015”. С. 129–130.
Тимошенко А.Г., Белоусов Е.О., Моленкамп К.М. Особенности проектирования и изготовления МИС СВЧ GaN фазовращателей // Национальный исследовательский университет “МИЭТ”. М.: ИППМ РАН, октябрь 2016.
Simin G. et al. High-Power RF Switching Using III-Nitride Metal–Oxide–Semiconductor Heterojunction Capacitors // IEEE ELECTRON DEV. LETT. 2005. V. 26. № 2.
Simin G. et al. III-nitride transistors with capacitively coupled contacts // APP. PHYS. LETTERS. 2006. P. 89.
Adonin A.S., Evgrafov A.Yu., Minnebaev V.M., Perevezentsev A.V., Chernyh A.V., Miakonkikh A.V., Rogozhin A.E., Rudenko K.V. Microwave C3HFET AlGaN/GaN Switch Utilizing Contacts with Capacitive Coupling // 25th Int. Crimean conference “CriMiCo’2015” Conference proceedings. 2015. V. 2. P. 1244–1246.
Adonin A.S., Evgrafov A.Yu., Minnebaev V.M., Ivashchenko N.G., Myakon’kikh A.V., Rogozhin A.E., Rudenko K.V. Electromagnetic Modeling, Technology, and Production of Microwave C3MOSHFET Switches on AlGaN/GaN Heterostructures // Russian Microelectronics, 2017. V. 46. № 6. P. 390–395., Ltd., 2017.
Дополнительные материалы отсутствуют.
Инструменты
Микроэлектроника